Étude comparative sur les performances ferroélectriques dans des couches minces de Hf0.5Zr0.5O2 déposées en couche atomique à l'aide des précurseurs Tetrakis(éthylméthylamino) et Tetrakis(diméthylamino)
Résumé
Les propriétés chimiques, physiques et électriques de la couche atomique déposée Hf0,5 Zr0,5 O2 des films minces utilisant des précurseurs tétrakis(éthylméthylamino) (TEMA) et tétrakis(diméthylamino) (TDMA) sont comparés. Le ligand des précurseurs organométalliques affecte fortement la concentration en C résiduel, la taille des grains et les propriétés ferroélectriques résultantes. Dépôt Hf0,5 Zr0,5 O2 les films avec les précurseurs TDMA entraînent une concentration en C plus faible et une taille de grain légèrement plus grande. Ces découvertes sont bénéfiques pour faire croître davantage de film à dominante ferroélectrique, ce qui atténue son effet de réveil. Du test de réveil du TDMA-Hf0,5 Zr0,5 O2 film avec un champ cyclique de 2,8 MV/cm, l'effet de réveil indésirable a été bien supprimé jusqu'à 10 5 cycles, avec une valeur de polarisation rémanente double raisonnablement élevée de ~40 μC/cm 2 . Le film a également montré une commutation fiable jusqu'à 10 9 cycles avec le champ cyclable de 2,5 MV/cm sans impliquer l'effet de réveil mais avec le comportement de fatigue typique.
Introduction
Couche atomique déposée Hf1-x Zrx O2 (ZO, x ~ 0,5) les films minces ont été le principal concurrent en tant que couche ferroélectrique (FE) ultra-mince dans le domaine des dispositifs à semi-conducteurs pour les applications de mémoire et de logique. En effet, le film FE HZO à structure en fluorite peut être réduit même en dessous de 10 nm et déposé de manière homogène sur des nanostructures tridimensionnelles en utilisant des techniques de dépôt de couche atomique (ALD) matures. De plus, il est compatible avec l'électrode TiN conventionnelle [1, 2], ce qui peut difficilement être obtenu à partir des ferroélectriques conventionnels à structure pérovskite. Malgré l'amélioration significative du traitement des films HZO et de la fabrication de dispositifs utilisant les films minces à base d'ALD au cours des dernières années, il existe plusieurs lacunes non résolues. En particulier, la fiabilité des ferroélectriques à structure fluorite est incertaine. Actuellement, l'effet de réveil et le nombre limité d'endurance sont considérés comme les problèmes les plus graves [3]. Généralement, les courbes polarisation-champ électrique (P-E) sont pincées à l'état vierge, suggérant que le champ coercitif (Ec ) est spatialement non uniforme, et plusieurs domaines FE sont épinglés [4]. Après un cycle de champ électrique avec une intensité de champ supérieure à Ec , des courbes P–E plus symétriques et carrées peuvent être obtenues, un phénomène connu sous le nom d'effet de réveil. Dans certains cas, un tel processus de réveil dure 10 4 –10 5 cycles, qui est un cycle d'endurance typique d'env. mémoire flash, ce qui complique le fonctionnement de l'appareil et du système [5]. Le nombre limité d'endurance est un autre problème critique s'il est destiné à être utilisé comme mémoire de travail (endurance> 10 15 est requis). Pour la structure de condensateur métal-ferroélectrique-métal, l'endurance maximale signalée est inférieure à 10 11 [6], et pour l'empilement de grilles métal-ferroélectrique-semiconducteur dans un transistor à effet de champ ferroélectrique, l'endurance est limitée jusqu'à 10 5 fois [3, 7].
Diverses origines de l'effet de réveil ont été suggérées dans la littérature. Les mécanismes suggérés sont l'épinglage des limites de domaine par des défauts, tels que des impuretés, des lacunes d'oxygène et la présence de la phase non ferroélectrique (phase cubique ou tétragonale) aux interfaces adjacentes aux électrodes ou au canal semi-conducteur à l'état vierge [5, 8 ,9,10]. On s'attend à ce que la concentration du site d'accrochage diminue pendant la commutation de polarisation répétitive. De plus, le cyclage du champ électrique transforme les phases interfaciales tétragonales ou cubiques en phase orthorhombique FE [5]. Cette étude s'est principalement concentrée sur l'amélioration des performances électriques du film HZO ou l'élimination de l'effet de réveil en adoptant des précurseurs alternatifs Hf et Zr pendant le processus ALD, ce qui peut entraîner une concentration en impuretés plus faible, en particulier en impureté de carbone.
Pour les procédés ALD utilisant les précurseurs métallo-organiques, il est presque inévitable d'induire des impuretés résiduelles, telles que C, N et H dans le film développé, qui proviennent très probablement des ligands organiques. Kim et al. [11, 12] ont montré qu'en modifiant la température de dépôt de HfO2 et le film HZO, le polymorphisme et les propriétés électriques résultantes pourraient être contrôlés. D'après la spectroscopie électronique Auger (AES), la concentration en C dans le film mince d'ALD HZO augmentait avec la diminution de la température de dépôt, ce qui pourrait résulter des réactions d'échange de ligand imparfaites [11, 12]. De plus, le diamètre latéral des grains diminuait avec l'augmentation de la concentration en C. La formation des phases instables ou métastables (tétragonale, orthorhombique et cubique) plutôt que la phase monoclinique stable dans de tels films à structure de fluorite est étroitement liée à l'effet de la taille des grains [13,14,15,16]. Ainsi, le contrôle de la concentration en impuretés est crucial pour atteindre la phase souhaitée (FE orthorhombique) ainsi que pour améliorer la fiabilité électrique du film.
Pour l'ALD des couches minces FE HZO, les précurseurs organométalliques Hf et Zr les plus fréquemment utilisés sont le tétrakis[éthylméthylamino]hafnium (TEMAH) et le tétrakis[éthylméthylamino]zirconium (TEMAZ) [11, 12, 17]. Ces précurseurs ont été développés pour le dépôt chimique en phase vapeur métal-organique dans le but de faciliter la décomposition du ligand via le transfert de charge électrique entre les groupes méthyle et éthyle [18,19,20]. Cependant, ce type de décomposition de ligand induite thermiquement et l'élimination subséquente des (fragments de) ligands organiques interfèrent négativement avec la réaction ALD facile entraînant l'incorporation d'impuretés (C, H et N) dans le film [11, 17, 18, 19,20].
En revanche, les précurseurs tétrakis[diméthylamino]hafnium (TDMAH) et tétrakis[diméthylamino]zirconium (TDMAZ), qui ont également été utilisés pour déposer les films FE HZO [21,22,23,24], ne possèdent que des groupements méthyle dans leur ligands. Par conséquent, un tel effet indésirable pourrait ne pas être grave, bien que la suppression complète de la décomposition thermique ne puisse être garantie.
Cette étude a effectué une analyse comparative entre les films HZO cultivés par les procédés ALD avec deux précurseurs métalliques différents ; TEMAH/TEMAZ et TDMAH/TDMAZ. Ce dernier processus a entraîné une concentration en C plus faible dans le film, ce qui a considérablement amélioré les performances électriques du film HZO. Dans les conditions de cycle de commutation optimisées, presque aucun effet de réveil n'a été obtenu alors que la polarisation commutable est restée à ~ 40 μC/cm 2 .
Méthodes/Expérimental
Préparation du Hf0.5 Zr0,5 O2 Films Minces
Ce travail a examiné l'influence des types de précurseurs organo-métalliques sur la structure et les performances électriques de la couche atomique déposée Hf0,5 Zr0,5 O2 Films minces. Les films minces de HZO ont été déposés à l'aide d'un réacteur ALD thermique à l'échelle de 4 pouces de diamètre avec du TDMAH (ou TEMAH), du TDMAZ (ou TEMAZ) et de l'ozone (190 g/m 3 concentration) en tant que précurseur Hf, précurseur Zr et source d'oxygène, respectivement. Le processus ALD optimisé avec les précurseurs TEMAH/TEMAZ était comme dans les études précédentes des auteurs [5, 9, 11, 12, 13, 14, 15, 16]. Les films minces HZO avec précurseurs TDMAH/TDMAZ ont été préparés par ALD thermique à une température de substrat de 260°C. Un rapport Hf:Zr de 50:50 a été choisi pour le test électrique, car il a été rapporté que la composition présentait la plus grande polarisation rémanente (Pr ) dans des études antérieures [17, 25, 26]. Les couches minces HZO avec les précurseurs TDMAH/TDMAZ ont été déposées avec un rapport de cycle ALD 1:1 des précurseurs Hf et Zr sur TiN/Ti/SiO2 /Si substrat. Un cycle ALD était composé d'un processus d'alimentation de la source (2 s) - purge de la source (20 s) - alimentation en ozone (3 s) - purge d'ozone (10 s). Le taux de croissance du film HZO était de 0,13 nm par cycle et les films minces HZO de 10 nm d'épaisseur ont été préparés par des précurseurs TDMAH/TDMAZ pour les expériences. Les conditions optimales peuvent varier en fonction du volume de la chambre ALD. Le tableau 1 montre la comparaison des propriétés physiques des sources TEMA et TDMA. Les films TiN (50 nm) et Ti (5 nm) ont été déposés par pulvérisation cathodique avec une puissance de pulvérisation cathodique de 5 kW sur les substrats Si de type p oxydés thermiquement à l'aide d'un outil de pulvérisation commercial (Endura, Applied Materials). Les films de HZO déposés ne sont que partiellement cristallins ou amorphes à l'état brut de dépôt, de sorte que le recuit ultérieur pour la cristallisation a été effectué à l'aide d'un processus thermique rapide (RTP) à 450°C dans N2 ambiance.
Caractérisation des propriétés chimiques/physiques du Hf0,5 Zr0,5 O2 Films Minces
Les structures cristallines des films déposés ont été analysées à l'aide d'un diffractomètre à rayons X (XRD, X'pert pro, Panalytical) dans une géométrie d'incidence rasante avec un angle d'incidence de 0,5°. Les microstructures des échantillons ont été analysées à l'aide d'une microscopie électronique à balayage (SEM, S-4800, Hitachi), et la distribution granulométrique a été analysée à l'aide d'un logiciel Gwyddion [29] via une méthode de bassin versant. Les compositions chimiques du film HZO déposé ont été analysées en utilisant la fluorescence X (XRF, Quant'X, Thermo SCIENTIFIC), et les variations en profondeur des compositions chimiques, y compris les impuretés telles que C, ont été analysées en utilisant un temps de spectroscopie électronique Auger de vol (AES, PHI-700, ULVAC-PHI).
Caractérisation des propriétés électriques du Hf0,5 Zr0,5 O2 Films Minces
Pour analyser les propriétés électriques des films HZO, les électrodes TiN supérieures ont été déposées de manière réactive par un processus de pulvérisation cathodique avec une puissance de 100 W sous 92,6%-Ar/7,4%-N2 atmosphère. Les électrodes supérieures TiN ont été modelées à l'aide d'un masque perforé avec des trous circulaires d'un diamètre de 300 µm. Les caractéristiques P–E ont été analysées à l'aide d'un testeur ferroélectrique (analyseur TF 2000, systèmes Aixacct) à une fréquence de mesure de 1 kHz. Le test d'endurance a été réalisé avec des impulsions bipolaires rectangulaires d'une hauteur et d'une largeur de 2,8 ~ 3,8 MV/cm et 10 μs, respectivement, générées par un générateur d'impulsions (81110A, Agilent) et un testeur ferroélectrique (analyseur TF 2000, systèmes Aixacct). Les caractéristiques capacité-tension (C-V) ont été mesurées à l'aide d'un analyseur d'impédance (4194A, Hewlett-Packard) sous les impulsions sinusoïdales CA avec une fréquence de 10 kHz et une hauteur de 50 mV combinées à une polarisation CC. Les constantes diélectriques des films HZO ont été calculées à partir de la capacité mesurée ainsi que de la surface d'électrode mesurée par microscopie optique et l'épaisseur mesurée en utilisant l'ellipsométrie spectroscopique (ESM-300, J. A. Woollam). Les caractéristiques de densité de courant-champ électrique (J-E) ont été analysées à l'aide d'un analyseur de paramètres à semi-conducteurs (4155B, Hewlett-Packard) sous polarisation CC avec un temps de retard de 1 s.
Résultats et discussion
La figure 1a montre les diagrammes de diffraction des rayons X à incidence rasante (GIXRD) de 10 nm d'épaisseur Hf0,5 Zr0,5 O2 couches minces déposées en TDMAH/TDMAZ (TDMA-HZO, courbe noire) et TEMAH/TEMAZ (TEMA-HZO, courbe rouge) avec un angle d'incidence de 0,5°. Les schémas de référence tirés de la littérature pour les phases monoclinique, tétragonale et orthorhombique sont annexés dans la partie inférieure. A partir des deux modèles GIXRD des films TDMA et TEMA HZO, les intensités des pics de diffraction de la phase monoclinique étaient négligeables et aucune différence notable dans les formes et les intensités des pics n'a pu être identifiée. Ainsi, aucune différence significative dans la structure cristallographique entre TDMA et TEMA HZO n'a été confirmée expérimentalement par GIXRD.

(a) Les modèles GIXRD de films minces HZO déposés à l'aide de TDMAH/TDMAZ (courbe noire) et TEMAH/TEMAZ (courbe rouge), les modèles de référence tirés de la littérature pour les phases monoclinique, tétragonale et orthorhombique sont attachés dans les panneaux inférieurs. (b) L'image SEM planaire des films TDMA HZO et (c) la distribution granulométrique de TEMA (rouge; reproduit à partir de la référence [15]), TDMA (noir) HZO. (d) Le profil de profondeur des films minces TDMA HZO analysés à l'aide de la spectroscopie électronique Auger à temps de vol, et (e) la région de faible concentration agrandie de la partie de film HZO. La concentration moyenne en C de TDMA (ligne tiret-point noire), TEMA (ligne tiret rouge ; reproduite à partir de la référence [12]), HZO est présentée
La microstructure, y compris la taille des grains latéraux, est un autre facteur critique qui peut fortement affecter les propriétés FE des films minces HZO [13,14,15,16, 30]. Ainsi, les microstructures des films TDMA et TEMA HZO ont été analysées par microscopie électronique à balayage (MEB). La figure 1b montre l'image SEM planaire des films TDMA HZO. Diverses études antérieures ont rapporté que les films minces HZO déposés à l'aide d'ALD thermique présentaient une structure de grain colonnaire, suggérant que la taille des grains verticaux est aussi grande que l'épaisseur du film [1, 5, 11, 31]. La distribution de la granulométrie latérale analysée à l'aide du logiciel précité [29], a été ajustée avec la fonction gaussienne. La distribution granulométrique de TEMA HZO (courbe rouge) a été tirée d'une étude précédente [15], et tracée avec celle de TDMA HZO (courbe noire) sur la figure 1c. Comme le montre la figure 1c, le diamètre latéral moyen des grains du TDMA HZO (8,5 nm) était plus grand que celui du TEMA HZO (7,1 nm). Cela pourrait être la principale raison de l'amélioration des performances FE du TDMA HZO. Selon des rapports antérieurs, la formation des phases métastables, telles que les phases orthorhombiques et tétragonales, est déterminée par les origines cinétiques, et les phases tétragonales et orthorhombiques sont préférées dans la région de petite taille de grain [13, 16]. Des grains beaucoup plus gros préfèrent être des phases monocliniques, une taille de grain plus petite préfère la phase tétragonale et la taille de grain légèrement plus grande préfère la phase orthorhombique. Le quasi chevauchement des positions des pics des deux phases (phases tétragonale et orthorhombique) dans les diagrammes de diffraction n'a pas permis d'identifier sans ambiguïté la phase principale dans les deux films. Cependant, le SEM et l'analyse de la taille des grains qui l'accompagne ont indiqué que le film TDMA HZO pourrait avoir une partie plus élevée de la phase orthorhombique par rapport au film TEMA HZO.
Les différentes tailles de grains pourraient provenir du niveau différent de la concentration en impuretés C dans les deux films. Les concentrations d'impuretés pourraient fortement affecter la microstructure et les propriétés ferroélectriques résultantes des films minces HZO [11, 12, 32]. Par conséquent, la composition chimique des films minces TDMA et TEMA HZO a été analysée à l'aide de l'AES à temps de vol, et les concentrations en profondeur résultantes de divers atomes tels que Hf, Zr, O, C, Ti et N dans TDMA HZO film ont été tracés en fonction du temps de pulvérisation sur la Fig. 1d. La figure 1e montre la région agrandie à faible concentration de la figure 1d (boîte en pointillés rouges) dans la partie du film HZO. La concentration moyenne de C dans le film TDMA HZO (carré noir) était d'environ 2,4 %, ce qui est d'environ 38 % plus petit que celui (~ 3,9 %) du film TEMA HZO (triangle rouge) [12], dont les données AES ont été rapportées dans le étude précédente des auteurs [12]. Toutes les autres concentrations, y compris N, n'ont montré aucune différence notable.
Cho et al. ont suggéré que les impuretés C résiduelles formées au cours du processus ALD retardaient la croissance des grains et résultaient en la petite taille des grains des films finalement déposés [32]. Une tendance similaire a été observée pour le ferroélectrique Hf0,5 Zr0,5 O2 films minces et HfO2 pur films de Kim et al. lorsque la température de dépôt a diminué de 280 à 200 °C [11, 12]. Jung et al. utilisé des simulations informatiques pour montrer que la différence d'énergie libre entre la phase tétragonale et monoclinique diminue avec l'augmentation de la concentration de C dans HfO2 , suggérant que l'inclusion de l'impureté C améliore la stabilité de la phase tétragonale métastable [33]. Kuenneth et al. a également examiné l'effet de la concentration de C sur les valeurs d'énergie libre de HfO2 . Cependant, ils ont rapporté que l'augmentation de la concentration en C n'a pas entraîné la diminution de la différence d'énergie libre entre la phase orthorhombique et monoclinique [34]. Dans les travaux de Kuenneth et al., les défauts de substitution C ont été considérés, bien que les impuretés C soient généralement connues sous le nom de défauts interstitiels dans HfO2 [33, 35]. Par conséquent, les calculs théoriques n'ont pas clairement révélé que les impuretés C pouvaient diminuer la différence d'énergie libre entre les phases tétragonale et orthorhombique. Cependant, des expériences ont confirmé que l'augmentation des impuretés C pourrait augmenter la fraction de phase tétragonale dans les films minces ALD HZO [11, 12, 33].
La plus faible concentration d'impuretés C dans le film TDMA HZO pourrait être attribuée à la nature différente de la décomposition thermique des ligands TDMA et TEMA. Les atomes de carbone les plus à l'extérieur des ligands TEMA ont tendance à être dissociés thermiquement et restent à la surface du film pendant le processus ALD [11, 12], ce qui peut ne pas être le cas dans le ligand TDMA.
À l'étape suivante, l'effet de la concentration en C et de la microstructure résultante sur les propriétés ferroélectriques est discuté. Les figures 2a et b montrent les courbes P–E des condensateurs MFM avec les films TDMA HZO et TEMA HZO, respectivement, mesurés dans un état vierge et des états fatigués commutés par 10 2 , 10 3 , 10 4 , et 10 5 fois en utilisant les impulsions rectangulaires bipolaires de 3,8 µMV/cm de haut et de 10 µs de large. À partir des courbes P–E de la Fig. 2a et b (état vierge), la courbe P–E du condensateur TEMA HZO (courbe noire, Fig. 2b) est plus fortement pincée à l'état vierge que celle du condensateur TDMA HZO (noir courbe, Fig. 2a). La figure 2b montre clairement les bosses dans la courbe P–E vierge du condensateur TEMA HZO, ce qui n'est pas le cas pour la courbe P–E vierge du condensateur TDMA HZO. Les bosses de la courbe P-E proviennent de la division des pics de courant de commutation, qui résulte généralement de l'inhomogénéité spatiale du champ électrique interne et/ou du champ coercitif. La figure 2c montre les changements dans 2Pr valeurs des condensateurs TDMA et TEMA HZO en fonction des impulsions de fatigue. Le 2Pr valeurs après 10 5 temps d'impulsions électriques, par rapport au 2Pr vierge les valeurs des condensateurs TDMA et TEMA HZO sont respectivement de ~ 80 et ~ 69%. Cela suggère que le film TEMA HZO a un comportement de réveil plus élevé que le film TDMA HZO.

Les courbes polarisation-champ électrique (P–E) de (a ) le TDMA HZO et (b ) Condensateurs TEMA HZO (reproduit de la réf. [5]) mesurés à l'état vierge et à l'état fatigué pulsés par 10 2 , 10 3 , 10 4 , et 10 5 fois à des impulsions rectangulaires bipolaires de 3,8 MV/cm de haut et de 10 s de large. (c) Les changements dans 2Pr valeurs des condensateurs TDMA (noir) et TEMA (rouge) HZO en fonction des impulsions de fatigue. Les courbes constante diélectrique-champ électrique de (d ) le TDMA HZO et (e ) Condensateurs TEMA HZO (reproduit de la réf. [5]) avec les électrodes TiN supérieure et inférieure mesurées à l'état vierge et à l'état fatigué. (f) Les changements dans les valeurs de constante diélectrique avec l'augmentation du nombre d'impulsions de fatigue pour les condensateurs HZO TDMA (noir) et TEMA (rouge)
Les figures 2d et e montrent la constante diélectrique-champ électrique (εr - E) courbes des condensateurs TDMA HZO et TEMA HZO mesurés à l'état vierge et états fatigués commutés par 10 2 , 10 3 , 10 4 , et 10 5 fois en utilisant les impulsions rectangulaires bipolaires de 3,8 µMV/cm de haut et de 10 µs de large. Le εr les valeurs du condensateur TDMA HZO sont nettement inférieures à celles des condensateurs TEMA HZO dans toutes les conditions de test. La figure 2f montre les changements dans εr valeurs avec le nombre croissant de cycles de commutation de fatigue pour les condensateurs TDMA et TEMA HZO. Le εr les valeurs ont été calculées en faisant la moyenne de εr valeurs mesurées aux champs électriques les plus élevés et les plus faibles sur les Fig. 2d et e. D'après les modèles GIXRD de la figure 1a, les fractions de phase monoclinique dans les deux films étaient négligeables. Ainsi, la différence de εr La valeur peut être déterminée par les fractions relatives des phases tétragonales et orthorhombiques ou par la concentration de défauts, qui devrait diminuer la constante diélectrique moyenne avec des distorsions de réseau locales. Le εr la valeur de la phase tétragonale (35-40) était supérieure à celle de la phase orthorhombique (25-30). Ainsi, le r élevé La valeur du condensateur TEMA HZO indique qu'il a une fraction de phase tétragonale plus élevée par rapport aux condensateurs TDMA HZO. Avec le nombre croissant d'impulsions de fatigue, le εr la valeur des condensateurs TEMA HZO et TDMA HZO diminue, comme le montre la Fig. 2f. L'ampleur de la diminution de εr valeur pendant 10 5 fois la commutation de polarisation pour le condensateur TDMA HZO (26,8 à 25,3) était plus petite que celle du condensateur TEMA-HZO (32,2 à 29,6) d'environ ~ 42 %. Ceci est cohérent avec le comportement de réveil illustré à la Fig. 2c.
La différence de fraction de phase tétragonale et les différents εr qui en résultent La valeur des films minces TDMA et TEMA HZO peut être comprise à partir de la différence de concentration en C. Selon Kim et al. [12], l'augmentation de la concentration en C diminue l'énergie libre de la phase tétragonale par rapport à celle de la phase orthorhombique (la phase tétragonale est encore plus favorable par rapport à la phase orthorhombique). En conséquence, avec l'augmentation de la concentration en C, la fraction de phase tétragonale devrait augmenter. Étant donné que la concentration en C du film TDMA HZO est inférieure à celle du film TEMA HZO, la fraction de phase tétragonale dans le film TDMA HZO devrait être inférieure à celle du film TEMA HZO. La différence de taille de grain montrée sur la figure 1c soutient également la même tendance dans les fractions de phase cristalline relatives. Selon Materlik et al. [30], l'énergie de surface libre de la phase tétragonale (2,5 J/m 2 ) est inférieur à cela (2,9 J/m 2 ) de la phase orthorhombique, bien que ces énergies de surface libre aient été estimées pour expliquer les observations expérimentales dans des films minces de HZO avec différentes épaisseurs et concentrations de Zr. Batra et al. [36] ont calculé l'énergie de surface libre des différentes phases cristallines avec diverses orientations et ont montré que l'énergie de surface libre de la phase tétragonale est inférieure à celle de la phase orthorhombique et monoclinique. Il est généralement admis que l'énergie de joint de grain à angle élevé est d'environ 1/3 de l'énergie de surface libre [37]. Ainsi, l'énergie aux joints de grains de la phase tétragonale est la plus faible par rapport aux phases orthorhombique et monoclinique, ce qui en fait la phase la plus stable à la plus petite taille de grain. Ceux-ci sont cohérents avec l'idée que la taille de grain plus petite du TEMA HZO a tendance à inclure une partie plus élevée de la phase tétragonale non ferroélectrique par rapport au film TDMA HZO, qui avait une taille de grain moyenne plus grande. Par conséquent, la concentration en C et la taille des grains observées expérimentalement soutiennent systématiquement la structure cristalline différente et les propriétés électriques résultantes des films minces TDMA et TEMA HZO.
Pour élucider le mécanisme derrière l'effet de réveil, la mesure de commutation d'impulsions, qui peut estimer la capacité interfaciale (Ci ) provenant de la couche non ferroélectrique à proximité des électrodes, a été réalisée sur des condensateurs TDMA HZO et TEMA HZO [5]. Les figures 3a et b montrent les changements dans Ci , résistance de contact (Rc ), et Ec valeurs avec le nombre croissant d'impulsions de fatigue pour les condensateurs TDMA HZO et TEMA HZO, respectivement. La méthode de mesure détaillée et les résultats sont inclus dans les informations de support en ligne. Les données pour le condensateur TEMA HZO ont été tirées des travaux antérieurs de Kim et al. [5], où le Ci la valeur augmente avec l'augmentation du nombre de cycles de champ électrique [5]. Dans l'état vierge, le Ci (37.6 μF/cm 2 ) la valeur du condensateur TDMA est supérieure à celle (21,1 μF/cm 2 ) du condensateur TEMA HZO d'environ 75 %, ce qui suggère que l'épaisseur de la couche interfaciale non ferroélectrique dans TDMA HZO est beaucoup plus petite que celle du film TEMA HZO. Par contre, la différence de Ec La valeur à l'état vierge des condensateurs TDMA et TEMA HZO n'est que de 13%, ce qui suggère que la principale raison de la différence dans les caractéristiques P–E vierges des condensateurs TDMA et TEMA HZO est l'épaisseur différente des couches interfaciales non ferroélectriques. Depuis Rc La valeur est fortement affectée par la résistance de contact pour la configuration de test électrique, elle peut avoir une importance moindre par rapport aux deux autres facteurs. Par conséquent, les différentes caractéristiques P-E dans l'état vierge du condensateur TDMA et TEMA HZO pourraient être comprises de manière cohérente sur la base du modèle de réveil précédent suggéré par Kim et al. [5]. Selon les études précédentes, la concentration d'oxygène vacant à proximité des électrodes TiN est plus élevée que celle de la région massive du film à l'état vierge. Selon Hoffmann et al. [38], l'augmentation de la concentration en lacunes d'oxygène améliore la stabilité de la phase tétragonale par rapport à celle de la phase orthorhombique. Au cours de la commutation de polarisation répétitive dans le test d'endurance, la phase tétragonale interfaciale a semblé se convertir en phase orthorhombique FE en diffusant les lacunes d'oxygène dans la région de masse du film. Le champ appliqué a également induit une transition de phase de la phase interfaciale non-FE dans la phase FE. Étant donné que l'épaisseur de la couche interfaciale du condensateur TDMA-HZO est inférieure à celle des condensateurs TEMA-HZO à l'état vierge, l'effet de réveil pendant le cycle de champ pourrait être atténué.
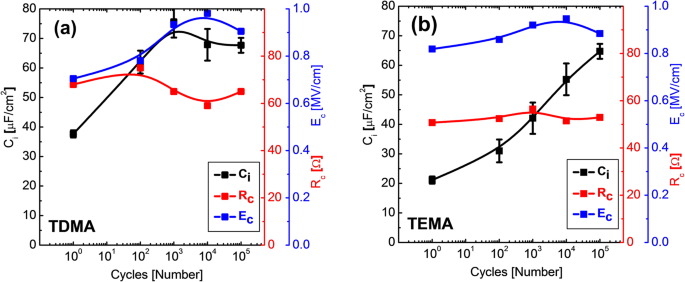
Les changements de (a ) AMRT HZO et (b ) TEMA HZO (reproduit de Réf. [5]) en capacité interfaciale (Ci ), résistance de contact (Rc ), et champ coercitif (Ec ) valeurs avec un nombre croissant d'impulsions de fatigue
De plus, l'amplitude de l'impulsion de fatigue est un autre facteur crucial qui peut fortement affecter les phénomènes de réveil des ferroélectriques à structure fluorite [6, 8]. Par conséquent, l'effet de réveil du condensateur TDMA HZO a été examiné en utilisant des impulsions de fatigue avec diverses amplitudes de 2,8, 3,1, 3,5 et 3,8 µMV/cm. Les figures 4a, b et c montrent les courbes P–E mesurées pendant le test de réveil avec des hauteurs d'impulsion de fatigue de 2,8, 3,1 et 3,5 MV/cm, respectivement. Les changements dans 2Pr pendant le test de réveil ont été résumés dans la Fig. 4d. Semblable au résultat du test de réveil illustré à la Fig. 2a, la mesure P–E a été effectuée au champ électrique de mesure de 3,8 MV/cm, après un certain nombre de cycles de réveil avec l'amplitude de champ donnée. Les changements de l'hystérésis P–E diminuent avec la diminution de l'amplitude des impulsions de fatigue, comme le montre la Fig. 4a–c. La figure 4d montre un résumé des changements dans 2Pr valeur pendant le test d'endurance avec des impulsions de fatigue d'amplitude 2,8, 3,1, 3,5 et 3,8 MV/cm. Comme on le voit sur la Fig. 4d, la magnitude de 2Pr augmenter après 10 5 les temps de cycle sur le terrain étaient de 0,41, 5,18, 9,93 et 9,94 μC/cm 2 pour les différentes amplitudes de champ de fatigue, qui correspondent à des changements de ~ 1, ~ 13, ~ 26 et ~ 24%, respectivement. Ce résultat implique que l'effet de réveil est négligeable lorsqu'une impulsion de fatigue d'amplitude 2,8 MV/cm a été appliquée, où un 2Pr raisonnablement élevé valeur (~ 40 μC/cm 2 ) pourrait encore être atteint.
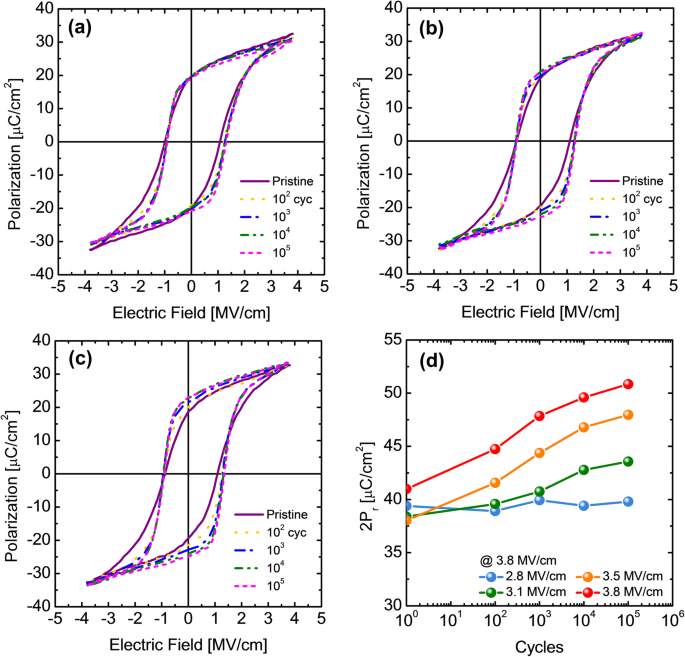
Les courbes polarisation-champ électrique (P-E) mesurées lors du test de réveil avec la hauteur d'impulsion de fatigue de (a ) 2.8, (b ) 3.1, et (c ) 3,5 MV/cm. (d) Les changements dans 2Pr valeur pendant le test d'endurance avec des impulsions de fatigue de 2,8, 3,1, 3,5 et 3,8 MV/cm
L'effet de réveil est fortement lié à la dérive des lacunes d'oxygène et à la transition de phase résultante de la phase tétragonale à la phase orthorhombique, principalement dans la couche interfaciale [9, 10]. La dérive des lacunes d'oxygène doit être fortement influencée par l'amplitude des impulsions de fatigue, et une amplitude de champ d'essai de fatigue convenablement inférieure (2,8 MV/cm dans ce cas) peut largement atténuer un tel effet néfaste. Bien que le maximum réalisable 2Pr la valeur a été réduite de ~ 51 μC/cm 2 (à 3,8 MV/cm) à ~ 40 μC/cm 2 (à 2,8 MV/cm), ~ 40 μC/cm 2 est encore une valeur raisonnablement élevée pour les dispositifs de mémoire ferroélectriques. Pour le cas du film TEMA HZO, une stratégie similaire pourrait être appliquée pour atténuer le problème de réveil, mais son 2Pr initialement faible valeur (~ 30 μC/cm 2 ) pourrait être le problème potentiel d'une telle méthode.
L'influence de la concentration en C a été encore clarifiée par le test d'endurance jusqu'à 10 9 cycles, comme le montrent les Fig. 5a et b, qui ont montré les variations de Pr sous une amplitude de champ de 2,5 et 3,0 µMV/cm pour les films TEMA et TDMA HZO, respectivement. Dans les deux cas, le Pr les valeurs ont été estimées par les boucles P-E avec le champ électrique maximal de la même force que le champ de cyclisme, donc le Pr estimé les valeurs sont généralement inférieures à celles de la Fig. 4, où les tests P–E ont été effectués avec 3,8 MV/cm. Lorsque le champ maximum (3,8 MV/cm) pour le test P–E de la Fig. 4 a été utilisé pour les tests d'endurance, les films ont été rapidement détruits, interdisant les tests d'endurance jusqu'au nombre de cycles maximum. Les deux films ont montré des tendances cohérentes dans l'évolution du Pr vs. cycle behavior:TEMA HZO film kept increasing the Pr values, whereas the trend was much lower for the case of the TDMA HZO film. The TEMA HZO film showed unsteady Pr changes before break down at ~ 10 7 and ~ 10 9 cycles using 3.0 and 2.5 MV/cm field cycling, respectively. In contrast, the TDMA HZO film showed no indication of breakdown up to ~ 10 7 and ~ 10 9 cycles at 3.0 MV/cm and 2.5 MV/cm field cycling, and sudden breakdown was observed. The Pr value decreased slightly after ~ 10 7 under the cycling field strength of 2.5 MV/cm, which corresponds to the genuine fatigue behavior. Similar decay in the Pr performance with the switching cycles has been extensively reported for conventional perovskite ferroelectrics, which usually ascribed to the domain wall pinning by the increasing defect density [40, 41]. In the previous studies on the HZO-based ferroelectric thin films, such genuine fatigue behaviors have hardly been observed due to the involvement of significant wake-up and early breakdown, which was also the case in Fig. 5a. The data shown in Fig. 5b reveals that the HZO film may also suffer from the fatigue effect, known in the perovskite ferroelectric film, under the condition that the wake-up and early breakdown are appropriately addressed.
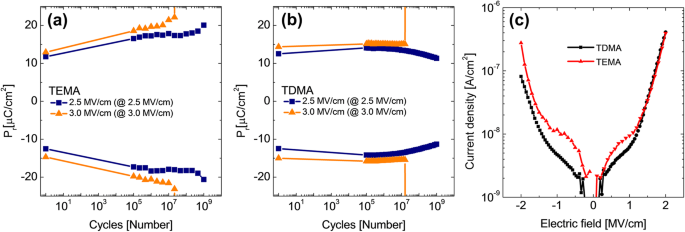
The results of endurance test of (a ) TEMA HZO (reproduced from Ref. 39) and (b ) TDMA HZO with the electric field cycling and pulse field amplitude of 2.5 and 3.0 MV/cm. The frequency of the rectangular double pulse for the endurance test was fixed at 100 kHz. (c) The current density–electric field curves of TDMA HZO (black) and TEMA HZO (red; reproduced from Ref. [39])
Figure 5c shows the comparison in the leakage current density performance of the two types of films. Due to the lower C concentration, TDMA HZO film had a lower leakage current than that of the TEMA HZO film at field strength <~ 1.5 MV/cm, where the trap-assisted tunneling may dominate. As a result of the leakage current improvement in TDMA HZO, the film did not show the breakdown up to 10 9 cycles, with relatively low field strength of 2.5 MV/cm.
However, in the higher field strength region, the difference becomes diminished, which may indicate that the high-field leakage current is more dominated by the interface Schottky barrier property, and such barrier property was less sensitive to the C concentration. Further research will be performed to more precisely identify the leakage current mechanism in subsequent work. The similar leakage currents in the high field region coincide with the no significant difference in the number of switching cycles before the breakdown at 3.0 MV/cm, shown in Fig. 5a and b.
Conclusion
In conclusion, this work examined the influence of types of metal-organic precursors on the structure and electrical performances of the atomic layer-deposited Hf0.5 Zr0.5 O2 Films minces. The adopted Hf and Zr precursors have either TEMA or TDMA ligands, where the former is more prone to the thermal decomposition compared to the latter. The ALD process using the precursors with TDMA ligands resulted in a lower C impurity concentration (~2.4 atomic % vs. ~3.9 atomic %) in the HZO film, which induced a slightly larger grain size (~8.5 nm vs. ~7.1 nm). As the slightly larger grain size prefers to have the ferroelectric orthorhombic phase rather than the non-ferroelectric tetragonal phase, the TDMA HZO film outperformed the TEMA HZO film, especially for the wake-up performance. When the wake-up field cycle was 2.8 MV/cm, the TDMA HZO film showed almost no wake-up effect, while a high 2Pr value of ~40 μC/cm 2 could be achieved. This is significant merit over the severely waking-up property of the TEMA HZO film. The TDMA HZO film also contained a lower portion of the interfacial non-ferroelectric phase with the TiN electrodes, compared with the TEMA HZO film. Due to the lower C concentration, the TDMA HZO film showed a lower leakage current in the low field region (<~1.5 MV/cm), but the high-field leakage current behaviors were similar. As a result, the number of switching cycles before breakdown was similar when the cycling field was as high as 3.0 MV/cm (~10 7 cycles), but it could be extended over 10 9 cycles when the cycling field was lower (2.5 MV/cm) for the case of the TDMA HZO film. The TDMA HZO film revealed that the typical fatigue behavior, i.e., decreasing Pr value with the increasing switching cycles, could be observed after ~ 10 7 cycles at 2.5 MV/cm, which might be ascribed to the domain wall pinning by the accumulated defects, as for the conventional perovskite ferroelectric films.
Disponibilité des données et des matériaux
The datasets supporting the conclusions of this article are included within the article and its Additional file 1.
Abréviations
- TEMA:
-
Tetrakis(ethylmethylamino)
- TDMA:
-
Tetrakis(dimethylamino)
- TEMAH:
-
Tetrakis[ethylmethylamino]hafnium
- TEMAZ:
-
Tetrakis[ethylmethylamino]zirconium
- TDMAH:
-
Tetrakis[dimethylamino]hafnium
- TEMAZ:
-
Tetrakis[dimethylamino]zirconium
- TDMA HZO:
-
Hf0.5 Zr0.5 O2 thin films deposited using TDMAH/TDMAZ
- TEMA HZO:
-
Hf0.5 Zr0.5 O2 thin films deposited using TEMAH/TEMAZ
- ALD :
-
Dépôt de couche atomique
- AES:
-
Auger electron spectroscopy
- RTP:
-
Rapid thermal process
- XRD :
-
Diffractomètre à rayons X
- GIXRD:
-
Grazing incidence X-ray diffraction
- SEM :
-
Microscopie électronique à balayage
- HZO:
-
Hf1-x Zrx O2 , x~0.5
- FE :
-
Ferroelectric
- Pr :
-
Remanent polarization
- Ec :
-
Coercive field
- P–E:
-
Polarization–electric field
- C–V:
-
Capacitance–voltage
- J–E:
-
Current density–electric field
- Ci :
-
Interfacial capacitance
- Rc :
-
Résistance de contact
Nanomatériaux
- Dévoilement de la structure atomique et électronique des nanofibres de carbone empilées
- Les nanofibres hiérarchiques antibactériennes en polyamide 6-ZnO fabriquées par dépôt de couche atomique et croissance hydrothermale
- Étude des premiers principes sur la stabilité et l'image STM du borophène
- Réglage des morphologies de surface et des propriétés des films de ZnO par la conception de la couche interfaciale
- Fabrication de couches minces SrGe2 sur des substrats Ge (100), (110) et (111)
- Étude de la force d'adhérence et de la transition vitreuse de films minces de polystyrène par microscopie à force atomique
- Une étude sur les nanofibres de carbone et le charbon actif en tant que supercondensateur symétrique dans l'électrolyte aqueux :une étude comparative
- Préparation et caractéristiques thermoélectriques du thermocouple à couche mince ITO/PtRh:PtRh
- Études TEM et STEM sur les morphologies transversales de films antireflet SiO2 à large bande double/tricouche



