Effet des hétérostructures bicouche CeO2−x/ZnO et ZnO/CeO2−x et polarité d'électroformage sur les propriétés de commutation de la mémoire non volatile
Résumé
Dispositifs de mémoire avec bicouche CeO2−x /ZnO et ZnO/CeO2−x des hétérostructures prises en sandwich entre les électrodes supérieures en Ti et inférieures en Pt ont été fabriquées par pulvérisation cathodique RF-magnétron à température ambiante. Des matériaux semi-conducteurs de type N ont été utilisés dans les deux hétérostructures de dispositifs, mais il est intéressant de noter que le changement d'hétérostructure et de polarité d'électroformage a provoqué des variations significatives des propriétés de commutation résistive (RS). Les résultats ont révélé que la polarité d'électroformage a une grande influence sur les deux CeO2−x /ZnO et ZnO/CeO2−x performances d'hétérostructure telles que la tension d'électroformage, bonne endurance cycle à cycle (~ 10 2 ) et le rapport ON/OFF. Un appareil avec CeO2−x L'hétérostructure /ZnO révèle de bonnes performances RS en raison de la formation d'une barrière Schottky aux interfaces supérieure et inférieure. Le mécanisme de conduction dominant de l'état de haute résistance (HRS) était l'émission de Schottky dans la région de champ élevé. La nature de la dépendance à la température de l'état de faible résistance et du HRS a confirmé que le RS est causé par la formation et la rupture de filaments conducteurs composés de lacunes d'oxygène.
Contexte
Les mémoires flash conventionnelles sont confrontées à leurs limites physiques et pratiques, de sorte que la recherche de nouveaux candidats possibles pour les applications de mémoire non volatile est devenue très nécessaire. À ce sujet, plusieurs nouveaux types de mémoire ont été suggérés comme candidats de mémoire non volatile de nouvelle génération [1, 2]. Parmi celles-ci, la mémoire à accès aléatoire résistive (RRAM) est considérée comme le meilleur candidat pour le remplacement des mémoires conventionnelles en raison de ses caractéristiques uniques telles qu'une capacité de mise à l'échelle élevée, une longue durée de conservation de la mémoire, une taille d'appareil plus petite, une vitesse de commutation rapide, une faible utilisation de l'énergie , non-volatilité et structure simple [3]. La cellule mémoire de la RRAM est une structure de type condensateur métal-oxyde-métal (MOM). Les comportements de commutation résistive bipolaire (BRS) et RS unipolaire (URS) entre deux états de résistance, c'est-à-dire l'état de faible résistance (LRS) et l'état de haute résistance (HRS) d'un film de résistance, peuvent être obtenus en appliquant une tension externe avec une amplitude appropriée et polarités [4,5,6].
Les performances de commutation d'un dispositif RS dépendent de l'uniformité de la tension SET, de la tension RESET et des niveaux de courant à LRS et HRS [7]. Ces paramètres de commutation sont influencés par les diélectriques du film, les matériaux des électrodes et la technique de fabrication/opération. De nombreux modèles ont été proposés jusqu'à présent pour expliquer la dépendance des caractéristiques de commutation sur ces paramètres. Le comportement de commutation peut être classé comme étant limité en volume ou limité à l'interface [8]. Pour la commutation de type à volume limité, les paramètres de commutation dépendent fortement de la permittivité des films diélectriques [9]. Cependant, la commutation limitée aux électrodes est due à la corrélation des électrons à l'interface métal-diélectrique et au travail de sortie des matériaux d'électrode [10]. L'interface entre une anode et un film diélectrique peut également affecter les paramètres RS d'un dispositif de mémoire [10, 11].
Parmi plusieurs oxydes, la cérine (CeO2 ) s'est avéré être un matériau prometteur pour les applications de mémoire RS en raison de sa grande constante diélectrique (~ 26), de son énergie libre de Gibbs inférieure (− 1024 kJ/mol), de deux oxydations (Ce + 4 à Ce + 3 ) et la distribution des lacunes (en particulier des lacunes en oxygène) selon un schéma non stoechiométrique [12, 13]. D'autre part, l'oxyde de zinc (ZnO), en raison de ses propriétés exceptionnelles, est largement utilisé dans diverses applications. Il est à noter que le ZnO est utilisé comme diélectrique en raison de sa transparence optique, de sa large bande interdite, de sa stabilité chimique et de sa résistivité élevée (10 5 -cm) [14]. Récemment, des structures de mémoire RS bicouche ont été proposées pour montrer des propriétés supérieures par rapport aux dispositifs à couche unique en termes de réduction des tensions d'électroformage et/ou de SET/RESET, d'amélioration de l'uniformité de la commutation, de longue endurance et d'auto-conformité [15]. Xu et al. [16] ont étudié le comportement RS de ZrO2 et des empilements à double couche de ZnO illustrant que la migration des lacunes d'oxygène dépend de la hauteur de la barrière interfaciale d'oxyde. Comportement RS observé dans le bicouche MnO/CeO2 structure a été proposée comme étant due à la réaction d'oxydation et de réduction de CeO2 comme rapporté par Hu et al. [17]. Yang et al. [18] ont révélé de bonnes caractéristiques de commutation résistive des dispositifs bicouches CuO/ZnO par rapport aux dispositifs monocouches à base de ZnO. Park et al. [19] ont démontré un fonctionnement RS plus fiable et reproductible observé dans Pt/TiOx cellules mémoire /ZnO/Pt que celui noté dans les cellules mémoire Pt/ZnO/Pt. Hsieh et al. [20] ont décrit que Ni/ZnO/HfO2 Les dispositifs /Ni ont présenté un comportement de commutation résistive bipolaire avec des caractéristiques à plusieurs niveaux pendant le processus de RÉINITIALISATION. Toutes ces caractéristiques RS améliorées ont motivé des recherches approfondies sur la bicouche sous forme de ZnO/CeO2 ou en tant que PDG2 /Hétérostructures ZnO, car aucune étude sur ces empilements et l'influence de la polarité de formation sur leurs caractéristiques RS et leurs performances mémoire n'a encore été rapportée.
Dans ce travail, nous avons rapporté l'influence de l'hétérostructure bicouche ainsi que de la polarité d'électroformage sur les propriétés RS de ZnO/CeO2−x et PDG2−x /Périphériques de mémoire à base de ZnO. Les résultats ont montré que le CeO2−x électroformé positivement Dispositifs /ZnO et ZnO/CeO électroformé négativement2−x les appareils présentent des tensions d'électroformage plus faibles et une bien meilleure endurance de commutation cycle à cycle (~ 10 2 ) performance. La dépendance à la température des résistances LRS et HRS de ces dispositifs bicouches avec des polarités de polarisation opposées indique que le mécanisme RS observé peut s'expliquer par des canaux conducteurs basés sur les lacunes d'oxygène.
Méthodes
Deux types de Ti/CeO2 /ZnO/Pt et Ti/ZnO/CeO2 Des dispositifs d'hétérostructure /Pt ont été préparés dans ce travail pour une étude comparative. Pour la fabrication du premier Ti/CeO2 Dispositif d'hétérostructure /ZnO/Pt, une couche active de film mince de ZnO (~ 10 nm) a été déposée sur du Pt/Ti/SiO2 commercial Substrats /Si (Pt) à température ambiante par pulvérisation cathodique magnétron radiofréquence (RF) utilisant une cible céramique ZnO (pur à 99,99%). Pendant le dépôt, puissance RF de 75 W et pression de ~ 10 mTorr sous Ar:O2 (6:18) mélange (débit =24 sccm) ont été maintenus. Ensuite, PDG2 couche (5 nm) a été déposée sur ZnO/Pt par pulvérisation magnétron RF dans les mêmes conditions pour former la bicouche CeO2 /Hétérostructure ZnO. Enfin, l'électrode supérieure (TE) Pt/Ti a été déposée sur ces deux hétérostructures par pulvérisation cathodique séquentielle de magnétron à courant continu (DC) à l'aide d'un masque métallique. Cette technique a produit des dispositifs circulaires (cellules mémoire) d'un diamètre de 150 μm. Ici, le Pt a été utilisé comme couche protectrice pour protéger le Ti TE de l'oxydation. De la même manière, un deuxième Ti/ZnO/CeO2 Le dispositif d'hétérostructure /Pt a également été fabriqué dans les mêmes conditions que celles maintenues pour Ti/CeO2 Hétérostructures /ZnO/Pt. Les deux Ti/CeO2 /ZnO/Pt et Ti/ZnO/CeO2 Les dispositifs de mémoire à hétérostructure /Pt ont été caractérisés par l'analyseur de paramètres à semi-conducteur Agilent B1500A à l'aide d'une méthode de mesure standard à deux sondes. La structure bicouche de ces dispositifs a été caractérisée à l'aide d'une microscopie électronique à transmission haute résolution à vues croisées (HRTEM-JEM 2001F).
Résultats et discussion
La figure 1a, b montre la configuration schématique du bicouche Ti/CeO2 /ZnO/Pt et Ti/ZnO/CeO2 /Pt dispositifs de mémoire à hétérostructure, respectivement. La figure 2a–d montre un courant-tension typique (I -V ) courbes de Ti/CeO2−x /ZnO/Pt et Ti/ZnO/CeO2−x /Pt dispositifs de mémoire à hétérostructure, incluant également le processus d'électroformage initial, indiquant les caractéristiques typiques de RS bipolaire. Lorsqu'un balayage de + 2 V a été appliqué à TE, un saut soudain de courant s'est produit à 0,6 V indiquant la formation de chemins conducteurs entre deux électrodes (Fig. 2a). Le dispositif est resté à l'état ON (LRS) après la suppression de la tension d'électroformage positive. La figure 2a montre également que l'appareil est passé avec succès à HRS avec un balayage de tension négative de 0 à - 1 V, et à nouveau à LRS avec un balayage de tension positif de 0 à + 1 V. Une polarité opposée, c'est-à-dire une tension d'électroformage négative, a également été fourni pour activer/initier un comportement de commutation dans la même cellule mémoire à hétérostructure. À cet égard, lorsqu'un balayage de 0 à - 8 V était appliqué à TE, la résistance de l'appareil présentait une chute soudaine à - 5,6 V, l'allumant ainsi à partir de l'état OFF appelé électroformage négatif (Fig. 2b). Après électroformage négatif, l'appareil n'a pas réussi à RESET positif et à SET négatif en raison de sa panne irréversible. Il est à noter que des tensions d'électroformage négatives beaucoup plus élevées sont nécessaires pour initier des caractéristiques RS que des tensions d'électroformage positives. Cependant, après électroformage négatif, aucune hystérésis de commutation n'a été observée, car le dispositif est resté à l'état ON quelle que soit l'application des tensions SET et RESET ; ce fait indique la formation de filaments conducteurs permanents pendant le processus d'électroformage. Le claquage irréversible lors de l'électroformage négatif pourrait résulter de différentes hauteurs de barrière tunnel initiées par la différence des fonctions de travail des électrodes supérieure et inférieure [21]. Ces résultats montrent que l'appareil avec Ti/CeO2−x L'hétérostructure /ZnO/Pt ne peut convenir aux caractéristiques non volatiles que si elle est électroformée avec une polarité positive, suivie des polarités négative et positive des opérations RESET et SET correspondantes. La seule différence entre le second (Ti/ZnO/CeO2−x /Pt) et le premier (Ti/CeO2−x /ZnO/Pt) est la position des couches isolantes dans l'hétérostructure sandwich. C'est pourquoi l'appareil avec Ti/ZnO/CeO2−x L'hétérostructure /Pt peut également être électroformée aux polarités positives et négatives des potentiels de polarisation, de la même manière que Ti/CeO2−x Dispositif d'hétérostructure /ZnO/Pt. La figure 2c montre un I-V bipolaire typique courbes pour un tel électroformage positif et un comportement de commutation ultérieur. Avec un balayage de 0 à + 4 V, l'appareil a été électroformé pour passer à l'état ON (un changement brusque de résistance à + 3 V) comme illustré par la Fig. 2c. L'appareil a ensuite été allumé en dessous de + 2 V (SET positif) et éteint à - 1,5 V (RESET négatif) pendant un cycle de commutation répétable. De même, le dispositif avec la même hétérostructure électroformé négativement (à - 3,5 V) a montré un RESET positif (à + 1,5 V) et un SET négatif (à - 2,5 V) comme le montre la figure 2d. Pour protéger les deux appareils d'une panne permanente, une conformité de courant de 1 mA a été appliquée pendant les processus d'électroformage et de SET.
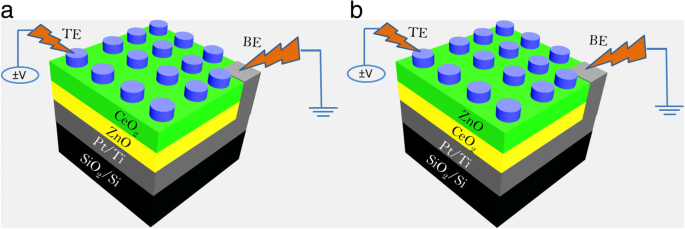
Configuration schématique de la bicouche a Ti/Directeur général2 /ZnO/Pt et b Ti/ZnO/CeO2 /Pt appareils
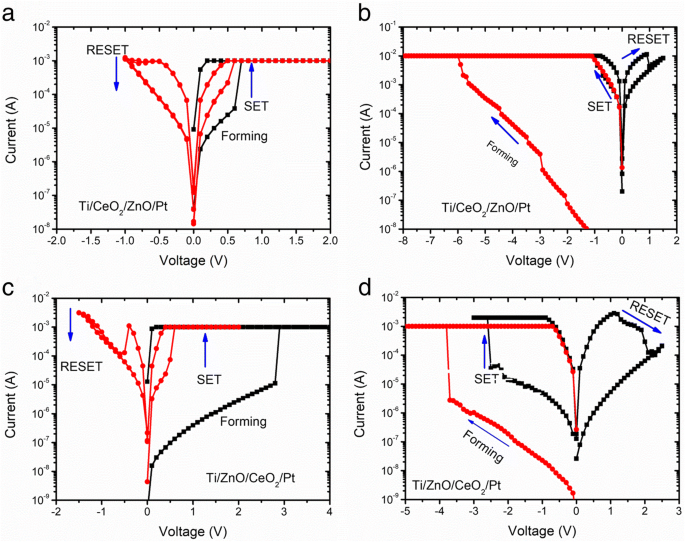
Les appareils décrivent le comportement bipolaire typique. un Formage positif (+ve) et opération de commutation ultérieure et b formation négative (−ve) et opération de commutation du Ti/CeO2−x Hétrostructures /ZnO/Pt. c +ve opération de formage et de commutation et d −ve formation et opération de commutation de Ti/ZnO/CeO2−x /Pt périphériques de mémoire. Les flèches indiquent les directions de changement
Pour vérifier l'uniformité des paramètres de commutation pour les deux dispositifs de mémoire à hétérostructure, les probabilités cumulées des tensions de fonctionnement (tensions SET et RESET) notées dans divers cycles de commutation sont affichées sur la Fig. 3a, b. Le Ti/CeO2−x Le dispositif de mémoire à hétérostructure /ZnO/Pt présente des variations relativement plus étroites des tensions SET et RESET par rapport au Ti/ZnO/CeO2−x /Pt dispositif de mémoire à hétérostructure. La figure 3c, d révèle l'analyse statistique des tensions moyennes SET, RESET et électroformage des deux dispositifs de mémoire à hétérostructure. Le Ti/CeO2−x Les dispositifs /ZnO/Pt nécessitent des tensions d'électroformage beaucoup plus faibles que celles nécessaires pour Ti/ZnO/CeO2−x /Pt dispositifs de mémoire à hétérostructure, mais les tensions SET et RESET ne présentent que de légères variations. Des fluctuations plus faibles des tensions de fonctionnement des deux dispositifs pourraient être associées à la création et à la rupture de filaments se produisant aux interfaces. Liu et al. [22] ont suggéré que les faibles tensions SET/RESET et l'uniformité de commutation notées dans WOx /NbOx La structure bicouche pourrait être attribuée à l'effet combiné de la migration de l'oxygène entre deux couches d'oxyde et de la transition métal-isolant. En tant qu'énergie libre de Gibbs ΔG de la formation d'oxyde pour ZnO et CeOx a une énorme différence d'environ 706 kJ/mol (pour CeO2 , ΔG = − 1024 kJ/mol et pour ZnO il est de − 318,52 kJ/mol) et un effet de chauffage localisé se produit, l'échange d'oxygène est induit. Il est bien connu que la couche mince de ZnO a beaucoup de lacunes en oxygène en raison de la faible énergie de formation [23]. De plus, de nombreuses lacunes initiales en oxygène présentes dans la couche de ZnO jouent un rôle majeur dans la conduction via des pièges peu profonds [24]. De plus, il est indiqué que le phénomène de formation libre dans les dispositifs à base de ZnO pourrait être attribué à une concentration élevée de lacunes d'oxygène déjà présentes dans les cristaux de ZnO [25]. De tous les faits mentionnés ci-dessus, on peut conclure qu'en présence d'un film de ZnO possédant beaucoup de lacunes d'oxygène dans les deux dispositifs à hétérostructure (ZnO/CeO2−x et PDG2−x /ZnO) joue un rôle crucial dans la réduction des tensions de fonctionnement. Les lacunes d'oxygène dans le ZnO pourraient agir comme des pièges peu profonds pour les électrons et les électrons dans ces sites de piégeage peuvent facilement être piégés ou dé-piégés à de faibles valeurs de tensions SET et RESET.

Distribution de probabilité cumulée cycle à cycle des tensions de fonctionnement dans a Ti/CeO2−x /ZnO/Pt et b Ti/ZnO/CeO2−x /Pt dispositifs de mémoire à hétérostructure. c Analyse statistique des tensions SET et RESET de Ti/CeO2−x /ZnO/Pt et Ti/ZnO/CeO2−x /Pt dispositifs de mémoire à hétérostructure. d Évaluation statistique des tensions d'électroformage pour les deux Ti/CeO2−x /ZnO/Pt et Ti/ZnO/CeO2−x /Pt dispositifs de mémoire à hétérostructure
Pour étudier la fiabilité des deux hétérostructures du dispositif, des tests d'endurance à différentes polarités de potentiel de polarisation ont été effectués. Les valeurs de résistance de HRS et LRS sont obtenues à 0,2 V à partir de cycles de commutation d'endurance CC. La figure 4a décrit les caractéristiques d'endurance du Ti/CeO2−x Dispositif de mémoire à hétérostructure /ZnO/Pt. On voit que Ti/CeO2 électroformé positivement Les dispositifs de mémoire à hétérostructure /ZnO/Pt ont présenté une bonne endurance avec une fenêtre de mémoire de ~ 10 qui pourrait assurer des HRS et LRS clairement distinguables. Formation de la barrière Schottky à Ti/CeO2−x l'interface est due à la différence de fonction de travail entre le Ti TE et la couche adjacente de CeO2−x , conduisant à de bonnes propriétés RS. Lorsque le même dispositif à hétérostructure (Ti/CeO2−x /ZnO/Pt) a été électroformé négativement, le dispositif n'a pas pu être changé de LRS à HRS comme le montre la Fig. 4b. La figure 4c illustre les caractéristiques d'endurance du Ti/ZnO/CeO2−x électroformé positivement /Pt dispositif de mémoire à hétérostructure présentant une très mauvaise propriété d'endurance. La fenêtre de mémoire semble être presque réduite, ce qui rend les états ON et OFF pratiquement impossibles à distinguer. Ce fait peut être attribué à l'incapacité du ZnO à capturer les porteurs injectés en raison de la présence d'une forte concentration de lacunes, ce qui rend la voie de conduction vers Ti TE car aucune barrière n'est formée à l'interface Ti/ZnO en raison de la différence de travail de travail négligeable entre Ti (4,33 eV) et ZnO (4,35 eV), ce qui entraîne une mauvaise endurance [26]. Une autre raison peut être la densité élevée de défauts dans le ZnO/CeO2−x matrice créée sous fort champ électrique, car la migration des lacunes d'oxygène est considérablement améliorée le long des défauts étendus. De plus, les lacunes d'oxygène chargées positivement ségréguées au niveau des sites de défaut augmentent les états de densité de surface, entraînant l'effondrement du rapport ON/OFF. Cela suggère que lorsque le contact de blocage Ti/ZnO est formé, les niveaux de Fermi sont alignés les uns avec les autres en raison du mouvement des électrons de Ti vers ZnO. En conséquence, les porteurs majoritaires sont rassemblés à la surface de la couche d'oxyde et presque aucune barrière n'est formée [26]. La figure 4d montre de bien meilleures caractéristiques d'endurance du Ti/ZnO/CeO2−x formé négativement /Pt dispositif de mémoire à hétérostructure par rapport à ceux du dispositif formé positivement. Zhu et al. [27] ont fabriqué trois types de dispositifs différents :(i) Ag/ZnO/NSTO/In, (ii) Ag/CeO2 /NSTO/In, et (iii) Ag/CeO2 /ZnO/NSTO/In. Le dispositif bicouche (CeO2−x /ZnO), par rapport aux monocouches, a présenté un meilleur comportement RS avec une conservation des données d'environ 10 ans. Ils ont attribué de meilleures caractéristiques RS des hétérostructures bicouches à la barrière d'interface entre CeO2−x /Structure bicouche de ZnO et existence d'un grand nombre de lacunes agissant comme des centres pièges dans les films de ZnO.
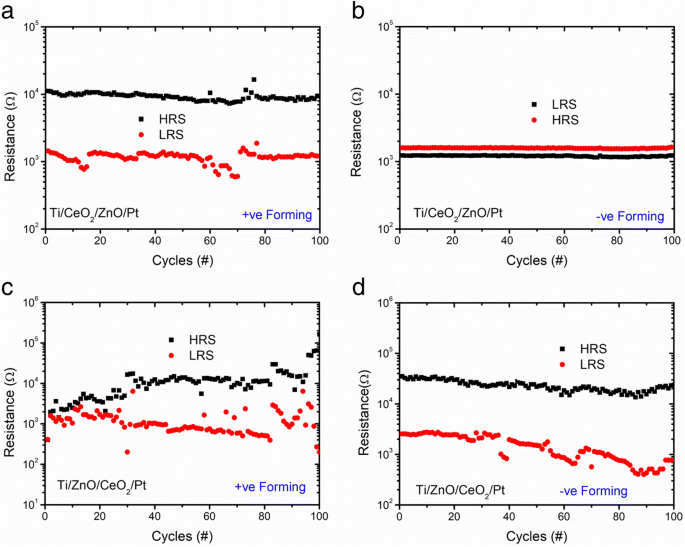
Caractéristiques d'endurance de a électroformé positivement et b Ti/CeO électroformé négativement2−x Dispositifs de mémoire à hétérostructure /ZnO/Pt. c Electroformé positivement et d Ti/ZnO/CeO2−x électroformé négativement /Pt dispositifs de mémoire à hétérostructure
Les performances de rétention des deux CeO2−x /ZnO et ZnO/CeO2−x les hétérostructures bicouches ont également été étudiées. Le temps de rétention des deux dispositifs à hétérostructure a été mesuré à température ambiante avec une tension de lecture de 0,2 V, comme le montrent les Fig. 5a, b. Aucune alimentation électrique n'était nécessaire pour maintenir la résistance constante dans un état donné. Jusqu'à un temps de rétention de 10 4 s, les résistances du HRS et du LRS ne révèlent aucun signe de détérioration, ce qui implique que les informations stockées dans les deux dispositifs à hétérostructure peuvent être conservées beaucoup plus longtemps que 10 4 s.

Caractéristiques de rétention de a Ti/CeO électroformé positivement2−x Dispositifs de mémoire à hétérostructure /ZnO/Pt et b Ti/ZnO/CeO2−x électroformé négativement /Pt dispositifs de mémoire à hétérostructure à température ambiante
Pour étudier le mécanisme de conduction prévalant dans la région de champ élevé des deux dispositifs de mémoire à hétérostructure, la procédure d'ajustement de courbe a été effectuée sous positif (pour CeO2−x /ZnO) et négative (pour ZnO/CeO2−x ) polarités de potentiel de polarisation. La figure 6a, b décrit que les ajustements de courbes linéaires aux données expérimentales sont bien alignés avec le comportement d'émission de Schottky pour les deux dispositifs à hétérostructure dans leurs polarités de polarisation respectives. On sait que l'émission Schottky se produit lorsque l'électrode injecte des électrons activés thermiquement à travers la barrière dans la bande de conduction de l'isolant, c'est donc ce qu'on appelle un mécanisme à électrode limitée. Généralement, l'émission Schottky se produit lorsque le contact de l'électrode est fortement injectif en porteurs. La relation linéaire de ln(I ) contre √V indique que les électrons ont atteint une quantité d'énergie suffisante pour vaincre la barrière énergétique. La conduction ohmique (le courant étant proportionnel à la tension appliquée) se produisant dans une région à faible champ montre que le courant circule en raison des électrons générés thermiquement (les résultats ne sont pas montrés ici). Le modèle d'émission de Schottky peut généralement être décrit par une équation de la forme [28] :\( \ln (J)=\ln {A}^{\ast }{T}^2-q\left({\varPhi} _b-\sqrt{\frac{qV}{4\pi {\varepsilon}_o{\varepsilon}_rd}}\ \right)/{k}_BT \), où J est la densité de courant, A * est la constante de Richardson, T est la température, q est la charge électrique, V est une tension éclectique, ε r est la constante diélectrique, ε o est la permittivité de l'espace libre, d est l'épaisseur du film, et k B est la constante de Boltzmann. De plus, les valeurs de résistance dépendant de la température de LRS et HRS ont été mesurées à une tension de 0,2 V dans la plage de température de 200 à 300 K pour les deux CeO2−x /ZnO et ZnO/CeO2−x dispositifs de mémoire à hétérostructure comme illustré à la Fig. 6c, d. On peut remarquer que les propriétés de transport électrique des deux dispositifs à hétérostructure dans un état de faible résistance sont de nature métallique, c'est-à-dire que les résistances dans le LRS augmentent avec l'augmentation de la température. Contrairement à cela, les propriétés de transport électrique pour les deux dispositifs à HRS sont de nature semi-conductrice, c'est-à-dire que les résistances dans HRS diminuent avec l'augmentation des températures. Valeurs d'énergie d'activation (E un ) obtenus à partir des tracés d'Arrhenius du LRS des deux dispositifs à hétérostructure (résultats non présentés) sont ~ 0,092 eV, et comparables à l'énergie de la première ionisation des lacunes d'oxygène (~ 0,1 eV) [25, 26, 29], ce qui indique que le premier l'ionisation des lacunes d'oxygène est responsable de la conduction au HRS, confirmant davantage la dominance de l'émission de Schottky en tant que mécanisme de conduction opérationnel dans le HRS. Le comportement métallique dans le LRS et le comportement semi-conducteur dans le HRS des deux dispositifs à hétérostructure fournissent des preuves suffisantes à l'appui du comportement de commutation dans Ti/CeO2−x /ZnO/Pt et Ti//ZnO/CeO2−x /Pt dispositifs de mémoire à hétérostructure qu'il peut être associé à un mécanisme filamentaire conducteur basé sur les lacunes d'oxygène.
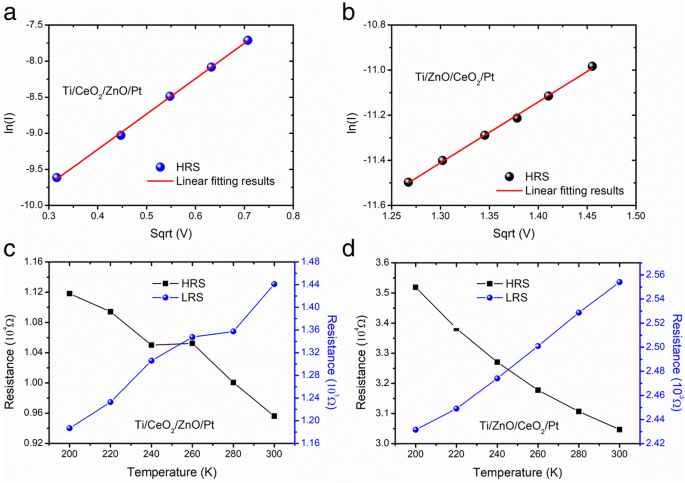
logI-V 1/2 caractéristiques dans le HRS de l'état SET. un Pour Ti/CeO2−x /ZnO/Pt. b Pour Ti/ZnO/CeO2−x /Pt dispositifs de mémoire à hétérostructure. Dépendance à la température du LRS et du HRS de c Ti/CeO2−x /ZnO/Pt et d Ti//ZnO/CeO2−x /Pt dispositifs de mémoire à hétérostructure
La figure 7 décrit le diagramme de bande d'énergie proposé pour CeO2 et des matériaux semi-conducteurs de type n-n ZnO en régime permanent. La différence entre les fonctions de sortie de ZnO (4,35 eV) et de CeO2 (3,33 eV) est égal à 1,02 eV pour la même transition électronique sur la lacune d'oxygène [30]. La fonction de travail inférieure du PDG2 (3,33 eV) que celui de ZnO (4,35 eV) permet le mouvement des électrons de CeO2 à ZnO, donnant lieu à leur concentration plus élevée dans la matrice.
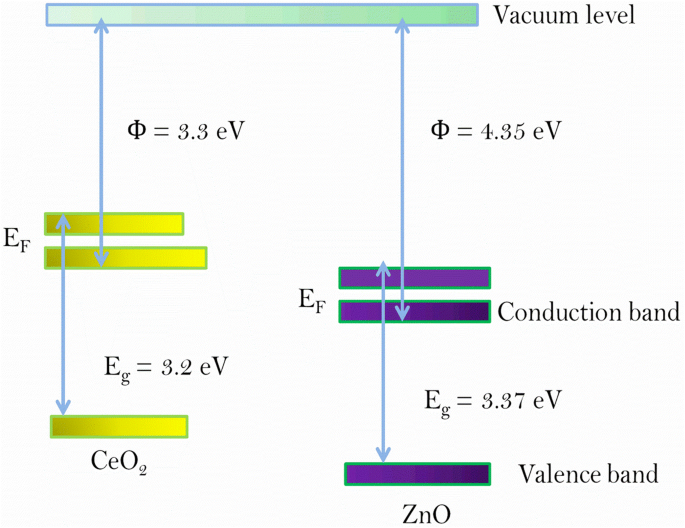
Diagramme de bande d'énergie de CeO2 et les matériaux semi-conducteurs de type n ZnO
D'après notre étude précédente [31], les caractéristiques RS du Ti/CeO monocouche2−x /Pt ont été attribués à la formation d'une couche interfaciale de TiO qui joue un rôle clé dans la création et la rupture des chemins filamentaires conducteurs. Warule et al. ont proposé que le comportement RS dans les dispositifs Ti/ZnO/Pt était induit par la création et la déconnexion de filaments conducteurs à base de lacunes d'oxygène [32]. De plus, le phénomène de formation sans formation dans les dispositifs Ti/ZnO/Pt est lié à l'existence d'une quantité considérable de lacunes d'oxygène dans les dispositifs Ti/ZnO/Pt tels que préparés [32,33,34]. La barrière Schottky à l'interface ZnO/Pt peut être éliminée par l'existence d'une quantité adéquate de lacunes d'oxygène dans le film de ZnO, résultant en un contact ohmique à l'interface ZnO/Pt. En conséquence, la formation de couche interfaciale TiO peut être associée à l'effet RS dans la bicouche ZnO/CeO2−x et PDG2−x /Hétérostructures ZnO. Il est bien connu que le Ti est un métal hautement réactif avec l'oxygène atmosphérique :par conséquent, il peut facilement former une couche de TiO à l'interface Ti/oxyde [35]. En Ti/ZnO/CeO2−x Dispositif de mémoire à hétérostructure /Pt, le ZnO est un semi-conducteur de type n et contient beaucoup de lacunes d'oxygène, donc un contact ohmique est formé à l'interface Ti/ZnO [36]. Comme Ti et ZnO ont à peu près les mêmes fonctions de travail, Ti est donc incapable d'extraire les ions oxygène de ZnO pour créer une couche interfaciale de TiO. Il a été rapporté que des ions oxygène non réticulaires et des oxygènes liés à des défauts réticulaires existent dans les films de ZnO [37]. En raison du dépôt d'oxyde de cérium (CeO2 ) par pulvérisation RF à température ambiante, fabriqué CeO2 les films sont de nature polycristalline. Ainsi, les films de cérine peuvent être non stoechiométriques car nous avons déjà prouvé dans nos travaux de recherche antérieurs que la cérine est réduite à CeO2−x [12]. Hu et al. [17] ont également signalé une telle réduction de CeO2 pendant le dépôt à CeO2−x . Défauts dans le CeO2−x les films sont insuffisants pour mobiliser les ions oxygène. Par conséquent, CeO2−x couche sert de réservoir d'oxygène dans Ti/ZnO/CeO2−x /Pt hétérostructure. Énergie de Gibb pour la formation de CeO2 est beaucoup plus petit (− 1024 kJ/mol) que celui de ZnO (− 318.52 kJ/mol) comme décrit précédemment, il existe donc des oxygènes non réticulaires dans ZnO en raison de sa nature non stoechiométrique, qui se déplacent vers CeO2 couche même en l'absence de biais externe [37]. Par conséquent, lorsque Ti TE est déposé sur ZnO, aucune couche interfaciale ne devrait se former entre Ti et ZnO, bien que l'énergie de Gibbs de formation de TiO soit inférieure à celle de ZnO. Lorsqu'une tension positive est appliquée au TE, les ions d'oxygène sont attirés vers le CeO2−x L'interface /Pt et les filaments conducteurs sont générés avec des lacunes d'oxygène en raison de leurs capacités de dérive et d'agencement des lignes.
Par contre, en Ti/CeO2−x Dispositifs de mémoire à hétérostructure /ZnO/Pt, une couche interfaciale de TiO très mince est formée à Ti/CeO2−x comme évident à partir de l'image HRTEM (Fig. 1c) et comme suggéré par notre étude précédente [37]. L'énergie de Gibbs de formation de TiO (− 944 kJ/mol) est relativement plus grande que celle de CeO2−x (− 1024 kJ/mol) ; par conséquent, bien que Ti en raison de sa forte affinité pour l'oxygène capture les ions oxygène de CeO2−x pour former la couche interfaciale de TiO, une partie des ions oxygène retourne à CeO2−x couche en l'absence/présence d'un champ négatif externe [38]. L'énergie de Gibbs de formation d'oxyde pour TiO et ZnO est respectivement de − 944 kJ/mol et − 318,52 kJ/mol. En conséquence, on peut obtenir l'énergie de Gibbs de formation d'oxyde pour (1/2)CeO2 = − 512 kJ/mol. En comparaison avec le ZnO, l'affinité pour l'oxygène du Ce est légèrement supérieure à celle du Zn, de sorte que les ions oxygène diffusent du ZnO au CeO2−x couche, puis à la couche de TiO d'où ces ions peuvent migrer vers TE, laissant des lacunes d'oxygène dans les couches d'oxyde. Par conséquent, tous les ions oxygène se rassemblent à l'interface supérieure et des filaments conducteurs avec des lacunes d'oxygène se forment entre les électrodes. En présence d'une polarité de polarisation opposée, les ions oxygène sont renvoyés vers les couches d'oxyde, ce qui entraîne le remplissage des lacunes d'oxygène conduisant à la rupture du filament.
Les fonctions de travail des électrodes supérieure Ti et inférieure Pt sont respectivement de 4,33 et 5,65 eV [39]. L'affinité électronique et le travail de sortie de ZnO (3,37 eV et 4,35 eV) sont supérieurs à ceux de CeO2 (3,50 eV et 3,2 eV) [40]. Donc une barrière énergétique au ZnO/CeO2−x l'interface est attendue, comme la barrière Schottky. Dans le régime de tension positive, les électrons ne peuvent pas être facilement injectés à travers les défauts de CeO2 par l'électrode inférieure de Pt à la couche de ZnO car le travail de sortie de ZnO est supérieur à CeO2 . C'est pourquoi les électrons sont moins capables de dériver de ZnO à l'électrode supérieure de Ti, car Ti est incapable d'attirer les ions oxygène de ZnO en raison de leurs fonctions de travail similaires. La hauteur de la barrière en haut Ti/ZnO et CeO2−x Les interfaces inférieures /Pt sont respectivement de 0,05 eV et 2,45 eV, hauteur de barrière à CeO2 L'interface inférieure /Pt est plus élevée, de sorte que les électrons ne peuvent pas être déclenchés facilement du métal au diélectrique, ce qui entraîne la formation d'une barrière Schottky à l'interface inférieure [41].
Cependant, la hauteur de barrière de l'interface Ti/ZnO supérieure est négligeable en raison de fonctions de travail similaires, mais elle est beaucoup plus élevée en bas CeO2−x /Pt c'est pourquoi la polarité du champ de polarisation n'est pas suffisante pour équilibrer les hauteurs de barrière des deux interfaces; par conséquent, les caractéristiques d'endurance et de commutation de Ti/ZnO/CeO2−x L'hétérostructure /Pt n'est pas aussi bonne pour la polarité positive du biais appliqué. Lorsqu'un balayage de tension négative est appliqué à l'électrode supérieure en Ti, l'injection d'électrons à partir de Ti TE est incapable de contrôler la barrière à l'interface Ti/ZnO car aucune barrière Schottky n'est formée à l'interface Ti/ZnO supérieure dans Ti/ZnO/CeO 2−x /Pt hétérostructure comme indiqué dans la Fig. 8a, b.
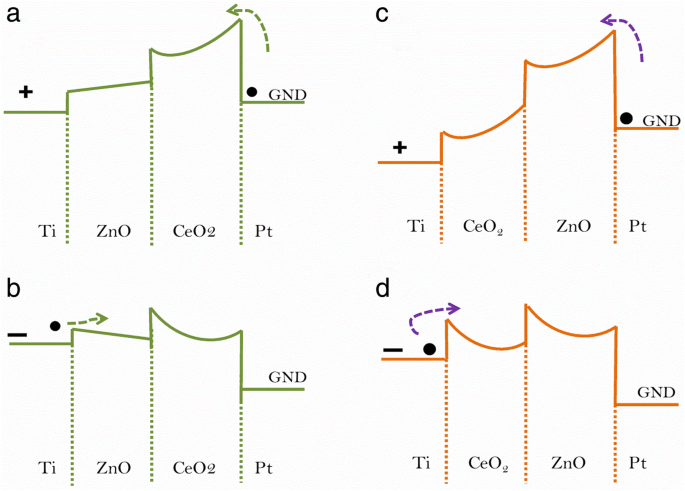
Diagrammes schématiques pour le décalage de bande de conduction de a , b Ti/ZnO/CeO2−x /Pt et c , d Ti/CeO2−x Dispositifs de mémoire à hétérostructure /ZnO/Pt. Arrows represent electrons drift direction according to switching polarities
In the positive voltage region, on the other hand, electrons can be easily injected through the defects in ZnO from Pt electrode to the CeO2−x couche. These electrons are then drifted from CeO2−x layer to Ti top electrode. The barrier heights of top Ti/CeO2−x (1.13 eV) and bottom ZnO/Pt (2.28 eV) interfaces suggest a Schottky emission as shown in Fig. 8c, d. When a negative voltage is swept to Ti top electrode, electron injection from top electrode is controlled by this Schottky barrier at Ti/CeO2−x interface, because trapping and de-trapping phenomena can easily occur at the lower barrier (1.13 eV). Oxygen ions can be migrated to Ti/CeO2−x interface by applying a positive voltage. The RS mechanism in Ti/CeO2−x /ZnO/Pt heterostructure memory device can be explained by the creation and dissolution of conducting filaments with oxygen vacancies in the oxide layers [41]. It means that oxygen ions can thus move back and forth between Ti/CeO2−x interface and oxide layers by two opposite polarities of the external bias. When a positive voltage is swept on Ti electrode, oxygen ions are drifted from CeO2−x /ZnO to Ti/CeO2−x interface. The conducting filaments with oxygen vacancies are formed in the oxide layer, and consequently, resistance state is switched from OFF- (HRS) to ON-state (LRS). When a negative voltage is swept on Ti TE, process of de-trapping is started and oxygen ions gathered at Ti/CeO2−x interface are moved back toward the bottom electrode. The conducting filaments are ruptured due to the migration of oxygen ions. The device is thus switched back again into HRS. Based on the current results, we have investigated the effect of device heterostructure such as CeO2−x /ZnO and ZnO/CeO2−x and electroforming polarity on resistive switching parameters for possible applications in resistive random access memory devices. We have noticed that both device structures and their electroforming polarity pose significant influence on switching parameters such as electroforming voltage, memory window, and uniformity in SET/RESET voltages. However, more attention is needed to achieve faster programing/erasing time, higher scalability, electroforming-free, and low cast devices in future research. In particular, work is needed in choosing suitable electrode material, utilizing either nanocrystals or metal ions embedded in an insulating layer and fabricating device on buffer layer structures.
Conclusions
In conclusion, deep investigations on the RS behavior have been made by changing the morphology of bilayer ZnO/CeO2−x and CeO2−x /ZnO heterostructures and sign of electroforming polarities. Significant impact is noticed on the performance, endurance characteristics, electroforming voltages, and uniformity in the operational voltages. Experimental results reveal the formation of TiO interfacial layer in Ti/CeO2−x /ZnO/Pt heterostructure on applying bias of positive polarity, and CeO2−x layer during negative polarity serves as an oxygen reservoir in Ti/ ZnO/CeO2−x /Pt heterostructures. Collectively, it can play an important role for the improvement of uniformity and repeatability of RS parameters. Dominant conduction mechanism in HRS was electrode-limited Schottky emission at a high field region. Temperature dependence of LRS and HRS resistances lead to the conclusion that observed RS mechanism is based on the movement of oxygen vacancies under the applied voltage.
Abréviations
- BRS:
-
Bipolar resistive switching
- DC :
-
Courant continu
- HRS :
-
High resistance state
- HRTEM :
-
Microscopie électronique à transmission haute résolution
- LRS :
-
Low resistance state
- MOM:
-
Metal-oxide-metal
- RRAM :
-
Mémoire vive résistive
- RS:
-
Resistive switching
- TE :
-
Électrode supérieure
- URS:
-
Unipolar resistive switching
Nanomatériaux
- L'effet du plasma de contact hors équilibre sur les propriétés structurelles et magnétiques des spinelles Mn Х Fe3 − X О4
- Propriétés paramagnétiques des nanomatériaux dérivés du fullerène et de leurs composites polymères :effet de pompage drastique
- Synthèse hydrothermale de nanoparticules d'In2O3 jumelles hybrides disque hexagonal hétérostructures ZnO pour des activités photocatalytiques et une stabilité améliorées
- Effets de l'épaisseur de la bicouche sur les propriétés morphologiques, optiques et électriques des nanolaminés Al2O3/ZnO
- Réglage des morphologies de surface et des propriétés des films de ZnO par la conception de la couche interfaciale
- Réglage au niveau de Fermi des films ZnO par dépôt de couche atomique supercyclée
- Synthèse de nanocristaux de ZnO et application dans des cellules solaires polymères inversées
- Effet synergique du graphène et des MWCNT sur la microstructure et les propriétés mécaniques des nanocomposites Cu/Ti3SiC2/C
- Fabrication et caractérisation de nano-clips de ZnO par le procédé à médiation par polyol



