Réglage au niveau de Fermi des films ZnO par dépôt de couche atomique supercyclée
Résumé
Un nouveau procédé de dépôt de couche atomique supercyclé (ALD) qui combine un procédé ALD thermique avec O2 in situ Le traitement plasma est présenté dans ce travail pour déposer des couches minces de ZnO aux propriétés électriques hautement accordables. Les deux O2 le temps de plasma et le nombre de cycles ALD thermiques dans un supercycle peuvent être ajustés pour obtenir un réglage fin de la résistivité du film et de la concentration de porteurs jusqu'à six ordres de grandeur sans dopage extrinsèque. On pense que la concentration des défauts d'hydrogène joue un rôle majeur dans l'ajustement des propriétés électriques des films de ZnO. Les résultats de la microscopie à force de sonde Kelvin montrent évidemment le décalage du niveau de Fermi dans différents films de ZnO et sont bien associés au changement de concentration en porteurs. Cette technique fiable et robuste décrite ici indique clairement la capacité d'utiliser cette méthode pour produire des films de ZnO avec des propriétés contrôlées dans différentes applications.
Contexte
Une fois défini comme le matériel futur , l'oxyde de zinc (ZnO) suscite l'intérêt de la communauté scientifique depuis plus d'un demi-siècle en raison de ses propriétés optiques et électriques supérieures [1]. Récemment, la croissance rapide de l'industrie des oxydes conducteurs transparents a encore relancé son application en tant qu'électrodes transparentes dans les écrans plats, les écrans tactiles, les revêtements à faible émissivité, les cellules solaires à couche mince, etc. [2, 3]. De plus, le ZnO a trouvé de nombreuses applications dans les appareils électroniques, notamment les diodes électroluminescentes, les photodétecteurs et les dispositifs d'alimentation [4, 5]. Ces différents types d'applications nécessitent que les films de ZnO aient divers paramètres électriques, et certaines applications exigent même des films multicouches de ZnO avec des propriétés électriques différentes [6]. Par exemple, de nombreux efforts ont été faits pour développer une mémoire vive résistive transparente (TRRAM) pour la réalisation d'une électronique transparente entièrement intégrée [7, 8]. En tant que l'un des candidats les plus prometteurs, la TRRAM à base de ZnO utilise un film de ZnO hautement résistif comme couche de commutation active, tandis que les films de ZnO hautement conducteurs sont idéalement requis pour agir comme des électrodes transparentes [8,9,10]. La capacité de contrôler les propriétés électriques telles que la résistivité et la concentration en porteurs des films de ZnO est donc une exigence clé. Le dopage est généralement utilisé lorsque la modification des propriétés est nécessaire et une variété de dopants ont été appliqués pour modifier les propriétés du film de ZnO [11,12,13]. Cependant, le dopage est toujours complexe et pourrait conduire à la formation d'une phase secondaire [14]. La modulation des propriétés électriques du ZnO non dopé par un seul procédé de dépôt peut donc être avantageuse.
Le dépôt de couche atomique (ALD) est devenu une technique populaire pour former du ZnO de haute qualité avec un excellent contrôle de l'épaisseur du film jusqu'à l'échelle nanométrique et de l'uniformité sur un grand substrat [15, 16]. La température de croissance du ZnO est généralement inférieure à 200 °C, ce qui le rend compatible avec une gamme de substrats, notamment le verre et les plastiques. L'ALD ZnO est normalement cultivé en utilisant du diéthylzinc (DEZ) comme précurseur de Zn et de la vapeur d'eau (thermique) ou du plasma d'oxygène (amélioré par plasma) comme précurseur d'oxygène. Le moyen dominant d'ajuster les propriétés du film de ZnO non dopé dans le processus ALD thermique consiste à modifier la température de croissance [17, 18]. Bien que cela permette le dépôt de films hautement conducteurs, des films de ZnO de haute qualité sont difficiles à obtenir avec une faible concentration en porteurs. L'ALD rehaussée par le plasma est de préférence utilisée lorsqu'une faible concentration de porteurs ZnO est requise [19, 20]. Nous avons récemment signalé la capacité de régler le ZnO à l'aide d'un seul processus ALD amélioré par plasma qui permet le réglage de sa résistivité et de sa concentration en porteurs jusqu'à trois ordres en utilisant différents O2 temps plasmatiques [21]. Cependant, l'ALD améliorée par le plasma pourrait subir une croissance non auto-limitative si un O2 court le temps plasma est appliqué pour atteindre la concentration de porteurs nécessaire, ce qui peut entraîner une mauvaise uniformité sur un grand substrat. Un processus ALD ajustable dans la fenêtre d'auto-limitation serait donc souhaitable.
Outre la capacité à régler les propriétés électriques du ZnO, la détermination de ces propriétés reste également difficile. La mesure par effet Hall est la technique la plus répandue pour mesurer les propriétés électriques des films minces de ZnO. Cependant, il peut être sujet à des interprétations erronées et a des difficultés à détecter sans ambiguïté la cause réelle du dopage [1]. La microscopie à force de sonde Kelvin (KPFM) est une technique de surface non destructive qui a été largement utilisée pour caractériser les propriétés structurelles, dynamiques et électriques à l'échelle nanométrique des matériaux et dispositifs semi-conducteurs [22, 23]. En mesurant directement la différence de potentiel de contact (V DPC ). Cependant, les travaux corrélant les propriétés du ZnO avec les résultats du KPFM sont rarement rapportés, et à notre connaissance, il n'y en a aucun basé sur des films de ZnO cultivés par ALD [24,25,26].
Dans ce travail, nous proposons un nouveau procédé ALD supercyclé pour le réglage des propriétés électriques dans le ZnO non dopé. Combinant le procédé ALD thermique avec un O2 in situ traitement au plasma, ce processus permet un réglage large mais raffiné de la résistivité du film de ZnO et de la concentration en porteurs. Plus important encore, les changements de niveau de Fermi dans les films de ZnO peuvent être directement mesurés par KPFM et utilisés pour caractériser les propriétés électriques du ZnO.
Méthodes
Tous les films minces de ZnO ont été préparés dans un système OIPT FlexAl ALD en utilisant un précurseur de diéthylzinc (DEZ). Chaque supercycle du processus ALD se compose de m cycles de procédés thermiques ALD (DEZ et H2 O) et un O2 étape plasma comme le montre la Fig. 1a. Dans le processus ALD thermique, la vapeur DEZ a été initialement introduite dans la chambre puis purgée par un flux d'argon, et H2 De la vapeur d'O a ensuite été introduite puis purgée à l'argon. Après m cycles de procédés thermiques ALD, un O2 l'étape de plasma a été ajoutée en tant qu'étape de traitement au plasma in situ. Le O2 l'étape plasma a été définie à l'aide d'un O2 débit de 60 sccm, puissance RF de 300 W et pression de 15 mTorr. Les deux numéros ALD thermiques (m ) et O2 temps plasma (t 3 ) ont été utilisés pour le contrôle des propriétés du film ZnO. Les détails spécifiques pour un supercycle de croissance dans le processus ALD sont donnés dans le fichier supplémentaire 1 :tableau S1. Tous les films de ZnO ont été déposés sur le SiO2 -substrats Si revêtus (1 cm × 1 cm) à une température fixe de 190 °C, et toutes les épaisseurs de film ont été projetées à 40 nm.

un Illustration du supercycle de croissance du processus ALD supercyclé proposé. b Taux de croissance du ZnO en fonction de l'O2 temps plasma pour ALD supercyclé avec cycle thermique fixe (m = 1) et les procédés ALD assistés par plasma ; les courbes en pointillés sont des guides de l'œil. c Taux de croissance du ZnO et ajustement linéaire en fonction du cycle de processus thermique m avec O2 fixe temps plasma (t 3 = 1 et 8 s)
L'épaisseur et les constantes optiques des films de ZnO déposés ont été mesurées par ellipsométrie (VASE, J.A. Woollam Co. M-2000) et équipées d'un modèle Tauc-Lorentz (TL). Les propriétés électriques ont été mesurées par des mesures Hall (Nanometrics HL5500PC) à température ambiante sous un champ magnétique de 0,5 T. Des précautions supplémentaires ont été prises pour s'assurer qu'un contact linéaire a été obtenu entre chaque sonde en cuivre et l'échantillon avant chaque mesure. Les diagrammes de diffraction des rayons X (XRD) ont été collectés en incidence rasante (θ 1 = 1°) à l'aide d'un diffractomètre Rigaku Smartlab avec un Cu-K de 9 kW α la source. Les données de spectroscopie photoélectronique à rayons X (XPS) ont été obtenues à l'aide d'un système de sonde Thermo Scientific Theta avec Al-K α rayonnement (énergie photonique = 1486.6 eV). Si nécessaire, la contamination de surface a été éliminée par l'utilisation d'un pistolet de pulvérisation ionique. Le Zn 2p , O 1s , et C 1s les spectres ont été collectés. Toutes les données ont été référencées aux C 1s pic, qui a reçu une énergie de liaison de 284,6 eV. Les mesures KPFM ont été effectuées sur le Nanonics CV2000 par une pointe revêtue de Pt-Ir Nanosensor ATEC avec une fréquence de résonance de 65 kHz. Pour réduire l'influence des contaminants de surface, les mesures ont été effectuées juste après que les échantillons aient été retirés de la chambre à vide.
Résultats et discussion
Le processus ALD supercyclé proposé est illustré à la Fig. 1a avec un supercycle composé de m cycles de procédés thermiques ALD (DEZ et H2 O) et un O2 étape plasma (O2 plasma). Plus de détails dans la section « Méthodes ». La figure 1b compare les taux de croissance du ZnO dans notre processus ALD supercyclé lorsque m = 1 et le procédé ALD conventionnel amélioré par plasma en fonction de O2 temps plasma. Le taux de croissance dans le processus ALD amélioré par plasma (rouge) s'avère sensible à l'O2 plasma à mesure qu'il augmente d'env. 1,4 à 1,7 Å/cycle avec le temps plasma passant de 2 à 4 s. Il est alors saturé au niveau de ca. 1,7 Å/cycle à des temps plasma plus longs. Le taux de croissance non saturé à O2 plus court le temps plasmatique est attribué au manque d'oxygène dans le processus. Bien que cela soit parfois préféré pour obtenir des films de ZnO à haute conductivité, cela n'est pas auto-limitatif et pourrait entraîner une mauvaise uniformité sur l'ensemble du substrat. D'autre part, le taux de croissance s'est avéré stable à env. 1,69 Å/supercycle dans le procédé ALD supercyclé (noir) et est proche de celui du procédé ALD thermique (t 3 = 0 s) quel que soit le temps plasma appliqué. De plus, augmentation du cycle thermique m dans un supercycle avec un temps de plasma fixe conduit à une augmentation linéaire du taux de croissance, comme le montre la figure 1c. Le gradient ajusté est calculé à 1,67 pour les deux croissances avec différents O2 temps plasma, ce qui est également proche du taux de croissance du procédé ALD thermique. Cela suggère que la croissance de ZnO dans notre ALD supercyclée est dominée par le processus ALD thermique et le O2 qui en découle. l'étape plasma sert simplement de traitement.
Tous les films ZnO cultivés par le procédé ALD supercyclé (m = 1) cristallisent dans la structure hexagonale de la wurtzite et illustrent une distribution similaire des intensités de pic quel que soit le O2 temps plasma, comme le montre la figure 2a. Par rapport au rapport d'intensité théorique de 0,44 entre le pic (0 0 2) et (1 0 1) (calculé à partir du JCPDS-34-1451 pour une orientation aléatoire des cristallites), ces films démontrent une forte orientation préférée le long du c -axe avec le ratio d'intensité des pics (0 0 2) et (1 0 1) compris entre 2 et 5, suggérant une bonne qualité cristalline des films. Une légère augmentation du rapport de crête (0 0 2) à (1 0 1) est observée avec l'augmentation de O2 temps plasma (indiqué dans le fichier supplémentaire 1 :Figure S1). Cela suggère un degré plus élevé d'orientation préférée lorsqu'il est exposé à un plasma plus long. Un comportement similaire a également été rapporté [27, 28]. Cependant, il convient de souligner que le changement du rapport d'intensité dans notre travail est plutôt trivial par rapport aux autres. Cela suggère en outre la stabilité de notre procédé ALD supercyclé pour produire des films de ZnO de haute qualité. La taille moyenne des grains a également été estimée sur la base de la formule de Scherrer [29] et s'est avérée être d'environ. 11 nm, suggérant que la taille des grains de ZnO était à peine affectée par le O2 temps plasma. Des motifs similaires sont également observés sur des films de ZnO issus de divers cycles thermiques ALD (m ) avec un O2 fixe temps plasma (1 s) comme indiqué sur la Fig. 2b.
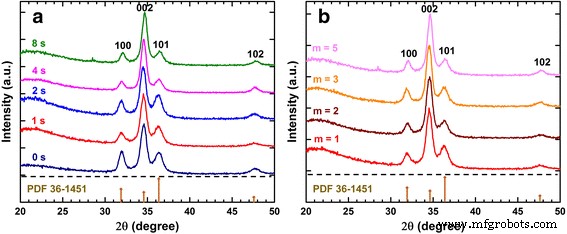
Modèles XRD de films de ZnO cultivés par le processus ALD supercyclé en utilisant a différent O2 temps plasma avec cycle thermique fixe (m = 1) et b différents cycles thermiques avec O2 fixe temps plasma (t 3 = 1 s)
Outre la cristallinité, les propriétés optiques des films de ZnO cultivés en ALD supercyclés ont également été étudiées à l'aide de l'ellipsométrie spectroscopique (SE). Constantes optiques (n et k ) peuvent être extraits des résultats d'ellipsométrie par un modèle de Tauc-Lorentz qui est couramment utilisé dans l'ajustement des films de ZnO [28, 30, 31]. Semblable à la cristallinité analogue, les propriétés optiques des films de ZnO déposés avec différents O2 les temps de plasma et les cycles thermiques restent également inchangés, comme indiqué dans le fichier supplémentaire 1 :Figure S2. Ceci est cohérent avec les travaux rapportés selon lesquels un changement de cristallinité est toujours associé à un changement de propriétés optiques [28, 32]. Les propriétés morphologiques des films de ZnO sont caractérisées par AFM. Tous les films se sont avérés également lisses avec une rugosité moyenne entre env. 0,3 et 0,8 nm (Fichier supplémentaire 1 :Figure S3).
Les propriétés électriques des films de ZnO développés par le procédé ALD supercyclé sont étudiées par un système à effet Hall. Tous les films se sont avérés être n -type semi-conducteur, et la résistivité augmente d'env. 10 −3 à 10 3 Ω cm avec l'augmentation de O2 temps plasma et cycle thermique fixe (m = 1) comme le montre la figure 3a. Ceci est associé à la réduction de la concentration en porteurs d'env. 10 21 à 10 15 cm −3 comme le O2 le temps plasmatique passe de 0 à 8 s (Fig. 3b). Au contraire, les mobilités électroniques de tous les films de ZnO s'avèrent plutôt cohérentes (environ 3,0 ± 1,0 cm 2 /V s) et ne sont pas affectés par la durée du plasma. Le mécanisme de conduite détaillé sera traité plus en détail dans la section ci-dessous. Par rapport au processus ALD amélioré par plasma que nous avons rapporté précédemment [21], l'amplitude du réglage de la résistivité a été encore améliorée dans le processus ALD supercyclé à plus de cinq ordres. De plus, ce procédé ALD proposé offre un contrôle plus affiné de ces propriétés électriques en faisant varier le cycle thermique (m ) dans un supercycle tout en fixant le O2 temps plasma (t 3 ). Ceci est particulièrement utile dans le cas de t 3 = 1 s où le réglage n'est pas réalisable en réduisant davantage le temps de plasma en raison de la limitation de l'équipement ALD. Les points vides de la Fig. 3a, b représentent les résistivités et les concentrations de porteurs des films de ZnO cultivés par différents cycles thermiques (m = 2, 3, 5) lorsque t 3 = 1 s (les barres d'erreur sont à l'intérieur des points). On peut observer que plus de cycles thermiques entraînent des films moins résistifs avec des concentrations de porteurs plus élevées. Cela fournit un supplément de trois résistivités dans la plage de 10 −3 à 10 1 Ω cm.
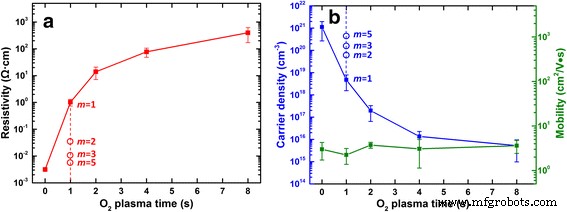
un Résistivité électrique des films de ZnO issus de différents O2 temps plasma avec cycle thermique fixe m (points pleins) et différents cycles thermiques avec O2 fixe temps plasma (points ouverts) par le procédé ALD supercyclé. b Concentration de porteurs (bleu) de films de ZnO cultivés à partir de différents O2 temps de plasma avec cycle thermique fixe (points pleins) et différents cycles thermiques avec O2 fixe temps plasma (points ouverts). Mobilité (vert) des films de ZnO issus de différents O2 temps plasma avec cycle thermique fixe
Des mesures KPFM ont été effectuées pour mieux comprendre les positions du niveau de Fermi des films de ZnO avec une résistivité changeante. Il mesure la différence de potentiel de contact V DPC entre une pointe conductrice et l'échantillon qui est défini comme :
$$ {V}_{\mathrm{CPD}}=\frac{\phi_{\mathrm{tip}}-{\phi}_{\mathrm{sample}}}{q} $$ (1)où q est la charge électronique, tandis que ϕ conseil et ϕ échantillon sont respectivement le travail de sortie de la pointe et de l'échantillon. Lorsque deux matériaux différents sont mis en contact électrique, les niveaux de Fermi s'alignent grâce au flux de courant électronique, ce qui induit par conséquent une différence de potentiel de contact entre la pointe et l'échantillon, comme indiqué dans le fichier supplémentaire 1 :Figure S4. Le principe de fonctionnement détaillé de KPFM est présenté dans le fichier supplémentaire 1. Les différences de potentiel de contact des films de ZnO cultivés par le processus ALD supercyclé à partir de différents O2 temps plasma avec cycle thermique fixe (m = 1) sont illustrés à la Fig. 4. Alors que chaque V DPC l'image semble être uniforme et relativement lisse, des différences substantielles dans le V moyen DPC des valeurs peuvent être observées (illustrées à la Fig. 4f). La fonction de travail des pourboires ϕ conseil reste constant pour toutes les mesures ; la différence substantielle de V DPC est donc la conséquence du décalage de niveau de Fermi au sein de différents films de ZnO. Un décalage total d'env. 0,32 eV est obtenu entre un film de ZnO cultivé avec 0 et 8 s O2 temps plasma qui est significatif par rapport à la bande interdite du ZnO (environ 3,22 eV sur la base des résultats SE dans ce travail, comme indiqué dans le fichier supplémentaire 1 :Figure S2c). Pour les films de ZnO issus de différents cycles thermiques (m = 2, 3, 5) à O2 fixe temps plasma (t 3 = 1 s), différents V DPC des valeurs ont également été détectées comme le montre la figure 4f. Les images KPFM bidimensionnelles de ces films se trouvent dans le fichier supplémentaire 1 :Figure S5. Cela implique que le changement de l'équilibre électron-trou se produit tout au long des films, ce qui pourrait avoir un impact considérable sur la concentration en porteurs de ZnO.
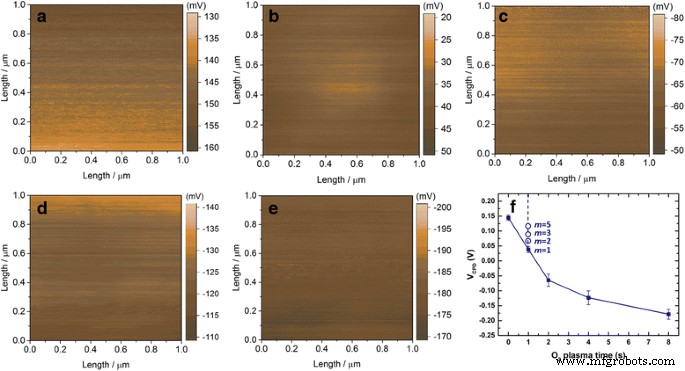
un –e Différence de potentiel de contact bidimensionnel V DPC images des mesures de potentiel de surface des films de ZnO supercyclés cultivés par ALD avec O2 temps plasma (t 3 ) variant de 0 à 8 s et cycle thermique fixe (m = 1). f V moyen DPC valeurs avec O2 variable temps plasma (points pleins) et cycles thermiques (points ouverts)
Afin d'étudier la relation entre le niveau de Fermi et la concentration de porteurs, nous adoptons le modèle d'énergie électronique proposé par Maragliano et al. pour corréler la différence de potentiel de contact V DPC avec la concentration de dopage dans le matériau [26]. En supposant la concentration effective des donneurs n D est significativement plus élevée que la concentration intrinsèque en porteurs, elle peut s'écrire :
$$ {n}_{\mathrm{D}}\approx {N}_{\mathrm{C}}\exp \left(\frac{q{V}_{\mathrm{C}\mathrm{PD} }-{\phi}_{\mathrm{tip}}+\chi }{K_BT}\right) $$ (2)où N C est la densité effective d'états, χ est l'affinité électronique du semi-conducteur, K B est la constante de Boltzmann, et T est la température. Bien que les valeurs de la densité effective d'états N C , la fonction de travail des pourboires ϕ conseil , et l'affinité électronique χ sont difficiles à obtenir, les différences relatives de concentration de porteurs de différents films de ZnO peuvent être calculées car ces valeurs sont les mêmes dans toutes les mesures. Par conséquent, le rapport de concentration en porteurs entre les films cultivés avec 0 s de O2 le temps plasma à un film de ZnO donné peut être exprimé comme :
$$ \frac{n_0}{n_x}=\exp \left(\frac{V_{\mathrm{CPD}0}-{V}_{\mathrm{CPD}x}}{K_BT/q}\right) $$ (3)dans lequel n 0 et n x sont la concentration en porteurs du film de ZnO cultivé avec 0 et x s de O2 temps plasma, respectivement, et V CPJ0 et V DPCx sont les différences de potentiel de contact correspondantes. Les rapports de concentration de porteurs calculés sont représentés sur la figure 5 en fonction de O2 temps plasma. Le rapport de concentration est calculé pour augmenter avec un O2 plus long temps plasma (rouge). Plus important encore, la tendance à la hausse correspond bien aux valeurs obtenues à partir des résultats de mesure de l'effet Hall (noir). Une tendance similaire a également été observée pour les films de ZnO issus de différents cycles thermiques (m = 2, 3, 5) à O2 fixe temps plasma (t 3 = 1 s). Cela suggère évidemment que le changement du niveau de Fermi du film ZnO est directement associé au niveau de concentration du porteur.
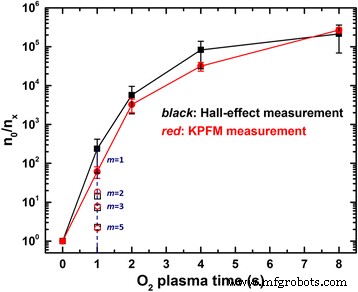
Effet Hall et résultats de mesure KPFM des rapports de concentration de porteurs entre les films de ZnO cultivés avec une variation de O2 temps plasma (points pleins) et cycles thermiques (points ouverts)
Des mesures de spectroscopie photoélectronique aux rayons X (XPS) ont été effectuées pour faire la lumière sur le mécanisme de conduction en étudiant les états de liaison et chimiques des films de ZnO cultivés en ALD supercyclés. Les états chimiques de O 1s sont illustrés à la Fig. 6 où deux pics peuvent être identifiés après des ajustements gaussiens. Le pic d'énergie inférieur (A) positionné à env. 530.3 eV est suggéré comme étant le O 2− ions dans la structure wurtzite du Zn 2+ hexagonal ions [33,34,35]. Les affectations de la composante d'énergie de liaison plus élevée à ca. 532.2 (B) ont été controversés par rapport à la littérature [33,34,35,36,37,38]. Cependant, il est largement rapporté qu'il est associé au groupe hydroxyle (c'est-à-dire Zn-OH) [33, 37, 38, 39] dans le film de ZnO. Nous attribuons donc provisoirement le OB pic observé sur la figure 6 aux liaisons Zn−OH. D'autre part, le pic associé à la lacune d'oxygène positionné à env. 531,2 eV [35] n'est pas observé dans ce travail. Film de ZnO développé par le procédé thermique ALD (t 3 = 0 s) caractérise un OB dominant pic dans le spectre XPS (Fig. 6a). Cela implique l'existence d'une grande quantité d'impuretés liées à l'hydrogène dans ce film. Ce niveau élevé de défauts sert de mécanisme d'autodopage et conduit à une concentration élevée en porteurs. Le O2 supplémentaire étape plasma (t 3 ) diminue les impuretés, et le OB l'intensité maximale diminue avec un O2 plus long temps plasma (Fig. 6f). Une tendance similaire a également été observée pour les films de ZnO issus de cycles thermiques variables dans lesquels davantage de cycles thermiques entraînent une augmentation de OB intensité maximale comme indiqué sur la figure 6f et le fichier 1 supplémentaire :figure S6.

un –e Spectres XPS et leurs raccords gaussiens des O 1s région des films de ZnO supercyclés cultivés par ALD avec O2 temps plasma (t 3 ) variant de 0 à 8 s et cycle thermique fixe (m = 1). f Proportion de l'OB lié à l'hydrogène pic dans les films de ZnO cultivés avec une variation de O2 temps plasma (points pleins) et cycles thermiques (points ouverts)
L'origine du n intrinsèque -La conductivité de type dans les films de ZnO est encore controversée. Bien que la sagesse conventionnelle ait attribué cette conductivité à un défaut natif (c. Il est également peu probable que les lacunes en oxygène contribuent à un niveau de concentration aussi élevé, car de nombreuses études suggèrent qu'il s'agit de donneurs profonds plutôt que peu profonds et qu'ils ont des énergies de formation élevées dans n -type ZnO (et sont donc de forme différente) [41,42,43,44]. De plus, l'O 1s lié au manque d'oxygène Le pic n'est pas non plus observé dans nos données XPS illustrées à la figure 6. Bien que les interstitiels de Zn soient des donneurs peu profonds, il a été suggéré qu'ils ont des énergies de formation élevées et sont des diffuseurs plus rapides et sont donc peu susceptibles d'être stables [41]. Les spectres XPS du Zn 2p 3/2 état des films de ZnO supercyclés cultivés par ALD avec divers O2 les temps de plasma sont montrés Fig. 7. Tous les spectres sont caractérisés par un pic similaire positionné à ca. 1021,5 eV attribuable au Zn 2+ collage en ZnO [6, 34, 46]. Cependant, la composante interstitielle de Zn à une énergie de liaison légèrement plus élevée [6, 47] n'est pas observée dans tous les spectres. Cela suggère que l'influence du Zn interstitiel sur la conductivité du film de ZnO peut également être exclue dans ce travail.

un –e Spectres XPS et leurs raccords gaussiens du Zn 2p 3/2 région des films de ZnO supercyclés cultivés par ALD avec O2 temps plasma (t 3 ) variant de 0 à 8 s et cycle thermique fixe (m =1)
Récemment, il est proposé que les impuretés/défauts liés à l'hydrogène jouent un rôle dans le n -conductivité de type en ZnO [33, 48]. La preuve de l'existence de liaisons hydrogène dans le ZnO a été démontrée par Janotti et al. [48], et il a été suggéré que ces liaisons sont capables de s'incorporer à des concentrations élevées et de se comporter comme des donneurs superficiels [49,50,51]. En effet, l'hydrogène est présent dans notre procédé ALD supercyclé à la fois comme précurseur et H2 O contient de l'hydrogène et une liaison Zn-OH est produite à chaque demi-cycle de l'étape ALD thermique. Ceci est également soutenu par l'observation de O 1s lié au groupe hydroxyle pic dans les spectres XPS (illustré à la Fig. 6). La résistivité du film de ZnO et la densité de porteurs sont tracées en fonction de la proportion de ce pic sur la figure 8. Une proportion élevée de ces impuretés d'hydrogène induit des concentrations élevées de porteurs, conduisant à de faibles résistivités. Le O2 suivant L'étape plasma au sein de chaque supercycle réduit la concentration de porteurs en éliminant efficacement les liaisons hydrogène. Ceci s'accompagne de la réduction de la concentration en porteurs ainsi que de l'augmentation de la résistivité. Le même comportement a également été signalé sur les processus ALD et CVD [33, 52].
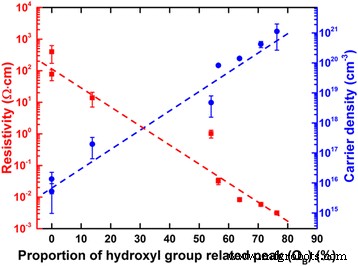
Résistivité électrique et concentration en porteurs en fonction du groupe hydroxyle OB proportion maximale (les lignes pointillées sont des guides de l'œil)
Conclusions
Le dépôt de films de ZnO non dopé avec des propriétés électriques hautement ajustables a été rapporté ici en utilisant un procédé ALD supercyclé qui combine un procédé ALD thermique et in situ O2 traitement plasma. Plus de cinq ordres de grandeur d'ajustement sur la résistivité du film et la concentration de porteurs ont été obtenus en ajustant le O2 temps plasma. Un réglage plus fin des propriétés peut également être réalisé en faisant varier le nombre de cycles ALD thermiques dans un supercycle. On pense que l'ajustement de ces propriétés électriques est associé au changement de concentration de défaut d'hydrogène dans le film. Cela provoque directement le décalage des niveaux de Fermi dans les films de ZnO, comme l'a révélé la microscopie à force de sonde Kelvin. En adoptant un modèle d'énergie électronique simple, les concentrations de porteurs calculées à partir des changements de niveau de Fermi démontrent une bonne correspondance avec les résultats de mesure de l'effet Hall. Cette technique fiable et robuste décrite ici indique clairement la capacité d'utiliser cette méthode pour produire des films de ZnO avec des propriétés contrôlées dans différentes applications.
Abréviations
- ALD :
-
Dépôt de couche atomique
- DEZ :
-
Diéthylzinc
- KPFM :
-
Microscopie à force de sonde Kelvin
- XPS :
-
Spectroscopie photoélectronique aux rayons X
- XRD :
-
Diffraction des rayons X
Nanomatériaux
- Technologies avancées de dépôt de couche atomique pour les micro-LED et les VCSEL
- Caractéristiques de commutation résistive bipolaire des dispositifs RRAM à structure tricouche HfO2/TiO2/HfO2 sur des substrats revêtus de Pt et de TiN fabriqués par dépôt de couche atomique
- Caractéristiques d'alignement interfacial, électrique et de bande des piles HfO2/Ge avec une couche intermédiaire de SiO2 formée in situ par dépôt de couche atomique amélioré par plasma
- Les nanofibres hiérarchiques antibactériennes en polyamide 6-ZnO fabriquées par dépôt de couche atomique et croissance hydrothermale
- Propriétés photocatalytiques des poudres de TiO2 revêtues de Co3O4 préparées par dépôt de couche atomique amélioré par plasma
- Dépôt en deux étapes de ZnO dopé Al sur p-GaN pour former des contacts ohmiques
- Réglage des morphologies de surface et des propriétés des films de ZnO par la conception de la couche interfaciale
- Propriétés optiques des films ZnO dopés Al dans la région infrarouge et leurs applications d'absorption
- Effet de différentes morphologies de CH3NH3PbI3 sur les propriétés photovoltaïques des cellules solaires à pérovskite



