Caractéristiques d'alignement interfacial, électrique et de bande des piles HfO2/Ge avec une couche intermédiaire de SiO2 formée in situ par dépôt de couche atomique amélioré par plasma
Résumé
SiO2 formé in situ a été introduit dans HfO2 diélectriques de grille sur substrat Ge comme intercalaire par dépôt de couche atomique assisté par plasma (PEALD). Les caractéristiques interfaciales, électriques et d'alignement de bande du HfO2 /SiO2 les empilements diélectriques de grille à k élevé sur Ge ont été bien étudiés. Il a été démontré que l'intercalaire Si-O-Ge se forme à la surface du Ge pendant le PEALD SiO2 in situ processus de dépôt. Cette couche intermédiaire montre une stabilité thermique fantastique pendant le recuit sans formation évidente de silicates Hf. De plus, il peut également supprimer le GeO2 dégradation. Les mesures électriques montrent que l'épaisseur équivalente de capacité de 1,53 nm et une densité de courant de fuite de 2,1 × 10 −3 A/cm 2 au biais de grille de Vfb + 1 V a été obtenu pour l'échantillon recuit. La bande de conduction (valence) se décale au HfO2 /SiO2 L'interface /Ge avec et sans PDA est respectivement de 2,24 (2,69) et 2,48 (2,45) eV. Ces résultats indiquent qu'in situ PEALD SiO2 peut être une couche de contrôle interfaciale prometteuse pour la réalisation de dispositifs à transistors à base de Ge de haute qualité. De plus, il peut être démontré que PEALD est une technologie beaucoup plus puissante pour le dépôt de couche de contrôle interfacial ultrafine que MOCVD.
Contexte
Avec la réduction continue des transistors à effet de champ métal-oxyde-semiconducteur (MOSFET), le MOSFET à base de silicium approche de ses limites physiques et techniques. Des matériaux de canaux alternatifs tels que le germanium (Ge) [1, 2] et les matériaux III-V [3-5] ont récemment suscité un grand intérêt pour les applications de dispositifs logiques hautes performances. Parmi eux, Ge a le potentiel de remplacer le silicium comme matériau de canal dans les MOSFET en raison de sa mobilité intrinsèque plus élevée des porteurs de trous [6]. Cependant, le dépôt direct de diélectriques de grille à k élevé sur des substrats de Ge provoque souvent une densité de piège d'interface élevée (Dit ) et la formation indésirable d'une couche interfaciale entre Ge et les couches diélectriques à k élevé [7]. Par conséquent, afin d'obtenir des MOSFET à base de Ge à grande vitesse et à faible puissance, il est très important d'obtenir un k élevé de haute qualité. /Ge interface. Heureusement, de nombreuses méthodes ont été rapportées pour améliorer la qualité de l'interface high-k/Ge [8], comme l'introduction de SiO2 [9], Si [10], GeO2 [11], Al2 O3 [12, 13], GeOx Ny [14, 15] et les oxydes de terres rares [16, 17] comme couche de contrôle interfaciale entre le substrat Ge et le haut-k diélectriques de grille. En particulier, le GeO2 La structure /Ge a des propriétés d'interface supérieures, une densité d'état d'interface extrêmement faible (Dit ) de moins de 1 × 10 11 cm −2 eV −1 peut être atteint [18]. Cependant, GeO2 se décomposerait au-dessus de 425 °C, et il est soluble dans l'eau. En conséquence, un Dit inacceptable est toujours révélé pour le condensateur Ge-MOS (MOSCAP) [6]. Heureusement, Kita et al. a signalé cette couche de recouvrement sur GeO2 peut supprimer le GeO2 dégradation; cependant, la sélection du matériau pour la couche de couverture devrait être très cruciale [19-21]. Par exemple, Si ou Y2 O3 fonctionne plus efficacement que HfO2 pour retarder la désorption Ge-O. Ces résultats indiquent l'importance des matériaux à k élevé ou de la sélection de la couche de contrôle interfaciale pour inhiber le GeO2 dégradation. Nakashima et al. a signalé qu'un SiO2 très mince /GeO2 bicouche par dépôt physique en phase vapeur (PVD) est une couche intercalaire prometteuse pour la passivation Ge, un Dit de 4 × 10 11 cm -2 eV −1 a été atteint près du midgap [22, 23]. Li et al. introduit le SiO2 intercalaire sur Ge par dépôt chimique en phase vapeur métal-organique (MOCVD) et SiO2 l'intercalaire peut supprimer efficacement la diffusion de Ge pendant HfO2 croissance et processus de recuit post-dépôt ultérieur [9]. Par conséquent, SiO2 devrait être une merveilleuse couche de contrôle interfacial pour le substrat Ge. Cependant, par rapport au PVD et au MOCVD, PEALD peut fournir une couche de passivation beaucoup plus uniforme, en particulier pour les épaisseurs ultrafines. Par conséquent, le SiO2 formé par PEALD peut être une couche de contrôle interfaciale prometteuse pour réaliser des dispositifs à transistors à base de Ge hautes performances.
Ici, nous avons introduit in situ le SiO2 formé par PEALD dans HfO2 /Ge s'empile comme couche interfaciale. Les caractéristiques interfaciales, électriques et d'alignement de bande d'ALD HfO2 des films sur des substrats de Ge de type n ont été soigneusement étudiés. Le SiO2 a d'abord été déposé sur les substrats Ge comme couche de contrôle interfacial par PEALD. Ensuite, HfO2 Le diélectrique de grille a été déposé in situ par mode ALD thermique. Recuit post-dépôt (PDA) à 500 °C pendant 60 s dans N2 a été réalisée pour le HfO2 /SiO2 empilements diélectriques de grille à k élevé sur Ge. Les analyses de spectroscopie photoélectronique aux rayons X révèlent que l'intercalaire Si-O-Ge et GeO2 la couche est formée sur la surface de Ge pendant PEALD SiO2 déposition. Cette couche intermédiaire Si-O-Ge montre non seulement une stabilité thermique fantastique, mais elle peut également supprimer la décomposition thermique de GeO2 . Par conséquent, de bonnes propriétés électriques ont été obtenues pour le HfO2 /Si-O-Ge/GeO2 /Ge piles. Par rapport au MOCVD SiO2 intercalaire, in situ PEALD SiO2 présente des propriétés électriques nettement améliorées. Par conséquent, PEALD est une technologie beaucoup plus puissante que MOCVD dans le domaine de la fabrication des MOSFET, en particulier pour le dépôt de couche de contrôle interfacial ultrafine.
Méthodes
Du Ge (100) dopé au Sb de type N avec une résistivité de 0,2 à 0,3 cm ont été utilisés comme substrats. Les substrats ont d'abord été nettoyés par sonication dans de l'acétone, de l'éthanol, de l'isopropanol et de l'eau déminéralisée pendant 5 min, respectivement. Ensuite, une solution de HBr diluée (H2 O/HBr = 3 :1) a été utilisé pour graver les oxydes natifs de surface pendant 5 min. Après un nettoyage chimique humide, les substrats ont été rincés à l'eau déminéralisée et séchés par soufflage dans du N2 pur . Par la suite, les substrats ont été immédiatement transférés au PEALD (Picosun SUNALE TM R-200). Avant le haut-k HfO2 dépôt de films, 10 cycles SiO2 le film a été déposé à 250 °C par PEALD en tant qu'intercalaire, où un cycle consistait en 1 s d'injection de source de Si, 10 s N2 purge, 13,5 s d'injection d'oxydant et 4 s N2 purge. Tris-(diméthylamino)-silane (TDMAS) et O2 plasma ont été utilisés comme précurseur de Si et oxydant pour SiO2 dépôt, respectivement. Le TDMAS a été conservé à température ambiante. Pur O2 le gaz (99,999 %) a été utilisé comme O2 source de plasma. La puissance plasma et O2 le débit de gaz était de 2500 W et 160 sccm, respectivement. Le taux de croissance de PEALD SiO2 a été déterminé à environ 0,7 Å/cycle par ellipsométrie spectroscopique ex situ. Puis ~4 nm d'épaisseur HfO2 le film a été déposé in situ à 250 °C pendant 40 cycles par ALD thermique, où un cycle consistait en un dosage de source de Hf de 0,1 s, 4 s N2 purge, 0,1 s H2 O dosage, et 4 s N2 purge. Tétrakis-(éthylméthylamino)-hafnium (TEMAH) et H2 O ont été utilisés comme précurseur de Hf et oxydant pour HfO2 dépôt, respectivement. TEMAH a été évaporé à 150 °C et H2 O a été conservé à température ambiante. Pur N2 (99,999 %) a été utilisé comme gaz porteur et gaz de purge. PDA a été réalisée en N2 ambiante à 500 °C pendant 60 s sous pression atmosphérique en utilisant un recuit thermique rapide.
Les structures interfaciales et la liaison chimique des films ont été étudiées par spectroscopie photoélectronique à rayons X ex situ (XPS, Thermo Fisher K-Alpha) avec une source de rayons X standard Al Kα (1486,7 eV). Les spectres XPS ont été collectés à un angle de décollage de 90°. L'échelle d'énergie de liaison a été calibrée à l'aide du Ge 3d5/2 pic à 29,4 eV. De plus, les spectres XPS ont été équipés de fonctions gaussiennes-lorentziennes (G-L) après soustraction de fond de type intelligent. Électrodes supérieures en Pt de surface 1,55 × 10 −4 cm 2 ont été déposés à la surface de HfO2 films utilisant un masque d'ombre par méthode de pulvérisation cathodique pour les mesures électriques. Les caractéristiques capacité-tension (C-V) et courant de fuite densité-tension (J-V) ont été mesurées par un système d'analyse de semi-conducteurs Keithley 4200 avec une plate-forme de sonde (Sommet Cascade 12000B-M).
Résultats et discussion
Pour le PEALD SiO2 mince (~0,7 nm) sur Ge, Si 2p présente un pic à 102,4 eV correspondant à la liaison Si-O (Fig. 1a), ce qui est inférieur à l'énergie de liaison du SiO2 idéal [24]. Les deux sous-oxyde de silicium (SiOx ) le dépôt et la formation de Si-O-Ge sur la surface de Ge pendant le processus PEALD peuvent entraîner le décalage de Si 2p vers une énergie plus faible. Par conséquent, le spectre Si 2p de PEALD épais (~ 7 nm) sur Ge a également été réalisé. On peut constater qu'il présente un pic principal à 103,6 eV correspondant au SiO2 idéal collage, comme illustré à la Fig. 1b. Ainsi, l'oxyde de silicium déposé par PEALD est ici le SiO2 idéal . Cependant, outre le fort pic Si-O-Si, il existe un pic faible situé à ~ 102,4 eV, qui devrait correspondre à la liaison Si-O-Ge sur la surface du Ge. Par conséquent, on peut conclure que Si-O-Ge est formé sur la surface de Ge dans le PEALD SiO2 initial croissance. Après in situ 4 nm HfO2 dépôt, l'intensité du pic de Si 2p diminue sans déplacement chimique évident (102,3 eV), comme le montre la figure 1a. De plus, le Si 2p le pic ne présente également aucun déplacement chimique évident (102,2 eV) après la PDA de 500 °C dans N2 , suggérant la bonne stabilité thermique du HfO2 /SiO2 interface pendant HfO2 processus de dépôt et PDA. Dans le spectre Hf 4f de HfO2 tel que déposé /SiO2 empilements de portes (Fig. 1c), le doublet à 16,5 et 18,2 eV peut être affecté à Hf 4f7/2 et Hf 4f5/2 pics de HfO2 avec une énergie de division de l'orbite de spin de 1,7 eV, conforme à la valeur de la littérature pour HfO2 [25]. Après 500 °C PDA, le spectre Hf 4f ne montre aucun changement évident avec seulement 0,1 eV de décalage vers une énergie plus élevée. Cela implique qu'il n'y a pas de Hf-silicates évidents formés pendant le processus PDA. Dans la Fig. 1d, le spectre Ge 3d de l'échantillon tel que déposé affiche les pics de doublet à 29,4 et 30,0 eV, qui peuvent être attribués aux pics Ge 3d5/2 et Ge 3d3/2 du substrat Ge avec l'énergie de division de l'orbite de spin de 0,6 eV. À l'exception du signal du substrat Ge, il existe un pic énorme à 32,7 eV pour la liaison Ge-O. Le pic Ge-O devrait résulter de la formation de Ge-O-Si et GeO2 . Le GeO2 couche a été formée par oxydation de surface au plasma d'oxygène pendant PEALD SiO2 processus de dépôt. Par conséquent, la véritable structure fabriquée ici est HfO2 /Si-O-Ge/GeO2 /Ge piles. De plus, le spectre Ge 3d ne montre aucun changement évident après un traitement PDA à 500 °C, indiquant la stabilité thermique de HfO2 /Si-O-Ge/GeO2 /Ge stacks sans GeO2 dégradation. Il a été rapporté par Kita et al. que des couches de recouvrement sur GeO2 pourrait supprimer le GeO2 décomposition, comme Si ou La2 O3 [19]. Par conséquent, le PEALD induit l'intercalaire Si-O-Ge ici peut également supprimer le GeO2 décomposition. Sur la base de l'analyse XPS ci-dessus, on peut conclure qu'une couche intermédiaire de Si-O-Ge ultrafine est formée sur la surface de Ge. De plus, cet intercalaire présente une stabilité thermique fantastique sans formation de Hf-silicates, il peut également inhiber le GeO2 dégradation.
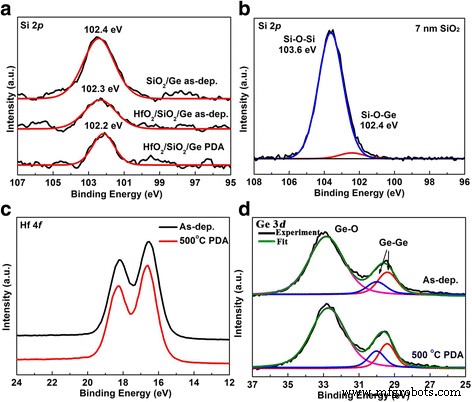
Spectres XPS de SiO2 /Ge et HfO2 /SiO2 /Gé structures. un Spectres Si 2p de SiO2 , tel que déposé et recuit HfO2 /SiO2 sur Ge. b Spectres Si 2p de SiO2 épais (7 nm) sur Ge. c, d Spectres 3d Hf 4f et Ge de HfO2 brut de dépôt et recuit /SiO2 /Gé structures
La figure 2a représente les courbes C-V à haute fréquence (1 MHz) de HfO2 /SiO2 La porte s'empile sur Ge avant et après PDA. On peut trouver que la tension de bande plate (V fb ) valeurs de HfO2 /SiO2 /Ge avant et après PDA sont respectivement de 0,42 et 0,27 V. Le V idéal calculé fb la valeur est de 0,55 V. Le V légèrement négatif fb décalage indique des charges fixes positives, qui peuvent être induites par les lacunes d'oxygène dans les diélectriques [26, 27]. Au cours du processus de recuit en atmosphère inerte, davantage de lacunes d'oxygène peuvent être induites, ce qui entraîne un V légèrement négatif. fb changement. Il a été démontré dans de nombreuses littératures rapportées que le GeO2 la dégradation pendant le recuit provoquera le V positif fb changement. On pense que le processus de désorption de Ge-O génère des charges négatives supplémentaires [28, 29]. Par conséquent, on peut également conclure que GeO2 la décomposition est supprimée par l'intercalaire Ge-O-Si de V fb changement. La capacité d'accumulation augmente évidemment de 1,92 à 2,25 μF/cm 2 après PDA. Les valeurs d'épaisseur équivalente de capacité (CET) correspondantes des condensateurs MOS peuvent être calculées à partir des capacités d'accumulation des courbes C-V en utilisant ε0 r A/Cac [30]. Par conséquent, un CET plus petit de 1,53 nm est obtenu après PDA par rapport à un échantillon tel que déposé de 1,80 nm. Cela peut être attribué au fait qu'une couche à k élevé plus dense et plus mince peut être acquise après le processus PDA. La figure 2b montre les caractéristiques du courant de fuite de HfO2 /SiO2 films sur Ge avant et après PDA. À la tension de polarisation de V fb + 1 V, la densité de courant de fuite est de 2,1 × 10 −3 A/cm 2 et 2,2 × 10 −4 A/cm 2 pour l'échantillon avant et après PDA, respectivement. L'augmentation de la densité de courant de fuite après PDA peut également être attribuée à la diminution de l'épaisseur des diélectriques de grille.
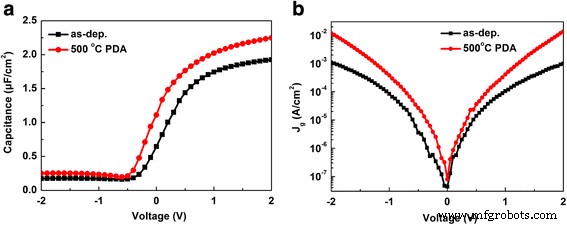
Caractéristiques électriques de HfO2 /SiO2 empilements de grilles sur substrats Ge avant et après 500 °C PDA. un Courbes C-V haute fréquence (1 M Hz). b Courbes J-V
Afin d'examiner la qualité de l'interface de HfO2 /SiO2 /Ge quantitativement, la densité d'état de l'interface (D il ) a été déterminée par la méthode de conductance [31]. La figure 3 montre la distribution de D il en dessous de Ec dans la bande interdite extraite par la méthode de conductance à température ambiante pour Pt/HfO2 /SiO2 /Ge avant et après 500 °C PDA. Le D il peut être calculé approximativement à partir de D il = 2,5 × (G p /w )max /Un q, où (G p /w )max est la valeur de crête des caractéristiques conductance-tension, f (=w /2π) est la fréquence, A est la surface de l'électrode, et q est la charge élémentaire. Par conséquent, D il valeurs de Pt/HfO2 /SiO2 Les structures /Ge sans et avec PDA sont déterminées à 4,05 × 10 12 eV −1 cm -2 et 5.37 × 10 12 eV −1 cm −2 à E-Ev = 0,38 eV, respectivement. Le D inférieur il valeurs de 2,03 × 10 12 cm −2 eV −1 et 2,67 × 10 12 cm −2 eV -1 près du bas de la bande de conduction sont observés pour les échantillons sans et avec PDA, respectivement.
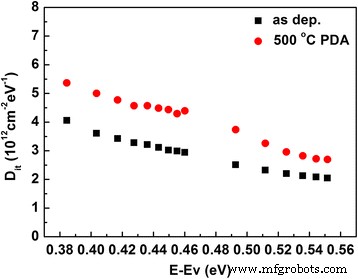
Distribution de Dit en dessous de Ec dans la bande interdite à température ambiante pour Pt/HfO2 /SiO2 /Ge avant et après 500 °C PDA
La figure 4 illustre la densité de courant de fuite (J g Relation )-CET du condensateur MOS à base de Ge avec différentes couches de contrôle interfaciales [32, 33]. Comparé au Ge S-passivé sans intercalaire rapporté par nos précédents travaux [34], le HfO2 /SiO2 /Ge dans ce travail présente des propriétés bien améliorées avec un CET plus petit (1,53 contre 2,18 nm), une densité de courant de fuite (2,1 × 10 −3 contre 3,1 A/cm 2 ), et D il (4,37 × 10 12 contre 8.61 × 10 12 eV −1 cm −2 ). Cela implique que le SiO2 formé par PEALD in situ est une merveilleuse couche de passivation pour Ge. De plus, par rapport au SiO2 formé ex situ intercalaire par MOCVD [9], l'échantillon avec du SiO2 formé in situ par PEALD La couche intermédiaire de ce travail montre de meilleures performances électriques avec un CET plus petit (1,53 contre 1,75 nm) et une densité de courant de fuite (2,1 contre 3,9 mA/cm 2 ). Cela peut être attribué au fait que SiO2 déposés par PEALD sont plus uniformes que MOCVD en particulier pour les épaisseurs ultrafines.
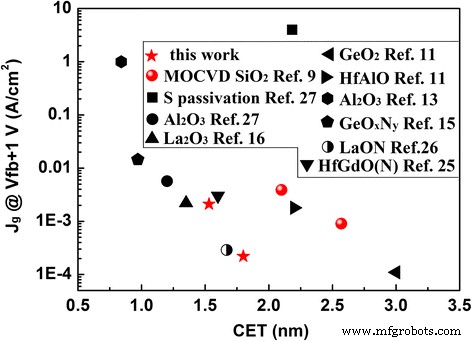
Relation densité de courant de fuite (Jg)-CET pour les condensateurs MOS à base de Ge avec différentes couches de contrôle d'interface
L'alignement des bandes à HfO2 /SiO2 L'interface /Ge a également été déterminée en mesurant le décalage de la bande de valence ∆E v (VBO) en utilisant XPS. Les valeurs VBO peuvent être obtenues en supposant que la différence d'énergie entre le niveau du cœur et le bord de la bande de valence (VB) du substrat reste constante avec/sans dépôt de films diélectriques [35]. Ici, le substrat Ge a été choisi comme référence pour déterminer le VBO entre l'empilement de diélectriques de grille et le substrat Ge. La figure 5a présente les spectres VB du substrat Ge propre, tel que déposé et recuit HfO2 /SiO2 Empilements /Ge déterminés par la méthode d'extrapolation linéaire, respectivement. Le bord VB du substrat Ge propre a été déterminé à 0,10 eV. Et, les bords VB de HfO2 tel que déposé et recuit /SiO2 les échantillons sont respectivement de 2,55 et 2,79 eV. On peut remarquer qu'il y a une petite queue dans les spectres VB pour HfO2 /SiO2 Empilements /Ge, ce qui correspond au signal du substrat Ge [36]. Le bord d'attaque de cette queue faible est mesuré à 0,10 eV et identique au bord VB du substrat Ge. Par conséquent, les VBO à l'interface de HfO2 /SiO2 /Ge avec et sans PDA sont estimés à 2,69 et 2,45 eV, respectivement. Le décalage de bande de conduction ∆E c (CBO) peut être obtenu en soustrayant le VBO et la bande interdite du substrat de la bande interdite de HfO2 :
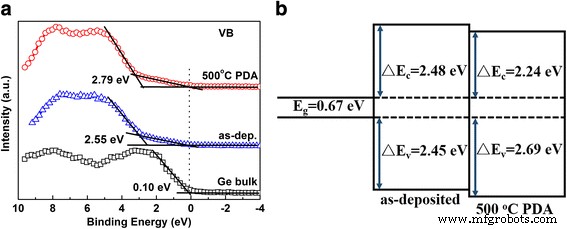
Alignement des bandes de HfO2 tel que déposé et recuit /SiO2 film sur Ge. un Spectres en bande de valence du substrat Ge, HfO2 tel que déposé et recuit /SiO2 cinéma. b Schéma de l'alignement des bandes de HfO2 tel que déposé et recuit /SiO2 film sur Ge
où E g (HfO2 ) et E g (Ge) sont la bande interdite de HfO2 et Ge, respectivement. Les bandes interdites de Ge et HfO2 sont respectivement de 0,67 et 5,6 eV. Par conséquent, les valeurs CBO à l'interface de HfO2 /SiO2 /Ge avec et sans PDA sont estimés à 2,24 et 2,48 eV, respectivement. Les valeurs du CBO sont cohérentes avec les données précédemment rapportées de 1,8 à 2,6 eV [37]. La figure 5b illustre l'alignement de bande correspondant de HfO2 tel que déposé et recuit /SiO2 /Gé structures. Évidemment, le HfO2 /SiO2 Les empilements diélectriques de grille à k élevé sur Ge présentent des valeurs VBO et CBO élevées avec des hauteurs de barrière énormes pour inhiber le courant de fuite.
Conclusions
En résumé, SiO2 intercalaire a été introduit dans HfO2 diélectriques de grille sur des substrats n-Ge avec succès par PEALD in situ. Nous avons étudié les propriétés interfaciales, électriques et l'alignement des bandes de HfO2 /SiO2 /Ge MOS. Il a été démontré que l'intercalaire Ge-O-Si et GeO2 la couche est formée sur la surface de Ge pendant le SiO2 in situ déposition. Cette couche intermédiaire Ge-O-Si montre une stabilité thermique fantastique pendant le PDA sans formation de Hf-silicates. De plus, l'intercalaire Ge-O-Si peut également inhiber le GeO2 dégradation au cours du processus de recuit. Le HfO2 /SiO2 L'échantillon /Ge après PDA présente une valeur CET de 1,53 nm avec une faible densité de courant de fuite de 2,1 × 10 −3 A/cm 2 à Vfb + 1 V. Les valeurs VBO au HfO2 /SiO2 /Ge avec et sans PDA sont déterminés à 2,69 et 2,45 eV, et les valeurs CBO à 2,24 et 2,48 eV, respectivement. Par rapport au SiO2 formé ex situ intercalaire par MOCVD, l'échantillon avec SiO2 formé in situ PEALD intercalaire dans ce travail montre des performances électriques améliorées, attribuée au fait que SiO2 déposés par PEALD sont plus uniformes que MOCVD. Par conséquent, PEALD est une technologie beaucoup plus puissante pour le dépôt d'une couche de contrôle interfaciale ultrafine que MOCVD.
Nanomatériaux
- Technologies avancées de dépôt de couche atomique pour les micro-LED et les VCSEL
- Modèle de rétention de TaO/HfO x et TaO/AlO x RRAM avec caractéristiques de commutateur auto-rectifiant
- Caractéristiques de commutation résistive bipolaire des dispositifs RRAM à structure tricouche HfO2/TiO2/HfO2 sur des substrats revêtus de Pt et de TiN fabriqués par dépôt de couche atomique
- Caractéristiques optiques et électriques des nanofils de silicium préparés par gravure autocatalytique
- Les nanofibres hiérarchiques antibactériennes en polyamide 6-ZnO fabriquées par dépôt de couche atomique et croissance hydrothermale
- Propriétés photocatalytiques des poudres de TiO2 revêtues de Co3O4 préparées par dépôt de couche atomique amélioré par plasma
- Propriétés électriques des matériaux composites avec alignement assisté par champ électrique des charges de nanocarbone
- Réglage des morphologies de surface et des propriétés des films de ZnO par la conception de la couche interfaciale
- Réglage au niveau de Fermi des films ZnO par dépôt de couche atomique supercyclée



