Caractéristiques de commutation résistive bipolaire des dispositifs RRAM à structure tricouche HfO2/TiO2/HfO2 sur des substrats revêtus de Pt et de TiN fabriqués par dépôt de couche atomique
Résumé
Le HfO2 /TiO2 /HfO2 Des dispositifs de mémoire à accès aléatoire résistif (RRAM) à structure tricouche ont été fabriqués sur des substrats de Si revêtus de Pt et de TiN avec des électrodes supérieures en Pt par dépôt de couche atomique (ALD). L'effet des électrodes inférieures de Pt et TiN sur les propriétés de commutation résistive des unités à structure tricouche a été étudié. Les deux Pt/HfO2 /TiO2 /HfO2 /Pt et Pt/HfO2 /TiO2 /HfO2 /TiN présente un comportement typique de commutation résistive bipolaire. Les mécanismes de conduction dominants dans les états de résistance faible et élevée (LRS et HRS) des deux cellules mémoire sont respectivement le comportement ohmique et le courant à charge d'espace limitée. On constate que les électrodes inférieures de Pt et de TiN ont une grande influence sur la préférence de polarité d'électroformage, le rapport de résistance élevée et faible et la dispersion des tensions de fonctionnement des cellules de mémoire à structure tricouche. Par rapport à l'utilisation d'électrodes supérieures/inférieures symétriques en Pt, les cellules RRAM utilisant des électrodes inférieures asymétriques en Pt/TiN présentent une tension de formation négative plus petite de -3,7 V, une distribution relativement étroite des tensions de réglage/réinitialisation et un rapport inférieur de résistances haute et basse de 10 2 . La polarité d'électroformage dépendant de l'électrode peut être interprétée en considérant l'activité chimique des électrodes avec l'oxygène, les réactions associées à l'anode et la distribution non uniforme de la concentration de lacunes d'oxygène dans la structure tricouche de HfO2 /TiO2 /HfO2 sur Si revêtu de Pt et TiN. De plus, pour Pt/HfO2 /TiO2 /HfO2 /Dispositifs TiN, l'électrode TiN en tant que réservoir d'oxygène joue un rôle important dans la réduction de la tension de formation et l'amélioration de l'uniformité des paramètres de commutation résistive.
Contexte
La mémoire à accès aléatoire résistive (RRAM) a attiré une grande attention en raison de son potentiel pour le remplacement de la mémoire flash dans les mémoires non volatiles de nouvelle génération [1,2,3]. Le phénomène de commutation résistive (RS) a été largement découvert dans les oxydes de métaux de transition, les électrolytes solides et les polymères organiques [4,5,6,7]. Les dispositifs RRAM basés sur des oxydes de métaux de transition ont été largement explorés en raison de leur composition simple et de leur traitement compatible avec la fabrication conventionnelle de métal-oxyde-semiconducteur complémentaire (CMOS) [8,9,10]. Le modèle de filament de la migration des lacunes d'oxygène est utilisé pour élucider le comportement de commutation [1, 11]. Un principe microscopique unifié est proposé pour quantifier les caractéristiques de commutation à la fois unipolaires et bipolaires de la RRAM à base d'oxyde de métal de transition, qui sont corrélées à la distribution des lacunes d'oxygène localisées dans la couche de commutation d'oxyde [12, 13].
Cependant, les cellules de mémoire utilisant des oxydes de métaux de transition souffrent de la non-uniformité des paramètres de commutation résistive, tels que des valeurs de résistance instables des états de résistance faible et élevée (LRS et HRS), des tensions de réglage et de réinitialisation dispersées, entravant les applications commerciales. Récemment, il a été démontré que les dispositifs RRAM à base d'oxyde à structure tricouche améliorent la dispersion des paramètres de commutation résistive. Les cellules avec une structure de Al2 O3 /HfO2 /Al2 O3 ont présenté une uniformité fantastique des tensions de réglage et de réinitialisation, et une excellente endurance de commutation entre le LRS et le HRS [14]. La liaison ou la rupture des filaments conducteurs s'est produite plus facilement dans deux couches interfaciales entre Al2 O3 /IL/HfO2 /IL/Al2 O3 . Pendant ce temps, l'unité de structure tricouche de TaOx /TiO2 /TaOx a montré de bonnes performances dans un réseau de résistances à un sélecteur, ce qui a été attribué au fait que la bande d'énergie du TiO2 le film était plié symétriquement en haut et en bas TaO x /TiO2 interfaces et modifié comme une barrière d'oxyde à crête en raison de la diffusion de certains atomes de Ta dans TiO2 film [15].
De plus, le comportement RS d'un support de stockage d'oxyde donné peut être significativement affecté par les matériaux des électrodes [1, 16, 17]. Cependant, les modèles existants basés sur l'énergie libre de formation d'oxyde interfacial et les fonctions de travail du métal sont insuffisants pour expliquer complètement les résultats. Pendant ce temps, les travaux sur le phénomène RS dépendant des électrodes de la RRAM à structure tricouche font également plutôt défaut à l'heure actuelle.
Le dépôt de couche atomique (ALD) est un nouveau type de technologie de dépôt de couche mince basée sur des réactions séquentielles de chimisorptions de surface autolimitées et complémentaires utilisant la vapeur de précurseur avec un contrôle d'épaisseur simple et précis, une grande uniformité de surface et une excellente conformité tridimensionnelle, en particulier pour le dépôt de structure nano-stratifiée [18, 19].
Dans ce travail, le HfO2 /TiO2 /HfO2 des dispositifs RRAM à structure tricouche ont été préparés sur Si/SiO2 Substrats /Ti/Pt et Si/TiN avec électrodes supérieures en Pt par ALD. L'impact des électrodes inférieures de Pt et TiN sur les comportements RS de HfO2 /TiO2 /HfO2 appareils a été soigneusement étudié. L'explication associée a été proposée.
Méthodes
Dans cette expérience, nous avons utilisé deux électrodes inférieures différentes, y compris du Si/SiO2 du commerce /Ti/Pt et Si/SiO2 maison /Étain. Le TiN conducteur a été déposé par dépôt de couche atomique assisté par plasma (PEALD) dans notre laboratoire.
L'ALD a été réalisée dans un Picosun SUNALE TM commercial Réacteur avancé R-200 (Picosun, Finlande). P des plaquettes de type Si (100) avec une résistivité de 1 à 10 Ω cm ont été utilisées comme substrats de départ. Après le nettoyage RCA conventionnel des plaquettes de Si sans enlever l'oxyde natif, du TiN de 30 nm d'épaisseur a été déposé sur Si comme électrode inférieure à 400 °C par PEALD, en utilisant du TiCl4 à température ambiante. et NH3 gaz plasma comme précurseurs Ti et N, respectivement. NH liquide3 a été sélectionné comme NH3 source de plasma à température ambiante. La puissance plasma et NH3 le débit de gaz était de 2500 W et 150 scccm, respectivement.
Par la suite, 5 nm HfO2 /10 nm TiO2 /5 nm HfO2 les structures d'empilement ont été successivement déposées sur des substrats Si revêtus de Pt et TiN à 250 °C par ALD thermique en utilisant Hf[N(C2 H5 )CH3 ][sub>4 (TEMAH), TiCl4 , et H2 O en tant que précurseurs Hf, Ti et O, respectivement, où un cycle d'oxyde consistait en 0,1s injection de source métallique, 4s N2 purge, 0,1s H2 O injection, et 4s N2 purge. Le TEMAH a été évaporé à 150 °C. Pur N2 (99,999 %) a été utilisé comme gaz vecteur et gaz de purge. Ensuite, des électrodes supérieures en Pt de 100 nm d'épaisseur ont été pulvérisées en courant continu à travers un masque perforé d'un diamètre de 150 μm à l'aide du système Q150T.
La croissance par cycle (GPC) de HfO2 pur ou TiO2 sur Si a été déterminée par ellipsomètre spectroscopique (GES-5, Sopra). La topographie et la rugosité de surface des films et des électrodes inférieures ont été analysées par microscopie à force atomique (AFM, Cypher, Asylum Research). Les valeurs de rugosité quadratique moyenne (RMS) ont été enregistrées à partir de zones de 1 μm × 1 μm. La composition et l'état chimique des structures de l'empilement ont été examinés par spectroscopie photoélectronique aux rayons X (XPS, Thermo Fisher K-Alpha) avec un Al Kα monochromatique source (hν = 1486.6 eV) pour l'excitation des photoélectrons. L'effet de charge a été calibré en réglant le C 1s photoémission à 284,6 eV. Le profil de profondeur XPS de HfO2 /TiO2 /HfO2 sur Si revêtu de Pt et de TiN a été obtenu par gravure ionique Ar. Les propriétés électriques du HfO2 /TiO2 /HfO2 Les dispositifs RRAM à structure tricouche ont été mesurés par le système de caractérisation des semi-conducteurs Keithely 4200 sur une station de sonde (CasCade Summit 12000 B-M). Une conformité de courant de 10 mA a été imposée pour protéger les unités de dispositifs fabriquées contre les dommages causés par un courant élevé pendant les processus définis. La tension de polarisation a été appliquée à l'électrode supérieure en Pt avec les électrodes inférieures mises à la terre en Pt ou TiN.
Résultats et discussion
Le schéma du dispositif RRAM de HfO2 /TiO2 /HfO2 La structure tricouche par ALD est illustrée sur la Fig. 1. La morphologie de la surface et la rugosité des électrodes inférieures et la structure tricouche de HfO2 /TiO2 /HfO2 sur Si revêtu de Pt et TiN ont été examinés. L'électrode inférieure en Pt a une valeur RMS plus petite de 0,39 nm que le TiN dérivé de PEALD de 0,87 nm. Par conséquent, l'échantillon de HfO2 /TiO2 /HfO2 sur Si revêtu de Pt présente également une surface relativement plus lisse avec une RMS de 0,68 nm que celle sur Si revêtu de TiN avec 1,3 nm.
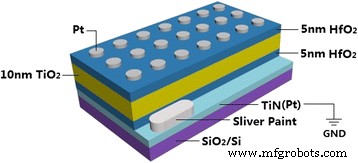
Le schéma du dispositif RRAM de HfO2 /TiO2 /HfO2 structure tricouche par ALD
Les courbes DC I-V de Pt/HfO2 /TiO2 /HfO2 /Pt et Pt/HfO2 /TiO2 /HfO2 Les dispositifs /TiN contenant le processus d'électroformage initial sont tracés sur les figures 2a, b, respectivement, indiquant une caractéristique de commutation résistive bipolaire typique. Pour presque tous les échantillons, une tension de formation plus élevée est nécessaire pour former des filaments conducteurs avant le test de commutation. Lors de l'application d'une tension de polarisation positive sur l'électrode supérieure Pt, le Pt/HfO2 /TiO2 /HfO2 L'unité de l'appareil /Pt montre une tension de formation de +7 V sur la figure 2a. En poursuivant le balayage de tension, une tension de réinitialisation de -0,8 V est mesurée pour la cellule unitaire de LRS à HRS et une tension de consigne de 2,0 V de HRS à LRS. Le rapport correspondant des résistances hautes et basses est d'environ 10 5 . Le processus d'électroformage et de repos peut également être complété en appliquant une tension négative de -11 V et une tension positive de +4 V, respectivement, qui sont beaucoup plus grandes que les tensions de formation positive et de réinitialisation négative. De plus, la cellule de l'appareil ne passe de LRS à HRS que pendant plusieurs cycles après le processus de formation négative, puis ne parvient pas à se réinitialiser à HRS en raison de la panne irréversible (non illustrée ici). Dans la Fig. 2b, par rapport à celle avec des électrodes supérieure et inférieure en Pt symétriques, les dispositifs RRAM à structure tricouche avec une électrode inférieure en TiN asymétrique et une électrode supérieure en Pt présentent une tension de formation inférieure opposée d'environ -3,7 V, une tension de consigne de -1,5 V , une tension de réinitialisation de +1,5 V et un rapport relativement plus faible de résistances haute et basse de 10 2 . Lors de l'imposition de la tension d'électroformage positive, le phénomène RS ne peut pas être observé dans le Pt/HfO2 /TiO2 /HfO2 /TiN et l'appareil est en panne en permanence à +14 V sans la réinitialisation efficace suivante de LRS à HRS à une tension négative (non illustrée ici).
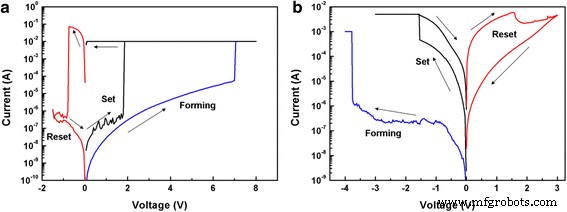
Les caractéristiques typiques de commutation résistive bipolaire des dispositifs RRAM. un Pt/HfO2 /TiO2 /HfO2 /Pt. b Pt/HfO2 /TiO2 /HfO2 /TiN
Les dispositifs RRAM à structure tricouche avec des électrodes supérieure/inférieure en Pt symétriques et des électrodes inférieures asymétriques en TiN/électrodes supérieures en Pt présentent une préférence de polarité d'électroformage si différente. L'électrode inférieure en Pt chimiquement inerte ou en TiN relativement actif semble jouer un rôle clé. La raison connexe de la polarité de l'électroformage dépendant de l'électrode sera discutée plus tard après avoir examiné les profils de profondeur XPS des structures tricouches de HfO2 /TiO2 /HfO2 sur Si revêtu de Pt et TiN.
Pour les applications de mémoire haute densité, l'uniformité des paramètres RS est très importante. La figure 3a, b trace les résultats statistiques de la distribution des tensions de réglage et de réinitialisation mesurées à partir d'une seule unité d'appareil du Pt/HfO2 /TiO2 /HfO2 /Pt et Pt/HfO2 /TiO2 /HfO2 /TiN pour 200 fois les tests, respectivement. La figure 3c, d enregistre les courbes I-V de 10 unités d'appareil sélectionnées au hasard du Pt/HfO2 /TiO2 /HfO2 /Pt et Pt/HfO2 /TiO2 /HfO2 /TiN, respectivement. Les unités de dispositif RRAM à structure tricouche avec des électrodes supérieure et inférieure en Pt symétriques présentent une large distribution pour une tension de consigne de 1,2 à 2,8 V et une tension de réinitialisation de -0,5 à -1 V (Fig. 3a) et des courbes I-V dispersives (Fig. 3c). Alors que les unités de l'appareil avec des électrodes inférieures et supérieures en Pt asymétriques TiN affichent un meilleur comportement RS, comme une distribution relativement concentrée de la tension définie de -0,8 à -1,8 V et une tension de réinitialisation de 1,3 à 1,8 V, et une reproductibilité stable dans les courbes I-V (Fig. 3b, d). Simultanément, par rapport à ceux sur Si revêtu de Pt, différentes unités de dispositif sur Si revêtu de TiN présentent également une monodispersion améliorée dans les paramètres RS, bénéfique pour les applications pratiques RRAM.

Les résultats statistiques de la distribution des tensions de réglage et de réinitialisation mesurées à partir d'un seul appareil pour 200 tests. un Pt/HfO2 /TiO2 /HfO2 /Pt. b Pt/HfO2 /TiO2 /HfO2 /Étain. Les courbes I-V de 10 unités d'appareil sélectionnées au hasard. c Pt/HfO2 /TiO2 /HfO2 /Pt. d Pt/HfO2 /TiO2 /HfO2 /TiN
Les propriétés d'endurance et de rétention des unités de l'appareil de Pt/HfO2 /TiO2 /HfO2 /Pt et Pt/HfO2 /TiO2 /HfO2 /TiN ont été examinés, comme le montrent les Fig. 4a–d, respectivement. En Pt/HfO2 /TiO2 /HfO2 /Pt, la tension de balayage a été appliquée de 0 à 3 V pour le réglage et de 0 à -1,5 V pour la réinitialisation. En Pt/HfO2 /TiO2 /HfO2 /TiN, la tension de balayage a été appliquée de 0 à -2 V pour le réglage et de 0 à 2 V pour la réinitialisation. Les valeurs de résistance ON et OFF ont été lues en utilisant 0,2 V à température ambiante. Les tests de rétention ont été mesurés à température ambiante avec une tension de lecture de 0,2 V. Après 200 cycles de programmation/effacement, Pt/HfO2 /TiO2 /HfO2 Les unités de l'appareil /Pt présentent un rapport de résistance relativement stable des états OFF/ON supérieur à 10 5 (Fig. 4a) ; cependant, la caractéristique d'endurance de Pt/HfO2 /TiO2 /HfO2 Les cellules mémoire /TiN ne semblent pas aussi bonnes que celles de Pt/HfO2 /TiO2 /HfO2 /Pt (Fig. 4b). Les états ON et OFF dans les appareils avec des électrodes Pt-TiN ne sont pas très stables avec un rapport de résistance plus petit des états OFF/ON d'environ 10 2 pendant le test de cycle de commutation, fluctuation de HRS particulièrement importante que celle de LRS. Basé sur le modèle physique de la Réf. [12], l'endurance sera améliorée en augmentant l'énergie de formation de lacune d'oxygène et d'interface O 2− quantité. Nous spéculons sur une explication plausible. Dans nos travaux précédents [14], d'excellentes propriétés de commutation résistive bipolaire de l'Al2 dérivé de l'ALD O3 /HfO2 /Al2 O3 des structures tricouches avec des électrodes inférieures asymétriques en TiN et supérieures en Pt ont été démontrées, y compris une meilleure endurance de commutation jusqu'à 10 3 cycles avec un rapport de résistance ON/OFF stable. Ici, nous avons adopté HfO2 /TiO2 /HfO2 configurer au lieu de Al2 O3 /HfO2 /Al2 O3 . Les ions métalliques dans HfO2 et TiO2 ont la même valence chimique identique de +4, conduisant à moins de défauts chargés à l'interface tels que les lacunes en oxygène entre deux couches interfaciales (IL) de la tricouche HfO2 /TiO2 /HfO2 . Alors que les ions métalliques dans Al2 O3 et HfO2 ont une valence chimique différente de Al 3+ et Hf 4+ , produisant plus de défauts chargés d'interface des lacunes d'oxygène entre deux IL d'Al2 O3 /HfO2 /Al2 O3 . On peut en déduire que l'interface O 2− montant en ajoutant deux IL entre Al2 O3 /HfO2 /Al2 O3 devrait être plus élevé qu'entre HfO2 /TiO2 /HfO2 . De plus, l'énergie de formation de la lacune d'oxygène dans la couche de stockage d'Al2 O3 /HfO2 /Al2 O3 est également supérieur à celui de HfO2 /TiO2 /HfO2 (énergie de formation du manque d'oxygène 7,08 eV (Al2 O3 ), 6,53 eV (HfO2 ) et 4,35 eV (TiO2 ) [20, 21]). Après avoir considéré ces facteurs, la cellule mémoire de Pt/HfO2 /TiO2 /HfO2 /TiN présente une dégénérescence d'endurance, par rapport à Pt/Al2 O3 /HfO2 /Al2 O3 /TiN.

Les caractéristiques d'endurance et de rétention des unités de l'appareil. un , c Pt/HfO2 /TiO2 /HfO2 /Pt. b , d Pt/HfO2 /TiO2 /HfO2 /TiN.
Pour Pt/HfO2 /TiO2 /HfO2 /Pt et Pt/HfO2 /TiO2 /HfO2 /TiN, le niveau de résistance des états ON et OFF n'a pas de changement évident après un temps d'attente cumulé de 10 4 s à température ambiante sur la Fig. 4c–d, indiquant une meilleure propriété de rétention des deux cellules mémoire sur 10 ans sur la base de la méthode d'extrapolation.
Pt/HfO2 /TiO2 /HfO2 Les appareils /TiN ont un rapport de résistance des états OFF/ON beaucoup plus faible que Pt/HfO2 /TiO2 /HfO2 /Pt, qui peut être attribué à la différence des électrodes inférieures en fonction de travail et en conductivité. Le travail de sortie des électrodes inférieures Pt et TiN est respectivement de 5,65 et 4,5 eV ; par conséquent, la barrière d'interface entre TiN et HfO2 sous-jacent est relativement plus faible dans le Pt/HfO2 /TiO2 /HfO2 /Périphérique TiN. Au cours d'un processus de réinitialisation, l'énergie nécessaire à l'électron pour traverser la barrière est également plus petite. Donc Pt/HfO2 /TiO2 /HfO2 /TiN manifeste une valeur de résistance inférieure à l'état OFF que Pt/HfO2 /TiO2 /HfO2 /Pt en conséquence. Au cours d'un processus défini, le dispositif RRAM passe de HRS à LRS en raison de la formation des canaux conducteurs. L'électrode inférieure en Pt a une conductivité plus élevée que l'électrode inférieure en TiN ; en conséquence, la valeur de résistance à l'état ON pour Pt/HfO2 /TiO2 /HfO2 /TiN est supérieur à celui de Pt/HfO2 /TiO2 /HfO2 /Pt. En conséquence, Pt/HfO2 /TiO2 /HfO2 Les appareils /TiN présentent un rapport de résistance des états OFF/ON inférieur à 10 2 . Cependant, le rapport de résistance de 10 2 a déjà satisfait aux exigences des applications RRAM.
Pour clarifier le mécanisme conducteur lors de la commutation résistive, les courbes I-V typiques sont retracées en échelle double logarithmique. La figure 5a, b montre l'ajustement linéaire des courbes I-V pour les régions de balayage de tension de Pt/HfO2 /TiO2 /HfO2 /Pt et Pt/HfO2 /TiO2 /HfO2 /Appareils TiN. Les deux cellules mémoire ont un mécanisme conducteur similaire. Lorsque l'appareil est commuté sur le LRS, les courbes de log (I)-log (V) sont linéaires avec une pente proche de 1 (0,94 dans la Fig. 5a, 0,98 dans la Fig. 5b), indiquant que l'I-V au Le LRS est dominé par la loi ohmique. Le modèle de filament de la migration des lacunes d'oxygène peut être utilisé pour expliquer le comportement de commutation. Pour le HRS, à basse tension (valeur absolue <0,11 V), l'I-V est dominé par la loi ohmique avec la relation linéaire du courant et de la tension (pente 1,05 sur la figure 5a, 1,09 sur la figure 5b). Dans une région de tension plus élevée (6,8 V > valeur absolue>0,11 V sur la figure 5a, 1,85 V > valeur absolue>0,11 V sur la figure 5b), la pente des lignes log (I)-log (V) est d'environ 2 et le courant dépend du carré approximatif de la tension appliquée (I/V 2 ). A la tension critique (valeur absolue 6,8 V sur la figure 5a, 1,85 V sur la figure 5b), une forte montée de courant apparaît soudainement avec une très grande pente. Ce résultat se compose de trois régions dans HRS, obéissant essentiellement à l'injection typique de conduction à charge limitée (SCLC) contrôlée par piège [11].
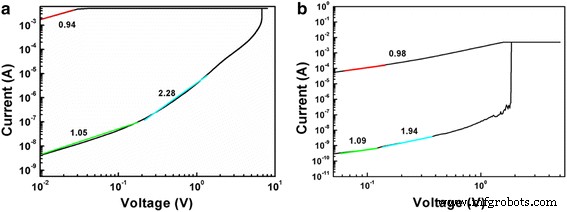
Les courbes I-V typiques tracées en échelle double logarithmique de a Pt/HfO2 /TiO2 /HfO2 /Pt et b Pt/HfO2 /TiO2 /HfO2 /TiN
Afin de mieux comprendre le mécanisme de commutation résistif sous-jacent de HfO2 /TiO2 /HfO2 sur Si revêtu de Pt et revêtu de TiN, nous avons effectué des balayages étroits XPS et des analyses de profondeur sur des structures tricouches avec des électrodes inférieures/supérieures symétriques et asymétriques. Les spectres XPS ont été équipés de fonctions gaussiennes-lorentziennes (G-L) après soustraction de fond de type intelligent.
La figure 6a–d illustre les spectres XPS à balayage étroit de Hf 4f , Ti 2p , et O 1s pics de HfO2 et TiO2 couches sur Si recouvert de TiN. Le Hf 4f et les spectres Ti 2p de HfO2 et TiO2 les couches peuvent être déconvoluées en deux groupes de pics. Le plus fort Hf 4f 5/2 et Hf 4f 7/2 les pics à 18,4 et 16,7 eV avec une séparation spin-orbite de 1,7 eV sont attribués à la liaison Hf–O (Hf 4+ ) de HfO2 (Fig. 6a). Les pics de doublet spin-orbite plus faibles à une énergie de liaison inférieure de 17,6 et 14,8 eV résultent peut-être de l'état de faible valence chimique de Hf n + –O (n < 4), indiquant la présence de lacunes d'oxygène dans HfO2 couche. La concentration calculée en pourcentage de Hf n + (n < 4) est d'environ 3,7 % en ions Hf. Sur la figure 6b, un doublet plus fort correspond à Ti 2p 3/2 et 2p 1/2 caractéristiques à 458,8 et 464,5 eV, appartenant à la liaison Ti-O (Ti 4+ ) de TiO2 . Un doublet plus faible se situe à 456,1 et 462,0 eV, attribué au Ti 3+ –O liaison. La concentration calculée en pourcentage de Ti 3+ est d'environ 21 % en ions Ti. Ceci implique l'existence de lacunes en oxygène dans TiO2 couche.
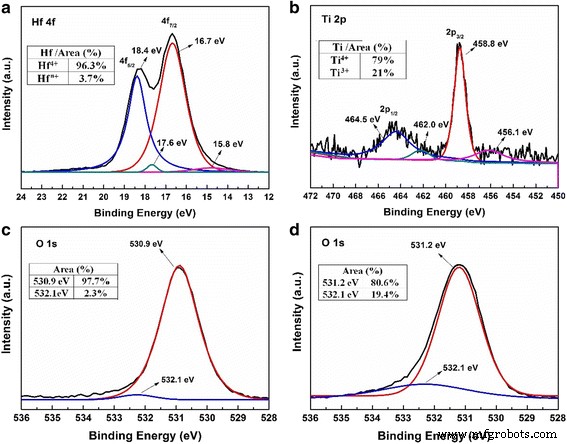
Spectres XPS à balayage étroit à partir de la structure tricouche de HfO2 /TiO2 /HfO2 sur Si recouvert de TiN. un Hf 4f, b Ti 2p pics de HfO2 /TiO2 /HfO2. O 1s pics de c HfO2 et d TiO2 calques
Les O 1s spectres de HfO2 et TiO2 les couches peuvent également être déconvoluées en deux pics, comme le montrent les Fig. 6c, d. Les énergies de liaison relativement plus faibles des O 1s les pics à ~530,9 et 531,2 eV sont attribués aux liaisons Ti-O et Hf-O dans TiO2 et HfO2 couches, respectivement, appartenant à l'oxygène du réseau sans lacunes d'oxygène. Alors que l'énergie légèrement plus élevée de 532,1 eV dans le O 1s les spectres de la Fig. 6c, d sont attribués aux atomes d'oxygène à proximité des lacunes d'oxygène dans HfO2 et TiO2 couches basées sur les rapports de la littérature [22,23,24,25]. La concentration relative de manque d'oxygène dans la couche d'oxyde peut être grossièrement évaluée en calculant la proportion de surface de chaque pic [22, 23]. La concentration calculée en pourcentage du manque d'oxygène dans HfO2 et TiO2 couches est d'environ 2,3 et 19,4 %, respectivement, en accord avec les résultats de Hf n + et Ti 3+ .
La figure 7a, b montre les profils de profondeur XPS de HfO2 /TiO2 /HfO2 échantillons sur Si recouvert de Pt et de TiN par gravure ionique Ar, respectivement. La structure tricouche de HfO2 /TiO2 /HfO2 sur Si revêtu de Pt et TiN peut être facilement reconnu, bien que la diffusion interfaciale significative entre HfO2 /TiO2 et HfO2 /TiN a été observé. Habituellement, le modèle de filament de migration des lacunes d'oxygène domine le comportement RS dans les dispositifs RRAM basés sur des oxydes de métaux de transition [11]. Cependant, la simple augmentation de la teneur en lacunes d'oxygène n'est pas pleinement efficace. Comment contrôler efficacement la distribution des filaments d'oxygène vacants est un problème clé pour enfin améliorer l'uniformité du RS [20]. De nombreux travaux ont montré qu'une distribution non uniforme des lacunes d'oxygène est généralement bénéfique pour les comportements RS, notamment en diminuant la tension de formation, en améliorant la stabilité de commutation et la capacité d'endurance [1, 14, 20, 26,27,28,29]. Une distribution initiale non uniforme des lacunes d'oxygène dans une couche d'oxyde de stockage est souvent obtenue par l'utilisation d'une électrode chimiquement active avec une affinité pour l'oxygène relativement élevée (par exemple, Ta, Ti, Al ou TiN) ou en introduisant délibérément une lacune riche en oxygène couche interfaciale par ingénierie d'interface [1, 17, 30].
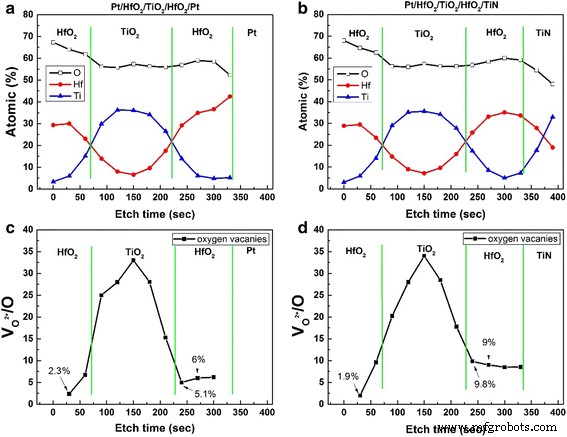
Profils de profondeur XPS de HfO2 /TiO2 /HfO2 sur Si revêtu de Pt et TiN par gravure ionique Ar. un HfO2 /TiO2 /HfO2 sur Si revêtu de Pt. b HfO2 /TiO2 /HfO2 sur Si recouvert de TiN. La distribution en profondeur de la concentration d'oxygène vacant (V O 2+ /O) déterminé à partir des spectres XPS pour HfO2 /TiO2 /HfO2 sur Si revêtu de Pt et TiN. c HfO2 /TiO2 /HfO2 sur Si revêtu de Pt. d HfO2 /TiO2 /HfO2 sur Si revêtu TiN
La figure 7c, d présente les courbes de distribution de la concentration d'oxygène manquant de HfO2 /TiO2 /HfO2 sur Si revêtu de Pt et de TiN sur la base des profils XPS de profondeur ci-dessus, respectivement. La concentration en manque d'oxygène a été évaluée en utilisant la méthode mentionnée ci-dessus. On peut constater que la concentration d'oxygène la plus élevée (~34%) apparaît dans TiO2 couche intermédiaire. Une autre caractéristique remarquable est que le HfO2 sous-jacent la couche près des électrodes inférieures de Pt ou de TiN a une concentration en oxygène vacante plus élevée que la couche supérieure de HfO2 couche (~2%). En outre, la concentration en manque d'oxygène (~9%) du HfO2 sous-jacent couche sur Si revêtu de TiN est évidemment supérieure à celle (~6%) sur Si revêtu de Pt.
La figure 8 montre les diagrammes schématiques de l'électroformage et de la réinitialisation de Pt/HfO2 /TiO2 /HfO2 /Pt aux tensions de polarisation positive et négative. Pour les électrodes supérieures et inférieures en Pt chimiquement inertes, les phénomènes d'électroformage dépendant de la polarité de polarisation sont liés à l'O2 gaz libéré de la couche d'oxyde à l'anode en tant que produit d'électroréduction. Comme on le sait, pendant le processus d'électroformage, des lacunes d'oxygène sont créées par un champ électrique élevé et migrent vers la cathode, formant des filaments conducteurs localisés dans la couche d'oxyde, c'est-à-dire O O →V O 2+ + O 2− , V O 2+ + 2e − →V O [12] (Fig. 8b, e). Simultanément, O 2− les ions dérivent vers l'anode, libérant leur charge et faisant évoluer O2 gaz, c'est-à-dire O 2− →1/2O 2 + 2e − (Fig. 8b, e), ce qui peut entraîner une déformation physique de la cellule et même la formation de fissure ou de trou [31]. Lors de l'application d'une tension de formation positive à l'électrode supérieure Pt, nous postulons le O2 gaz libéré au-dessus du HfO2 supérieur le film s'échappe facilement au niveau du bord supérieur de l'électrode ou à travers un petit nanopore dans l'électrode supérieure en Pt (Fig. 8b), ce qui provoque une faible déformation physique. Pendant ce temps, compte tenu de la concentration d'oxygène relativement plus élevée dans le HfO2 sous-jacent (~6%) à proximité de l'électrode inférieure Pt que le HfO2 supérieur couche (~ 2,3%) (Fig. 7c), le filament conducteur se forme facilement, conduisant à une tension de formation positive plus petite de +7 V. Avec une tension inverse de -0,8 V, la réaction inverse conduit à la rupture du filament et le dispositif est facilement ramené à l'état HRS (Fig. 8d).

Diagrammes schématiques de l'électroformage et de la réinitialisation de la structure tricouche de HfO2 /TiO2 /HfO2 avec électrodes supérieure et inférieure symétriques en Pt. un –d Electroformage à tension positive et remise à zéro à tension négative. e –g Electroformage à tension négative et remise à zéro à tension positive
Inversement, avec une tension de formation négative sur l'électrode supérieure, de l'oxygène gazeux se forme sous le HfO2 sous-jacent. couche et au-dessus de Pt l'électrode inférieure (Fig. 8e). Le O2 la libération devient plus difficile, ce qui gênera la formation de filaments conducteurs. De plus, parce que la concentration en manque d'oxygène du HfO2 supérieur couche (~2,3 %) est inférieure à celle du sous-jacent HfO2 (~6%) (Fig. 7c), la tension de formation négative plus élevée de -11 V est nécessaire pour former des filaments. Quand plus de O2 s'accumule jusqu'à une certaine pression sous le HfO2 sous-jacent , il jaillit éventuellement de la partie mécaniquement la plus faible des films minces, conduisant au trou dans les films d'oxyde ou à la séparation entre les films d'oxyde et l'électrode inférieure induite par la fissuration des bulles. Bien que l'appareil puisse être réinitialisé sur HRS à une polarisation de +4 V appliquée (Fig. 8g), la cellule mémoire se dégrade après plusieurs cycles de commutation. Dans nos échantillons, une partie de l'électrode supérieure a été soufflée après le processus de formage. Un scénario similaire de préférence de polarité d'électroformage a également été observé dans Pt/TiO2−x /Pt cellules RRAM bipolaires avec diverses preuves de déformation physique des jonctions [31, 32].
Pt/HfO2 /TiO2 /HfO2 Les dispositifs /TiN présentent une polarité d'électroformage assez différente de celle du Pt/HfO2 /TiO2 /HfO2 /Pt. Le LRS causé par l'électroformage peut être observé à la fois à une tension de polarisation négative et positive ; cependant, la réinitialisation effective de LRS à HRS ne peut être obtenue qu'à une tension de polarisation positive en Pt/HfO2 /TiO2 /HfO2 /Périphérique TiN. Une préférence similaire pour l'électroformage avec des électrodes Pt et TiN asymétriques a été observée dans certaines littératures avec diverses couches d'oxyde de stockage telles que HfO2 [33, 34], TiO2 [35], ZrO x /HfO y bicouche [22], et Al2 O3 /HfO2 /Al2 O3 tricouche [14]. Cependant, les explications associées sont divergentes ou font défaut.
Après avoir considéré l'activité chimique de l'électrode TiN avec l'oxygène [1, 30, 36] et la non-distribution de la concentration en oxygène vacant dans la structure tricouche de HfO2 /TiO2 /HfO2 basé sur les profils de profondeur XPS (Fig. 7), un mécanisme possible sur la préférence de polarité d'électroformage de Pt/HfO2 /TiO2 /HfO2 Les cellules /TiN sont proposées. La figure 9 montre les diagrammes schématiques de l'électroformage et de la réinitialisation de Pt/HfO2 /TiO2 /HfO2 /TiN aux tensions de polarisation négative et positive. L'électrode inférieure en TiN joue un rôle clé dans la polarité de l'électroformage. Kwak et al. ont rapporté que l'électrode TiN relativement active absorberait facilement les ions d'oxygène des films d'oxyde pour former TiO x N1−x (TiON) couche interfaciale [36]. La diffusion sévère de l'oxygène du HfO2 sous-jacent couche dans l'électrode inférieure de TiN a été confirmée dans notre échantillon par le profil de profondeur XPS (Fig. 7b). Pour Pt/HfO2 /TiO2 /HfO2 /Dispositif TiN, l'électrode TiN à haute affinité pour l'oxygène [34, 36] produit beaucoup de lacunes en oxygène dans le HfO2 sous-jacent couche près de l'électrode inférieure TiN. La concentration de lacunes en oxygène d'environ 9 % du HfO2 sous-jacent couche est beaucoup plus élevée que celle de ~6% dans le Pt/HfO2 /TiO2 /HfO2 /Pt appareil.
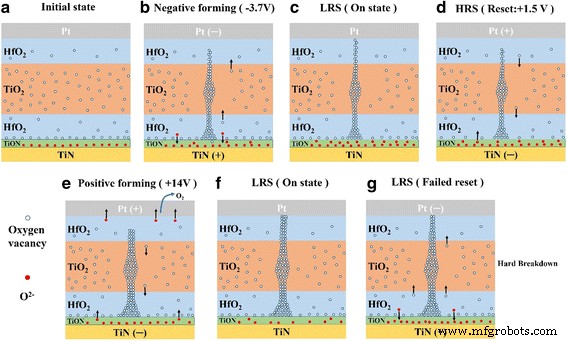
Diagrammes schématiques de l'électroformage et de la réinitialisation de la structure tricouche de HfO2 /TiO2 /HfO2 avec électrode supérieure Pt asymétrique et électrode inférieure TiN. un –d Electroformage à tension négative et remise à zéro à tension positive. e –g Electroformage à tension positive et remise à zéro à tension négative
Pour l'électrode supérieure en Pt chimiquement inerte et l'électrode inférieure en TiN relativement active, lors de l'application d'une tension de formation négative, O 2− les ions dérivent vers l'anode TiN et sont absorbés pour former TiO x N1−x couche (Fig. 9b), c'est-à-dire TiN + x O 2− →TiO x N 1−x + x 2e , en évitant le O2 libération et endommagement possible des cellules. L'électrode TiN pourrait agir comme un réservoir pour les ions oxygène dérivant sous une tension appliquée [1, 36]. Simultanément, en raison du manque d'oxygène plus élevé dans le HfO2 sous-jacent couche (~9%) et intermédiaire TiO2 (~10-34%) que le HfO2 supérieur (~1.9%), la migration des lacunes riches en oxygène du HfO2 sous-jacent couche à travers TiO2 couche vers le haut HfO2 couche, produisant directement des filaments de lacunes d'oxygène conducteurs avec une tension de formation plus petite de -3,7 V (Fig. 9b). Lors de l'exécution du processus de réinitialisation inverse à +1,5 V, l'électrode inférieure de la couche de TiN agissant comme réservoir d'oxygène fournit des ions d'oxygène pour réagir avec l'oxygène manquant, c'est-à-dire O 2− + V O 2+ →O O (oxygène du réseau), ce qui est bénéfique pour l'opération de réinitialisation de LRS à HRS avec rupture de filament conducteur (Fig. 9d). Surtout, l'effet de réservoir d'oxygène de l'électrode inférieure TiN contribue à la réduction de la tension de formation ainsi qu'à une meilleure variation de tension de réglage/réinitialisation [1, 29, 36].
D'autre part, en imposant la tension de formation positive sur l'électrode supérieure Pt, les lacunes d'oxygène migrent depuis le HfO2 supérieur dans le HfO2 sous-jacent sur TiN, s'accumulent dans son voisinage et se développent en filaments. En raison de la plus faible concentration en oxygène dans le HfO2 supérieur (~1,9 %) que le sous-jacent HfO2 couche (~9%) et intermédiaire TiO2 (~10-34%), cela conduit à une augmentation supplémentaire de la concentration d'oxygène manquant dans le HfO2 sous-jacent et intermédiaire TiO2 couche. Dans le même temps, en raison de la faible présence d'oxygène dans les films de TiN dérivés de PEALD (environ 10 %), certains ions d'oxygène du TiN dérivent vers le HfO2 sous-jacent. couche pour former un réseau isolant d'oxygène avec une lacune d'oxygène à proximité, empêchant la croissance de filaments conducteurs (Fig. 9e). Enfin, lorsque la tension de polarisation atteint +14 V, les filaments conducteurs grossissants en oxydes se forment. Cependant, lorsqu'une tension négative est appliquée sur l'appareil, le filament conducteur dans la structure tricouche est trop gros pour être rompu (Fig. 9g). Par conséquent, l'appareil ne peut pas passer en HRS en appliquant une tension négative, indiquant qu'une panne irréversible se produit en Pt/HfO2 /TiO2 /HfO2 /Appareil TiN.
Enfin, du fait que le TiO2 inséré couche stocke plus de lacunes d'oxygène que HfO2 couche, la distribution des lacunes d'oxygène dans la structure tricouche n'est pas uniforme, en particulier dans les deux couches interfaciales entre HfO2 /IL/TiO2 /IL/HfO2 , ce qui pourrait affecter la position de croissance, la direction et le chevauchement des filaments conducteurs. La liaison ou la rupture des filaments conducteurs correspond respectivement au processus d'établissement de HRS à LRS ou au processus de réinitialisation de LRS à HRS, qui se produit plus facilement dans deux couches interfaciales. De plus, la forme et la position des filaments conducteurs dans HfO2 et TiO2 les couches changent moins dans les processus de définition et de réinitialisation.
Conclusions
En résumé, les périphériques RRAM basés sur une structure à trois couches de Pt/HfO2 /TiO2 /HfO2 /Pt et Pt/HfO2 /TiO2 /HfO2 /TiN ont été préparés par ALD. Les deux cellules mémoire présentent des caractéristiques typiques de commutation résistive bipolaire et des mécanismes de conduction dominants ohmique et SCLC dans les LRS et HRS, respectivement. On constate que les électrodes inférieures de Pt et TiN ont une grande influence sur la préférence de polarité d'électroformage, le rapport des résistances haute et basse et la dispersion de la tension de fonctionnement des cellules de mémoire à structure tricouche. Par rapport aux électrodes supérieures/inférieures symétriques en Pt, les cellules RRAM avec électrodes inférieures asymétriques en Pt/TiN présentent une tension de formation négative plus petite de -3,7 V, une distribution relativement étroite des tensions de fonctionnement de réglage/réinitialisation et un rapport plus faible de résistances haute et basse de 10 2 . La polarité d'électroformage dépendant des électrodes peut être expliquée en considérant l'activité chimique des électrodes avec l'oxygène, les réactions associées à l'anode et la distribution non uniforme de la concentration d'oxygène vacant dans la structure tricouche de HfO2 /TiO2 /HfO2 sur Si revêtu de Pt et TiN. De plus, l'électrode TiN en tant que réservoir d'oxygène joue un rôle important dans la formation de la réduction de tension et une meilleure dispersion des paramètres RS pour Pt/HfO2 /TiO2 /HfO2 /Appareils TiN. Compte tenu de l'effet de modulation de l'électrode et de la structure tricouche sur les performances de commutation résistive, ce travail fournit une nouvelle voie de conception de dispositif pour les futures applications RRAM.
Nanomatériaux
- Technologies avancées de dépôt de couche atomique pour les micro-LED et les VCSEL
- Modèle de rétention de TaO/HfO x et TaO/AlO x RRAM avec caractéristiques de commutateur auto-rectifiant
- Caractéristiques d'alignement interfacial, électrique et de bande des piles HfO2/Ge avec une couche intermédiaire de SiO2 formée in situ par dépôt de couche atomique amélioré par plasma
- Les nanofibres hiérarchiques antibactériennes en polyamide 6-ZnO fabriquées par dépôt de couche atomique et croissance hydrothermale
- Une RRAM SRAM 4T intégrée avec charge de commutation résistive à auto-inhibition par un processus logique CMOS pur
- Effet de la distribution de nanoparticules d'or dans le TiO2 sur les caractéristiques optiques et électriques des cellules solaires à colorant
- Propriétés photocatalytiques des poudres de TiO2 revêtues de Co3O4 préparées par dépôt de couche atomique amélioré par plasma
- Réglage au niveau de Fermi des films ZnO par dépôt de couche atomique supercyclée
- Étude collective sur la modélisation et la simulation de mémoires résistives à accès aléatoire



