Points quantiques de bismuth dans des puits quantiques recuits GaAsBi/AlAs
Résumé
La formation de nanocristaux de bismuth dans des couches de GaAsBi cultivées par épitaxie par faisceau moléculaire à une température de substrat de 330 °C et recuite après la croissance à 750 °C est rapportée. Des super-réseaux contenant des couches alternées de GaAsBi et d'AlAs de 10 nm d'épaisseur ont été développés sur un substrat de GaAs semi-isolant. Les couches d'AlAs ont servi de barrières de diffusion pour les atomes de Bi, et la taille des nanoclusters qui ont nucléé après le recuit de l'échantillon était en corrélation avec l'épaisseur des couches de bismide. La spectroscopie à dispersion d'énergie et les mesures de diffusion Raman ont mis en évidence que les nanoparticules étaient majoritairement constituées d'atomes de Bi. Un fort signal de photoluminescence avec des longueurs d'onde de photons allant de 1,3 à 1,7 μm a été observé après recuit ; son amplitude augmentait avec l'augmentation du nombre de couches de GaAsBi. La bande de photoluminescence observée peut être due à l'émission de nanocristaux de Bi. Les estimations théoriques effectuées soutiennent l'hypothèse. Ils montrent qu'en raison de l'effet de taille quantique, les nanoparticules de Bi subissent une transition vers l'état semi-conducteur à bande interdite directe.
Contexte
Les hétérostructures à base de GaAsBi ont un grand potentiel pour les applications optoélectroniques dans une large gamme spectrale s'étendant du proche au moyen infrarouge. GaAsBi est un composé semi-conducteur du groupe III-V qui est activement étudié pour les émetteurs de rayonnement infrarouge à base de GaAs [1] et les détecteurs [2,3,4,5]. Lewis et al. [6] ; le laser au bismide injecté électriquement avec ~6% de Bi dans un puits multiquantique GaAsBi/GaAs (MQW) a été rapporté dans la réf. [sept]. La principale difficulté dans ce domaine est une augmentation de la densité de centre de recombinaison non radiative en raison des basses températures de substrat nécessaires à une croissance par épitaxie par faisceau moléculaire (MBE) de couches de GaAsBi avec une teneur en Bi supérieure à 5%. L'une des procédures technologiques standard permettant une réduction du taux de recombinaison non radiative est un recuit post-croissance à des températures supérieures à celles utilisées pour la croissance du MBE. Cependant, dans le cas de GaAsBi, l'effet du recuit n'est pas sans ambiguïté. Il a été montré précédemment par notre groupe [8, 9] que le recuit à des températures supérieures à 600 °C conduit à plusieurs nouvelles caractéristiques, dont la plus non négligeable est l'apparition dans certains des échantillons d'une photoluminescence (PL) assez intense. dans la gamme de longueurs d'onde de 1,35 à 1,5 μm, ce processus s'accompagnant de changements substantiels dans la couche épitaxiale de GaAsBi :une réduction de la teneur en Bi dans le réseau cristallin et l'apparition d'amas de taille nanométrique [9].
La croissance de nanostructures - nanofils, puits quantiques contraints ou points quantiques (QD) - est un moyen courant d'éviter le décalage de réseau entre un substrat et la couche épitaxiale qui y est développée. Les exemples les plus largement étudiés de QD basés sur des composés III-V sont les QD basés sur InGaAs- [10] et InGaN- [11] développés par la technique de Stranski-Krastanow [12]. Dans le cas de GaAsBi, un tel mécanisme de croissance n'est toujours pas réalisé. La nucléation d'amas liés au Bi dans des couches épitaxiées de GaAsBi recuit et leurs caractéristiques structurelles ont été systématiquement étudiées dans la Réf. [13]. Il a été montré que des nanoclusters de différentes structures et compositions cristallines - rhomboédriques As et Bi ainsi que des nanoclusters zinc-blende GaAsBi - nucléent dans les couches de bismide lors du recuit; leur taille varie entre 5 et 20 nm. Des amas rhomboédriques de bismuth pur ont été observés dans GaAsBi avec une teneur en Bi relativement importante (4,7 %) cultivée à basse température (200 °C) [13]. Dans notre étude précédente [9], une formation d'agrégats de Bi de taille nanométrique a été signalée dans le GaAsBi recuit à haute température avec une teneur en Bi supérieure à 6%. De plus, il a été supposé qu'en raison des effets de quantification de la taille, les nanoclusters de bismuth deviennent semi-conducteurs plutôt que semi-métalliques (comme c'est le cas dans les cristaux de Bi en vrac), et que la recombinaison radiative ayant lieu dans les clusters de Bi peut être responsable de l'émission à grande longueur d'onde observée dans les échantillons de GaAsBi recuits [9].
Le présent travail rend compte d'une formation de nanocristaux de Bi dans des puits quantiques recuits GaAsBi/AlAs. Les couches d'AlAs servaient de barrières à la fois pour un confinement des porteurs de charge et pour empêcher la diffusion de Bi à partir des couches de GaAsBi pendant une procédure de recuit. La présence de couches d'AlAs a assuré une nucléation de nanoparticules de Bi d'une manière plus contrôlée - leur distribution de taille était plus étroite et leur densité était plus élevée que dans les couches massives recuites [9]. Les échantillons obtenus ont été caractérisés par des mesures de microscopie électronique à transmission à haute résolution (HRTEM), PL et Raman. Les résultats de ces expériences indiquent une présence de nanocristaux de Bi purs dans les hétérostructures recuites. Les estimations théoriques effectuées confirment que les nanocristaux de Bi peuvent être transformés par les effets de quantification de la taille en semi-conducteurs à gap direct.
Méthodes
Les structures GaAsBi/AlAs MQW ont été développées sur des substrats semi-isolants GaAs (100) à l'aide d'un réacteur SVT-A MBE équipé de sources métalliques Ga, Al et Bi ainsi que d'une source de craquage à deux zones pour produire As2 . Le schéma de croissance MBE suivant a été utilisé. Tout d'abord, la couche tampon de GaAs (d'environ 100 nm) et la première barrière d'AlAs ont été développées en utilisant le mode de croissance MBE standard à la température élevée de 600 °C. Ensuite, la croissance a été interrompue et la température du substrat a été abaissée pour une croissance des barrières GaAsBi QWs et AlAs. Le mode d'épitaxie assistée par migration (MEE) a été utilisé pour le dépôt d'AlAs à la séquence de croissance suivante :une monocouche (ML) d'Al, 5 s d'interruption pour une migration d'atomes du groupe III, puis un apport de 1 ML d'As [14, 15 ]. Enfin, la structure MQW a été recouverte d'une couche de recouvrement GaAs de 5 nm d'épaisseur. La teneur en Bi dans les couches de GaAsBi a été déterminée à partir du (200)-réflexe du balayage XRD -2Θ et était d'environ 7 % pour les échantillons tels que cultivés.
Deux échantillons MQW différents ont été choisis pour les mesures. L'échantillon A MQW contient trois QWs GaAsBi de 10 nm d'épaisseur et un de 20 nm d'épaisseur de GaAsBi (croissance MBE à 330 °C) séparés par des barrières AlAs de 20 nm d'épaisseur (croissance MEE à la même température). L'échantillon B MQW contient 20 QW avec des couches de GaAsBi de 10 nm de large séparées par des barrières d'AlAs de 4 nm d'épaisseur cultivées dans des conditions similaires à celles utilisées pour la croissance de l'échantillon A. Le traitement à haute température des deux échantillons a été effectué dans le four de recuit thermique rapide (RTA) à la température de 750 °C pendant 180 s à température ambiante d'azote. Pour éviter la perte d'arsenic de la couche de surface, lors du recuit, les échantillons ont été recouverts d'une plaquette sacrificielle de GaAs.
L'analyse de surface par microscopie à force atomique a démontré des surfaces sans gouttelettes des structures MQW telles que développées et recuites. La rugosité de surface de la couche de couverture de GaAs était inférieure à 1 nm. Les mesures structurelles à haute résolution des nanoparticules, qui ont été formées dans les MQW après recuit de l'échantillon, ont été effectuées par FEI Tecnai G2 F20 X-TWIN TEM avec module STEM, équipé d'un détecteur de spectroscopie à dispersion d'énergie (EDS) à rayons X pour cartographie et un détecteur de champ sombre annulaire à grand angle (HAADF) pour l'imagerie à contraste Z. Un microscope à double faisceau FEI Helios Nanolab 650 équipé d'un manipulateur Omniprobe a été utilisé pour préparer les échantillons pour les mesures MET.
La figure 1 montre l'image STEM de l'échantillon A. L'image révèle évidemment de nombreuses nanoparticules, qui se sont formées dans des couches de puits quantiques de GaAsBi (QW) après recuit. Une corrélation évidente entre la taille des nanoparticules et la largeur des couches QW peut être tracée dans l'image. La corrélation met en évidence que les couches d'AlAs (régions les plus sombres) agissent effectivement comme des barrières empêchant une diffusion externe des atomes de Bi à partir des couches de GaAsBi. La cartographie élémentaire EDS d'une zone sélectionnée de l'échantillon obtenue simultanément avec l'imagerie HAADF montre (Fig. 2) que les nanocristaux formés sont principalement constitués d'atomes de bismuth.
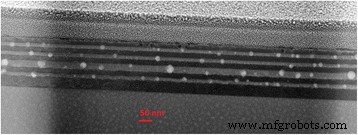
Image STEM de l'échantillon A avec trois barrières QW GaAsBi de 10 nm d'épaisseur et une de 20 nm d'épaisseur cultivées par MBE et des barrières d'AlAs cultivées par MEE de 20 nm d'épaisseur après recuit à une température de 750 °C pendant 180 s

Image de contraste HAADF-STEM Z de nanocristaux de Bi dans des structures GaAsBi/AlAs MQW (ci-dessus ). Les images EDS (ci-dessous ) représentent la cartographie élémentaire des intensités de Ga, Al, Bi et As, mesurées sur la zone marquée de l'image STEM
Résultats
Spectroscopie Raman
Les spectres Raman des échantillons GaAsBi MQW étudiés ont été enregistrés dans la géométrie de rétrodiffusion par un spectromètre Via Raman (Renishaw) équipé d'une caméra CCD refroidie thermoélectriquement (-70 °C) et d'un microscope. La ligne de rayonnement à 532 nm du laser à semi-conducteur pompé par diode a été utilisée pour une photoexcitation. L'objectif 50×/0,75 NA et le réseau 1800 lignes/mm ont été utilisés pour enregistrer les spectres Raman. Le temps d'accumulation était de 400 s. Pour éviter d'endommager l'échantillon, la puissance du laser sur l'échantillon a été limitée à 0,06 mW. Les fréquences Raman ont été calibrées à l'aide de l'étalon silicium (ligne à 520,7 cm −1 ). Les paramètres des modes vibrationnels ont été déterminés en ajustant les spectres expérimentaux avec des composants de forme gaussienne-lorentzienne à l'aide du logiciel GRAMS/A1 8.0 (Thermo Scientific).
Les spectres Raman de l'échantillon A de GaAsBi/AlAs MQW brut de croissance et recuit sont présentés sur la Fig. 3. Un doublet intense observé dans l'échantillon brut de croissance (Fig. 3, courbe verte) à 269 et 290 cm -1 correspond aux modes de phonons optiques transverses (TO) et longitudinales (LO) de type GaAs, respectivement [16,17,18]. Dans la géométrie de rétrodiffusion, la bande TO est symétriquement interdite pour le cristal GaAs idéal [17, 18], mais le désordre de la structure cristalline induit par Bi casse la symétrie du réseau cristallin GaAs et active le mode TO. Deux autres larges modes vibrationnels induits par Bi visibles à proximité de 227 et 181 cm −1 peut être attribué à des modes vibrationnels de type GaBi [18]. La présence de barrières AlAs peut être reconnue dans le spectre Raman à partir d'un mode LO net à 402 cm −1 [19].
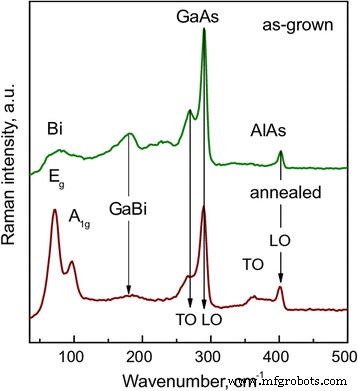
Spectres Raman de la croissance (courbe verte ) et recuit (courbe rouge ) GaAsBi MQW A-échantillon
Un recuit thermique relativement court (180 s) de l'échantillon à 750 °C induit des changements essentiels dans le spectre Raman :(i) des bandes de basses fréquences intenses apparaissent à 72 et 96 cm −1 , (ii) intensité des bandes proches de 269, 227 et 181 cm −1 diminue, et (iii) une large caractéristique proche de 361 cm −1 apparaît dans le spectre de l'échantillon recuit. Les deux bandes de basse fréquence à 72 et 96 cm −1 correspond bien à E g et A 1g modes du bismuth cristallin [20,21,22,23,24]. L'apparition de ces bandes accompagnée d'une diminution d'intensité des bandes de type GaBi induites par le Bi à 269 et 181 cm −1 montre que le recuit thermique provoque le retrait du bismuth des sites du réseau GaAsBi et son agglomération en nanocristaux de Bi. De plus, la formation de nanocristaux de bismuth affecte également la structure cristalline des couches d'AlAs, comme il ressort de l'apparition d'une large caractéristique TO induite par défaut près de 361 cm −1 [25].
Mesures de photoluminescence
Les mesures de photoluminescence (PL) dépendantes de la température ont été effectuées à l'aide d'un monochromateur de focale de 500 mm (Andor SR-500i) avec le photodétecteur InGaAs refroidi à l'azote liquide. Un laser à semi-conducteur pompé par diode émettant à la longueur d'onde de 532 nm a été utilisé comme source d'excitation à la puissance d'excitation de 38 mW. Les échantillons ont été montés sur le doigt froid d'un cryostat à hélium à cycle fermé couplé à un contrôleur de température, permettant des mesures dans la plage de température de 3 à 300 K.
Les spectres PL de l'échantillon A recuit, qui contient trois QW GaAsBi de 10 nm d'épaisseur et un de 20 nm d'épaisseur, mesurés à différentes températures, sont présentés sur la figure 4a. Deux ensembles principaux de caractéristiques spectrales en dessous de la bande interdite de GaAs peuvent être distingués. Un fort pic à haute énergie situé à environ 1,35 eV peut être attribué aux transitions radiatives dans les QW de GaAsBi. La position du pic est proche de celle observée dans GaAs0.979 Bi0,021 /GaAs quantum wells [26] et est en corrélation avec les données XRD qui indiquent une teneur en Bi de 2,1% dans les couches GaAsBi QW de l'échantillon A après son recuit. Les caractéristiques spectrales du côté basse énergie, 0,6-1,05 eV, apparaissent dans les spectres PL après un recuit thermique de l'échantillon et, par conséquent, peuvent être attribuées aux transitions optiques dans les nanocristaux de Bi. La bande PL à basse énergie a une structure interne, qui se révèle à basse température. À savoir, à T = 3 K, les composantes PL positionnées à 0,67, 0,88 et 0,98 eV peuvent être distinguées. Comme le montre la figure 4a, à la température de l'hélium liquide, le signal PL de GaAsBi QWs est de deux ordres de grandeur plus fort que la bande PL de basse énergie. Cependant, le pic PL à haute énergie diminue rapidement avec une augmentation de la température et le pic PL à basse énergie commence à dominer à T> 100 K.

Spectres PL dépendant de la température du recuit a Échantillon A composé de trois QW GaAsBi/AlAs de 10 nm de large et d'un de 20 nm de large et b Échantillon B composé de 20 QW GaAsBi/AlAs de 10 nm de largeur
Les spectres PL de l'échantillon B, qui contient vingt puits quantiques GaAsBi de 10 nm d'épaisseur séparés par des barrières en AlAs de 4 nm d'épaisseur, sont présentés sur la figure 4b. Avant le recuit thermique, comme c'était le cas pour l'échantillon A, l'échantillon B ne manifestait que la bande PL de plus haute énergie, liée à QW. Le fort pic de faible énergie PL à environ 0,85 eV a été observé après le recuit thermique et, par conséquent, nous supposons qu'il peut être attribué à l'émission de nanocristaux de Bi. L'intensité du pic de basse énergie dans l'échantillon B est plus forte que celle de l'échantillon A et augmente avec un nombre accru de QW. À basse température, trois composants du pic, qui étaient bien résolus dans l'échantillon A, peuvent être tracés. Cependant, dans l'échantillon B, le pic PL de basse énergie est dominé par sa composante de 0,85 eV dans toute la plage de températures étudiée. La position du pic PL de plus haute énergie, lié à QW, est légèrement décalée vers des énergies plus basses par rapport à sa position dans l'échantillon A conformément aux données XRD, qui indiquaient les 2,8% de Bi dans les couches de puits quantiques de l'échantillon B après son recuit thermique. Dans l'échantillon B, le pic PL lié à QW révèle sa structure interne. Le pic est constitué de la composante liée à l'exciton lié à environ 1,27 eV, qui domine à basse température, et de la composante liée à l'exciton délocalisé, qui se situe à environ 1,35 eV et domine à des températures plus élevées. La structure interne du pic lié à QW entraîne une dépendance caractéristique de la température de type S de la position du pic PL (points pleins sur la figure 5), qui a été observée précédemment à la fois dans le GaAsBi [27] et dans les puits quantiques GaAsBi/GaAs [26]. Le pic PL positionné à de faibles énergies de photons montre une dépendance à la température beaucoup plus faible (points ouverts et courbe sur la Fig. 5), qui peut être ajustée par la fonction de Varshni E (T ) = E (0) − αT 2 /(β + T ) avec les paramètres α et égaux à 10 −4 eV/deg et 100 K, respectivement. Il est à noter que la valeur du paramètre α, responsable de la variation de la bande interdite avec la température, est bien inférieure à ses valeurs standard pour une majorité de semi-conducteurs, 3°10 −4 –5°10 −4 eV/deg. Cela fait de la matrice de nanocristaux Bi un système potentiel important pour les sources lumineuses émettant aux longueurs d'onde des télécommunications et ayant une faible sensibilité à la température.

Dépendances en température des positions spectrales des bandes PL de haute et basse énergie pour l'échantillon B recuit composé de vingt QW GaAsBi/AlAs de 10 nm de large
Discussion
Les mesures de spectroscopie HRTEM, EDS et Raman effectuées dans la présente étude indiquent que les nanocristaux de Bi (points quantiques) précipitent dans les couches de GaAsBi après un recuit thermique des échantillons GaAsBi/AlAs MQW cultivés en MBE à basse température. On peut supposer que ces nanocristaux sont responsables de la bande de photoluminescence à grande longueur d'onde qui se révèle dans les échantillons recuits. Bien que le bismuth massif soit semi-métallique, les faibles masses effectives des porteurs de charge Bi entraînent une apparition précoce des effets de confinement quantique dans les nanostructures à base de Bi. En fait, l'une des premières observations expérimentales des effets de quantification de la taille a été rapportée pour des couches minces de Bi [28]. Transition semi-métal-semi-conducteur dans les couches minces de Bi, d < 30 nm, a été observé expérimentalement dans la réf. [29]. La transition a également été révélée dans des nanofils de Bi de diamètre inférieur à 65 nm [30, 31]. Dans ces deux cas, l'état semi-conducteur a été identifié à partir de mesures des caractéristiques électriques dépendantes de la température. L'effet de taille quantique dans les nanoparticules de bismuth a été étudié pour la première fois par spectroscopie de perte d'énergie électronique [32], et la transition semi-métal à semi-conducteur s'est produite dans les nanoparticules de Bi avec des diamètres inférieurs à 40 nm. La transition vers l'état semi-conducteur direct a été récemment rapportée [33] pour les nanoparticules de Bi colloïdales à 3,3 nm.
Dans le Bi pur, les principales vallées d'électrons et de trous sont situées au L et T points de la zone de Brillouin et correspondent à des surfaces isoénergétiques ellipsoïdales (tableau 1). L'état fondamental des électrons de la vallée ellipsoïdale (trous) dans une boîte quantique sphérique peut être approximativement estimé comme
$$ W=\frac{\pi^2{\hslash}^2}{2\overline{m}{r}_0^2}\ . $$ (1)Ici r 0 est le rayon QD et \( \overline{m} \) est la masse effective inverse moyenne,
$$ \frac{1}{\overline{m}}=\frac{1}{3}\left(\frac{1}{m_1}+\frac{1}{m_2}+\frac{1}{ m_3}\droit), $$ (2)m 1 , m 2 , et m 3 sont les principales masses effectives de la vallée ellipsoïdale.
La formule phénoménologique (1) donne une estimation précise du niveau d'énergie du sol ε1 dans un QD sphérique infiniment profond à des rapports arbitraires des masses effectives. En effet, c'est exact, ε1 = W , dans le cas d'une surface isoénergétique sphérique (m 1 = m 2 = m 3 ), prédit le ε1 énergie avec une précision de 12%, ε1 ≈ 0.88 W , et 25%, ε1 = 0,75 W , dans les cas limites de vallée sphéroïdale fortement allongée (m 1 = m 2 , m 3 → ∞) et sphéroïdale fortement aplatie (m 1 = m 2 , m 1 → ∞), respectivement. Par conséquent, à des valeurs arbitraires des principales masses effectives, la formule (1) se rapproche de l'énergie du sol QD avec une précision supérieure à 25 %.
La formule (1) permet une évaluation simple et directe des écarts énergétiques effectifs dans les points quantiques de bismuth, E g,eff = E g + W e + W h , où E g est un écart d'énergie dans un cristal massif et W e et W h sont les énergies de quantification de la taille des électrons et des trous (1). Le T effectif calculé et L les écarts d'énergie sont présentés graphiquement sur la figure 6. (Les masses des électrons et des trous à la fois T et L les points ont été supposés égaux.)

Evolution avec le spectre d'énergie Bi QD avec une diminution de sa taille (r 0 et d sont le rayon et le diamètre QD)
Dans le bismuth semi-métallique en vrac, la bande de conduction minimale du L la vallée est à 38 meV en dessous du T bande de valence maximale. Lorsqu'une taille de particules Bi est réduite, la bande interdite d'énergie effective au L le point augmente plus rapidement que celui au T point en raison des masses efficaces plus petites du L -valley, ce qui conduit finalement à la transition semi-métal à semi-conducteur (le i -point de croisement sur la Fig. 6). Au début, un nanocristal de bismuth devient le semi-conducteur indirect avec le minimum de bande de conduction le plus bas au L point et le maximum de la bande de valence la plus élevée au T point. Avec une nouvelle diminution de la taille du QD, les bords de la bande de valence et de conduction émergeront au T points faisant du Bi QD un semi-conducteur à gap direct (le d -point de croisement sur la Fig. 6).
Il convient de noter que la figure 6 ne présente qu'un schéma approximatif du spectre d'énergie, car le schéma ne tient pas compte des effets de non-parabolicité et suppose les barrières énergétiques infinies pour les QD. Un écart par rapport à la loi de dispersion parabolique est indispensable pour le L -valley (voir par exemple, [34]). En effet, les masses effectives au L -centre de la vallée sont environ cinq fois plus petites que leurs valeurs à l'énergie de Fermi (qui ont été utilisées pour les calculs du spectre d'énergie présenté sur la Fig. 6). En revanche, les effets de non-parabolicité sont plus faibles au T points, où la bande interdite d'énergie est plus grande, et par conséquent, le T effectif présenté l'écart énergétique (Fig. 6) peut être considéré comme son estimation pertinente.
Ci-dessus, nous avions supposé que le pic PL de basse énergie à ~0,85 eV était dû aux transitions optiques qui se produisent dans les nanocristaux de Bi d'un diamètre d'environ 10 nm. Les calculs présentés pour le d = 10 nm QDs prédisent le E g,eff = 0,76 eV d'écart énergétique effectif, ce qui est en accord raisonnable avec l'expérience et, par conséquent, soutient l'hypothèse hypothétique de l'origine du pic PL de basse énergie.
Conclusions
En résumé, plusieurs structures de puits quantiques à couches de GaAsBi/AlAs ont été développées par un procédé MBE/MEE mixte sur des substrats de GaAs. Après recuit thermique post-croissance des structures à 750 °C, de nombreuses nanoparticules relativement peu dispersées ont été nucléées dans des puits quantiques de GaAsBi. Les mesures de spectroscopie HRTEM, EDS et Raman montrent que les nanocristaux sont majoritairement composés de bismuth. Les mesures de photoluminescence effectuées révèlent un pic PL supplémentaire de faible énergie, ≈ 0,85 eV, qui apparaît dans les échantillons recuits. Le pic de faible énergie PL peut probablement être dû à des transitions optiques dans les nanocristaux de Bi, qui par les effets de taille quantique sont transformés en l'état semi-conducteur à bande interdite directe. Les estimations effectuées du spectre d'énergie des points quantiques Bi soutiennent l'hypothèse. Des travaux expérimentaux et théoriques plus poussés et plus détaillés sont nécessaires pour une réponse définitive.
Abréviations
- EDS :
-
Spectroscopie à dispersion d'énergie
- HAADF :
-
Fond noir annulaire grand angle
- HRTEM :
-
Microscopie électronique à transmission haute résolution
- MBE :
-
Epitaxie par faisceau moléculaire
- MEE :
-
Epitaxie améliorée par la migration
- PL :
-
Photoluminescence
- QD :
-
Point quantique
- QW :
-
Puits quantique
- RTA :
-
Recuit thermique rapide
- STEM :
-
Microscopie électronique à transmission à balayage
- TO et LO :
-
Modes de phonons optiques transverses et longitudinaux, respectivement
Nanomatériaux
- N,N-diméthylformamide régulant la fluorescence des points quantiques MXene pour la détermination sensible de Fe3+
- Synthèse de points quantiques de carbone co-dopés en pyridinique N, S en tant qu'imitateurs d'enzymes efficaces
- Synthèse verte de points quantiques InP/ZnS Core/Shell pour une application dans des diodes électroluminescentes sans métaux lourds
- Une approche simple pour la synthèse de points quantiques de carbone fluorescent à partir d'eaux usées de tofu
- Synthèse de points quantiques de sulfure d'antimoine solubles dans l'eau et de leurs propriétés photoélectriques
- Synthèse sonochimique en une étape facile et propriétés photocatalytiques des composites graphène/Ag3PO4 Quantum Dots
- Élimination de la taille bimodale dans les points quantiques InAs/GaAs pour la préparation de lasers à points quantiques de 1,3 μm
- Dépendance de l'épaisseur de la coque du transfert d'énergie interparticulaire dans le dopage des points quantiques Core-Shell ZnSe/ZnSe avec Europium
- Photoconductivité interbande des points quantiques métamorphiques InAs/InGaAs dans la fenêtre 1,3–1,55 μm



