Co-dosage d'ozone et d'eau désionisée en tant que précurseurs oxydants de la croissance de couches minces de ZnO par dépôt de couche atomique
Résumé
Caractéristiques des couches minces de ZnO cultivées par dépôt de couche atomique (ALD) sur des substrats de saphir avec et sans ozone à trois impulsions (O3 ) en tant que précurseur d'oxydant et le recuit thermique post-dépôt (TA) sont étudiés. La température de dépôt et l'épaisseur des épicouches de ZnO sont respectivement de 180 °C et 85 nm. Le recuit thermique post-dépôt est réalisé à 300 °C dans l'ambiance d'oxygène (O2 ) pendant 1h. Avec oxydant fort O3 et post-dépôt TA dans la croissance du ZnO, la contrainte intrinsèque et le stress sont réduits à 0,49% et 2,22 GPa, respectivement, avec une concentration d'électrons de fond extrêmement faible (9,4 × 10 15 cm −3 ). Ceci est dû à une densité plus faible de défauts activés thermiquement dans les analyses de trempe thermique des spectres d'intensité intégrée de photoluminescence (PL). Le TA facilite en outre la recristallisation en formant plus de grains sans défaut, puis réduit la déformation et l'état de contrainte, provoquant une diminution remarquable de la concentration électronique et une amélioration de la rugosité de la surface.
Introduction
Plusieurs agents oxydants sont utilisés dans la croissance de ZnO. Ils comprennent l'eau (H2 O), peroxyde d'hydrogène (H2 O2 ), l'oxygène (O2 ) et l'ozone (O3 ) [1,2,3,4,5,6]. H2 O est un oxydant couramment utilisé dans la croissance de ZnO avec dépôt de couche atomique (ALD). L'ALD est un mécanisme de croissance auto-limitant couche par couche. Des ligands de surface spécifiques échangent des réactions avec une impulsion séquentielle de précurseurs respectifs. Les réactions de surface s'arrêtent et se saturent lorsque les sites réactifs de la surface sont complètement épuisés. La croissance ALD de films minces présente des avantages tels qu'un dépôt conforme supérieur sur les surfaces et les régions latérales, d'excellentes couvertures d'étapes des bords, une uniformité élevée sur une grande surface, une précision dans le contrôle de l'épaisseur de la couche et une faible température de dépôt [7,8,9] .
Les agents oxydants forts influencent non seulement les structures matérielles mais les caractéristiques optoélectriques du ZnO déposé par ALD. H2 O2 l'oxydant fournit des conditions plus riches en oxygène que le H2 couramment utilisé O précurseur pour passiver les défauts de manque d'oxygène (VO ) et les interstitiels de zinc (Zni ) dans des films de ZnO cultivés par ALD à des températures de croissance basses de 80 à 150 °C. Des morphologies de surface colonnaires avec (002) orientation préférentielle du plan de croissance se sont produites lorsque l'utilisation de l'oxydant est modifiée par rapport à H2 O à H2 O2 [2]. H2 O2 l'oxydant augmente les taux de croissance d'environ 70 % par rapport à l'utilisation de O3 réactif gazeux de ZnO cultivé par ALD à 200 °C. L'augmentation de la densité des groupes hydroxyle (OH) sur la surface de croissance des films est responsable de l'augmentation des taux de croissance [3]. L'augmentation du taux de croissance de ZnO d'environ 60% pour l'utilisation d'O2 pur au lieu de H2 O en tant qu'oxydant est également signalé [4].
O3 est un oxydant efficace dans les matériaux d'oxyde cultivés par ALD. Le potentiel électrochimique élevé de O3 donne lieu à des vitesses de réaction rapides à basse température de croissance. O3 est plus volatile que H2 O, H2 O2 , et O2 , et il est plus facile à purger. Par conséquent, les temps de purge dans chaque cycle peuvent être raccourcis. L'absence d'hydrogène dans O3 molécule conduit à moins de contamination par l'hydrogène et l'hydroxyle dans la croissance. Une épaisseur moins uniforme en raison de la perte de surface recombinée de ZnO est indiquée pour 10 s de O3 temps d'exposition lorsque la croissance est à 200 °C [5]. Films ZnO non dopés préparés par ALD avec O3 les agents oxydants présentent un double facteur de puissance thermoélectrique par rapport aux échantillons avec H2 oxydant. H2 O- et O3 -les films de ZnO cultivés ont les mêmes niveaux de défauts de VO mais différents niveaux de défauts liés au Zn. Pouvoir d'oxydation suffisant de l'O3 entraîne une teneur inférieure en Zni natif et donc un facteur de puissance thermoélectrique plus important. Fort effet oxydant de O3 élève les performances thermoélectriques des films de ZnO non dopés [6]. Co-dosage O3 et H2 O pourrait améliorer l'uniformité et la conformité du film mince de ZnO pour des processus ALD appropriés [5].
Des souches intrinsèques et extrinsèques existent dans un film de ZnO cultivé naturellement sur un substrat de saphir. La contrainte intrinsèque provient d'imperfections cristallographiques à haute densité dans le ZnO. Les imperfections cristallographiques comprennent les complexes d'hydrogène, les interstitiels de zinc (Zni ), les lacunes en oxygène (VO ), les dislocations de filetage (TD) et les joints de grains (GB) [10,11,12,13,14,15,16,17,18,19,20,21]. La contrainte extrinsèque est générée à partir d'une grande inadéquation des constantes de réseau et des coefficients de dilatation thermique entre l'épicouche de ZnO et le substrat de saphir. Diverses manières sont exercées pour diminuer la contrainte intrinsèque et extrinsèque des matériaux ZnO sur les saphirs. Une fine couche tampon de MgO peut diminuer la contrainte extrinsèque, réduire la rugosité de surface de 58,8 % et supprimer les fissures superficielles du film mince de ZnO sur le saphir [22]. La déformation extrinsèque de ZnO sur le saphir est complètement relâchée avec une épaisseur atteignant 30 nm préparée par dépôt par pulvérisation magnétron à 550 °C [23]. La relaxation de la contrainte de compression de 1,77 à 1,47 GPa de films de ZnO déposés par la méthode de pyrolyse par pulvérisation avec l'augmentation des températures du substrat de verre de 350 à 450 ° C est présentée [24].
ALD ZnO cultivé à 180 °C avec des précurseurs à une impulsion (DEZn et H2 O) montre une concentration d'électrons de fond aussi élevée que ~ 10 18 cm −3 même avec une TA post-dépôt [25]. H2 à une impulsion couramment utilisé Les précurseurs O des processus ALD ne génèrent pas de monocouche idéale d'atomes d'oxygène. Précurseurs à trois impulsions (DEZn et H2 O) pourrait générer de multiples impacts ou collisions de molécules précurseurs avec un ligand de surface pour favoriser la probabilité de réaction pour l'ALD ZnO cultivé à basse température 100 ° C. Le choix de « trois » impulsions permet de sécuriser les réactifs en localisant correctement le site de chimisorption ou de réaction ouvert. Concentration électronique de fond extrêmement faible 8,4 × 10 14 cm −3 , mobilité de dérive électronique élevée 62,1 cm 2 /Vs, et une amélioration prononcée de la photoluminescence (PL) près du bord de la bande interdite (NBE) des précurseurs à trois impulsions ZnO avec une couche tampon appropriée et des conditions RTA sont acquises [26]. Plusieurs rapports montrent une amélioration de la qualité des matériaux des films minces de ZnO et des puits quantiques multiples de ZnO/ZnMgO avec recuit thermique [27, 28]. Dans ce rapport, O3 à trois impulsions et une impulsion suivante H2 O en tant qu'oxydants par cycle ALD sont utilisés pour faire croître des films minces de ZnO à 180 °C. Un recuit thermique post-dépôt (TA) est appliqué pour améliorer la qualité cristalline des échantillons. Les caractéristiques des matériaux micro- et nano-structurels, de photoluminescence et d'effet Hall des films minces de ZnO cultivés par ALD sont explorées.
Méthodes expérimentales
Les épicouches de ZnO sont déposées sur du saphir conventionnel à face c (c-Al2 O3 ) substrats par le système Cambridge NanoTech Savannah 100 ALD. Dans la croissance de films minces ALD ZnO, précurseurs comprenant le H2 déionisé (DI) O, O3 , et le diéthyl zinc (DEZn, Zn(C2 H5 )2 ) sont utilisés. Le tableau 1 montre les conditions du nombre d'impulsions de O3 et post-dépôt TA de trois spécimens nommés A, B et C. Un diagramme schématique de la séquence d'impulsions avec le temps par cycle ALD d'échantillons est affiché sur la figure 1. Sur cette figure, un cycle ALD contient six étapes séquentielles. La première étape est l'injection de H2 désionisé (DI) à une impulsion O dans un réacteur à l'échelle métrique pour fabriquer une surface à terminaison hydroxyle (OH) sur du saphir ou pour réagir avec les groupes éthyle pendants (C2 H5 ) formant des ponts zinc-oxygène (Zn–O) sur la surface de Zn avec des groupes de surface hydroxyle. Une couche atomique d'oxygène (O) est produite. La deuxième étape est la purge d'azote gazeux de haute pureté (N2 ) pour éliminer les molécules précurseurs en excès et les sous-produits volatils et pour empêcher le mélange des précurseurs ultérieurs après chaque exposition de réactifs. La troisième étape est l'injection d'O3 à trois impulsions dans des réacteurs pour faciliter la réduction des défauts natifs. La quatrième étape est la purge de la chambre par N2 gaz. La cinquième étape est l'injection de DEZn à une impulsion dans des réacteurs pour produire une couche atomique de zinc (Zn) sur la couche d'oxygène. La dernière étape est également la purge de la chambre par N2 gaz. Précurseurs puisés dans la chambre de réaction par le gaz de transport N2 avec une pression de chambre de 4 × 10 −1 Torr. La condition optimale de temps d'exposition pour les réactifs DI H2 O, O3 , et DEZn est de 0,01, 0,5 et 0,015 µs, respectivement. Le temps d'impulsion de l'évacuation de la chambre est de 5µs. L'épaisseur des films minces de ZnO est de 85 nm avec 500 cycles ALD de chaque échantillon. D'autres conditions favorables de paramètres de dépôt sont présentées dans les rapports précédents [29]. Post-dépôt TA à 300 °C dans l'ambiance de O2 pendant 1 h dans un four est traité sur l'échantillon C.
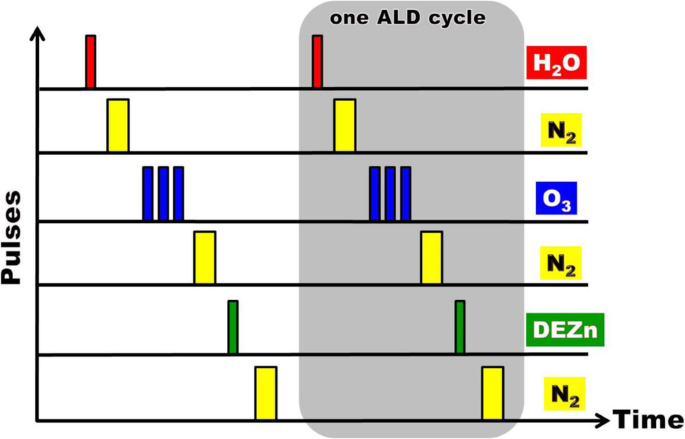
Films de ZnO cultivés par ALD sur des substrats de saphir avec séquence d'impulsions H2 O/N2 /O3 /N2 /DEZn/N2 en utilisant de l'eau déionisée, O3 , et Zn(C2 H5 )2 comme précurseurs
Les propriétés structurelles, optiques et électriques du matériau des échantillons sont déterminées par les mesures suivantes. Les diagrammes de diffraction des rayons X (XRD) sont mesurés avec un angle de diffraction (2θ ) gamme de 33 à 38° et longueur d'onde 0,154 nm de rayonnement Kα de cuivre en utilisant l'instrument D2 phaser (Bruker Corporation). La mesure de l'effet Hall utilise le système Ecopia HMS-3000, et les spécimens sont découpés en carrés ayant une superficie de 0,7 × 0,7 cm 2 . Les quatre coins des spécimens sont soudés par de petites gouttes d'indium montrant des contacts ohmiques en configuration van der Pauw. La densité de support de feuille, la mobilité et la résistivité des films sont mesurées. Les spectres de photoluminescence (PL) sont réalisés de 10 à 300 K avec une longueur d'onde d'excitation de 325 nm et une puissance de 55 mW de laser He-Cd. La trempe thermique de l'intensité intégrée des spectres PL avec l'augmentation de la température est analysée. La texture de surface et la rugosité des spécimens examinés à partir d'images haute résolution du microscope à force atomique (AFM) sont prises par l'instrument Veeco Dimension 3100.
Résultats et discussion
La figure 2 démontre la nature cristalline des spécimens par les mesures de motifs XRD. Deux pics de diffraction de Bragg (002) et (101) correspondent à la structure wurtzite hexagonale du ZnO. L'intensité de pic la plus forte des modèles XRD est normalisée pour la comparaison de l'intensité de pic entre les échantillons. Deux flèches vertes indiquées sur l'axe horizontal supérieur montrent les angles de diffraction 34,4° et 36,2° de (002) et (101), respectivement, du ZnO en vrac sans déformation acquis à partir des ensembles de données de matériaux publiés par l'organisation du Comité mixte sur la diffraction des poudres Normes (JCPDS). Sur la figure, on peut observer les pics (002) et (101) dans l'approche des échantillons B et C et approcher davantage les angles de diffraction de (002) et (101) du ZnO en vrac sans déformation.

Modèles XRD de films de ZnO avec des orientations cristallines le long des directions (002) et (101) des spécimens. Les flèches indiquent les angles de diffraction 34,4° et 36,2° de (002) et (101) du ZnO en vrac, respectivement
Déformation biaxiale le long du c -L'axe des couches épitaxiales peut être obtenu par le décalage des motifs XRD le long de (002) contrairement au ZnO massif sans contrainte. Contrainte moyenne (ε z ) dans le réseau des films de ZnO est estimée à partir des paramètres du réseau en utilisant l'expression suivante.
$$ {\varepsilon}_z=\frac{c-{c}_0}{c_0}\times 100\% $$ (1)où c et c 0 sont les constantes de réseau le long du c -axe calculé à partir des angles de diffraction de Bragg des pics (002) des films de ZnO et du volume. Le stress moyen (σ ) dans le plan des films peut être calculé à l'aide du modèle de déformation biaxiale :
\( \sigma =\frac{2{c}_{13}^2-{c}_{33}\gauche({c}_{11}+{c}_{12}\right)}{c_ {13}}\times {\varepsilon}_z=-453.6\times {\varepsilon}_z\left(\mathrm{GPa}\right) \) (2)où c 11 =209,7 GPa, c 12 =121.1 GPa, c 13 =105,1 GPa, et c 33 =210,9 GPa sont les constantes de rigidité élastique du ZnO en vrac. Dans le tableau 1, les déformations/contraintes (ε z /σ ) des échantillons A, B et C sont de 1,08 %/4,90 GPa, 0,74 %/3,37 GPa et 0,49 %/2,22 GPa, respectivement. La déformation/le stress est réduit et encore réduit dans les échantillons B et C.
Les spectres PL à diverses températures de 10 à 300 K d'échantillons sont affichés sur la Fig. 3. Une forte recombinaison radiative près du bord de la bande des excitons avec une énergie spectrale de pic autour de 3,34 eV est dominante dans les spectres PL de tous les échantillons. Une émission optique assistée par phonons optique longitudinale (LO) est observée à l'épaulement d'énergie inférieure des spectres PL des échantillons. Sur la figure 4a–c, il présente le tracé d'Arrhenius de l'intensité intégrée des spectres PL en fonction de l'inverse de la température. La trempe thermique de l'intensité intégrée de PL avec une température croissante peut être ajustée par la formule d'Arrhenius suivante.
$$ I(T)=\frac{A}{1+{D}_{nr1}\exp \left(\frac{-{E}_{A1}}{k_{\mathrm{B}}T} \right)+{D}_{nr2}\exp \left(\frac{-{E}_{A2}}{k_{\mathrm{B}}T}\right)} $$ (3)où je (T ) représente l'intensité PL intégrée. Un est une constante. D nr 1 et D nr 2 sont des constantes liées à la densité des centres de recombinaison non radiatifs. E A 1 et E A 2 sont les énergies d'activation correspondant au processus de recombinaison non radiative des excitons liés au donneur à basse température et des excitons libres à haute température, respectivement. k B est la constante de Boltzmann. La méthode des moindres carrés dans l'analyse de régression est utilisée pour ajuster les données montrant les paramètres de D nr 1 , D nr 2 , E A 1 , et E A 2 avec des courbes d'ajustement rouges dans le tableau 2 et les figures 4a–c. Le résultat de l'ajustement montre que les variations de D nr 1 , E A 1 , et E A 2 parmi les échantillons sont légers. D nr 2 sont 132,7, 153,6 et 110,8 des échantillons A, B et C, respectivement, montrant une grande différence dans la quantité de densité de défauts. La plus petite valeur de D nr 2 suggère la plus faible densité de défauts activés thermiquement dans l'échantillon C.
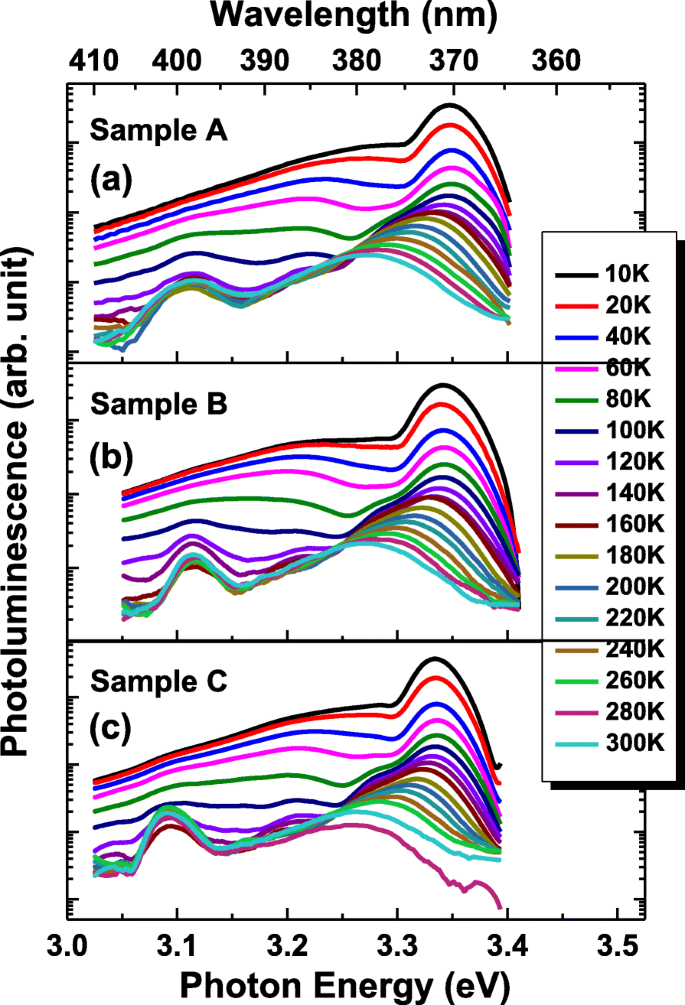
un –c Spectres PL des échantillons dépendant de la température
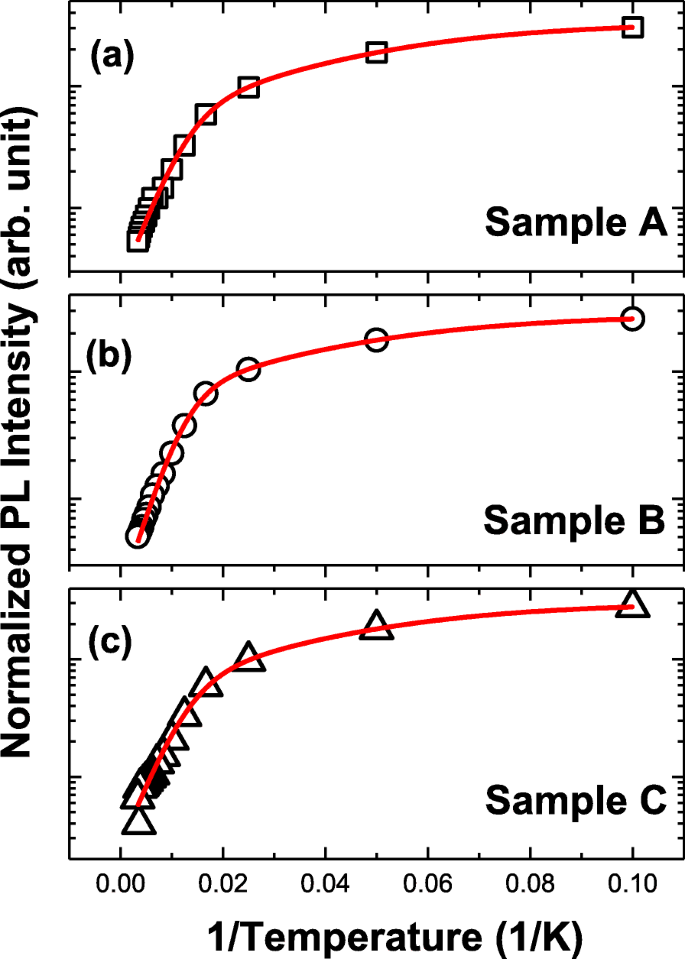
un –c Tracés d'Arrhenius de l'extinction thermique de l'intensité intégrée des spectres PL et des courbes d'ajustement rouges des échantillons
La concentration d'électrons de fond, la mobilité et la résistivité des mesures de l'effet Hall des échantillons sont répertoriées dans le tableau 2. Dans l'échantillon B, une diminution de deux ordres de grandeur de la concentration des porteurs avec une réduction de la mobilité est indiquée par rapport à l'échantillon A. Diminution considérable supplémentaire de la concentration des porteurs à la valeur la plus faible de 9,4 × 10 15 cm −3 et la montée en puissance de la mobilité à une valeur de 6,1 cm 2 /Vs sont observés dans l'échantillon C par rapport à l'échantillon B. La moindre concentration d'électrons est due à la plus grande relaxation des états de contrainte/contrainte et à la réduction remarquable de la densité de défauts natifs dans l'échantillon C.
Les figures 5a–c et d–f sont des images AFM 2D et 3D de spécimens. La rugosité moyenne quadratique (RMS) de A, B et C est de 1,92, 4,30 et 2,18 nm, respectivement, comme indiqué dans le tableau 2. La rugosité de la texture de surface la plus faible s'est produite dans l'échantillon A. Avec l'utilisation de O3 précurseur dans l'échantillon B, la rugosité de surface est augmentée. La réduction de l'uniformité spatiale des films ALD ZnO est due à la perte de surface de O3 [21]. Perte de surface de O3 est liée à la transition d'une croissance limitée par la réaction à la recombinaison et peut constituer le principal canal de perte atomique pour détruire les films, ce qui entraîne une mauvaise uniformité d'épaisseur. Ceci est corrélé à la réduction de l'intensité du pic de diffraction le long de (002) dans l'échantillon B sur la figure 2. Avec le traitement du TA post-dépôt dans l'échantillon C, l'uniformité de la surface est améliorée. Pendant ce temps, une diminution spectaculaire de la concentration d'électrons de fond et une augmentation de la mobilité sont obtenues. Le recuit thermique provoque une migration dans le réseau cristallin; ainsi, une recristallisation métallurgique a lieu. La recristallisation accompagne la réduction de la résistance à la déformation/contrainte et des imperfections intrinsèques du réseau cristallin ; par conséquent, une meilleure qualité de film mince de ZnO est atteinte. Ce résultat est cohérent avec l'amélioration de deux intensités de pic de diffraction dans le motif XRD dans l'échantillon C. Il est intéressant de noter que la mobilité des électrons peut être affectée par des sources de diffusion telles que les impuretés, les réseaux et les défauts. Que les sources de diffusion pourraient modifier la vitesse moyenne des électrons. En général, la réduction de la densité de défauts et donc la diminution de la concentration électronique conduisent à l'augmentation de la mobilité. Dans ce rapport, une augmentation de la rugosité de la texture de surface due à l'action du dosage du précurseur d'ozone pourrait entraîner une mobilité électronique plus faible dans l'échantillon C que dans A. Sur la figure 6, un diagramme pyramidal contenant trois triangles de couleurs différentes illustre les trois principaux facteurs de croissance et conditions de traitement pour obtenir des épicouches ALD ZnO de haute qualité dans ce rapport.
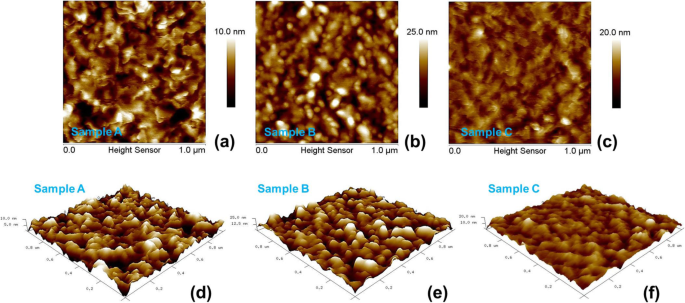
un –c 2D et d –f Images AFM 3D de spécimens. L'échelle de hauteur dans les images 2D est présentée sur la barre de couleur de droite

Un diagramme pyramidal. Dans la pyramide, quatre triangles sont illustrés de différentes couleurs. Trois triangles aux bords de la pyramide montrent les conditions clés de croissance et de traitement du ZnO. La combinaison de ces trois composants cruciaux dans la croissance favorise la qualité des épicouches ALD ZnO représentées par le triangle au centre de la pyramide
Conclusions
H2 à une impulsion O et oxydant fort à trois impulsions O3 les précurseurs dans les processus ALD peuvent diminuer la contrainte/la contrainte et donc réduire de manière visible la concentration d'électrons dans le film mince de ZnO mais augmenter la rugosité de la surface. Post-dépôt TA à 300 °C dans l'ambiance d'oxygène (O2 ) pendant 1 h peut en outre faciliter la formation de grains plus exempts de défauts avec une contrainte/une contrainte inférieure, une concentration d'électrons de fond inférieure et une amélioration de la rugosité de surface après la croissance de l'utilisation d'O3 à trois impulsions précurseurs. La plus faible contrainte/contrainte et concentration d'électrons de fond qui sont de 0,49%/2,22 GPa et 9,4 × 10 15 cm −3 , respectivement, en raison de la diminution spectaculaire du défaut natif intrinsèque des films minces de ZnO cultivés par ALD.
Disponibilité des données et des matériaux
Les données qui appuient les résultats de cette étude sont disponibles auprès de l'auteur correspondant (Yung-Chen Cheng) sur demande raisonnable.
Abréviations
- ALD :
-
Dépôt de couche atomique
- O3 :
-
Ozone
- AT :
-
Recuit thermique
- O2 :
-
Oxygène
- PL :
-
Photoluminescence
- H2 O :
-
Eau
- H2 O2 :
-
Peroxyde d'hydrogène
- OH :
-
hydroxyle
- Zni :
-
Interstitiels en zinc
- VO :
-
Vacance d'oxygène
- TD :
-
Dislocations de filetage
- Go :
-
Joints de grains
- NBE :
-
Bord de bande interdite proche
- c-Al2 O3 :
-
saphir c-face
- DI :
-
Déionisé
- C2 H5 :
-
Groupes éthyles
- N2 :
-
Azote gazeux
- Zn :
-
Zinc
- XRD :
-
Diffraction des rayons X
- AFM :
-
Microscope à force atomique
- RMS :
-
Racine moyenne quadratique
Nanomatériaux
- Technologies avancées de dépôt de couche atomique pour les micro-LED et les VCSEL
- Caractéristiques de commutation résistive bipolaire des dispositifs RRAM à structure tricouche HfO2/TiO2/HfO2 sur des substrats revêtus de Pt et de TiN fabriqués par dépôt de couche atomique
- Caractéristiques d'alignement interfacial, électrique et de bande des piles HfO2/Ge avec une couche intermédiaire de SiO2 formée in situ par dépôt de couche atomique amélioré par plasma
- Les nanofibres hiérarchiques antibactériennes en polyamide 6-ZnO fabriquées par dépôt de couche atomique et croissance hydrothermale
- Propriétés photocatalytiques des poudres de TiO2 revêtues de Co3O4 préparées par dépôt de couche atomique amélioré par plasma
- Réglage des morphologies de surface et des propriétés des films de ZnO par la conception de la couche interfaciale
- Réglage au niveau de Fermi des films ZnO par dépôt de couche atomique supercyclée
- Étude de la force d'adhérence et de la transition vitreuse de films minces de polystyrène par microscopie à force atomique
- Préparation et caractéristiques thermoélectriques du thermocouple à couche mince ITO/PtRh:PtRh



