Dépendance de composition des propriétés structurelles et électroniques de l'InGaNBi quaternaire
Résumé
Pour réaliser une ingénierie de structure de bande réalisable et donc une efficacité de luminescence améliorée, InGaNBi est un alliage attrayant qui peut être exploité dans des dispositifs photoniques de lumière visible et infrarouge moyen. Dans la présente étude, les propriétés structurelles et électroniques telles que la bande interdite, l'énergie de séparation spin-orbite et la déformation du substrat des compositions InGaNBi par rapport aux compositions In et Bi sont étudiées à l'aide de calculs des premiers principes. Les paramètres de réseau augmentent presque linéairement avec l'augmentation des compositions In et Bi. Par dopage au bismuth, la bande interdite quaternaire InGaNBi pourrait couvrir une large gamme d'énergie de 3,273 à 0,651 eV pour Bi jusqu'à 9,375 % et In jusqu'à 50 %, correspondant à la gamme de longueurs d'onde de 0,38 à 1,9 µm. L'énergie de séparation spin-orbite calculée est d'environ 0,220 eV pour 3,125 %, 0,360 eV pour 6,25 % et 0,600 eV pour 9,375 % Bi, respectivement. Nous avons également montré la déformation d'InGaNBi sur GaN; cela indique qu'en ajustant les compositions In et Bi, InGaNBi peut être conçu sur GaN avec une déformation acceptable.
Introduction
Ces dernières années, la wurtzite (WZ) In x Ga 1−x Les alliages N et les puits quantiques (QW) InGaN/GaN ont suscité une grande attention en raison de leur grand potentiel de développement de cellules solaires, de diodes électroluminescentes (DEL) et de diodes laser (LD) à haut rendement [1–10]. Le In orienté [0001] couramment utilisé x Ga 1−x Les QW N/GaN subissent un champ électrique intégré intense induit par la contrainte de compression biaxiale de l'In x Ga 1−x couche N [11], qui entraîne la diminution de l'énergie d'émission QW et de la force de l'oscillateur des paires électron-trou. De plus, il existe une forte densité de défauts géométriques dans In x Ga 1−x alliages N, y compris les défauts d'empilement et les dislocations de filetage (TD) [12] ; ces TD ont une forte corrélation avec les centres de recombinaison non radiatifs. Les défauts, les fuites d'électrons et la recombinaison Auger sont les trois sources du statisme d'efficacité de In x Ga 1−x N LED, dont la recombinaison Auger est la cause principale [13].
De même, pour les diodes infrarouges à base de GaAs, il a déjà été proposé que l'alliage de bismuth soit une méthode efficace pour réduire la bande interdite (E g ) ainsi que d'améliorer la division spin-orbite (SO) pour obtenir la suppression du processus de recombinaison Auger [14]. Le plus grand élément du groupe V du bismuth révèle des effets intéressants sur les propriétés physiques des alliages de bismide. Les changements dans la structure de bande des alliages de bismide ont été étudiés pour différents matériaux d'alliages ternaires à la fois expérimentalement et théoriquement, tels que AlNBi [15], GaNBi [16, 17], GaSbBi [18, 19], InPBi [20, 21], et InSbBi [19, 22-24]. La bande interdite est principalement modifiée par la grande souche induite par l'atome de Bi à haute concentration en InPBi. L'incorporation de Bi perturbe les bandes de valence (VB) en raison de l'interaction des états d'impuretés Bi avec des bandes de trous lourds/légers et des bandes de séparation spin-orbite [21]. Plus récemment, les alliages de bisamide quaternaire (par exemple, GaAsNBi [25–27], InGaAsBi [28, 29], GaAsPBi [30]) ont également suscité une grande attention. Les distorsions locales autour des atomes P et Bi contribuent de manière significative à la modification de la bande interdite de GaAsPBi. Une exigence de composition pour Ga As 1−x −y P y Bi x pour obtenir un rapport de recombinaison Auger inférieur à celui du GaAs [30]. La combinaison du bismuth et d'autres atomes III ou V augmente la portée de l'ingénierie de la structure de la bande, y compris le contrôle de la bande interdite, de la division spin-orbite, des décalages de bande de conduction (CB) et de valence, et de la déformation [25]. Par conséquent, il est d'un intérêt significatif de décrire l'effet de la substitution Bi sur le [0001] In x Ga 1−x N/GaN, accordant les propriétés structurelles et électroniques et donc l'efficacité de luminescence. Dans la présente étude, en utilisant les calculs des premiers principes [31], les propriétés structurelles et électroniques telles que la bande interdite, l'énergie de séparation spin-orbite (Δ SO ), et la déformation du substrat des compositions InGaNBi par rapport aux compositions In et Bi sont étudiées. Compte tenu de la grande disparité de réseau et de la mauvaise qualité des teneurs en In supérieures à 55 à 60 % dans l'échantillon d'InGaN [32] ainsi que de la faible solubilité du bismuth dans les alliages de bismide dilué, les concentrations d'In et de Bi sont contrôlées jusqu'à 50 % et 9,375%, respectivement. L'article est organisé de la manière suivante. Dans la section « Méthodes », nous présentons les méthodes de calcul détaillées. Les propriétés structurelles, électroniques et la déformation du substrat sont fournies dans la section « Résultats et discussion ». Enfin, un bref résumé est résumé.
Méthodes
Nos calculs théoriques sont basés sur la théorie de la fonctionnelle de la densité (DFT) [31] telle qu'implémentée dans le code VASP [33, 34]. Dans les calculs des propriétés structurelles, les interactions électron-ion et échange-corrélation sont traitées avec la méthode des ondes augmentées par projecteur (PAW) [35, 36] et l'approximation du gradient généralisé (GGA) du Perdew-Burke-Ernzerhof (PBE) [37], respectivement. Les configurations d'électrons de valence pour les atomes In, Ga, N et Bi sont utilisées comme 4d 10 5s 2 5p 1 , 3d 10 4s 2 4p 1 , 2s 2 2p 3 , et 5d 10 6s 2 6p 3 , respectivement. Afin de surmonter la sous-estimation du potentiel PBE sur la bande interdite des propriétés électroniques, nous utilisons le potentiel d'échange Becke-Johnson modifié en combinaison avec la corrélation d'approximation de densité locale (MBJLDA) [38]. Le bismuth a un effet de couplage spin-orbite (SOC) important et, par conséquent, le SOC est inclus dans les calculs électroniques. Dans tous les calculs, les structures sont relâchées jusqu'à ce que les forces sur chaque atome deviennent inférieures à 0,02 eV/Å et que le changement d'énergie maximal soit de l'ordre de 10 −4 eV. Une coupure d'onde plane de 450 eV est définie pour assurer la précision des calculs. Un Monkhorst-Pack de 4×4×4k -le maillage ponctuel est adopté dans la première zone de Brillouin.
Résultats et discussion
Propriétés structurelles
Les supercellules sont constituées de 4×2×2 de cellules primitives WZ-GaN, comprenant 64 atomes. Nous étudions 36 compositions de I n y Ga 1−y N 1−x Bi x avec 0≤x ≤0.09375,0≤y ≤0,5 sur la base d'expériences récentes où l'échantillon d'InGaN présente une grande disparité de réseau et une mauvaise qualité pour une teneur en In supérieure à 55 à 60 % [32] ainsi que la faible solubilité du bismuth dans les alliages de bismide dilué. Une configuration représentative est considérée où les atomes In et Bi sont uniformément répartis. Nous avons résumé les paramètres de maille calculés du ternaire In y Ga 1−y N et quaternaire In y Ga 1−y N 1−x Bi x alliages avec d'autres données théoriques et expérimentales sur la figure 1. Pour le GaN vierge, les paramètres de réseau a =3.211, c =5.235 Å, qui sont en bon accord avec d'autres calculs théoriques a =3.155,3.22 Å, c =5,144,5,24 Å [39–41] et données expérimentales 3,19 Å pour a , 5,19 Å pour c [42]. Les paramètres de maille (a , c ) de Dans y Ga 1−y N augmente lorsque la composition In est augmentée et montre une variation presque linéaire, comme le montre la figure 1a. Les calculs actuels prédisent a =3.304 , c =5.365 Å pour In 0.25 GaN et a =3.397 Å, c =5.509 Å pour In 0,5 GaN, qui sont tous en bon accord avec les résultats précédents de a =3,33 , c =5,39 pour Dans 0.25 GaN et a =3.43,3.485 , c =5.55,5.488 Å pour I n 0,5 GaN [39, 40, 43, 44]. Dans le cas des alliages quaternaires In y Ga 1−y N 1−x Bi x , en ce qui nous concerne, il n'y a pas de valeurs expérimentales et théoriques pour les propriétés structurelles. Sur la figure 1b, les paramètres de réseau obtenus augmentent également presque linéairement avec l'augmentation des compositions In et Bi. En raison des rayons ioniques plus grands de In et Bi que des atomes Ga et N, la substitution de In sur Ga et Bi sur N conduit à des paramètres de réseau améliorés de InGaNBi.

Les paramètres de réseau pour a alliages ternaires En y Ga 1−y N , avec 0≤y ≤0,5 et b alliages quaternaires In y Ga 1−y N 1−x Bi x , avec 0≤x 0,09375, 0≤y 0,5. A titre de comparaison, nous ajoutons quelques autres calculs et données expérimentales de la Réf. [39-44] dans la Fig. 1a. La ligne continue représente a et la ligne pointillée est c
L'incorporation d'In et de Bi brisera la périodicité du cristal et introduira une déformation géométrique dans une structure fortement alliée. Nous choisissons Dans 0.25 GaN Bi 0,0625 comme exemple pour quatre statistiques de liaisons chimiques, comme le montre la figure 2 ; les longueurs moyennes des liaisons Ga-N, In-N, Ga-Bi et In-Bi sont respectivement de 2,009, 2,195, 2,592 et 2,704 . Notez que la longueur de la liaison Ga-N dans le GaN en vrac vierge est de 1,970 Å. La longueur de la liaison In-N est plus grande que celle de Ga-N, ce qui indique que l'atome In repousse nettement l'atome N. De même, la plus grande longueur de liaison de Ga-Bi que Ga-N signifie que l'atome Bi repousse l'atome Ga, trouvant une bonne cohérence avec l'ordre des rayons covalents de Ga (1,22 ), In (1,42 ), N (0,71 Å), et Bi (1,48 Â) [45]. D'autres configurations affichent le même comportement. La déformation du réseau et la disparité d'électronégativité entre l'hôte et le dopant ont un effet considérable sur les propriétés électroniques et optiques.

Histogramme de la longueur de liaison en In 0.25 GaNBi 0,0625 . Les valeurs dans le panneau indiquent les longueurs moyennes des quatre types de liaison
Propriétés électroniques
Il a été démontré que les potentiels fonctionnels ou de correction et l'effet SOC influencent grandement la précision prédite de l'énergie de la bande interdite de l'alliage III-V, de la bande de valence et de l'énergie de division spin-orbite. Ainsi, nous validons nos résultats en utilisant le potentiel MBJLDA et les comparons avec d'autres calculs théoriques et expériences. La figure 3 est un graphique de l'énergie de la bande interdite par rapport à la composition In dans In y Ga 1−y N ainsi qu'un ajustement aux données. Certaines valeurs de bande interdite obtenues par des expériences, les fonctionnelles théoriques HSE06, mBJ et LMTO-CPA-MBJ sont également tracées. La bande interdite prévue de GaN est de 3,273 eV, ce qui est en bonne cohérence avec les calculs et expériences actuels, 3,33 eV par mBJ [40], 3,261, 3,23 eV par HSE06 [39, 46] et 3,40–3,50 eV par expériences [47– 49]. Comme observé dans I n y G un 1−y N, nos résultats DFT confirment que E g valeurs de Je n y G un 1−y N diminue continuellement à mesure que y passe de 0 à 50 %. E g diminue progressivement de 3,273 à 1,546 eV. Cela se compare bien avec ceux des résultats théoriques (HSE06, potentiels mBJ)[39, 40, 46] et expérimentaux [50, 51].
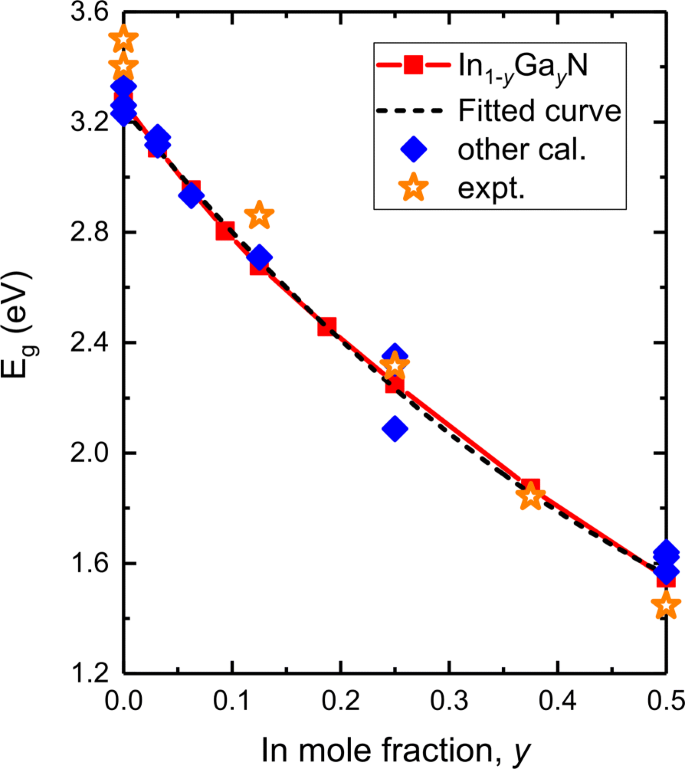
Énergie de bande interdite prévue (E g , trait plein rouge) en fonction de la composition In dans I n y G un 1−y N ainsi qu'un ajustement aux données (ligne pointillée noire). D'autres résultats théoriques [39, 40, 46] et expérimentaux [47-51] sont également tracés
Le tracé de contour pour la bande interdite du I quaternaire n y G un 1−y N 1−x B je x alliages est illustré à la Fig. 4. Les bandes interdites des alliages quaternaires présentent une tendance non linéaire en fonction de la composition, qui diminue avec l'augmentation des teneurs en In et Bi. D'après les résultats, nous constatons que la bande interdite InGaNBi pourrait couvrir une large gamme d'énergie de 3,273 à 0,651 eV pour Bi jusqu'à 9,375% et In jusqu'à 50%, correspondant à la gamme de longueurs d'onde de 0,38 à 1,9 µm, indiquant leurs applications optoélectroniques potentielles dans lumière visible et infrarouge moyen.

Tracé de contour des valeurs de bande interdite pour I n y G un 1−y N 1−x B je x alliages, en fonction de Bi(x ) et In(y ) compositions
Par rapport à InGaN, l'incorporation de Bi induit une réduction de la bande interdite plus importante. Mais au-delà, une augmentation significative de Δ SO est obtenu en raison du fort effet SOC du bismuth où l'interaction avancée entre le spin de l'électron et le moment angulaire orbital diminue l'énergie de la bande SO. En outre, le bord amélioré de la bande de valence résultant de l'effet anti-croisement de la bande de valence des alliages de bismide améliore également considérablement Δ SO [28]. Notre Δ calculé SO les valeurs sont d'environ 0,220 eV pour 3,125%, 0,360 eV pour 6,25 % et 0,600 eV pour 9,375% Bi, respectivement, ce qui a une variation insignifiante avec la fraction d'indium. Des études antérieures ont démontré que différents arrangements de Bi ont une grande influence sur les structures de bande des alliages de bisamide, y compris l'énergie de séparation spin-orbite [21, 52]. Les résultats actuels montrent que le I n 0,5 G un N B je 0,09375 la valeur de bande interdite (0,651 eV) est très proche de celle de Δ SO (0,577 eV). Étant donné que l'échantillon d'InGaN présente une grande disparité de réseau et une mauvaise qualité pour une teneur en In supérieure à 55 à 60 % [32] ainsi que la faible solubilité du bismuth dans les alliages de bismide dilué, nous avons défini les teneurs en In jusqu'à 50 % et Bi jusqu'à 9,375%. Nous pensons qu'une teneur plus élevée en indium ou en bismuth permettra d'atteindre Δ SO >E g dans un échantillon quaternaire d'InGaNBi pour améliorer l'efficacité des LED et des LD basés sur InGaNBi.
Les structures de bandes projetées et la densité totale d'états (TDOS) du GaN vierge, I n 0.25 GaN, et I n 0.25 G un N B je 0,03125 les alliages sont présentés sur la figure 5. Les contributions de In et Bi sont mises en évidence par la couleur :le bleu (rouge) correspond à l'état provenant de In (Bi). La substitution In dans I n 0.25 GaN a une grande influence sur la bande de conduction et la bande de valence, où le minimum de bande de conduction (CBM) est poussé à des énergies plus basses par rapport au niveau de Fermi et reflète un écart énergétique plus étroit. Contrairement au bismuth qui introduit la bande de défaut dans la bande interdite proche du niveau de Fermi, les atomes In montrent une hybridation avec le niveau profond du VB. Pour alliage quaternaire I n 0.25 G un N B je 0,03125 , on peut clairement voir que la réduction de la bande interdite résulte à la fois du maximum de bande de valence vers le haut (VBM) et du CBM vers le bas, et que le CBM change de manière plus significative par rapport à I n 0.25 GaN, qui est attribué à une plus grande contrainte de compression dans InGaNBi due à l'ajout de bismuth. Le niveau de défaut mis en évidence par la couleur rouge a une forte interaction avec le bord VB, qui est dérivé de l'hybridation principalement entre les atomes Bi et Ga proches. Le TDOS de la Fig. 5e reflète également le niveau de défaut local à -1,0 à -0,5 eV.
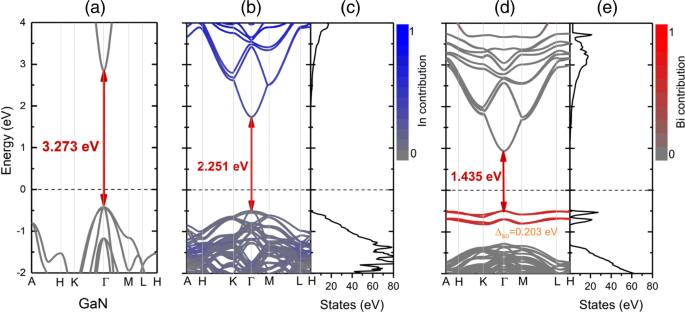
Les structures de bandes projetées et leur densité totale d'états correspondante (TDOS) de a GaN, b , c Je n 0.25 G un N , et d , e Je n 0.25 G un N B je 0,03125 . La ligne pointillée noire représente le niveau de Fermi, qui est égal à zéro. Les contributions relatives de In et Bi sont mises en évidence par la couleur :le bleu (rouge) correspond à l'état provenant de In (Bi)
Souche d'InGaNBi sur GaN
Le I orienté [0001] n y G un 1−y Les puits quantiques contraints N/GaN sont largement adoptés dans les dispositifs LED et LD actuels, dans lesquels I n y G un 1−y N couches subissent une contrainte de compression biaxiale. Les fluctuations de composition locales et les différents rayons covalents des atomes In et Ga donnent lieu aux déformations dans I n y G un 1−y N couches [53]. La figure 6 montre la déformation d'InGaNBi sur un substrat de GaN. Puisque l'atome d'indium est plus grand que l'atome de gallium, l'atome de bismuth est plus grand que l'atome d'azote; ainsi, l'incorporation d'atomes In et Bi dans InGaNBi induit une contrainte de compression InGaNBi sur GaN. Il est montré que dans la teneur en In de 50% et la teneur en Bi de 9,375%, InGaNBi est soumis à une contrainte de compression élevée de 8,5%. Pour la fraction In à 6,25% et la fraction Bi à 2,8%, la déformation de l'InGaNBi sur GaN est à 1%. C'est-à-dire qu'en ajustant les compositions In et Bi, InGaNBi peut être conçu sur GaN avec une déformation acceptable.

Déformation des alliages InGaNBi sur substrat GaN à divers In (0–0,5) en fonction de la fraction Bi. Des valeurs positives de déformation indiquent qu'InGaNBi est soumis à une déformation compressive
Conclusions
Les propriétés structurelles, électroniques et la déformation d'InGaNBi sur les compositions de GaN par rapport à In et Bi sont étudiées sur la base de la théorie de la fonctionnelle de la densité. Les paramètres de réseau d'InGaNBi augmentent presque linéairement avec l'augmentation des compositions In et Bi. Étant donné que les atomes In et Bi ont un rayon atomique plus grand que celui des atomes Ga et N, les longueurs de liaison In-N et Ga-Bi sont plus grandes que celles de Ga-N. Pour les propriétés électroniques, nous avons montré le tracé de contour pour la bande interdite de I quaternaire n y G un 1−y N 1−x B je x alliages. La bande interdite des alliages quaternaires pourrait couvrir une large gamme d'énergie de 3,273 à 0,651 eV pour Bi jusqu'à 9,375 % et In jusqu'à 50 %, correspondant à la gamme de longueurs d'onde de 0,38 à 1,9 µm. Le Δ calculé SO les valeurs sont d'environ 0,220 eV pour 3,125%, 0,360 eV pour 6,25 % et 0,600 eV pour 9,375% Bi, respectivement, ce qui a une variation insignifiante avec la fraction d'indium. Nous pensons qu'une composition plus élevée d'indium ou de bismuth permettra d'atteindre Δ SO >E g dans un échantillon d'InGaNBi quaternaire pour améliorer l'efficacité des LED et des LD à base d'InGaNBi. Les analyses de structure de bande montrent que l'indium a une grande influence à la fois sur CB et VB, et le bismuth a une forte interaction avec le bord VB. Enfin, nous étudions la déformation d'InGaNBi sur GaN. En ajustant les compositions In et Bi, InGaNBi peut être conçu sur GaN avec une déformation acceptable.
Nanomatériaux
- PPA renforcé de fibres de carbone pour composants automobiles et électroniques structurels
- Structure et propriétés électroniques de la nanoargile de kaolinite dopée par un métal de transition
- Modulation des propriétés d'anisotropie électronique et optique du ML-GaS par champ électrique vertical
- L'effet du plasma de contact hors équilibre sur les propriétés structurelles et magnétiques des spinelles Mn Х Fe3 − X О4
- Propriétés optiques et électroniques des photodiodes N+/P au silicium hyperdopées induites par laser femtoseconde
- Propriétés structurelles et optiques dans le proche infrarouge du TiO2 dopé au Cr pour les pigments froids colorés
- Étude des propriétés structurelles, électroniques et magnétiques des amas Ag n V (n = 1–12)
- Propriétés des PCB automobiles et considérations de conception
- Propriétés et composition de la fonte brute



