Sur l'amélioration de la figure de mérite (BFOM) de Baliga d'un nouveau transistor à effet de champ vertical à nano-pilier GaN avec canal 2DEG et Substrat à motifs
Résumé
Un nouveau transistor à effet de champ (FET) GaN vertical à mode d'enrichissement avec 2DEG pour réduire la résistance à l'état passant (R ON ) et un motif de substrat (SP) pour améliorer la tension de claquage (BV) est proposé dans ce travail. En concevant délibérément la largeur et la hauteur du SP, le champ électrique hautement concentré (champ E) sous le capuchon p-GaN pourrait être séparé sans impacter considérablement le R ON , s'avérant une figure de mérite de Baliga améliorée (BFOM, BV 2 /R ON ). Vérifié par une simulation ATLAS calibrée expérimentalement, le dispositif proposé avec un SP de 700 nm de long et de 4,6 µm de largeur présente un BFOM six fois plus élevé que le FET sans substrat à motifs. De plus, le dispositif de pilier proposé et le SP à l'intérieur n'occupent qu'une zone à l'échelle nanométrique, permettant une intégration à haute densité de tels dispositifs, ce qui rend son potentiel élevé dans les futures applications d'alimentation.
Contexte
De nos jours, les semi-conducteurs à large bande interdite tels que le ZnO, l'In2 O3 , SiC et le nitrure de gallium (GaN) ont attiré l'attention [1,2,3,4,5]. Considérant que, compte tenu des propriétés électroniques, le transistor latéral à haute mobilité électronique (HEMT) AlGaN/GaN est largement considéré comme un candidat potentiel pour remplacer le dispositif à base de Si dans les applications de puissance ou de fréquence en raison de la tension de claquage (BV) plus élevée ainsi que la stabilité thermique plus forte. Beaucoup d'efforts, tels que capuchon de type p [6, 7], implantation d'ions fluor [8, 9], barrière mince [10, 11], double canal [5, 12] et grille à couplage de champ [13] , ont été réalisés sur la réalisation du HEMT de type enrichissement que l'on souhaite pour simplifier le circuit de pilotage.
Ces technologies sont toutefois confrontées à de nombreux défis redoutables tels qu'une faible uniformité de la tension de seuil, le gaspillage de la zone de puce verticale, l'effondrement du courant, la figure de mérite limitée de Baliga (BFOM), etc. Surtout, la contradiction entre la longueur de dérive et la BV influence négativement la réduction d'échelle du dispositif [14, 15]. En d'autres termes, un appareil plus petit conduit à un BV plus faible, dans lequel il est plus difficile d'adopter les bornes de jonction qui favorisent le BFOM en optimisant la répartition du champ électrique. À cette fin, une barrière arrière [16], une jonction enterrée [17], une plaque de champ de puits quantique [18] et d'autres structures qui sont insérées dans le HEMT latéral présentant la caractéristique de la plaque de champ électrique ont été proposées pour améliorer la BV en utilisant la région verticale de la puce.
D'autre part, en raison de la nature supérieure du GaN, le transistor à effet de champ vertical (VFET) en vrac GaN attire de plus en plus l'attention en raison de la réalisation plus facile de la fonctionnalité de type enrichissement et de la pleine utilisation de la région verticale [19 ,20,21,22]. De nombreuses nouvelles structures sont présentées par des expériences ou des simulations pour incliner le BV et réduire simultanément la résistance à l'état passant (R ON ) [23,24,25]. Cependant, sans parler des difficultés de fabrication de la super-jonction (SJ) dans GaN, l'absence du gaz d'électrons bidimensionnel à haute mobilité (2DEG) conduit à un R plus élevé ON [26], ce qui entrave l'optimisation du BFOM dans de tels appareils.
Dans ce travail, un nouveau FET GaN vertical à mode d'amélioration avec 2DEG pour réduire le R ON et un motif de substrat (SP) pour améliorer le BV est proposé, dans lequel la combinaison du canal 2DEG et du SP équilibre efficacement la contradiction entre la faible résistance à l'état passant et le BV élevé. De plus, le pilier de dispositif proposé et le SP à l'intérieur n'occupent qu'une surface à l'échelle nanométrique, permettant une intégration à haute densité de tels dispositifs. Vérifié par simulation numérique construite dans ATLAS, le dispositif proposé présente un BFOM plus élevé que le même transistor à effet de champ (FET) sans le substrat à motifs, ce qui rend son potentiel élevé dans les futures applications d'alimentation.
Méthode
Le dispositif proposé est généré dans un Al0.23 normal Plaquette de GaN/GaN avec un substrat de type n hautement concentré agissant comme électrode de drain, comme le montre la figure 1a, où l'épaisseur de la couche de nitrure de silicium (SiN), d'AlGaN et de GaN est de 105 nm, 20 nm et 5 μm , respectivement. Un GaN de type n avec 2 × 10 16 cm −3 dopage n D et un capuchon GaN de type p avec 2 × 10 17 cm −3 dopage n A est défini comme le tampon et le canal composite respectivement [27, 28]. Un autre composant du canal à côté de la grille est une fine couche d'AlGaN qui est introduite pour induire 2DEG, comme le montre la figure 1b. Un SP, fait d'oxyde d'aluminium (Al2 O3 ) par exemple dans ce papier, est cultivé sur le substrat.
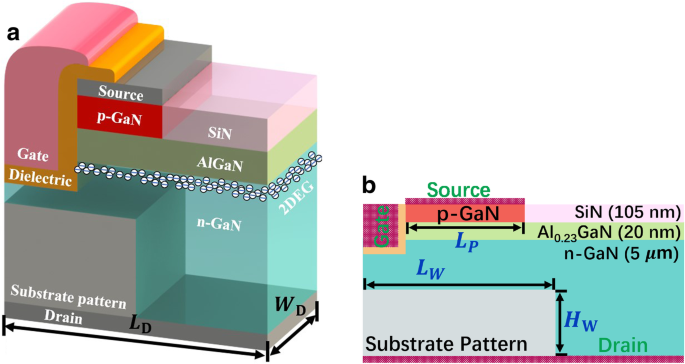
Le schéma a Structure de pilier 3D et b section transversale avec des paramètres géométriques étiquetés du SP-VFET proposé
L'ensemble du dispositif pourrait donc être fabriqué par un procédé standard successivement :(1) le dépôt épitaxié du substrat de conduction et de la couche SP intégrée, (2) la gravure partielle du motif SP, (3) le dépôt et le polissage de n- Tampon GaN, (4) le dépôt de la barrière AlGaN et du capuchon p-GaN, et (5) la fabrication des électrodes et la passivation.
Le simulateur ATLAS implanté est calibré par les données expérimentales d'un HEMT de type rehaussement avec une coiffe p-GaN [29, 30]. Les spécifications calibrées et autres de l'appareil sont présentées dans le tableau 1. D'autres configurations ont pu être trouvées dans nos travaux précédents [31]. Le type et la densité du piège d'interface situé à l'interface SP/GaN se réfèrent à des mesures expérimentales basées sur la capacité [32,33,34]. La charge de polarisation sur la surface AlGaN/GaN est confirmée selon l'équation d'ajustement quadratique simple correspondante [35].
Mécanisme de physique
À l'état passant, par rapport au dispositif sans canal 2-DEG et SP, le transistor à effet de champ vertical proposé avec motif de substrat (SP-VFET) présente un chemin hautement conducteur grâce au 2-DEG et à un canal de courant vertical plus étroit qui rétrécit la conductance comme le montre la Fig. 2. En détail, grâce au 2DEG haute densité concentré à l'interface AlGaN/GaN, le chemin latéral du flux de courant a pu être maintenu, ce qui compense partiellement toute la conductance de l'appareil. En revanche, la capacité de transport actuelle du dispositif SP-VFET sans canal 2DEG serait considérablement influencée.
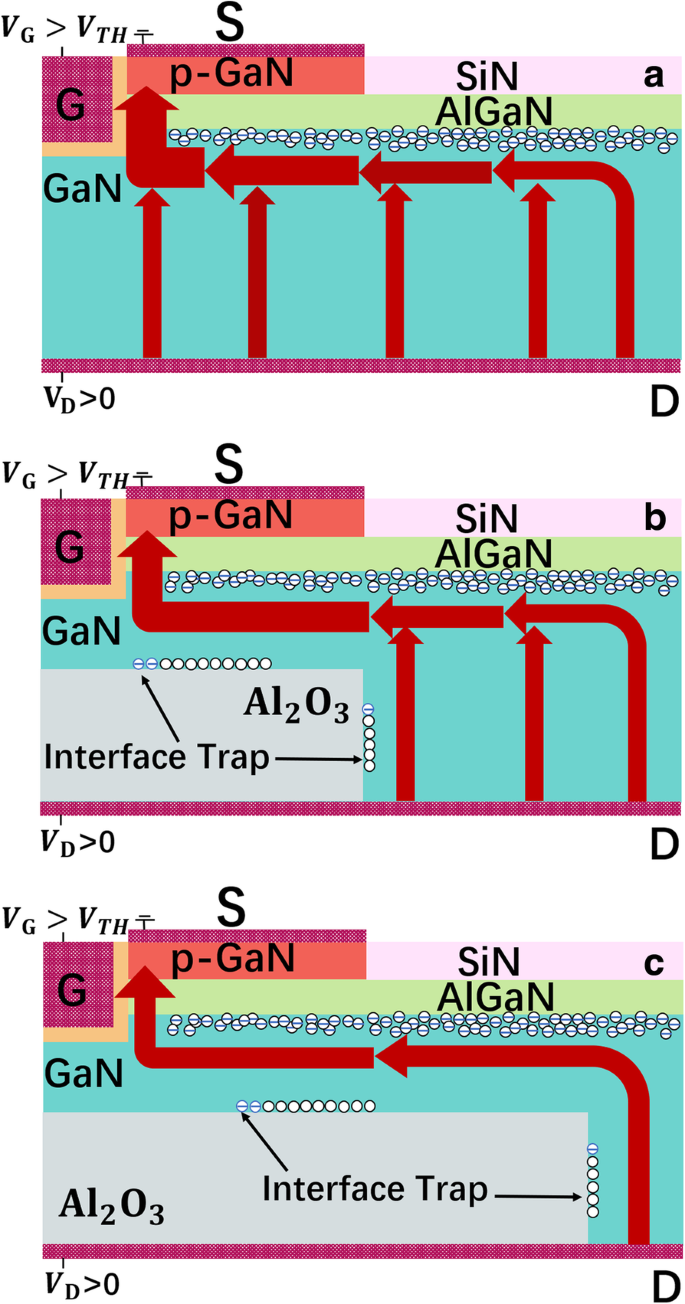
L'illustration schématique du flux de courant direct dans a l'appareil sans le SP, b le SP-VFET proposé avec un SP court, et c un long SP
La longueur du capuchon p-GaN n'influencerait pas considérablement la concentration du champ électrique (champ E) jusqu'à ce que la longueur soit supérieure à 700 nm par laquelle le p-GaN couvre presque toute la surface de l'appareil. Comme le montre la figure 3, la distribution du champ E le long de l'interface AlGaN/GaN possède un pic autour du coin droit du p-GaN. La position du pic se déplace avec la longueur variable de p-GaN, et cependant, conserve la même amplitude. Une petite différence de la valeur de crête peut être observée sur la Fig. 3 lorsque le capuchon p-GaN est plus long que 600 nm, car le long capuchon p-GaN aplatit l'ensemble du champ E dans l'appareil et augmente ainsi la résistance de l'appareil en raison à l'épuisement du 2DEG.
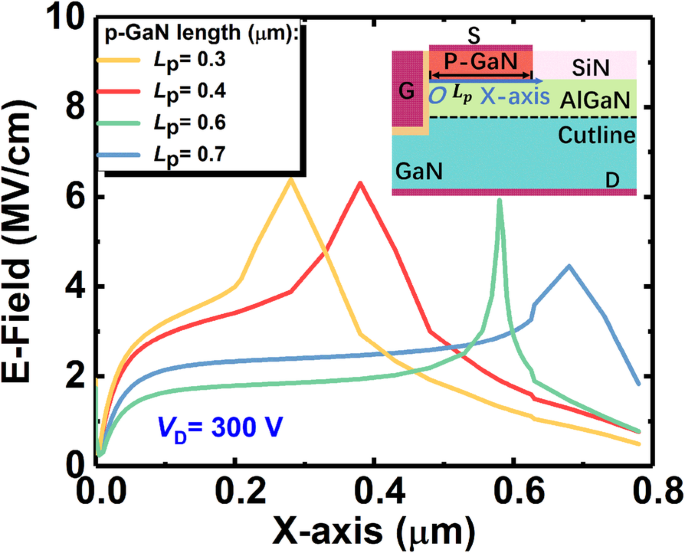
La distribution du champ électrique de l'appareil sans le SP le long de l'hétérojonction AlGaN/GaN dans différentes longueurs p-GaN
Pour illustrer l'influence du p-GaN, du 2-DEG et du SP introduits simultanément, un modèle de conduction à l'état passant peut être construit, comme le montre schématiquement la figure 4a. M 1 et M 2 sont les transistors de type MIS avec le canal de conduction formé respectivement en p-GaN et AlGaN. R 1 représente la partie infinitésimale de la résistance verticale dans le GaN massif. R 2 et R 3 représentent les parties de résistance infinitésimales du canal 2-DEG avec et sans épuisement partiel respectivement. Selon la loi de la résistance, R 1 , R 2 , et R 3 peut être obtenu comme
$$ {R}_1=\frac{1}{n_1 q\mu}\bullet \frac{l}{dx\bullet {W}_D} $$$$ {R}_2=\frac{1}{n_2 q\mu}\bullet \frac{dx}{t\bullet {W}_D} $$$$ {R}_3=\frac{1}{n_3 q\mu}\bullet \frac{dx}{t\ puce {W}_D} $$où n 1 , n 2 , et n 3 représentent la concentration électrique en GaN, 2-DEG non appauvri et 2-DEG appauvri respectivement ; q est la charge électronique et μ est la mobilité de l'électron dans GaN; l est la longueur du chemin conducteur vertical et dx est la longueur infinitésimale de l'horizon ; W D est la largeur de l'appareil ; et t est l'épaisseur du 2-DEG. Pour plus de commodité, t est fixé à 10 nm [7]. La concentration du 2-DEG appauvri sous p-GaN n 3 est égal à la concentration non appauvrie n 1 moins la charge négative totale dans le p-GaN appauvri [31], qui se lit
$$ {n}_3={n}_2-{n}_A{x}_D $$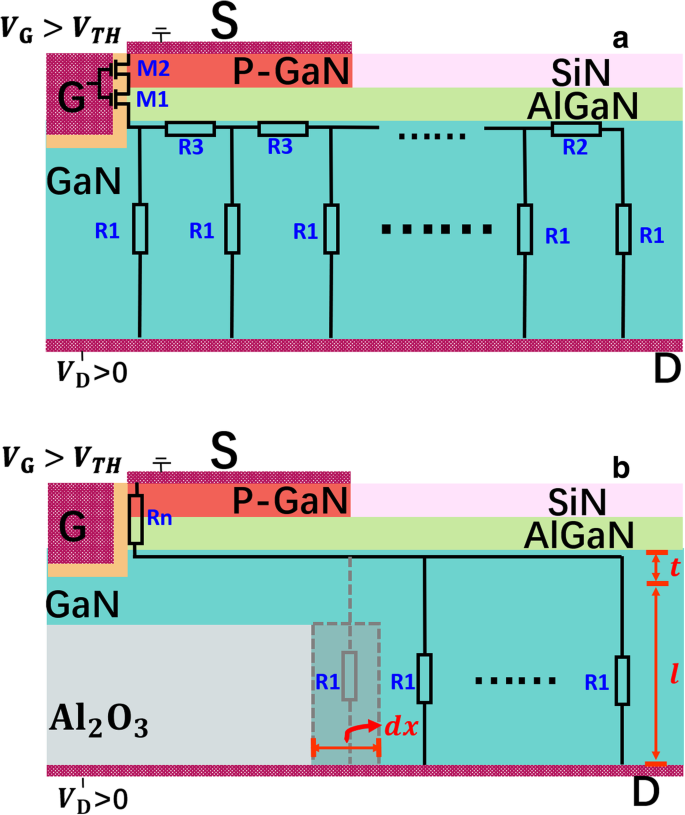
Le schéma de a modèle sur état proposé sans SP b modèle de réseau de résistance sur état avec SP
Le plafond p-GaN peut être considéré comme complètement épuisé, donc x D est égal à 105 nm, l'épaisseur de p-GaN. Par rapport à R 1 , R 2 et R 3 sont bien inférieurs à R 1 , en raison de leur concentration en électrons plus élevée et de leur chemin conducteur plus court. Par conséquent, la résistance dans le canal 2-DEG peut être ignorée. De plus, lorsque la tension de drain est faible et que les transistors de type MIS M 1 et M 2 travailler dans le modèle non saturé, la résistance à l'état passant de M 1 et M 2 peut être considérée comme une résistance constante R ignorable n . Pour simplifier le calcul, la forme analytique de la conductance du chemin de courant vertical G v du chemin de courant vertical peut être obtenu comme
$$ {G}_v={\int}_0^{L_D}\frac{1}{R_1}={\int}_0^{L_D}{n}_1 q\mu \bullet \frac{dx\bullet { W}_D}{l} $$où L D est la longueur de l'appareil.
Par conséquent, la résistance à l'état passant R sur peut être obtenu, qui lit
$$ {R}_{on}=\frac{1}{G_v}+{R}_n=\frac{1}{n_1 q\mu}\bullet \frac{l}{L_D\bullet {W}_D }+{R}_n $$Lorsque SP existe, comme le montre la figure 4b, le chemin conducteur vertical a été partiellement bloqué. Ainsi, la conductance du chemin de courant vertical peut être exprimée sous la forme
$$ {G}_v={\int}_{L_W}^{L_{\mathrm{D}}}\frac{1}{R_1}={\int}_{L_W}^{L_D}{n} _1 q\mu \bullet \frac{dx\bullet {W}_D}{l} $$où L W est la longueur du SP.
Par conséquent, le R correspondant sur peut être exprimé comme
$$ {R}_{on}=\frac{1}{G_v}+{R}_n=\frac{1}{n_1 q\mu}\bullet \frac{l}{\left({L}_D -{L}_W\right)\bullet {W}_D}+{R}_n $$À l'état éteint, en raison de la fonctionnalité de type condensateur et du piège d'interface chargé négativement, le SP redistribuerait efficacement le champ électrique sous le capuchon p-GaN, produisant une concentration de champ autour du SP qui possède une bande interdite plus large, comme indiqué dans Fig. 5. Une telle redistribution du champ E réduit la région d'appauvrissement qui apparaît autour du p-GaN et de la grille, et soulage ainsi la forte concentration de champ autour du capuchon p-GaN et de la grille, ce qui améliorerait le BV du SP-VFET remarquablement. D'autre part, comme mentionné ci-dessus, le SP influencerait la conductance du dispositif de telle sorte que la charge négative introduite par le SP entraîne une augmentation de l'énergie potentielle près de la grille, ce qui explique la diminution de 2-DEG près de la grille. En conséquence, un BFOM fluctuant serait obtenu en faisant varier la longueur et la hauteur du SP.
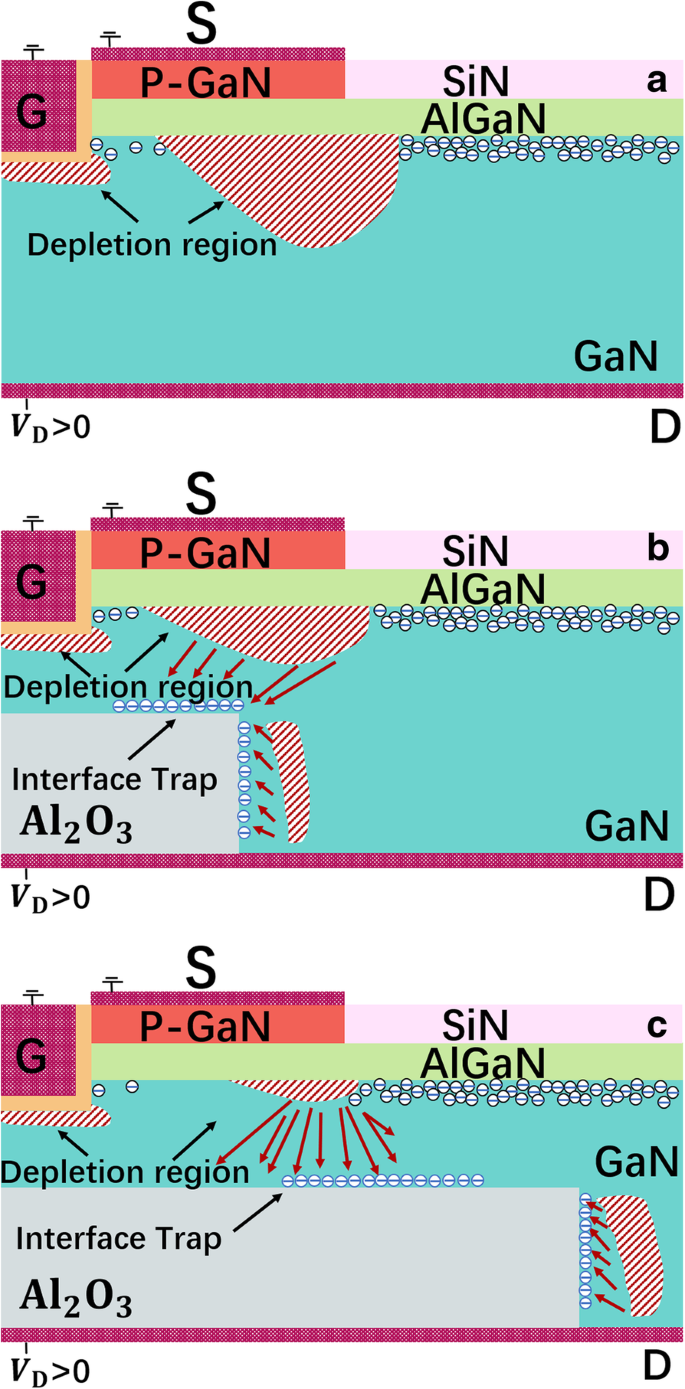
La distribution schématique du champ électrique et de la région d'épuisement dans a l'appareil sans le SP, b le SP-VFET proposé avec un SP court, et c le SP-VFET proposé avec un SP long
En d'autres termes, le SP pourrait réduire le pic du champ E autour du coin p-GaN et simultanément, attirer le champ E se concentrant à travers le SP, comme le montre la Fig. 6a, b. Cependant, grâce au champ E critique plus élevé du SP, une telle concentration de champ E ne briserait pas le dispositif, par lequel le SP-VFET présenterait une BV beaucoup plus élevée.
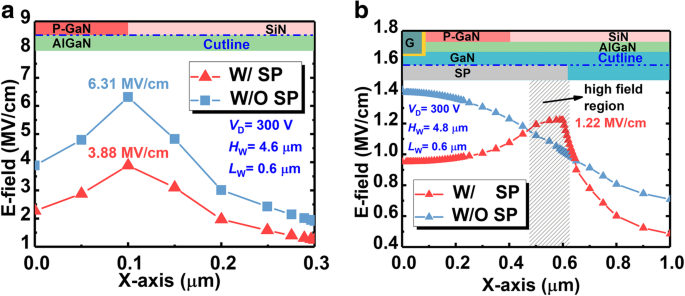
La distribution du champ électrique du SP-VFET proposé le long de l'interface de a p-GaN/AlGaN et b GaN/SP
Résultat et discussion
La figure 7a, b montre respectivement les courbes de transfert et de sortie du dispositif proposé sans le SP. Avec une longueur différente du capuchon p-GaN, ces courbes se superposent dans les régimes sous-seuil et d'activation, suggérant que la longueur du capuchon p-GaN n'influence pas la conductance de l'appareil sans le SP. En d'autres termes, bien que le plafond p-GaN épuiserait partiellement le 2-DEG et affecterait ainsi la résistance du canal 2-DEG, le 2-DEG restant possède toujours une grande concentration n 3 qui se rapproche de la concentration non appauvrie n 2 , qui est réalisé en optimisant la concentration de type p dans le cap de p-GaN. De plus, comme analysé précédemment, la résistance du canal 2-DEG est plutôt faible par rapport à la résistance du n-GaN dans le trajet vertical. Par conséquent, les courbes de transfert se superposent sur les Fig. 7a, b. Cependant, afin de protéger la grille du champ E hautement concentré, un tel encombrement ne doit pas être adjacent à la grille, ce qui signifie que la longueur du p-GaN ne peut pas être trop courte. Ainsi, la longueur minimale du p-GaN dans notre travail est de 400 nm, sauf indication contraire.
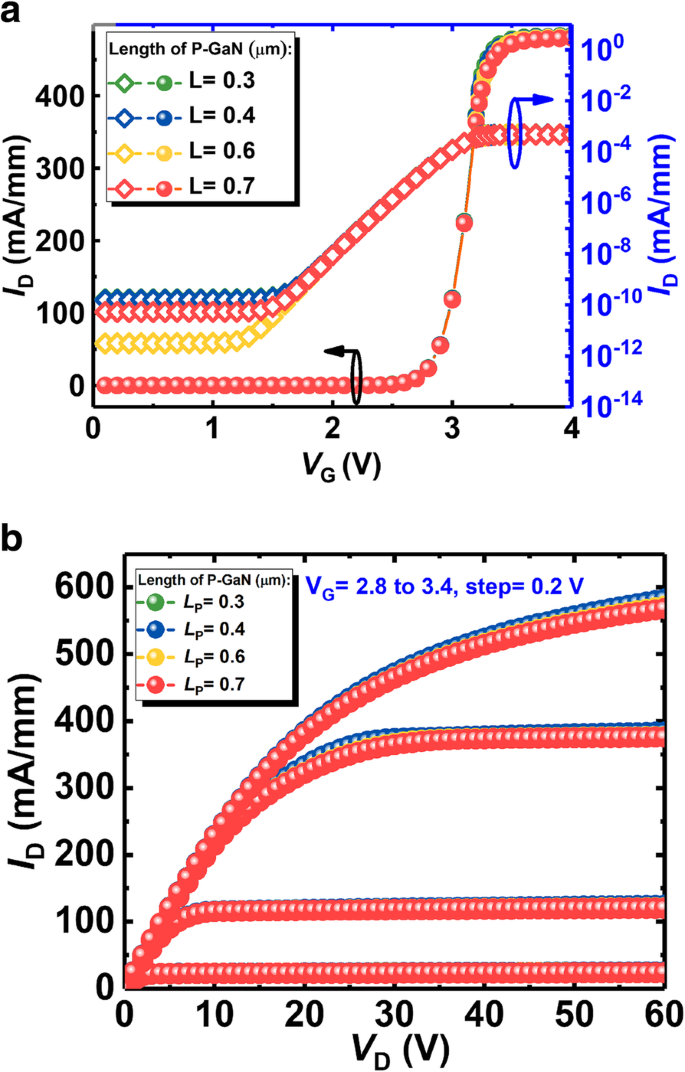
un Les courbes de transfert et b courbes de sortie de l'appareil sans le SP dans différentes longueurs du capuchon p-GaN
La figure 8 montre les caractéristiques de sortie du SP-VFET proposé et du VFET sans le SP. On peut voir que le SP impose la résistance du dispositif en rétrécissant le canal de conduction vertical. En détail, la résistance à l'état passant est indépendante de la hauteur du SP lorsque la hauteur est inférieure à 4,7 μm, tandis qu'elle dépend de manière significative de la longueur du SP qui correspond au mécanisme selon lequel le chemin de courant vertical étroit réduit la conductance. La première indépendance est due au fait que le 2DEG est le principal canal de conduction latéral qui ne serait pas affaibli par le SP dans sa hauteur modérée. Cependant, si le SP est adjacent au canal 2-DEG, la charge négative introduite autour du SP nivellera la bande d'énergie, entraînant une diminution spectaculaire de la concentration de 2-DEG. Par conséquent, la résistance du 2-DEG augmente et la résistance totale à l'état passant R sur augmente en conséquence. En outre, la dépendance ultérieure provient de la résistance remarquablement renforcée dans le canal vertical, comme mentionné ci-dessus. De plus, il convient de noter que les défauts de réseau en 2-DEG induits par un SP élevé limitent la hauteur de SP.
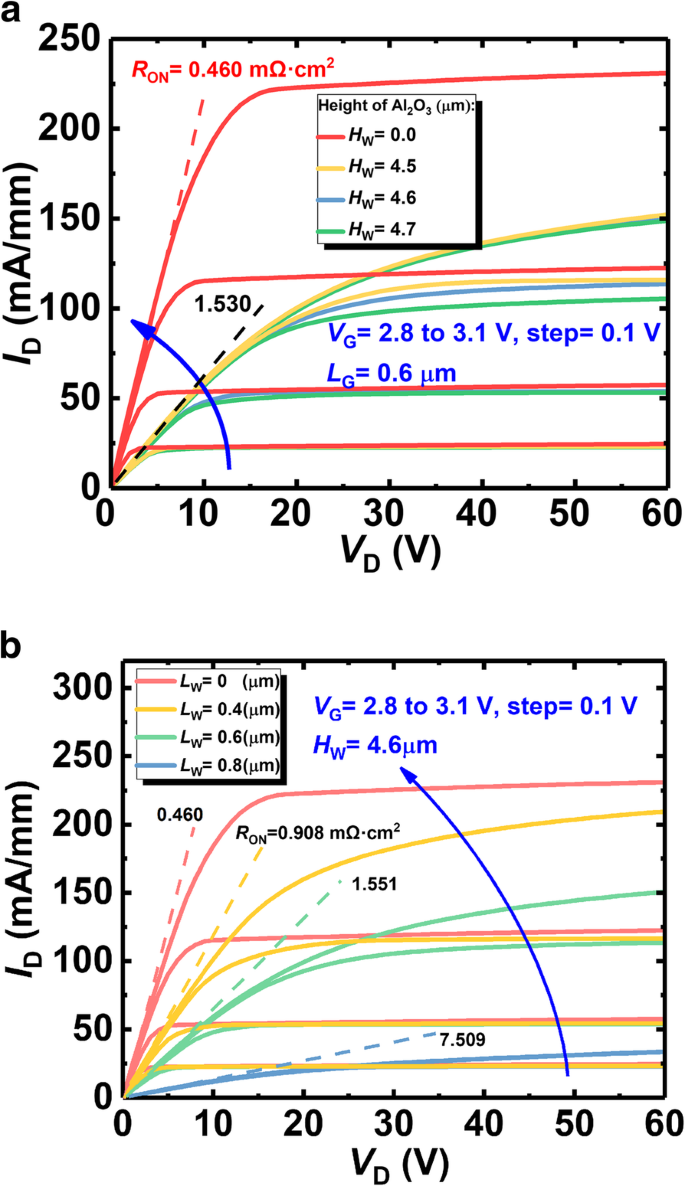
Les courbes de sortie du SP-VFET proposé avec a variable Largeur SP et b Longueur SP par rapport à l'appareil sans SP
La figure 9 montre les détails de la distribution de la densité de courant autour de la grille des dispositifs VFET avec ou sans SP, dans laquelle le VFET sans SP a une capacité de transport de courant plus élevée qui reste conforme à la figure 8a. Et à l'inverse, le SP-VFET réduit la conduction du courant en rétrécissant le canal vertical. Pendant ce temps, les figures détaillées illustrent clairement que le courant dans le canal latéral est transporté par le 2DEG, et la densité de courant totale change légèrement avec la hauteur de SP croissante, ce qui est également démontré dans la section du mécanisme. Les résultats indiquent que la résistance du canal latéral n'est pas imposée notamment par le SP dans une hauteur modérée.
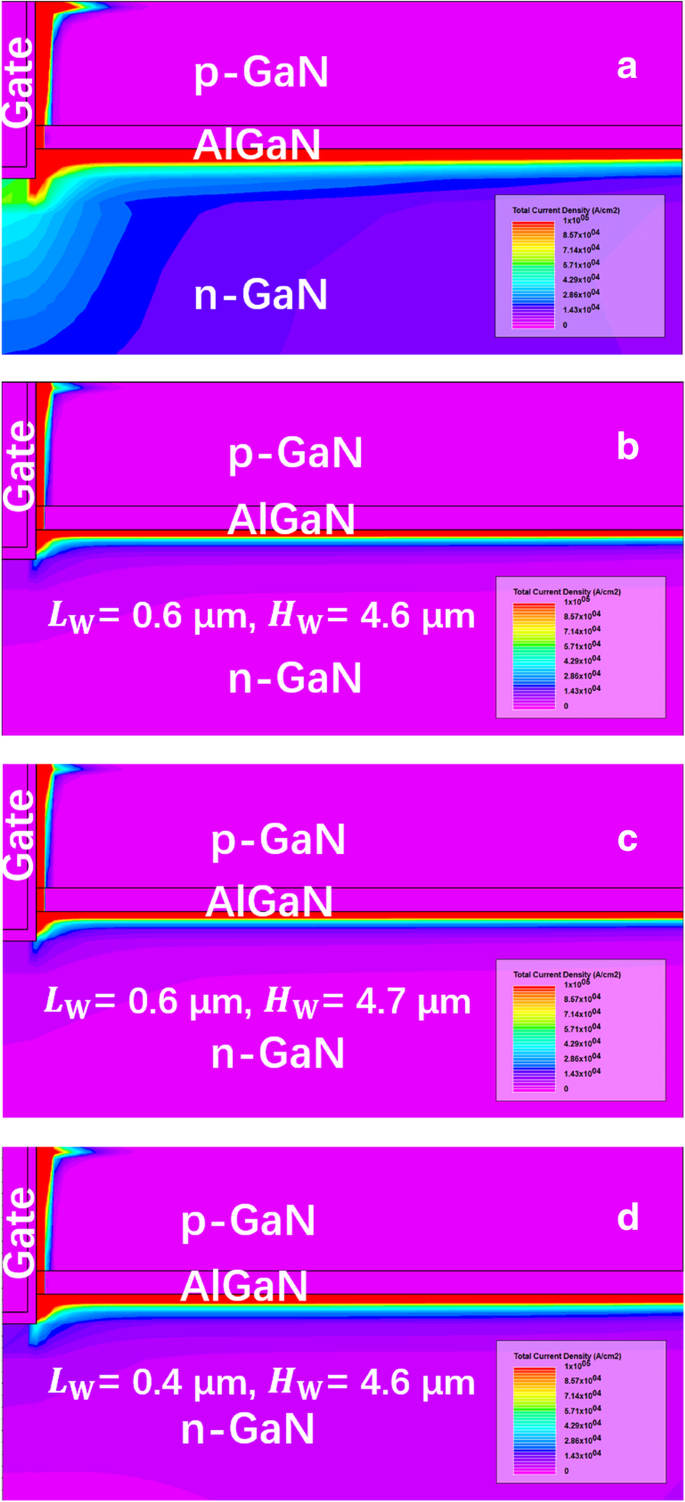
La densité actuelle de a l'appareil sans le SP et b –d le SP-VFET proposé avec différents paramètres géométriques SP
La figure 10a montre la résistance à l'état passant extraite et le BV correspondant. La résistance du SP-VFET augmente avec un SP plus long. Et surtout, la courbe de la résistance en fonction de la longueur SP présente une tendance hyperbolique, et le gradient de la courbe augmente avec la longueur SP plus longue. Comme analysé précédemment, R sur varie avec différentes longueurs de SP L W sous une forme de fonction hyperbolique, qui correspond au résultat de la simulation. De plus, la courbe de la résistance avec différentes hauteurs de SP se superpose car la hauteur est inférieure à 4,7 μm, ce qui suggère que le canal 2-DEG est le principal chemin conducteur latéral et que le canal 2-DEG n'est pas affecté, comme mentionné ci-dessus.
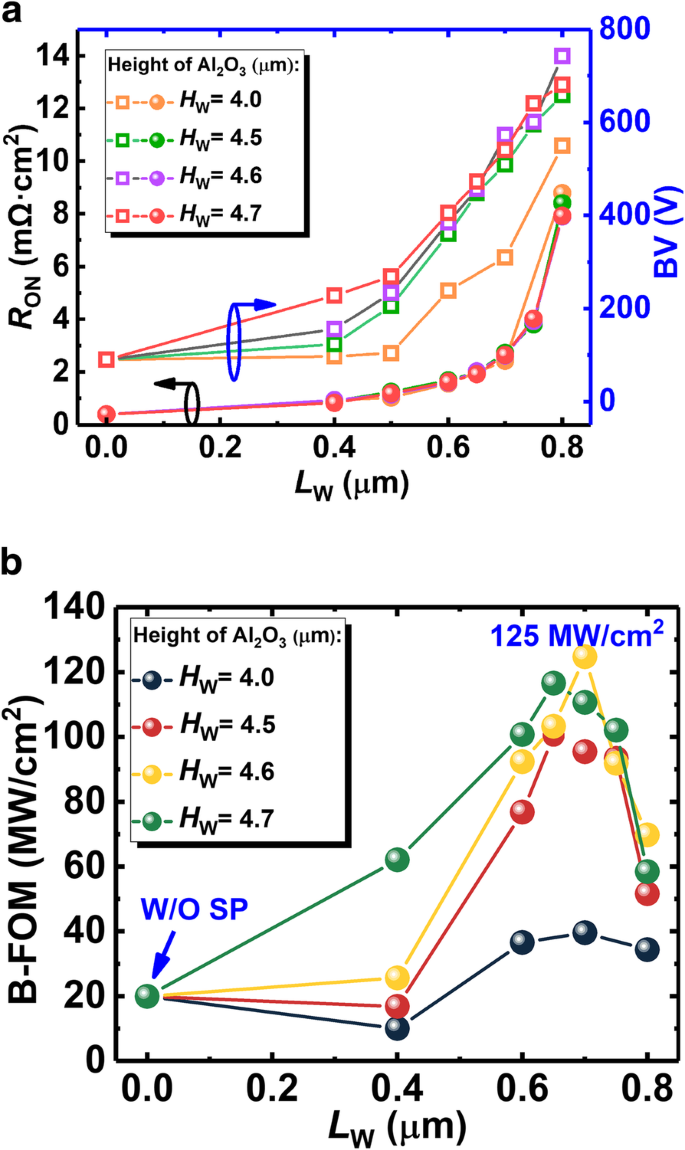
un La résistance à l'état activée extraite ainsi que BV, et b le BFOM correspondant du SP-VFET proposé dans différentes longueurs et largeurs de SP
La figure 10b montre le BFOM calculé du SP-VFET. En raison du taux d'augmentation différent du BV et de la résistance à l'état passant, le BFOM de tous les appareils augmente d'abord, puis diminue après la longueur du SP supérieure à 400 nm. Un BFOM de pointe de 125 MW/cm 2 est atteint lorsque la longueur atteint 700 nm et la hauteur atteint 4,6 μm. Par rapport à l'appareil sans le SP, le SP-VFET proposé est plus de six fois plus performant en termes de BFOM.
Cette amélioration est obtenue grâce à la suppression du champ E élevé sous le p-GaN, grâce au piège d'interface chargé négativement autour du SP. L'interaction, qui se produit entre la charge négative piégée à l'interface du SP et la région d'appauvrissement autour du p-GaN, forme une nouvelle distribution du champ E principalement vers la charge piégée. D'après la loi de Gauss, le flux électrique est limité par la charge encerclée. Ainsi, le champ E introduit affectera le flux électrique vers ailleurs. Comme la charge négative de la région d'appauvrissement est la principale source du champ E envahi autour de p-GaN, le champ E introduit par la charge piégée jouera un rôle dans la suppression du champ E autour de p-GaN, et par conséquent, BV est amélioré. Plus précisément, lorsque la longueur de SP est inférieure à 400 nm, la charge négative introduite par SP est éloignée de la région d'appauvrissement. Ainsi, le champ E formé entre la région d'appauvrissement et la charge négative piégée est trop petit pour jouer un rôle dans l'incidence du champ E saturé sous p-GaN. Et en conséquence, le BV de l'appareil augmente légèrement. Cependant, comme la longueur du SP est supérieure à 400 nm, en raison de la charge négative plus piégée à l'interface du SP et de la distance plus courte entre la région d'épuisement et la charge négative piégée, le champ E entre la région d'épuisement et la charge négative piégée est amélioré, conduisant à la croissance de la BV.
De plus, la région autour du SP est considérablement épuisée en raison de la charge négative introduite par SP. Et comme le montre la Fig. 11, avec le SP plus long, le chemin du courant de fuite vertical se resserre en largeur en raison de la région appauvrie qui se resserre sur le bord de l'appareil, ce qui bloque également le courant de fuite et améliore par conséquent le BV. Par conséquent, le BV augmente remarquablement avec l'augmentation de la longueur du SP.
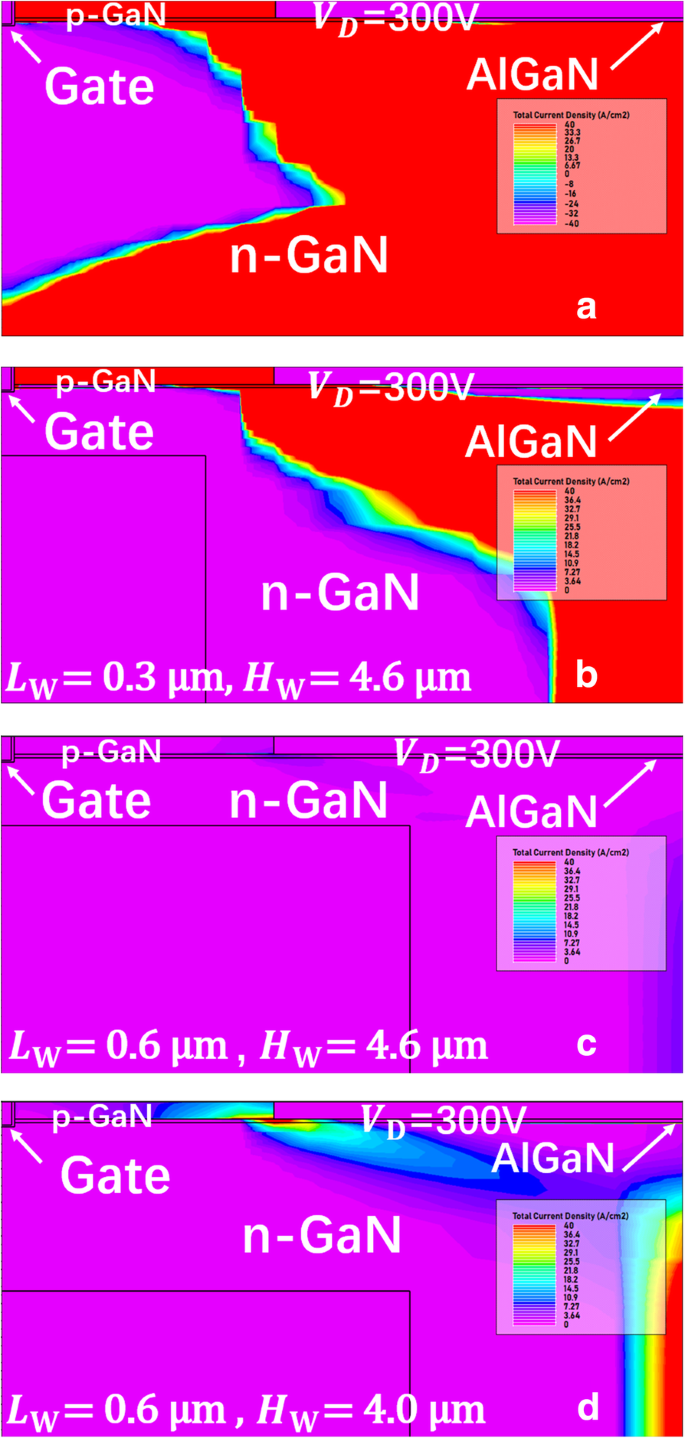
La densité de courant de fuite de a l'appareil sans le SP et b –d le SP-VFET proposé avec différents paramètres géométriques SP
La figure 12 montre la distribution simulée du champ E dans le SP-VFET lorsque la tension de drain est de 300 V, où apparemment le SP induit d'autres nouveaux points de concentration de champ E, ce qui signifie que la région de pic du champ E sous le p-GaN est supprimée . Par rapport à la distribution du champ E dans les appareils avec une hauteur SP différente, l'augmentation de la longueur SP supprime la congrégation du champ E et améliore par conséquent le BV plus efficacement.

La distribution du champ E autour de la grille du VFET a avec ou b –d sans le SP lorsque la tension de drain est de 300 V
Un tel champ E aplati pourrait également être observé explicitement sur la figure 13, dans laquelle les distributions de champ E le long du bord horizontal et perpendiculaire du SP (voir la ligne de coupe) sont tracées. Comme le démontre la polychromie de la Fig. 12, on peut voir sur la Fig. 13 qu'un SP plus élevé et plus long joue un rôle de plus en plus efficace dans la reconstruction du champ E sous p-GaN et, en attirant le champ E pour se concentrer à travers le SP bord. Cette redistribution contrecarre le champ E autour du p-GaN vulnérable. Ainsi, le BV de l'appareil est amélioré, augmentant le B-FOM du SP-VFET proposé.
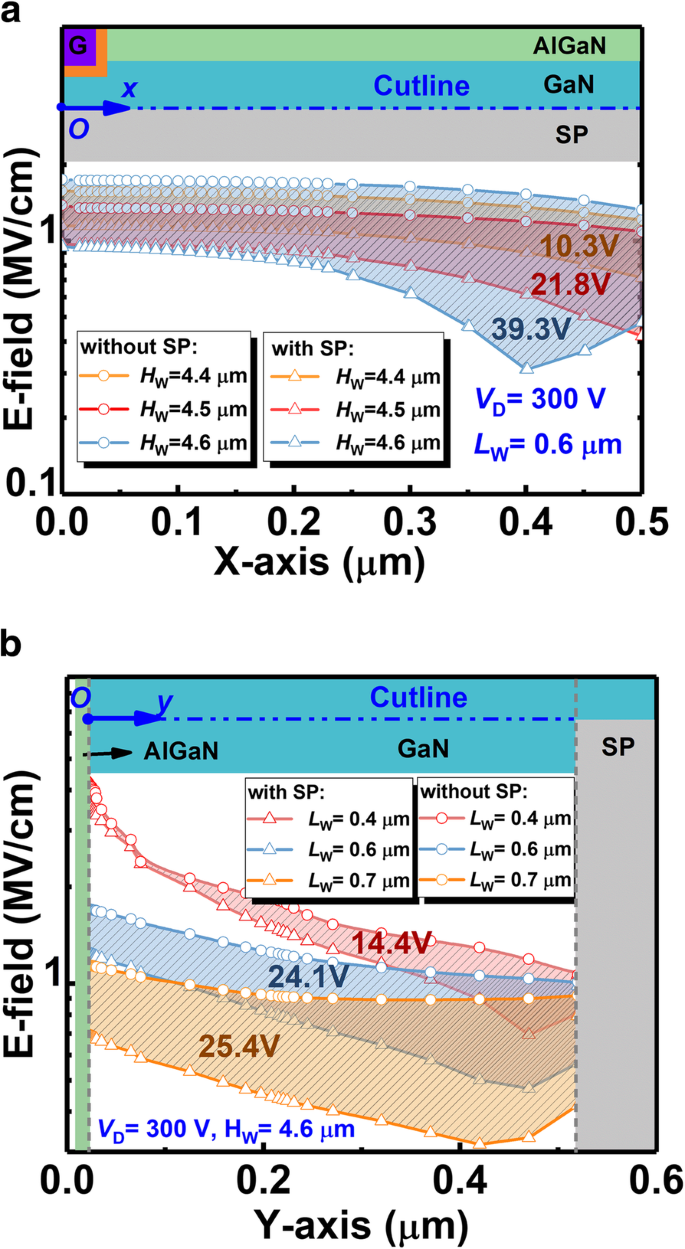
La distribution du champ E a horizontalement et b extrait perpendiculairement le long de la ligne de coupe du bord SP dans le SP-VFET
Conclusion
Dans ce travail, un nouveau FET vertical GaN de type amélioration (SP-VFET) avec canal 2DEG et motif de substrat pour améliorer le BFOM de celui-ci est proposé et étudié. Vérifié par une simulation étalonnée expérimentalement mise en œuvre avec ATLAS, c'est le SP qui soulage le pic de champ E sous le p-GaN et, simultanément, attire une nouvelle concentration de champ E à travers le SP qui possède un champ E critique plus élevé. Par conséquent, le BV du SP-VFET proposé est augmenté avec une résistance à l'état passant modérément croissante en raison de la compensation 2DEG. Le BFOM du SP-VFET est donc amélioré six fois mieux que celui de l'appareil sans le SP lorsque la longueur et la hauteur du SP sont respectivement de 700 nm et de 4,6 µm, ce qui rend le potentiel prometteur du SP-VFET proposé en puissance haute densité. intégration.
Abréviations
- n A :
-
Concentration de dopage en GaN de type p
- n D :
-
Concentration de dopage en GaN de type n
- 2DEG :
-
Gaz d'électrons bidimensionnel
- Al0.23 GaN :
-
Nitrure d'aluminium et de gallium avec une fraction molaire de 0,23 pour l'aluminium
- Al2 O3 :
-
Oxyde d'aluminium
- BFOM :
-
Figure de mérite de Baliga
- D SP :
-
Densité de piège d'interface du motif de substrat
- Champ E :
-
Champ électrique
- E T :
-
La différence entre la bande de conduction et le niveau d'énergie du piège de l'interface
- FET :
-
Transistor à effet de champ
- GaN :
-
Nitrure de gallium
- HEMT :
-
Transistor à haute mobilité électronique
- H G :
-
Hauteur du portail
- H W :
-
Hauteur du motif du substrat
- L D :
-
Longueur de l'appareil
- L G :
-
Longueur de la porte
- L P :
-
Longueur du capuchon p-GaN
- L W :
-
Longueur du motif du substrat
- SiN :
-
Nitrure de silicium
- SP :
-
Motif de substrat
- SP-VFET :
-
Transistor à effet de champ vertical avec motif de substrat
- W D :
-
Profondeur de l'appareil
- σ p :
-
Frais de polarisation
Nanomatériaux
- En route avec l'IoT
- Impact des états de surface et de la fraction molaire d'aluminium sur le potentiel de surface et 2DEG dans les HEMT AlGaN/GaN
- Modulation des propriétés d'anisotropie électronique et optique du ML-GaS par champ électrique vertical
- L'effet du plasma de contact hors équilibre sur les propriétés structurelles et magnétiques des spinelles Mn Х Fe3 − X О4
- Effet du traitement de recuit in situ sur la mobilité et la morphologie des transistors à effet de champ organiques à base de TIPS-Pentacène
- Synthèse contrôlée de BaYF5:Er3+, Yb3+ avec une morphologie différente pour l'amélioration de la luminescence de conversion ascendante
- Effets de photoconductivité, de sensibilité au pH, de bruit et de longueur de canal dans les capteurs FET à nanofil Si
- Synthèse verte de nanoparticules de métal et d'oxyde métallique et leur effet sur l'algue unicellulaire Chlamydomonas reinhardtii
- Effet de la morphologie et de la structure cristalline sur la conductivité thermique des nanotubes de titane



