Effet de résistance différentielle négative dans un dispositif RRAM à base de Ru fabriqué par dépôt de couche atomique
Résumé
Dans ce travail, les dispositifs RRAM à base de Ru avec couche atomique déposés AlOy /HfOx couche fonctionnelle ont été fabriqués et étudiés. Un comportement de résistance différentielle négative (NDR) a été observé pendant le processus de réglage de la tension et son origine physique a été explorée. Sur la base de la compréhension de la physique de la commutation résistive, on pense que le comportement NDR mesuré est associé à l'effet de réinitialisation partiellement unipolaire, qui est dû à la recombinaison entre les lacunes d'oxygène et les ions d'oxygène thermiquement libérés du RuO2 couche d'interface. Les caractéristiques électriques mesurées et les résultats de la spectroscopie photoélectronique à rayons X (XPS) ont vérifié l'interprétation physique.
Introduction
En tant que l'une des mémoires non volatiles émergentes les plus prometteuses, la mémoire résistive à accès aléatoire (RRAM) a été largement étudiée en ce qui concerne l'optimisation des matériaux, l'amélioration des performances et l'intégration de dispositifs [1,2,3,4]. En raison des avantages importants tels qu'une structure cellulaire simple, une vitesse de fonctionnement rapide, une faible consommation d'énergie et un potentiel de miniaturisation incomparable [5], la RRAM a été largement appliquée dans le calcul neuromorphique inspiré du cerveau et la logique booléenne reconfigurable [6,7,8,9 ,10] et présente également un grand potentiel pour les applications de mémoire de classe de stockage (SCM) [11]. Cependant, comme l'indique la feuille de route internationale pour les appareils et les systèmes 2017 (https://irds.ieee.org/images/files/pdf/2017/2017IRDS_ES.pdf), des défis tels que l'évolutivité, la fiabilité des appareils et la compatibilité des processus continuent d'entraver Les développements de RRAM. Par conséquent, la construction de dispositifs RRAM compatibles CMOS avec des performances supérieures est d'une grande importance pour les applications basées sur la structure 1T1R de la cellule RRAM [12,13,14]. Selon une étude précédente [15], un dispositif RRAM à base de Ru montre un grand potentiel par rapport à ceux à base de Pt, tandis que la résistance différentielle négative (NDR) a été démontrée lors d'un processus de réglage de tension. Les phénomènes NDR accompagnés de commutation résistive ont été étudiés dans d'autres structures RRAM, qui étaient principalement dus au piège/détrap de porteurs électroniques entre des états profondément localisés induits par des nanoparticules métalliques implantées [16, 17], ou à l'accumulation de défauts provoqués par la réinstallation de jonctions. [18]. Alors que l'apparition de NDR dans une cellule RRAM à base de Ru sous un courant important est toujours en suspens, dans ce travail, les performances électriques d'un dispositif RRAM à base de Ru fabriqué par la technique de dépôt de couche atomique (ALD) ont été évaluées. Sur la base de la caractérisation de la spectroscopie photoélectronique aux rayons X (XPS) et des mesures électriques avec différents stimulus, le phénomène NDR dans la RRAM à base de Ru peut être expliqué dans le cadre du modèle de filament conducteur à vide d'oxygène.
Méthodes
Le schéma de principe de la structure de l'appareil et de la matrice RRAM fabriquée sont illustrés respectivement aux Fig. 1a, b. Le Ru/AlOy /HfOx Le dispositif /TiN RRAM a été fabriqué sur un SiO2 300 nm oxydé thermiquement substrat. Un film mince de Ru de 80 nm a été déposé sur une couche d'adhérence de Ti de 20 nm en tant qu'électrode inférieure par pulvérisation cathodique magnétron DC (Angstrom Engineering NEXDEP) en utilisant une cible métallique de Ru. SiO2 développé par dépôt chimique en phase vapeur assisté par plasma (PECVD) sert de diélectrique pour isoler les électrodes et forme les vias. Puis la couche résistive de 2 nm AlOy et 3 nm HfOx a été déposé par un système de dépôt par couche atomique (PICOSUN R200) à 300 °C avec des précurseurs de triméthylaluminium (TMA) et de tétrakis[éthylméthylamino]hafnium (TEMAH). Après cela, 80 nm TiN a été pulvérisé réactif à l'aide d'une cible de Ti et gravé pour former les motifs d'électrode supérieure. Une autre gravure à sec a également été effectuée pour exposer l'électrode inférieure pour un contact électrique.
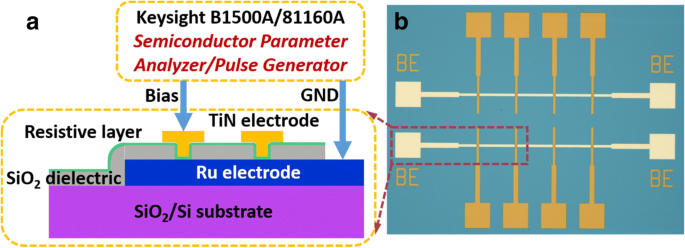
un Diagramme schématique d'un appareil à base de Ru. b Matrice RRAM fabriquée
L'analyse des éléments a été effectuée par un système de spectroscopie photoélectronique à rayons X (XPS) (Thermo Scientific ESCALAB 250Xi) en utilisant l'échantillon frais sans électrode supérieure. Avant la mesure, un nettoyage de surface a été effectué avec un plasma d'Ar avant la mesure pour éliminer l'influence de C. La position du pic de Al 2p a été utilisée pour l'étalonnage. Les mesures électriques ont été effectuées à température ambiante par un analyseur de dispositifs à semi-conducteurs (Agilent B1500A) et un générateur arbitraire à fonction d'impulsion (Agilent 81160A).
Résultats et discussion
Les caractéristiques IV typiques des dispositifs RRAM à base de Ru sont illustrées à la Fig. 2a. Après l'électroformage, une tension positive (2,5 V) a été appliquée pour le processus défini pour faire passer la cellule de l'état de haute résistance (HRS) à l'état de faible résistance (LRS) avec un courant de conformité de 1 mA pour éviter la panne permanente pendant la conduction formation de filaments (CF). Après la transition définie, une tension négative (− 2,3 V) a été utilisée pour faire passer l'appareil de LRS à HRS avec un courant décroissant progressivement. Afin d'évaluer la variabilité de la résistance d'un appareil à l'autre, 10 cellules RRAM à base de Ru ont été choisies arbitrairement. Comme le montre la figure 2b, les résultats statistiques démontrent l'excellente uniformité de HRS et LRS avec une fenêtre de résistance supérieure à 10 3 , qui pourrait être un candidat prometteur pour les applications logiques basées sur NVM. Par rapport aux dispositifs à base de Pt précédemment rapportés [2], il convient de noter qu'un phénomène NDR a été observé pendant le processus de réglage, où le courant diminue avec l'augmentation de la tension (set-phase 1) dans une échelle de tension limitée suivie d'une augmentation au courant de conformité (set-phase 2).

un Caractéristiques CC. b Distributions statistiques HRS/LRS de 10 dispositifs RRAM basés sur Ru
La variabilité cycle à cycle des dispositifs RRAM à base de Ru a également été étudiée en mode impulsion pour étudier l'uniformité du cycle. Les impulsions de réglage (2,4 V, 15 ns) et d'impulsion (− 3 V, 100 ns) sont utilisées pour basculer l'appareil entre LRS et HRS avec une tension de lecture de 0,1 V après chaque impulsion. Comme le montre la figure 3a, l'appareil de 1 000 cycles a une distribution uniforme avec des écarts types de 379 Ω et 3 × 10 5 Ω pour LRS et HRS, ce qui se traduit par une fenêtre de mémoire stable supérieure à 100. Aucune dégradation de l'endurance ne se produit même après 10 6 cycles de commutation comme indiqué précédemment dans la Réf. [15]. De plus, l'appareil démontre également une excellente propriété de rétention, comme le montre la figure 3b. Les résistances LRS et HRS maintiennent une valeur constante supérieure à 10 5 s à 120 °C sans défaillance.

un 1000 cycles d'endurance. b Comportement de rétention à haute température d'un Ru/AlOy /HfOx /Périphérique TiN RRAM
Afin d'explorer le phénomène NDR, le I–V les courbes ont été mesurées à la fois en mode de balayage de tension et en mode de balayage de courant. La figure 4a montre le processus de formation de cinq nouvelles cellules RRAM sélectionnées au hasard. Le courant augmente progressivement suivi d'un décollement, indiquant la formation de CF, alors qu'aucun NDR n'a été observé. Après l'électroformage, des opérations définies dans différents modes de balayage sont effectuées dans la même cellule afin d'observer la variation de courant, comme le montre la figure 4b. Pour l'ensemble entraîné par le courant, le courant augmente lentement avec une diminution soudaine de la tension, démontrant la transition de la résistance de HRS à LRS. Ce comportement est distinct de la caractéristique qui est entraînée par la tension, qui pourrait être due aux différents échauffements Joule induits par les stimuli à travers le CF. De plus, des opérations de réglage/réinitialisation consécutives sous différents biais ont été effectuées pour étudier l'état de résistance intermédiaire dans la région NDR. Une tension d'arrêt appropriée de 1 V a été appliquée pendant le processus de réglage, comme le montre la figure 4c, pour terminer le balayage au fond de la vallée. Un état de résistance non volatile a été obtenu après la suppression de la tension, ce qui a présenté un comportement de commutation résistive unipolaire. Par conséquent, ce phénomène de NDR est provisoirement attribué à une deuxième réinitialisation du CF au cours du processus de définition.
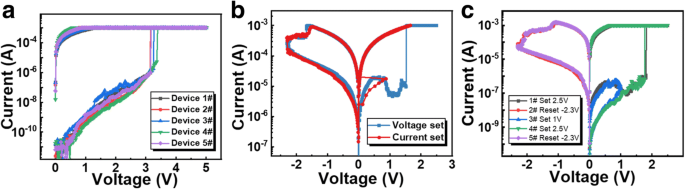
un Formation de tension de cinq dispositifs RRAM à base de Ru. b Processus définis par tension et par courant dans la même cellule RRAM. c Processus de réglage incomplet avec la tension d'arrêt au fond de la vallée actuelle
Combiné avec les mesures dans différents modes et procédés de fabrication de dispositifs ainsi que les propriétés de RuO2 , l'origine physique du phénomène NDR a été proposée, comme illustré sur la Fig. 5. Une étude précédente [19, 20] a suggéré que la génération et la recombinaison de la lacune d'oxygène appauvri en électrons (V o ) et l'ion oxygène (O 2− ) sous différentes polarités électriques sont responsables du HfOx conventionnel -Des dispositifs RRAM bipolaires basés sur, qui sont similaires aux processus de mise en phase 2 et de réinitialisation. Cependant, contrairement au processus de prise classique, une seconde rupture du CF a lieu déconnectant l'électrode Ru et le CF et conduisant au NDR. En général, les atomes d'oxygène se dissocient en V o et O 2− sous champ électrique avec la dérive de l'O 2− à l'électrode supérieure, en laissant le V o pour former le CF qui est utilisé pour le transport des électrons. Mais en raison de l'échauffement Joule causé par le champ électrique, le RuO2 formé la couche d'interface se décompose lentement à ~ 600 °C et libère O 2− qui pourrait se recombiner avec le V appauvri en électrons o (V o 2+ ) près de l'électrode Ru (set-phase 1) [21], entraînant une diminution du courant. Ce processus peut également être considéré comme un processus de réinitialisation unipolaire partiel. Avec la tension croissante, le CF entre TE et BE sera reconstruit par une accumulation de V o comme indiqué dans la phase de réglage 2 et les commutateurs de cellule RRAM vers LRS. Lors de la réinitialisation, deux processus ont lieu simultanément :(1) le O 2− libéré de l'électrode TiN se recombinent rapidement avec le V chargé positivement o en raison de la section de capture améliorée, (2) le O 2− dérive vers BE réagit avec Ru et reforme le RuO2 couche d'interface due à l'échauffement Joule local [22]. A cette condition, la cellule RRAM passe en HRS.

Processus physiques de commutation résistive dans une RRAM à base de Ru. un Effet NDR (set-phase 1). b Processus communs SET (set-phase 2). c Processus de RESET de l'appareil
Analyse XPS du RuO2 couche d'interface, qui a été formée pendant le processus de fabrication du dispositif, prend également en charge l'explication proposée de l'effet NDR. La figure 6a montre le spectre complet XPS de l'échantillon, qui comprend les niveaux de noyau O 1s, Ru 3d, Al 2p et Hf 4f. Les autres pics non marqués correspondent tous à ces éléments avec des orbites d'électrons différentes. La courbe d'ajustement de la Fig. 6b correspond parfaitement aux données expérimentales et est divisée en quatre pics, qui correspondent au Ru 3d5/2 (280,01 eV pour Ru et 280,75 eV pour RuO2 ) et Ru 3d3/2 (284,3 eV pour Ru et 285,26 eV pour RuO2 ) niveaux de base, démontrant la coexistence du Ru et RuO2 dans le film mince [23]. La faible intensité de Ru 3d5/2 pic indique que le RuO2 formé la couche d'interface est très fine comme nous l'avions prévu.

Spectres XPS de a Ru/AlOy /HfOx film mince et b Ru niveau de base 3D. Le RuO2 film mince entre Ru et AlOy formulaires pendant le processus ALD [18]
Conclusion
Dans cette étude, le Ru/AlOy compatible CMOS /HfOx /TiN RRAM a été fabriqué. L'excellente performance de commutation a été obtenue avec une résistance uniforme d'un appareil à l'autre et une grande fenêtre de résistance ainsi qu'une bonne propriété de rétention à haute température. Sur la base des mesures électriques et de l'analyse XPS, le phénomène NDR dans le processus défini peut être expliqué par la recombinaison des lacunes d'oxygène et des ions oxygène libérés par le RuO2 couche d'interface due au chauffage Joule induit par l'électricité.
Abréviations
- ALD :
-
Dépôt de couche atomique
- CF :
-
Filament conducteur
- HRS :
-
État de haute résistance
- LRS :
-
État de faible résistance
- NDR :
-
Résistance différentielle négative
- PECVD :
-
Dépôt chimique en phase vapeur amélioré par plasma
- RRAM :
-
Mémoire vive résistive
- GDS :
-
Mémoire de classe de stockage
- XPS :
-
Spectroscopie photoélectronique aux rayons X
Nanomatériaux
- Qu'est-ce que l'effet de peau ?
- Technologies avancées de dépôt de couche atomique pour les micro-LED et les VCSEL
- Caractéristiques de commutation résistive bipolaire des dispositifs RRAM à structure tricouche HfO2/TiO2/HfO2 sur des substrats revêtus de Pt et de TiN fabriqués par dépôt de couche atomique
- Caractéristiques d'alignement interfacial, électrique et de bande des piles HfO2/Ge avec une couche intermédiaire de SiO2 formée in situ par dépôt de couche atomique amélioré par plasma
- L'effet des anions sulfate sur la nucléation ultrafine du titane
- Les nanofibres hiérarchiques antibactériennes en polyamide 6-ZnO fabriquées par dépôt de couche atomique et croissance hydrothermale
- Propriétés photocatalytiques des poudres de TiO2 revêtues de Co3O4 préparées par dépôt de couche atomique amélioré par plasma
- Réglage au niveau de Fermi des films ZnO par dépôt de couche atomique supercyclée
- Effets des variations de gravure sur la formation de canaux Ge/Si et les performances de l'appareil



