Propriétés électriques des super-réseaux InAs/GaSb à ondes moyennes et longues cultivées sur des substrats GaAs par épitaxie par faisceau moléculaire
Résumé
Dans le présent travail, nous rapportons les propriétés de transport électrique dans le plan des super-réseaux InAs/GaSb de type II à ondes moyennes (MWIR) et infrarouges à ondes longues (LWIR) (T2SL) cultivés par un système d'épitaxie par faisceau moléculaire (MBE) sur GaAs (001) substrat. L'énorme décalage de réseau entre le substrat T2SL et GaAs est réduit par la croissance de la couche tampon GaSb basée sur la technique du réseau interfacial misfit (IMF). Afin de compenser la contrainte dans le InAs/GaSb T2SL, nous avons utilisé une séquence d'obturateurs spéciale pour obtenir des interfaces de type InSb et GaAs. On constate que le MWIR InAs/GaSb T2SL présente un p - et n -type conduction à basses et hautes températures, respectivement. Il est intéressant de noter que la température de changement de conduction dépend de la température de croissance. D'autre part, la conduction LWIR T2SL n'est dominée que par les électrons. Il est important de noter que le mécanisme de diffusion dominant dans le LWIR T2SL à basse température est le mécanisme de diffusion de la rugosité de l'interface.
Contexte
Depuis InAs/GaSb T2SL a été conceptualisé par Sai-Halasz et al. [1] en 1977, une grande attention a été accordée à l'étude de ce matériau semi-conducteur. Les photodétecteurs basés sur ce T2SL présentent un potentiel théoriquement plus élevé que le tellurure de mercure et de cadmium (HgCdTe) et les systèmes de matériaux infrarouges de pointe pour la prochaine génération d'applications infrarouges (IR) [2, 3]. Il est intéressant de noter que InAs/GaSb T2SL présente une gamme inhabituelle de bandes interdites brisées de type II où le minimum de bande de conduction InAs est situé 140 meV plus bas que le sommet de la bande de valence GaSb [1]. Par conséquent, la transition fondamentale entre les sous-bandes de trous lourds et le fond de la bande de conduction dépend de l'épaisseur de la couche d'InAs ou de GaSb [4]. Cependant, le principal avantage de cet alignement est la réduction du taux de recombinaison Auger grâce à la suppression de certaines voies non radiatives dans la bande de valence [5]. De plus, l'effet tunnel de bande à bande est considérablement réduit en raison des grandes masses effectives (≈ 0,04 m 0 ) d'électrons et de trous [6]. Ces deux dernières caractéristiques permettent la réduction du courant d'obscurité, ce qui conduit à la température de fonctionnement élevée (HOT) du photodétecteur.
L'InAs/GaSb T2SL est traditionnellement cultivé sur un substrat GaSb adapté au réseau. Cependant, ce dernier est coûteux et disponible dans de petites tailles inférieures à 3 pouces, ce qui entrave la réalisation de réseaux plan focal (FPA) grand format. De plus, les substrats de GaSb ne sont pas « épi-prêts » et leurs surfaces de croissance contiennent de nombreux défauts macroscopiques [7]. De plus, le coefficient d'absorption est relativement élevé dans le substrat GaSb (≈ 100 cm −1 ) pour le rayonnement IR supérieur à 5 μm [8]. En raison de ses nombreux avantages, GaAs a été proposé comme un candidat viable pour la croissance de InAs/GaSb T2SL [9,10,11,12]. En effet, ils sont « épi-prêts », économiques et disponibles dans de grandes tailles jusqu'à 6 pouces. En outre, le GaAs a un coefficient d'absorption inférieur de deux ordres de grandeur à celui du GaSb. Malheureusement, un énorme décalage de réseau (~ 7,5 %) existe entre GaAs et InAs/GaSb T2SL, ce qui entraîne une densité élevée de dislocations de décalage (10 9 cm −2 ) [13]. Par conséquent, il est obligatoire de concevoir de nouvelles techniques de croissance pour soulager la contrainte et réduire la densité de luxation. Parmi ces techniques figurent la nucléation à basse température [14] et la technique IMF [15, 16].
Afin d'améliorer les performances des photodétecteurs à base d'InAs/GaSb T2SL, une meilleure compréhension des paramètres fondamentaux est nécessaire. L'un de ces paramètres est la concentration de fond en porteurs qui est associée à la durée de vie des porteurs minoritaires et aux longueurs de diffusion. Il convient de noter que les matériaux en vrac InAs et GaSb ont une polarité opposée de la concentration des porteurs. En effet, les matériaux InAs et GaSb cultivés par épitaxie par faisceau moléculaire (MBE) sont résiduellement n - et p -type, respectivement [17, 18]. Par conséquent, la conduction de l'InAs/GaSb T2SL devrait dépendre de l'épaisseur de chaque constituant.
Dans cet article, nous étudions les propriétés de transport dans le plan de 10 ML InAs/10 ML GaSb et 24 ML InAs/7 ML GaSb T2SL dédiés à la détection dans les régions MWIR et LWIR, respectivement, cultivés sur GaAs semi-isolant (001) substrats. Cette étude est réalisée en effectuant une mesure de l'effet Hall dépendant de la température en utilisant la méthode de Van der Pauw. Par ailleurs, l'influence de la température de croissance sur la conduction de l'InAs/GaSb T2SL est présentée.
Méthodes
Des échantillons d'InAs/GaSb T2SL ont été cultivés sur des substrats semi-isolants GaAs (001) dans un système MBE à source solide RIBER Compact 21-DZ. Ce dernier est équipé de cellules à épanchement standard pour les éléments du groupe III (indium (In) et gallium (Ga)) et de cellules craquées à valve pour les matériaux du groupe V (arsenic (As) et antimoine (Sb)). Les températures du craqueur ont été maintenues à 900 °C pour As et Sb afin de produire As2 et Sb2 , respectivement. Le thermocouple manipulateur (TC) et BandiT (BT) sont utilisés pour surveiller la température de croissance. Ce dernier a été calibré à partir de la température de désorption de l'oxyde GaAs. Suite à la désoxydation des substrats de GaAs à 610 °C (mesurée par BT), une couche de GaAs de 250 nm d'épaisseur a été déposée à 585 °C (BT) pour obtenir une surface de départ lisse. Par la suite, une couche tampon de GaSb de 1 μm d'épaisseur a été développée en utilisant la technique IMF à une température BT de 440 °C [16, 19]. Cette technique consiste en la formation d'un réseau périodique de dislocations inadaptées à 90° à l'interface GaAs/GaSb conduisant à une faible densité de dislocations (≈ 10 6 cm −2 ) [20]. Après la croissance de la couche tampon de GaSb, le BT ne peut plus être utilisé en raison des changements d'émissivité, de la rugosité de la surface et des mécanismes d'absorption radiative supplémentaire [21]. Ainsi, la température de croissance de l'InAs/GaSb T2SL est contrôlée uniquement par le TC. Les MWIR 10 ML InAs/10 ML GaSb T2SL sont cultivés à différentes températures de substrat, 330, 390 et 400 °C (TC) pour étudier l'influence de la température de croissance sur les propriétés de transport. D'autre part, le LWIR 24 ML InAs/7 ML GaSb T2SL a été déposé à seulement 390 °C. Afin de compenser la contrainte entre InAs et GaSb, une séquence d'obturateurs spéciaux, qui a été signalée pour conduire à une meilleure qualité structurelle [22, 23], a été utilisée comme suit :la croissance d'InAs a été suivie d'un trempage de Sb de 8 s pour former InSb -comme des liaisons, alors que la croissance de GaSb a été suivie de 2 s de trempage d'As pour faire croître une interface de type GaAs. Le rapport de flux V/III est respectivement de 8,3 et 4,6 pour InAs et GaSb. En outre, le taux de croissance est de 0,5 ML/s pour l'InAs et le GaSb. La croissance a été surveillée in situ par un système de diffraction d'électrons à haute énergie par réflexion (RHEED).
Les échantillons cultivés ont été évalués par diffraction des rayons X à haute résolution (HRXRD) de PANalytical X'Pert pour étudier les propriétés structurelles. Le Cu Kα1 rayonnement (λ ≈ 1.5406 Å) provenant d'un foyer linéaire et d'un monochromateur Ge (004) à quatre rebonds ont été utilisés. Les propriétés de transport ont été évaluées par des mesures par effet Hall à l'aide de la méthode de Van der Pauw dans un système ECOPIA, avec une plage de température de 80 à 300 K. Les mesures ont été effectuées sur des échantillons carrés de 6 × 6 mm 2 ; le contact a été établi par des points d'indium dans chaque coin. Un champ magnétique de 0,4 T a été appliqué normalement aux échantillons.
Résultats et discussion
La figure 1 illustre le HRXRD 2θ-ω mesuré et simulé courbes de balayage de la réflexion symétrique (004) pour les T2SL MWIR et LWIR InAs/GaSb. La simulation est réalisée par le logiciel « Epitaxy » fourni par PANalytical X’Pert. Comme on peut le voir, il existe des satellites bien résolus avec une commande allant jusqu'à 4 pour le MWIR T2SL et jusqu'à 7 pour le LWIR un. Cela indique la haute qualité structurelle des couches développées, en particulier pour le LWIR T2SL. D'autre part, la pleine largeur à mi-hauteur (FWHM) du pic d'ordre zéro mesuré en ω-2θ la direction est de 107 et 99 arcsec pour les T2SL MWIR et LWIR, respectivement. La période du super-réseau (L ) est déterminé à partir de la distance angulaire entre deux satellites adjacents (Δθ ) comme suit :

HRXRD 004 2θ-ω scan de a MWIR b et LWIR InAs/GaSb T2SL. Expérimental (ligne noire) et simulé (ligne rouge) HRXRD 2θ-ω recherche le (004) reflet de a MWIR T2SL ; il existe des satellites bien résolus avec un ordre jusqu'à 4, ce qui est une caractéristique d'une bonne qualité de super-réseau. La FWHM du pic d'ordre zéro est de 107 arcsec, b et LWIR InAs/GaSb T2SL; il y a des pics satellites avec un ordre jusqu'à 7, ce qui confirme la haute qualité cristalline. La FWHM du pic d'ordre zéro est de 99 secondes d'arc. La période de chaque super-réseau est calculée à partir de la distance entre les satellites adjacents
$$ L=\lambda /\left(2\times \Delta \theta \times \mathit{\cos}{\theta}_{SL}\ \right) $$ (1)où λ est la longueur d'onde du faisceau de rayons X incident mentionné précédemment et θ SL est l'angle de Bragg du pic d'ordre zéro du super-réseau. D'après la figure 1, la période des T2SL MWIR et LWIR est de 6,74 ± 0,01 et 10,24 ± 0,02 nm, respectivement. En ajustant la courbe mesurée avec celle simulée, la composition d'une période de MWIR T2SL est la suivante :GaSb 3,4 nm (11,2 ML), GaAs 0,1 nm (0,2 ML), InAs 3,0 nm (10,1 ML), et InSb 0,2 nm (0,5 ML). De plus, les épaisseurs des constituants du LWIR T2SL sont les suivantes :GaSb 2,3 nm (7,5 ML), GaAs 0,1 nm (0,2 ML), InAs 7,4 nm (24,7 ML) et InSb 0,4 nm (1 ML). Le décalage de réseau déterminé à partir de l'angle entre le pic d'ordre zéro et la couche tampon de GaSb est de 8,9 × 10 −3 et 4,5 × 10 −3 pour les T2SL MWIR et LWIR, respectivement. La figure 2 présente la carte de l'espace réciproque (RSM) asymétrique (115) pour les T2SL développés. Dans les deux échantillons, les satellites des super-réseaux et le pic de GaSb sont alignés verticalement (ils ont la même composante du vecteur de diffusion Qx ), ce qui conduit à la conclusion que les deux T2SL sont pratiquement entièrement tendus.

Asymétrique 115 RSM de a MWIR et b LWIR InAs/GaSb T2SL. La carte de l'espace réciproque pour la réflexion asymétrique (115) de a MWIR et b LWIR InAs/GaSb T2SL. Les pics des deux super-réseaux sont alignés verticalement (ils ont la même valeur du vecteur de diffusion Qx ). Par conséquent, les deux super-réseaux pour MWIR et LWIR sont pratiquement entièrement tendus
Les paramètres électriques dans le plan des MWIR InAs/GaSb T2SL développés sont illustrés à la Fig. 3. Comme on peut le voir, l'InAs/GaSb T2SL dopé involontairement présente un changement reproductible du type de conductivité. Malgré l'influence de la couche tampon GaSb (p -type) sur les mesures par effet Hall, il est à noter que le changement de type de conductivité est dû uniquement à la couche T2SL. Ce changement a également été rapporté par plusieurs groupes [6, 24, 25, 26]. Le T2SL présente un p -type conduction en dessous de la température à laquelle se produit le changement (T ch ) et un n -type conduction au-dessus de T ch . Comme mentionné précédemment, les couches InAs et GaSb présentent un n -type et p -type conduction, respectivement. Par conséquent, le fond résiduel du InAs/GaSb T2SL avec une épaisseur similaire pour les deux constituants est induit par la compensation des porteurs majoritaires des constituants binaires du T2SL [27]. Pour la valeur de T ch , Mohseni et al. [6] ont rapporté une valeur de 140 K, Christol et al. [24] ont obtenu une valeur de 190 K, tandis que Khoshakhlagh et al. [25] ont souligné une valeur de 200 K. Le comportement de la concentration et de la mobilité des porteurs de feuille est régi par les mécanismes bien connus de diffusion intrinsèque des phonons (acoustique, piézoélectrique, optique polaire et non polaire). Exceptionnellement, la mobilité de Hall augmente avec l'augmentation de la température au-dessus de T ch (Fig. 3b); c'est probablement à cause des pièges ionisés dus à l'interface InSb à l'interface GaSb-on-InAs [6]. T ch la valeur est de 145, 195 et 225 K, pour le T2SL cultivé à 330, 390 et 400 °C, respectivement (Fig. 3) ; cela est dû probablement à la concentration élevée de trous à une température de croissance plus élevée, ce qui déplace le T ch pour abaisser la température. La concentration élevée de trous est due à des défauts et des lacunes ionisées à haute température de croissance. L'InAs/GaSb T2SL cultivé à 390 °C est caractérisé par une concentration de porteur de 1,8 × 10 16 et 2,5 × 10 16 cm −3 à 80 et 300 K, respectivement. Ce résultat est meilleur que celui rapporté par Mohseni et al. [6] (La concentration de Hall varie de 1,5 à 4 × 10 17 cm −3 ) et pratiquement le même que celui rapporté par Christol et al. [24] (Concentration Hall de 1,6 × 10 16 et 6 × 10 16 cm −3 à 100 et 300 K, respectivement). En revanche, la mobilité Hall est de 1300 (p -type) et 3 200 cm 2 /V s (n -type), à 80 et 300 K, respectivement. La mobilité atteinte est bien supérieure à celle rapportée par Christol et al. [24], qui a obtenu une mobilité Hall de 100 et 1800 cm 2 /V s à 100 et 300 K, respectivement.

un Concentration Hall et b Mobilité Hall de MWIR InAs/GaSb T2SL cultivés à différentes températures. Les paramètres électriques des MWIR InAs/GaSb T2SL cultivés à différentes températures. un Concentration de Hall :les trois T2SL présentent un changement de conductivité. Ils sont p -type à basse température et n -type à haute température. b Mobilité Hall :il existe deux régions pour la tendance mobilité. Pour les basses températures, la mobilité diminue en raison des différents mécanismes de diffusion. Pour des températures élevées, la mobilité augmente en augmentant la température, ce qui peut s'expliquer par les pièges ionisés dans l'interface de type InSb. La température à laquelle le changement de conductivité se produit augmente lorsque la température de croissance augmente, ce qui est dû aux niveaux élevés de défauts à des températures plus élevées
La résistivité des trois échantillons différents est illustrée à la figure 4. On peut remarquer que la résistivité et la température ont deux pentes bien définies. Pour chaque échantillon, deux énergies d'activation thermique peuvent être extraites de la loi d'Arrhenius. Pour le n -région de type, l'énergie d'activation E un est de 58, 72 et 68 meV pour le T2SL cultivé à 330, 390 et 400 °C, respectivement. Tandis que pour le p -type région, E ap est égal à 7, 12 et 14 meV, pour l'InAs/GaSb T2SL déposé à 330, 390 et 400 °C, respectivement. Pour les basses températures (inférieures à T ch ), le T2SL affiche un p -type en raison de p -type transporteurs associés à E ap qui dominent les mécanismes de génération et de recombinaison des porteurs. Pour des températures supérieures à T ch , le T2SL présente un n -type conduction due à l'activation de porteurs de profondeur associée à une énergie d'activation élevée E un . La source de ces niveaux profonds est les niveaux peu profonds dans l'InAs en vrac qui sont le résultat de la gamme de bandes entre InAs et InAs/GaSb T2SL et qui agissent comme des niveaux profonds dans l'InAs/GaSb T2SL [28].
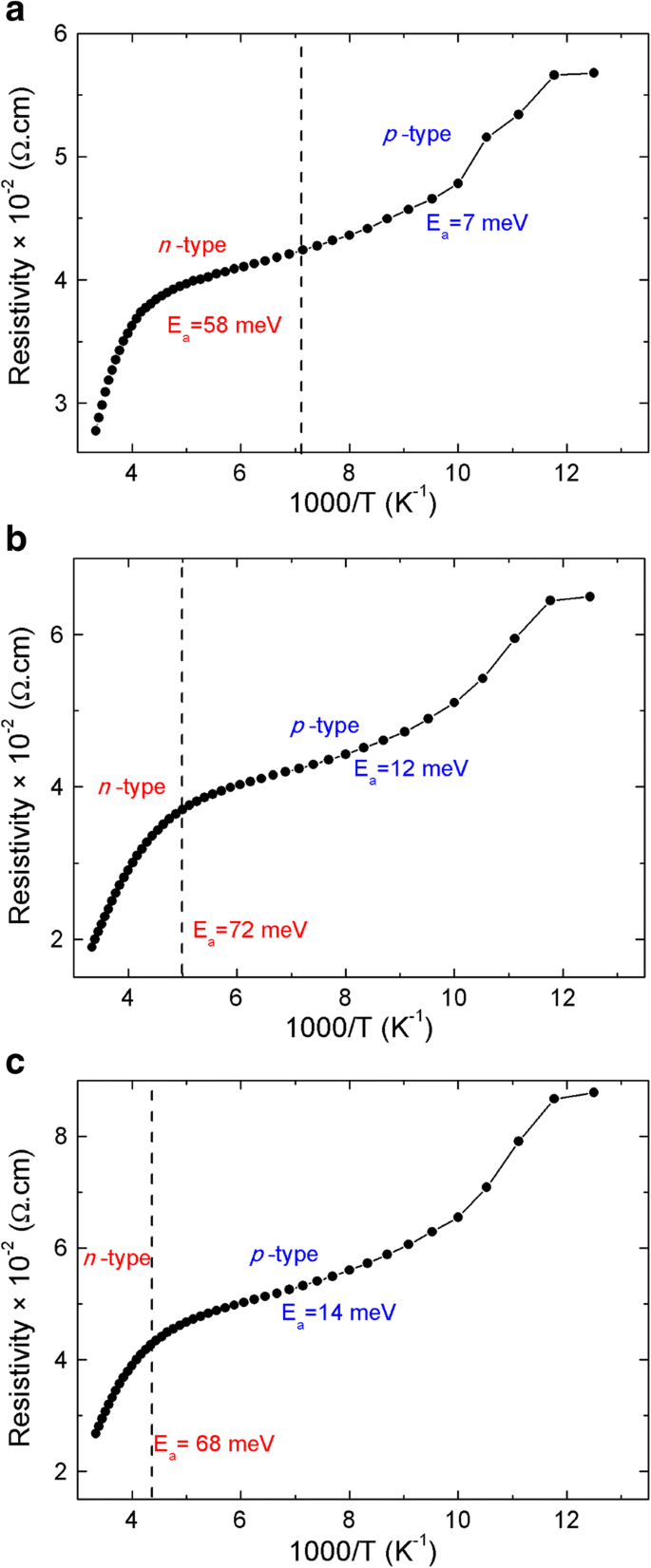
Résistivité Hall du MWIR InAs/GaSb T2SL développé à a 330 °C, b 390 °C, et c 400 °C. La résistivité Hall du MWIR InAs/GaSb T2SL déposé à différentes températures de croissance, a 330 °C, b 390 °C, et c 400 °C. Pour chaque graphique, il y a deux pentes bien définies. De la loi d'Arrhenius, deux énergies thermiques peuvent être extraites, ce qui confirme l'existence de deux niveaux d'impuretés. L'un représente le n -type transporteurs, et le second correspond au p -type transporteurs. Le niveau d'impureté profond associé au n -type carriers est le résultat de l'alignement des bandes entre InAs et InAs/GaSb T2SL
La concentration Hall, la mobilité et la résistivité du LWIR InAs/GaSb T2SL sont présentées sur la Fig. 5. Contrairement au MWIR T2SL, il n'y a pas de changement de type de conductivité dans le cas de cet échantillon. Ce T2SL présente un n -type conduction. L'influence du p -Couche tampon de type GaSb (porteurs à faible mobilité) sur la mesure de l'effet Hall pour ce n -type T2SL (transporteurs à grande mobilité) est négligeable, car la mobilité Hall est proportionnelle au carré de la mobilité des transporteurs. Khoshakhlagh et al. [25] ont rapporté le même résultat pour 13 ML InAs/7 ML GaSb T2SL. De plus, Szmulowicz et al. [29] ont souligné que le LWIR T2SL, dans lequel la couche d'InAs est plus épaisse que GaSb, a tendance à être n -taper. Ce n -type conduction est due à la grande épaisseur de couche d'InAs (résiduellement n -dopé.) par rapport à celui du GaSb. Ces n Les porteurs de type -sont associés à une énergie d'activation de 33 meV (Fig. 5b). Le comportement de la concentration de Hall et de la mobilité est typique pour n -type semi-conducteurs, à l'exception de la plage de températures inférieure à 95 K, où la concentration et la mobilité du porteur sont presque indépendantes de la température. Ceci est une indication de l'existence d'un mécanisme de diffusion indépendant de la température dans cette région de température. Il est démontré que ce dernier est le mécanisme de diffusion de rugosité d'interface (IRS) [30,31,32,33,34]. Ce mécanisme est dominant à basse température, où la diffusion des phonons est figée [35]. Le mécanisme IRS est dû à l'existence d'interfaces, ainsi qu'à la variation des épaisseurs des couches, qui se traduit par la variation des niveaux d'énergie électronique; par conséquent, ils agissent comme une source de diffusion des porteurs [35]. De plus, la mobilité de Hall dominée par le mécanisme IRS est proportionnelle à la puissance sixième de l'épaisseur d'InAs (\( \mu \propto {d}_{\mathrm{InAs}}^{6.2} \)) [35].

un Concentration Hall, mobilité Hall et b Résistivité Hall de LWIR InAs/GaSb T2SL dopé non intentionnellement. Les propriétés de transport du LWIR InAs/GaSb T2SL. un Concentration de Hall et mobilité :ce super-réseau ne présente que n -type conduction pour toute la plage de température. La concentration de Hall augmente en augmentant la température qui est causée par les effets d'ionisation. D'autre part, le comportement de la mobilité Hall est régi par les différents mécanismes de diffusion (phonons et impuretés ionisées) pour des températures supérieures à 95 K. Pour des températures inférieures à 95 K, la mobilité est constante (ainsi que la concentration Hall), ce qui confirme l'existence d'un autre mécanisme de diffusion indépendant de la température. Ce dernier est le mécanisme de rugosité d'interface. b Résistivité de Hall :d'après la loi d'Arrhenius, il n'y a qu'une seule énergie thermique associée à un seul niveau d'impureté
Conclusions
En résumé, les T2SL InAs/GaSb ont été développées sur un substrat GaAs en utilisant une couche tampon GaSb basée sur la technique IMF. De plus, ces T2SL ont été démontrées pour les régions de détection MWIR et LWIR. Il a été constaté que le MWIR T2SL présente un changement dans le type de conduction, sous la forme p - à n -type lorsque la température augmente. De plus, la température à laquelle le changement se produit augmente à mesure que la température de croissance des T2SL augmente. Ce changement de type de conduction est attribué à l'existence de deux niveaux d'impuretés avec deux énergies d'activation différentes. D'autre part, il est démontré que la conduction LWIR InAs/GaSb T2SL est n -type pour toute la plage de température. En plus des mécanismes de diffusion conventionnels, le mécanisme IRS s'est avéré être le mécanisme de diffusion dominant à basse température. Ces résultats permettent une meilleure compréhension des propriétés physiques de l'InAs/GaSb T2SL, ce qui conduit à l'amélioration des performances des photodétecteurs IR basés sur ce matériau.
Abréviations
- BT :
-
Bandit
- FPA :
-
Réseaux à plan focal
- FWHM :
-
Pleine largeur à mi-hauteur
- CHAUD :
-
Température de fonctionnement élevée
- HRXRD :
-
Diffraction des rayons X haute résolution
- FMI :
-
Tableau d'inadéquation interfaciale
- IR :
-
Infrarouge
- IRS :
-
Diffusion de la rugosité de l'interface
- LWIR :
-
Infrarouge à ondes longues
- MBE :
-
Epitaxie par faisceau moléculaire
- MWIR :
-
Infrarouge moyen
- RHEED :
-
Diffraction des électrons à haute énergie par réflexion
- RSM :
-
Carte de l'espace réciproque
- T2SL :
-
Super-réseau de type II
- TC :
-
Thermocouple
Nanomatériaux
- Préparation et propriétés magnétiques des nanoparticules de spinelle FeMn2O4 dopées au cobalt
- Vers les nanofluides TiO2—Partie 1 :Préparation et propriétés
- Modélisation et simulation de dynamique moléculaire de la coupe de diamant de cérium
- Caractéristiques optiques et électriques des nanofils de silicium préparés par gravure autocatalytique
- Dépendance de la température de la bande interdite dans le MoSe2 cultivé par épitaxie par faisceau moléculaire
- Effets de l'épaisseur de la bicouche sur les propriétés morphologiques, optiques et électriques des nanolaminés Al2O3/ZnO
- Effets bipolaires en photovoltage des hétérostructures à points quantiques métamorphiques InAs/InGaAs/GaAs :solutions de caractérisation et de conception pour les dispositifs sensibles à la lum…
- Préparation et propriétés optiques des films GeBi à l'aide de la méthode d'épitaxie par faisceau moléculaire
- Étude des propriétés structurelles, électroniques et magnétiques des amas Ag n V (n = 1–12)



