Effets bipolaires en photovoltage des hétérostructures à points quantiques métamorphiques InAs/InGaAs/GaAs :solutions de caractérisation et de conception pour les dispositifs sensibles à la lumière
Résumé
L'effet bipolaire du substrat GaAs et des couches avoisinantes sur le photovoltage des structures métamorphiques verticales InAs/InGaAs en comparaison avec les structures de points quantiques (QD) pseudomorphiques (conventionnelles) InAs/GaAs ont été étudiés. Les structures métamorphiques et pseudomorphiques ont été développées par épitaxie par faisceau moléculaire, en utilisant des contacts inférieurs au niveau du n développé. + -tampons ou le substrat GaAs. Les caractéristiques liées aux QD, aux couches de mouillage et aux tampons ont été identifiées dans les spectres photoélectriques des deux structures en contact avec le tampon, tandis que les spectres des échantillons en contact avec le substrat ont montré l'apparition supplémentaire attribuée aux centres de défaut EL2. Les échantillons en contact avec le substrat ont démontré un photovoltage bipolaire ; il a été suggéré que cela se produisait en raison de la compétition entre les composants liés aux QD et leurs couches de revêtement avec les défauts liés au substrat et la couche la plus profonde. Aucun effet de substrat direct n'a été trouvé dans les spectres des structures en contact avec le tampon. Cependant, une influence négative notable du n + -Une couche tampon GaAs sur le signal de photovoltage et de photoconductivité a été observée dans la structure InAs/InGaAs. En analysant les résultats obtenus et les calculs effectués, nous avons pu fournir des informations sur la conception de structures QD métamorphiques, qui peuvent être utiles pour le développement de nouveaux dispositifs photoniques efficaces.
Contexte
Au cours des deux dernières décennies, les matériaux composites contenant des nanostructures semi-conductrices ont trouvé une grande utilité dans les applications photoniques en raison de leur sensibilité à la lumière, leur facilité et leur faible coût de fabrication, leur accordabilité spectrale et leur émission très efficace avec une courte durée de vie [1,2,3,4,5 ]. Les hétérostructures à points quantiques (QD) In(Ga)As constituent une classe importante de nanostructures sensibles à l'infrarouge, qui ont été largement utilisées dans divers dispositifs photoniques, tels que les lasers [2, 6], les sources de photons uniques [7, 8], photodétecteurs [9,10,11,12,13] et cellules solaires [14,15,16]. De nombreuses recherches ont été consacrées à l'amélioration des propriétés photoélectriques de tels dispositifs photosensibles. Par exemple, la plage de photosensibilité peut être étendue via l'excitation via une bande interdite intermédiaire [17, 18] ou la génération d'excitons multiples [19, 20], de sorte que les rendements de conversion de puissance des cellules solaires à base de QD peuvent dépasser en théorie les limites de la simple -cellules solaires à bande interdite [21]. Les méthodes telles que l'équilibrage des contraintes [22] et la technique de gestion des écarts [23] ainsi que le recuit thermique [24] sont utilisées pour réduire les contraintes dans ces structures, en exploitant la plage de travail [25] ainsi qu'en augmentant la photoréponse due à la suppression des défauts liés à la déformation [26] qui peuvent agir comme des centres de recombinaison.
Une méthode efficace pour la réduction de la déformation est basée sur la croissance d'un tampon métamorphique InGaAs (MB) au lieu du tampon GaAs conventionnel. En conséquence, les structures QD InAs/InGaAs ont suscité beaucoup d'intérêt au cours de la dernière décennie [27,28,29]. En faisant croître les QD sur l'InGaAs MB, on peut observer des différences essentielles dans le processus de formation et les propriétés optiques des QD par rapport à celles conventionnelles dans la matrice GaAs [25, 30, 31, 32, 33]. Par exemple, la couche de confinement InGaAs réduit le décalage de réseau entre les QD et le tampon et, par conséquent, les contraintes dans les QD. En conséquence, la bande interdite de InAs est réduite et une augmentation significative de la longueur d'onde d'émission est observée [34]. L'application du MB comme matériau de confinement permet de décaler sa valeur dans la fenêtre de télécommunication à 1,3 et 1,55 μm [28, 29, 35, 36].
De plus, il y a eu des tentatives prometteuses pour appliquer les propriétés photoélectriques des structures métamorphiques InAs QD à la conception de dispositifs photosensibles tels que les photodétecteurs infrarouges métamorphiques [11,12,13] et les cellules solaires [37,38,39]. Certaines études ont été menées pour développer la conception de la structure [25, 31,32,33] et d'autres pour améliorer les propriétés photoélectriques [39, 40]. Des recherches sont en cours pour réduire les contraintes dans les hétérostructures [34, 41], car cela conduit à une amélioration substantielle de la densité de photocourant et de la réponse spectrale des cellules solaires [39, 40] ainsi que de l'efficacité de photoémission de telles structures [ 29, 32, 42].
Le développement des dispositifs photosensibles nécessite une étude approfondie des propriétés photoélectriques. Les études de photovoltage (PV) ou de photoconductivité (PC) sont un outil idéal pour la détermination de la photoréponse en fonction de l'énergie lumineuse, des transitions entre les niveaux, du transport des porteurs et de la plage de fonctionnement de l'appareil [10, 43, 44]. Cependant, malgré le fait que certaines études sur les propriétés photoélectriques des structures avec des QDs d'InAs métamorphiques aient été réalisées ces dernières années [37,38,39, 43], les aspects complets du mécanisme de photoréponse restent encore flous, ainsi que l'influence du MB sur les propriétés des nanostructures. En particulier, les effets du substrat GaAs et des interfaces associées sur les spectres photoélectriques des structures QD InAs/InGaAs/GaAs n'ont pas été explorés en détail. Bien que des efforts importants soient consacrés pour éviter l'influence du substrat, la photoréponse est affectée à la fois par le substrat et les couches voisines développées par épitaxie par faisceau moléculaire (MBE). Ainsi, alors que la géométrie de contact appliquée doit conserver les couches inférieures et le substrat électriquement inactifs, un effet négatif notable de celles-ci sur le PV et le photocourant a été détecté par nous dans une enquête précédente [43]. Très récemment, nous avons comparé les propriétés photoélectriques du métamorphique InAs/In0.15 Ga0,85 Comme structure QD avec celles d'une QD standard InAs/GaAs et a trouvé que le photocourant de l'InAs/In métamorphique0,15 Ga0,85 Comme les hétérostructures n'étaient pas affectées par les niveaux liés aux défauts au voisinage de QD [45]. De plus, il a été conclu que des dispositifs photoniques efficaces à 1,3 μm peuvent être développés avec des nanostructures similaires en tant que matériau actif.
Dans ce travail, nous poursuivons l'étude des propriétés photoélectriques des hétérostructures avec des InAs QD intégrés soit dans le métamorphique In0.15 Ga0,85 As ou tampons GaAs conventionnels, en se concentrant sur l'effet du substrat GaAs et des couches MBE voisines. Afin d'atteindre une compréhension claire du rôle du substrat et des couches tampons, nous avons considéré les structures avec des contacts inférieurs sur (i) le In0.15 Ga0,85 Comme couche tampon ou (ii) le substrat GaAs inférieur (voir Fig. 1). Ainsi, en fonction de la sélection du contact inférieur, le courant a traversé (i) uniquement les QD et les couches tampons et (ii) la structure complète, y compris les substrats et leurs interfaces avec les couches MBE. L'analyse des résultats et des calculs nous a permis de donner un aperçu de la meilleure conception de capteurs de lumière sur des structures QD métamorphiques.
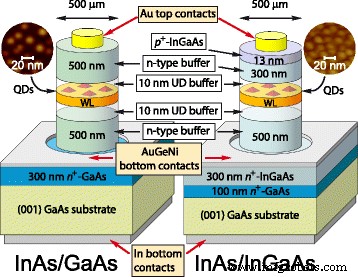
(Couleur en ligne) schémas du métamorphique InAs/In0.15 Ga0,85 Comme/si -GaAs (à droite) et InAs/GaAs/si -GaAs (gauche) échantillons QD étudiés ; Des images AFM des structures non coiffées sont affichées
Méthodes
Les structures ont été préparées par MBE sur (001) semi-isolant (si ) Substrats GaAs. Les substrats étaient n -type, avec des valeurs de 3 × 10 7 cm −3 concentration résiduelle en porteurs, épaisseur de 500 μm et résistivité de 2 × 10 7 Ω × cm. Les structures QD métamorphiques InAs/InGaAs consistent en (i) 100 nm n + -Couche tampon GaAs cultivée à 600 °C, (ii) n d'épaisseur 300 nm + -En0.15 Ga0,85 Comme MB avec n = 5 × 10 18 cm −3 cultivé à 490 °C, (iii) 500 nm d'épaisseur n -En0.15 Ga0,85 Comme MB avec n = 3 × 10 16 cm −3 cultivé à 490 °C, (iv) 3,0 monocouches (ML) de QD InAs auto-assemblés intégrés dans un In0,15 non dopé de 20 nm Ga0,85 Comme couche cultivée à 460 °C, (v) 300 nm n -En0.15 Ga0,85 Comme couche de finition supérieure avec n = 3 × 10 16 cm −3 cultivé à 490 °C, et (vi) 13 nm p + -dopé à0.15 Ga0,85 Comme casquette avec p = 2 × 10 18 cm −3 cultivée à 490 °C (Fig. 1). Le taux de croissance était de 1,0 ML/s, à l'exception des QD qui ont été cultivés avec un taux de croissance de 0,15 ML/s. Les couches non dopées sont nécessaires pour séparer les QD de n régions dopées et, par conséquent, de réduire l'influence des centres de recombinaison non radiatifs, maximisant ainsi l'efficacité d'émission de lumière QD [30, 46]. Les structures QD standard InAs/GaAs sont constituées de (i) 300 nm n + -Couche tampon GaAs avec n = 5 × 10 18 cm −3 cultivé à 600 °C, (ii) 500 nm d'épaisseur n -GaAs MB avec n = 3 × 10 16 cm −3 cultivé à 600 °C, (iii) 3,0 ML de QD d'InAs intégrés dans une couche de GaAs non dopé de 20 nm cultivée à 460 °C, et (iv) 500 nm n -Couche de coiffage supérieure GaAs avec n = 3 × 10 16 cm −3 cultivé à 600 °C. Le taux de croissance était de 1,0 ML/s, à l'exception des QD qui ont été cultivés avec un taux de croissance de 0,15 ML/s.
Les images de microscopie à force atomique (AFM) des structures non coiffées sont présentées sur la figure 1. Par l'analyse des données AFM sur des structures similaires, les valeurs les plus fréquentes des tailles QD ont été estimées à 20 nm (diamètre) et 4,9 nm (hauteur) pour les métamorphoses. QD et 21 nm (diamètre) et 5,0 nm (hauteur) pour les QD standard [30, 31, 45].
Pour les mesures photoélectriques, des mésas circulaires de 500 μm d'épaisseur ont été gravés sur les structures jusqu'au tampon inférieur n + couches; Des contacts supérieurs rectifiants d'un diamètre de 400 μm et d'une épaisseur de 70 nm ont ensuite été évaporés au sommet des mesas. Pour obtenir des contacts ohmiques sur le bas n + -InGaAs et n + -Couches tampons GaAs, respectivement, Au0.83 Ge0.12 Ni0,05 l'alliage a été déposé à 400 °C pendant 1 min dans une atmosphère d'azote. Des contacts ohmiques d'indium épais ont été réalisés sur le fond des substrats dans d'autres morceaux des mêmes échantillons, afin d'avoir des mesures également avec le courant circulant dans le tampon GaAs et si -Substrat GaAs. L'ohmicité des contacts a été vérifiée par le I -V mesures, contact avec un morceau de substrat; les caractéristiques courant-tension se sont avérées linéaires (données non présentées).
Suivant l'approche proposée dans la Réf. [47] et utilisé dans d'autres ouvrages [48, 49], le mince p + -Couche d'InGaAs entre le contact Au et le n -La couche d'InGaAs a été utilisée pour rehausser la hauteur de barrière Schottky, puisque la structure obtenue par le simple dépôt d'un métal sur n -InGaAs présentait une hauteur de barrière Schottky relativement faible. Par conséquent, le dépôt de p mince + -La couche d'InGaAs agrandit la hauteur de la barrière Schottky pour qu'elle soit similaire à celle du contact Au-GaAs, maintenant la ressemblance du profil de barrière pour les structures métamorphiques et InAs/GaAs.
Pour la conception de structures et de contacts ainsi que la compréhension du profil énergétique des deux structures composé par le In0.15 Ga0,85 MBs As ou GaAs, QDs In(Ga)As, couche de protection non dopée et contacts Au/AuGeNi, les calculs ont été effectués à l'aide du logiciel Tibercad [50]. Les profils de bande ont été modélisés dans l'approximation dérive-diffusion, en tenant compte des conditions de déformation, des densités de pièges liées aux défauts dans la région d'interface InGaAs/GaAs, des couches d'appauvrissement près des contacts et des hauteurs de barrière Schottky appropriées. Pour le calcul des profils de bandes QD métamorphiques, les tailles des données AFM ont été prises en compte et les effets de contrainte ont été inclus, suivant une approche déjà validée dans les Réfs. [42, 51]. Le calcul des niveaux quantiques QD n'entre pas dans le cadre de cet article, et la modélisation QD a été effectuée précédemment dans la réf. [45]. Dans ce travail, cependant, nous calculons les profils de bande de l'ensemble de l'hétérostructure, y compris le substrat.
Le photocourant vertical et les spectres PV ont été mesurés dans la plage de 0,6 à 1,8 eV en utilisant une géométrie d'excitation d'incidence normale à température ambiante (RT) (300 K) et la même intensité de source lumineuse (1,5 mW/cm 2 ). Le photocourant a été mesuré à l'aide d'un amplificateur de courant et d'une technique de courant continu [10, 43, 44, 45], avec un biais de 1 V. Le courant a été mesuré comme une chute de signal de tension à travers une résistance de charge en série de 100 kΩ (voir l'encadré de la Fig. 5). La photoluminescence (PL) excitée à 532 nm a été mesurée à 300 K. Certaines informations concernant les structures et les méthodes sont décrites plus en détail dans la réf. [45].
Résultats et discussion
A. Caractérisation photoélectrique
Les spectres PV des deux InAs/In0.15 Ga0,85 Des échantillons d'As et d'InAs/GaAs sont présentés sur la Fig. 2. Contacté uniquement avec les couches MBE, épaisses n -InGaAs, ou n Tampons -GaAs, les caractéristiques des spectres ont été décrites ailleurs [45]. Le seuil spectral de l'InAs/In0.15 Ga0,85 La valeur à 0,88 eV est liée à l'absorption de l'état fondamental dans l'ensemble QD, ce qui correspond à l'apparition de la bande QD dans le spectre PL à RT mesurée précédemment [45] (Fig. 2a). Le spectre d'émission métamorphique QD montre une large bande à 0,94 eV qui se situe dans la gamme des télécommunications à 1,3 μm (0,95 eV), tandis que le QD PL démontre une bonne efficacité, comme cela a été noté dans des articles antérieurs [30, 45, 46, 52]. La large bande du spectre PV a culminé à 1,24 eV et avec une limite à 1,11 eV est due à la génération de porteuses dans le In0,15 Ga0,85 Comme MB et couche mouillante (WL) y compris le chemin à travers les niveaux peu profonds. Il faut ajouter que le In0.15 Ga0,85 La bande interdite calculée pour la couche cultivée par MBE est de 1,225 eV [53], et le WL PL est observé à 1,2 eV [45]. De plus, une chute importante au-dessus de 1,36 eV est observée, probablement causée par un effet indirect de la couche tampon de GaAs dopé lourd située en dehors de la région d'intercontact qui a été mentionnée dans la réf. [43]. La couche tampon est remplie de nombreux niveaux peu profonds et de non-uniformités de bande provenant de défauts de croissance MBE et de centres de dopage qui décalent vers le rouge l'absorption interbande de GaAs [33, 46, 54, 55]. Pour la nanostructure classique en InAs/GaAs à contact tampon, le début à 1,05 eV du spectre PV sur la figure 2b provient de l'état fondamental QD, comme le confirme le spectre PL, tandis que le pas brusque à 1,3 eV peut être lié à la transitions dans le WL [56]. La caractéristique après 1,39 eV est évidemment liée à l'absorption de la couche tampon supérieure en GaAs dopé. Un mécanisme pour cet effet sera discuté en détail ci-dessous.

(Couleur en ligne) Spectres PV à température ambiante du a InAs/In métamorphique0.15 Ga0,85 Comme et b Structures QD InAs/GaAs ; Le PV a été mesuré au contact uniquement des couches MBE [45] (courbes noires) et à travers les si semi-isolants -Substrat GaAs (bleu). Les spectres PV mesurés à travers le si -Les substrats GaAs sont inversés par signe de tension inférieure à 1,68 et 1,44 eV respectivement pour a et b . Les parties à basse énergie des courbes sont indiquées dans les encadrés ; les bandes QD PL mesurées avant [45] pour les deux structures sont présentées pour le positionnement énergétique de l'état fondamental QD (rouge)
Comme il est mentionné ci-dessus, la chute brutale du signal PV au-dessus de 1,36 eV dans l'InAs/In0,15 Ga0,85 Comme la structure est liée à n + -Couche inférieure de GaAs coiffant le substrat. Pour effacer les effets des couches sous le contact AuGeNi inférieur sur la photoréponse, nous avons étudié les propriétés photoélectriques des structures en utilisant un contact en indium au dos du substrat. Contrairement à la géométrie de contact précédente Au et AuGeNi qui permet le PV unipolaire, le signal bipolaire a été observé pour les structures en contact avec le dessus de l'échantillon et le dos du substrat (Fig. 2). Il est nécessaire de noter que le signe PV change le long de l'axe d'énergie des photons, et sur la figure 2, les spectres des deux échantillons sont inversés par signe de tension en dessous de 1,68 et 1,44 eV pour InAs/In0,15 Ga0,85 Structures QD As et InAs/GaAs respectivement. Ici, PV est considéré comme positif lorsque, comme dans le cas du contact avec les couches MBE, le potentiel positif est appliqué au contact Au supérieur tandis que le potentiel négatif est appliqué au contact inférieur.
Toutes les transitions optiques mentionnées ci-dessus contribuent au signal PV des structures dans la géométrie de contact substrat-top. Cependant, lors de la mesure de PV à travers le substrat, le début du signal pour les structures métamorphiques et conventionnelles se produit à environ 0,72 eV. Le début à 0,72 eV est attribué à la transition depuis le centre du défaut EL2 situé à si -Substrat GaAs et interfaces associées près de 0,75 eV en dessous de la bande de conduction GaAs [57], en tenant compte de la possibilité de transition à travers les niveaux peu profonds de défauts [46, 54, 55]. Les aspects liés à leur localisation ainsi que le redshift d'apparition du PC EL2 ont été discutés en détail ailleurs [10, 45]. Comme aucun signal sous les bandes liées à QD n'a été observé dans les spectres des échantillons mis en contact avec les tampons InGaAs ou GaAs (Fig. 2), nous concluons que le substrat et les interfaces associées n'ont pas d'influence substantielle sur les propriétés des hétérostructures cultivées en MBE. .
Pour comprendre l'apparence du signal PV dans nos échantillons, il faut regarder la Fig. 3 où nous montrons les profils de bande calculés le long de la direction de croissance. Une explication détaillée de l'origine PV entre les contacts Au et AuGeNi est donnée dans l'article précédent [45]. En résumé, les électrons excités par la lumière (trous) dérivent principalement vers le substrat (surface), donnant un potentiel positif au contact Au et négatif au contact AuGeNi.

(Couleur en ligne) profil de bande calculé dans le métamorphique InAs/In0.15 Ga0,85 Structures As (en haut) et pseudomorphes InAs/GaAs (en bas), pour expliquer le mécanisme PV. La courbure de la bande des couches plus profondes sous le contact AuGeNi est indiquée en gris. Les transitions optiques observées dans les spectres PV sont indiquées par des flèches verticales; les flèches en gras montrent les directions de dérive des porteurs de charge excités optiquement sous le champ interne (création PV) ; E F est l'énergie de Fermi. Les calculs ont été effectués à l'aide du logiciel Tibercad [50]
Expliquer le PV bipolaire des structures avec le si électriquement actif -Substrats GaAs, on peut considérer leurs structures de bande calculées sur la Fig. 3. Comme auparavant, les porteurs générés dans les couches supérieures ainsi que dans les QD et WL pourraient donner « + » au sommet et « - » au substrat. Le niveau de Fermi dans le substrat semi-isolant est situé beaucoup plus bas que celui dans le n -couches MBE dopées. Par conséquent, la bande se pliant près du n + - L'interface GaAs/substrat est opposée à celle du reste de la structure développée par MBE (voir la Fig. 3). Par conséquent, l'excitation dans le n + -La couche et le substrat de GaAs (au-dessus de 1,36 eV) donnent un signal PV opposé à celui des QD, WL et tampons. Il en va de même pour l'excitation des défauts EL2 (supérieurs à 0,72 eV) du substrat GaAs et en particulier les défauts de type EL2 dans n + -Région contrainte GaAs/GaAs [46, 57]. Contribution du substrat et n + -GaAs au signal PV total est essentiellement plus fort que celui des couches supérieures de MBE, et le signal négatif de PV est généralement observé à des énergies d'excitation plus faibles, tandis que l'impact des couches et des nanostructures d'InGaAs apparaît sous forme de vallées sur les courbes spectrales respectives de la Fig. . 2. Cela est clairement visible en comparant les bandes spectrales QD, WL et tampon sur les courbes PV des structures en contact avec les tampons MBE avec les vallées dans les spectres des échantillons en contact avec le substrat. Pour les énergies plus élevées, cependant, l'excitation est absorbée plus près de la surface de l'échantillon n'atteignant pas les couches MBE plus profondes et le substrat, qui est la principale source de signal négatif. Par conséquent, le signal PV devient positif à des énergies plus élevées. Ainsi, la présence de si électriquement actifs -substrat conduit à la compétition entre les composantes spectrales liées aux couches supérieures de MBE et les défauts liés au substrat et le n + -Absorption de GaAs.
Sinon, une caractéristique similaire au-dessus de 1,35 eV a été observée au moyen de la spectroscopie PV de surface dans une récente étude détaillée de p -structures dot-in-well dopées InAs/GaAs QD et InAs/InGaAs basées sur si Substrats -GaAs [58]. La chute drastique de l'amplitude PV a été expliquée, contrairement à notre cas, par différents porteurs de charge générés en dessous et au dessus de 1,35 eV. Cependant, compte tenu de la différence drastique entre les structures référencées et présentes ainsi que les spécificités des méthodes appliquées, nous suivons notre interprétation de nos propres résultats.
Sur la base du concept de la courbure de la bande sous le contact AuGeNi, on peut expliquer la chute brutale du signal PV dans la structure métamorphique InAs/InGaAs à contact tampon au-dessus de 1,36 eV observée sur la figure 2a. Cette caractéristique spectrale est due à l'effet du substrat et du MBE le plus profond n + -Couche GaAs. En effet, les électrons qui y sont générés se déplacent sous le champ intrinsèque jusqu'au contact AuGeNi y évoquant un champ électrique supplémentaire, d'où une barrière due à la courbure de bande à l'hétérojonction InGaAs/GaAs est évidemment trop faible pour être un obstacle essentiel pour les porteurs de charge. Cela aligne la flexion de la bande dans les couches supérieures, qui contribuent directement au PV, et, par conséquent, réduit l'alimentation des porteurs photoexcités au-dessus du n + -Couche GaAs et, par conséquent, le signal PV total.
Une petite caractéristique proche de 1,39 eV est observée sur la figure 2b dans le spectre de l'échantillon pseudomorphique contacté avec les tampons MBE, bien qu'une chute drastique du signal comme dans la structure métamorphique soit attendue au-dessus de 1,36 eV, en tenant compte d'une flexion de bande similaire près de n + -Interface GaAs/substrat. Une telle caractéristique n'est pas un attribut du seul substrat et n + -GaAs dopé ; de telles transitions ont été détectées dans les structures QD In(Ga)As/GaAs basées sur p -dopé [58] et non dopé GaAs [10, 55]. Ces transitions se produisent évidemment aussi dans les couches supérieures de GaAs de notre structure pseudomorphique, compensant principalement l'effet négatif des couches proches du substrat sur le signal PV. En conséquence, seule une influence négligeable de la couche proche du substrat peut être observée sur la courbe noire pour l'échantillon InAs/GaAs de la Fig. 2b plutôt que la chute de la courbe de la couche métamorphique provenant des couches GaAs plus profondes, malgré un bipolaire similaire effet observé avec la participation directe du substrat à la formation PV.
La raison de la petite caractéristique après 1,39 eV dans le spectre de l'échantillon InAs/GaAs en contact avec les tampons MBE peut être différente de celle évoquée ci-dessus pour l'échantillon métamorphique InAs/InGaAs. À notre avis, cela est dû à la légère chute du signal causée par le bord d'absorption du tampon GaAs de 500 nm d'épaisseur de MBE supérieur ombrageant les QD et WL qui contribuent plus efficacement au PV à ces énergies de photons. En effet, les électrons et les trous générés dans les QD et les WL sont transportés vers des côtés différents et évitent la recombinaison, contrairement à la génération de volume, où la recombinaison est beaucoup plus probable. C'est la principale raison d'une détection efficace des photoporteurs provenant même d'une seule couche de QD et WL. Les photons d'énergies plus élevées sont absorbés bande à bande dans n près de la surface -La couche tampon de GaAs et les électrons s'échappent vers le volume de l'échantillon loin des trous, entraînant une forte augmentation du PV au-dessus de 1,4 eV. L'exactitude de la raison suggérée pour la caractéristique de 1,36 eV dans la structure InAs/GaAs à contact tampon plutôt que celle supposée pour la structure métamorphique est confirmée par des études de cellules solaires basées sur des structures InAs/GaAs avec les contacts inférieurs sur le n + -Substrats GaAs [18, 24, 59], c'est-à-dire avec une bande monotone courbant tout l'échantillon de contact en contact. Leurs spectres PV révèlent la même caractéristique sans barrière liée à l'interface de la couche MBE avec le substrat. De plus, un pendage étroit a été observé dans la même gamme spectrale dans les spectres PC des structures InGaAs/GaAs avec une géométrie de contact latéral et aucun champ intrinsèque [10, 55].
Les spectres PC des structures obtenus à un biais de 1 V dirigé comme le champ intrinsèque dans les couches supérieures des structures (« » en haut et « + » au contact du bas) sont présentés sur la Fig. 4. Les spectres PC pour les structures en contact avec les couches MBE sont très similaires à celles des PV de la Fig. 2. Les composants des tampons QD, WL, InGaAs ou GaAs ainsi que n + -Les couches de GaAs sont observées aux mêmes énergies. Concernant les structures avec le contact inférieur sur le si -Substrat GaAs, les spectres PC ont des seuils proches de 0,72 eV liés à l'absorption du centre du défaut EL2.
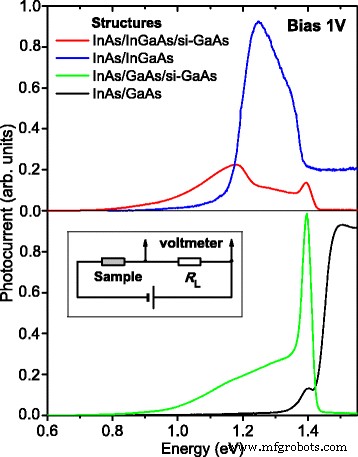
(Couleur en ligne) spectres de photocourant à température ambiante du métamorphique InAs/In0.15 Ga0,85 Comme/si -GaAs et InAs/GaAs/si conventionnels -Structures QD GaAs. Encart :schéma électrique de connexion de l'échantillon pour mesures PC
Les caractéristiques des spectres PC pour les structures en contact avec les couches MBE présentées sur la Fig. 4 correspondent principalement à celles des spectres PV de la Fig. 2 considérés ci-dessus. Concernant les structures avec le contact inférieur sur le si -Substrat GaAs avec la composante centrale EL2, il y a une compétition entre le signal provenant de l'absorption dans les couches MBE et des niveaux liés à EL2, comme discuté ci-dessus. Cependant, les formes des courbes permettent de conclure qu'aucun porteur de charge n'est excité au sein des couches au-dessus de n + -GaAs participent au PC ; ceci est particulièrement pertinent pour le spectre de structure QD métamorphique. Évidemment, les électrons n'atteignent pas le fond à cause de la barrière de potentiel élevée (voir Fig. 3) induite par si -substrat. Le substrat a une résistance trop élevée et la principale chute de polarisation appliquée se produit dessus, par conséquent, aucun abaissement de la barrière ne se produit.
Ainsi, on peut noter que le PV et le photocourant sont affectés négativement par le n lié au substrat + -Couche GaAs :l'absorption au-dessus de 1,36 eV provoque une réduction drastique du signal. La principale cause de la barrière sous le contact AuGeNi est le si -Substrat GaAs avec un positionnement assez bas du niveau de Fermi entraînant une courbure de la bande opposée à celle du sommet de la structure. C'est le seul effet du substrat observé dans le PV à une telle géométrie de contact, et il se manifeste même à une couche intermédiaire assez épaisse (400 nm) entre le contact inférieur et le substrat.
B. Solutions de conception de couches intermédiaires substrat-hétérostructure
D'un point de vue pratique, on peut conclure qu'une telle conception de structure InAs/InGaAs avec si -Le substrat GaAs n'est pas utile dans l'ingénierie des dispositifs photosensibles verticaux, en particulier avec un n relativement mince + -tampon dopé, même lorsque la configuration des contacts élimine le passage du courant à travers le substrat. La zone de charge d'espace formée dans le n + -La région d'interface GaAs/substrat oblige les porteurs de charge excités ici à se déplacer à l'opposé de ceux excités dans la structure métamorphique, comme dans les Figs. 3 et 5a, générant ainsi un signal PV opposé et réduisant l'efficacité quantique totale de l'échantillon.
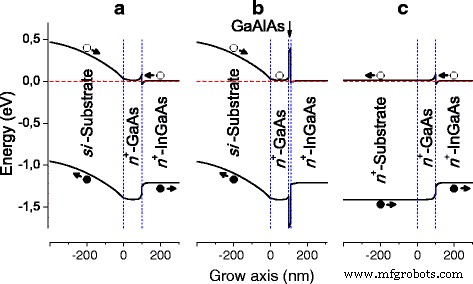
(Couleur en ligne) profils de bande calculés près de In0.15 Ga0,85 Interfaces As/GaAs de la structure métamorphique développée sur un si -substrat avec le n + -Épaisseur de couche de GaAs de a 100 nm (échantillon actuel), b 100 nm et un Ga0.3 mince de 10 nm Al0.7 En tant que couche barrière, et c structure comme le présent mais cultivée sur un n + -substrat dopé similaire au n de 100 nm d'épaisseur + -Couche GaAs au-dessus. Les calculs ont été effectués à l'aide du logiciel Tibercad [50]
Par conséquent, pour les dispositifs basés sur l'absorption de la lumière, une conception de structure différente doit être envisagée. Nous pensons qu'une telle amélioration doit être suggérée car de nombreux groupes de recherche considèrent si -Substrat GaAs comme base pour le nouveau p -n -tapez à la fois les photodétecteurs infrarouges QD [11,12,13] et les cellules solaires [15].
Épaississement simple du n + -Un tampon GaAs sous structure métamorphique ne semble pas être une très bonne idée. Bien qu'un tel tampon puisse absorber plus de quanta d'excitation au-dessus de 1,37 eV et masquer l'interface et le substrat en dessous, son épaisseur doit être très élevée, car 800 nm de matériau InGaAs à bande interdite plus étroite au-dessus est insuffisant pour supprimer complètement les effets bipolaires négatifs. De plus, même un n très épais + Le tampon -GaAs ne peut pas exclure l'effet négatif des centres de type EL2 qui sont situés principalement dans le substrat et à proximité de leur interface avec la couche MBE. Néanmoins, comme les porteurs de charges ont un libre parcours moyen limité, l'épaississement du n + -La couche de GaAs peut affaiblir le champ négatif induit sur le contact AuGeNi ci-dessus.
A better improvement could be provided by growing a thin barrier layer for the electrons coming from substrate like it is shown at Fig. 5b. For calculations, a 10-nm thin undoped Ga0.3 Al0.7 As barrier layer has been chosen. Such barrier could strongly confine the electrons excited in the substrate within the n + -GaAs layer. Similar high-ohmic layers grown by wide-bandgap materials as InAlAs, GaAlAs, and AlAs have been used in laser structures to avoid the charge carrier leakage from the active region of optoelectronic device [60]. However, for the case of GaAs-In0.15 Ga0.85 As based device, Ga0.3 Al0.7 As best matches due to the wide bandgap and small lattice mismatch between the epitaxial layer. Decreasing the carrier-induced field on the AuGeNi contact, it can suppress the negative effect of the substrate region on the photoresponse, especially in combination with increase in the n + -InGaAs layer thickness.
Yet, a more optimal design of the vertical structures seems to be in use of a monotonous gradient of doping, including an n + -doped GaAs substrate as it is proposed in Refs [14, 39, 40]. This design is the most efficient and at the same time simplest. If the substrate is doped similar to the capping n + -layer or heavier, this causes the band bending depicted in Fig. 5c. Furthermore, an essential advantage of such a substrate could manifest itself in solar cell design. A low-resistive substrate allows for utilization of the configuration with the “–” contact on the sample bottom [24, 38,39,40, 59], non-shadowing the MBE structure from the sunlight.
Conclusions
We have shown that photoelectrical characterization evidences a critical influence of the deep levels on the photoelectrical properties of vertical metamorphic InAs/In0.15 Ga0.85 As and pseudomorphic (conventional) InAs/GaAs QD structures in the case of electrically active si -GaAs substrate. Both nanostructures manifest a bipolar PV caused by a competition of the components originated from the oppositely sloped band profiles near the GaAs substrate and bottom MBE n + -GaAs layer on one side and the rest of MBE-grown structure on the other side. An alternative contact configuration, which allows to avoid the current flow through the bottom layers, demonstrates the unipolar PV. The last configuration together with thick buffers on substrate strongly suppresses the influence of the photoactive deep levels originated from interfaces with the si -GaAs substrate on photoelectric properties of the nanostructures. However, a notable negative indirect effect of the substrate on the photovoltage and photocurrent signal from the InAs/InGaAs structure is observed when the excitation is absorbed in the substrate and near-substrate n + -GaAs MBE layer. Analyzing the obtained results and the performed calculations, we have been able to provide insights on the design of metamorphic QD structures, which can be useful for the development of novel efficient photonic devices.
Abbreviations
- AFM:
-
Atomic force microscopy
- MB:
-
Metamorphic buffer
- MBE:
-
Molecular beam epitaxy
- ML:
-
Monolayer
- PC:
-
Photoconductivity
- PL:
-
Photoluminescence
- PV:
-
Photovoltage
- QD:
-
Quantum dot
- R L :
-
Load resistance
- si :
-
Semi-insulating
- WL:
-
Wetting layer
Nanomatériaux
- Conception et développement d'appareils 5G :gammes de performances 5G
- Composites de graphène quantique/TiO2 co-dopé S, N pour une génération d'hydrogène photocatalytique efficace
- Ingénierie des procédés de revêtement par immersion et optimisation des performances pour les appareils électrochromes à trois états
- Source lumineuse à photon unique à 1,3 μm basée sur un point quantique à double couche InAs dans un micropilier
- Détection de l'excitation spatialement localisée dans les superréseaux à points quantiques InAs/InGaAs auto-organisés :un moyen d'améliorer l'efficacité photovoltaïque
- Une conception efficace et efficiente des nanofils InP pour une récupération maximale de l'énergie solaire
- Évaluation des structures graphène/WO3 et graphène/CeO x en tant qu'électrodes pour les applications de supercondensateurs
- Lignes directrices pour la conception RF et micro-ondes
- Reculs et solutions dans la conception de circuits imprimés RF



