Étude sur la mémoire à commutation de résistance multi-niveaux et la phototension dépendante de l'état de la mémoire dans les jonctions Pt/Nd:SrTiO3
Résumé
Pt/Nd :SrTiO3 Les dispositifs (STO)/In ont été fabriqués en déposant des électrodes Schottky-contact Pt et Ohmic-contact In sur un monocristal STO avec un dopage Nd. Les dispositifs Pt/Nd:STO/In présentent des effets de mémoire à commutation de résistance (RS) à plusieurs niveaux et de phototension (PV) dépendant de l'état de la mémoire, qui peuvent être contrôlés par la largeur ou l'amplitude d'impulsion appliquée. RS et PV sont tous deux liés à la modulation induite par le biais de la barrière d'interface, à la fois en hauteur et en largeur, à l'interface Pt/Nd:STO. Les résultats établissent un lien étroit entre les effets RS/PV et la modulation de l'interface Nd:STO déclenchée par le champ électrique appliqué et fournissent une nouvelle voie en utilisant une tension en circuit ouvert pour détecter de manière non destructive plusieurs états de mémoire non volatile.
Contexte
SrTiO3 (STO) est un isolant à large bande interdite (3,2 eV). Il est considéré comme un matériau modèle de pérovskite en raison de sa structure cubique simple dans une large plage de températures [1]. La STO a des performances photoélectriques abondantes qui peuvent être directement manipulées par dopage avec un métal de transition de type donneur ou accepteur. La gamme d'applications du système STO est très large [2, 3]. Récemment, le système STO a reçu beaucoup d'attention scientifique en raison du phénomène de commutation résistive (RS), qui peut être considéré comme un bon candidat pour la construction de la mémoire résistive à accès aléatoire (RRAM) [4, 5].
Le dispositif RS basé sur STO est généralement une structure métal/STO/métal. Les propriétés RS du système STO, c'est-à-dire de la STO dopée par l'accepteur à la STO dopée par le donneur, ont été largement étudiées. Différents mécanismes physiques ont été proposés pour expliquer le comportement de commutation. Pour le STO dopé par un accepteur (par exemple, Fe et Cr), les travaux mettent l'accent sur le changement de propriété dans la masse cristalline, dans laquelle le RS a été attribué à la migration induite par le champ électrique des lacunes d'oxygène, soit au transport rapide des lacunes d'oxygène le long des dislocations ou la formation d'un réseau de lacunes d'oxygène sous un stress électrique élevé [6,7,8,9,10,11]. D'autre part, pour le dispositif RS basé sur le STO dopé par le donneur (par exemple, Nb), le contact de type Schottky entre le métal et le Nb:STO de type n est nécessaire et souligné par de nombreux travaux. Cependant, certains rapports ont connecté RS avec des changements de la couche d'appauvrissement des électrons dans les jonctions métal/Nb:STO, qui sont causés par la stoechiométrie de l'oxygène dans une couche interfaciale mince [12,13,14] ou par un écart par rapport à la stoechiométrie nominale des cations. dans la région proche de la surface [15, 16] et certains rapports suggèrent que la barrière interfaciale reste inchangée pendant le processus RS, mais les filaments conducteurs jouent un rôle vital pour le changement de résistance [17, 18, 19].
Au vu des points rapportés ci-dessus, il est évident qu'il n'y a pas eu de consensus sur le mécanisme de commutation de la STO de type donneur. Deux points de vue sur l'interface et le changement de résistance en vrac coexistent jusqu'à présent. En ce qui concerne les raisons spécifiques de la RS, il existe encore de nombreux mécanismes physiques rapportés. Le mécanisme physique peu clair fait obstacle au progrès de la RRAM basée sur le matériel STO. Pour clarifier le mécanisme RS et développer un dispositif RRAM basé sur un système STO de type donneur, il est avantageux d'étudier différents matériaux STO dopés au métal.
Les propriétés de transport électronique de la STO peuvent être modulées par dopage avec un métal de transition [20]. Comparé aux films minces, les monocristaux ont des propriétés homogènes sur toute la zone et une physique et une chimie des défauts bien établies. Jusqu'à présent, nous n'avons trouvé que des monocristaux STO dopés par un donneur avec un élément Nb signalés pour les dispositifs RS. Pour les monocristaux STO dopés au Nd (Nd:STO), le rayon ionique de Sr 2+ , Ti 4+ , et Nd 3+ (Sd 2+ ) est de 0,118, 0,0605 et 0,0983 (0,129) nm, respectivement, ce qui suggère que Nd 3+ pourrait facilement remplacer Sr 2+ plutôt que Ti 4+ en raison du rayon similaire entre Nd 3+ et Sr 2+ [21]. Ce site de substitution est différent du Nb:STO de type n. Ainsi, le monocristal Nd:STO est un matériau dopé donneur et à conductivité de type n qui sera certifié par effet Hall plus tard. Nd : STO monocristal est un nouveau STO de type n pour RS, et nous n'avons pas trouvé les travaux signalés jusqu'à présent.
Il est généralement connu que l'effet photovoltaïque (PV) est lié au champ électrique interne [22,23,24,25,26]. Ainsi, l'effet PV devrait dépendre des états de la mémoire si le RS est principalement déterminé par la couche d'appauvrissement près du métal et de l'interface STO de type n. A l'inverse, le PV n'a pas d'importance pour les états de mémoire si le RS est induit par les filaments conducteurs. Dans ce travail, nous avons fabriqué des électrodes Schottky-contact Pt et Ohmic-contact In sur un monocristal Nd:STO de type n. La mémoire RS et l'effet PV ont été étudiés ensemble pour clarifier le mécanisme de commutation du dispositif Pt/Nd:STO/In. Fait intéressant, les résultats montrent clairement que le dispositif Pt/Nd:STO/In a une mémoire à plusieurs niveaux et un effet PV contrôlé par l'état de la mémoire, qui peut être modulé par le biais de commutation. Les résultats suggèrent que le mécanisme partagé pour RS et PV est lié à la modulation de la barrière d'interface Pt/Nd:STO, qui est induite par l'injection et le piégeage ou le dépiégeage de porteurs.
Méthodes
Monocristaux Nd:STO (100) d'une taille de 5 mm × 5 mm × 0,5 mm avec 0,05 % en poids de dopage Nd ont été sélectionnés comme substrat. Les électrodes In (électrodes orange) ont été directement pressées sur la surface rugueuse du Nd:STO pour former les contacts ohmiques. Les électrodes de Pt d'un diamètre de 0,1 mm ont été pulvérisées sur le monocristal Nd:STO à travers un masque perforé (électrodes bleues). La distance entre deux électrodes de Pt proches était de 0,5 mm. L'encadré de la Fig. 2a montre la configuration des appareils Pt/Nd:STO/In et In/Nd:STO/In. Les caractéristiques courant-tension (I-V) et RS ont été mesurées sur un Keithley 2400 SourceMeter. Un champ électrique positif est défini comme le courant circulant de l'électrode In vers Pt.
L'effet Hall a été réalisé à l'aide du système de mesure Hall Ecopia HMS-3000 afin d'étudier la concentration en porteurs induite par le dopage Nd. La structure cristalline du STO a été examinée par diffraction des rayons X (XRD, Bruker, D8-Advance) en utilisant le rayonnement Cu Kα. Les mesures de diffusion Raman ont été effectuées sur un spectromètre confocal micro-Raman (Renishaw R-1000) avec une lumière laser visible de longueur d'onde 632,8 nm comme source d'excitation.
Résultats et discussion
La figure 1a montre les modèles XRD de monocristaux STO et Nd:STO non dopés. Tous les pics correspondent à la phase pérovskite et peuvent être indexés sur le groupe spatial cubique Pm3m avec une constante de réseau a ≈ 3.905 Å. Les pics ne montrent aucun changement observable après l'implantation de Nd, indiquant que le dopage de Nd a peu d'effet sur la structure en vrac. Les spectres Raman des monocristaux STO et Nd:STO non dopés sont donnés sur la figure 1b. Le spectre Raman de STO non dopé montre deux larges bandes distinctes provenant de la diffusion du second ordre, qui sont centrées à 200-400 cm −1 et 600–800 cm −1 et appartient à la structure de pérovskite cubique idéale. La position de ces deux bandes est en accord avec la littérature publiée [27, 28]. La ligne élargie avec une diminution de la bande large de second ordre dans Nd:STO est également observée, indiquant une centrosymétrie plus faible en raison d'un trouble local induit par le dopage Nd. En comparaison avec les modèles XRD, les résultats Raman indiquent qu'il existe des défauts structurels à la surface du monocristal Nd:STO, qui devraient être induits par le dopage Nd.

un Les modèles XRD et b Spectres Raman de monocristal STO non dopé et STO dopé Nd
Il est généralement connu que le monocristal STO non dopé est un matériau isolant. Pour étudier l'impact du dopage Nd sur les propriétés électriques du monocristal STO, l'effet Hall a été mesuré. Les résultats de Hall montrent que le monocristal Nd:STO a une conductivité de type n et que la concentration en porteurs est d'environ 2 × 10 19 cm −1 . Cette conductivité de type n peut être attribuée à la substitution de Nd 3+ dans Sr 2+ sites.
L'encart de la Fig. 2a montre l'illustration schématique des dispositifs In/Nd:STO/In et Pt/Nd:STO/In. Le Je –V Les caractéristiques des appareils In/Nd:STO/In et Pt/Nd:STO/In sont représentées respectivement sur les Fig. 2a, b. La tension de balayage a été appliquée comme 0 V → 5 V → 0 V → − 5 V → 0 V avec un courant de conformité de 50 mA. Le dispositif In/Nd:STO/In a un I linéaire –V courbes (illustrées à la Fig. 2a) et présente un bon contact ohmique entre les électrodes In pressées et le monocristal Nd:STO, mais aucun effet RS n'apparaît, tandis que le dispositif Pt/Nd:STO/In présente des propriétés RS réversibles, comme illustré dans Figure 2b. Lorsque la tension appliquée augmente, la transition de résistance se produit, la direction de transition dépend de la polarité de la tension appliquée. Lorsque la tension appliquée diminue, l'état de résistance élevée et faible (HRS et LRS) sera maintenu, indiquant que l'état de résistance est stable et non volatile après la formation. Le grand Je –V l'hystérésis indique que le dispositif Pt/Nd:STO/In a les propriétés de mémoire ; le comportement prototypique de la diode indique qu'une barrière Schottky est formée à l'interface Nd:STO de type n et Pt et domine la résistance du dispositif Pt/Nd:STO/In. Par conséquent, il est facile de conclure que l'effet RS du dispositif Pt/Nd:STO/In provient de l'interface Schottky entre les monocristaux Pt et Nd:STO. Ce résultat, RS dépend de l'interface Schottky, est en accord avec nos travaux rapportés sur le monocristal Nb:STO de type n [29].

Le Je –V caractéristiques de a le In/Nd:STO/In et b Pt/Nd:STO/In appareils dans la plage de tension de 0 V → 5 V → 0 V → − 5 V → 0 V avec un courant de conformité de 50 mA. L'encart montre l'illustration schématique de l'appareil
Pour évaluer le potentiel d'application du dispositif Pt/Nd:STO/In dans une mémoire multiple, l'effet de la largeur et de l'amplitude d'impulsion sur les états de résistance a été étudié et illustré à la Fig. 3a–c. L'appareil a d'abord été réglé sur LRS par une impulsion de - 5-V avec une largeur de 100 ms, puis appliqué par une impulsion de + 5-V avec des largeurs d'impulsion variées de 100 ns, 10 μs et 10 ms, respectivement. La résistance a été lue à 0,1 V. La transition de résistance correspondante du LRS aux états de résistance intermédiaires ou HRS a été obtenue, comme le montre la figure 3a. La figure 3b montre les cycles RS consécutifs de HRS à LRS induits par les impulsions de polarité opposée. Les résultats confirment que la résistance à plusieurs niveaux peut être obtenue par tension d'impulsion avec différentes largeurs. La propriété de rétention de chaque état de résistance a été étudiée plus avant, et aucun changement significatif dans les amplitudes de résistance n'a été observé (montré dans le fichier supplémentaire 1 :Figure S1). La figure 3c présente des boucles de mémoire résistive non volatile typiques contrôlées par une tension d'impulsion. Le dispositif Pt/Nd:STO/In a d'abord été réglé sur LRS par une impulsion de − 3 V, suivie d'un balayage de la tension d'impulsion à + 2 V (ou + 3, + 4 et + 5 V) et de nouveau à − 3 V avec une largeur d'impulsion de 100 ms. La résistance a été lue à 0,1 V. Une série d'états de résistance intermédiaires peut être obtenue en ajustant l'amplitude de l'impulsion. À partir de la Fig. 3a–c, nous avons le résultat que l'état de résistance à plusieurs niveaux du dispositif Pt/Nd:STO/In peut être obtenu en ajustant la largeur ou l'amplitude d'impulsion, indiquant que le dispositif se comporte comme un memristor [23, 30 ].

Cycles RS consécutifs a de LRS à HRS et b de HRS à LRS. L'appareil a d'abord été réglé sur LRS (HRS) par une impulsion de − 5 V (+ 5 V) avec une largeur de 100 ms, puis appliqué par une impulsion de + 5 V (− 5 V) avec des largeurs d'impulsion variées de 100 ns, 10 μs, et 10 ms, respectivement. La transition de résistance correspondante du LRS (HRS) aux états de résistance intermédiaires ou HRS (LRS). c R –V boucles d'hystérésis contrôlées par tension d'impulsion. Le dispositif Pt/Nd:STO/In a d'abord été réglé sur LRS par une impulsion de − 3 V, suivie d'un balayage de l'impulsion à + 2 V (ou + 3, + 4 et + 5 V) et de nouveau à − 3 V avec une largeur d'impulsion de 100 ms. Toute la résistance a été lue à 0,1 V
Il est généralement connu que la photoexcitation des porteurs de charge se produit lorsque la longueur d'onde éclairée correspond à la bande interdite optique du matériau actif. Les électrons et les trous générés seront séparés par le champ électrique interne, ce qui conduit à l'effet PV [23,24,25]. Dans le cas du dispositif Pt/Nd:STO/In, si les états de mémoire multi-niveaux sont principalement déterminés par la couche d'épuisement près de l'interface Pt/Nd:STO, l'effet PV devrait dépendre des états de mémoire du appareil. Au contraire, la PV n'est pas pertinente pour les états de la mémoire si la couche d'épuisement est maintenue inchangée pendant le processus RS. Plus intéressant encore, nous avons trouvé un effet PV dépendant de l'état de la mémoire pour le dispositif Pt/Nd:STO/In. La figure 4a, b montre le I –V courbes en régime de faible polarisation (− 0,6 à + 0,6 V) après commutation avec une série d'impulsions de + 1 à + 5 V avec 100 ms (commutation de LRS aux états de résistance intermédiaire et à HRS) sous l'éclairage clair et sombre , respectivement. Sous un éclairage lumineux, le I –V les courbes de HRS présentent des décalages notables le long de l'axe de tension, et la tension en circuit ouvert (Voc) (tension à courant nul) atteint ~ 135 mV. Correspondant à une série d'états de résistance intermédiaires, le Voc diminue progressivement avec la diminution de la résistance de l'appareil et est négligeable pour le LRS. Alors que peu de changement a été observé pour I –V courbes mesurées dans l'obscurité. Le résultat similaire a été obtenu par Hu et al. [23]. De plus, une méthode de test pour Voc a été rapportée par Shang et al. [24,25,26]. Selon cette méthode, le Voc a été en outre mesuré au LRS et au HRS. Comme prévu, une élévation de tension est produite par un éclairage lumineux, et le Voc dépend de la résistance de jonction (voir le fichier supplémentaire 1 :Figure S2). Les résultats ci-dessus témoignent que l'amplitude de Voc dépend des états de mémoire du dispositif Pt/Nd:STO/In.
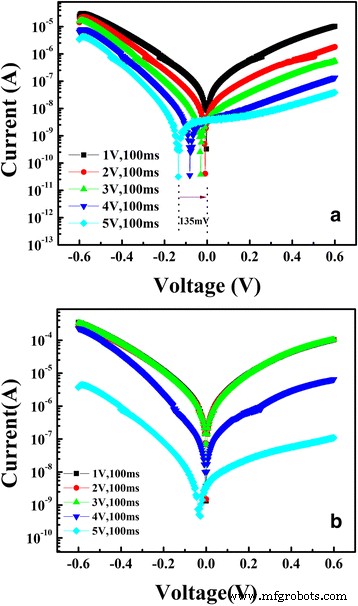
Le Je –V courbes en régime de faible polarisation (− 0,6 à + 0,6 V) après commutation avec une série d'impulsions de tension de + 1 à + 5 V avec 100 ms (passage de LRS à des états de résistance intermédiaires et à HRS) sous a l'éclairage lumineux et b sombre, respectivement
La mémoire à plusieurs niveaux et l'effet PV dépendant de l'état de la mémoire du dispositif Pt/Nd:STO/In suggèrent sans ambiguïté que les états de la mémoire sont principalement déterminés par la couche d'épuisement près de l'interface Pt/Nd:STO. En d'autres termes, la largeur et la hauteur de la barrière Schottky près de l'interface Pt/Nd:STO seront modulées par la tension de balayage. Selon les résultats Raman de la figure 1b, il existe certains défauts (par exemple, des lacunes en oxygène) à la surface Nd:STO. Lorsqu'une tension ou une impulsion négative était appliquée au dispositif, les électrons injectés de l'électrode In étaient piégés par les défauts à l'interface Pt/Nd:STO. Les électrons piégés conduisent à une barrière Schottky plus étroite et plus basse, résultant en LRS. En revanche, lors du prochain balayage de polarisation positive, les électrons piégés sont libérés en raison de l'existence de la région d'appauvrissement, ce qui entraîne HRS. De plus, la distribution spatiale des défauts doit être inégale. L'épinglage de Fermi peut être formé au niveau du défaut à haute densité, de sorte que le HRS et le LRS peuvent être conservés lorsque le biais appliqué est supprimé. La couche d'appauvrissement peut être ajustée par la largeur ou l'amplitude d'impulsion, de sorte que des états de mémoire à plusieurs niveaux ont été observés. La figure 5 montre le schéma de principe du processus de piégeage ou de dépiégeage d'électrons sur l'interface Pt/Nd:STO.
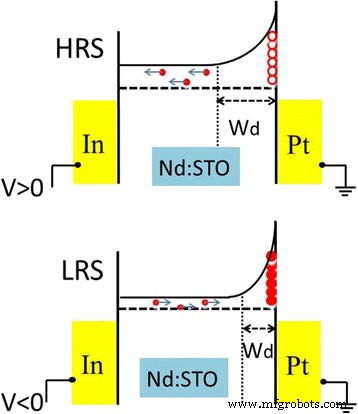
Diagramme schématique de la structure de la bande d'énergie et de l'état de l'interface du système Pt/NSTO/In à HRS et LRS. Les sphères rouges creuses et pleines à l'interface représentent respectivement l'état d'interface inoccupé et occupé
L'effet PV dépendant de l'état de la mémoire est induit par différentes largeurs et hauteurs de la barrière d'interface Pt/Nd:STO à différents états de mémoire. Le HRS avec une région d'appauvrissement plus large se traduit par un plus grand nombre de paires électron-trou générées dans la région d'appauvrissement sous un éclairage lumineux. Les électrons photogénérés sont entraînés dans le volume Nd:STO par la forte courbure de la bande ascendante dans le HRS, et les trous traversent la barrière, ce qui entraîne un Voc plus élevé. Inversement, le LRS avec une région d'appauvrissement inférieure et plus étroite entraîne un Voc inférieur. En général, le Voc dépend de la largeur et de la hauteur de la barrière d'interface qui correspond aux états de mémoire à plusieurs niveaux du dispositif Pt/Nd:STO/In.
Notez que les états de mémoire et l'effet PV présentent une dépendance similaire vis-à-vis du biais de commutation, indiquant le mécanisme partagé lié à l'épuisement/accumulation d'électrons sur l'interface Nd:STO, révélant l'importance de la barrière d'interface et de la redistribution des charges d'interface (Fig. 5). L'effet PV est induit par les électrons photogénérés et les trous séparés par le champ électrique interne. Ainsi, l'effet PV dépendant de l'état de la mémoire observé dans le dispositif Pt/Nd:STO/In témoigne que le RS est induit par la modulation induite par le biais de la barrière Schottky sur l'interface Pt/Nd:STO et non par la formation de filaments conducteurs. Le Voc dépend des états de la mémoire, donc un tel effet PV dépendant de l'état de résistance fournit une nouvelle voie en utilisant Voc pour détecter les états de mémoire du dispositif RS en plus de la lecture de résistance conventionnelle [23]. Ce nouveau parcours de lecture est non destructif et fiable car l'éclairage lumineux ne modifiera pas l'état de la mémoire des appareils.
Conclusions
En résumé, nous avons étudié les caractéristiques RS et PV de dispositifs memristifs monocristallins à base de Nd:STO. L'effet RS est lié à la jonction Schottky près de l'interface du monocristal Pt et Nd:STO de type n. Les états de mémoire peuvent être modulés par la largeur ou l'amplitude d'impulsion. L'effet PV dépendant de l'état de la mémoire du dispositif Pt/Nd:STO/In est obtenu par la tension de commutation. Ces effets complémentaires sont attribués à la modulation induite par le biais de la barrière d'interface, à la fois en hauteur et en largeur, à l'interface Pt/Nd:STO, qui est causée par l'injection de porteurs et le processus de piégeage/dépiégeage sur l'interface Pt/Nd:STO . Les résultats établissent un lien étroit entre les effets RS/PV et la modulation de l'interface Nd:STO déclenchée par le champ électrique appliqué et fournissent une nouvelle voie en utilisant Voc pour détecter de manière non destructive plusieurs états de mémoire non volatile.
Abréviations
- HRS :
-
État de haute résistance
- Je –V :
-
Courant-tension
- LRS :
-
État de faible résistance
- PV :
-
Photovoltage
- RRAM :
-
Mémoires vives à résistance
- RS :
-
Commutation de résistance
- XRD :
-
Diffraction des rayons X
Nanomatériaux
- Étude d'un nouveau système micellaire ressemblant à un ver amélioré par des nanoparticules
- Étude des premiers principes sur la stabilité et l'image STM du borophène
- Étude expérimentale sur les caractéristiques d'écoulement et de transfert de chaleur de nanofluides TiO2-eau dans un tube cannelé en spirale
- Étude collective sur la modélisation et la simulation de mémoires résistives à accès aléatoire
- Conception et ajustement de la fonction de travail du graphène via la taille, la modification, les défauts et le dopage :une étude théorique du premier principe
- Étude des propriétés structurelles, électroniques et magnétiques des amas Ag n V (n = 1–12)
- Fabrication et caractérisation de nano-clips de ZnO par le procédé à médiation par polyol
- Dépendances de la température et de la pression des propriétés élastiques des monocristaux de tantale sous charge de traction <100> :une étude de dynamique moléculaire
- Nouvelle étude :impact de la COVID-19 sur l'avenir du travail et de l'automatisation



