Effet de la concentration d'Ag dispersée dans des films minces HfOx sur la commutation de seuil
Résumé
Un courant de chemin de fuite - un courant traversant une cellule de mémoire voisine - est un problème inhérent et inévitable dans un réseau crossbar constitué de cellules de mémoire memristors. Ce problème sérieux peut être atténué en connectant en série le dispositif sélecteur à chaque cellule memristor. Parmi les différents types de concepts de dispositifs sélecteurs, le sélecteur diffusif a suscité une attention considérable en raison de ses excellentes performances. Ce sélecteur est doté d'une commutation à seuil volatil (TS) utilisant la dynamique de métaux actifs tels que Ag ou Cu, qui agissent comme une électrode ou un dopant dans l'électrolyte solide. Dans cette étude, un sélecteur diffusif basé sur HfOx dopé Ag est fabriqué à l'aide d'un système de co-pulvérisation. En tant que concentration d'Ag dans le HfOx couche varie, des propriétés électriques différentes et donc des caractéristiques TS sont observées. La nécessité du processus d'électroformage (EF) pour la caractéristique TS est déterminée par la concentration appropriée en Ag dans le HfOx couche. Cette différence dans le processus EF peut affecter de manière significative les paramètres des caractéristiques TS. Par conséquent, une condition de dopage optimisée est requise pour qu'un sélecteur diffusif atteigne un excellent comportement du dispositif de sélection et évite un processus EF qui peut éventuellement dégrader les performances du dispositif.
Introduction
La mémoire à commutation de résistance, également connue sous le nom de memristor, a été largement étudiée pendant des décennies en tant que candidat prometteur pour la mémoire non volatile de prochaine génération. Récemment, des dispositifs à memristor ont été appliqués à des synapses artificielles et à des neurones ressemblant à leur mécanisme de commutation basé sur la migration d'ions pour l'informatique inspirée du cerveau [1,2,3]. Vitesse de commutation rapide (< 1 ns), évolutivité extrême (< 2 nm), assez bonne endurance (jusqu'à 10 11 cycles de programmation/effacement) et la structure d'empilement tridimensionnel ont été prouvées jusqu'à présent dans des systèmes memristifs individuels [4,5,6]. De plus, le traitement d'image et la reconnaissance de formes peuvent être activés en créant un grand réseau de barres croisées (CBA) [1, 3, 7, 8].
Cependant, une structure CBA présente un problème inhérent en ce qu'un courant de chemin furtif à travers des cellules de mémoire memristor voisines perturbe les opérations d'écriture/lecture au niveau de la cellule sélectionnée ou semi-sélectionnée [9,10,11]. Pour supprimer le problème de courant de chemin de fuite et de demi-sélection, un dispositif sélecteur à deux bornes peut être connecté en série à chaque cellule de mémoire. Il existe de nombreux types de dispositifs sélecteurs avec courant-tension non linéaire (I -V ) caractéristiques introduites, telles que les diodes Schottky, les transitions métal-isolant (MIT), les commutateurs à seuil ovonique (OTS), les sélecteurs à barrière tunnel et les sélecteurs diffusifs (également appelés memristors diffusifs) [9,10,11,12,13,14 ,15]. Parmi eux, un sélecteur diffusif basé sur la dynamique de diffusion des espèces métalliques (Ag ou Cu) à l'intérieur des diélectriques a suscité un intérêt considérable en raison de sa structure simple et de ses performances supérieures, telles que sa non-linéarité extrêmement élevée [14,15,16,17,18, 19,20,21,22]. Le sélecteur diffusif est doté d'un interrupteur à seuil volatil (TS) basé sur la formation et l'auto-rupture de filaments métalliques. Divers systèmes de sélecteurs diffusifs et leurs propriétés dynamiques ont été rapportés jusqu'à présent; cependant, la compréhension du mécanisme de fonctionnement sous-jacent reste difficile. De plus, il est nécessaire d'établir la concentration et la distribution des espèces métalliques diffusantes pour obtenir d'excellentes performances TS, car elles peuvent affecter de manière significative la conduction électrique et les propriétés de transition.
Ici, nous avons fabriqué un HfOx dopé Pt/Ag /Pt stack comme sélecteur diffusif, dans lequel Ag et HfOx agissent respectivement comme dopant métallique diffusif et matériau diélectrique. Nous avons examiné les propriétés électriques des dispositifs à différentes concentrations de dopage pour mettre en relation les conditions appropriées pour la caractéristique TS. Les caractéristiques TS nécessaires à l'électroformage (nécessaire EF) et sans électroformage (sans EF) ont été déterminées par la concentration de dopant dans les sélecteurs diffusifs. Pour expliquer la différence dans le processus d'électroformage (EF) et les caractéristiques TS ultérieures, nous avons effectué des analyses structurelles et chimiques des dispositifs de sélection par diffusion. Notre étude suggère l'effet de la concentration de dopant sur les caractéristiques TS du sélecteur diffusif et fournit une direction pour améliorer ses performances.
Méthodes
La figure 1a montre un système de co-pulvérisation avec un Ag et HfO2 cibler. Nous avons fabriqué des dispositifs placés à quatre positions sur le substrat à 0,5 cm les unes des autres. Les positions étaient proches du HfO2 cible dans l'ordre des appareils 1, 2, 3 et 4 (D1, D2, D3 et D4), comme illustré à la Fig. 1a. Le HfOx dopé Ag la couche de commutation de tous les appareils a été déposée sur le Pt/Ti/SiO2 Substrat /Si via co-pulvérisation avec une puissance de pulvérisation de 10 W pour Ag et 150 W pour HfO2 , respectivement. Avant le processus de dépôt, la pression de base de la chambre à vide a été évacuée jusqu'à ~ 5 × 10 6 . La couche de commutation a été déposée pendant 5 min sans faire tourner le substrat à température ambiante sous un flux d'Ar de 20 sccm pour maintenir le plasma d'Ar. La pression de traitement était de 10 mTorr. Ensuite, l'électrode de Pt supérieure a été déposée sur une couche de commutation telle que déposée à l'aide d'un masque perforé de 200 µm de diamètre via une évaporation par faisceau électronique. Les figures 1 b et c montrent respectivement l'image en coupe transversale et la conception schématique de l'appareil fabriqué.
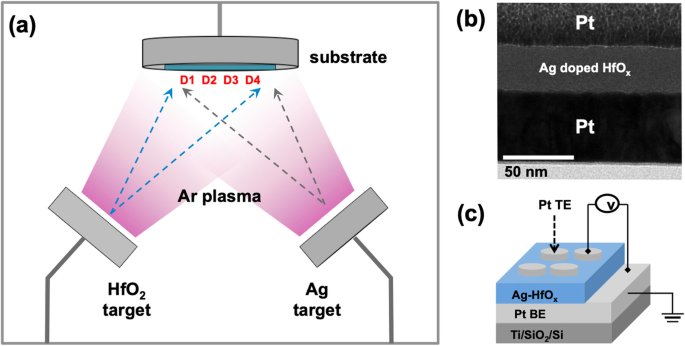
un Schéma d'un système de co-pulvérisation. b Image TEM en coupe du dispositif fabriqué. c Schéma de principe de l'appareil avec le système de mesure électrique
L'épaisseur de la couche de commutation déposée par co-pulvérisation a été mesurée à l'aide d'un ellipsomètre (FS-1, Film-Sense, USA). La spectrométrie de rétrodiffusion Rutherford (RBS ; 6SDH-2, NEC, États-Unis) et la spectrométrie de fluorescence X (XRF ; ARL, Thermo Fisher Scientific, États-Unis) ont été réalisées pour analyser la composition atomique du HfO dopé Agx couche. Pour évaluer les propriétés électriques du dispositif, un analyseur de paramètres à semi-conducteurs (SPA; HP-4155A, Agilent, USA) a été utilisé à température ambiante. Toutes les mesures ont été effectuées en appliquant une polarisation à l'électrode supérieure tandis que l'électrode inférieure était mise à la terre comme le montre la figure 1c. La surface des appareils a été analysée à l'aide d'un microscope électronique à balayage à émission de champ (FE-SEM ; JSM-6700F, JEOL, Japon) et d'une microscopie à force atomique (AFM ; XE-100, Park system, Corée). Les échantillons transversaux des dispositifs ont été préparés à l'aide d'un processus de faisceau d'ions focalisé (FIB ; Quanta 3D FEG, FEI, Pays-Bas) et ont été observés à l'aide d'un microscope électronique à transmission haute résolution (HR-TEM :JEM-2100F, JEOL, Japon ). La composition chimique a été analysée par spectroscopie à rayons X à dispersion d'énergie (EDS).
Résultats et discussion
Nous avons fabriqué simultanément quatre HfOx dopé Ag dispositifs pour sélecteurs diffusifs au cours d'un même processus. Pendant le processus de dépôt, le substrat n'a pas été tourné pour confirmer l'effet de la concentration de dopage sur les propriétés électriques. Le tableau 1 montre l'épaisseur, le rapport cationique Ag:Hf et la rugosité moyenne quadratique (RMS) de D1, D2, D3 et D4, respectivement. La composition d'Ag dans la couche de commutation a été exprimée en tant que rapport de cations en utilisant une quantité d'Ag et de Hf obtenue à partir de l'analyse XRF. Comme indiqué, chaque appareil a une épaisseur et une concentration en Ag différentes. Avec une augmentation de la distance du HfO2 cible, l'épaisseur de la couche de commutation a diminué tandis que la composition d'Ag dans la couche d'oxyde a augmenté. Avec l'augmentation de la concentration d'Ag, les valeurs de rugosité RMS ont légèrement augmenté (les images AFM sont présentées dans le fichier supplémentaire 1 :Figure S1).
Courant continu (CC)–tension (I -V ) les caractéristiques mesurées à partir de tous les appareils sont illustrées à la Fig. 2a–d. D1 (35,3 nm, 7% Ag) était initialement dans un état hautement isolant, et aucune commutation de seuil n'a été observée lors des mesures en courant continu (Fig. 1a) en raison de la concentration en Ag insuffisante pour produire un filament conducteur malgré l'épaisse couche de commutation. En revanche, D2 (27,3 nm, 16 % Ag) a montré un seuil passant d'un état de haute résistance (HRS) à un état de faible résistance (LRS) après le processus d'électroformage (EF) à l'état vierge pour produire un dispositif fonctionnel comme le montre la figure 1b. Au cours du processus EF, le courant a augmenté d'un niveau bas pour atteindre un courant de conformité (I cc ) à la tension de − 4,3 V. Par la suite, D2 a montré en continu un comportement TS à une tension de fonctionnement inférieure à la tension de formation dans les deux polarités de polarisation. De même, D3 (24 nm, 39% Ag) a montré un comportement TS bidirectionnel typique; cependant, le processus EF n'était pas nécessaire dans l'état vierge de D3. En d'autres termes, D3 présente un comportement TS sans EF. En revanche, D4 (18,8 nm, 58 Ag%) était initialement dans un état hautement conducteur, probablement à cause de la percolation d'Ag dans le mince HfOx couche étant donné la concentration élevée en Ag.

Propriétés électriques des appareils fabriqués. un I-V courbe de D1 (état très isolant). b I-V courbe de D2, montrant le processus EF et les comportements TS ultérieurs. c I-V courbe de D3, montrant le comportement de TS sans le processus EF. d I-V courbe de D4 (état conducteur)
La morphologie de la surface et la taille des grains ont changé avec l'augmentation de la concentration en Ag. Comme indiqué précédemment, avec l'augmentation de la concentration d'Ag, les valeurs de rugosité RMS ont augmenté comme indiqué dans le tableau 1. La taille des grains a également été évaluée à l'aide d'un SEM (Fichier supplémentaire 1 :Figure S2). Une augmentation de la taille des grains a été observée à mesure que la concentration en Ag augmentait. Cependant, dans le cas de D2 et D3 qui présentent des caractéristiques TS disparates, la différence de rugosité de surface et de taille de grain était assez faible. Néanmoins, il y avait une différence considérable dans leurs propriétés électriques en termes de processus EF et suivant les caractéristiques TS. Ainsi, nous avons comparé les caractéristiques TS de D2 et D3 comme suit.
Les figures 3 a et b montrent le comportement reproductible du TS observé dans D2 et D3 via une mesure DC. A titre de comparaison, seules les caractéristiques TS au biais négatif sont présentées dans les figures. Les deux appareils ont initialement montré plusieurs niveaux de courant pA à - 0,1 V sous la limite de détection. Le comportement TS dans D2 était évident après le processus EF à une tension de formation de ~ − 3,5 V, tandis qu'un courant de conformité (I cc ) de 5 μA a été réglé pour l'appareil afin d'éviter une panne brutale. Après le processus EF, l'appareil a montré un comportement TS typique, comme le montre la figure 3a. Lorsque la tension appliquée a dépassé la tension de seuil (V ème ) de ~ − 1.1 V, le courant a soudainement atteint un I cc de 5 μA ; l'appareil est passé de l'état OFF à l'état ON. Cependant, l'état ON de l'appareil est revenu à l'état OFF lorsque la tension appliquée a diminué à moins que la tension de maintien (V tenir ). Bien que l'appareil soit revenu à l'état OFF, un courant OFF plus élevé a été observé que celui de l'appareil avant EF.
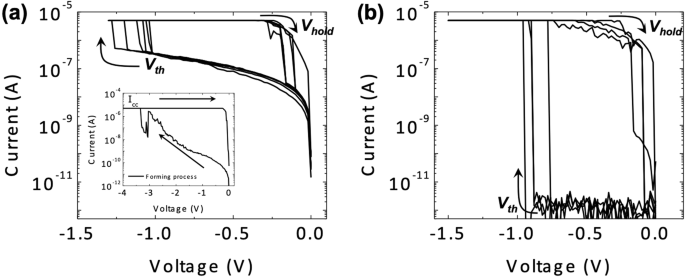
Comparaison des caractéristiques TS en D2 et D3. un Comportement TS avec un courant OFF accru suivant le processus EF. La figure en médaillon montre le processus EF dans un appareil tel que déposé. b Comportement TS sans que le processus EF maintienne un courant OFF faible et un NL élevé
D3 a également montré des caractéristiques TS typiques, comme le montre la figure 3b. Cependant, le processus EF n'était pas nécessaire pour induire un comportement TS dans l'appareil à l'état vierge. Le courant a atteint un I cc de 5 μA à un V ème de ~ − 0.8 V, qui est l'état ON, puis est revenu spontanément à l'état initial OFF à un V ème moins de ~ − 0.2 V. Le D3 suivant I -V les boucles étaient similaires au premier I -V boucles. De plus, l'appareil a systématiquement montré un faible courant OFF à une faible tension de fonctionnement par rapport à celle de D2. De plus, la densité de courant à l'état OFF dans D3 restait toujours inférieure à celle de D2; la différence était d'environ 10 5 A/cm 2 . Par conséquent, il a été confirmé que la différence de concentration d'Ag dans le HfOx La couche a déterminé la nécessité du processus EF et, à son tour, les caractéristiques du TS ont radicalement changé.
Pour réaliser une mémoire résistive à un sélecteur (1S1R), un sélecteur nécessite un faible courant OFF pour supprimer le courant de fuite et un courant ON élevé correspondant au courant de réinitialisation de la mémoire résistive [21, 22]. Pour remplir un tel Je -V caractéristiques non linéaires, nous avons confirmé la non-linéarité (NL ) et la sélectivité (S ) de nos dispositifs et ceux des sélecteurs TS précédemment rapportés pour évaluer leurs performances en tant que sélecteurs [14, 18, 21, 22, 23]. Ici, nous définissons NL et S en utilisant les équations. (1) et (2), respectivement, comme suit :
$$ NL=\frac{I_{V_{\mathrm{th}}}}{I_{\frac{1}{2}{V}_{\mathrm{th}}}} $$ (1) $$ S=\frac{I_{\mathrm{ON}}}{I_{\mathrm{OFF}}} $$ (2)NL est défini comme le rapport du courant à V ème et demi de V ème . Dans le schéma à demi-biais du tableau crossbar, V ème est appliqué à la cellule de ciblage tandis que la moitié de V ème est appliqué aux cellules voisines semi-sélectionnées. Par conséquent, NL est essentiel pour empêcher le dysfonctionnement du réseau crossbar pendant les opérations de programmation/lecture. En revanche, S est le rapport du courant à l'état ON et à l'état OFF à V ème , représentant les performances du sélecteur basé sur TS. Les deux définitions sont largement utilisées pour la comparaison des performances des dispositifs de sélection. Ainsi, les grandes NL et S des valeurs sont requises pour que le fonctionnement 1S1R supprime efficacement le courant de chemin de fuite.
Divers paramètres de commutation, y compris NL et S dans nos appareils et les sélecteurs TS dans la littérature sont présentés dans le tableau 2. Dans le cas de D2, une augmentation du courant OFF entraîne une diminution significative de NL et S . En revanche, le courant D3 OFF est suffisamment faible pour qu'une valeur supérieure à 10 6 NL et S ont été acquis. Cependant, D2 et D3 ne pouvaient montrer une caractéristique TS qu'à un faible I cc (< 10 μA) car TS est passé à la commutation de mémoire à un I plus élevé cc . Il est bien connu que la plupart des dispositifs sélecteurs TS utilisant un filament Ag sont soumis à une transition de commutation de mémoire non volatile à un I cc supérieur à 10–100 μA [23,24,25,26]. Quand Je cc est supérieur à 10-100 μA, un filament métallique robuste et stable est formé qui est difficile à rompre spontanément par rapport au filament mince et instable formé à un I inférieur cc [26, 27]. Par conséquent, diverses méthodes, telles qu'une structure multicouche (Ag/TaOx /TaOy /TaOx /Ag) et des nanodots d'Ag modélisés dans le diélectrique, ont été suggérés pour obtenir des caractéristiques TS fiables à un I plus élevé cc [21, 22].
Pour observer la taille et la distribution des atomes d'Ag dans le HfOx des analyses élémentaires de couche, HR-TEM et EDS ont été réalisées à J2 et J3. La figure 4 a et b (c et d) montrent des images HR-TEM en coupe transversale de D2 (D3). D'après les images HR-TEM, il est probable que la taille atomique de l'Ag soit uniformément dispersée dans le HfOx matrice. Aucune particule d'Ag ou amas d'Ag distinguables de quelques nanomètres n'a été observé dans les deux appareils. De plus, le HfOx La phase amorphe a été confirmée via une image de transformée de Fourier rapide (FFT) comme indiqué dans les encarts des Fig. 4 b et d. Cependant, le signal Ag dans les profils de ligne indique la présence d'Ag dans le HfOx couche. Ainsi, il est conclu que Ag dans HfOx serait distribué à l'échelle atomique. La région de commutation comprenant le nanofilament d'Ag doit être étudiée ; cependant, les caractéristiques TS sont volatiles de sorte que l'observation MET in situ devrait être tentée à l'avenir.
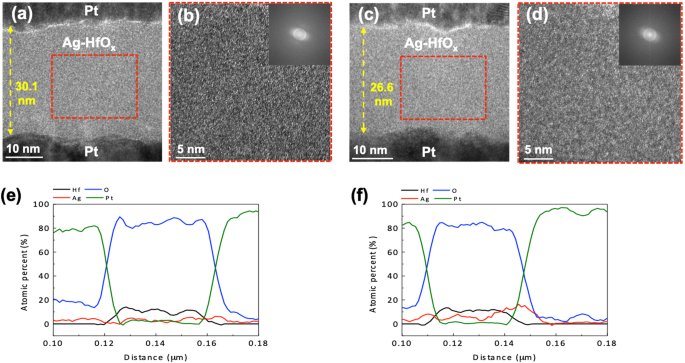
Analyse microstructurale et compositionnelle. un Image en coupe MET de D2. b Image TEM agrandie de D2. L'encart est l'image FFT correspondante. c Image en coupe TEM de D3. d Image TEM agrandie de D3. L'encart est l'image FFT correspondante. Profils de ligne élémentaire EDS de e D2 et f D3
Nous proposons le mécanisme suivant pour les comportements TS dans nos appareils, comme le montrent les Fig. 5 a et b. Le HfOx dopé Ag tel que fabriqué les couches de commutation ont des atomes d'Ag uniformément répartis dans le HfOx . Cependant, on s'attend à ce qu'il y ait une distance relativement longue entre les atomes d'Ag en raison de la faible concentration d'Ag dans D2. La figure 5a montre le processus EF à partir de D2 tel que fabriqué. Lorsqu'un champ électrique est appliqué à l'appareil dans un état vierge, les atomes d'Ag dans le HfOx peut être oxydé en Ag + ions et ils migrent le long de la direction du champ. L'Ag + oxydé les ions sont à nouveau réduits en atomes Ag à l'autre électrode de Pt, où un filament conducteur d'Ag peut croître en continu. Une fois le filament connecté entre les deux électrodes, l'appareil passe d'un état ON à un état OFF. Au cours du processus EF dans D2, de plus grands amas d'Ag pourraient se former en raison du champ électrique élevé. Il a été trouvé qu'un champ électrique aussi important est suffisant pour former des nanoparticules d'Ag de plusieurs nanomètres de diamètre à partir de l'observation MET in situ dans la littérature [14, 15]. Une fois le champ électrique appliqué supprimé, Ag à l'échelle atomique se diffuse dans le HfOx matrice, indiquant que l'appareil est revenu à l'état OFF. Cependant, les plus gros amas d'Ag, qui ne peuvent pas diffuser suffisamment, restent sur le chemin conducteur. Ainsi, ces amas d'Ag résiduels conduisent à un courant OFF plus important dans l'état OFF suivant. En revanche, dans le cas du D3 tel qu'illustré à la figure 5b, le filament d'Ag est formé sans formation d'amas d'Ag car D3 fonctionne sous un champ électrique faible, ce qui signifie que l'appareil peut maintenir un faible courant d'arrêt. De même, lorsque le champ électrique appliqué est supprimé, l'appareil revient à l'état OFF en raison de la rupture spontanée du filament d'Ag qui peut s'expliquer par l'effet Thomson-Gibbs de minimisation de l'énergie interfaciale entre un filament et la matrice [15, 18 , 28]. Par conséquent, les caractéristiques TS bidirectionnelles peuvent être obtenues grâce à une dynamique de diffusion atome/ion Ag reproductible.
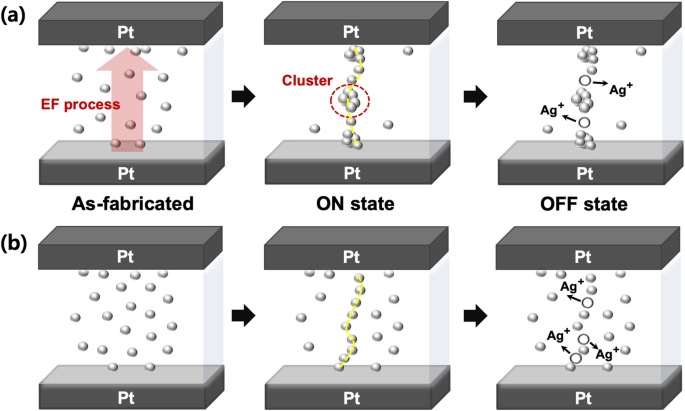
Mécanisme suggéré de TS dans un dispositif HfOx dopé Ag. La première formation/rupture de filament d'Ag pour le comportement TS en a EF-nécessaire (D2) et b Appareils sans EF (D3)
Pour expliquer la différence au cours du processus EF, nous proposons les équations suivantes. (3) et (4) :
$$ D={D}_0\mathit{\exp}\left(-\frac{E_{\mathrm{mo}}}{kT}\right) $$ (3)où D est la diffusivité, D 0 est le facteur pré-exponentiel, E mo est la barrière migratoire à zéro biais, k est la constante de Boltzmann, et T est la température absolue locale. Pour former le filament Ag dans le HfOx couche, les ions Ag doivent surmonter une barrière de migration pour se déplacer vers l'électrode polarisée négativement. Lorsque la polarisation externe est appliquée, le champ électrique peut abaisser la barrière de migration, E m , conduisant à des migrations d'ions le long de la direction du champ comme suit :
$$ {E}_{\mathrm{m}}={E}_{\mathrm{m}\mathrm{o}}-\frac{e\bullet {V}_{\mathrm{bias}}}{ Z_{\mathrm{box}}}\bullet \Delta z $$ (4)avec une charge électronique e , tension de polarisation V biais , HfOx épaisseur de couche Z boîte , et Ag distance de saut dans le z direction ∆z . En effet, les ions Ag peuvent sauter dans toutes les directions sous un biais nul. Cependant, nous avons envisagé de sauter le long du z direction dans le processus EF car l'appareil peut être mis à l'état ON sous le champ électrique élevé où les ions Ag sautent de manière dominante le long de la direction du champ électrique. Pour estimer le E m , nous avons calculé la distance de saut Ag (∆z ) comme 0,67 nm dans D2 et 0,45 nm dans D3 à partir de nos résultats expérimentaux de concentration d'Ag et d'épaisseur de film. La barrière migratoire à zéro biais, E mo = 3,02 eV, a été utilisé à partir de la littérature [29]. Dans la première formation du filament d'Ag, ~ 1,6 MV/cm de champ électrique était requis dans D2 et a abaissé la barrière de migration de 0,11 eV. En revanche, ~ 0,4 MV/cm de champ électrique était nécessaire pour la première commutation en D3 et a abaissé la barrière de migration de 0,04 eV. Ainsi, la diffusion d'Ag est suffisante pour former le filament d'Ag dans D3 malgré la réduction de barrière plus faible en raison de la courte distance de saut et de la concentration élevée d'Ag par rapport à celles de D2. Cependant, en raison de la distance de saut relativement longue dans D2, la plus grande réduction de barrière était nécessaire pour une diffusion suffisante pour former un filament d'Ag. Une fois le filament formé, il doit se rompre spontanément en cessant la tension; cependant, le filament d'Ag n'a pas pu diffuser entièrement dans leur distribution initiale, et donc la distance de saut ∆z diminue par rapport à celui du D2 brut de fabrication. Par conséquent, ce résultat a conduit à un champ électrique réduit (~ 0,4 MV/cm) lors de la commutation de seuil ultérieure. Il est à noter que l'épaisseur du film affecte considérablement le I -V caractéristiques de l'appareil. Par conséquent, nous avons confirmé le processus EF dans les dispositifs d'épaisseur similaire mais ayant une concentration en Ag différente. De même, les dispositifs présentaient une transition des caractéristiques EF nécessaires aux caractéristiques sans EF au fur et à mesure de l'augmentation de la concentration en Ag. Par conséquent, il a été démontré que la concentration en Ag affecte essentiellement le processus EF en contrôlant le champ électrique interne effectif. C'est-à-dire moduler la concentration en Ag et donc la distance de saut dans le HfOx couche est requise pour les caractéristiques TS sans EF avec un NL plus grand et S valeurs.
Conclusions
Dispositifs sélecteurs diffusifs basés sur HfOx dopé Ag des films minces ont été fabriqués et leurs caractéristiques TS ont été évaluées. Pour comprendre l'effet de la concentration d'Ag sur les propriétés électriques, des dispositifs avec différentes concentrations d'Ag ont été évalués. Le comportement TS dans les dispositifs peut être décrit par la formation/auto-rupture de filament d'Ag à partir d'atomes d'Ag atomiquement dispersés dans le HfOx . Il a été confirmé que la concentration en Ag pouvait affecter le processus EF pour former un tel filament métallique. L'appareil avec une faible concentration en Ag nécessitait un processus EF précédent pour le comportement TS, tandis que le comportement TS sans EF a été prouvé dans l'appareil avec une concentration en Ag plus élevée. De plus, l'appareil sans EF a montré de meilleures performances TS que celles de l'appareil EF-nécessaire en termes de non-linéarité et de courant OFF. Par conséquent, un contrôle approprié de la concentration et de la distribution du dopant est nécessaire pour obtenir un dispositif de sélection de diffusion sans EF afin d'éviter la dégradation des performances résultant du processus EF.
Disponibilité des données et des matériaux
Toutes les données sont entièrement disponibles sans restriction.
Abréviations
- CBA :
-
Réseau de barres transversales
- EF :
-
Electroformage
- HRS :
-
État de haute résistance
- LRS :
-
État de faible résistance
- NL :
-
Non-linéarité
- S :
-
Sélectivité
- TS :
-
Commutation de seuil
Nanomatériaux
- Fabrication de couches minces SrGe2 sur des substrats Ge (100), (110) et (111)
- Étude de la force d'adhérence et de la transition vitreuse de films minces de polystyrène par microscopie à force atomique
- Effet de commutation résistive asymétrique induit par effet de champ ferroélectrique dans les hétérojonctions épitaxiales BaTiO3/Nb:SrTiO3
- Analyse d'impédance de couches minces de pérovskites organiques-inorganiques CH3NH3PbI3 avec contrôle de la microstructure
- Nanoparticules d'or de forme ronde :effet de la taille et de la concentration des particules sur la croissance des racines d'Arabidopsis thaliana
- Effet de différentes morphologies de CH3NH3PbI3 sur les propriétés photovoltaïques des cellules solaires à pérovskite
- Double fonction du périphérique V/SiOx/AlOy/p++Si comme sélecteur et mémoire
- Effet des hétérostructures bicouche CeO2−x/ZnO et ZnO/CeO2−x et polarité d'électroformage sur les propriétés de commutation de la mémoire non volatile
- Effet du recuit post-thermique sur les propriétés optiques des films InP/ZnS Quantum Dot



