Points quantiques d'indium de taille uniforme cultivés à la surface d'une couche épitaxiale d'InGaN par un processus de refroidissement en deux étapes
Résumé
Une nouvelle méthode pour faire croître des points quantiques d'indium (In QDs) sur la surface d'une couche épitaxiale d'InGaN par MOCVD est proposée. Il a été découvert que des points quantiques In de taille uniforme se forment à la surface d'une couche d'InGaN lorsqu'un processus de refroidissement en deux étapes est effectué. Grâce à l'analyse, nous avons constaté que la formation de In QD sur la surface est due à la réaction entre la couche de surface riche en In et le gaz porteur H2 à la période de température inférieure dans le processus de refroidissement en deux étapes. Dans le même temps, comme la densité des QD d'In dépend étroitement de la couche de surface riche en In, cela nous permet d'étudier directement la propriété de surface de la couche d'InGaN.
Introduction
Ces dernières années, les matériaux à base de (Al, In, Ga)N ont attiré beaucoup d'attention en raison de leur application réussie dans un dispositif électroluminescent (LED) et une diode laser (LD) [1,2,3,4, 5]. InGaN a une absorption élevée, une large couverture spectrale et une dureté de rayonnement et il est toujours utilisé comme matériau actif pour la fabrication de dispositifs optoélectroniques. Cependant, la croissance de matériaux InGaN de haute qualité est un grand défi, en raison d'un certain nombre de problèmes. Par exemple, la grande différence de constante de réseau entre InN et GaN entraîne un écart de miscibilité en phase solide [6, 7]. La pression de vapeur relativement élevée de l'InN par rapport au GaN conduit à une faible incorporation d'indium dans l'alliage InGaN [8]. De plus, une grande différence d'enthalpies de formation pour InN et GaN provoque une forte ségrégation de surface de l'indium sur le front de croissance [9]. D'autre part, dans le processus de croissance de la couche InGaN, il existe toujours une couche riche en In à la surface en raison de l'effet de traction, ce qui affectera la qualité de la couche suivante du puits quantique multiple InGaN/GaN (MQW) en introduire des atomes d'indium dans la croissance subséquente de la couche de GaN [10]. Pour obtenir les hautes performances des dispositifs optoélectroniques basés sur InGaN, nous devons surmonter tous ces obstacles. Au cours de la recherche, la croissance d'une seule couche d'InGaN est toujours utilisée pour optimiser le paramètre de croissance d'InGaN/GaN MQW. Dans cet article, nous avons parfois trouvé des points quantiques In de taille uniforme à la surface de la couche unique d'InGaN lors d'un processus de refroidissement en deux étapes qui remplace le processus de refroidissement régulier en une étape après la croissance de la couche unique d'InGaN. Grâce à l'analyse, nous avons constaté que la formation de QD d'In est liée à la couche riche en In existant à la surface de la couche d'InGaN, et cela nous fournit un moyen d'étudier directement la couche riche en In de surface.
Expérience
Les échantillons utilisés dans cette étude étaient des couches simples d'InGaN cultivées sur un substrat de saphir de plan c par un AIXTRON 6 × 2 dans un dépôt chimique métalorganique (MOCVD) dans un réacteur à pomme de douche à couplage étroit dans un N2 atmosphère. Triméthylgallium (TMGa), triméthylindium (TMIn) et ammoniac (NH3 ) sont utilisés comme précurseurs de source Ga, In et N, respectivement. Les couches uniques d'InGaN d'une épaisseur inférieure à 60 nm et d'une teneur en In inférieure à 15% ont été développées sur une couche de GaN à dopage non intentionnel de 2 m d'épaisseur après une couche tampon de GaN de 25 nm développée sur un substrat de saphir. Le schéma de la structure est illustré à la Fig. 1. H2 et N2 sont utilisés comme gaz vecteur à différentes périodes du processus de croissance. Classiquement, le N2 est utilisé comme gaz vecteur dans le processus de croissance de la couche d'InGaN car H2 a un effet corrosif sur la couche d'InGaN qui diminuera considérablement l'efficacité d'incorporation d'In [11, 12]. Cependant, H2 en tant que gaz porteur, il peut grandement améliorer la mobilité de surface des atomes et réduire la concentration en impuretés. Par conséquent, H2 est préférable d'utiliser comme gaz porteur pendant la croissance de la couche de GaN pour améliorer la qualité cristalline. Généralement, lorsque la croissance de la couche d'InGaN est terminée, la température est directement abaissée à la température ambiante dans une atmosphère d'azote. Ici, nous appelons un tel processus « refroidissement en une étape ». Dans cet article, un processus de refroidissement en deux étapes a été entrepris après la croissance de la couche d'InGaN, dans lequel la température a été abaissée à 400 °C dans une atmosphère d'azote lors de la première période de refroidissement, puis elle est réduite à la température ambiante. dans un H2 atmosphère. La diffraction des rayons X à haute résolution (XRD), la microscopie à force atomique (AFM), le microscope électronique à balayage (MEB) et le spectromètre à dispersion d'énergie (EDS) sont utilisés pour caractériser les échantillons d'InGaN.
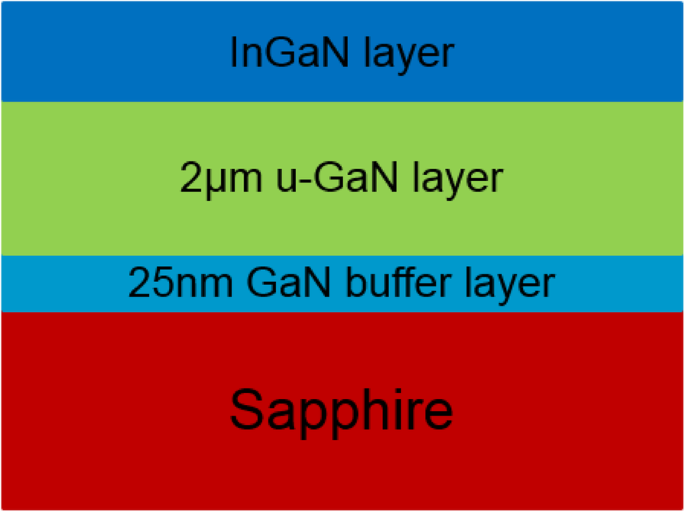
Le schéma de structure de la seule couche d'InGaN développée sur un modèle de GaN en utilisant un substrat de saphir
Résultat et discussion
Une topographie de surface anormale de la couche d'InGaN a été trouvée lors de la croissance sur une seule couche d'InGaN sur le modèle de GaN avec un processus de refroidissement en deux étapes. La morphologie de surface AFM des échantillons d'InGaN avec un refroidissement en une étape et un refroidissement en deux étapes est respectivement illustrée sur les figures 2a et b. La figure 2a montre une morphologie de surface typique de l'épicouche d'InGaN, à partir de laquelle nous pouvons constater que la couche d'InGaN a un flux de croissance 2D clair. Dans le même temps, il existe de nombreux îlots 3D sur la surface de l'échantillon qui sont attribués à des lignes de dislocation de vis dans la couche de GaN. On peut également voir qu'il y a un point sombre sur le dessus de chaque îlot 3D qui s'est avéré être la fosse en V formée le long de la dislocation de la vis [13, 14]. À la différence de la figure 2a, à l'exception de la surface d'écoulement en escalier et des îlots 3D, il existe également de nombreux points quantiques de taille uniforme (les petits points blancs sur l'image) sur la figure 2b. Combiné avec l'encart de la figure 2b dans le coin supérieur gauche qui est un diagramme 3D de la surface, nous pouvons obtenir la taille moyenne de ces points quantiques est d'environ 100 nm × 100 nm, la hauteur moyenne est d'environ 20 nm, et le la densité est d'environ 1,6 × 10 8 cm −2 . Il est à noter que la principale différence entre ces deux modes de refroidissement des échantillons est que H2 est utilisé comme gaz vecteur au lieu de N2 dans la deuxième période de refroidissement du processus de refroidissement en deux étapes. Par conséquent, la formation de points quantiques à la surface de la couche d'InGaN est liée au gaz porteur H2 dans le processus de refroidissement à basse température.
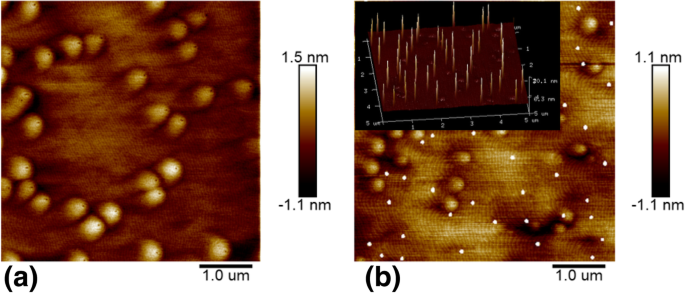
Topographie de surface AFM de a Échantillon InGaN avec refroidissement en une étape et b Échantillon InGaN avec processus de refroidissement en deux étapes où l'encart est un diagramme 3D de la surface
Pour comprendre comment cela se produit lorsqu'un processus de refroidissement en deux étapes est effectué sur des échantillons d'InGaN, nous effectuons une expérience de refroidissement en deux étapes sur GaN au lieu d'InGaN. Cette couche de GaN a été cultivée dans les mêmes conditions que les échantillons de couche unique d'InGaN étudiés dans ce travail, c'est-à-dire à une température de croissance relativement inférieure de 740 °C et N2 est utilisé comme gaz vecteur. La topographie de surface AFM de la couche de GaN après un processus de refroidissement en deux étapes est illustrée à la figure 3a. Nous pouvons constater qu'il n'y a pas de points quantiques à la surface et que la surface est exactement la même que celle des échantillons de couche de GaN cultivés par MOCVD à refroidissement en une étape, comme cela a été largement rapporté [15]. De plus, nous avons vérifié ce qui se passera lorsque le processus de refroidissement en deux étapes est utilisé pour un échantillon de couche d'InGaN à très faible teneur en In dans lequel la teneur en In n'est que de 1%. La figure 3b montre la morphologie de surface AFM de cet échantillon d'InGaN à faible teneur en In après un processus de refroidissement en deux étapes. On constate que la densité des points quantiques présente une très forte diminution par rapport à l'échantillon InGaN à forte teneur en In mentionné ci-dessus dont la teneur en In est d'environ 13%. Ces résultats signifient que la formation de points quantiques à la surface de la couche d'InGaN dans le processus de refroidissement en deux étapes est corrélée à l'atome In, et ces points quantiques peuvent être l'un des états In qui se forme en raison de la réaction entre l'InGaN couche et gaz vecteur H2 en cours de deuxième refroidissement.
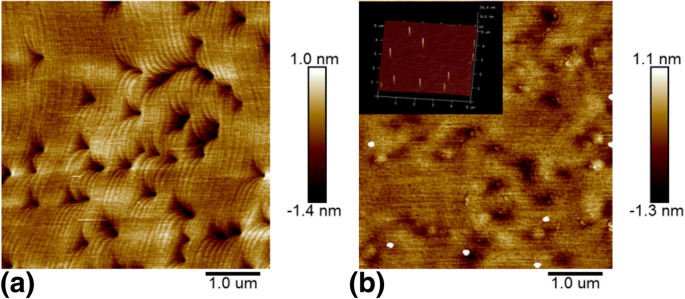
Topographie de surface AFM des échantillons avec refroidissement en deux étapes. un couche de GaN. b Couche InGaN avec contenu In 1%
Des études antérieures ont montré qu'il existe trois états différents des atomes d'In dans le processus de croissance de la couche d'InGaN [16, 17]. Le premier est les atomes d'In dans le réseau cristallin d'alliage InGaN, qui est la partie principale et le produit cible de la croissance de la couche d'InGaN ; le second est l'alliage InN qui apparaît toujours à la surface de la couche d'InGaN; et la troisième est la gouttelette In qui peut apparaître dans des conditions de croissance particulières. Différents états de l'atome In peuvent être distingués par les spectres XRD car ils ont des pics de diffraction différents dans le mode de balayage ω/2θ. Pour déterminer à quel état In ces points appartiennent, une mesure XRD a été prise pour les échantillons d'InGaN avec des processus de refroidissement en une ou deux étapes. La figure 4 montre les spectres XRD ω/2θ typiques pour les échantillons avec un refroidissement en deux étapes (ligne rouge) et un refroidissement en une étape (ligne bleue). Trois pics caractéristiques ont été trouvés pour les échantillons avec refroidissement en deux étapes alors qu'il n'y a que deux pics caractéristiques pour les échantillons avec refroidissement en une étape. Ainsi, le pic caractéristique supplémentaire pour les échantillons avec refroidissement en deux étapes peut représenter les points quantiques qui se forment à la surface. Les deux pics caractéristiques qui existent couramment dans ces échantillons sont situés aux alentours de 33,5° et 34,5°. Ils appartiennent respectivement aux cristaux InGaN et GaN. Alors que le pic caractéristique supplémentaire situé à 2θ = 32,8° a été vérifié comme provenant de la gouttelette In [16, 17]. Nous pouvons donc conclure que les points quantiques que nous avons observés sur la surface d'InGaN avec le processus de refroidissement en deux étapes sont la gouttelette d'In. Afin de confirmer cette conclusion, la mesure SEM a été prise sur les échantillons avec un processus de refroidissement en deux étapes, le résultat est montré sur la figure 5a, à partir de laquelle nous pouvons également trouver les points existent sur la surface. Pour identifier ces points, EDS a été prise au même endroit, la figure 5b–d montre la distribution des atomes de surface pour In, Ga et N, respectivement, d'où nous pouvons obtenir que les atomes de Ga et N sont uniformément distribués la surface, tandis que la concentration d'atomes d'In sur les points est beaucoup plus grande que celle qui l'entoure, ce qui signifie que ces points sont riches en In. Ainsi combiné avec l'analyse ci-dessus, nous pouvons conclure que le gaz vecteur H2 peut réagir avec la couche d'InGaN à basse température et former des gouttelettes d'In à la surface.
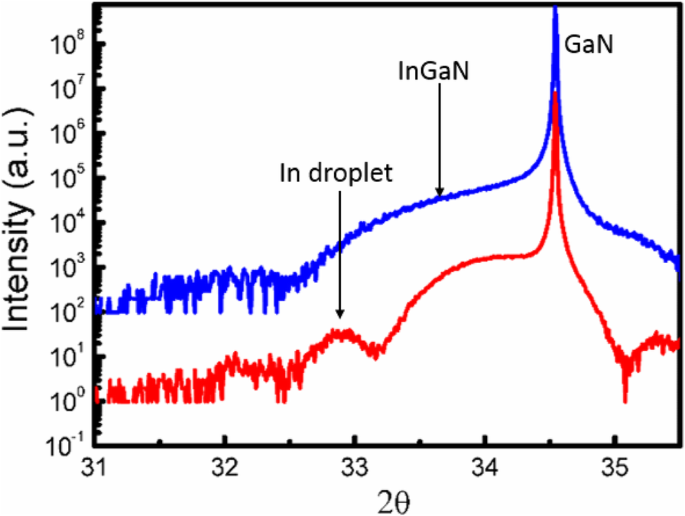
Les spectres XRD pour l'échantillon avec deux étapes de refroidissement (ligne rouge) et une étape de refroidissement (ligne bleue)
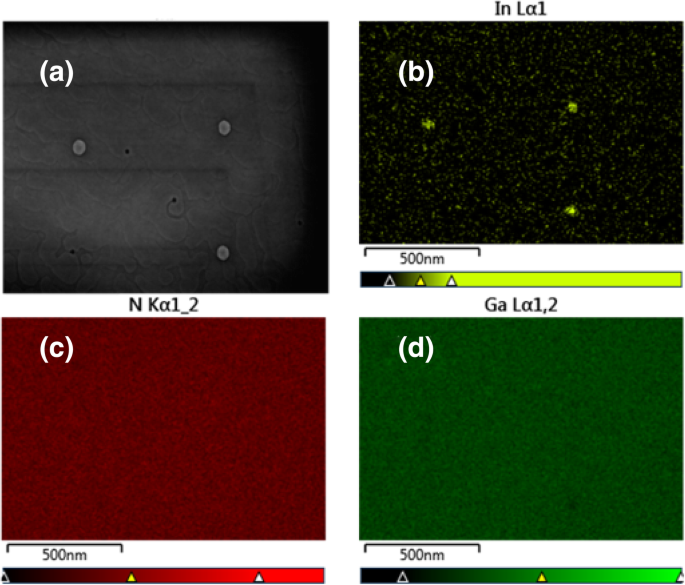
un La photographie de surface SEM pour l'échantillon avec un processus de refroidissement en deux étapes, b –d est le résultat de l'analyse des éléments EDS pour les atomes In, N et Ga, respectivement
Il a été rapporté qu'il y a souvent une couche riche en In formée à la surface de la couche épitaxiale en InGaN en raison de l'effet de traction de surface [10]. Dans notre expérience, les échantillons ont été directement refroidis à température ambiante après la croissance d'une seule couche d'InGaN, ce qui signifie que la couche de surface riche en In existe toujours à la surface lors du processus de refroidissement. Par conséquent, il existe deux possibilités d'origine de l'atome d'In pour les QD d'In que nous avons observés :la couche d'InGaN et la couche de surface riche en In, respectivement. Pour savoir quelle est l'origine de l'atome In des points quantiques In et comment la réaction se produit, d'autres expériences ont été menées. Il est connu qu'un processus de recuit peut effacer la couche riche en In [18]. Par conséquent, nous procédons à un recuit thermique pour les échantillons d'InGaN avant le processus de refroidissement en deux étapes. La durée du processus de recuit thermique est fixée à 60 s et la température est d'environ 800 °C, ce qui est 60° plus élevé que la température de croissance de la couche d'InGaN. La topographie AFM de l'échantillon d'InGaN avec un processus de recuit avant le processus de refroidissement en deux étapes est illustrée sur la figure 6, il n'y a évidemment pas de points quantiques sur la surface. Cependant, par rapport à la figure 2a, un grand changement de la topographie de la surface peut être trouvé, la surface devient plus rugueuse. L'absence de points quantiques In à la surface montre que la couche d'InGaN ne formerait pas de QD In avec H2 dans le deuxième processus de refroidissement, car le recuit thermique ne peut qu'effacer la couche riche en In. Ainsi, la formation de points quantiques d'In à la surface de la couche d'InGaN dans le processus de refroidissement en deux étapes est due à la réaction entre la couche de surface riche en In et le gaz porteur H2 dans la plage des basses températures.
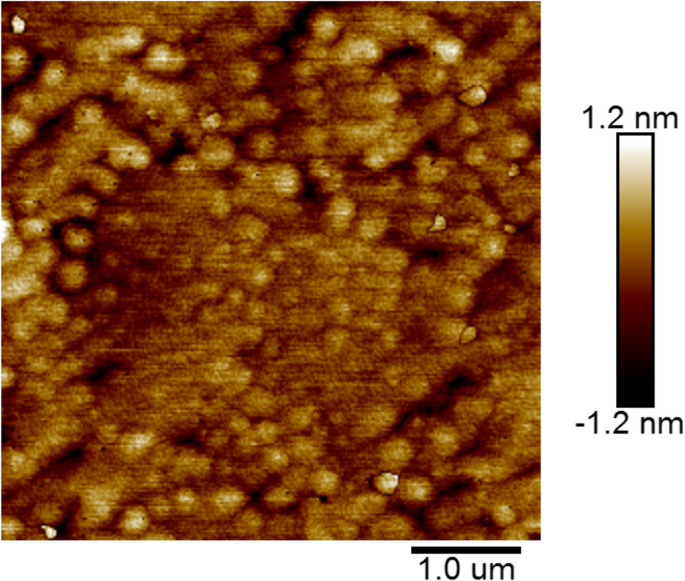
La topographie de surface AFM de la couche d'InGaN avec un recuit thermique avant le refroidissement en deux étapes.
L'effet corrosif de H2 sur la croissance de la couche d'InGaN a été largement rapporté. On sait que H2 peut empêcher les atomes d'In de s'incorporer dans le réseau [19, 20], et c'est la raison principale pour laquelle conventionnellement seulement N2 est utilisé comme gaz porteur dans la croissance MOCVD des couches d'InGaN. L'effet corrosif de H2 sur la couche d'InGaN peut être vu comme un processus inverse de la croissance de la couche d'InGaN, qui peut être exprimé par la réaction chimique suivante :
$$ {3\mathrm{H}}_2+2\mathrm{In}\mathrm{N}\to 2\mathrm{In}+{2\mathrm{NH}}_3 $$La formation de points quantiques In dans le processus de refroidissement en deux étapes peut être considérée comme une sorte d'effet corrosif, mais il existe quelques différences entre les températures élevées (pour faire croître InGaN avec H2 ) et à basse température (pour refroidir InGaN et former des In QD avec H2 ). À haute température, l'atome d'In formé par l'effet corrosif sur la surface a suffisamment d'énergie pour s'échapper à travers la couche limite de surface, diminuant ainsi l'efficacité d'incorporation de l'In. Cependant, à basse température (inférieure à 400 °C), nos résultats révèlent que H2 n'a qu'un effet corrosif sur la couche de surface fortement contenue en In car cette couche est plus instable que la couche d'InGaN. D'un autre côté, comme la température est inférieure à 400 °C, les atomes d'In se forment à la surface peuvent beaucoup moins s'échapper à travers la limite de la surface en temps opportun, ils migreront donc sur la surface de l'échantillon puis formeront des gouttes d'In sur la surface.
Dans notre étude, comme la formation de QD d'In est liée à la couche riche en In sur la surface d'InGaN, ils peuvent donc fournir directement des informations sur la couche de surface riche en In d'InGaN. Les échantillons de couche d'InGaN avec différentes teneurs en In et épaisseurs sont utilisés pour effectuer des expériences de traitement de refroidissement en deux étapes. La figure 7 montre la topographie de surface des couches d'InGaN avec différentes teneurs et épaisseurs en In. La teneur en In est de 7,65 %, 8,45 % et 9,6 %, respectivement, pour les échantillons A, B et C, et l'épaisseur de la couche d'InGaN pour ces trois échantillons est presque la même (environ 13,4 nm). À partir des morphologies de surface AFM des échantillons A, B et C, nous pouvons constater que la densité de In QD augmente avec la teneur en In dans la couche d'InGaN. Et la densité des QD est d'environ 2,4 × 10 7 cm −3 , 4,8 × 10 7 cm −3 , et 9,2 × 10 7 cm −3 respectivement pour les échantillons A, B et C, tandis que la taille des QD pour ces échantillons est presque la même. D'autre part, l'échantillon D a la même teneur en In que l'échantillon A (7,65 %), tandis que son épaisseur de couche est d'environ 41 µnm. Comparez la surface pour deux échantillons de A et D, il est clair que la densité des points quantiques In augmente lorsque l'épaisseur de la couche d'InGaN augmente. De notre analyse mentionnée ci-dessus, on apprend que la formation de ces points quantiques In est causée par la réaction de H2 avec la couche superficielle riche en in à basse température. Ainsi, la tendance changeante de la densité de In QDs peut refléter l'état de la couche superficielle riche en In, c'est-à-dire que les atomes instables In existant dans la couche superficielle riche en In, ils augmentent avec l'augmentation de la teneur en In et de l'épaisseur de l'InGaN couche. Ce résultat est cohérent avec les études théoriques précédentes qui ont montré que la teneur en In de la couche superficielle riche en In est liée à la teneur en In et à l'épaisseur des couches d'InGaN [21]. Cela prouve également que le mécanisme de formation des points quantiques d'In est bien lié à la surface de la couche riche en In.
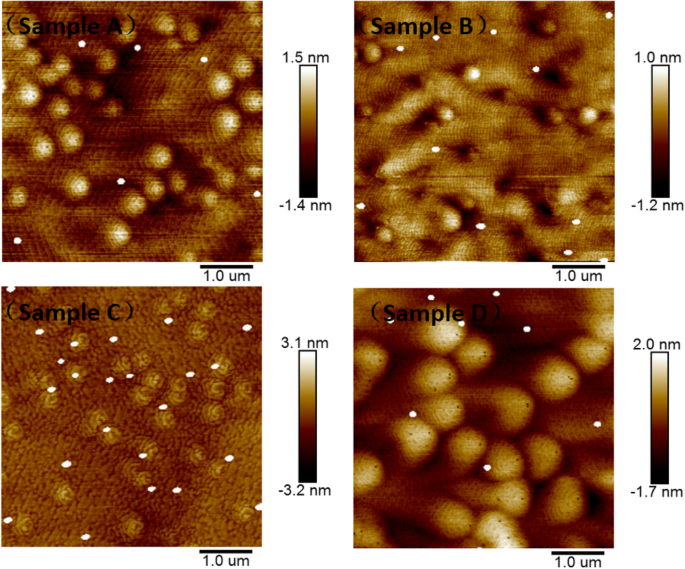
La topographie de surface AFM des couches d'InGaN a , b , c , et d avec un contenu et une épaisseur différents (voir texte)
Conclusion
Dans cet article, nous avons introduit une nouvelle méthode pour obtenir des QD d'In de taille uniforme à la surface d'une couche d'InGaN. Nous avons trouvé des In QD de taille uniforme à la surface d'une couche d'InGaN lors d'un processus de refroidissement en deux étapes. Grâce à une analyse détaillée, nous avons constaté que la formation de points quantiques d'In à la surface est due à la réaction entre la couche de surface riche en In et le gaz porteur H2 à basse température. Dans le même temps, nos expériences révèlent que H2 n'a un effet corrosif sur la couche superficielle riche en In que lorsque la température est inférieure à 400 °C, et ce processus corrosif formera des QD d'In sur la surface. D'autre part, comme la formation des QD d'In est étroitement liée à la couche riche en In à la surface, un tel processus peut nous fournir un moyen d'étudier directement la propriété de cette couche.
Méthode
L'objectif de cet article est d'introduire une nouvelle méthode pour obtenir des QD In de taille uniforme à la surface de la couche d'InGaN. Les échantillons utilisés dans cette étude ont été cultivés par un AIXTRON 6 × 2 dans un dépôt chimique métalorganique (MOCVD) de réacteur à pomme de douche à couplage étroit. La diffraction des rayons X à haute résolution (XRD), la microscopie à force atomique (AFM), le microscope électronique à balayage (MEB) et le spectromètre à dispersion d'énergie (EDS) sont utilisés pour caractériser les échantillons d'InGaN. Tous les participants à cette étude sont des scientifiques de l'Université de l'Académie chinoise des sciences de Chine.
Disponibilité des données et des matériaux
Les ensembles de données utilisés et/ou analysés au cours de la présente étude sont disponibles auprès de l'auteur correspondant sur demande raisonnable.
Abréviations
- AFM :
-
Microscopie à force atomique
- EDS :
-
Spectromètre à dispersion d'énergie
- GaN :
-
Nitrure de gallium
- Dans les QD :
-
Points quantiques d'indium
- InGaN :
-
Nitrure d'indium et de gallium
- InN :
-
Nitrure d'indium
- LD :
-
Diode laser
- LED :
-
Appareil électroluminescent
- MOCVD :
-
Dépôt chimique organométallique
- MQW :
-
Puits quantique multiple
- NH3 :
-
Ammoniac
- QD :
-
Points quantiques
- SEM :
-
Microscope électronique à balayage
- TMGa :
-
Triméthylgallium
- TMIn :
-
Triméthylindium
- XRD :
-
Diffraction des rayons X
Nanomatériaux
- N,N-diméthylformamide régulant la fluorescence des points quantiques MXene pour la détermination sensible de Fe3+
- La conception de la couche d'émission pour les multiplicateurs d'électrons
- Points quantiques de bismuth dans des puits quantiques recuits GaAsBi/AlAs
- Nanofils de silicium amorphe cultivés sur film d'oxyde de silicium par recuit
- Réglage des morphologies de surface et des propriétés des films de ZnO par la conception de la couche interfaciale
- Défauts à la surface du nanophosphore MgAl2O4 dopé Ti
- Contrôle de la croissance des nanofils de séléniure d'indium à haute uniformité (In2Se3) via le processus de recuit thermique rapide à basse température
- Fabrication et caractérisation de nano-clips de ZnO par le procédé à médiation par polyol
- Facteurs clés qui affectent les résultats du processus de meulage de surface



