Dépôt de couche atomique amélioré par plasma de films de cobalt utilisant le Co(EtCp)2 comme précurseur de métal
Résumé
Pour la technologie d'interconnexion Cu avancée, les films de Co ont été largement étudiés pour servir de revêtement et de remplacement de la couche d'ensemencement en raison d'une meilleure mouillabilité au Cu que au Ta. Dans cet article, les films de Co sont développés par dépôt de couche atomique assisté par plasma en utilisant Co(EtCp)2 comme précurseur, et les influences des paramètres de processus sur les caractéristiques des films de Co sont minutieusement étudiées. Les résultats indiquent que la fenêtre de processus est de 125 à 225 °C avec un taux de croissance de ~ 0,073 Å/cycle. C'est-à-dire que la connexion du groupe Et au ligand Cp peut permettre une croissance stable du film à 125 °C, tandis que la température correspondante doit être supérieure à 200 °C en termes de Co(Cp)2 et Co(MeCp)2 . Les films déposés contiennent des éléments N et O en plus des dominants Co et C. De plus, le prolongement du NH3 le temps d'impulsion améliore considérablement la conductivité du film de Co et une faible résistivité de 117 μΩ cm peut être obtenue avec un NH3 temps d'impulsion de 40 s. La rugosité quadratique moyenne montre une variation plus faible avec la température de dépôt et maintient une faible valeur d'environ 0,3 nm, indiquant un film de Co plat.
Contexte
Compte tenu du processus d'interconnexion Cu conventionnel dans les circuits intégrés ultra-larges à grande vitesse, une couche barrière telle que TaN est indispensable pour empêcher la diffusion des atomes de Cu dans les diélectriques intercouches environnants (ILD) [1]. Outre la couche barrière, une couche de revêtement comme le Ta est également nécessaire pour améliorer l'adhérence entre la couche barrière et Cu. De plus, il est difficile pour la raie Cu de se déposer sur la couche de revêtement par galvanoplastie directement en raison de la faible nucléation des atomes de Cu sur la surface de Ta. En conséquence, une couche d'ensemencement de Cu doit être appliquée sur la couche de revêtement avant la galvanoplastie de Cu. C'est-à-dire qu'un empilement de couche germe TaN/Ta/Cu doit être inséré entre l'ILD et la ligne Cu. De plus, cet empilement est enduit sur l'ILD sous forme de tranchées et de vias. Avec la réduction de la taille des fonctionnalités de l'appareil, le volume disponible pour la ligne d'interconnexion Cu diminue régulièrement. Afin d'obtenir une résistance d'interconnexion Cu inférieure, la couche barrière/revêtement sans pépins a été largement étudiée [2,3,4,5,6]. Par exemple, TaN fonctionne toujours comme couche barrière et Co remplace Ta comme couche de revêtement. En raison d'une meilleure mouillabilité du Co au Cu que du Ta, le Cu peut être plaqué directement sur la surface du Co. Traditionnellement, la couche barrière/revêtement est développée par un procédé de dépôt physique en phase vapeur. Cependant, le dépôt d'une couche barrière/revêtement de haute qualité est difficile car le PVD a un faible taux de couverture des étapes dans les tranchées et les vias à rapport d'aspect élevé. Au lieu de cela, des films ultrafins, continus et à bonne couverture par étapes peuvent être obtenus par la technique de dépôt de couche atomique (ALD) grâce à la propriété de croissance auto-limitante [7].
En termes de films ALD Co, un grand nombre de précurseurs de Co, en particulier ceux à base de ligand cyclopentadiényle (Cp), ont été largement étudiés, comme le bis-cyclopentadiényl cobalt (CoCp2 ) [8,9,10,11,12,13,14], bis(η-méthylcyclopentadiényl) cobalt [Co(MeCp)2 ] [15], et le cyclopentadiényl isopropyl acétamidinato cobalt [Co(CpAMD)] [16]. L'emploi de CoCp2 permet la croissance de films de Co avec une faible résistivité et une grande pureté ; cependant, la croissance stable du film est limitée aux températures au-delà de 250 °C. Avec l'ajout d'un groupe méthyle au ligand Cp, une croissance à plus basse température peut être obtenue à 200 °C, ce qui est attribué à la réactivité plus élevée de NH3 radical au ligand MeCp par rapport au ligand Cp. Sur la base de la croissance du film Co avec CoCp2 et Co(MeCp)2 en tant que précurseurs, la fenêtre de processus pourrait être déplacée vers des températures plus basses, c'est-à-dire < 200 °C si le groupe éthyle est connecté au ligand Cp.
Dans ce travail, des films minces de Co ont été cultivés par ALD amélioré par plasma (PE-ALD) en utilisant du bis(éthylcyclopentadiényl) cobalt [Co(EtCp)2 ] et NH3 plasma comme précurseurs. L'influence de différents paramètres de processus sur les caractéristiques des films de Co a été minutieusement étudiée. En conséquence, une fenêtre de processus de 125 à 225 °C a été atteinte avec succès. De plus, les films de Co présentent une résistivité plus faible (~ 130 μΩ cm).
Méthodes
Divers films minces de Co ont été développés par PE-ALD sur un SiO2 à 200 nm film, qui a été déposé sur des substrats de silicium de type p par oxydation thermique. Co(EtCp)2 a été utilisé comme précurseur de métal, qui a été stocké dans un conteneur à 70 °C et transféré dans la chambre de dépôt avec un N2 gaz vecteur. Le NH3 le plasma a été généré par un générateur de plasma à distance sous une puissance de 2800 W, agissant comme agent réducteur. Le débit de N2 a été maintenu à 50 sccm et la pression de travail était d'environ 1 000 Pa pendant la croissance du film. Pour étudier l'effet de la température de dépôt sur la croissance du film, la température du substrat a varié de 100 à 270 °C avec un pas de 25°C. De plus, pour optimiser les paramètres du procédé, les temps d'impulsion de Co(EtCp)2 et NH3 plasma ont également été modifiés, respectivement. De plus, afin d'étudier l'effet du post-recuit sur les performances des films de Co, les échantillons déposés à différentes températures ont été recuits dans le gaz de formation (N2 /4%-H2 ) à 400 °C pendant 30 min.
L'épaisseur et la densité du film ont été déduites par réflexion des rayons X, et la microstructure du film a été déterminée par diffraction des rayons X à incidence rasante (XRD) sur un diffractomètre (Bruker D8 Discover) avec Cu Kα radiation. La morphologie de surface du film a été observée au microscope à force atomique (AFM) (Bruker Icon) et au microscope électronique à balayage (MEB) (Zeiss SIGAMA HD). La composition élémentaire et les liaisons chimiques du film ont été analysées par spectroscopie photoélectronique à rayons X (XPS) (Kratos Axis Ultra DLD). La résistance de couche du film a été mesurée par une sonde à quatre points et la résistivité du film a été calculée en fonction de l'épaisseur du film et de la résistance de la couche.
Résultats et discussion
Optimisation des paramètres du processus ALD
La figure 1a montre le taux de croissance du film de Co en fonction de la température du substrat. On constate que le taux de croissance augmente lors de l'augmentation de la température du substrat à 125 °C, puis un taux de croissance relativement stable de 0,073 ± 0,02 Å/cycle est obtenu entre 125 et 225 °C. Cependant, lorsque la température du substrat atteint 250 °C ou plus, le taux de croissance augmente. Par conséquent, la plage de températures de 125 à 225 °C peut être considérée comme une fenêtre de processus appropriée. Par rapport à Co(Cp)2 et Co(MeCp)2 , l'ajout du groupe Et au ligand Cp permet à la fenêtre de processus de passer à une température de dépôt inférieure, indiquant une réactivité plus élevée des ligands EtCp avec NH3 plasma. Une telle croissance à basse température à 125 °C est bénéfique pour réduire le budget thermique. En ce qui concerne les températures de substrat inférieures à 125 °C, la croissance relativement plus lente du film doit être attribuée au manque d'énergie d'activation adéquate pour la réaction chimique [7]. Un taux de croissance aussi élevé à ≥ 250 °C est lié à la décomposition thermique du précurseur métallique [17]. Pour étudier l'influence de Co(EtCp)2 temps d'impulsion sur le taux de croissance du film déposé, le temps d'impulsion de Co(EtCp)2 augmente progressivement de 1 à 4 s avec un pas de 1 s tandis que les autres paramètres du processus sont fixes. Comme le montre la figure 1b, le taux de croissance augmente de ~ 0,06 à ~ 0,073 Å/cycle avec l'incrément de Co(EtCp)2 temps d'impulsion de 1 à 2 s, puis maintient une valeur relativement stable. Cela indique que l'adsorption de surface de Co(EtCp)2 atteint une saturation à un temps d'impulsion de 2 s. La figure 1b illustre également l'influence de NH3 -temps d'impulsion plasma sur le taux de croissance du film. Le taux de croissance augmente avec la prolongation de NH3 -temps d'impulsion du plasma ; cependant, lorsque le temps d'impulsion du plasma dépasse 20 s, le taux de croissance atteint une valeur de saturation de ~ 0,12 Å/cycle.

Dépendance du taux de croissance du film ALD sur a température du substrat, b Co(EtCp)2 , et NH3 temps d'impulsion
Caractérisation des Co-films déposés
La figure 2 montre les spectres XPS d'étude des films déposés à 175 °C. Les films déposés sont constitués d'éléments Co, N, O et C. Il convient de mentionner que pour éliminer complètement la contamination de surface, tous les échantillons ont été gravés in situ avec un bombardement d'ions Ar pendant 6 min avant la collecte des spectres XPS. Le tableau 1 répertorie les pourcentages élémentaires du film déposé à 175 °C avec le temps de gravure et les teneurs en C et O restent constantes après 6 min de gravure, indiquant une élimination complète de la contamination de surface. Le tableau 2 répertorie le rapport atomique élémentaire des films cultivés à 100 et 175 °C, respectivement, qui sont extraits des spectres XPS haute résolution. Lorsque la température du substrat augmente de 100 à 175 °C, la teneur relative en C diminue de 40 à 32 % et le pourcentage élémentaire de N augmente de 14 à 18 %. De plus, le pourcentage relatif de O montre une légère augmentation de 5 à 7%. Les teneurs plus élevées en C doivent être attribuées à l'élimination partielle des ligands EtCp [15, 16]. Comme il n'y a pas d'élément O dans les précurseurs, les atomes d'O dans les films déposés proviennent probablement de l'oxygène dans la chambre de réaction.
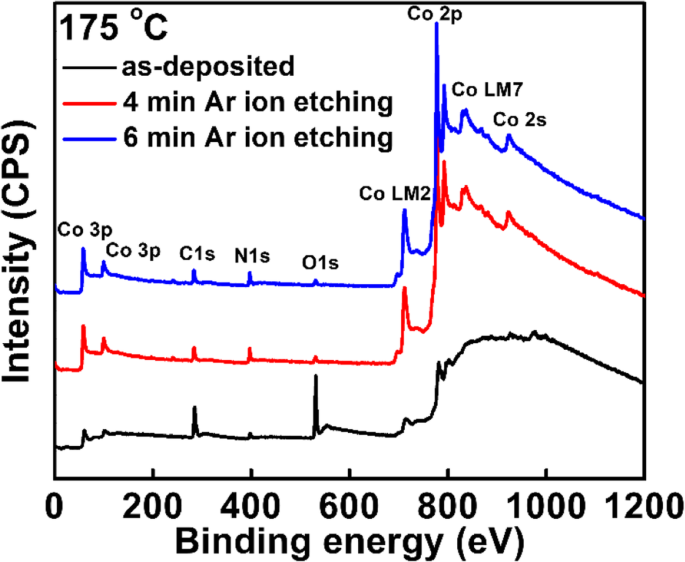
Les spectres d'étude des films de Co déposés à 100 °C avec des temps de gravure différents
La figure 3a montre les spectres C 1s haute résolution des films déposés à différentes températures. Le spectre C 1s peut être bien divisé en quatre composantes à 283,2, 284,7, 286,1 ± 0,1 eV et 288,9 eV, qui résultent de C-Co [12], CC [12, 18], CN [15, 19] et liaisons CO [12], respectivement. Lorsque la température augmente de 100 à 175 °C, la teneur relative en liaison C-C diminue de 61 à 56 %, tandis que celles de C-Co, C-N et C-O augmentent de 1 %, 2 % et 2 %, respectivement. Cela révèle que davantage de ligands EtCp ont été décomposés à une température plus élevée, conduisant ainsi à la réduction du pourcentage relatif de C dans le film. La figure 3b montre les spectres N 1s haute résolution des films déposés à différentes températures. Chaque spectre N 1s peut être bien séparé en deux composantes à l'aide de la fonction gaussienne-lorentzienne. Le pic situé à 397,8 eV doit être associé à la liaison N-Co [13], et les pics centrés à 399,2 eV doivent correspondre à la liaison N-C [20, 21]. Lorsque la température du substrat augmente de 100 à 175 °C, la teneur relative en N-Co diminue de 72 à 69 %. En effet, la désorption de l'azote du film est améliorée à une température plus élevée, ce qui entraîne la formation de moins de liaisons N-Co. La figure 3c montre le Co 2p3/2 haute résolution Spectres XPS des films de Co déposés à différentes températures. En ce qui concerne l'existence des liaisons C-Co et N-Co, comme le révèle la Fig. 3a, b, il est raisonnable que le Co 2p3/2 Le spectre peut être séparé en trois composantes, qui sont situées à 778, 778,9 et 780,86 ± 0,34 eV, respectivement. Le pic à la plus petite énergie de liaison doit être attribué à la liaison Co-Co [12, 22]. De plus, comme l'électronégativité de Pauling de C (2,55) est plus petite que celle de N (3,04), la densité de charge positive sur Co lié à N est plus grande que celle sur Co lié à C. Par conséquent, les pics à 778,9 et 780,86 ± 0,34 eV devrait provenir des liaisons Co-C et Co-N, respectivement. Lorsque la température de dépôt est augmentée de 100 à 175 °C, la teneur relative en liaison Co-N diminue de 48 à 32 %, ce qui est cohérent avec l'évolution de la liaison N-Co sur la figure 3b.

Haute résolution a Co 2p3/2 , b C 1s, et c N 1s spectres XPS des films déposés respectivement à 100 °C et 175 °C
Les propriétés cristallines des films de Co sont caractérisées par MET, comme le montre la figure 4. Les films de Co déposés à 100 et 250 °C, respectivement, sont tous deux cristallisés. La figure 5 montre les images AFM des films de Co cultivés à différentes températures. Lorsque la température de dépôt augmente de 100 à 250 °C, la rugosité moyenne quadratique (RMS) montre une variation plus petite et maintient une faible valeur d'environ 0,3 nm, indiquant un film de Co plat.
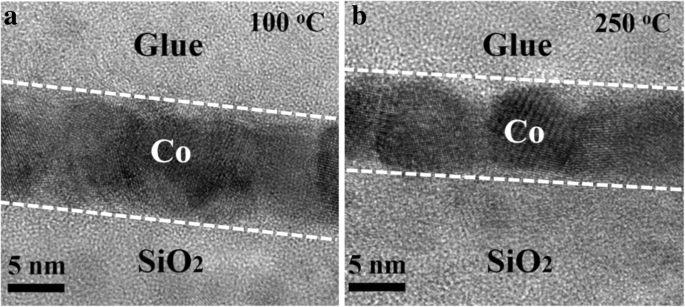
Les images MET transversales des films de Co (1200 cycles) déposés à a 100 °C et b 250 °C, respectivement
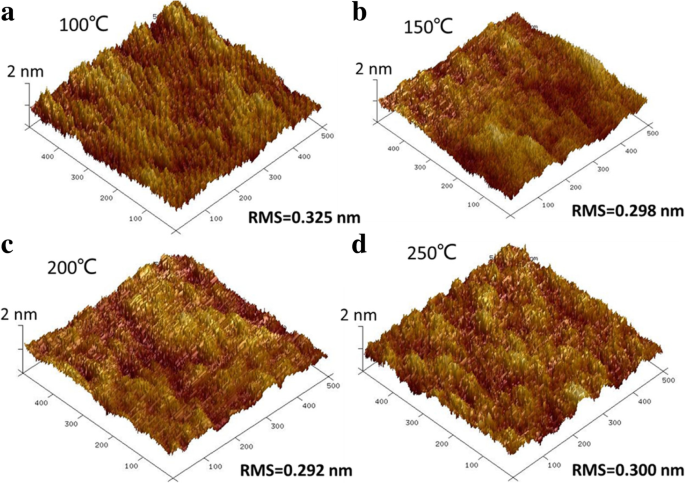
Images AFM des films de Co (1200 cycles) déposés avec Co(EtCp)2 temps d'impulsion de 2 s et NH3 temps d'impulsion plasma de 10 s à différentes températures :a 100 °C ; b 150 °C ; c 200 °C ; d 250 °C
La figure 6a, b montre la dépendance de la résistivité des films de Co sur la température du substrat et NH3 temps d'impulsion. La résistivité du film diminue remarquablement de 652 à 130 Ω cm, puis reste constante avec l'augmentation de la température de dépôt de 100 à 275 °C. Les résultats doivent être attribués à l'augmentation de la teneur relative en Co métallique dans le film. Comme le NH3 le temps d'impulsion augmente de 10 à 40 s, la résistivité des films de Co diminue de 158 à 117 μΩ cm (voir Fig. 6b). La figure 7 montre le Co 2p3/2 Spectres XPS des films de Co déposés avec différents NH3 temps plasma. Comme le NH3 le temps plasma est prolongé de 10 à 40 s, le pourcentage relatif des liaisons Co-Co augmente de 31 à 34 % et la teneur relative des liaisons Co-C diminue de 40 à 31 %. De plus, la teneur en carbone diminue de 22% à mesure que le NH3 le temps d'impulsion du plasma passe de 10 à 40 s. Cela indique l'élimination progressivement accrue des ligands EtCp, contribuant ainsi à la diminution de la résistivité du film de Co.

La résistivité du film de Co en fonction de la température de croissance (a ) et NH3 temps d'impulsion (b ), respectivement
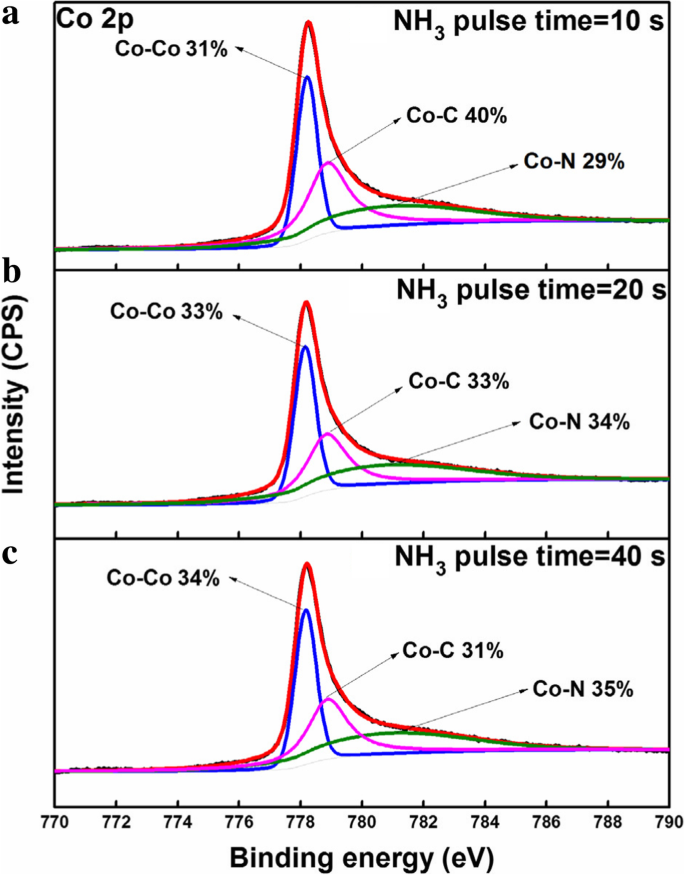
Les spectres XPS des films Co avec différents NH3 temps plasma :a 10 s ; b 20 s ; c 40 s
Le tableau 3 montre la comparaison des performances des films de Co cultivés par différents précurseurs. Par rapport au CoCp2 et Co(MeCp)2 , Co(EtCp)2 permet le dépôt de couches atomiques de films de Co à une température plus basse. De plus, en utilisant le précurseur métallique de Co(EtCp)2 conduit à un taux de croissance plus faible. Théoriquement, le procédé ALD est la croissance de monocouche par monocouche. En effet, l'effet d'encombrement stérique et l'adsorption en surface des précurseurs affectent tous deux la croissance du film. En termes d'effet d'encombrement stérique, cela signifie que les ligands des espèces précurseurs métalliques chimisorbées peuvent protéger une surface partielle et empêcher d'autres espèces précurseurs métalliques d'être complètement adsorbées sur la surface du substrat. Depuis Co(EtCp)2 a un ligand plus gros que le CoCp2 et Co(MeCp)2 , il est supposé qu'un effet d'encombrement stérique significatif se produira pendant le processus ALD. Cela peut conduire à la croissance d'une sous-monocouche, entraînant ainsi un taux de croissance plus faible. D'autre part, étant donné qu'une couche de revêtement de Co doit être déposée sur une couche barrière de TaN pour les futures applications pratiques, 1200 cycles de films de Co ont été développés sur le film ALD TaN à 125 °C. La figure 8 montre l'image MET en coupe transversale du film de Co déposé sur la surface de TaN. On observe que le film de Co est continu et uniforme, révélant un comportement de croissance supérieur. De plus, on constate que l'épaisseur (environ 10 nm) du film de Co déposé sur le film ALD TaN est similaire à celle développée sur le SiO2 surface.
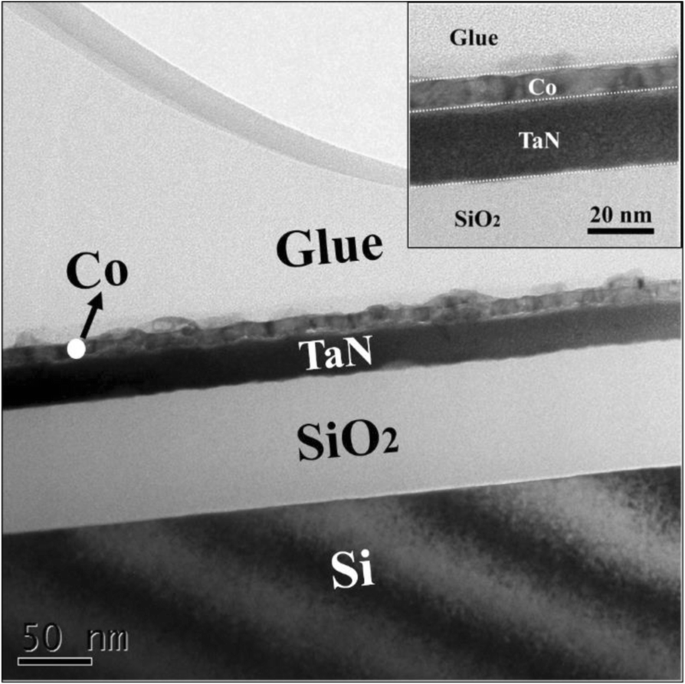
L'image MET en coupe transversale du film de Co (1200 cycles) déposé à 125 °C sur la surface ALD TaN et l'encart est une image agrandie
Conclusions
La croissance du film mince de Co est dévolue par PE-ALD en utilisant les précurseurs de Co(EtCp)2 , et l'influence des paramètres du procédé sur les caractéristiques des films de Co ont été étudiées. L'ajout du groupe Et au ligand Cp permet à la fenêtre de processus de passer à une température de dépôt inférieure de 125 °C. De plus, les films de Co sont composés d'éléments Co et C ainsi que de quelques éléments N et O. Avec l'augmentation de la température de dépôt, les ligands EtCp sont éliminés plus suffisamment et le pourcentage élémentaire relatif de C est diminué. En conséquence, la résistivité des films de Co déposés diminue de 652 à 130 μΩ cm et reste ensuite une valeur stable lorsque la température du substrat est augmentée de 100 à 275 °C. Pour la température de dépôt de 125 °C, la résistivité diminue progressivement avec l'allongement de NH3 le temps d'impulsion et une faible résistivité de 117 μΩ cm peuvent être obtenus lorsqu'un NH3 un temps d'impulsion de 40 s est utilisé. La rugosité quadratique moyenne montre une variation plus faible avec la température de dépôt et maintient une faible valeur d'environ 0,3 nm, indiquant un film de Co plat.
Abréviations
- AFM :
-
Microscopie à force atomique
- ALD :
-
Dépôt de couche atomique
- Co(CpAMD) :
-
Cyclopentadiényl isopropyl acétamidinato cobalt
- Co(EtCp)2 :
-
Bis(éthylcyclopentadiényl) cobalt
- Co(MeCp)2 :
-
Bis(η-méthylcyclopentadiényl) cobalt
- CoCp2 :
-
Bis-cyclopentadiényl cobalt
- Cp :
-
Cyclopentadiényle
- ILD :
-
Diélectrique intercalaire
- PE :
-
Plasma amélioré
- RMS :
-
Racine moyenne quadratique
- SEM :
-
Microscope électronique à balayage
- XPS :
-
Spectroscopie photoélectronique aux rayons X
- XRD :
-
Diffraction des rayons X
Nanomatériaux
- Technologies avancées de dépôt de couche atomique pour les micro-LED et les VCSEL
- Caractéristiques de commutation résistive bipolaire des dispositifs RRAM à structure tricouche HfO2/TiO2/HfO2 sur des substrats revêtus de Pt et de TiN fabriqués par dépôt de couche atomique
- Caractéristiques d'alignement interfacial, électrique et de bande des piles HfO2/Ge avec une couche intermédiaire de SiO2 formée in situ par dépôt de couche atomique amélioré par plasma
- Enquêtes sur la sorption d'ions de métaux lourds à l'aide de nanocomposites de biocharbon modifié par du fer
- Les nanofibres hiérarchiques antibactériennes en polyamide 6-ZnO fabriquées par dépôt de couche atomique et croissance hydrothermale
- Propriétés photocatalytiques des poudres de TiO2 revêtues de Co3O4 préparées par dépôt de couche atomique amélioré par plasma
- Dépôt en deux étapes de ZnO dopé Al sur p-GaN pour former des contacts ohmiques
- Mesurer l'épaisseur d'une couche à l'aide d'un microscope
- Avantages de l'utilisation d'alliages



