Enquête sur le ZrO2 imprimé par jet d'encre direct par rapport au revêtement par centrifugation pour le transistor à couche mince IGZO à pulvérisation cathodique
Résumé
Dans ce travail, un faible courant de fuite ZrO2 a été fabriqué pour un transistor à couche mince à pulvérisation cathodique d'oxyde de gallium et d'indium (IGZO) à l'aide de la technologie d'impression directe à jet d'encre. ZrO2 revêtu par rotation et imprimé directement par jet d'encre ont été préparés pour étudier le processus de formation du film et les performances électriques pour différents processus. Homogène ZrO2 films ont été observés à travers les images MET à haute résolution. La structure chimique du ZrO2 les films ont été étudiés par des mesures XPS. Le ZrO2 imprimé à jet d'encre couche sur IGZO a montré une performance supérieure sur la mobilité et le courant à l'état désactivé, mais un grand V ème changement sous stress de biais positif. En conséquence, le périphérique TFT basé sur le ZrO2 imprimé à jet d'encre présentait une mobilité de saturation de 12,4 cm 2 /Vs, un Ion /Ioff rapport de 10 6 , une tension d'activation de 0 V et un V de 1,4 V ème décalage après 1 h de souche PBS. Des films de densité plus élevée avec moins de lacunes d'oxygène étaient responsables d'un faible courant d'état d'arrêt pour le ZrO2 imprimé appareil. Le mécanisme des performances détériorées sur le test PBS peut être attribué à la région riche en In formée au niveau du canal arrière qui absorbe facilement H2 O et oxygène. Le H2 absorbé O et l'oxygène capturent les électrons sous contrainte de polarisation positive, servant d'accepteurs dans le dispositif TFT. Ce travail démontre le processus de formation de film de films d'oxyde imprimés par jet d'encre direct et revêtus par centrifugation et révèle le potentiel du diélectrique d'oxyde imprimé par jet d'encre direct dans un dispositif TFT à oxyde haute performance.
Contexte
Les diélectriques à oxyde métallique sont récemment apparus comme des alternatives prometteuses au SiO2 et SiNx dans les transistors à couche mince (TFT) en raison de leurs propriétés supérieures, notamment une capacité élevée, de faibles états de défaut et une large bande interdite qui conduit à une mobilité élevée et à un faible courant de coupure [1,2,3]. Pour ces raisons, les diélectriques d'oxyde fabriqués par procédé sous vide sont largement étudiés dans les écrans, les réseaux de capteurs et les circuits de commande [4]. Pendant ce temps, le processus de solution a également reçu une attention remarquable en raison de l'avantage du faible coût pour la fabrication à grande échelle, y compris le revêtement par centrifugation, l'impression à jet d'encre, le revêtement par pulvérisation et le revêtement par fente [5, 6]. Parmi celles-ci, l'impression à jet d'encre direct est la méthode la plus prometteuse qui permet de réaliser des films à motifs sans photolithographie. Cependant, les dispositifs TFT fabriqués par le procédé d'impression à jet d'encre présentent des performances électriques inférieures à celles traitées sous vide. Les films d'oxyde métallique à impression directe par jet d'encre sont confrontés à de sérieux problèmes :(1) l'étalement incontrôlable du précurseur d'oxyde sur le substrat en raison de la différence d'énergie de surface du fluide et du substrat et (2) la compatibilité des diélectriques d'oxyde imprimés avec le semi-conducteur [7 ].
Le processus de formation de film du film diélectrique traité en solution a une influence significative sur la propriété électrique. La méthode de revêtement par centrifugation en tant que technique établie est largement utilisée dans les TFT traités en solution. La densité de courant de fuite du diélectrique d'oxyde revêtu par centrifugation est généralement inférieure à 10 −6 A/cm 2 à 1 MV/cm, et le champ électrique de claquage est supérieur à 2 MV/cm. La mobilité de saturation du TFT basé sur un diélectrique d'oxyde revêtu est d'environ 10 cm 2 /Vs. Cependant, pour le diélectrique d'oxyde imprimé, la densité de courant de fuite est d'environ deux ordres de grandeur plus élevée que celle du film d'oxyde revêtu (>10 − 4 A/cm 2 à 1 MV/cm) et la mobilité de saturation est inférieure à 5 cm 2 /Vs. Peu de rapports ont comparé des films diélectriques imprimés à jet d'encre avec des films revêtus par centrifugation, en particulier sur le processus de formation du film. La densité, la rugosité de surface et l'homogénéité des films diélectriques sont les facteurs les plus importants liés aux performances électriques du TFT [8]. De plus, l'interface entre l'isolant de grille et le semi-conducteur joue également un rôle clé pour le processus de solution TFT [9]. Une étude approfondie sur les diélectriques d'oxyde imprimés par jet d'encre est d'une grande valeur pour mieux comprendre cette technique prometteuse.
Dans cet article, nous avons préparé du ZrO2 de haute qualité films avec un aspect de surface favorable et d'excellentes performances électriques par la méthode de revêtement et d'impression et a étudié l'effet électrique appliqué dans l'oxyde de zinc gallium-indium (IGZO) pulvérisé [10, 11]. Le processus de formation du film des méthodes de revêtement par centrifugation et d'impression directe est comparé. La méthode de revêtement par centrifugation est dominée par la force centrifuge conduisant à une distribution uniforme mais dispersive des molécules, tandis que le processus d'impression à jet d'encre dépend de la dynamique des fluides. Selon les tests XPS et IV, ZrO2 imprimé à jet d'encre film (doubles couches) avait moins de lacunes d'oxygène par rapport à celui revêtu par centrifugation. Augmentation des couches imprimées de ZrO2 les films peuvent remplir les trous et les vides créés par l'écoulement instable du précurseur se répandant sur le substrat, contribuant à moins de défauts et à une uniformité supérieure. le ZrO2 imprimé par jet d'encre direct le film pour IGZO pulvérisé a une densité de courant de fuite plus faible, une mobilité plus élevée, un rapport marche/arrêt plus important et un V plus grand ème décalage sous contrainte de polarisation positive que le ZrO2 spin-coated -TFT. La région riche en In formée au niveau du canal arrière du ZrO2 imprimé à jet d'encre Le TFT est responsable d'une plus mauvaise stabilité, car les molécules d'eau et l'oxygène de l'air peuvent facilement être absorbés sous une contrainte de polarisation positive, consommant des électrons de la couche IGZO. Il révèle que la technique d'impression directe à jet d'encre est capable de fabriquer un diélectrique d'oxyde haute densité, mais le défaut d'interface doit être bien contrôlé pour éviter l'instabilité électrique.
Méthodes
Matériaux
Le ZrO2 la solution a été synthétisée en dissolvant 0,6 M de ZrOCl2 ·8H2 O dans un mélange solvant de 10 ml de 2-méthoxyéthanol (2MOE) et d'éthylène glycol avec un rapport de 2:3 pour atteindre une certaine tension superficielle de précurseur. La solution a été agitée à 500 r/min à température ambiante pendant 2 h, suivi d'un vieillissement pendant au moins 1 jour. Pour le processus de traitement UV à l'ozone, une lampe UV de 100 W avec une longueur d'onde de 250 nm a été utilisée pour irradier le substrat d'oxyde d'indium et d'étain (ITO) nettoyé par de l'alcool isopropylique et de l'eau déminéralisée. Par la suite, ZrO2 les films ont été formés par revêtement par centrifugation ou par procédé d'impression directe à jet d'encre. Le processus de revêtement a été effectué à une vitesse de 5000 rpm pendant 45 s, tandis que l'espace de goutte et la température de la buse sont de 30 m et 30 °C pour le processus d'impression. ZrO2 les films ont été recuits à 350°C sous atmosphère atmosphérique pendant 1 h. L'IGZO de 10 nm d'épaisseur a ensuite été cultivé par une méthode de pulvérisation cathodique pulsée à courant continu avec une pression de 1 mTorr (oxygène:argon =5%) et modelé par un masque d'ombre. IGZO a été recuit à 300 °C pendant 1 h pour réduire le défaut du film. La largeur et la longueur du canal étaient de 550 μm et 450 μm ; ainsi, le rapport largeur/longueur était de 1,22. Enfin, des électrodes source/drain d'Al de 150 nm d'épaisseur ont été déposées par pulvérisation cathodique en courant continu à température ambiante.
Instruments
Des mesures de spectroscopie photoélectronique à rayons X (XPS) ont été effectuées pour étudier la structure chimique dans les semi-conducteurs à oxyde réalisée par ESCALAB250Xi (Thermo-Fisher Scientific, Waltham, MA, USA) à une pression de base de 7,5 × 10 −5 mTorr. Les images de microscopie électronique à transmission en coupe (MET) ont été mesurées par JEM-2100F (JEOL, Akishima, Tokyo, Japon) et les résultats du balayage cartographique du système différentiel électronique (EDS) ont été analysés par Bruker (Adlershof, Berlin, Allemagne) pour étudier la distribution des éléments. Dans l'obscurité et dans l'air à température ambiante, les courbes capacité-tension ont été mesurées par un appareil de mesure LCR de précision Agilent 4284A (HP, États-Unis). Pour mesurer les caractéristiques de transfert du TFT IGZO et les courbes de densité de courant de fuite, nous avons utilisé l'analyseur de paramètres à semi-conducteur de précision Agilent 4156C. Les caractéristiques de transfert ont été mesurées par une tension de grille allant de − 5 à 5 V avec une tension de drain de 5 V. Nous avons calculé la mobilité de l'effet de champ en utilisant la courbe de transfert mesurée et l'équation suivante :
$$ {I}_{\mathrm{DS}}=\frac{W\mu {C}_{\mathrm{i}}}{2L}{\left({V}_{\mathrm{GS}} -{V}_{\mathrm{th}}\right)}^2 $$ (1)où jeDS , Ci , μ, W, L, VGS , et Vème sont respectivement le courant de drain, la capacité du diélectrique de grille par unité de surface, la mobilité de saturation, la largeur de canal, la longueur de canal, la tension de grille et la tension de seuil. La constante diélectrique est calculée par l'équation comme suit :
$$ {\varepsilon}_{\mathrm{r}}=\frac{C\cdotp d}{\varepsilon_0\cdotp S} $$ (2)où ε r , C , d , ε 0 , et S sont la constante diélectrique relative, la capacité du diélectrique de grille, l'épaisseur du diélectrique de grille, la constante diélectrique du vide et la surface de l'électrode, respectivement.
Résultat et discussion
Le processus de formation de film de la méthode d'impression à jet d'encre direct par rapport à la méthode de revêtement par centrifugation est proposé sur la figure 1. Au cours du processus de revêtement par centrifugation, les gouttelettes sont forcées de se répandre uniformément sur l'ensemble du substrat par la force centrifuge [12]. En conséquence, après le processus de recuit ZrO2 les molécules sont bien réparties sur le substrat. Pendant ce temps, la majorité des ZrO2 des molécules sont projetées pendant le processus de revêtement, des lacunes se produisent à l'intérieur du film. La densité des films fabriqués par le procédé de revêtement par centrifugation n'est pas pertinente pour les paramètres de revêtement pour certains précurseurs [13]. Pour le processus d'impression à jet d'encre, l'imprimante se déplace dans une direction particulière pour laisser des gouttelettes sur le substrat. Les gouttelettes fusionnent à l'équilibre du processus d'étalement et de rétrécissement qui est influencé par la gravité, la tension superficielle et la viscoélasticité du précurseur. Le processus de formation de film de l'impression à jet d'encre peut être bien contrôlé en optimisant les paramètres de traitement de l'espace des gouttelettes, de la vitesse du jet, de la composition de l'encre et de la température du substrat [14]. Le facteur le plus important est l'espace de chute défini par l'imprimante et le processus de post-traitement du substrat. Fichier supplémentaire 1 :la figure S1 montre des images de l'angle de contact du précurseur d'impression sur un substrat d'ITO avec différentes périodes de traitement UV et le microscope polarisant de ZrO2 recuit cinéma. ZrO2 Le film imprimé sur un substrat ITO avec une irradiation à l'ozone de 40 s possède la meilleure morphologie. De plus, la méthode d'impression multicouche est efficace pour réduire les trous dans le film en comblant les lacunes avec des gouttelettes supplémentaires directement imprimées sur le dessus de la première couche, conduisant à un film plus homogène avec une densité plus élevée et moins de défauts [15]. L'épaisseur des films imprimés à 1 couche et à 2 couches est respectivement de 45 nm et 60 nm (Fichier supplémentaire 1 :Figure S2). L'épaisseur du film n'est pas proportionnelle aux couches imprimées, ce qui explique que la méthode d'impression multiple n'est pas seulement un processus d'accumulation d'épaisseur [16]. En général, la qualité du ZrO2 à impression directe les films peuvent être bien contrôlés par les paramètres de traitement. Dans notre expérience, nous préparons du ZrO2 couché par centrifugation (SC), imprimé à jet d'encre direct 1 couche (DP1) et 2 couches (DP2) films et dispositifs IGZO-TFT basés sur ces films pour étudier la différence de morphologie de film et de propriété électrique à partir de différents processus de formation de film.
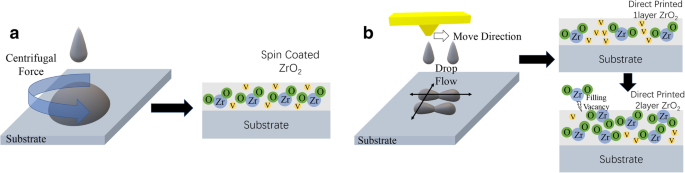
Processus de formation du film de a revêtement par centrifugation et b méthode d'impression directe à jet d'encre
La figure 2a–c montre le spectre O1s de ZrO2 film préparé par différentes méthodes. Nous avons ajusté le pic d'oxygène 1s à une superposition de trois composants de pic. Les pics centrés à 529,8 ± 0,2 eV, 531,7 ± 0,2 eV et 532,1 ± 0,1 eV peuvent être attribués à des espèces de liaison métal-oxygène (V M-O ), les lacunes en oxygène (V O ), et les espèces faiblement liées (V M-OU ), respectivement [17, 18]. Le V M-O espèces du DP2-ZrO2 le film est de 81,57 %, ce qui est beaucoup plus élevé que le SC-ZrO2 et DP1-ZrO2 . Le V O l'espèce est également la plus faible pour DP2-ZrO2 film. Ceci est cohérent avec les idées mentionnées ci-dessus :(1) le processus d'impression à jet d'encre direct peut obtenir du ZrO2 film avec une densité plus élevée et moins de lacunes d'oxygène, et (2) un processus d'impression répété peut combler les trous et les pièges et réduire les lacunes à l'intérieur du film. La mesure AFM a été réalisée pour étudier la morphologie de surface du ZrO2 imprimé film par rapport à celui du ZrO2 spin-coated illustré dans le fichier supplémentaire 1 :Figure S3. ZrO2 revêtu par centrifugation présente la surface la plus lisse avec une rugosité de surface de 0,29 nm et une impression directe à 1 et 2 couches de ZrO2 les films sont respectivement de 1,05 nm et 0,67 nm. ZrO2 à impression directe le film possède une surface plus rugueuse en raison du flux incontrôlable de fluide pendant le processus de formation du film [19]. La diminution remarquable de la rugosité de surface résultant de l'impression d'une couche supplémentaire pour le ZrO2 à impression directe Le film peut être attribué au fluide imprimé sur le substrat, ce dernier remplissant les trous de la couche initiale pour développer un film plus homogène. Les résultats XPS et AFM montrent que la méthode d'impression à jet d'encre a le potentiel de produire des films diélectriques de meilleure qualité et à moindre défaut par rapport à la méthode de revêtement par centrifugation, ainsi qu'une rugosité de surface approximative qui convient à la fabrication de TFT.

Spectre O1s de a CS, b Couche DP1 et c Couche DP2 ZrO2 film
Des mesures de capacité-tension et de courant-tension ont été effectuées pour étudier les propriétés électriques du SC-ZrO2 et DP-ZrO2 film à l'aide d'un Al/ZrO2 /Condensateur ITO (métal-isolant-métal) fabriqué sur substrat de verre. Nous éliminons l'influence apportée par l'épaisseur du film car ils ont une épaisseur approximative (respectivement 60 nm, 45 nm et 60 nm). Comme le montre la figure 3, DP1-ZrO2 le film ne présente pratiquement aucune propriété isolante, causée par un grand nombre de lacunes dans le film qui servent de passage pour le courant de fuite. DP2-ZrO2 le film présente la meilleure propriété isolante, en accord avec le résultat du spectre O 1s mentionné ci-dessus. En conséquence, la densité de courant de fuite de DP2-ZrO2 le film est 2,4 × 10 −5 A/cm 2 à 1 MV/cm et la tension de claquage est supérieure à 2,5 MV/cm. Dans notre expérience, plus de couches imprimées sont similaires sur la rugosité de surface et montrent peu d'amélioration de la densité de courant de fuite par rapport au ZrO2 imprimé à 2 couches. film. Au contraire, l'impression d'un trop grand nombre de couches peut facilement pousser la triple ligne (ligne de phase différente :gaz, liquide, solide) vers l'extérieur, induisant la distribution non uniforme de l'encre précurseur. La figure 4 montre la courbe capacité-tension du ZrO2 revêtu par centrifugation et imprimé directement cinéma. La constante diélectrique relative pour ces trois échantillons est calculée à 19,2, 20,1 et 18,8, ce qui est proche de la valeur de référence (18). Pour ZrO2 à la fois couché par rotation et imprimé à jet d'encre films, la densité de capacité augmente avec l'hystérésis de tension est observée dans les trois échantillons, et elle est la plus petite dans SC-ZrO2 échantillon et le plus grand dans DP1-ZrO2 film. L'hystérésis est liée à l'uniformité et à l'état défectueux du film diélectrique. Il confirme que l'homogénéité du revêtement ZrO2 le film est le meilleur et plusieurs couches peuvent améliorer l'uniformité des films d'impression directe à jet d'encre [20, 21].
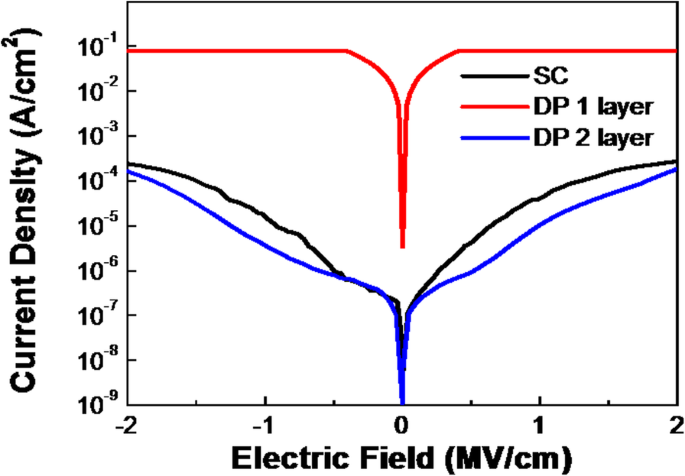
Densité de courant de fuite des couches SC, DP1 et DP2 ZrO2 film
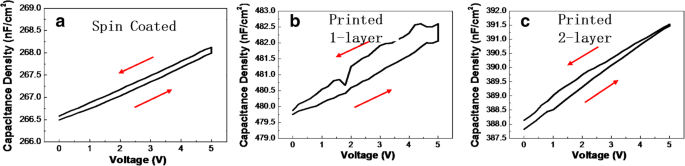
Densité de capacité de a CS, b Couche DP1 et (c ) DP2-couche ZrO2 film
Pour approfondir l'étude de l'effet de ZrO2 couche fabriquée de différentes manières sur les performances TFT et la stabilité de la polarisation de la grille, les résultats de la contrainte de polarisation de grille négative (NBS) et de la contrainte de polarisation de grille positive (PBS) de l'IGZO-TFT avec les deux SC-ZrO2 et DP2-ZrO2 sont présentées dans la Fig. 5. Les courbes caractéristiques de transfert sous NBS et PBS ont été mesurées en appliquant un biais positif (+ 5 V) ou négatif (− 5 V) pendant 1 h. Le DP2-ZrO2 IGZO TFT montre de meilleures performances à l'état statique avec une mobilité de saturation (μ samedi ) de 12,5 cm 2 /V·s, Je sur /Je désactivé radio de 10 6 , et V ème de 0 V. Le SC-ZrO2 IGZO TFT présente une mobilité approximative mais inférieure de 10,2 cm 2 /V·s, pire I sur /Je désactivé radio de 2 × 10 5 , et un courant à l'état bloqué plus élevé (I désactivé ), principalement en raison d'une augmentation des fuites de canaux par une plus grande quantité de lacunes d'oxygène (V O ) dans le film diélectrique. Le V ème décalage de IGZO TFT avec les deux SC-ZrO2 et DP2-ZrO2 sous les mesures NBS est négligeable. Le V négatif ème Le déplacement des TFT d'oxyde sous NBS est généralement causé par le piégeage des trous ou l'injection de charges puisque les lacunes d'oxygène ionisé peuvent migrer vers l'interface semi-conducteur/isolant sous le champ de polarisation de grille négative. Les résultats NBS indiquent que soit SC-ZrO2 ou DP2-ZrO2 le film a un contact favorable avec IGZO [22, 23]. Cependant, contrairement à SC-ZrO2 IGZO TFT qui présente un V ème décalage de 0,4 V après application du PBS pendant 1 h, le DP2-ZrO2 IGZO TFT montre une grave dégénérescence des performances et un grand V ème décalage de 1,2 µV sous test PBS. Les résultats de ZrO2 -Les TFT IGZO sous test PBS sont résumés dans le tableau 1. Étant donné que le V ème Le déplacement des TFT d'oxyde sous test PBS est généralement causé par la diffusion de molécules d'eau ou d'oxygène absorbées, nous pouvons supposer que le canal arrière de DP2-ZrO2 IGZO TFT est plus sensible à l'environnement atmosphérique selon le test PBS [24, 25].
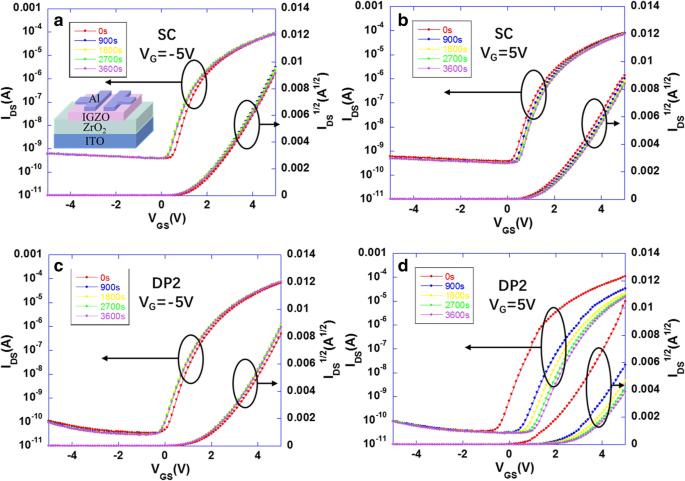
un NBS et b Résultats PBS de SC-ZrO2 IGZO TFT. c NBS et d Résultats PBS de DP2-ZrO2 IGZO TFT
Pour étudier la dégénérescence et Vth décalage sous test PBS pour ZrO2 -IGZO TFT, les images de microscopie électronique à transmission (MET) en coupe transversale et le balayage linéaire EDS ont été mesurés pour analyser la distribution des éléments. À partir des images MET en coupe illustrées à la Fig. 6a et b , une structure de l'Al/IGZO/ZrO2 étudiée dans cet article a été présentée. À partir des images TEM haute résolution de la région du canal pour les deux SC-ZrO2 IGZO TFT et DP2-ZrO2 IGZO TFT, une couche d'IGZO de près de 8 nm d'épaisseur peut évidemment être observée, ce qui peut être prouvé par la distribution de l'élément In (Ga, Zn) dans les résultats de balayage de ligne EDS. Pendant ce temps, pour les deux SC-ZrO2 IGZO TFT et DP2-ZrO2 IGZO TFT, le ZrO2 couche présente une structure amorphe qui est bénéfique pour une faible densité de courant de fuite. Il est évident qu'à partir du résultat du balayage linéaire, l'élément Al se diffuse dans la couche IGZO, ce qui peut être causé par un impact pendant le processus de pulvérisation d'Al. De plus, le rapport de l'élément Zr et O est d'environ 1:2, ce qui démontre que le ZrO2 pur a été formé après le processus de recuit. Une distribution uniforme des éléments In, Ga, Zn et Zr est également obtenue dans la couche IGZO pour SC-ZrO2 IGZO TFT, indiquant une structure homogène de ZrO2 et le film IGZO a été établi pendant la pulvérisation cathodique et le processus de post-recuit [19]. Mais pour DP2-ZrO2 IGZO TFT, In, Ga, Zn, O et Zr sont en distribution irrégulière. À partir de la figure 6 (b), nous pouvons voir que l'élément Zr et l'élément O sont concentrés à l'interface de la couche diélectrique et active. Et cela a totalement coïncidé avec l'analyse du processus de formation de film de la méthode d'impression multicouche. Lors du processus d'impression multiple, le précurseur imprimé en dernier sur le substrat remplit en partie les lacunes, et la majorité des gouttelettes s'accumulent au sommet [26]. De plus, la ségrégation des éléments In et Zn au niveau du canal arrière de la couche IGZO est observée dans la couche IGZO de ZrO2 imprimé -TFT. Étant donné que la proportion de l'élément Zn est minimale dans notre expérience, les performances électriques de l'IGZO TFT sont déterminées par l'élément In et Ga. La formation d'une région riche en In à l'interface Al/IGZO peut être conclue comme suit :lors du processus de recuit de la couche IGZO qui vise à éliminer l'état de défaut de l'IGZO, il y a eu une redistribution de chaque élément. Les atomes O ont été "retirés" des éléments In et Zn car ils ont une énergie de dissociation de la liaison oxygène inférieure à celle de l'élément Zr, les éloignant de l'interface diélectrique/semi-conducteur. La substance élémentaire des éléments In et Zn étant instable, ils se sont recombinés avec l'oxygène absorbé au niveau du canal arrière, ce qui peut être prouvé par le balayage EDS [27,28,29]. La région riche en In avec des molécules d'eau absorbées et de l'oxygène est la raison d'un grand V ème décalage sous test PBS.
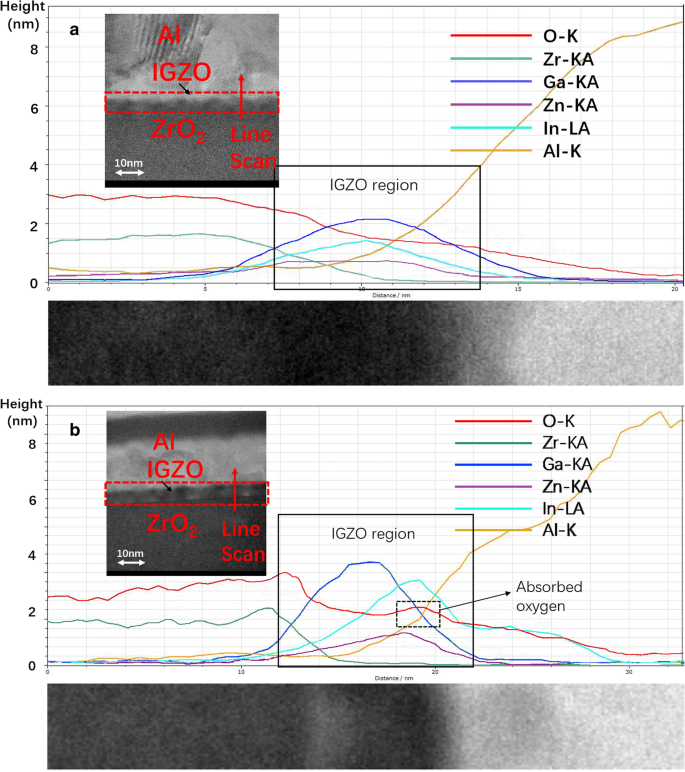
un Image TEM et balayage en ligne EDS du SC-ZrO2 IGZO TFT. b Image TEM et balayage en ligne EDS de DP2-ZrO2 IGZO TFT
Afin de décrire conceptuellement le mécanisme de la performance dégénérée et V ème décalage sous contrainte de polarisation positive pour IGZO TFT, diagrammes de bandes schématiques de TFT pour ZrO2 spin-coated et ZrO2 imprimé à jet d'encre sont illustrés à la Fig. 7. DP2-ZrO2 TFT peut accumuler plus de porteuses que SC-ZrO2 TFT à l'état statique en raison d'une meilleure propriété isolante, mais sous contrainte de polarisation positive, la plupart des porteurs sont épuisés par des molécules de type accepteur comme l'eau et l'oxygène dans l'atmosphère. En général, l'hydrogène, l'oxygène et H2 Les molécules d'O s'intégreront dans le film mince IGZO en raison de la diffusion dans le canal arrière. Ensuite, l'hydrogène réagira avec l'oxygène et générera des liaisons oxygène-hydroxyde et consommera des électrons, ce qui entraînera une dégradation des performances sous une contrainte de polarisation positive. Pendant ce temps, l'O2 adsorbé et H2 Les molécules O agissent comme un piège de type accepteur qui peut capturer les électrons de la bande de conduction, conduisant au V positif ème décalage après PBS [30]. Les performances dégénérées et V ème décalage sont instables et il peut récupérer après des heures sous une atmosphère ambiante. En raison des différentes énergies de dissociation des liaisons oxygène du Zr-Oxide (756 kJ/mol), du Ga-Oxide (364 kJ/mol), du In-Oxide (336 kJ/mol) et du Zn-Oxide (240 kJ/mol) [31 ], les atomes O sont plus susceptibles de se combiner avec l'élément Zr en raison des grandes énergies de dissociation des liaisons oxygène. Les éléments In et Zn repoussés de ZrO2 L'interface /IGZO avec le canal arrière absorbe l'oxygène dans l'environnement. Pour IGZO TFT utilisant le ZrO2 imprimé à jet d'encre direct comme isolant de grille, de grandes quantités d'hydrogène, d'oxygène et de H2 Les molécules O « consomment » les électrons lors de l'application d'une contrainte de polarisation positive, entraînant une dégénérescence des performances du dispositif. Les procédés comprenant l'introduction d'une couche de passivation dans la partie supérieure de l'électrode de source/drain pour la structure de grille inférieure, utilisant la structure de grille supérieure, et l'introduction d'une couche de modification d'interface entre la couche diélectrique et la couche semi-conductrice sont des moyens efficaces d'améliorer le PBS pour un dispositif TFT traité en solution, ce qui est intéressant et sera réalisé dans nos recherches futures.

Diagrammes de bandes SC-ZrO2 TFT et DP2-ZrO2 TFT sous stress de biais positif
Conclusion
En conclusion, nous avons fabriqué un ZrO2 imprimé à jet d'encre direct de haute qualité Isolateur de grille utilisant une méthode d'impression multicouche sans technologie de motif supplémentaire, qui convient au processus de fabrication d'impression de grande taille. Le processus de formation du film démontre que ZrO2 le film fabriqué par un procédé d'impression à jet d'encre direct obtient une structure plus dense par rapport au procédé de revêtement par centrifugation, mais l'homogénéité est pire en raison du flux de fluide incontrôlable de l'encre précurseur. Les résultats XPS indiquent un ZrO2 imprimé à 2 couches le film possède le pourcentage le plus élevé d'espèces M-O-M (V M-O ) et les plus faibles lacunes en oxygène (V O ), se traduisant par une faible densité de courant de fuite. Courbe capacité-tension de DP2-ZrO2 le film montre une légère hystérésis, qui est similaire avec SC-ZrO2 . En conséquence, DP2-ZrO2 le film présente une densité de courant de fuite relativement faible de 2,4 × 10 −5 A/cm 2 à 1 MV/cm et une tension de claquage supérieure à 2 MV/cm; Appareil TFT basé sur DP2-ZrO2 présentait une mobilité de saturation de 12,4 cm 2 /Vs, un I sur /Je désactivé rapport de 10 6 , une tension d'activation de 0 V et un V de 1,2 V ème décalage après 1 h de test PBS. La ségrégation de l'élément In au niveau du canal arrière de la couche IGZO observée dans l'image TEM et le balayage EDS peut être responsable d'un Vth plus grand décalage pendant le test PBS en raison de l'O2 adsorbé et H2 Molécules O qui agissent comme un piège de type accepteur pouvant capturer les électrons de la bande de conduction. Cet article présente les avantages de la technologie d'impression à jet d'encre direct et étudie la propriété diélectrique de l'isolant d'oxyde traité en solution utilisé dans le dispositif TFT d'oxyde. Il démontre que DP2-ZrO2 a une structure plus dense avec moins de lacunes d'oxygène, mais une faible stabilité sous PBS causée par la diffusion des éléments. Il est prometteur pour la technologie d'impression à jet d'encre directe à appliquer dans la production de masse en raison de son faible coût et de ses hautes performances après avoir amélioré sa stabilité.
Abréviations
- 2MOE :
-
Méthoxyéthanol (solvant)
- AFM :
-
Microscope à force atomique
- Al :
-
Aluminium
- DP1/2 :
-
1/2 couche en impression directe
- EDS :
-
Système différentiel électronique
- H2 O :
-
Molécule d'eau
- IGZO :
-
Oxyde d'indium gallium zinc (oxyde semi-conducteur)
- ITO :
-
Oxyde d'indium-étain (électrode)
- O 1s :
-
Oxyde 1s orbitale atomique
- O2 :
-
Molécule d'oxygène
- PBS/NBS :
-
Contrainte de biais positive/négative (mode test)
- SC :
-
Revêtement par rotation
- SiNx :
-
Nitrure de silicium (diélectrique)
- SiO2 :
-
Dioxyde de silicium (diélectrique)
- TEM :
-
Microscope électronique à transmission
- TFT :
-
Transistor à couche mince
- UV :
-
Ultraviolet
- V M-O :
-
Pourcentage de liaison métal-oxyde
- V M-OU :
-
Pourcentage de liaison métal-organique
- V O :
-
Pourcentage de caution de vacance d'oxyde
- V ème :
-
Tension de seuil
- XPS :
-
Spectroscopie photoélectronique aux rayons X
- ZrO2 :
-
Zircone (oxyde diélectrique)
- ZrOCl2 ·8H2 O :
-
Oxychlorure de zirconium octahydraté (matériau)
Nanomatériaux
- PROCESSUS DE PRODUCTION DE FILM D'EMBALLAGE PLASTIQUE POUR DIFFÉRENTS TYPES DE MATÉRIAUX
- Ingénierie des procédés de revêtement par immersion et optimisation des performances pour les appareils électrochromes à trois états
- Réalisation d'une couverture complète d'un film pérovskite stable par un processus anti-solvant modifié
- Nanofils de silicium amorphe cultivés sur film d'oxyde de silicium par recuit
- Croissance directe de structures de ZnO ressemblant à des plumes par une technique de solution facile pour une application de détection photo
- Nanopétales d'oxyde de nickel mésoporeux (NiO) pour la détection ultrasensible du glucose
- Dépôt en couche atomique de nano-films d'oxyde d'indium pour transistors à couche mince
- Préparation et caractéristiques thermoélectriques du thermocouple à couche mince ITO/PtRh:PtRh
- Film de capteur pour l'aérospatiale



