Évolution structurelle de l'interface HfO2/Si dépendante de la température et son mécanisme
Résumé
Dans ce travail, l'oxyde d'hafnium (HfO2 ) des couches minces sont déposées sur des substrats de Si de type p par dépôt de couche atomique plasma à distance sur Si de type p à 250°C, suivi d'un recuit thermique rapide sous azote. Effet de la température de post-recuit sur la cristallisation de HfO2 films et HfO2 Les interfaces /Si sont étudiées. La cristallisation du HfO2 films et HfO2 L'interface /Si est étudiée par microscopie électronique à transmission à émission de champ, spectroscopie photoélectronique aux rayons X, diffraction des rayons X et microscopie à force atomique. Les résultats expérimentaux montrent que lors du recuit, l'oxygène diffuse à partir de HfO2 à l'interface Si. Pour une température de recuit inférieure à 400 °C, le HfO2 le film et la couche interfaciale sont amorphes, et cette dernière est constituée de HfO2 et dioxyde de silicium (SiO2 ). A une température de recuit de 450-550°C, le HfO2 le film devient polycristallin polyphasé, et un SiO2 cristallin se trouve à l'interface. Enfin, à température de recuit au-delà de 550°C, le HfO2 le film est dominé par le polycristallin monophasé et la couche interfaciale est complètement transformée en SiO2 cristallin .
Introduction
Oxyde d'hafnium (HfO2 ) le film mince est un matériau intéressant pour une variété d'applications. Il peut être utilisé dans le revêtement optique multicouche [1], le revêtement protecteur [2], le diélectrique de grille [3], la couche de passivation [4,5,6], et ainsi de suite en raison de ses excellentes propriétés, telles que haute densité, haute réfraction indice, large bande interdite et stabilité thermique relativement élevée. De nombreuses méthodes ont été utilisées pour préparer HfO2 films minces, tels que l'évaporation par faisceau d'électrons [7], le dépôt de solution chimique [8], la pulvérisation cathodique réactive [9], le dépôt chimique en phase vapeur métal-organique [10], l'épitaxie par faisceau moléculaire [11] et le dépôt de couche atomique (ALD). L'ALD est une méthode prometteuse pour obtenir des films minces avec à la fois un contrôle d'épaisseur de haute précision et une uniformité de haute précision. Le post-recuit s'avère avoir des influences significatives sur l'ALD HfO2 films [12,13,14,15]. Selon la recherche, HfO2 les films minces peuvent cristalliser pour une température de recuit supérieure à 500°C [16,17,18]. La structure cristalline de HfO2 affecte fortement les propriétés optiques et électriques. Par exemple, le changement structurel de HfO2 de la phase cristalline amorphe à monoclinique pourrait conduire à des changements d'indice de réfraction de 1,7 à 2,09, de gap optique de 5,75 à 6,13 eV et de constante diélectrique de 24,5 à 14,49 [19, 20]. Pour ALD HfO2 déposé sur des substrats de silicium, une couche d'oxyde est généralement observée à HfO2 /Si interface [21, 22]. La présence de cette couche interfaciale diminuerait la constante diélectrique [22]. De plus, Kopani et al. [23] ont présenté les propriétés structurelles du 5-nm HfO2 films après oxydation à l'acide nitrique de substrats en Si dopé n. Ils ont découvert qu'une température de recuit élevée augmente le taux de croissance des noyaux cristallins. Cependant, leurs propriétés de cristallisation en particulier HfO2 /interface substrat ont été peu étudiées. Par conséquent, la température de recuit affectant les propriétés de cristallisation de HfO2 des films minces préparés par ALD valaient la peine d'être approfondis.
Dans ce travail, le HfO2 des films minces ont été fabriqués par un dépôt de couche atomique plasma à distance (RP-ALD) sur des substrats de silicium de type p. Le post-recuit a été effectué par un système de recuit thermique rapide (RTA) à différentes températures. Les changements structurels et les propriétés de cristallisation de HfO2 Les films minces par RTA ont été caractérisés par microscopie à force atomique (AFM), diffraction rasante des rayons X incident (GIXRD), spectroscopie photoélectronique à rayons X (XPS) et microscopie électronique à transmission haute résolution (HR-TEM). Le HfO2 dépendant de la température L'évolution structurelle de l'interface /Si et son mécanisme sont également étudiés.
Méthode
Des plaquettes de Si Czochralski polies double face (100) orientées de type p de 2 pouces 250 μm avec une résistivité de 30 cm ont été utilisées. Avant le dépôt, les plaquettes de Si ont été nettoyées par une méthode standard de Radio Corporation of America suivie d'un trempage dans une solution d'acide fluorhydrique dilué (5%) pendant 2 min pour éliminer les éventuels oxydes parasites sans rinçage final à l'eau. Après nettoyage, toutes les plaquettes ont été séchées avec de l'azote pur (N2 ) gaz et monté sur le porte-substrat. Environ 15 nm HfO2 (168 cycles ALD) des couches minces ont été déposées sur des plaquettes de Si par RP-ALD (Picosun R-200, Finlande) en utilisant du tétrakis (éthylméthylamino) hafnium (TEMAH) et de l'oxygène (O2 ) en impulsion alternée avec N2 purge de la chambre de réaction entre les impulsions. La TEMAH et O2 le plasma a été puisé dans le réacteur dans la séquence suivante :impulsion TEMAH 1,6 µs; N2 purger 10 s ; O2 impulsion plasma 10 s, et N2 purger 12 s. Après avoir déposé le HfO2 couches minces, le recuit thermique rapide a été réalisé en N2 ambiante pendant 10 min. Les températures de recuit ont varié de 400 à 600 °C pour étudier l'effet sur la cristallisation du HfO2 films minces et HfO2 /Si interface. Le tableau 1 répertorie les conditions typiques de RPALD et de post-recuit.
Les mesures AFM ont été effectuées en mode tapotement pour étudier la morphologie de surface du HfO2 Films minces. Les images AFM présentées dans ce travail sont des scans de 2 μm × 2 μm avec une résolution de 256 points × 256 lignes. La structure de HfO2 Les films ont été caractérisés par des mesures de diffraction des rayons X incident rasant (GIXRD, Rigaku TTRAXIII, Japon) avec un tube à rayons X à focale longue et fine en Cu. Des rayons X d'une longueur d'onde de 0,154 nm ont été produits à une tension de fonctionnement de 50 kV et un courant de 300 mA. Un angle d'incidence de 0,5° a été sélectionné pour obtenir des diagrammes de diffraction sur un 2θ plage de 20 à 60°. Une spectroscopie photoélectronique aux rayons X (XPS, Thermo Fisher K-alpha) a également été réalisée en utilisant un rayonnement X monochromatique Al Kα (hν = 1486.6 eV). Pour l'analyse XPS, un spot de 100 µm de diamètre a été utilisé et les photoélectrons ont été collectés à un angle de décollage de 45°. Les coupes transversales du HfO2 des films minces ont été préparés par une technique d'extraction de faisceau d'ions focalisés dans un système Hitachi NX2OOO. Les images en coupe du HfO2 des films minces ont été examinés par une microscopie électronique à transmission haute résolution à émission de champ (HR-TEM, JEM-2100F, USA).
Résultats et discussion
La figure 1 montre les images AFM pour le HfO2 films recuits à différentes températures. Les valeurs de la moyenne quadratique (RMS) et de la rugosité de surface moyenne (Ra) sont indiquées pour indiquer la rugosité de la surface. La valeur RMS est de 0,44 nm pour le film tel que déposé. Elle augmente légèrement jusqu'à 0,47 nm lorsque la température de recuit s'élève à 500 °C. Une augmentation supplémentaire de la température de recuit à 600 °C conduit à une amélioration significative de la rugosité de surface avec un RMS augmentant jusqu'à 0,69 nm. La même tendance est observée dans les valeurs Ra. L'augmentation de la rugosité de surface des films recuits pourrait induire un changement structurel.
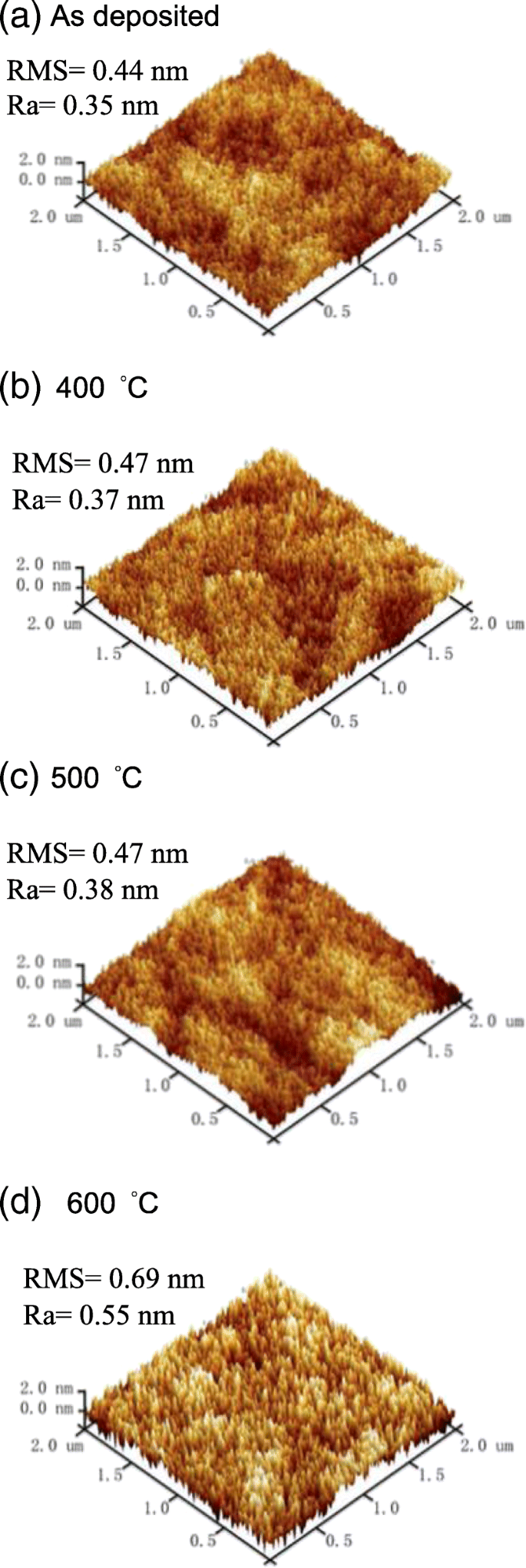
Images AFM de a tel que déposé, b 400 °C recuit, c 500 °C recuit, et d HfO2 recuit 600 °C films
La figure 2 montre les spectres GIXRD dépendant de la température de divers HfO2 Films minces. Le HfO2 tel que déposé films est amorphe et reste amorphe après recuit à 400 et 450°C. A une température de recuit supérieure à 500 °C, des pics de diffraction apparaissent, indiquant la formation de HfO2 cristallin . Les pics à 1/d = 0.319 et 0.354 Å −1 correspondent respectivement aux plans − 111 et 111 de la phase monoclinique (ICDD PDF#34-0104, groupe spatial P21/c). Le pic à 1/d = 0.340 Å −1 correspond au plan (111) de la phase orthorhombique (ICDD PDF#21-0904, groupe d'espace Pbcm). Les autres pics proches de 1/d = 0.380~0.395 sont les plans 200, 020 et 002 de la monoclinique et le plan 020 des phases orthorhombiques. Les résultats révèlent également que la phase monoclinique diminue et que les phases orthorhombiques augmentent avec la température de recuit. L'orthorhombique HfO2 domine la structure cristalline à des températures de recuit plus élevées. Cependant, les pics de diffraction du HfO orthorhombique2 ont été observés à un 1/d inférieur (un espacement d plus petit) par rapport à celui de l'ICDD PDF#21-0904. De plus, le décalage de 1/d = 0.340 Å −1 vers une valeur plus élevée indique que l'espacement d diminue avec la température de recuit.
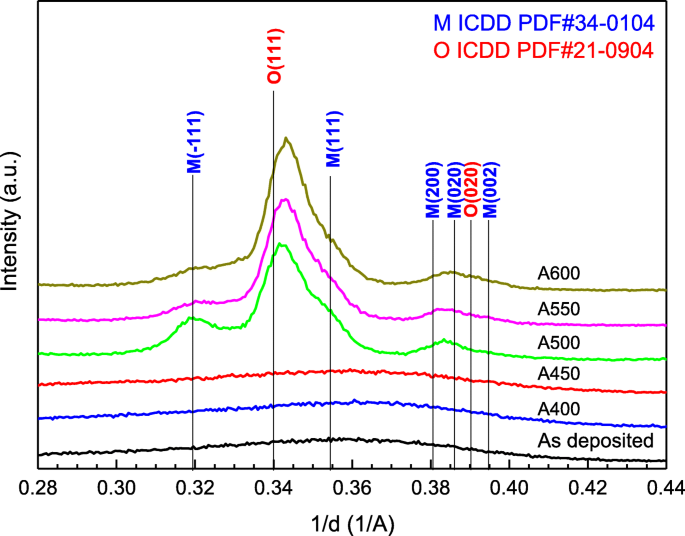
Spectres GIXRD de HfO2 films minces recuits à différentes températures
Les concentrations de Hf et O au sein du HfO2 les films ont été mesurés à l'aide d'un XPS profilé en profondeur. La figure 3 montre le rapport de composition O/Hf du HfO2 tel que déposé et post-recuit. cinéma. Le rapport O/Hf diminue de 1,60 à 1,29 avec la température de recuit. En raison de l'utilisation de N2 pendant le recuit, le HfO2 devient pauvre en oxygène avec la température. Le HfO2 déficient en oxygène le film entraîne également un espacement plus petit comme mentionné précédemment.

Rapport atomique oxygène/hafnium pour HfO2 films minces recuits à différentes températures
Les figures 4a, b, c, d, e et f montrent les images HR-TEM en coupe transversale à haute résolution de 400 °C-, 450 °C-, 500 °C-, 550 °C-, et HfO2 recuit 600 °C films minces sur substrats Si, respectivement. On peut voir que le HfO2 couche et substrat Si sont clairement exposés dans ces images. De plus, une fine couche d'une épaisseur de 1 à 2 nm entre HfO2 et le substrat Si pourrait être le SiO2 film. Comme le montre la figure 4a, il n'y a pas d'agencement de réseau évident dans le HfO2 tel que déposé film, indiquant que ce film est amorphe. Après recuit à 400 °C, bien que la plupart des régions de HfO2 film sont encore amorphes, nous pouvons observer qu'une fraction des arrangements de réseau avec les valeurs d'espacement d de 2,82 et 3,12 Å sont formés dans ce film. Ces deux valeurs d-espacement sont indexées à la monoclinique HfO2 (111) et monoclinique HfO2 (− 111) plans, respectivement, et le film recuit à 400°C montre la structure nanocristalline. Avec l'augmentation de la température de recuit de 400 à 600 °C, la qualité cristalline de HfO2 le film est progressivement amélioré. Lorsque le HfO2 le film est recuit à 500–550 °C, les principaux agencements de réseau étant constitués de HfO2 monoclinique (− 111), monoclinique HfO2 (200), et orthorhombique HfO2 (111) peuvent être identifiés. Cependant, en augmentant encore la température de recuit à 600 °C, la structure réticulaire de HfO2 orthorhombique (111) existe toujours dans le film, et les deux autres dispositions en treillis disparaissent progressivement. D'autre part, les valeurs d-espacement de HfO orthorhombique2 (111) plans pour les recuits HfO2 recuit 500 °C-, 550 °C- et 600 °C les films sont déterminés à 2,93, 2,90 et 2,88 Å, respectivement. Cela concorde bien avec le résultat XRD que le HfO orthorhombique2 (111) le pic de diffraction se déplace vers la direction de l'angle élevé avec l'augmentation de la température de recuit de 500 à 600°C. Le résultat révèle que la teneur en oxygène de HfO2 le film diminue progressivement à mesure que la température de recuit augmente. L'autre phénomène intéressant se trouve dans les changements de structure cristalline et d'épaisseur du SiO2 couche. A l'état de dépôt, le SiO2 la couche est amorphe. Même si l'échantillon est recuit à 400 °C, l'énergie thermique n'est pas assez élevée pour transformer la structure de SiO2 couche d'amorphe à cristallin. Néanmoins, en augmentant la température de recuit de 450 à 600 °C, le SiO2 cristallin couche (avec le SiO2 cubique (220)) est formée et son épaisseur augmente de 1,0 à 1,6 nm. On peut observer que le SiO2 amorphe la couche se transforme complètement en SiO2 cubique structure après recuit de l'échantillon à 600°C. Avec un incrément de température de recuit de 550 à 600 °C, la valeur d-espacement de SiO2 cubique (220) passe de 2,48 à 2,56 . Cela signifie que la teneur en oxygène de SiO2 couche augmente en augmentant la température de recuit. On peut raisonnablement supposer que l'ajout de la teneur en oxygène dans le SiO2 couche est attribuée à la diffusion d'atomes d'oxygène provenant du HfO2 film. De plus, l'épaisseur globale diminue pour la température de recuit de 550 et 600 °C et pourrait être liée à l'augmentation de la densité du film causée par la cristallisation et l'élimination de l'hydrogène.
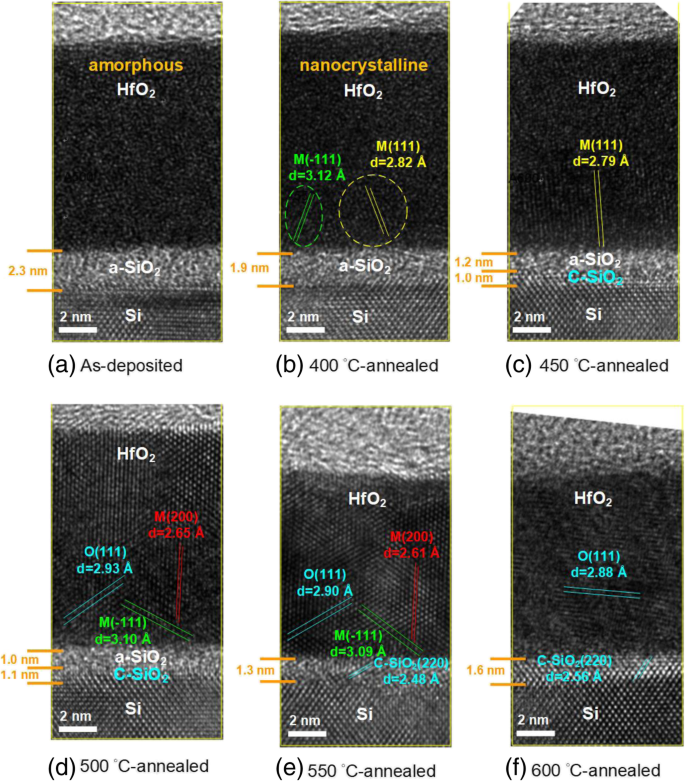
Images MET transversales de a tel que déposé, b 400 °C recuit, c recuit à 450°C, d 500 °C recuit, e recuit à 550°C et f HfO2 recuit 600 °C /Si
Sur la base des résultats ci-dessus, la figure 5 illustre les mécanismes du HfO2 films avec différentes températures de recuit. Étant donné que la température de recuit est inférieure à 400 °C (Fig. 5a), le film est amorphe où les atomes Hf et O sont disposés de manière aléatoire. La couche interfaciale entre HfO2 et la plaquette de c-Si est un oxyde mixte constitué de a-SiO2 et a-HfO2 . A une température de recuit de 450-550°C (Fig. 5b), le HfO2 le film reçoit de l'énergie thermique conduisant à un changement structurel d'amorphe à polycristallin avec des phases monocliniques et orthorhombiques. L'orientation cristalline et l'espacement d sont indiqués selon les résultats HR-TEM et GIXRD. Un SiO2 cristallin couche est formée. Plusieurs travaux ont rapporté une couche d'oxyde de silicium ordonnée à l'interface de a-SiO2 et (100) c-Si, mais le mécanisme et la structure à l'échelle atomique sont restés controversés. L'oxydation thermique du silicium pourrait être considérée comme des opérations d'insertion séquentielle d'atomes d'oxygène dans des liaisons Si-Si, ce qui induit une grande accumulation de contraintes de compression dans les régions oxydées et pourrait éventuellement provoquer une transformation structurelle en oxyde ordonné au niveau SiO2 /c-Si [24]. Il a également été rapporté qu'une phase cristalline contenant de l'oxygène pouvait se former dans des conditions de forte sursaturation en oxygène de Si [25] ou de faible densité de défauts d'interface [26]. A partir des images XPS et TEM de ce travail, le HfO2 couche est pauvre en oxygène. Les quantités importantes d'oxygène diffusent à partir de HfO2 vers le substrat de silicium, ce qui pourrait conduire à une sursaturation en oxygène à l'interface c-Si et à la formation de SiO2 cristallin . Dans cette plage de température, le SiO2 cristallin l'épaisseur de la couche augmenterait mais le a-HfO2 + a-SiO2 l'épaisseur de la couche mélangée diminue avec l'augmentation de la température de recuit. A une température de recuit supérieure à 550°C (Fig. 5c), le HfO2 La structure est dominée par des polycristallins orthorhombiques (111) monophasiques. La couche interfaciale est entièrement régie par le SiO2 cristallin . L'espacement d diminue pour HfO orthorhombique2 couche et augmente pour c-SiO2 . Bien que recuit de HfO2 est nécessaire pour obtenir une passivation et une constante diélectrique élevées des plaquettes de Si, à des températures élevées, la cristallisation résultante du HfO2 et l'interface SiO2 peut réduire les propriétés du film. La température de recuit de 500°C permet d'obtenir la meilleure constante diélectrique de 17,2. Une augmentation supplémentaire de la température de recuit conduit à une réduction de la constante diélectrique, probablement en raison du changement de la phase cristalline. Tomida et al. ont rapporté que la constante diélectrique de HfO2 diminue lorsque la structure passe d'une phase polycristalline à une phase monoclinique [27]. La meilleure passivation de HfO2 /Si peut également être obtenu à la température de recuit de 500 °C, car des températures plus élevées pourraient conduire à un c-SiO2 complet couche interfaciale et déshydrogénation à l'interface.
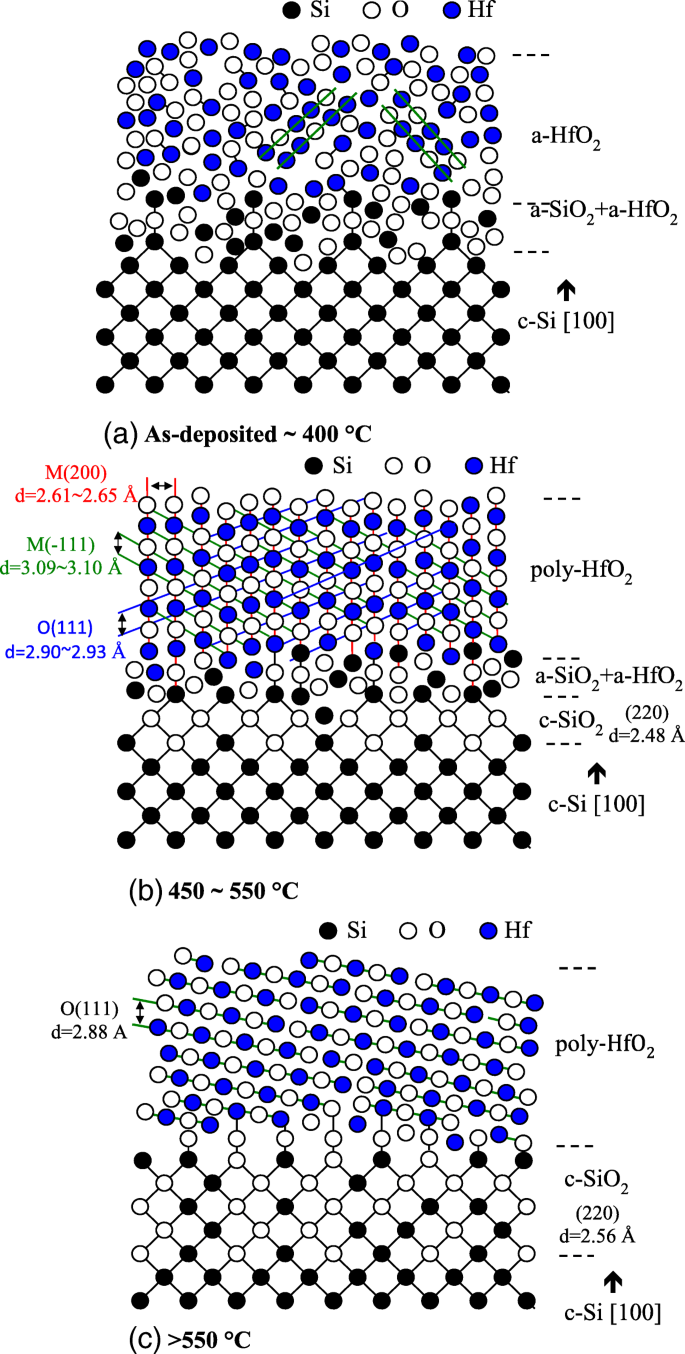
Schémas de mécanisme de cristallisation de HfO2 films et couche interfaciale dans les plages de température a tel que déposé à 400 °C, b 450 à 550°C, et c au-delà de 550°C. La valeur d-espacement et l'orientation cristalline sont également indiquées
Conclusion
HfO2 les films sont préparés en utilisant RP-ALD, et effet de la température de recuit sur la structure cristalline du HfO2 a fait l'objet d'une enquête. Pour HfO2 tel que déposé et celui recuit en dessous de 400 °C, le HfO2 et la couche interfaciale sont amorphes. Avec l'augmentation de la température de recuit, l'espacement d de l'orthorhombique diminue tandis que celui du c-SiO2 la couche interfaciale augmente, indiquant la diffusion d'oxygène de HfO2 à l'interface Si. Une température de recuit supérieure à 550°C montre un HfO2 couche monophasée polycristalline orthorhombique, et la couche interfaciale se transforme complètement en c-SiO2 . Bien qu'un recuit soit requis pour HfO2 dans de nombreuses applications telles que l'obtention d'une passivation élevée des plaquettes de Si et d'une constante diélectrique élevée, la cristallisation pourrait nuire aux propriétés du film. La température de recuit de 500 °C permet d'obtenir la meilleure qualité de passivation des tranches de silicium et la meilleure constante diélectrique.
Abréviations
- AFM :
-
Microscopie à force atomique
- a-HfO2 :
-
Oxyde d'hafnium amorphe
- ALD :
-
Dépôt de couche atomique
- a-SiO2 :
-
Dioxyde de silicium amorphe
- c-SiO2 :
-
Dioxyde de silicium cristallin
- GIXRD :
-
Diffraction rasante des rayons X incident
- HfO2 :
-
Oxyde d'hafnium
- HR-TEM :
-
Microscopie électronique à transmission haute résolution
- N2 :
-
Azote
- O2 :
-
Oxygène
- RMS :
-
Moyenne quadratique
- RP-ALD :
-
Dépôt de couche atomique plasma à distance
- RTA :
-
Recuit thermique rapide
- TEMAH :
-
Tetrakis (éthylméthylamino) hafnium
- XPS :
-
Spectroscopie photoélectronique aux rayons X
Nanomatériaux
- Caractéristiques de commutation résistive bipolaire des dispositifs RRAM à structure tricouche HfO2/TiO2/HfO2 sur des substrats revêtus de Pt et de TiN fabriqués par dépôt de couche atomique
- Réglage des morphologies de surface et des propriétés des films de ZnO par la conception de la couche interfaciale
- Préparation de nanosphères polymères à empreinte ionique de palladium(II) et son élimination du palladium(II) d'une solution aqueuse
- Mécanisme de conduction et endurance améliorée dans la RRAM à base de HfO2 avec traitement de nitruration
- Fabrication de couches minces SrGe2 sur des substrats Ge (100), (110) et (111)
- Étude des propriétés structurelles, électroniques et magnétiques des amas Ag n V (n = 1–12)
- Fabrication de nanofibres hélicoïdales CA/TPU et son analyse de mécanisme
- Caractérisation par résonance magnétique et hyperfréquence en fonction de l'épaisseur de films FeCoBSi à motifs de bandes combinés
- Une simulation théorique des réponses de rayonnement de Si, Ge et de superréseau Si/Ge à une irradiation à basse énergie



