Conception de points quantiques GeSn/GeSiSn à ingénierie de contrainte pour l'émission de bande interdite directe dans le milieu IR sur substrat Si
Résumé
Des points quantiques GeSn/GeSiSn auto-assemblés par ingénierie de contrainte dans une matrice Ge ont été étudiés numériquement dans le but d'étudier leur potentiel pour l'émission directe de bande interdite dans la gamme IR moyen. L'utilisation de l'alliage GeSiSn comme milieu environnant pour les points quantiques GeSn (QD) permet d'ajuster la déformation autour du QD par la variation de la composition Si et/ou Sn. En conséquence, le décalage de réseau entre les points quantiques GeSn et la couche environnante GeSiSn a été réglé entre - 2,3 et - 4,5 % grâce à la variation de la composition de la barrière Sn pour différentes tailles de QD en forme de dôme. Les résultats obtenus montrent que la longueur d'onde d'émission, remplissant les critères de directivité QD spécifiques, peut être réglée successivement sur une large gamme IR moyen de 3 à 7 μm, ouvrant de nouvelles perspectives pour les sources laser du groupe IV entièrement intégrées dans les systèmes photoniques Si pour les applications de détection.
Contexte
Récemment, la démonstration de matériaux à bande interdite directe du groupe IV par l'alliage de Ge [1, 2] et SiGe [3, 4] avec de l'étain a motivé des activités de recherche intenses en raison des opportunités réelles et réalisables vers la photonique et l'électronique efficaces sur puce. l'intégration. En effet, il a été démontré que l'alliage GeSn présente une bande interdite directe au-delà d'une certaine composition grâce à la diminution plus rapide de par rapport à la vallée L [5,6,7,8]. Bien que les résultats rapportés soient très encourageants, les propriétés des matériaux et les potentialités d'application ne sont pas encore pleinement explorées. En effet, la principale voie actuellement disponible pour augmenter la longueur d'onde de fonctionnement des lasers à semi-conducteurs à base de GeSn, vers la fenêtre de transparence de l'atmosphère qui chevauche les raies absorbantes de divers gaz [9], comprend l'augmentation de la teneur en Sn dans les couches de GeSn [10, 11 ]. Cependant, en raison du grand décalage de maille entre Ge et Sn (14 %), la préservation de la qualité cristallographique du matériau apparaît comme le principal défi interdisant cet objectif [12, 13]. Une solution potentiellement intéressante pour augmenter la longueur d'onde d'émission et assurer un meilleur relais de confinement des porteurs sur des structures de plus faible dimension telles que les nanofils [14,15,16], les nanotiges [17], et les points quantiques [18]. Dans le cadre des critères de directivité spécifiques, la longueur d'onde d'émission interbande directe à bande interdite est théoriquement limitée à 4,3 μm [19]. Pour surmonter ces limitations, il est nécessaire d'introduire un degré de liberté supplémentaire dans la conception des structures quantiques basées sur le groupe IV. Cela peut être assuré en utilisant une couche ternaire de GeSiSn [20,21,22], comme matériau d'environnement pour les points quantiques GeSn (QD) offrant la possibilité d'ingénierie des contraintes en incorporant des compositions Si et Sn appropriées. En conséquence, l'utilisation de la couche d'ingénierie de contrainte GeSiSn autour de GeSn QD devrait offrir une plus large gamme de longueurs d'onde d'émission de bande interdite directe accessibles.
Dans ce contexte, nous rapportons une étude théorique de l'effet de l'ingénierie des contraintes en faisant varier la composition de Sn dans la couche GeSiSn entourant le GeSn QD sur la longueur d'onde d'émission interbande directe à bande interdite.
Méthodes
Étant donné que les décalages de bande entre les alliages binaires et ternaires du groupe IV contenant du Sn et Ge ne sont pas connus expérimentalement, l'alignement relatif des bandes entre les différents semi-conducteurs du groupe IV impliqués dans ce travail est évalué, par rapport au bord de la bande de valence de Ge, en utilisant la théorie simplifiée de Jaros des décalages de bandes [23] comme détaillé par D'Costa et al. [24]. Les effets de déformation résultant du décalage de réseau entre le substrat de Ge et la couche de GeSiSn et entre le GeSn QD et le matériau GeSiSn environnant ont été évalués pour les bords des bandes de conduction et de valence.
En effet, le bord de la bande de conduction est décalé de \( \delta {E}_c^i \) et celui de la bande de valence de δE v comme le montre l'éq. (1) et (2) :
$$ \delta {E}_c^i={a}_c^i\left({\varepsilon}_{xx}+{\varepsilon}_{yy}+{\varepsilon}_{zz}\right) $ $ (1) $$ \delta {E}_v={a}_v\left({\varepsilon}_{xx}+{\varepsilon}_{yy}+{\varepsilon}_{zz}\right)+ b\gauche({\varepsilon}_{xx}-{\varepsilon}_{zz}\right) $$ (2)où i désigne la vallée L ou Γ, a c et un v sont le potentiel de déformation de la bande de conduction et de valence, respectivement, et b est le potentiel de déformation par cisaillement. \( {\varepsilon}_{xx}={\varepsilon}_{yy}=\varepsilon =\left(\frac{a_s-{a}_{\mathrm{l}}}{a_{\mathrm{l }}}\right) \) est la souche dans le plan et \( {\varepsilon}_{zz}=-2\frac{C_{12}}{C_{11}}{\varepsilon}_{xx} \) est la déformation dans le sens de la croissance. un s et un l sont respectivement le paramètre de maille du substrat et la couche contrainte. C 11 et C 12 sont les constantes de rigidité.
Les paramètres binaires et ternaires des matériaux d'alliage sont dérivés de ceux de Ge, Si et Sn par interpolation linéaire. Ces paramètres sont tirés de la référence [11].
Les bandes interdites contraintes dépendant de la composition peuvent être évaluées en ajoutant les décalages d'énergie générés par la contrainte correspondants à la bande interdite du matériau non contraint donnée dans l'équation. (3) pour GeSn et Eq. (4) pour GeSiSn :
$$ {E}_g^i\left({\mathrm{Ge}}_{1-{X}_d}{\mathrm{Sn}}_{X_d}\right)=\left(1-{X} _d\right){E}_g^i\left(\mathrm{Ge}\right)+{X}_d{E}_g^i\left(\mathrm{Sn}\right)-{b}^i{ X}_d\left(1-{X}_d\right) $$ (3) $$ {\displaystyle \begin{array}{l}{E}_g^i\left({\mathrm{Ge}}_ {1-{x}_b-y}{\mathrm{Si}}_y{\mathrm{Sn}}_{x_b}\right)=\left(1-{x}_b-y\right){E} _g^i\left(\mathrm{Ge}\right)+{x}_b{E}_g^i\left(\mathrm{Sn}\right)+{yE}_g^i\left(\mathrm{Si }\right)-{b}_{\mathrm{Ge}\mathrm{Sn}}^i{x}_b\Big(1-{x}_b-\\ {}y\Big)-{b}_ {\mathrm{Si}\mathrm{Sn}}^iy\left(1-{x}_b-y\right)-{b}_{\mathrm{Ge}\mathrm{Si}}^i{x} _by\end{array}} $$ (4)où b est le paramètre de courbure de la bande interdite correspondante des alliages binaires résumés dans le tableau 1.
Pour déterminer les états confinés des porteurs et en déduire les énergies de transition interbandes, l'équation de la masse effective monobande de Schrödinger a été résolue en coordonnées cartésiennes par la méthode des éléments finis fournie par le logiciel COMSOL Multiphysics [25] :
$$ -\frac{{\mathrm{\hslash}}^2}{2}\nabla \left(\frac{1}{m^{\ast}\left(\overrightarrow{r}\right)}\ mathrm{\nabla \uppsi}\left(\overrightarrow{r}\right)\right)+V\left(\overrightarrow{r}\right)\uppsi \left(\overrightarrow{r}\right)=E\ uppsi \left(\overrightarrow{r}\right) $$ (5)E représente l'énergie du porteur, et est la fonction d'onde correspondante. m* est la masse effective du porteur, ћ est la constante de Planck réduite, \( \overrightarrow{r} \) est le vecteur de coordonnées tridimensionnel, et V est le potentiel de confinement du porteur (discontinuité de bande). Pour simplifier la procédure de calcul de la structure électronique QD, nous avons adopté l'approximation à déformation constante [26, 27] au lieu de l'approche de simulation atomique coûteuse en calcul qui pourrait évidemment donner plus de précision dans le profil de distribution de déformation [28, 29]. En effet, nous considérons que le potentiel de confinement des porteurs dans le QD contraint en compression est suffisamment profond pour minimiser l'impact de la non-uniformité de la contrainte sur les états confinés d'électrons [27]. De plus, les bords de la bande de conduction, qui sont les paramètres les plus importants dans ce travail, permettant d'étudier la directivité de la bande interdite, ne sont décalés que par la déformation hydrostatique étant la moins sensible à la non-uniformité de la déformation, en particulier lorsqu'un désappariement de réseau relativement faible est considéré [30].
Résultats et discussion
Comme nous sommes principalement concernés par l'impact de la déformation autour du GeSn QD, la composition Sn du QD est fixée à 28% et la composition Si du GeSiSn à 35%; l'étude est donc focalisée sur l'impact de la composition de la barrière Sn (x b ) variation entre 6 et 22%. La déformation dans le plan résultante, soit dans la couche GeSiSn, soit dans le GeSn QD, est indiquée sur la figure 1a.
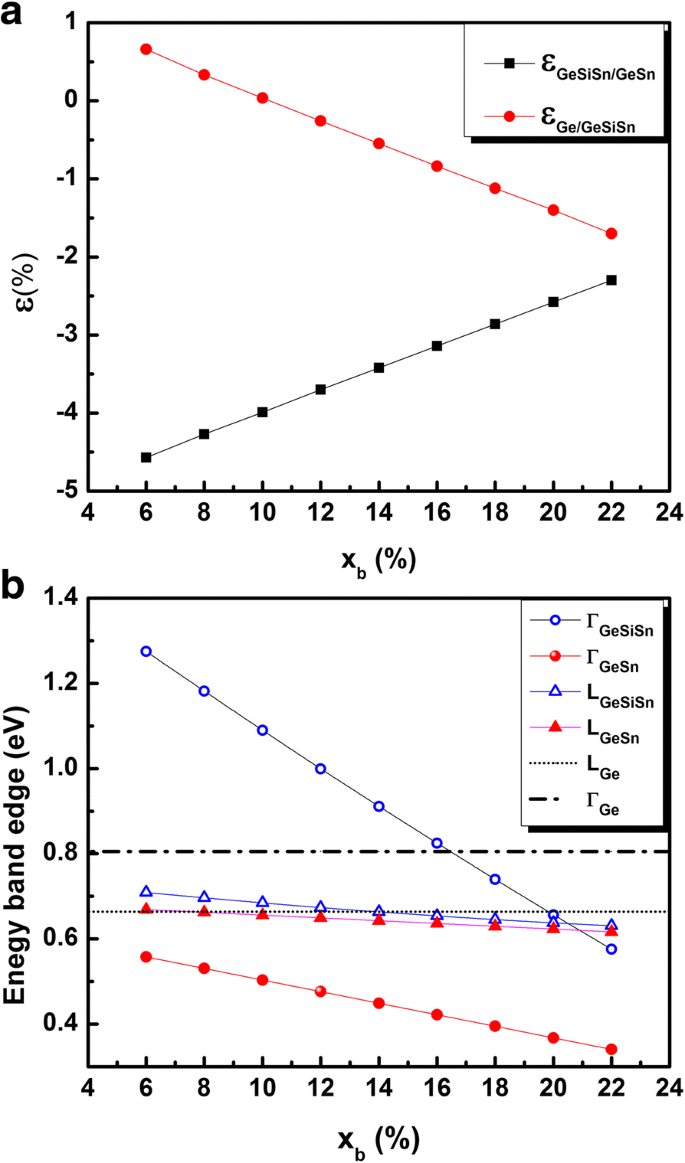
un Discordance de réseau entre Ge0.65-xb Si0.35 Sn xb et Ge (cercles pleins) et entre Ge0.72 Sn0.28 et Ge0.65-xb Si0.35 Sn xb (carrés pleins) en fonction de x b . b Bords de bande aux vallées L et G pour Ge0.65-xb Si0.35 Sn xb , Ge0.72 Sn0.28 , et Ge en fonction de x b
La déformation dans le plan dans la couche bidimensionnelle de matériau GeSiSn varie entre 0,6% (x b = 6%) et − 1.7% (x b = 22%). Nous supposons que cette couche reste soumise à une déformation pseudo-méorphique permettant de garder la structure conçue expérimentalement réalisable. Le GeSn est choisi pour être soumis à une contrainte de compression dans le matériau environnant GeSiSn avec un décalage de maille allant de - 2,3 à - 4,5 % assurant des conditions favorables à la formation de GeSn QD auto-organisé.
La figure 1b montre la dépendance de la bande interdite contrainte aux points L et par rapport à Ge0,72 Sn0.28 et Ge(0.65-xb ) Si0.35 Sn xb en fonction de x b . La vallée de Ge0.72 Sn0.28 le matériau reste en dessous des vallées L, témoignant de son type I pour toute la gamme étudiée de composition de barrière d'étain. Pendant ce temps, lorsque le confinement des électrons est pris en compte, la bande interdite effective augmente et l'effet de taille de QD devient décisif [18] en particulier pour les QD fortement sollicités. En effet, en présence de confinement quantique, l'énergie de l'état fondamental doit être considérée à la place du minimum de la bande . En conséquence, des QD de plus petite taille devraient avoir des niveaux d'énergie confinés plus élevés dans la vallée Γ qui peuvent dépasser la vallée L (et/ou le niveau d'énergie des électrons de l'état fondamental dans la vallée L). Il est donc important d'étudier la plage de taille du QD en obéissant aux critères de franchise spécifiques.
La structure modélisée est présentée schématiquement sur la Fig. 2. Le Ge0.72 Sn0.28 QD est considéré comme ayant une forme de dôme avec une base circulaire de diamètre D allant de 15 à 40 nm et un rapport hauteur/diamètre fixe égal à 0,25. Le QD est positionné à l'intérieur d'une couche de GeSiSn de 15 nm d'épaisseur ayant une composition Si de 35% et une composition Sn accordable. Cette structure est censée être formée sur un substrat Ge-buffered et recouverte d'une couche de Ge.
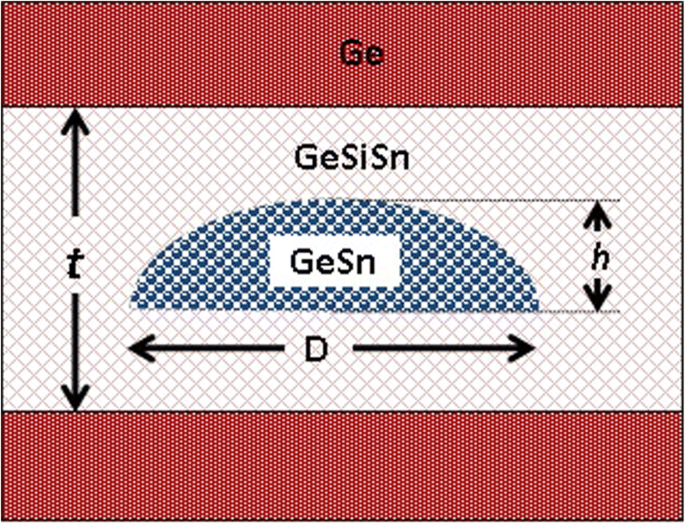
Présentation schématique du GeSn QD de hauteur modélisé (h ) et le diamètre (D ) dans la couche de réduction de contrainte GeSiSn dans la matrice Ge
Pour assurer une conception QD cohérente pour un meilleur fonctionnement du dispositif électroluminescent, un paramètre de directivité approprié prenant en compte l'espacement d'énergie entre la position de niveau d'énergie confiné QD le plus bas dans les vallées L et G a été introduit [18]. Ce paramètre est noté GSL -GSΓ et doit être supérieure à l'énergie thermique à température ambiante pour éviter la perte de porteurs par activation thermique, où GSL (GSΓ ) représente le niveau d'énergie de l'état fondamental des électrons dans la vallée L (vallée Γ) par rapport au maximum de la bande de valence. L'évaluation de GSL -GSΓ est illustré schématiquement dans l'encart de la Fig. 3.
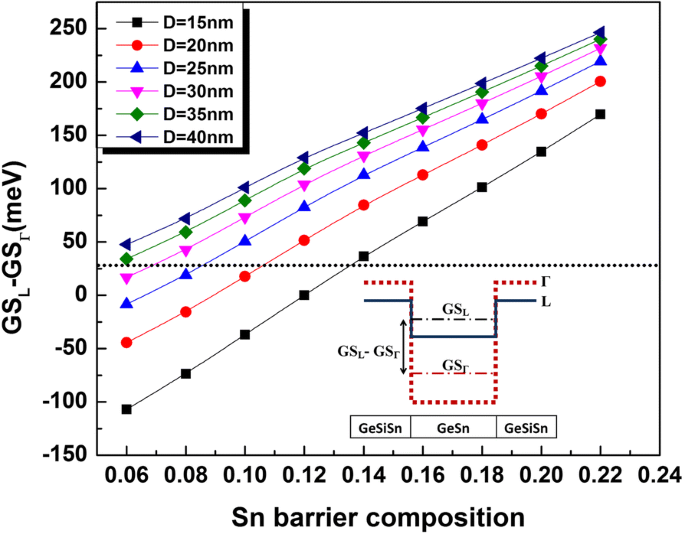
Paramètre de directivité (GSL -GSΓ ) variation en fonction du Ge0.72 Sn0.28 Taille QD et composition Sn du Ge0.65-x Si0.35 Sn x couche environnante. La ligne pointillée indique l'énergie thermique à température ambiante. L'encart représente une définition schématique du paramètre de directivité
Le calcul des niveaux d'énergie des électrons GeSn QD dans les vallées Γ et L pour différents diamètres en fonction de la composition Sn dans GeSiSn permet d'obtenir le paramètre de directivité correspondant (GSL -GSΓ ). Les résultats sont représentés sur la figure 3. Pour un x donné b , la valeur de GSL -GSΓ est principalement régie par la taille du QD. En conséquence, les points plus petits ayant des états d'énergie confinés manifestement plus élevés nécessitent une énergie de bande interdite inférieure grâce à la réduction de la déformation pour remplir les critères de directivité. Comme le montre la figure 3, des points plus gros (D> 25 nm) satisfont GSL -GSΓ> 26 meV pour x b supérieur à 8 %. Cependant, une bande interdite directe efficace à partir de QD de petite taille est garantie pour des valeurs plus élevées de x b (x b ≥ 14% pour D = 15 nm).
Dans les paramètres adoptés dans ce travail, et en particulier les paramètres de courbure des matériaux binaires, l'augmentation de la teneur en Sn du matériau GeSiSn réduit la tache autour du QD et réduit également la bande interdite du matériau environnant. En effet, comme le montre la figure 1b, l'augmentation de x b de 6 à 22% réduit la discontinuité de la bande de conduction à la vallée Γ de 0,72 eV à 0,23 eV. En effet, comme le montre la Fig. 4, où la fonction d'onde au carré \( {\left|\uppsi \left(\overrightarrow{r}\right)\right|}^2 \) de l'électron de l'état fondamental dans les points quantiques de diamètre 35 nm est indiqué dans le plan xy pour une composition de barrière de Sn de 6 % et 22 %, les électrons se trouvent être entièrement localisés à l'intérieur du QD quelle que soit la composition de la barrière (discontinuité de la bande de conduction). Les électrons fortement confinés indiquent une fiabilité plus élevée du QD étudié en tant que milieu actif pour les émetteurs de lumière sur substrat Si.

Fonction d'onde de l'état fondamental des électrons au carré pour Ge0,72 de 35 nm de diamètre Sn0.28 QD pour a Xb = 6% et b Xb = 22%
En limitant les tailles QD pour un x donné b à ceux qui engendrent une émission directe efficace à bande interdite, nous avons évalué la longueur d'onde d'émission interbande de l'état fondamental QD. Les résultats sont présentés sur la figure 5, où la longueur d'onde d'émission est tracée en fonction de x b pour différentes tailles de QD. Il convient de noter que la plus grande taille QD considérée dans ce travail (D = 40 nm) a montré une faible séparation d'énergie entre l'état fondamental de l'électron et le premier état excité (inférieur à 26 meV) et a donc été ignoré dans cette étude. Néanmoins, la longueur d'onde d'émission évaluée en fonction de x b a été conservé dans la Fig. 5 avec une ligne pointillée.
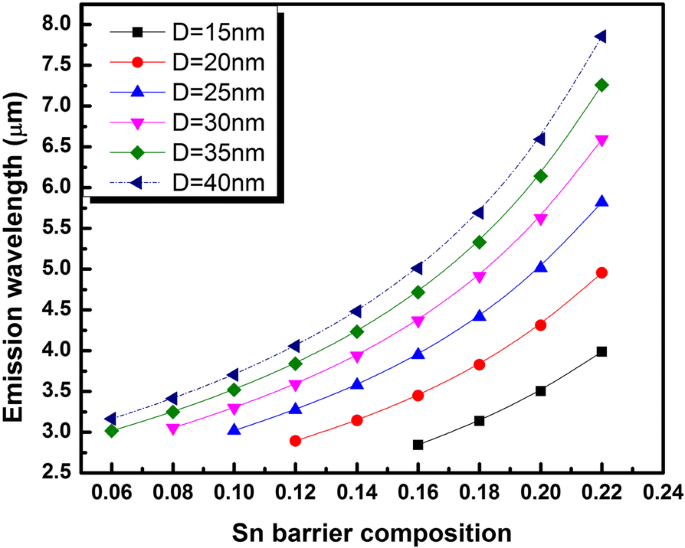
Longueur d'onde d'émission à l'état fondamental à température ambiante à partir de la bande interdite directe Ge0,72 Sn0.28 QD en fonction de la taille et de la composition Sn du Ge0.65-xb Si0.35 Sn xb couche environnante
La plage de longueurs d'onde qui devrait être couverte par la conception QD proposée va de 3 à 7 μm. La plage de rendement est extrêmement importante pour les applications de détection de gaz. La mise en œuvre expérimentale de cette structure pourrait offrir l'opportunité de couvrir, pour la première fois, l'ensemble de la gamme mid-IR avec un matériau entièrement compatible avec la technologie microélectronique existante ouvrant la voie à de nouvelles perspectives dans l'optoélectronique mid-IR basée sur QD compatible CMOS.
Conclusions
GeSn QD dans la couche d'ingénierie de déformation GeSiSn sur la matrice Ge ont été étudiés en fonction de la taille de QD et de la discordance du réseau avec le matériau environnant. La réduction de la contrainte autour du GeSn QD en faisant varier la composition en Sn du matériau de barrière GeSiSn améliore la longueur d'onde d'émission directe de type I à bande interdite de 3 à 7 μm. La structure conçue ouvre de nouvelles perspectives dans l'émetteur de lumière mid-IR entièrement compatible avec la technologie Si.
Abréviations
- CMOS :
-
Métal-oxyde-semi-conducteur complémentaire
- GSL :
-
Niveau d'électrons à l'état fondamental dans la vallée L
- GSΓ :
-
Niveau d'électrons à l'état fondamental dans la vallée Γ
- QD :
-
Points quantiques
Nanomatériaux
- N,N-diméthylformamide régulant la fluorescence des points quantiques MXene pour la détermination sensible de Fe3+
- La conception de la couche d'émission pour les multiplicateurs d'électrons
- Synthèse de points quantiques de type II/Type-I à suppression de réabsorption ZnSe/CdS/ZnS Core/Shell et leur application pour le dosage immunosorbant
- Synthèse de points quantiques de carbone co-dopés en pyridinique N, S en tant qu'imitateurs d'enzymes efficaces
- Points quantiques de bismuth dans des puits quantiques recuits GaAsBi/AlAs
- Effets bipolaires en photovoltage des hétérostructures à points quantiques métamorphiques InAs/InGaAs/GaAs :solutions de caractérisation et de conception pour les dispositifs sensibles à la lum…
- Synthèse verte de points quantiques InP/ZnS Core/Shell pour une application dans des diodes électroluminescentes sans métaux lourds
- Conception pour la fabrication de PCB
- Conseils de conception pour l'impression 3D par frittage laser direct de métal



