Transistors à effet de champ ferroélectrique à base de motifs à rayures micrométriques à dominance de nanotubes de carbone à simple paroi avec couche de contrôle des défauts HfO2
Résumé
Transistors ferroélectriques à effet de champ (FeFET) avec des nanotubes de carbone à paroi simple (SWCNT) dominés par une bande large d'un micron modelée en canal, (Bi, Nd)4 Ti3 O12 films comme isolant, et HfO2 des films en tant que couche de contrôle des défauts ont été développés et fabriqués. Les SWCNT-FeFET préparés possèdent d'excellentes propriétés telles qu'une grande conductance de canal, un rapport de courant marche/arrêt élevé, une mobilité élevée des porteurs de canal, une excellente endurance à la fatigue et la conservation des données. Malgré sa faible épaisseur équivalente de capacité, l'isolant de grille avec HfO2 la couche de contrôle des défauts montre une faible densité de courant de fuite de 3,1 × 10 −9 A/cm 2 à une tension de grille de − 3 V.
Contexte
Le transistor à effet de champ ferroélectrique (FeFET) est un candidat prometteur pour les dispositifs de mémoire non volatile et les circuits intégrés en raison de sa structure à dispositif unique à grande vitesse, de sa faible consommation d'énergie et de son opération de lecture non destructive [1,2,3]. (Bi,Nd)4 Ti3 O12 (BNT) est un film mince ferroélectrique sans plomb avec des propriétés chimiques stables et des performances d'endurance à la fatigue. Ainsi, le FeFET utilisant le BNT comme diélectrique de grille aurait une tension de seuil plus petite, une conductance de canal élevée, etc. Les nanotubes de carbone (CNT) ont été largement appliqués dans le FeFET pour sa conductivité élevée et sa grande mobilité des porteurs [4,5,6,7]. Il est bien connu qu'il n'y a pas de liaisons pendantes à la surface des NTC idéaux, ce qui conduit à une petite réaction d'interface entre le film ferroélectrique et les NTC [8, 9]. Cependant, il est très difficile d'obtenir une croissance de CNT unique entre les électrodes de source et de drain dans l'expérience. En outre, le rapport courant marche/arrêt du réseau de nanofils CNT FeFET est généralement faible en raison du mélange de nanotubes métalliques dans le réseau CNT [7, 10]. Song et al. ont proposé d'utiliser des bandes de NTC multicouches de largeur micron à motifs comme matériau de canal de FeFET pour résoudre les problèmes mentionnés ci-dessus, mais les performances d'endurance à la fatigue et la conservation des caractéristiques physiques de CNT FeFET ne sont pas claires [9]. Comparé au CNT à parois multiples (MWCNT), le CNT à paroi unique (SWCNT) est une feuille de graphène unique enveloppée sans couture formée dans un tube cylindrique [11]. De plus, il existe certains défauts (tels que les impuretés ioniques, les lacunes d'oxygène et les dislocations) qui sont difficiles à contrôler lors de la fabrication d'un film mince ferroélectrique [12,13,14]. La diffusion de ces défauts peut affecter le rapport de courant marche/arrêt, les performances d'endurance à la fatigue et la conservation des données [15, 16]. Par conséquent, nous implantons HfO2 couche en SWCNT-FeFET, qui est utilisée pour bloquer la diffusion des défauts ponctuels et peut être utilisée comme couche tampon pour éliminer le décalage entre le BNT et le Si et donc pour réduire la densité de dislocation dans le film de BNT. Il peut contrôler les défauts dans SWCNT-FeFET, puis améliorer considérablement le rapport de courant marche/arrêt, les caractéristiques de fatigue et la conservation des données.
Dans cette étude, nous avons fabriqué des SWCNT de réseau à rayures micrométriques régulières et alignées en tant que couche de canal, des films BNT en tant qu'isolant et HfO2 films comme couche de contrôle des défauts pour fabriquer un FeFET de type à grille inférieure et devrait obtenir un bon rapport de courant marche/arrêt, des caractéristiques de fatigue et une conservation des données. La structure de SWCNT-FeFET et sa procédure de préparation sont illustrées à la Fig. 1a, b. En outre, nous avons également fabriqué le MWCNT-FeFET à des fins de comparaison.
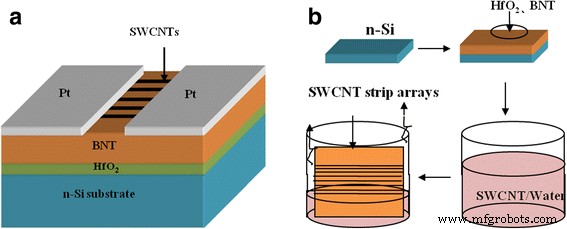
un Le diagramme de structure du SWCNT-FeFET à rayures. b Organigramme du SWCNT/BNT/HfO2 à rayures -Fabrication FeFET
Méthodes
Dans les dispositifs FeFET, la bande SWCNT de largeur micron est utilisée comme canal, le film mince BNT est utilisé comme diélectrique de grille, HfO2 des films sont utilisés comme couche de contrôle des défauts, et le Si de type n fortement dopé est utilisé simultanément comme substrat et électrode de grille arrière de FeFET. La résistivité du Si de type n est de 0,0015 Ω cm. Le HfO2 a été déposé sur le substrat de Si par dépôt laser pulsé (PLD) en utilisant un laser excimère KrF avec une longueur d'onde de 248 nm, et son épaisseur est d'environ 20 nm. Le film de BNT a été déposé sur le substrat de Si par PLD comme décrit dans les premiers travaux [17], et son épaisseur est d'environ 300 nm. Le SWCNT vierge à décharge à l'arc a été acheté auprès de l'Institut de chimie organique de Chengdu (Académie chinoise des sciences); la longueur et le diamètre sont de 10-30 μm et 0,8-1,1 nm, respectivement. Sa pureté est de 85 % ce qui signifie que le SWCNT est dominé. Les SWCNT ont été fabriqués en utilisant un auto-assemblage induit par évaporation. La concentration de SWCNT/dispersion dans l'eau était de 100 mg/L, le taux d'évaporation variait dans une plage de 9 à 21 μL/min et la température était de 80 °C. En contrôlant la température d'évaporation du solvant, un motif de rayures bien défini s'est formé à l'interface solide-liquide-vapeur sur le BNT/HfO2 /Si substrat. Ensuite, des électrodes de source/drain de Pt ont été déposées sur les SWCNT/BNT par pulvérisation cathodique par faisceau d'ions à l'aide d'une plaque de masque. La surface totale de la plaque du masque métallique est de 1 cm 2 , et les zones de source et de drain sont toutes deux de 4,5 mm 2 . La longueur du canal (L ) et la largeur (W ) de FeFET sont respectivement de 200 et 1500 μm. Le SWCNT-FeFET fabriqué suivi d'un post-recuit à 500 °C pendant 2 h pour améliorer le contact entre les électrodes source/drain et les SWCNT. Comme indiqué, le réseau CNT contient à la fois des nanotubes métalliques et semi-conducteurs. Le réseau CNT a été traité en appliquant une grande tension de grille. Les nanotubes SWCNT métalliques ont été presque supprimés et les nanotubes SWCNT semi-conducteurs sont restés par courant de charge [18]. Pour comparer, SWCNT/SiO2 -Les FET ont été fabriqués par la même méthode et les mêmes conditions ; Les MWCNT/BNT-FET ont également été fabriqués par la méthode décrite dans les premiers travaux [9]. Les caractéristiques du FeFET ont été mesurées à l'aide d'un analyseur de paramètres Keithley 4200. Les boucles d'hystérésis et les polarisations du FeFET ont été mesurées à l'aide d'un analyseur ferroélectrique RT Precision Workstation.
Résultats et discussion
La figure 2 montre des images SEM typiques des motifs à rayures SWCNT. Les SWCNTs réguliers et alignés à rayures micrométriques sont affichés sur la figure 2a. Les bandes protubérantes et claires sont des bandes SWCNT, dans lesquelles les SWCNT sont densément emballés, comme le montre l'image agrandie d'une bande sur la figure 2b. Les rayures creuses et grises correspondent au BNT/HfO2 dénudé Substrat /Si dans les espaces entre les bandes SWCNT micrométriques. La concentration de la solution de précurseur de SWCNT augmente avec l'évaporation, et la largeur des bandes graduées augmente légèrement avec la baisse du niveau de liquide SWCNT/eau. Le BNT/HfO2 les films et les films BNT sur le substrat Si sont illustrés à la Fig. 2c, d. On peut voir que la surface du BNT/HfO2 Le film est composé de nombreux grains et pores cristallins, ce qui indique une rugosité plus grande que celle des films BNT. La figure 2e montre le P -V boucles d'hystérésis de BNT et BNT/HfO2 films, respectivement. Les polarisations des boucles d'hystérésis du BNT/HfO2 les films sont plus grands que ceux des films BNT dans la même tension. Même si HfO2 couche partagée partie de la tension de BNT/HfO2 films, le film BNT montre toujours une meilleure valeur de polarisation que celle du BNT cultivé sur substrat Si. C'est parce que les films BNT ont poussé sur le HfO2 couche ont une concentration de défauts de diffusion inférieure à celle des films BNT cultivés directement sur le substrat Si.

un Micrographie SEM de la bande SWCNT à motifs dans le SWCNT/BNT/HfO2 -FeFET. b La structure de grille des SWCNT. c Image SEM de la surface pour BNT/HfO2 film. d Image SEM de la surface pour film BNT. e Boucles d'hystérésis de BNT et BNT/HfO2 films
La figure 3 montre les caractéristiques de sortie (I DS -V DS ) courbes de SWCNT/BNT/HfO2 -FeFET et SWCNT/BNT-FeFET. SWCNT/BNT/HfO2 -FeFET et SWCNT/BNT-FeFET montrent le p typique caractéristiques des transistors à canal et courants source-drain saturés à basse tension source-drain. Leur longueur de canal (L ) est de 200 μm. En raison du motif à rayures SWCNT d'une largeur d'un micron, le courant « on » et la conductance du canal de SWCNT/BNT/HfO2 -FeFET et SWCNT/BNT-FeFET atteignent tous les deux 3,8×10 −2 A, 3,6×10 −2 A et 9.5×10 −3 S, 9×10 −3 S à V GS = − 4 V et V DS = 4 V. Cependant, SWCNT/BNT/HfO2 -FeFET montre des courants à l'état bloqué inférieurs à ceux de SWCNT/BNT-FeFET, et SWCNT/BNT-FeFET montre un grave phénomène de courant de fuite à V GS = 0 V. C'est parce que le HfO2 couche bloque efficacement la diffusion des défauts.

Courbes caractéristiques de sortie de SWCNT/BNT/HfO2 -FeFET(letf) et SWCNT/BNT-FeFET(droite)
Les caractéristiques de transfert (I D -V G ) du SWCNT/BNT/HfO2 -FeFET et SWCNT/BNT-FeFET avec L = 200 μm et V DS =0,6 V sont présentés sur la Fig. 4. La tension de seuil (V ème ) de SWCNT/BNT/HfO2 -FeFET et SWCNT/BNT-FeFET sont V ème = 0,2 V et V ème = 0,8 V par un ajustement linéaire de (I D ) 1/2 contre V GS courbe du transistor fonctionnant dans la zone de saturation. La mobilité du canal (μ samedi ) est calculé sur la base du (I DS ) 1/2 contre V GS courbe ainsi que l'expression de la région de saturation pour un transistor à effet de champ [19],
$$ {I}_{\mathrm{DS}}=\left(\frac{\varepsilon_0{\varepsilon}_r{\mu}_{\mathrm{sat}}W}{t_{\mathrm{ins}} 2L}\right){\left({V}_{\mathrm{GS}}\hbox{-} {V}_{\mathrm{th}}\right)}^2 pour\kern0.5em {V_{ \mathrm{DS}}}^{{}^3}{V}_{\mathrm{GS}}\hbox{-} {V}_{\mathrm{th}}, $$où ε r est la permittivité relative et t ins est l'épaisseur du BNT. Une constante diélectrique relative (ε r ) du film BNT est de 350, ce qui est mesuré à 1 MHz par l'analyseur de paramètres HP4156. Le μ samedi de SWCNT/BNT/HfO2 -FeFET et SWCNT/BNT-FeFET sont 395 et 300 cm 2 /Vs. La figure 5 montre le I DS –V GS courbes de transfert logarithmique des SWCNT/BNT/HfO2 fabriqués -FeFET, SWCNT/BNT-FeFET et SWCNT/SiO2 /HfO2 -FET en mode double balayage. Le balayage de tension de grille a été effectué à un V DS de 0,6 V et au V GS va de − 7 à 4 V, − 6 à 3 V, et − 4 à 1 V. Le I DS rapport marche/arrêt de SWCNT/BNT/HfO2 -FeFET, SWCNT/BNT-FeFET et SWCNT/SiO2 /HfO2 -FET sont 2 × 10 5 , 2 × 10 4 , et 2,3 × 10 2 au V GS plage de − 7 à 4 V. Le I DS rapports marche/arrêt de SWCNT/BNT/HfO2 -FeFET sont supérieurs à ceux de MWCNT/BNT-FeFET [9] et SWCNT/BNT-FeFET. C'est parce que le HfO2 La couche de contrôle des défauts a été implantée dans SWCNT-FeFET, qui bloque efficacement la diffusion des défauts. Pour Je DS -V GS caractéristiques, nous avons obtenu une boucle d'hystérésis dans le sens horaire due à l'inversion de polarisation ferroélectrique du film BNT, la largeur de fenêtre mémoire (MW) obtenue de SWCNT/BNT/HfO2 -FeFET et SWCNT/BNT-FeFET sont d'environ 4,2 et 4,1 V, ce qui est supérieur à celui de CNT/PZT-FeFET (1,1 V) avec le réseau CNT comme couche de canal [20]. Le MW plus grand indique un bon couplage diélectrique dans ce système FeFET. À partir de la figure 4c, nous pouvons voir la largeur de fenêtre obtenue de SWCNT/SiO2 /HfO2 -FET est d'environ 1 V, ce qui est principalement causé par les densités de défauts de SWCNT [21]. Ces résultats suggèrent que l'hystérésis de la fenêtre mémoire (4,2 V) du FeFET ferroélectrique est causée à la fois par la polarisation BNT et les densités des défauts SWCNT.
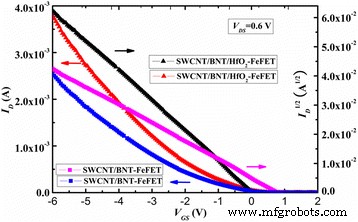
La courbe caractéristique de transfert linéaire et ajustée I DS 1/2 -V G courbe en V DS = 0,6 V pour la bande à motifs de SWCNT/BNT/HfO2 -FeFET et SWCNT/BNT-FeFET

Courbes de transfert logarithmique des rayures a SWCNT/BNT/HfO2 -FeFET, b SWCNT/BNT-FeFET et c SWCNT/SiO2 /HfO2 -FET à V DS = 0,6 V. Les flèches indiquent une boucle d'hystérésis dans le sens inverse des aiguilles d'une montre et les lignes continues indiquent la largeur de la fenêtre de mémoire
La figure 6a montre les caractéristiques courant de fuite-tension du BNT/HfO2 et le film BNT. Comme on peut le voir, les courants de fuite sont de 1,2 × 10 −9 A et 1,5 × 10 −8 A pour BNT/HfO2 et le film BNT, respectivement, lorsque la tension atteint jusqu'à − 3 V. Les caractéristiques courant de fuite-tension du BNT/HfO2 et le film BNT ont été étudiés à des fins de comparaison en ajustant le I -V Les données. Les caractéristiques de courant de fuite d'un contact Schottky étaient représentées par Ln(J ) = b (V + V bi * ) 1/4 [9, 22, 23], et les graphiques correspondants pour BNT/HfO2 et les films BNT dans la plage de tension de 0 à 3,8 V sont illustrés à la figure 6b. Les tensions intégrées V bi * et pente b dans la formule peut être obtenu en ajustant l'expérience I-V Les données. Les densités de charge d'espace calculées N eff , qui se composait de centres de piégeage profonds et de lacunes d'oxygène [22], est d'environ 2.132 × 10 17 cm −3 et 1.438 × 10 19 cm −3 pour BNT/HfO2 et le film BNT, respectivement. Il est indiqué que les films de BNT déposés sur substrat Si sont des semi-conducteurs de type n selon la formule des hauteurs de barrière d'interface [24]. Ceci est cohérent avec l'effet du HfO2 sur la réduction du courant de coupure de I D -V G courbe de la Fig. 4a, b, parce que le BNT de type n génère des électrons augmente le courant de coupure en tension négative. La conduction du film BNT montre un mécanisme de contrôle du volume, ce qui implique en outre que le BNT de type n est principalement induit par les défauts conducteurs ou les impuretés [9, 22].
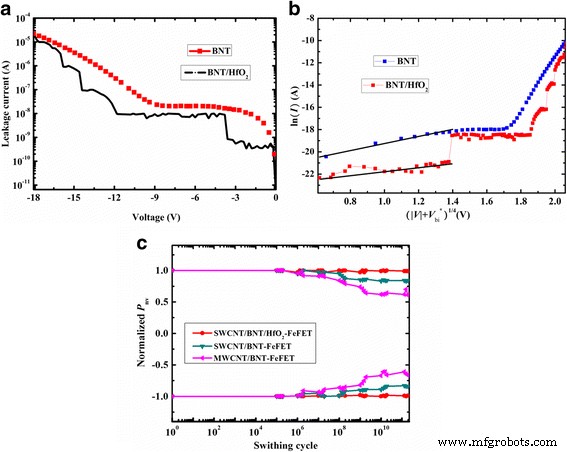
un Caractéristiques courant de fuite-tension du BNT/HfO2 et le film BNT. b La courbe d'ajustement des caractéristiques courant de fuite-tension du BNT/HfO2 et le film BNT. c Performances d'endurance à la fatigue du SWCNT/BNT/HfO2 -FeFET, SWCNT/BNT-FeFET et MWCNT/BNT-FeFET
La figure 6c montre les performances d'endurance à la fatigue pour le SWCNT/BNT/HfO2 -FeFET, SWCNT/BNT-FeFET et MWCNT/BNT-FeFET avec une impulsion bipolaire de 100 KHz au V GS plage de − 7 à 4 V. Les performances d'endurance à la fatigue du FeFET se manifestent par la perte de polarisation commutable avec des cycles de commutation répétés. La valeur de la polarisation non volatile (P nv ) est obtenu par l'équation P nv = P r * − P r ^ puis, normalisé avec P nv /P r0 * [25], où P r * est deux fois la polarisation résiduelle de FeFET, P r ^ est la perte de polarisation après l'impulsion suivante, et P r0 * est le double de la polarisation résiduelle initiale du FeFET. La perte partielle du P normalisé nv après 10 11 des cycles de commutation lecture/écriture sont observés pour le FeFET, qui sont d'environ 3, 10 et 25 % pour SWCNT/BNT/HfO2 -FeFET, SWCNT/BNT-FeFET et MWCNT/BNT-FeFET, respectivement. Lorsque le BNT croît directement sur l'électrode inférieure Si, les performances en fatigue du SWCNT/BNT-FeFET sont très mauvaises en raison de la diffusion entre le BNT et le substrat Si à travers le joint de grain [12,13,14]. Ces résultats suggèrent que le HfO2 La couche bloque efficacement la diffusion du substrat Si et réduit les impuretés ioniques, ce qui se traduit par d'excellentes performances d'endurance à la fatigue.
Pour évaluer la fiabilité de l'appareil de FeFET vers l'application NVRAM, nous avons examiné la conservation des données. La figure 7 montre les courbes de rétention de courant source-drain pour le SWCNT/BNT/HfO2 -FeFET, SWCNT/BNT-FeFET et MWCNT/BNT-FeFET à température ambiante. L'impulsion de tension de V GS = − 4 V et V GS = 1 V à V DS = 1 V est appliqué à la grille et à l'électrode source-drain, commutant la tension du FeFET sur l'état désactivé ou activé, respectivement. Les rapports de courant mesurés à l'état marche/arrêt sont proches de 3 × 10 4 , 7 × 10 3 , et 6 × 10 2 pour SWCNT/BNT/HfO2 -FeFET, SWCNT/BNT-FeFET et MWCNT/BNT-FeFET après 10 6 s, respectivement. Il n'y a pas de perte significative du rapport courant marche/arrêt (3,2%) après un temps de rétention de 1 × 10 6 s pour SWCNT/BNT/HfO2 -FeFET. En extrapolant les courbes à 10 8 s pour SWCNT/BNT/HfO2 -FeFET, SWCNT/BNT-FeFET et MWCNT/BNT-FeFET, les rapports de courant marche/arrêt sont de près de 1,9 × 10 4 , 3 × 10 3 , et 2 × 10 2 , respectivement. Le rapport d'état marche/arrêt de SWCNT/BNT/HfO2 -FeFET est encore suffisamment élevé pour la fonction des mémoires, démontrant une propriété de rétention souhaitable du présent dispositif de mémoire. La rétention est influencée par le courant de fuite de grille [26, 27]. Le long temps de rétention indique HfO2 La couche de contrôle des défauts peut réduire efficacement le courant à l'état bloqué et le courant de fuite de grille, ce qui stabilise le rapport de courant marche/arrêt. En outre, nous avons également fait une comparaison entre les FET à base de ferroélectrique et différents CNT dans le tableau 1, suggérant que le SWCNT/BNT/HfO2 fabriqué -FeFET dans cette étude peut fournir un rapport de courant marche/arrêt élevé, une excellente performance d'endurance à la fatigue et une conservation des données.
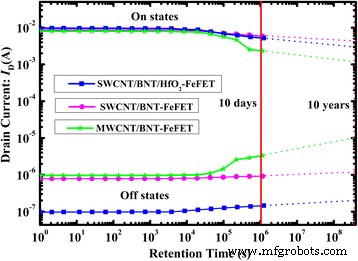
Caractéristiques de rétention du SWCNT/BNT/HfO2 -FeFET, SWCNT/BNT-FeFET et MWCNT/BNT-FeFET à température ambiante
Afin de mieux comprendre comment les défauts influencent les caractéristiques physiques de l'appareil, le P -E boucles d'hystérésis et I DS -V GS courbe pour le SWCNT/BNT/HfO2 -FeFET et SWCNT/BNT-FeFET ont été simulés en considérant la charge asymétrique causée par les défauts en utilisant nos modèles précédents [12, 28]. Une charge asymétrique causée par des défauts est considérée pour simuler le P -E boucles d'hystérésis et I DS -V GS courbe du BNT, et une charge symétrique est considérée pour simuler celle du BNT/HfO2 . Les résultats de la simulation sont présentés dans les Fig. 8a, b, qui sont similaires aux résultats expérimentaux des Fig. 2e et 5a, b, respectivement. Les résultats de la simulation indiquent HfO2 La couche réduit efficacement les charges asymétriques des films ferroélectriques causées par des défauts, ce qui augmente encore le courant à l'état bloqué. Par conséquent, il peut être démontré que les défauts du film mince ferroélectrique étaient efficacement contrôlés par HfO2 couche de contrôle des défauts.
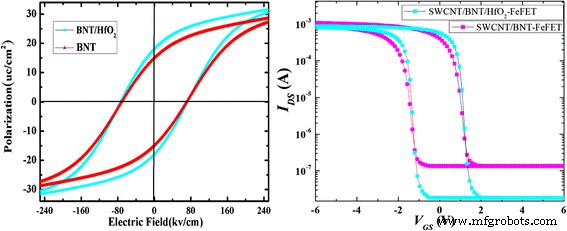
Simulation de a P -E boucles d'hystérésis de BNT et BNT/HfO2 films et b Je DS -V GS courbe pour le SWCNT/BNT/HfO2 -FeFET et SWCNT/BNT-FeFET
Conclusions
En résumé, l'effet de HfO2 matériaux en tant que couche de contrôle des défauts sur le rapport de courant marche/arrêt, les performances d'endurance à la fatigue et la rétention de données des SWCNT/BNT-FeFET ont été étudiés, dans lesquels les défauts du film mince ferroélectrique sont contrôlés par HfO2 comme couche de contrôle des défauts. En raison de la fine couche de contrôle des défauts de HfO2 , le SWCNT/BNT/HfO2 fabriqué -FeFET montre un faible courant de fuite de 1,2 × 10 −9 A lorsque la tension atteint − 3 V, un rapport de courant marche/arrêt important de 2 × 10 5 , un V ème de 0,2 V et un μ de 395 cm 2 /Vs. De plus, le SWCNT/BNT/HfO2 -FeFET a montré d'excellentes performances d'endurance à la fatigue et une bonne rétention des données qui sont attribuées au mince HfO2 couche de contrôle des défauts. Les boucles d'hystérésis P -E et Je DS -V GS courbe pour le SWCNT/BNT/HfO2 -FeFET et SWCNT/BNT-FeFET ont été simulés pour comprendre comment les défauts influencent les caractéristiques physiques de l'appareil. Les résultats de la simulation ont en outre démontré que la charge asymétrique peut être réduite dans SWCNT/BNT/HfO2 -FeFET par HfO2 pour contrôler les défauts.
Abréviations
- BNT :
-
(Bi,Nd)4 Ti3 O12
- FeFET :
-
Transistors ferroélectriques à effet de champ
- MWCNT :
-
CNT à parois multiples
- PLD :
-
Dépôt laser pulsé
- SWCNT :
-
Nanotube de carbone monoparoi
Nanomatériaux
- Des articles récents détaillent l'évolutivité des nanotubes de carbone, les avancées en matière d'intégration
- Fil de nanotubes de carbone, muscle et feuilles transparentes
- Contrôle complet de la polarisation térahertz avec bande passante élargie via des métasurfaces diélectriques
- Caractéristiques de commutation résistive bipolaire des dispositifs RRAM à structure tricouche HfO2/TiO2/HfO2 sur des substrats revêtus de Pt et de TiN fabriqués par dépôt de couche atomique
- Transistors multicouches à effet de champ SnSe Nanoflake avec contacts Au Ohmic à faible résistance
- Caractéristiques d'alignement interfacial, électrique et de bande des piles HfO2/Ge avec une couche intermédiaire de SiO2 formée in situ par dépôt de couche atomique amélioré par plasma
- Diélectrophorèse assistée par chauffage pour film de nanotubes de carbone à paroi unique alignés de très haute densité
- Nanosphères de carbone monodispersées à structure poreuse hiérarchique comme matériau d'électrode pour supercondensateur
- Conception de matériaux de nanotubes de carbone soignés et composites par caractérisation porosimétrique



