Commutation analogique et comportement synaptique artificiel du dispositif Ag/SiOx:Ag/TiOx/p++-Si Memristor
Résumé
Dans cette étude, en insérant une couche tampon de TiOx entre le SiOx :Couche d'Ag et l'électrode inférieure, nous avons développé un dispositif memristor avec une structure simple de Ag/SiOx :Ag/TiOx /p ++ -Si par un procédé de dépôt physique en phase vapeur, dans lequel la croissance et la rupture du filament peuvent être efficacement contrôlées pendant la commutation analogique. Les caractéristiques synaptiques du dispositif memristor avec une large gamme de changement de résistance pour la modulation de poids en mettant en œuvre des trains d'impulsions positifs ou négatifs ont été largement étudiées. Plusieurs fonctions d'apprentissage et de mémoire ont été réalisées simultanément, notamment la potentialisation/la dépression, la facilitation des impulsions appariées (PPF), la plasticité à court terme (STP) et la transition STP à LTP (plasticité à long terme) contrôlée par des impulsions répétées plus qu'une opération de répétition, et la plasticité dépendante du temps de pointe (STDP) également. Sur la base de l'analyse des caractéristiques logarithmiques I-V, il a été constaté que l'évolution/dissolution contrôlée des filaments d'Ag conducteurs à travers les couches diélectriques peut améliorer les performances du dispositif de test à memristor.
Introduction
En 2008, le concept théorique de memristor du professeur Chua [1] est devenu une réalité lorsque Strukov et al. ont publié leurs études sur la relation entre le flux magnétique et la charge dans un TiO2 -basé sur deux terminaux compacts pour la première fois [2], ce qui a suscité l'intérêt des chercheurs du monde entier. Outre diverses applications potentielles allant des opérations logiques et des systèmes de radiofréquence reconfigurables aux applications de mémoire non volatile [2,3,4], les memristors ont également été étudiés pour émuler les fonctions biosynaptiques en raison de leur structure et de leur dynamique de travail similaires. De nos jours, il est largement admis que l'émulation directe des fonctions synaptiques dans un appareil électronique est cruciale pour le développement de systèmes informatiques neuromorphiques inspirés du cerveau [5,6,7]. Cependant, les synapses électroniques de conception traditionnelle reposent sur des technologies complémentaires métal-oxyde-semiconducteur (CMOS), qui souffrent de l'effet de goulot d'étranglement von Neumann en termes de processus d'exécution compliqué de calcul, de limites de densité d'intégration et de dissipation d'énergie. Par conséquent, l'utilisation d'un dispositif réglable à deux bornes a insufflé de nombreuses opportunités prometteuses pour développer de nouvelles structures pour les synapses électroniques, qui résultent des propriétés uniques des memristors avec des caractéristiques non volatiles, une taille nanométrique, une faible consommation d'énergie, une réponse plus rapide, etc. . [8, 9].
Récemment, divers matériaux (par exemple, des oxydes métalliques comme le ZnO2 , WOx , SnOx [10, 11], des chalcogénures comme Cu2 S, Ag2 S [12, 13], et des matériaux ferroélectriques comme La2 O3 , Pb0,8 Ba0.2 ZrO3 [14, 15]) ont été étudiées pour la conception et la fabrication de dispositifs à memristor. Pour de nombreux appareils, le changement de résistance est attribué à la migration induite par le champ de lacunes d'oxygène ou d'ions métalliques (par exemple, Ag + , Cu 2+ , et Al 3+ ) et la formation d'un chemin hautement conducteur. Le chemin conducteur dans les memristors est généralement appelé «filament conducteur (CF)», qui pourrait par la suite être rompu lors d'une opération de commutation. En général, deux types de comportements de commutation ont été observés dans les memristors, à savoir, brusque (commutation numérique) et progressif (commutation analogique). Le changement brusque de résistance est cohérent avec le signal numérique (0 ou 1), ce qui est bénéfique pour le stockage des informations [16, 17].
Contrairement à la commutation numérique, l'accordabilité continue de la conductance dans les memristors présente certaines similitudes avec une synapse biologique, qui est l'unité cellulaire de base pour les fonctions d'apprentissage et de mémoire dans le cerveau humain [18]. Dans plusieurs dispositifs memristor, les changements de conductance analogique utilisés pour émuler la modulation de poids des synapses biologiques ont été réalisés [19, 20]. Ag diffusif dans a-Si et memristors à base d'oxyde avec Pt/a-Si:Ag/Pt et Pt/SiOx Ny :Les structures Ag/Pt ont réussi à imiter le Ca 2+ ou Na + dynamique dans les bio-synapses [21, 22]. De même, des filaments d'ions d'oxygène/lacunes dans des memristors à base d'oxyde métallique ont également été proposés pour réaliser des fonctions synaptiques, notamment la potentialisation à court terme (STP) et la facilitation d'impulsions appariées (PPF) [23, 24]. Cependant, les règles d'apprentissage biologique sont diverses, et jusqu'à présent, toutes les fonctions synaptiques n'ont pas été impliquées dans les modèles memristor [16].
Outre la sélection des matériaux, le contrôle de la croissance et de la rupture des filaments en insérant une couche diélectrique supplémentaire dans la structure « métal/couche memristive/métal » offre certains avantages pour émuler les fonctions synaptiques, notamment STP et LTP ainsi qu'une faible consommation d'énergie. Récemment, afin de contrôler le taux de formation/rupture de filament conducteur, Wang et al. [25] ont démontré le comportement de commutation analogique en insérant un SiO2 couche dans un TaOx -basé memristor. Wan et al. [26] ont également réalisé la commutation analogique et les fonctions STP et STDP émulées en insérant une couche d'oxyde de graphène réduite dans la structure de Ag/SrTiO3 /FTO memristor pour contrôler la prolifération des filaments Ag. De plus, il a été rapporté [27, 28] que sur la base de la connaissance de TiOx matériau à constante diélectrique élevée (~40) et à faible bande interdite (~3 eV), les performances du dispositif memristor en termes d'endurance de cycle et d'uniformité ont été améliorées notamment par l'insertion d'un TiO2 fine couche avec le HfO2 couche memristive. En dehors de cela, il a été rapporté [24] qu'en raison de la faible mobilité des ions et de la faible vitesse de réaction redox, le TiOx le film mince peut également agir comme une couche tampon pour empêcher la prolifération du filament conducteur, permettant un meilleur comportement synaptique et gardant un bon contact du filament conducteur pendant les processus de commutation résistive.
Dans cet article, nous rapportons une nouvelle structure de Ag/SiOx :Ag/TiOx /p ++ -Si memristors et leurs comportements de commutation analogique. Par rapport à un dispositif monocouche qui a été rapporté précédemment [22, 29], il a été constaté que l'insertion d'un TiOx couche comme indiqué dans la structure ci-dessus affecte le comportement de commutation du dispositif memristor en termes d'agrandissement de la fenêtre de conductance et de maintien d'un état stable pendant les processus de commutation. De plus, la conductance du dispositif à memristor peut facilement être réglée sous des trains d'impulsions positifs et négatifs, respectivement. Nos résultats récents démontrent que nous avons obtenu avec succès une commutation analogique fiable et des fonctions biosynaptiques consciencieusement émulées telles que la plasticité à court et à long terme (STP et LTP), la fonction de facilitation d'impulsions appariées (PPF), la plasticité dépendante du temps de pointe ( STDP) ainsi que la transition STP vers LTP en Ag/SiOx :Ag/TiOx /p ++ -Si memristor.
Méthodes
- je.
Fabrication de l'appareil :comme le montre la figure 1a, notre memristor a été conçu comme Ag/SiOx :Ag/TiOx /p ++ -Si structure. Le p ++ -Substrats Si (15 × 15 mm 2 ) avec une résistivité d'environ 0,01 Ω cm ont été nettoyés par une méthode standard, puis les dispositifs ont été fabriqués dessus. Tous les processus suivants ont été effectués à température ambiante dans un système à vide poussé. Tout d'abord, une couche d'oxyde de titane d'environ 10 nm d'épaisseur a été déposée sur p ++ -Substrats Si par pulvérisation cathodique magnétron RF utilisant une céramique de haute pureté TiO2 cibler. Ensuite, un SiOx d'environ 95 nm d'épaisseur :La couche d'Ag a été déposée par co-pulvérisation RF à l'aide d'un SiO2 cible avec de petites tranches d'Ag placées sur le chemin de pulvérisation magnétique. Au cours du processus de dépôt, le débit et la pression d'Ar ont été maintenus à 50 sccm et 20 mTorr, respectivement, tandis que la puissance RF a été maintenue à 80 W. Enfin, l'électrode supérieure (TE) d'une couche d'Ag d'environ 30 nm d'épaisseur a été modelée grâce à une technique de photolithographie et de lift-off dans laquelle les fines couches métalliques ont été déposées en utilisant la pulvérisation cathodique magnétron DC. Le diamètre de l'électrode individuelle est d'environ 150 μm.
- ii.
Méthodes de caractérisation :des mesures de microscopie électronique à transmission (MET) et des analyses de spectroscopie photoélectronique à rayons X (XPS) ont été effectuées pour analyser la microstructure de SiOx :Ag et TiOx couches et l'état chimique des atomes d'Ag, respectivement, dans lesquels l'échantillon MET a d'abord été réalisé en utilisant un faisceau d'ions focalisé (FIB, FEI Nova Nano Lab 200) puis observé sous un système FEI Phillips CM10-Supra TEM. Les caractérisations électriques ont été réalisées avec un analyseur de semi-conducteurs (Keithley 2636B) connecté à une station sonde. Lors de la mesure électrique, les polarisations positives et négatives ont été définies par le courant circulant entre l'électrode supérieure et celle du bas. Toutes les mesures électriques ont été effectuées à température ambiante dans l'air.

Schéma du Ag/SiOx :Ag/TiOx /p ++ -Dispositif de memristor Si et son analyse MET en coupe transversale. un Illustration schématique du dispositif et analogie entre la synapse biologique et la synapse électronique. b Vue MET en coupe transversale d'une seule unité de memristor Ag/SiOx :Ag/TiOx /p ++ -Si structure. Le SiOx :Ag et TiOx films minces pris en sandwich entre Ag TE et p ++ -Électrodes Si BE. c La cartographie élémentaire de la section transversale de l'appareil
Résultats et discussion
Un schéma de l'appareil et de la configuration de mesure est décrit sur la figure 1a. L'appareil a une structure simple constituée de SiOx :Ag et TiOx couches minces prises en sandwich entre un Ag TE et un p ++ -Si BE qui est confirmé par le TEM en coupe transversale de la cellule memristor et la cartographie élémentaire montrée sur les Fig. 1b et c. L'état chimique des atomes d'Ag à la surface de SiOx est analysé par XPS, comme indiqué dans le fichier supplémentaire 1 :Figure S1. Le spectre Ag3d pour Ag est déconvolué en un seul doublet avec des énergies de liaison de 368,0 eV pour Ag3d5/2 et 374,0 eV pour Ag3d3/2 , qui sont précisément attribués à l'état métallique Ag. L'image HRTEM dans le fichier supplémentaire 1 :la figure S2 montre une coupe transversale du TiO amorphex couche, tandis que les petits nanoclusters Ag sont visibles dans SiOx :Couche d'Ag, qui est probablement causée par la diffusion externe d'Ag au cours du processus de préparation de l'échantillon MET pour minimiser l'énergie interfaciale totale du système matériel [22]. De plus, la transformée de Fourier rapide (FFT) confirme que les nanoclusters d'Ag intégrés dans SiOx ont une structure polycristalline, tels que les nanocristaux Ag (111) et Ag (002). Dans le Ag/SiOx :Ag/TiOx /p ++ -Si memristor dispositif, l'Ag/SiOx :Ag et le TiOx /p ++ -Si comme la membrane pré-synaptique et la membrane post-synaptique, respectivement, comme illustré sur la Fig. 1a. Le poids synaptique change via la libération de Ca 2+ ou Na 2+ ions dans un espace entre les membranes pré- et post-synaptiques appelé "fente" par la membrane pré-synaptique lorsque les impulsions neurales sont reçues. De même, la conductance de l'Ag/SiOx :Ag/TiOx /p ++ -Le dispositif de memristor Si peut être modulé artificiellement en tant que synapse électronique grâce à la migration d'ions Ag sous les impulsions de tension.
La figure 2a montre la courbe courant-tension (I-V) de Ag/SiOx :Ag/TiOx /p ++ -Si memristor dispositif dans l'échelle semilogarithmique. Sous le biais de balayage de 0 V → +4,0 V → -4,0 V → 0 V, la courbe I-V mesurée montre une boucle d'hystérésis pincée, qui est une empreinte digitale d'un memristor. Lorsqu'un biais positif est appliqué à l'Ag TE, une augmentation progressive du courant jusqu'à la limite de courant de conformité (Icc ) se produit et l'état de résistance de l'appareil passe d'un état à haute résistance (HRS) à un état à faible résistance (LRS), appelé processus « SET ». Alors que, lorsqu'une polarisation négative est appliquée à l'Ag TE, une diminution du courant se produit et l'état de résistance est renvoyé à HRS à partir de LRS, ce qui est appelé processus de « RESET ». Il indique que la conductivité de l'appareil peut être modulée en conséquence avec une polarisation de balayage positive ou négative, montrant un comportement de commutation résistive bipolaire. Au lieu d'une augmentation ou d'une diminution brutale du courant pendant les processus SET et RESET à un régime de haute tension, il est très intéressant de noter que le courant de l'appareil augmente ou diminue consécutivement sous le balayage de tension répété de 0 V → +2,1 V ou 0 V → -2,1 V, comme le montre la figure 2b. La relation du courant et de la tension en fonction du temps (I-V-t) est également tracée dans l'encart de la figure 2b pour montrer plus clairement les changements de conductance. Comme dans une bio-synapse, une réponse évidente du dispositif de l'évolution descendante ou montante ou descendante du courant est observée après la mise en œuvre de parties consécutives positives (1er-5e) et négatives (6e-10e) des courbes I-V, respectivement. L'augmentation (ou la diminution) continue du courant pendant les balayages de tension positifs (ou négatifs) indique que la résistance de l'appareil peut être modulée par le mode de balayage CC. Il est également observé que lors de chaque balayage positif ou négatif suivant, la courbe I-V sélectionne où le dernier est laissé de côté, montrant une caractéristique de commutation analogique typique pour un dispositif memristor. Les performances d'endurance du dispositif memristor peuvent être évaluées en mettant en œuvre une tension de balayage bipolaire plus large à une tension de lecture de +0,3 V, comme sur la figure 2c, montrant que le dispositif peut être utilisé de manière stable et uniforme entre LRS et HRS pendant le réglage/la réinitialisation. opération sur 10 3 cycles.

Caractéristiques I–V de l'Ag/SiOx :Ag/TiOx /p ++ -Si memristor dispositif. un Comportement de commutation bipolaire b Potentiation ou dépression par répétition des balayages de tension. L'encart montre la relation tension et courant en fonction du temps (V-I-t), démontrant l'état de conductance pendant la potentialisation ou la dépression. c Test de performance de cyclage d'endurance à une tension de lecture de -0,3 V pour 10 3 cycles d'une gamme plus large de balayages bipolaires de 0 à +4,0 V pour le réglage et de 0 à -4,0 V pour la réinitialisation. d Propriétés répétées de la modulation de conductance
Le dispositif à memristor peut également fonctionner sous les signaux d'impulsion plutôt que sous la tension de balayage de polarisation continue. La figure 2d montre la réponse du dispositif sous forme de potentialisation ou de dépression après la mise en œuvre d'impulsions répétitives de potentialisation (biais positif) et d'abaissement (biais négatif). Les amplitudes des impulsions de potentialisation et d'abaissement sont respectivement de +1,2µV et -1,2µV, et toutes les largeurs et intervalles d'impulsions sont fixés à 5µms. Ici, la modulation de conductance dans le dispositif est observée indépendamment du biais d'impulsion positif ou négatif, qui est similaire à la réponse synaptique sous forme de potentialisation ou de dépression sous le stimulus potentialisateur et déprimant, respectivement. Il est évident que la réponse de l'appareil peut être ajustée d'un cycle à l'autre en fonction du nombre d'impulsions de stimulation, indiquant qu'une potentialisation et une dépression stables et uniformes au-delà de la polarité du biais appliqué peuvent être utilisées pour émuler l'ajustement du poids et la mémoire. rehaussement dans une synapse électronique [30].
Pour la compréhension du comportement de commutation, les mécanismes de conduction sont analysés en ajustant les caractéristiques I-V. A cet effet, un SiOx autonome :Memristor à couche mince d'Ag avec la structure Ag/SiOx :Ag/p ++ -Si est également fabriqué. Comme le montre la figure 3a, la réponse du dispositif aux balayages de tension quasi-CC indique un comportement de commutation de seuil typique, comme indiqué précédemment [29, 31]. Les directions des flèches montrent que l'appareil peut être cyclé entre les deux états en tant que mémoire volatile. Cependant, la courbe I-V de Ag/SiOx :Ag/TiOx /p ++ -Le dispositif Si memristor montre que la situation est assez différente de celle du SiOx autonome :Dispositif memristor à base d'Ag. La figure 3b montre que le dispositif présente des comportements de commutation bipolaire dans l'aspect du LRS et du HRS sous la partie positive et négative de la courbe I-V, alors que les tensions de fonctionnement sont relativement plus élevées. La figure 3c montre la courbe I-V de Ag/SiOx :Ag/TiOx /p ++ -Si memristor dispositif, qui est monté comme Ln(I) par rapport à Ln(V) des données de région positive pour HRS et LRS. Ces résultats d'ajustement montrent que le comportement de transport de charge à HRS est cohérent avec un mécanisme classique de conduction limitée à charge spatiale contrôlée par piège (SCLC), qui se compose de trois parties comme la région ohmique (I/V), la région de la loi de Child (I/ V 2 ), et la région d'augmentation de courant abrupte [32]. Alors que le comportement linéaire au LRS, où la pente est = 1, indique un excellent comportement ohmique, comme le montre la figure 3c. Les différents comportements de conduction à HRS et LHR sont mis en évidence par la formation d'un filament d'Ag conducteur à LRS [32]. La figure 3d soutient en outre que la commutation résistive est causée par la formation/rupture de filament conducteur. On peut voir que si le LRS de l'appareil est indépendant de la taille de la cellule de l'appareil, le HRS de l'appareil est proportionnel à la taille de la cellule. Cette propriété indépendante de la taille au LRS a généralement été observée dans les dispositifs de mémoire à filament conducteurs [33]. Par conséquent, on peut conclure que le phénomène de commutation résistive dans Ag/SiOx :Ag/TiOx /p ++ -Le dispositif de memristor Si provient généralement de la formation/rupture contrôlée de filament conducteur sous la tension de polarisation positive/négative. Les changements graduels de conductance pourraient résulter de la variation de l'écart transversal entre TE et BE sous le champ électrique de manière similaire à d'autres rapports [34]. Ainsi, la résistance totale de l'appareil peut être décrite comme R =Rij =V/I selon le circuit équivalent, où Rij est défini comme la résistance liée à la taille de l'écart latéral de CF entre TE et BE. Par conséquent, si cet écart peut être ajusté en modulant la taille Ag CF entre TE et BE en utilisant un biais programmé de manière appropriée, alors la conduction ou la résistance du dispositif memristif peut être ajustée progressivement.

Analyse du mécanisme de conduction Ag/SiOx :Ag/p ++ -Si et Ag/SiOx :Ag/TiOx /p ++ -Si appareils. un La courbe I-V linéaire de Ag/SiOx :Ag/p ++ -Si et b Ag/SiOx :Ag/TiOx /p ++ -Si appareil. c Les mécanismes de conduction correspondent à SCLC à HRS et Ohmic à LRS pour l'Ag/SiOx :Ag/TiOx /p ++ -Si appareil selon les résultats d'ajustement de la région positive de la courbe I-V dans (b ). d Dépendance de la zone de cellule de la conductance au LRS ou au HRS
Un modèle physique correspondant est également présenté dans la Fig. 4 pour interpréter le mécanisme de commutation dans SiO autonomex :Ag et SiOx :Ag/TiOx dispositifs à base de memristor. Le comportement des nanoparticules d'Ag dans SiOx Les cellules à base de cellules peuvent être interprétées sur la base de réactions électrochimiques (migration et accumulation d'ions Ag et d'atomes Ag) entre les électrodes bipolaires similaires à celles rapportées précédemment [22, 35]. Lorsque la tension de balayage est appliquée, les nanoparticules d'Ag se développent davantage pour combler l'écart entre les électrodes, ce qui entraîne une augmentation brutale du courant jusqu'au niveau de conformité, et le memristor est activé dans LRS (comme indiqué dans le panneau central de la Fig. 4a). Après suppression de la polarisation électrique, les nanoclusters d'Ag allongés qui ont formé le pont au début sont maintenant rapidement contractés [22], et le dispositif revient à HRS (comme indiqué dans le dernier panneau de la Fig. 3a) [35], indiquant une commutation de seuil bipolaire comportement dans un memristor qui peut être cyclé entre les deux états comme dans les dispositifs de mémoire volatile.
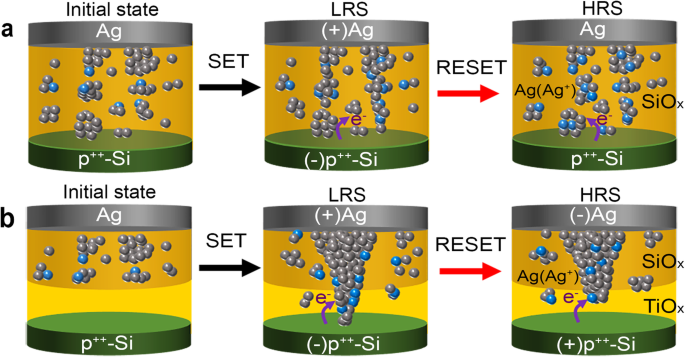
Diagramme schématique du modèle physique pour le comportement de commutation. un Ag/SiOx :Ag/p ++ -Si memristor dispositif ; b Ag/SiOx :Ag/TiOx /p ++ -Si memristor appareil
La situation est assez différente dans le cas de SiOx :Ag/TiOx -dispositif memristor, où le SiOx couche mince a une bande interdite élevée (~9 eV) et une constante diélectrique inférieure (~3), mais le TiOx couche a une faible bande interdite (~3 eV) et une constante diélectrique élevée (~40), ce qui rend le champ électrique à travers SiOx couche supérieure à celle du TiOx couche, dissolvant plus d'atomes d'Ag dans la couche de commutation [28]. C'est la faible mobilité des ions et la faible vitesse de réaction redox de l'oxyde de titane qui contrôlent la migration et l'accumulation des atomes Ag et des ions Ag à travers la couche interfaciale [36]. Ces deux faits, comme mentionné ci-dessus, peuvent provoquer la formation d'un filament en forme de nano-cône de TE à BE [37]. La région métallique concentrée sous la forme d'un confinement efficace de la croissance des filaments sous forme de nano-cône de TE à BE peut offrir un contrôle des états de résistance pendant le fonctionnement cyclique [38]. Lorsque l'électrode Ag supérieure est suffisamment polarisée positivement à travers les doubles couches, le champ électrique à travers les couches diélectriques est suffisant pour conduire les ions Ag de l'Ag TE vers p ++ -Si BE à travers la couche interfaciale, ce qui entraîne une diminution de l'écart effectif entre les électrodes (comme indiqué dans le panneau central de la figure 4b). Les filaments d'Ag ne sont pas dissous à moins qu'une tension négative ne soit appliquée et tendent à conserver leur forme d'origine même si la tension de polarisation est supprimée. Lorsqu'une tension négative est appliquée, un RESET normal commence et les Ag CFs sont partiellement détruits (généralement à l'endroit le plus mince) en raison du processus électrochimique assisté thermiquement [39]. Le dispositif memristor s'éteint et revient à HRS (dernier panneau de la figure 4b), puis bascule de manière réversible entre deux états (représentés sur la figure 3b) en tant que dispositif de mémoire non volatile. Le panneau de gauche de la figure 4b présente que les filaments formés ici doivent être plus épais que ceux du panneau central de la figure 4a, qui ne peuvent pas être dissous et rompus à moins qu'une tension négative ne soit appliquée. La partie filament dans le SiOx couche est encore beaucoup plus fine que celle de la partie nano-cône dans le TiOx couche, et la forme de l'ensemble du filament ressemble en quelque sorte à un nano-cône. Ainsi, lorsqu'une polarisation négative est appliquée, le filament se rompra rapidement lorsqu'une tension négative est appliquée (Fig. 3b), tandis que la tension sera encore augmentée et le courant est à nouveau augmenté, indiquant un risque de négatif-SET à haute polarisation plage due aux atomes d'Ag résiduels existant près de la surface de BE.
En fait, la résistance totale du memristor au HRS est simplement liée à l'écart entre la pointe du nano-cône du filament et l'électrode inférieure, qui peut être augmenté ou diminué en ajustant la polarisation électrique [33]. Cette tendance à modifier le HRS dans les memristors peut être observée sur la figure 2b, dans laquelle le courant peut être augmenté ou diminué consécutivement sous le biais de balayage répété de 0 V à +2,1 V et de 0 V à -2,1 V, respectivement. D'autre part, le balayage constant d'une tension inférieure à +2,1 V ne suffit pas à former un filament conducteur aux bornes du TE et du BE. Au lieu de cela, le filament d'Ag conducteur peut progressivement accumuler des atomes d'Ag, entraînant une diminution de l'écart effectif entre les électrodes, comme le montre le fichier supplémentaire 1 :Figure S3. Par conséquent, en utilisant un biais de programmation approprié, la transition d'une commutation de seuil typique à une commutation graduelle peut être réalisée, et la résistance totale de la cellule mémoire peut être réglée en ajustant l'écart effectif entre les électrodes tel qu'il peut être observé dans une synapse biologique.
Semblable à une bio-synapse, les stimuli d'entrée avec une programmation d'impulsions appropriée peuvent modifier les états de conductance du dispositif memristor pour effectuer plusieurs tâches neuronales. Le PPF est un autre type de caractéristique cruciale, qui peut ajuster la conductance par sommation temporelle des stimuli d'entrée et effectuer plusieurs tâches neuronales à court terme, y compris le filtrage synaptique et l'adaptation [40, 41]. La fonction PPF dans une bio-synapse fonctionne comme suit :la deuxième réponse post-synaptique devient supérieure à celle de la première au cours de deux stimuli de pointes successifs, laissant l'intervalle de temps des pointes inférieur au temps de récupération [22]. La figure 5a montre la réponse de l'appareil, qui est surveillée après la mise en œuvre d'une paire d'impulsions de facilitation à une amplitude de +2,0 V avec une largeur et un intervalle fixes nommés comme une échelle de 0,08 s. Une augmentation notable du courant en réponse à la deuxième impulsion par rapport à la première est observée, indiquant un changement apparent de l'état de conductance après la mise en œuvre d'une programmation d'impulsion appropriée. Pendant l'intervalle entre deux impulsions successives, une décroissance du courant est observée, qui peut être attribuée à l'existence de caractère volatil dans le dispositif. La décroissance de la conductance pourrait correspondre à la diffusion des atomes d'Ag après la suppression de l'impulsion de potentialisation [42]. La fonction PPF réussie ne peut être exécutée que lorsque l'intervalle de temps entre deux impulsions consécutives est inférieur au temps de relaxation de diffusion des atomes d'Ag, provoquant plus d'atomes d'Ag poussés dans le SiOx :Ag/TiOx couche. De plus, un état de saturation est atteint lorsque le dispositif est stimulé en continu avec un certain nombre d'impulsions de facilitation avec une amplitude de +2,0 V et une largeur et un intervalle fixes nommés comme une échelle de 0,08 s, comme le montre la figure 5b. Les résultats montrent que lorsque des impulsions haute fréquence sont appliquées, ce qui pompe plus d'atomes d'Ag dans le SiOx couche jusqu'à ce qu'un pont conducteur soit formé entre le TE et le BE, atteignant un niveau de saturation [22]. Ce phénomène est assez similaire à la règle d'apprentissage de Hebbian, où les changements de poids synaptique doivent avoir une valeur saturée pour éviter une excitabilité excessive des neurones avec les pointes non colorées du train d'impulsions appliquées [43].
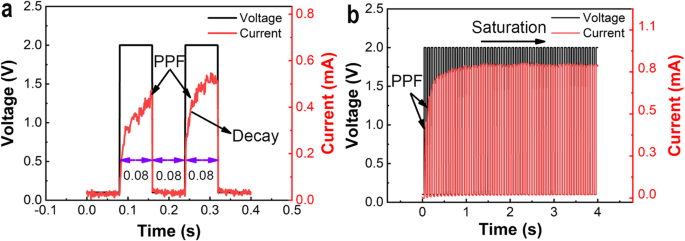
Résultats expérimentaux de la facilitation par impulsions appariées (PPF). un Implémentation de PPF sur Ag/SiOx :Ag/TiOx /p ++ -Si appareil utilisant une hauteur d'impulsion de +2,0 V avec 0,08 s. b Démonstration du mouvement du poids synaptique de la saturation en utilisant un train d'impulsions d'amplitude +2,0 V avec la même largeur et le même intervalle de 0,08 s
De plus, de la même manière que dans une synapse biologique, un memristor subira une perte de mémoire avec une diminution soudaine du courant après la mise en œuvre d'un pic de potentialisation, ce qui peut être attribué à l'existence de STP dans le memristor [44, 45]. En neurobiologie, STP et LTP sont communément appelés mémoire à court terme (STM) et mémoire à long terme (LTM) [46]. Il a été établi que la transition STP à LTP pourrait se produire à travers les stimuli répétés (c'est-à-dire un processus de répétition) [46, 47]. Afin de vérifier et de comparer ce comportement avec ceux observés dans les synapses biologiques, une séquence d'impulsions de tension a été implémentée sur notre Ag/SiOx :Ag/TiOx /p ++ -Si memristor dispositifs. La figure 6a montre l'augmentation du courant d'un état initial de 0,05 mA à 1,8 mA après mise en œuvre de 15 impulsions consécutives (amplitude +1,4 V, largeur et intervalle 5 ms). La décroissance du courant normalisé ((It -Io )/Io × 100 %) est mesurée à la tension de lecture +0,3 V immédiatement après avoir imposé des impulsions de potentialisation avec le temps (t ), comme le montre la figure 6b. La relation entre la décroissance du courant normalisée et le temps bien ajustée par la relation donnée dans l'Eq. (1) [48] :
$$ {\Delta I}_t/{\Delta I}_o\times 100\%=\exp \left[-{\left(t/\tau \right)}^{\beta}\right] $$ ( 1)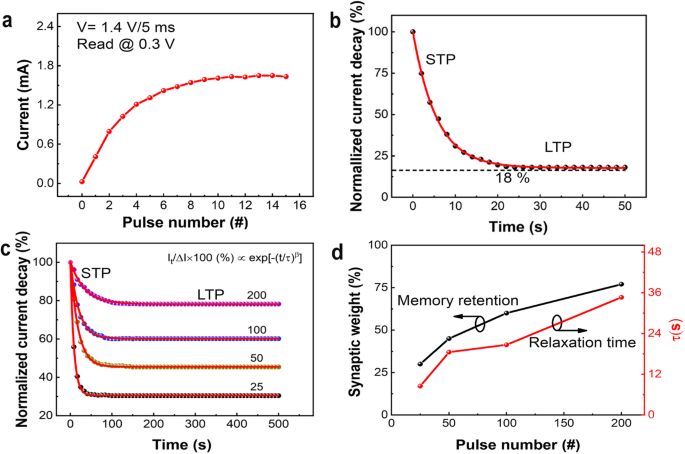
Décroissance actuelle et rétention de mémoire dans Ag/SiOx :Ag/TiOx /p ++ -Si memristor. un Augmentation du courant après mise en oeuvre de 15 impulsions identiques de potentialisation consécutives. b La décroissance du courant est surveillée à une tension de lecture de +0,3 µV après stimulation de l'appareil. c La décroissance du courant normalisé en fonction du temps montrant la transition de STP à LTP après la mise en œuvre des trains d'impulsions du nombre de stimulations. d Le temps de rétention et de relaxation de la mémoire (τ ) pour pulser des nombres
ici, τ est appelé temps de relaxation, et β est appelé l'indice d'étirement (0 <β <1). Généralement, cette relation est utilisée pour décrire les processus de relaxation dans les matériaux désordonnés avec une distribution aléatoire des énergies. La courbe montre que la décroissance du poids synaptique est similaire à la "courbe d'oubli" de la mémoire humaine en psychologie [49], qui présente une décroissance rapide au début qui pourrait être appelée STP, puis atteint progressivement un niveau stable qui pourrait être appelé LTP dans l'appareil. Cependant, une décroissance évidente du courant normalisé dans l'appareil est observée dans un intervalle de temps très court (t ) puis atteint un niveau de saturation à un état de faible conductance (jusqu'à 16% en 50µs). Dans cette situation, sans aucune autre modification des paramètres d'impulsion, nous avons effectué un autre processus de simulation avec un nombre répété d'impulsions. The current is measured at a read voltage of +0.3 V immediately after imposing different numbers of pulses (i.e., 25, 50, 100, and 200) from the same initial state for each set of pulse trains. Figure 6c shows that the normalized current decay with time in each set of measurements is fitted by the relation given in Eq. (1). Figure 6d shows that by an increase of the stimulation number, the relaxation time (τ ) increases, indicating forgetting process fades slowly. Meanwhile, an obvious elevation of the current level is observed, implying a positive change in synaptic weight (conductance), as shown in Fig. 6d by the black line. These results presented in Fig. 6 provide clear evidence of the existence of STP and LTP in our device. A smaller number of stimulations can only induce STP in the device, with a slight rise in conductance at saturation level. Therefore, by increasing the number of repetitive stimulations, the rehearsal process not only rises a conductance level but also is achieved a long-lasting memory retention phenomenon, as shown in Fig. 6d by the red line.
The conventional digital-type memories require the non-volatility to store the information, while in bio-synapse, information processes and accordingly reconfigures the memory status. It can be seen in Fig. 6 that the transition from STP to LTP is realized, and the synaptic weight is adjusted accordingly, while the unimportant ones with small synaptic weight are temporarily stored and then diminished with time. This phenomenon is quite similar to the “multi-store model” presented by Atkinson and Shiffrin [50]. In this model, first input information is analyzed, then stored in different hierarchy levels, according to the importance of “synaptic weight” through the rehearsal process. Therefore, an increase in synaptic weight and resultant prolonged relaxation time (τ ) in our device as a function of stimulation numbers has best verified the rehearsal scheme.
Besides the pulse repetition process, the transition of the STP to the LTP phenomenon is further examined as a function of pulse strength. The device response is monitored after implementation of different pulse amplitudes, i.e., +1.2 V, +1.6 V, +2.0 V, and +2.8 V with similar width and interval scale of 3 ms, as shown in Fig. 7a. The current is monitored with a readout voltage of +0.3 V after imposing each pulse train consisting of 50 pulses. The fitted results with the stretched exponential relaxation model in Fig. 7a shows that the relaxation time is increased as a function of pulse strength (as shown in Fig. 7b red line). Meanwhile, as shown in Fig. 7b, an elevation of the synaptic weight of about 90% is observed at a larger τ of 43 s and +2.8 V amplitude, which is much higher than the synaptic weight of about 25% at a smaller τ of 10 s and +1.2 V amplitude (as shown in Fig. 7b black line), indicating the formation of LTP. Based on these results, it is easy to find that the formation and persistence of LTP in our device are highly dependent on both pulse numbers or pulse amplitude. These results coincide with the facts that the memory states, i.e., STM and LTM, and their stabilities in bio-synapses are related to the input stimulus characteristics.
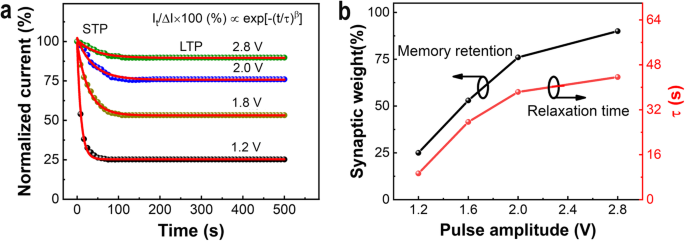
Experimental results of current decay in Ag/SiOx :Ag/TiOx /p ++ -Si memristor device after the stimulation process. un The normalized current decay versus time showing the transformation from STP to LTP; b The memory retention and relaxation time (τ ) as a function of the pulse amplitude
The spike-time-dependent-plasticity (STDP) is another fundamental character for learning and memory function [51] in a biological synapse. It has been reported [52] that in the electronic synapse, the weight can be modulated by a relative timing of pre- and post-synaptic pulses. The Hebbian STDP rule works as follows:if the pre-spike precedes the post-spike (Δt> 0), it could reinforce the connection strength between two neurons. In contrast, if the post-spike heads the pre-spike (Δt <0), it could weaken the connection strength between two neurons. Such kinds of reinforcement and weakening of connection strength between two neurons are also called LTP and LTD, respectively [45]. In the whole process, the order of pre- and post-spikes with respect to time determines the weight change (ΔW) polarity. In order to emulate the STDP rule in our device, a pair of pulses (+1.2 V, 5 ms, and −1.2 V, 5 ms) as pre- and post-spiking signals are implemented, as shown in Fig. 8a. It can be seen that there will emerge a more considerable conductance change (synaptic weight) with the decrease of Δt (in both cases when Δt> 0 and Δt <0). The percentage change in synaptic weight is defined as ΔW =(Gt −G0 )/G0 × 100%. Here, G0 is the conductance measured before stimulation and Gt is the conductance measured after the stimulation using pre- and post-spiking pairs, respectively. A plot is shown in Fig. 8b, that can explain the relationship between ΔW and Δt before and after the simulation process. It can be seen that when the pre-synapse (positive) appears before the post-spike (negative) (Δt> 0), the conductance is enhanced with an increase in ΔW along with the decrease in Δt. On the contrary, when the pre-synapse (positive) appears after the post-spike (negative) (Δt <0), the net conductance of the device is decreased (depressed) in ΔW along with the increase in Δt. These results have demonstrated that our Ag/SiOx :Ag/TiOx /p ++ -Si memristor device has successfully emulated the Hebbian STDP learning rule in the form of an artificial synapse.
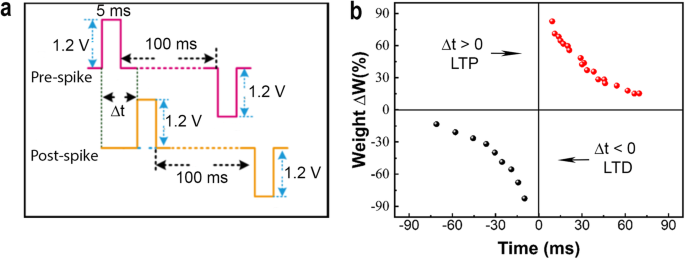
Experimental results for implementation of STDP rule in Ag/SiOx :Ag/TiOx /p ++ -Si memristor device. un The schematic illustration of implementing electrical programming bias comprising the pair of pulses at amplitudes +1.2 V and −1.2 V fixed with the same width of 5 ms. The approaching time difference between stimulus pulses is Δt ms (t =±10n, n =1, 2, …, 10); b The synaptic weight (ΔW) as a function of spike timing (Δt), demonstrating well on the potentiation and depression behaviors in the memristor device
Conclusions
In summary, a new kind of memristor device with the simple structure of Ag/SiOx :Ag/TiOx /p ++ -Si has been fabricated by a physical vapor deposition process. The synaptic characteristics of the memristor with a wide range of resistance change for synaptic weight modulation by implementing positive or negative pulse trains have been investigated extensively. Several crucial learning and memory functions have been demonstrated simultaneously in such a single fabricated memristor device, including short-/long-term potentiation and depression (STP/STD, LTP/LTD), PPF and the STP-to-LTP transition as well as STDP, which are adjusted and controlled by repeating pulses more than a rehearsal operation. Furthermore, the analysis of logarithmic I-V characteristics with corresponding physical model indicates that the controlled formation/dissolution of Ag-filaments across the Ag and p ++ -Si electrodes could improve the performance of the new Ag/SiOx :Ag/TiOx /p ++ -Si memristor device with a buffer layer of TiOx between the SiOx :Ag layer and the bottom electrode. This developed device, as an artificial synapse, might bring a potential research prospect in the design and hardware implementation of new-generation biomimetic neural networks and computing systems.
Disponibilité des données et des matériaux
Toutes les données sont entièrement disponibles sans restriction.
Abréviations
- BE :
-
Bottom electrode
- HRS :
-
État de haute résistance
- I-V :
-
Courant-tension
- LRS :
-
État de faible résistance
- LTM:
-
Long-term memory
- LTP :
-
Long-term plasticity
- PPF:
-
Paired-pulse-facilitation
- SCLC :
-
Space-charge limited conduction
- STDP:
-
Spike-time-dependent-plasticity
- STM :
-
Short-term memory
- STP:
-
Short-term plasticity
- TE :
-
Top electrode
- TEM :
-
Microscopie électronique à transmission
- XPS :
-
Spectroscopie photoélectronique aux rayons X
Nanomatériaux
- Signaux analogiques et numériques
- Types de capteurs analogiques et numériques avec applications
- Double fonction du périphérique V/SiOx/AlOy/p++Si comme sélecteur et mémoire
- Effets des variations de gravure sur la formation de canaux Ge/Si et les performances de l'appareil
- Effet des hétérostructures bicouche CeO2−x/ZnO et ZnO/CeO2−x et polarité d'électroformage sur les propriétés de commutation de la mémoire non volatile
- Absorbeur amélioré dans le proche infrarouge :silicium noir structuré fabriqué en deux étapes et son application périphérique
- Propriétés photocatalytiques sensibles à la lumière visible améliorées des composites de nanofeuillet Ag/BiPbO2Cl
- L'intelligence artificielle prédit le comportement des systèmes quantiques
- Avantages et inconvénients de l'intelligence artificielle



