Absorbeur amélioré dans le proche infrarouge :silicium noir structuré fabriqué en deux étapes et son application périphérique
Résumé
Le silicium est largement utilisé dans l'industrie des semi-conducteurs, mais a de faibles performances dans les dispositifs photoélectroniques dans le proche infrarouge en raison de sa réflectance élevée et de sa limite de bande interdite. Dans cette étude, un processus en deux étapes, une méthode de gravure ionique réactive profonde (DRIE) combinée à une implantation ionique par immersion dans le plasma (PIII), sont utilisés pour fabriquer du silicium noir microstructuré à la surface de C-Si. Ces surfaces améliorées dopées avec des éléments de soufre permettent d'obtenir une bande interdite plus étroite et une amélioration de l'absorption de la lumière, en particulier dans le proche infrarouge (800 à 2000 nm). Pendant ce temps, l'absorption maximale de la lumière augmente considérablement jusqu'à 83%. Un détecteur photoélectronique Si-PIN avec du silicium noir microstructuré à la surface arrière présente des performances de dispositif remarquables, conduisant à une réactivité de 0,53 A/W à 1060 nm. Ce nouveau silicium noir microstructuré, combinant une caractéristique de bande interdite étroite, pourrait avoir une application potentielle dans la détection photoélectronique dans le proche infrarouge.
Contexte
Jusqu'à présent, de nombreux matériaux de silicium noir micro et nanostructurés peuvent également être fabriqués en utilisant un traitement DRIE et une implantation ionique, visant à réduire la réflectance de la lumière et à améliorer l'absorbance dans le proche infrarouge [1,2,3,4,5]. Le procédé DRIE est généralement mis en œuvre dans un mode d'étapes de gravure-passivation cycliques avec un masque photorésistant qui peut permettre la microfabrication en silicium de structures à rapport d'aspect élevé. Généralement, cette approche utilise des plasmas à base de F tels que SF6 pour une gravure isotrope rapide puis passe à un cycle de passivation des flancs en utilisant C4 F8 [6,7,8]. Lors du cycle de gravure suivant, le film de passivation est préférentiellement éliminé du fond de la rainure en raison du bombardement ionique, tout en empêchant la gravure des flancs [9]. Enfin, l'alternance de cycles de gravure et de passivation pourrait former les géométries spécifiques des structures de silicium gravées, qui dépendent principalement de la taille du masque, du débit de gaz, de la puissance des électrodes, du temps de traitement, des temps de cycle, etc. Afin d'améliorer l'absorption du silicium dans le proche infrarouge, les structures de silicium gravées seront dopées par implantation ionique après procédé DRIE. Dans certaines conditions, les réseaux de silicium noir peuvent être obtenus, et les dopants de soufre résultants contenus dans le réseau de silicium finiront par provoquer une absorption significative du rayonnement inférieur à la bande interdite [10, 11].
En tant que l'un des matériaux les plus importants de l'industrie des semi-conducteurs, le silicium noir a été largement utilisé dans les détecteurs photoélectroniques sensibles, les cellules solaires, les capteurs biochimiques, les dispositifs d'affichage et les objets de communication optique [12,13,14,15,16,17,18, 19,20]. Les micro- et nanostructures de silicium noir ont fait l'objet d'intenses recherches ces dernières années en raison de leur application étendue aux dispositifs. Un détecteur photoélectronique Si-PIN avec du silicium noir à la surface avant a été étudié dans notre première étude [21]. Cette structure de dispositif a une large couche d'appauvrissement afin qu'elle puisse réduire l'influence du mouvement de diffusion des porteurs et atteindre l'objectif d'améliorer la sensibilité et la vitesse de réponse du dispositif. Il est également remarqué qu'il est très difficile d'utiliser du silicium noir comme surface photosensible pour que les porteurs générés soient collectés par la couche P pour produire un photocourant à travers l'électrode, ce qui entraîne une réponse à la lumière visible relativement faible par rapport à un détecteur Si-PIN traditionnel. Ainsi, il semble que si un détecteur photoélectronique Si-PIN avec du silicium noir à la surface arrière pouvait effectuer deux tâches à la fois, c'est-à-dire augmenter la sensibilité de l'appareil non seulement dans le proche infrarouge mais aussi dans la longueur d'onde visible ? /P>
Dans cet article, nous rapportons l'amélioration de l'absorption de la lumière et la bande interdite plus étroite caractéristique du silicium noir microstructuré fabriqué par un processus en deux étapes :DRIE combiné avec PIII. L'effet de différents processus de gravure sur l'absorption de la lumière dans la plage de longueurs d'onde de 400 à 2000 nm a été étudié, et le détecteur basé sur ce silicium noir microstructuré à la surface arrière a également été étudié en mettant l'accent sur la réactivité de l'appareil dans la longueur d'onde de 400~1100 nm.
Méthodes
Comme le montre la figure 1a, des réseaux cylindriques à distribution uniforme et périodique ont été choisis pour rechercher les propriétés optiques du silicium microstructuré par le logiciel de simulation FDTD. La figure 1b représente la relation entre l'absorbance et quatre tailles de modèle différentes du silicium microstructuré après une simulation optimisée, dans laquelle quatre modèles ont le même diamètre de cylindre (D = 4 μm) mais entraxe différent (T 1 = 12 μm, T 2 = 10 μm, T 3 = 8 μm, T 4 = 6 μm).
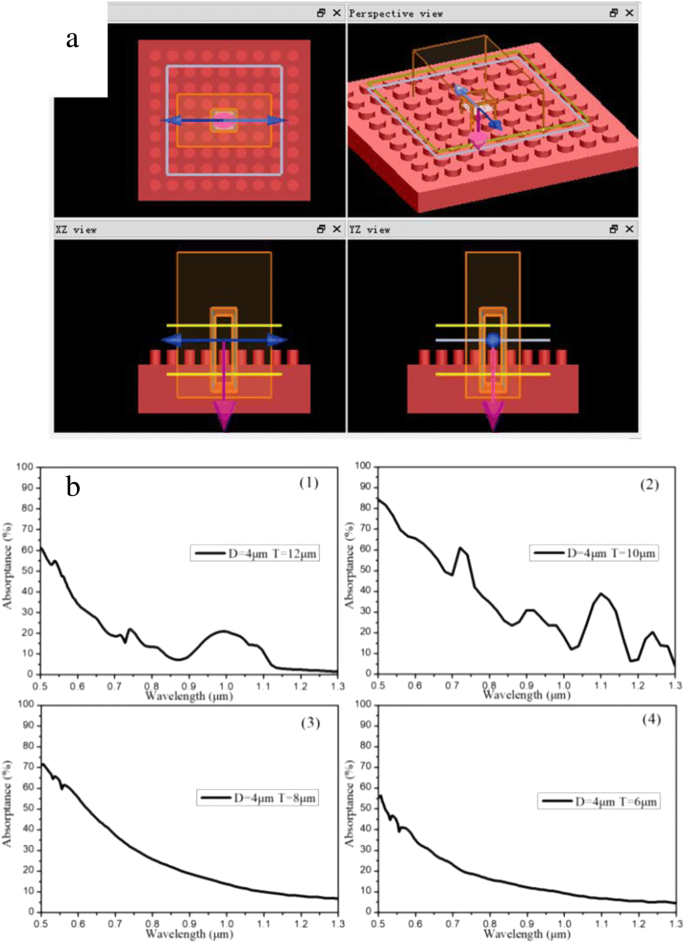
Modèle de simulation optique (a ) et les résultats de la simulation (b ) de silicium microstructuré
Comme le montre la figure 2, sur la base des résultats de simulation optimisés ci-dessus, trois masques de photolithographie différents ont été conçus en faisant varier la taille du masque nommé masque I (D = 4 μm, T = 6 μm), masque II (D = 4 μm, T = 8 μm), et masque III (D = 4 μm, T = 10 μm), respectivement. Ensuite, la résine photosensible NR9-1500PY a été appliquée pour déposer un masque de matrices circulaires sur la surface de polissage des pièces de silicium (15 × 15 cm 2 ), qui ont été découpées dans des plaquettes de silicium de type n d'une épaisseur de 500 μm et d'une résistivité de 2500 à 3000 Ω · cm. Afin d'étudier l'effet du processus de gravure sur l'absorption de la lumière du silicium microstructuré, nous avons déplacé les échantillons de test résultant du masque III dans la cavité de processus (DRIE, ICP-100D) et modifié les temps de cycle, dans lesquels SF6 a été utilisé comme gaz de gravure et C4 F8 comme gaz de passivation, pour 30 fois, 70 fois et 100 fois, différemment. Après les processus de gravure, les morceaux de silicium ont été retirés de toute résine photosensible résiduelle sous l'atmosphère d'oxygène pour garantir que la surface du silicium était propre et lisse. Afin d'améliorer l'absorbance du silicium microstructuré, en particulier dans la bande proche infrarouge, les échantillons de test résultant du masque III ci-après ont été dopés avec des éléments de soufre par procédé PIII dans la condition de 1,0E + 15 cm − 2 dose d'implantation et énergie d'implantation de 800 eV, respectivement.

Le schéma de principe de la taille du masque
Les morphologies du silicium noir ont été caractérisées par un microscope électronique à balayage à émission de champ (SEM, JSM-7500F). L'absorbance lumineuse a été obtenue à température ambiante à l'aide d'un spectromètre à fibre optique (NIR2500) équipé d'une sphère d'intégration (Idea Optics, IS-20-5). La sensibilité du détecteur a été mesurée en utilisant un wattmètre optique (OPHIR, Vega), un hacheur optique (Scitec Instruments, modèle-300CD) et un appareil Keithley2636B dans un environnement de chambre noire. Afin de garantir la précision de la mesure, nous avons effectué un étalonnage avant test et chacune de ces mesures a été réalisée sur quelques échantillons (généralement 4 à 6).
Résultats et discussion
La figure 3 donne les images SEM typiques de matrices de silicium microstructurées alignées qui sont perpendiculaires à la surface du substrat pour trois tailles de masque différentes. Il est clairement montré que la vue de dessus du silicium microstructuré n'est pas réellement des cercles standard du fait que le processus DRIE dépend principalement de la taille du masque et de la qualité de la technique de photolithographie. Ensuite, afin d'étudier l'effet du processus de gravure sur l'absorption de la lumière du silicium microstructuré, nous modifions les temps de cycle comme 30, 70 et 100 fois sur des échantillons de test du masque III dans les conditions de gravure avec SF6 pendant 3 s, et passivation avec C4 F8 pendant 2 s, à chaque cycle.
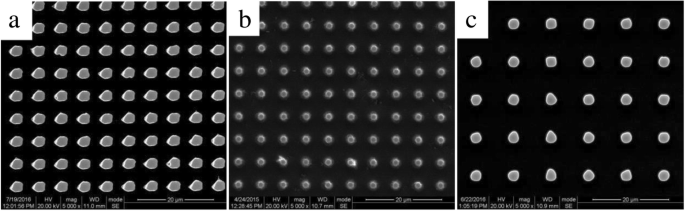
Réseaux de silicium microstructurés typiques fabriqués par DRIE pour différentes tailles de masque. un Masque I. b Masque II. c Masque III
Selon le rapport de taux de gravure différent entre la résine photosensible et le silicium, la profondeur de gravure peut être contrôlée par des paramètres de traitement tant que la résine photosensible est suffisamment épaisse comme masque. On peut voir sur la figure 4 que la hauteur des cylindres augmente avec le nombre de temps de cycle, dans lesquels la hauteur du sommet au substrat est d'environ 1,87 μm, 2,35 μm et 3,15 μm, respectivement. Il est bien connu qu'en procédé DRIE, bien qu'il existe des gaz de passivation pour protéger la paroi latérale de la cible de gravure, celle-ci s'accompagne toujours plus ou moins d'une gravure latérale. C'est la raison pour laquelle les morphologies résultantes ne sont pas des réseaux cylindriques idéaux. De toute évidence, les morphologies de ces matrices de silicium microstructurées peuvent être bien contrôlées en faisant varier le processus de lithographie et les temps de cycle de gravure.
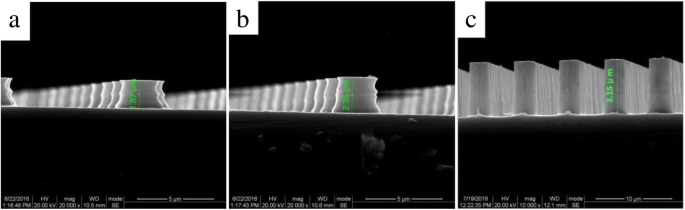
Vues en coupe d'échantillons de masque III fabriqués pour différents temps de cycle. (un ) 30, (b ) 70, et (c ) 100
La figure 5a représente l'absorption de la lumière des réseaux cylindriques microstructurés à différents temps de cycle sans processus PIII. Il est montré que le C-Si avec des matrices de silicium gravé, par rapport au C-Si ordinaire, peut améliorer l'absorption de la lumière dans toute la gamme de longueurs d'onde de 400 à 2000 nm dans une certaine mesure. L'échantillon gravé pendant 100 cycles présente l'absorbance la plus élevée, jusqu'à 70 % dans la gamme NIR (800 à 2000 nm), et l'absorbance moyenne de cet échantillon atteint 55 % dans la gamme de longueurs d'onde de 400 à 2000 nm. Cela est dû à la réflexion et à l'absorption multiples du silicium microstructuré (comme sur la Fig. 6). Au cours de la réflexion continue de la lumière incidente sur la surface latérale du cylindre, la longueur du trajet d'absorption de la lumière incidente augmente, ce qui entraîne une augmentation de l'absorbance. Néanmoins, le taux d'absorption n'est toujours pas assez élevé lorsque la longueur d'onde est supérieure à 1000 nm. Par conséquent, afin d'améliorer encore l'absorbance du silicium microstructuré, en particulier dans la bande proche infrarouge, les mêmes échantillons sont dopés avec des éléments soufrés par procédé PIII sous la condition de 1,0E + 15 cm − 2 dose d'implantation et énergie d'implantation de 800 eV, respectivement. Comme le montre la figure 5b, l'absorption de la lumière est évidemment augmentée dans la plage de longueurs d'onde de 400 à 2000 nm après l'implantation ionique. Ici, l'absorbance de la lumière de l'échantillon gravé pendant 100 temps de cycle est beaucoup plus élevée que celle du C-Si. L'absorbance lumineuse maximale et moyenne augmente de manière significative jusqu'à 83 % et 62 %, respectivement. De plus, on peut facilement observer (comme sur la Fig. 5c) que l'absorbance des échantillons de 100 cycles a un changement significatif dans la longueur d'onde de 800 à 2000 nm avant et après le dopage des éléments soufrés, dans laquelle les valeurs maximales et moyennes augmentent de 13% et 7 %, respectivement.
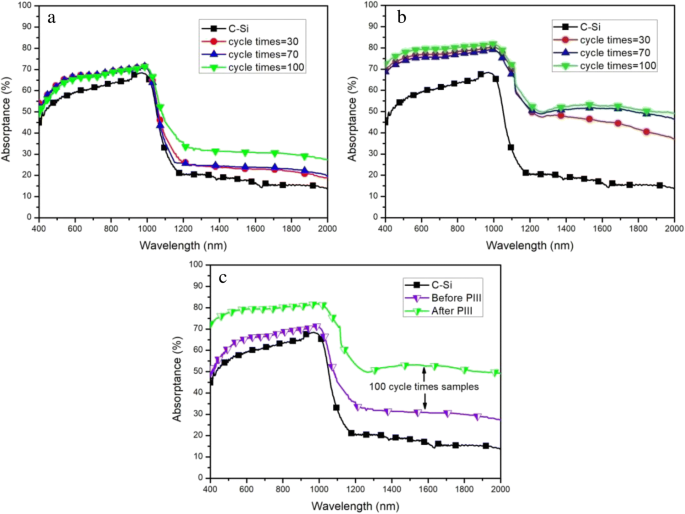
Absorption du C-Si et du silicium noir fabriqué par différents temps de cycle avant (a ) et après PIII (b ) et comparaison d'échantillons de 100 cycles (c )

Le chemin de transmission de la lumière incidente à la surface du silicium microstructuré
Cette absorptance élevée provient principalement du dopage au soufre parmi les réseaux cylindriques microstructurés, formant de multiples niveaux d'impuretés dans la structure de bande d'énergie du C-Si. En conséquence, lorsque ces multiples niveaux d'impuretés induits se chevauchent, une nouvelle bande d'impuretés se forme après élargissement, ce qui réduit finalement la bande interdite du C-Si. La bande interdite peut être obtenue à partir du spectre d'absorbance de l'échantillon par cartographie Tauc. Les étapes spécifiques adoptées sont les suivantes :
(i) le spectre de réflectance est converti en fonction K-M F (R ∞ ) en utilisant la théorie de Kubelka-Munk :
$$ F\gauche(R\infty \right)\approx \frac{A^2}{2R} $$ (1)dans lequel R et A sont respectivement le spectre de réflectance et le spectre d'absorption de l'échantillon.
(ii) La fonction K-M F (R ∞ ) est substitué dans la formule Tauc comme suit :
$$ {\left( hv\alpha \right)}^{1/n}=K\left( hv- Eg\right) $$ (2) $$ hv=\frac{1239.7}{\lambda } $$ (3)dans laquelle la valeur de l'indice n est liée au type de transition de l'échantillon :transition directe, n = 1/2 ; transition indirecte, n = 2. F (R ∞ ) est proportionnel au coefficient d'absorption α, qui peut être remplacé par F (R ∞ ), et n = 2 est substitué dans la formule (2) pour obtenir :
$$ {\left( hv F\left(R\infty \right)\right)}^{1/2}=K\left( hv- Eg\right) $$ (4)(iii) Les données spectrales de réflectance et d'absorbance de l'échantillon sont substituées dans l'Eq. (1), et l'éq. (1) est substitué dans l'équation. (4), avec hv en abscisse (X axe) et (hvF(R ∞ )) 1/2 en ordonnée (Y axe).
(iv) Le point d'inflexion (le point maximum de la dérivée première) est obtenu en calculant la dérivée première de la hv -(hvF(R ∞ )) 1/2 courbe, et la tangente de la courbe est faite à ce point. L'abscisse de l'intersection de la tangente et du X l'axe sont la bande interdite de l'échantillon.
La figure 7 montre les bandes interdites calculées finales du C-Si et du silicium noir avec différents temps de cycle. On peut facilement constater que trois bandes interdites inférieures du silicium noir, à savoir 1,045 eV, 1,033 eV et 1,025 eV, sont manifestement diminuées, respectivement, par rapport à la bande interdite de 1,12 eV du C-Si.
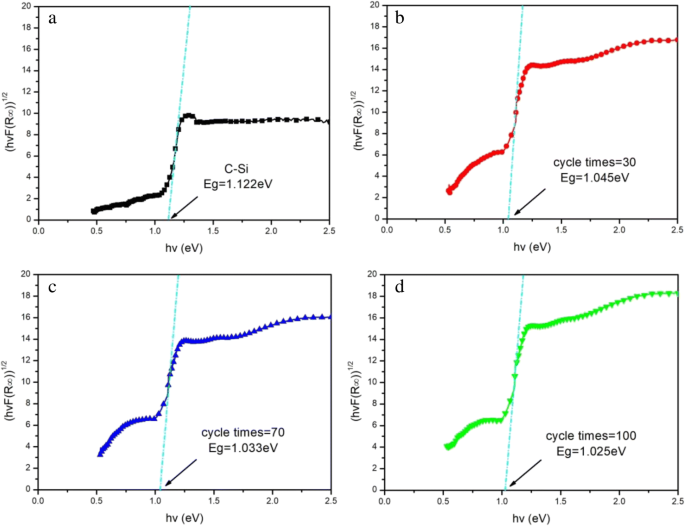
Bandes interdites de C-Si (a ) et du silicium noir obtenu par différents temps de cycle :(b ) 30, (c ) 70, (d ) 100
Sur la base du silicium noir ci-dessus avec des propriétés optiques améliorées, un détecteur Si-PIN avec du silicium noir formé sur la surface arrière a été fabriqué. Premièrement, une plaquette de silicium monocristallin intrinsèque pur (type n) est oxydée des deux côtés pour former du SiO2 couches. Deuxièmement, la couche P est fabriquée par diffusion de bore sur la région photosensible qui est formée tôt en gravant le SiO2 couche sur la surface avant de la plaquette par le processus de photolithographie. Troisièmement, une couche de Si3 N4 un film de perméation est déposé sur la couche P, puis la surface arrière de la plaquette est polie et meulée à une épaisseur d'environ 200 μm. Quatrièmement, un N + dopé P couche est déposée sur la surface meulée, puis le silicium noir microstructuré est formé sur le dessus de N + couche. Enfin, les fenêtres d'électrodes sont gravées par procédé de photolithographie et des électrodes métalliques sont déposées de part et d'autre de la plaquette. La figure 8 donne une image réelle de l'appareil (a), le courant d'obscurité (b), la courbe I-V sous un éclairage de longueur d'onde de 1060 nm (c) et la comparaison de la sensibilité de deux détecteurs différents (d). Il est déclaré par la présente que la réactivité de l'appareil 1 (S1336-44BK, un détecteur Si-PIN commercial) est retracée sur la base du site Web public de Hamamatsu Photonics Company [22], et la réactivité de l'appareil 2 est obtenue sur notre nouvellement détecteur Si-PIN fabriqué avec du silicium noir formé sur la surface arrière, dans lequel la surface photosensible était un cercle d'un diamètre de 2 mm. On peut clairement voir que l'appareil 2 effectue une augmentation substantielle de la réactivité, en particulier aux longueurs d'onde du proche infrarouge, c'est-à-dire 0,53 A/W à 1060 nm et 0,31 A/W à 1100 nm, respectivement.
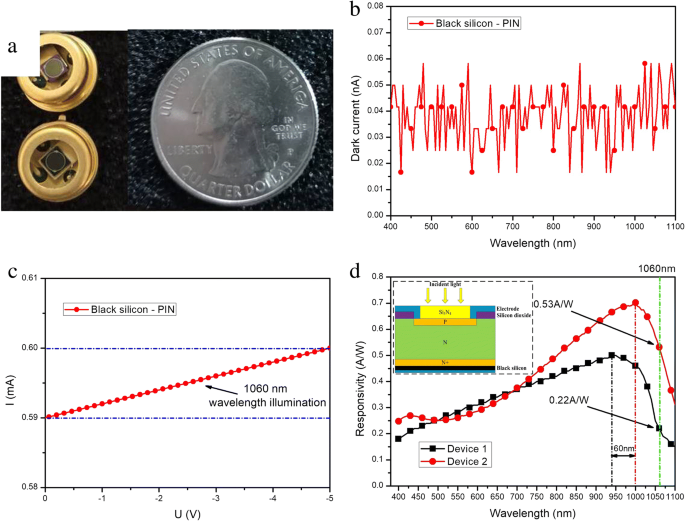
Image du détecteur (a ), courant d'obscurité (b ), courbe I-V sous un éclairage de longueur d'onde de 1060 nm (c ), et les réactivité de deux détecteurs différents (d ) :appareil 1 à partir de la réf. [22] et dispositif 2 sur la base des résultats du présent article. L'encart de d montre la structure de l'appareil
On peut voir à partir de la Fig. 8b que bien que le détecteur Si-PIN avec du silicium noir formé sur la surface arrière (dispositif 2) montre une réactivité relativement peu améliorée dans le spectre visible, le spectre de réponse de celui-ci donne une réactivité encore plus élevée dans la longueur d'onde plage de 680 à 1100 nm avec un décalage vers le rouge d'environ 60 nm de la sensibilité maximale, par rapport au détecteur Si-PIN du commerce (dispositif 1). La principale raison d'une telle distinction est que la structure des dispositifs de ces deux détecteurs (dispositifs 1 et 2) est différente. Lorsque l'énergie des photons est supérieure à la bande interdite du C-Si, la lumière incidente est principalement absorbée par la couche P et les porteurs générés ont donc suffisamment d'énergie pour traverser la couche N. La plupart des transporteurs générés peuvent être collectés par N + couche pour produire un photocourant à travers l'électrode. Dans cette condition, que la surface arrière du détecteur soit introduite avec ou sans silicium noir, il y aura une influence limitée sur la réponse du dispositif dans la longueur d'onde visible. Différent du détecteur au silicium noir en face avant [21], le dispositif 2 montre une meilleure réponse dans la longueur d'onde visible. C'est pourquoi il y a relativement peu d'amélioration de la réponse à la lumière visible selon la courbe de réactivité mesurée. Encore une fois dans le dispositif 2, parce que la couche de silicium noir est placée sur la surface arrière, même si l'énergie des photons est inférieure à la bande interdite de C-Si, la lumière proche infrarouge est capable de pénétrer la couche P et absorbée par la couche N, et alors un grand nombre de porteurs générés sont susceptibles d'être collectés par le N + couche sous l'action de la polarisation inverse. En conséquence, il y aura une sortie de photocourant dénombrable et l'appareil représente une augmentation substantielle de la réactivité dans la longueur d'onde du proche infrarouge.
D'après les résultats ci-dessus, notre présente étude pourrait fournir une stratégie réalisable pour le champ de détection photoélectronique dans le proche infrarouge, mais de nombreux aspects doivent encore être pris en compte. Par exemple, de meilleurs procédés de fabrication et technologies d'implantation ionique du silicium noir microstructuré, qui pourraient contrôler avec précision les morphologies et les bandes interdites du silicium structuré, devraient être explorés. En outre, d'autres nouvelles structures de dispositif de détecteur photoélectronique à base de silicium noir devraient être conçues afin d'obtenir de meilleures performances de dispositif.
Conclusions
En résumé, les matériaux de silicium noir microstructuré sont fabriqués par un processus en deux étapes :une gravure ionique réactive profonde combinée à une implantation ionique par immersion plasma. Les réseaux cylindriques microstructurés à la surface des plaquettes de silicium ont trois tailles différentes :masque I (D = 4 μm, T = 6 μm), masque II (D = 4 μm, T = 8 μm), et masque III (D = 4 μm, T = 10 μm), avec une hauteur de 1,87 μm, 2,35 μm et 3,15 μm, respectivement. De toute évidence, l'absorption de la lumière améliorée du silicium noir a été obtenue dans une large plage de longueurs d'onde de 400 à 2000 nm, et l'absorption de la lumière maximale et moyenne atteint 83 % et 62 %, respectivement. Ces améliorations sont largement discutées sur la base de réflexions multiples, d'une longueur de trajet d'absorption accrue et d'une bande interdite étroite. Un nouveau détecteur photoélectronique Si-PIN avec du silicium noir formé sur la surface arrière a été fabriqué, et une comparaison de la réactivité du dispositif a été effectuée avec un dispositif commercial nommé S1336-44BK. Il est conclu que notre détecteur photoélectronique Si-PIN avec du silicium noir formé sur la surface arrière a une augmentation substantielle de la réactivité, en particulier dans les longueurs d'onde du proche infrarouge, atteignant 0,53 A/W à 1060 nm et 0,31 A/W à 1100 nm , respectivement.
Nanomatériaux
- Application du molybdène métal et de ses alliages
- Comment réaliser une intégration fluide et efficace des appareils via une application mobile
- Gestion des appareils IoT et son rôle dans la facilitation des déploiements IoT à grande échelle
- L'interaction rotation-orbite de Coin Paradox améliore l'effet magnéto-optique et son application dans l'isolateur optique intégré sur puce
- États électroniques de nanocristaux dopés à l'oxygène et émission visible sur silicium noir préparés par ns-Laser
- Absorbeur parfait à bande ultra-étroite et son application en tant que capteur plasmonique dans la région visible
- A Resumable Fluorescent Probe BHN-Fe3O4@SiO2 Hybrid Nanostructure for Fe3+ and its Application in Bioimaging
- Examen de l'application du silicium noir nanostructuré
- Anticorps monoclonal héparanase marqué par nanoparticules d'or magnétique et son application ultérieure pour l'imagerie par résonance magnétique des tumeurs



