Tunneling Atomic Layer-Deposited Aluminium Oxide :une étude corrélée des performances structurelles/électriques pour la passivation de surface des jonctions de silicium
Résumé
La passivation est un processus clé pour l'optimisation des jonctions p-n du silicium. Parmi les différentes technologies utilisées pour passiver les interfaces de surface et de contact, l'alumine est largement utilisée. Un paramètre clé est l'épaisseur de la couche de passivation qui est généralement déposée en utilisant la technique de dépôt de couche atomique (ALD). Cet article vise à présenter des études structurales/électriques corrélées pour l'effet de passivation de l'alumine sur les jonctions Si afin d'obtenir une épaisseur optimale de la couche de passivation d'alumine. Des observations au microscope électronique à transmission à haute résolution (HRTEM) couplées à des mesures par rayons X à dispersion d'énergie (EDX) sont utilisées pour déterminer l'épaisseur de l'alumine à l'échelle atomique. Les paramètres électriques corrélés sont mesurés à la fois avec le simulateur solaire et le Suns-Voc de Sinton des mesures. Enfin, une épaisseur d'alumine optimale de 1,2 nm est ainsi mise en évidence.
Introduction
La réduction des pertes de recombinaison de surface dans les jonctions p-n du silicium est primordiale afin d'améliorer l'efficacité de l'absorption de la lumière et sa conversion en photocourant, avec les cellules solaires comme application principale [1, 2]. Parmi les processus clés pouvant améliorer la recombinaison des défauts dans les jonctions silicium, la passivation de la surface et des contacts a été et est toujours d'une importance primordiale. Des passivations de surface avant et arrière ont été développées, à la fois pour les régions non métallisées éclairées ainsi que pour les contacts métal-silicium [3, 4]. L'interface métal-silicium présente une grande recombinaison, ainsi deux options ont été développées pour minimiser les pertes au niveau de la zone de contact :petite surface de contact associée à un faible niveau de dopage local, ou passivation locale de l'interface métal-silicium par l'introduction d'un tunnel mince couche diélectrique. Récemment, une nouvelle voie avec un potentiel prometteur a été suggérée en utilisant une couche de passivation sélective des porteurs [5]. Dans ce cas, une polarité des porteurs de charge est autorisée à passer au métal tandis que l'autre polarité est bloquée.
Parmi toutes les couches de passivation, l'oxyde d'aluminium (Al2 O3 ) déposé par dépôt de couche atomique (ALD) est l'une des méthodes les plus utilisées, même si le procédé de dépôt chimique en phase vapeur assisté par plasma (PECVD) peut également être appliqué [6, 7]. L'ALD permet un bon contrôle de l'épaisseur jusqu'à l'échelle atomique, tandis que l'utilisation d'alumine conduit à une bonne passivation chimique des états d'interface ainsi qu'à une passivation efficace par effet de champ grâce à des charges localisées dans la couche d'oxyde [8]. Par exemple, Elmi et al. ont montré que l'introduction de nanoparticules d'Ag incorporées dans une fine couche d'alumine peut améliorer efficacement la passivation par effet de champ [9]. On sait que le signe et la densité des charges localisées ainsi que l'épaisseur de couche d'alumine sont des paramètres importants pour la passivation de surface. De nombreux travaux ont été publiés pour étudier l'influence de l'épaisseur d'alumine sur les performances du dispositif; cependant, il n'y a pas de consensus sur l'épaisseur d'alumine optimale car elle varie de 0,24 à 30 nm dans la littérature, comme cela est résumé dans le tableau 1. Le tableau 1 illustre la diffusion de l'épaisseur d'alumine optimisée. En effet, de nombreuses données concernent la vitesse de recombinaison surfacique (Se) qui ne correspond pas aux mesures sur les dispositifs solaires fabriqués. La tendance générale est une diminution de Se pour des valeurs d'épaisseur plus importantes en raison d'une meilleure passivation chimique par la présence d'hydrogène dans la couche d'alumine qui passive les états d'interface lors du recuit thermique post-croissance.
Richter et al. a signalé que le courant de saturation de l'émetteur descendait jusqu'à 30 fA/cm 2 pourrait être obtenu pour couche mince (0,5 à 3 nm) mais avec une structure d'empilement constituée d'alumine et 70 nm de SiNx [17]. Le meilleur contact passivé métal-silicium est observé avec un Al2 de 0,24 nm d'épaisseur O3 [18]. Enfin, concernant les niveaux de dopage et de type, la passivation est plus efficace sur n + mais un SiO2 La structure d'empilement d'alumine donne la possibilité d'ajuster la densité de charges localisées et peut être utilisée à la fois sur le type n ou p [23]. Néanmoins, seuls quelques travaux ont démontré la corrélation entre la qualité de l'interface substrat/alumine et les performances électriques des dispositifs. Il est donc nécessaire d'effectuer une observation systématique à l'échelle atomique sur la couche de passivation d'alumine et d'obtenir une valeur optimisée de l'épaisseur d'alumine corrélée aux performances électriques.
Dans cet article, des couches d'alumine déposées en utilisant la technique ALD avec différentes épaisseurs de 0,24 à 1,9 nm ont été utilisées pour passiver le Si n + implanté. -p jonctions. L'interface de la couche d'alumine sur la surface avant de la jonction Si a été étudiée à l'aide d'un microscope électronique à transmission à haute résolution (HRTEM), tandis que l'épaisseur de la couche d'alumine a été corrélée aux paramètres électriques associés tels que la résistance série, le facteur d'idéalité, la durée de vie, efficacité quantique (EQE) et efficacité de conversion de puissance (PCE). Suns-Voc de Sinton des mesures ont été effectuées pour résoudre l'influence de la résistance série. Enfin, une épaisseur d'alumine optimisée de 1,2 µm a été obtenue. Il est à noter que nous nous intéressons ici uniquement à la passivation des contacts frontaux des jonctions p-n silicium; l'efficacité de l'appareil n'est pas entièrement optimisée, ce qui n'est pas dans le but de ce travail.
Méthodes
Fabrication d'appareils
La figure 1a montre le processus de fabrication du Si n + implanté -p jonctions avec passivation surfacique de Al2 O3 /SiNx :H s'empile. Des plaquettes de silicium (100) de type p dopé au bore de quatre pouces avec une résistivité de 5 à 10 Ω·cm ont été utilisées comme substrats. Les échantillons ont été nettoyés à l'aide de solution de piranha et d'eau distillée avant la réalisation de n + couche supérieure. L'implantation d'ions phosphorés a été réalisée à l'aide d'une dose de 10 14 à/cm 2 à 180 keV, suivi d'un recuit à 900 °C pendant 5 min pour activer les dopants. Des descriptions détaillées du processus technologique peuvent être trouvées dans nos travaux antérieurs [24, 25].

un Schéma du procédé de fabrication du Si n + implanté -p jonction passivée par Al2 O3 /SiNx empiler. b Image HRTEM prise selon la direction [011] du substrat de silicium. Profil d'intensité correspondant au rectangle blanc (un film d'alumine d'une épaisseur d'environ 0,9 µm est visible au sommet de la couche de silice). c , d Images STEM HAADF des deux couches d'alumine cultivées par ALD avec les cartes STEM EDX correspondantes d'Al, O et Si. Les contrastes plus brillants dans les images HAADF sur le dessus de la couche de silice sont dus à la densité plus élevée (moyenne Z plus élevée valeur) par rapport à celle de la silice ou du nitrure de silicium. Les profils d'intensité donnent des épaisseurs de couches d'alumine de ~ 1.2 nm et 1.9 nm, respectivement
Un Al2 ultrafin O3 couche tunnel avec une épaisseur attendue d allant de 0,24 à 1,9 nm a été déposé en utilisant la technique ALD. A noter que cette épaisseur a été déduite de l'épaisseur moyenne déterminée par spectroscopie ellipsométrique, obtenue pour des films minces d'alumine développés avec différents nombres de cycles. Un cycle ALD a déposé une monocouche qui équivaut à 0,12 nm. Jonctions sans alumine (d = 0), c'est-à-dire avec des contacts métal-silicium non passivés, ont été réalisés, mais le PCE est très faible, seulement 0,4% [9]. Le dépôt d'alumine a été réalisé dans un système PICOSUN R200 par un procédé thermique. Les réactifs utilisés étaient le triméthylaluminium (TMA) et H2 O, alors que la température de croissance était de 290°C. Au cours du processus ALD, les cycles de l'eau ont été utilisés pour oxyder le précurseur TMA. En conséquence, un SiO2 mince couche d'oxyde s'est déposée entre la surface de silicium et la couche d'alumine en raison de l'oxydation naturelle de la surface de silicium. L'épaisseur d'une telle couche d'oxyde natif observée par MET était proche de 1,5 µnm. Deuxièmement, un SiNx de 80 nm d'épaisseur :La couche H qui correspond à la valeur habituellement utilisée dans l'industrie des cellules solaires Si a été déposée sur l'échantillon en utilisant l'approche PECVD avec un mélange de SiH4 et NH3 . La température de dépôt était de 340°C, tandis que la pression était de 1 Torr et la puissance de 10 W. L'échantillon a ensuite été recuit à 650 °C pendant 10 min pour faire diffuser H dans Si.
Des électrodes au doigt de Ti/Au (20/800 nm) ont été déposées sur la face avant par pulvérisation cathodique avec un masque perforé après l'ouverture du SiNx :H revêtement en utilisant la gravure ionique réactive (RIE). Le contact arrière a ensuite été déposé par évaporation d'un film Ti/Au de 400 nm d'épaisseur. Enfin, les échantillons ont été recuits à 400 °C pendant 10 min pour former un contact ohmique.
Caractérisation
L'analyse MET a été réalisée à partir de feuilles minces en coupe transversale préparées par faisceau d'ions focalisé (FIB) sur un FEI Helios Nanolab 600i à double faisceau. Avant l'amincissement des ions, un film de carbone et une couche de platine ont été déposés pour protéger la surface supérieure de l'échantillon. Les observations MET, STEM à champ sombre annulaire à grand angle (HAADF) et STEM à rayons X à dispersion d'énergie (EDX) ont été effectuées avec un microscope FEG froid JEOL ARM200F à double correction opéré à 200 kV et équipé d'un spectromètre EDX (CENTURION de JEOL ). Le traitement de l'image a été effectué à l'aide du DIGITALMICROGRAPH (GATAN). Les images ont été prises avec le faisceau d'électrons parallèle à la direction [011] du substrat orienté Si (100). Dans cette orientation, le faisceau d'électrons est parallèle à l'interface alumine/substrat.
Les paramètres électriques sous éclairage ont été mesurés à l'aide d'un simulateur solaire (Oriel®Sol3ATM) sous un éclairage AM 1.5G, tandis que les spectres d'efficacité quantique externe (EQE) ont été mesurés dans des conditions de mesure standard sur un système 7-SCSpec fabriqué par 7-STAR Co. Pour surmonter l'influence de la résistance en série, le Suns-Voc de Sinton des mesures ont été effectuées [26,27,28]. Suns-Voc de Sinton La technique est une méthode en circuit ouvert pour indiquer les performances d'une jonction p-n ou d'une cellule solaire qui permet de comparer les paramètres électriques donnés par le simulateur solaire avec ceux déduits sans l'influence de la résistance série. L'installation comprend une lampe flash au xénon avec un jeu complet de filtres à densité neutre et un étage de plaquette contrôlé à 25 °C. Un format de courbe I-V standard avec un Jsc estimé peut être effectué soit en sondant directement les régions p+ et n+, soit en sondant la couche de métallisation. Les données peuvent être utilisées directement pour indiquer la qualité du matériau et de la passivation des cellules solaires.
Résultats et discussion
La figure 1(b) est une image HRTEM typique prise le long de la direction [011] du substrat de silicium. Dans cette direction, le faisceau d'électrons est nécessairement parallèle à l'interface film substrat. Notez que la surface supérieure du substrat n'est pas parfaitement plane. Cette observation implique que les interfaces entre les différentes couches amorphes ci-dessus (silice, alumine et nitrure de silicium) sont également rugueuses, rendant leur caractérisation très difficile. En effet, la mesure d'épaisseur est toujours surestimée à cause de cette rugosité. L'encart de la figure 1(b) est un profil d'intensité perpendiculaire au substrat et sur une région de 10 nm de large comme indiqué par le rectangle blanc de l'image HRTEM. Ce profil met en évidence la différence de contraste entre les trois couches amorphes au sommet du substrat Si. En effet, en raison du contraste Z, une couche plus foncée de 0,9 nm d'épaisseur peut être observée au-dessus de la couche de silice, qui est très probablement la couche d'alumine développée par ALD. Pour confirmer ce résultat, une imagerie en champ sombre annulaire à grand angle a été réalisée sur deux couches d'alumine différentes combinées à une cartographie chimique obtenue par microscopie électronique à transmission à balayage couplée à un spectromètre à rayons X à dispersion d'énergie. Les figures 1(c) et (d) sont deux ensembles de données illustrant deux épaisseurs de couche d'alumine différentes.
Les deux ensembles sont composés d'une image HAADF présentant la surface supérieure du substrat Si (selon la direction [011]) et les trois couches amorphes à savoir la silice (région sombre), l'alumine (région plus blanche) et enfin le nitrure de silicium (contraste intermédiaire). Notez que certains points lumineux sont visibles en particulier sur la figure 1(d). Ces caractéristiques sont dues aux poussières de platine provenant de la couche de protection lors de la préparation FIB de la feuille mince. Pour les deux structures, les cartes chimiques STEM EDX de l'aluminium, de l'oxygène et du silicium sont présentées en haut des figures 1(c) et (d). Les cartes d'aluminium montrent bien la présence d'aluminium correspondant aux régions les plus blanches des images HAADF. On constate que des points lumineux sont présents dans les régions adjacentes mais ceux-ci correspondent à du « bruit » en arrière-plan lors de l'acquisition. Des régions plus larges sont visibles sur les cartes d'oxygène car elles imagent les couches d'alumine et de silice. Enfin, les cartes de silicium représentent une ligne sombre correspondant aux couches d'alumine, la seule couche sans silicium. En raison des phénomènes de diffusion par diffusion, les cartes chimiques ne sont pas les meilleures données pour estimer correctement les valeurs d'épaisseur.
Afin de montrer plus clairement le contraste différent induit par la présence de la couche d'alumine, nous avons tracé les profils d'intensité pour les deux images comme le montre la figure 1(c) et (d). Comme le montrent clairement ces profils, une bande large indique les régions les plus brillantes correspondant à la couche d'alumine. Considérant que l'alumine présente une certaine rugosité, il est raisonnable d'estimer l'épaisseur de la couche en mesurant la distance entre deux lignes verticales situées au milieu des pentes de chaque côté de la couche. Les résultats sont respectivement d'environ 1,2 nm et 1,9 nm.
Évolution de la résistance série R s
Comme le montre la figure 2a, R s est presque constant (R s = 1.1 ± 0.15 Ω) de d = 0,24 à 1,2 nm et augmente brusquement à 3,1 ± 0,2 Ω pour d = 1.9 nm. La résistance mesurée R s est l'addition des zones d'émetteur et de base, des doigts métalliques, et de la résistance associée au SiO2 mince couche d'oxyde, entièrement étiquetée R je , plus la résistance R jeu associé à la couche d'alumine. Pour tous les échantillons, dans la limite de la reproductibilité de la procédure technologique donnée par les barres d'erreur (± 0.15 Ω) de la Fig. 4, R je est considérée comme constante puisque le même processus technologique est appliqué. d est le seul paramètre modifié. Ainsi, en tant que R s est constant jusqu'à d = 1.2 nm et comme résistance tunnel R jeu varie évidemment avec d , nous concluons que jusqu'à d = 1.2 nm, R jeu varie mais sa variation est inférieure à la dispersion des mesures, soit 0,15 Ω. R jeu est directement lié à l'inverse du coefficient de transfert γ pour l'effet tunnel, c'est-à-dire la probabilité d'effet tunnel des porteuses à travers une barrière rectangulaire, donnée par [29] :
$$ \gamma \approx \kern0.5em \exp \left(-\frac{2d\sqrt{2q{m}^{\ast }{\upphi}_{\mathrm{B}}}}{\overline{ h}}\droit) $$ (1)où m * est la masse effective dans la barrière d'alumine (m * = 0,75 m 0 [30], avec m 0 comme la masse de l'électron), h est la constante de Planck, q est la charge électronique, et ϕ B est la hauteur effective de la barrière, égale au décalage de la bande de conduction ΔEC entre le diélectrique et le n + contact en silicone. La résistance tunnel est donnée par :
$$ {R}_{\mathrm{jeu}}=Ax{\gamma}^{-1} $$ (2)où A est une constante. Pour d = 1.9 nm, R jeu correspond au pas mesuré sur R s , et donc, on en déduit R jeu (1.9 nm) = 2 Ω. A partir de cette valeur, A peut être calculé. Pour cela, il faut savoir ϕ B qui est égal au décalage de bande de conduction entre Si et la couche diélectrique, puisque le niveau de Fermi est dans le minimum de la bande de conduction dans le n + fortement dopé contact en silicone. En fait, la couche diélectrique est en fait de quelques nanomètres de SiO2 /Al2 O3 pile, donc le décalage de bande dépend de ces deux couches diélectriques. Le décalage de la bande de conduction se situe dans la plage de 3,13 à 3,5 eV et 2,08 à 2,8 eV pour SiO2 et Al2 O3 [31], respectivement. Le tableau 2 donne les valeurs de A préfacteur déduit de la valeur de R s mesuré à d = 1.9 nm, pour les deux valeurs extrêmes de ϕ B.
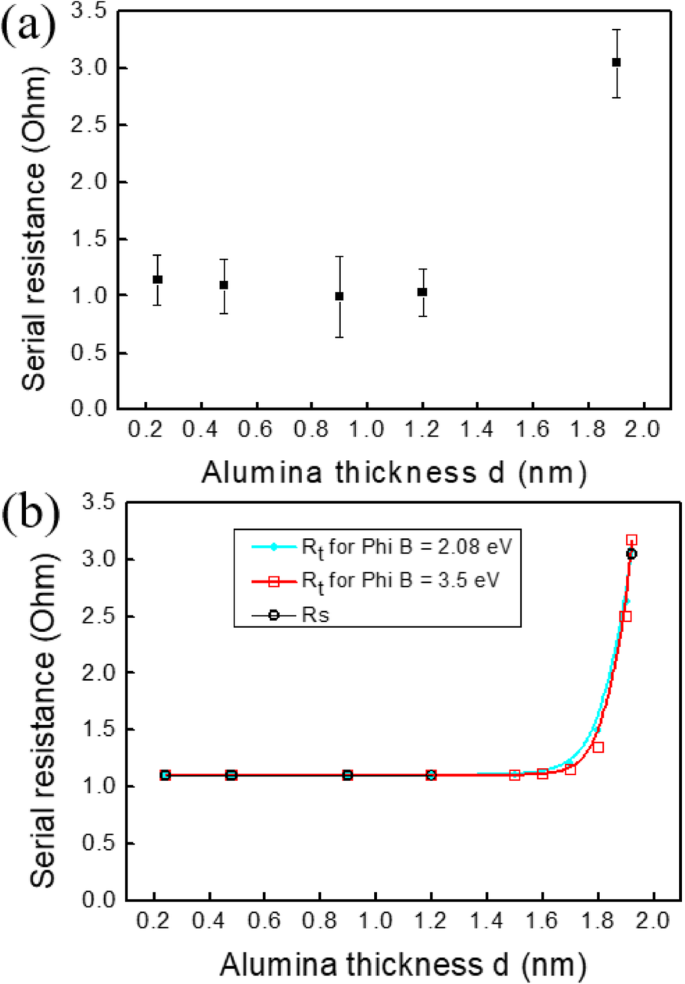
un Evolution de la résistance série R s par rapport à l'épaisseur d'alumine. b Valeurs expérimentales de R s et simulé un R simu calculé pour ϕ B = 2.08 et 3.5 eV versus l'épaisseur d'alumine d (nm)
Sur la figure 2b, nous avons tracé R s et la résistance totale simulée R simu = R je + R jeu pour les deux ϕ B valeurs par rapport à d (R s a été ramené à sa valeur moyenne de 1,1 Ω entre d = 0,24 et 1,2 nm). Quoi que ϕ B , pour d ≤ 1.2 nm, R jeu est négligeable. Il confirme notre hypothèse de départ :le pas observé à 1.9 nm dans l'évolution de R s est associée à l'évolution de la barrière tunnel. Pour d moins de 1.2 nm, l'effet principal de la couche d'alumine est de passiver le n + contacts et la surface p, par passivation à effet de champ associée aux charges fixes localisées dans l'oxyde. Pour les plus grands d valeurs, la couche d'alumine introduit une résistance de contact série parasite qui diminue les performances électriques des cellules.
Enfin, on peut estimer la résistivité ρ de la couche d'alumine. Pour cela, on considère la résistance mesurée R pour une valeur d'épaisseur de 1,9 nm. L'effet tunnel diminue et la couche commence à avoir un comportement « en vrac » (une approximation grossière). Avec une telle épaisseur d'alumine (d = 1.9 nm) et compte tenu de la surface S du contact (10,54 mm 2 ), on en déduit ρ en utilisant l'équation suivante :
$$ R=\rho\ \frac{d}{S} $$ (3)Cela conduit à ρ = 1.1 × 10 6 ·cm. Pour les matériaux en vrac sur les marchés, en fonction de la température de croissance et des impuretés dans l'alumine, la valeur de résistivité varie de 10 5 à 10 14 ·cm (de Kyocera™). Ainsi, notre valeur estimée montre que nous avons un matériau « pseudo-vrac », à la limite entre une couche mince et une couche massive.
Évolution du facteur d'idéalité n
En présence d'une résistance série, la courbe I-V d'une cellule solaire est :
$$ I={I}_{\mathrm{L}}-{I}_0\ \exp \left(\frac{q\left(V+I\ {R}_{\mathrm{s}}\right )}{n\ k\ T}\droit) $$ (4)où je est le courant de sortie de la cellule, I L est le courant lumineux généré, V est la tension aux bornes de la cellule, T est la température, k est la constante de Boltzmann, n est le facteur d'idéalité, et R S est la résistance en série des cellules. Pour un faible niveau d'injection, avec uniquement des recombinaisons bande à bande ou Schottky Read-Hall, le facteur d'idéalité n est inférieur à 2. Il atteint la valeur 1 lorsque la recombinaison est limitée par des porteurs minoritaires [31]. Une augmentation de n indique qu'un mécanisme de recombinaison inhabituel est en cours, impliquant à la fois des porteurs minoritaires et majoritaires [32]. Alors, n est une signature de la recombinaison (ou de la passivation) du dispositif. De plus, n est également lié à R s cela augmente le facteur d'idéalité [33]. L'évolution de n par rapport à l'épaisseur d'alumine est illustré à la figure 3a.

un Évolution du facteur d'idéalité n par rapport à l'épaisseur d'alumine d . b Évolution de la durée de vie τ par rapport à l'épaisseur d'alumine d
Pour une valeur d'épaisseur faible (0,24 nm), n est supérieur à 2, ce qui est la signature d'une surface non passivée. Au fur et à mesure que l'épaisseur d'alumine augmente, n diminue et se stabilise à environ 1,5, mettant en évidence un effet de passivation efficace à travers l'alumine. Pour une valeur d'épaisseur d'alumine de 1,9 nm, n augmente brusquement à 4, en conséquence de l'augmentation brusque de R s . Donc, les deux R s et n montrent que la couche d'alumine passive bien la jonction Si, associée à une faible barrière tunnel. Pour d = 1.9 nm, la barrière tunnel augmente, avec une dégradation ultérieure de R s et donc du facteur d'idéalité.
Durée de vie
Un autre paramètre clé qui illustre l'effet de passivation est la durée de vie des photoporteurs, τ . En effet, la durée de vie est directement liée au taux de recombinaison des porteurs, lié à la concentration de défauts de surface (centres de recombinaison). Elle a été déduite de la tension en circuit ouvert mesurée, de sa dérivée temporelle et du niveau d'éclairement réel. Son évolution en fonction de l'épaisseur d'alumine est donnée sur la Fig. 3b. L'évolution de la durée de vie est en accord avec les résultats précédents. La valeur moyenne est faible, principalement en raison du contact arrière non passivé. Cependant, il présente clairement une augmentation avec l'épaisseur d'alumine, en conséquence d'une meilleure passivation du contact avant et avec une valeur d'épaisseur optimale de 1,2 µm. Pour d = 1.9 nm, la durée de vie diminue. Il est possible qu'au fur et à mesure que l'épaisseur d'alumine augmente, moins d'hydrogène diffuse du SiNx couche au contact pendant le recuit thermique, et par conséquent, l'effet de passivation chimique diminue.
La figure 4 donne l'EQE mesurée en fonction de l'épaisseur d'alumine. Le meilleur EQE est observé pour d = 1.2 nm. La principale amélioration est observée pour la longueur d'onde variant de 600 à 900 nm. Dans tous les cas, l'EQE est loin d'une forme rectangulaire idéale dans l'IR qui est une signature de recombinaison au niveau du contact arrière non passivé.
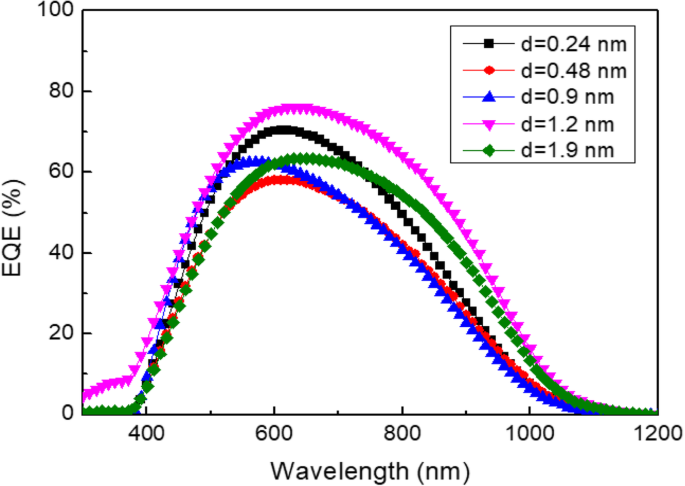
EQE mesuré par rapport à la longueur d'onde pour différentes épaisseurs d'alumine
Afin de compléter l'analyse, nous avons étudié les paramètres électriques sous éclairement mesurés à la fois sous simulateur solaire et selon la méthode de Sinton. La figure 5 montre l'efficacité énergétique des cellules solaires en fonction de l'épaisseur d'alumine :celle mesurée avec le simulateur solaire et celle optimisée sans R s . Au fur et à mesure que l'épaisseur d'alumine augmente, le PCE mesuré augmente en raison d'un meilleur effet de passivation atteignant une valeur maximale de 5% pour d = 1.2 nm, avant de diminuer pour d = 1.9 nm. Le PCE corrigé pour R s = 0 a une valeur assez constante autour de 11%. Cette valeur est raisonnable compte tenu uniquement de la passivation du contact arrière. Pour d = 1.9 nm, le rendement corrigé diminue jusqu'à 6%, en raison de la résistance aux shunts parasites.
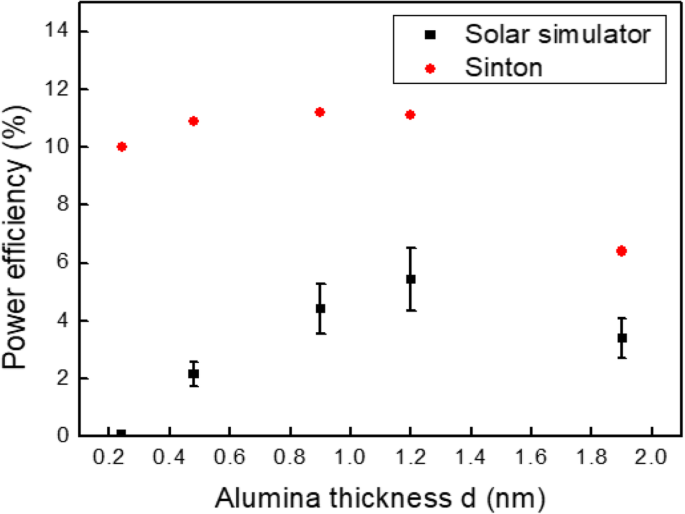
Efficacité énergétique mesurée et extrapolée par rapport à l'épaisseur d'alumine d
Conclusions
L'alumine déposée par ALD est une méthode efficace pour passiver les contacts électriques, un paramètre clé pour les jonctions p-n du silicium. Dans ce travail, une couche d'alumine déposée par couche atomique à effet tunnel avec différentes épaisseurs de 0,24 à 1,9 nm a été utilisée pour passiver le Si n + implanté. -p jonctions. Nous avons effectué des analyses structurelles systématiques HRTEM, STEM HAADF et STEM EDX corrélées à un ensemble complet de mesures électriques en utilisant à la fois le simulateur solaire et les analyses de Sinton. Cette approche originale permet d'affirmer que l'épaisseur d'alumine optimale pour obtenir un effet de passivation efficace est de 1,2 nm. Bien que l'efficacité du dispositif ne soit pas entièrement optimisée dans ce travail, la passivation optimale de l'alumine pourrait être bénéfique pour le développement des cellules solaires à base de silicium à haut rendement.
Abréviations
- ALD :
-
Dépôt de couche atomique
- EDX :
-
Rayons X à dispersion d'énergie
- EQE :
-
Efficacité quantique externe
- FIB :
-
Faisceau d'ions focalisé
- HAADF :
-
Champ sombre annulaire grand angle
- HRTEM :
-
Microscope électronique à transmission haute résolution
- PCE :
-
Efficacité de conversion de puissance
- PECVD :
-
Dépôt chimique en phase vapeur assisté par plasma
- RIE :
-
Gravure ionique réactive
- TEM :
-
Microscope électronique à transmission
- TMA :
-
Triméthylaluminium
Nanomatériaux
- Évaluer les avantages de DevOps pour les tests de performances IoT
- Le réarrangement atomique de plusieurs puits quantiques à base de GaN dans du gaz mixte H2/NH3 pour améliorer les propriétés structurelles et optiques
- Synthèse d'un composite de nanofibres de silice/nanoparticules d'or conductrices d'électricité par impulsions laser et technique de pulvérisation
- Formation et propriétés luminescentes de nanocomposites Al2O3:SiOC à base de nanoparticules d'alumine modifiées par le phényltriméthoxysilane
- Évolution de la zone de contact à charge normale pour les surfaces rugueuses :de l'échelle atomique à l'échelle macroscopique
- Effet de différents liants sur les performances électrochimiques des anodes à oxyde métallique pour les batteries lithium-ion
- Étude sur la mémoire à commutation de résistance multi-niveaux et la phototension dépendante de l'état de la mémoire dans les jonctions Pt/Nd:SrTiO3
- L'optimisation de l'ingénierie des espaceurs pour la DRAM sans condensateur basée sur le transistor à effet tunnel à double porte
- L'oxyde de graphène réduit intercalé tensioactif anionique/liquides ioniques pour supercondensateurs hautes performances



