Plaque à microcanaux haute sensibilité et longue durée traitée par dépôt de couche atomique
Résumé
En tant que composant clé du dispositif multiplicateur d'électrons, une plaque à microcanaux (MCP) peut être appliquée dans de nombreux domaines scientifiques. Oxyde d'aluminium pur (Al2 O3 ) en tant que couche d'émission d'électrons secondaires (SEE) ont été déposés dans les pores du MCP via un dépôt de couche atomique (ALD) pour surmonter des problèmes tels que le courant d'obscurité élevé et la faible durée de vie qui se produisent souvent sur le MCP traditionnel. Dans cet article, nous étudions systématiquement la morphologie, la distribution des éléments et la structure des échantillons par microscopie électronique à balayage (MEB) et spectroscopie à dispersion d'énergie (EDS), respectivement. Courant de sortie de différentes épaisseurs d'Al2 O3 a été étudiée et une épaisseur optimale a été trouvée. Des tests expérimentaux montrent que le gain moyen de l'ALD-MCP était près de cinq fois supérieur à celui du MCP traditionnel, et l'ALD-MCP a montré une meilleure sensibilité et une durée de vie plus longue.
Introduction
La plaque à microcanaux (MCP) est un multiplicateur d'électrons compact à gain élevé [1,2,3]. C'est un composant clé du MCP-PMT, des appareils de vision nocturne, de la microscopie électronique, de la caméra de cadrage à rayons X, etc. [4,5,6,7]. Il a été utilisé dans un plus large éventail d'applications de détection de particules et de photons, telles que les ions, les électrons, les neutrons, les rayons X et les rayons UV [8,9,10,11]. La plaque à microcanaux est un mince réseau bidimensionnel composé de plusieurs millions de pores de verre conducteurs ultra-minces de 4 à 25 m de diamètre et de 0,2 à 1,2 mm de longueur. Le MPC a trois principales caractéristiques de structure :l'angle de polarisation, le rapport de la longueur du canal au diamètre du canal et le rapport de la surface ouverte (rapport de la surface ouverte totale à la surface effective entière). En général, l'angle de biais est compris entre 5 et 15°. Le rapport de la longueur du canal au diamètre du canal est d'environ 20:1 à 100:1, et le rapport de surface ouverte d'environ 60 à 80 %. Le MCP traditionnel est composé de verre au silicate de plomb et fabriqué par étirage, empilement, fusion, tranchage, gravure et réduction à l'hydrogène. Après le traitement chimique de réduction à l'hydrogène, une couche conductrice et une couche d'émission d'électrons secondaires (SEE) sont générées dans le pore. Lorsqu'un électron ou un rayonnement pénètre dans un canal, des électrons secondaires sont émis par la couche SEE et ces électrons sont accélérés par un champ électrique développé par une tension V D appliqué sur la couche conductrice. Enfin, d'autres électrons secondaires ont été produits de cette manière et une amplification électronique a été réalisée. Bien que le MCP traditionnel ait été largement utilisé dans de nombreux domaines, il existe plusieurs inconvénients [12]. Premièrement, la gravure chimique à haut bruit augmente Ra sur la surface interne du pore, le facteur de bruit augmente et le rapport signal/bruit diminue lorsque les photoélectrons sont multipliés. Deuxièmement, la cuisson sous vide et le lavage des électrons entraînent une variation de l'élément de surface du MCP et réduisent la charge extraite et le gain du MCP. Troisièmement, la résistance électrique et les propriétés d'émission d'électrons secondaires ne peuvent pas être ajustées indépendamment. Étant donné que les causes des inconvénients sont différentes et que le processus de production du MCP traditionnel est complexe, il est difficile de surmonter tous les inconvénients en même temps en ajustant les paramètres du processus.
Alors que la technologie de dépôt de couche atomique (ALD) est appliquée dans de plus en plus de domaines de recherche [13,14,15,16,17], certains chercheurs ont proposé de déposer une couche conductrice et une couche SEE à l'intérieur des canaux pour optimiser les performances du MCP traditionnel [18, 19,20,21,22,23]. L'ALD est une technique de dépôt de couche mince dans laquelle un film est développé sur un substrat en exposant sa surface à des espèces gazeuses alternées. L'ALD est considérée comme une méthode de dépôt avec un grand potentiel pour produire des films conformes très minces avec un contrôle de l'épaisseur et de la composition des films possible au niveau atomique [24, 25].
L'application de la technologie ALD au post-traitement MCP présente de nombreux avantages. Dioxyde de silicium (SiO2 ) est le principal matériau d'émission d'électrons secondaires dans le MCP traditionnel [26] et a un faible rendement électronique secondaire (SEY). Si nous déposions un matériau SEE élevé sur la paroi du canal, le gain de MCP pourrait être amélioré. En raison du processus de gravure, les surfaces des canaux internes du MCP traditionnel conservent une rugosité de surface plus élevée et présentent de nombreux trous à l'échelle nanométrique. Les trous nanométriques adsorbent les gaz et autres polluants difficiles à nettoyer. Lorsqu'ils sont accélérés, les électrons frappent des absorbants, qui sont ionisés et accélérés par le champ électrique. Les ions accélérés ionisent de plus en plus d'absorbants et consomment des électrons supplémentaires du MCP. En raison de la durée de vie du MCP décidée par la quantité totale de charge électrique, l'existence d'absorbants conduit à une durée de vie plus courte. En attendant, le processus de lavage électrique est nécessaire pour assurer un vide poussé. Plus d'absorbants nécessitent un temps de lavage électrique plus long et coûtent plus de charge électrique, ce qui réduit encore la durée de vie du MCP. Si nous déposions un matériau SEE de plusieurs nanomètres sur la surface interne du canal, des parties de trous à l'échelle nanométrique pourraient être comblées pour améliorer la rugosité de la surface, puis pour avoir une durée de vie plus longue.
Dans cet article, Al2 O3 Le matériau SEE a été préparé par la technique ALD dans les pores du MCP avec une longueur de côté de 15 mm. La morphologie, la distribution des éléments, la structure du film mince d'oxyde déposé par ALD et les performances de l'ALD-MCP ont été systématiquement étudiées.
Méthodes expérimentales et de calcul
Le schéma de la configuration de l'expérience est illustré à la Fig. 1. Le système se compose d'une cathode en or, d'un MCP et d'une anode PCB et est placé dans une chambre à vide évacuée à 2 × 10 −4 Pa. Les tensions de toutes les électrodes sont fournies par une alimentation haute tension multicanal et sont introduites dans la chambre à vide par des traversées haute tension. Il y a un picoampèremètre entre l'anode du PCB et la terre pour mesurer le courant de sortie du MCP. Une lampe au mercure atténuée agit comme une source de lumière ultraviolette lorsque nous mesurons le courant de sortie du MCP. La lampe au mercure sans atténuation sert de source de lumière ultraviolette lorsque nous accélérons les tests de durée de vie de la plaque à microcanaux.
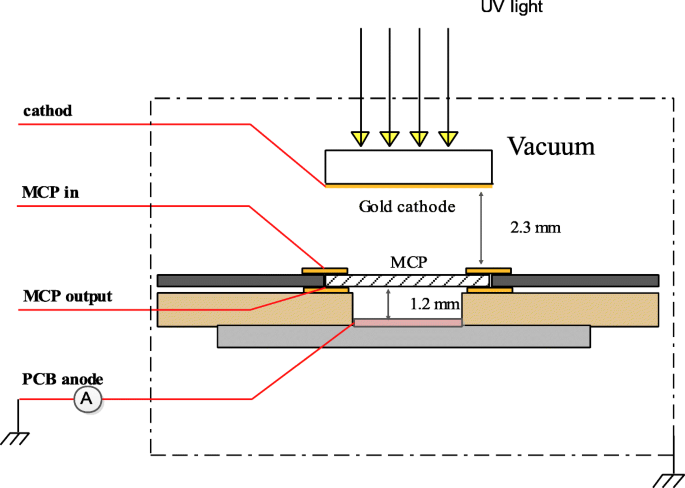
Le schéma de la configuration de l'expérience
Un système commercial de dépôt de couche atomique à paroi chaude a été utilisé pour préparer des films minces de nano-oxyde sur la surface du canal interne MCP (comme illustré sur la figure 2) et du silicium. Les échantillons déposés sur silicium sont utilisés pour mesurer le rendement d'émission secondaire. Les substrats de silicium polis ont été nettoyés par ultrasons dans un mélange acétone/éthanol/acide fluorhydrique/eau DI puis placés dans une chambre ALD en attente de dépôt. Les MCP nus (épaisseur =1,2 mm, taille des pores =24 m, rapport d'aspect =40, angle de polarisation =10°) ont été chauffés à 200 °C pendant 1 h pour faire croître des films minces de nano-oxyde. Selon l'article [27, 28], il est plus difficile de contrôler l'épaisseur et la composition des matériaux sur MCP que sur substrat plan. Deux approches ont été adoptées pour que l'épaisseur et la composition soient autant que possible uniformément réparties dans les pores du MCP. L'un étend les précurseurs pour chaque cycle ALD (échantillon F). L'autre utilise un modèle d'arrêt d'écoulement (échantillon G), dans lequel les précurseurs entrent et diffusent dans la chambre à paroi chaude pendant plusieurs secondes, puis pompés et purgés par un gaz vecteur.
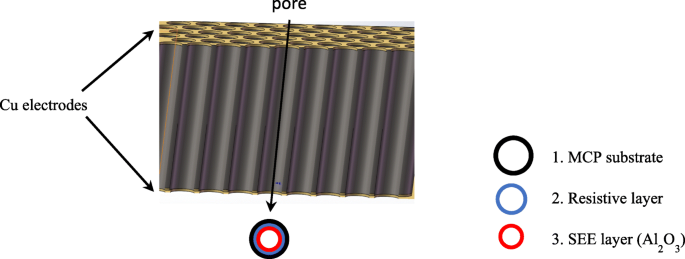
Schéma de principe de la structure d'ALD-MCP
Pour le dépôt de la deuxième couche d'émission d'électrons secondaires, Al2 O3 a été réalisée en utilisant du TMA et de l'eau déminéralisée comme précurseur d'Al et d'oxydant, respectivement. De l'azote ultra-pur a été utilisé comme gaz vecteur et de purge. L'Al2 O3 L'ALD a été réalisée à l'aide de TMA et H2 distincts O exposition avec séquence TMA/N2 /H2 O/N2 (0,05/10/0,05/10s). Le MCP carré avec une longueur de 15 mm de côté revêtu d'environ 4 nm (échantillon B), 6 nm (échantillon C), 8 nm (échantillons D et H), 10 nm (échantillon E) et 60 nm Al2 O3 (échantillon F). L'échantillon G a été réalisé en utilisant des TMA et H2 séparés O exposition avec séquence TMA/Stop/N2 /H2 O/Stop/N2 (0,05/3/20/0,05/3/20s) pendant 600 périodes. Un MCP circulaire (50 mm de diamètre) a été divisé en deux parties; une partie a été mise à nu et l'autre partie a été recouverte de deux morceaux de plaquette de silicium semi-circulaire, pour obtenir un MCP qui est à moitié avec le procédé ALD et à moitié non traité. Les détails des paramètres expérimentaux sont répertoriés dans le tableau 1. Les surfaces des échantillons de MCP ont été examinées par microscopie électronique à balayage (MEB). La composition élémentaire du film a été mesurée par la méthode SEM en coupe transversale (EDS). Après fonctionnalisation ALD, la couche de cuivre avec 200 nm comme électrodes a été préparée des deux côtés du MCP par un système d'évaporation pour la caractérisation électrique du MCP et les tests de durée de vie.
Résultats et discussion
Comme le montre la figure 1, le principe du test de gain MCP est illustré ci-dessous. Le photon ultraviolet arrive à la cathode en or et a été converti en photoélectron par effet photoélectrique. Le photoélectron est accéléré par la tension entre la cathode et le MCPin et obtient une énergie électronique primaire. Ensuite, un photoélectron avec une énergie électronique primaire amplifiée par MCP et émet des nuages d'électrons vers l'anode PCB. Enfin, les électrons affluent vers le sol et le courant de sortie a été mesuré par picoampèremètre. Le courant de sortie du MCP est commandé par des tensions de polarisation entre différentes électrodes. Afin de déterminer les tensions pour chaque électrode, l'échantillon A a été assemblé et la tension entre MCPin et MCPout a été réglée sur une valeur fixe ; puis, changez les tensions de cathode et d'anode pour obtenir une valeur optimale.
Le courant de sortie du MCP en fonction de l'énergie du photoélectron (l'énergie de l'électron primaire avant d'entrer dans le MCPin) est illustré à la figure 3 lorsque le réglage de la tension de polarisation pour le MCP est de 1400 V. Le courant de sortie du MCP augmente de manière linéaire à mesure que l'énergie du photoélectron diminue à 400 V et entre dans un plateau à une énergie supérieure à 400 eV. Cela peut être attribué au fait que le SEY du dioxyde de silicium est particulièrement faible à une énergie électronique incidente plus faible et une fois que le SEY est proche du maximum, le courant de sortie devient stable.

Tension de polarisation entre la cathode et le MCPin en fonction du courant de sortie du MCP
La figure 4 montre la courbe SEY de Al2 O3 et SiO2 . Dans la figure, le SEY de Al2 O3 augmente avec la tension et obtient la plus grande valeur de 3,6 à 400 V, et cette tendance correspond approximativement à la figure 3. Dans le Al2 O3 Courbe SEY, la valeur SEY descend à plus de 400 eV. Mais comme le montre la figure 3, le courant de sortie augmente toujours lorsque la tension de polarisation est supérieure à 400 V. Cela peut s'expliquer par le rapport de surface ouverte du MCP. Le MCP que nous avons utilisé a un ratio d'espace ouvert d'environ 60 % ; cela signifie que lorsque les photoélectrons arrivent au MCPin, 40% d'entre eux ne peuvent pas entrer dans les canaux et seraient réfléchis par la surface supérieure du MCP. Lorsque la tension entre la cathode et le MCPin augmente, le champ électrique réaccélère les 40 % d'électrons et pénètre à nouveau dans le canal.
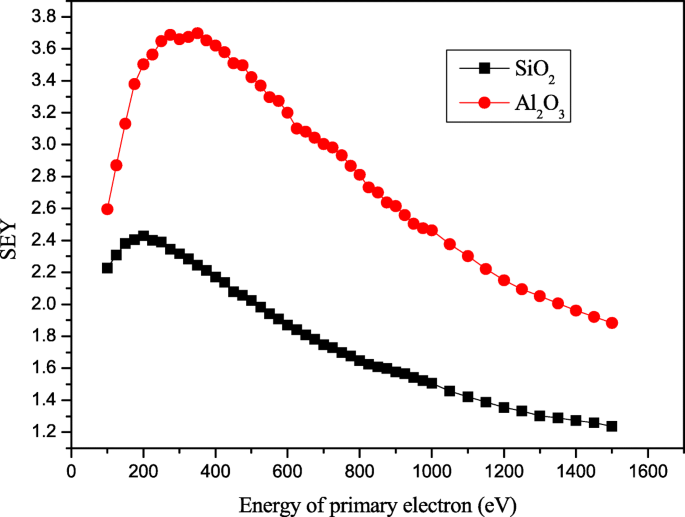
Rendement électronique secondaire (SEY) de SiO2 ALD Al2O3
En raison de l'uniformité de la couche SEE peut affecter l'uniformité du détecteur d'imagerie MCP, donc l'uniformité de la couche SEE est un facteur clé pour la caractérisation ALD-MCP. La figure 5 montre les spectres et la composition élémentaire des échantillons de MCP transversaux traités en étendant le modèle précurseur et le modèle d'arrêt d'écoulement. La distribution d'Al est caractérisée par l'EDS à cinq endroits le long de la surface interne des pores. Afin de réduire l'erreur de mesure EDS, les données de distribution des éléments ont été mesurées par deux échantillons plus épais, l'échantillon F et l'échantillon G, qui ont déposé 60 nm Al2 O3 . Sur la figure 5a, b, la composition élémentaire des MCP enrobés et non enrobés a été mesurée pour exclure l'influence du substrat sur la distribution d'Al. La quantité d'Al est inférieure à 1% dans le substrat et trop petite pour affecter les résultats finaux de l'expérience. La distribution d'Al des échantillons déposés par le modèle d'arrêt d'écoulement et le modèle de précurseur étendu est illustrée à la figure 5c. La teneur en Al à différents endroits signifiait que les éléments sont répartis plus uniformément dans la surface interne des pores que l'échantillon a déposé en étendant le modèle de précurseurs. Ceci implique également que la technique ALD est capable de déposer des couches minces homogènes de nano-oxydes sur des substrats à structure complexe. La distribution des éléments de l'échantillon déposé par le modèle d'arrêt d'écoulement montre une mauvaise uniformité. Les surfaces supérieure et inférieure du MCP ont un faible pourcentage atomique, tandis que le milieu du canal a un pourcentage atomique élevé. C'est probablement parce que les précurseurs à la surface étaient faciles à purger et à obtenir une couche de dépôt atomique. Au milieu du canal, les précurseurs étaient difficiles à purger et à obtenir un dépôt en phase vapeur au lieu d'un dépôt atomique.

Spectres et composition élémentaire d'échantillons MCP transversaux. un Spectres et composition élémentaire de l'ALD MCP. b Spectres et composition élémentaire du MCP non enrobé. c Al distribution des échantillons déposés par modèle d'arrêt d'écoulement et modèle précurseur d'extension.
L'épaisseur avec SEM pourrait être une meilleure option pour confirmer l'uniformité. Ainsi, l'épaisseur des couches SEE déposées sur la surface interne des pores MCP a été mesurée par SEM et est résumée sur la figure 6. L'épaisseur de cinq points différents le long d'un pore, comme indiqué sur la figure 6a, a été directement mesurée par SEM. Les courbes d'épaisseur de différents modèles de dépôt sont présentées sur la figure 6c, qui correspond essentiellement à la distribution d'Al comme sur la figure 5c.
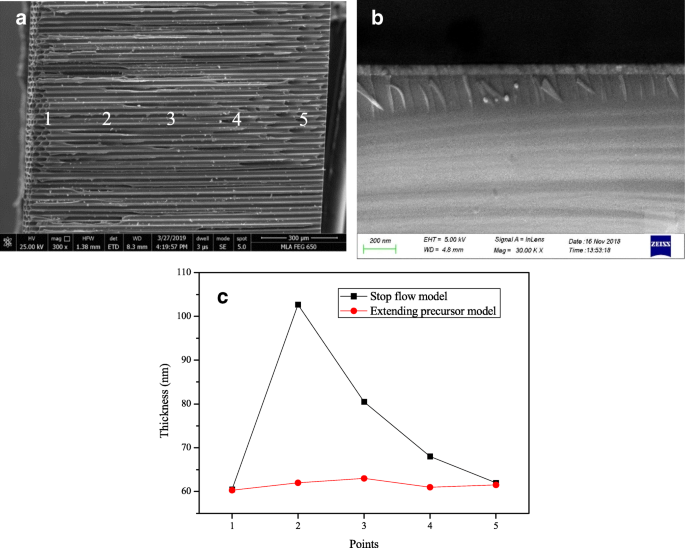
Images SEM en coupe de MCP. un Images SEM en coupe d'échantillons ALD-MCP. b Images SEM en coupe transversale de la couche d'Al2O3 à la surface du canal interne. c Épaisseur de la couche SEE à différents endroits mesurée avec SEM
Une fois les électrodes de cuivre préparées des deux côtés du MCP, la caractérisation électrique mesurée par un système est illustrée à la figure 1. La figure 7 montre le courant de sortie et l'image du MCP traditionnel et de l'ALD-MCP revêtu. La figure 7a montre le courant de sortie en fonction de différentes épaisseurs d'Al2 O3 . Sur la figure 7b, au fur et à mesure que l'épaisseur du film augmente de 6 à 10 nm, le courant de sortie du MCP revêtu soustrait non revêtu augmente d'abord de manière significative puis reste stable. Les ALD-MCP à 8 nm et 10 nm Al2 O3 le revêtement a obtenu plus de cinq fois le courant de sortie que le MCP conventionnel. Cela signifie que 8 nm d'épaisseur Al2 O3 est optimal pour l'application MCP. Ceci est causé par l'ALD-MCP qui a un matériau SEY plus élevé que nous pouvons voir sur la figure 3. Comme le montre (a), lorsqu'il est enduit de 4 nm sur la surface du canal interne du MCP, le courant de sortie est inférieur à celui non enduit MCP. Ceci probablement parce qu'il n'y a pas de matériau continu et que de nombreux défauts existent lorsque l'épaisseur d'Al2 O3 est inférieur à 4 nm. La recombinaison des électrons se produit dans les défauts pour réduire le nombre d'électrons secondaires et conduire à un courant de sortie inférieur à celui du MCP non revêtu.
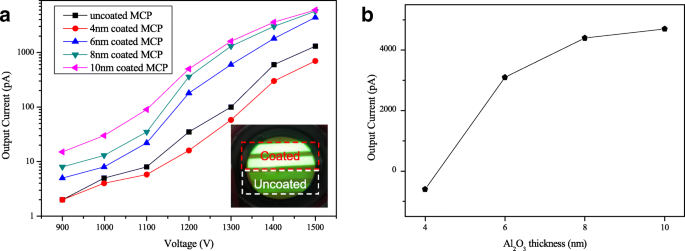
Courant de sortie et image du MCP traditionnel et du ALD-MCP revêtu. un Courant de sortie de différentes épaisseurs de revêtement d'Al2O3 sur MCP et photographie d'un écran au phosphore illuminé par de l'Al2O3 de 8 nm à moitié revêtu et à moitié non revêtu. b Le courant de sortie du MCP revêtu soustrait le MCP non revêtu en fonction de l'épaisseur d'Al2O3
Après avoir déposé 8 nm Al2 O3 sur la moitié de l'échantillon H, il y a quatre bandes de cuivre déposées sur l'échantillon H et un écran phosphorescent à la place de l'anode PCB pour collecter les électrons de sortie. Comme le montre la figure 7b, le MCP à moitié enduit a une image plus lumineuse que le MCP non enduit. Ceci est cohérent avec la caractérisation électrique.
L'échantillon A et l'échantillon D ont été éclairés en continu avec une lampe à mercure ultraviolet pour un test à vie. Afin d'accélérer les tests de durée de vie, une lampe au mercure ultraviolet à haute puissance sans atténuation a été utilisée. Les MCP fonctionnaient avec des courants de sortie élevés et restaient à un niveau de saturation pendant plusieurs jours. Comme le montre le tableau 2, le courant d'obscurité et le courant de sortie à un faible niveau d'éclairage ont été mesurés avant et après les tests de durée de vie. Avant les tests, le courant d'obscurité du MCP traditionnel était de 1,0 pA et celui de l'ALD-MCP était de 1,2 pA. Le courant d'obscurité plus élevé de l'ALD-MCP était simplement dû au fait que les substrats des MCP étaient des MCP traditionnels et que l'ALD-MCP était recouvert d'un matériau SEY élevé. Après les tests de durée de vie, le courant d'obscurité de l'ALD-MCP fonctionne mieux alors qu'ils ont montré des performances similaires avant les tests de durée de vie. Selon le tableau 2, le courant de sortie du MCP traditionnel a chuté d'environ 50 % après un éclairage à haute puissance, tandis que l'ALD-MCP montre un meilleur comportement et un courant de sortie maintenu autour de 6 nA.
Conclusions
La morphologie, la composition et la structure des films minces de nano-oxyde Al2 O3 préparées par dépôt de couche atomique ont été étudiées. Les uniformités d'épaisseur dans le canal déposé en étendant le modèle précurseur et le modèle d'arrêt d'écoulement ont été mesurées. Les teneurs en Al et l'épaisseur du film à différents endroits le long des canaux signifiaient que l'extension du précurseur peut obtenir une meilleure uniformité pour un MCP avec une taille de pores de 24 m et un rapport d'aspect de 40. Nous avons évalué un système de test MCP et observé que les tensions de polarisation entre la cathode et la surface supérieure du MCP peut affecter le courant de sortie. Les propriétés électriques et les mesures de durée de vie ont été étudiées. Les résultats des mesures électriques ont montré que lorsque l'épaisseur du film augmente de 6 à 10 nm, le courant de sortie augmente et la vitesse diminue. Et les ALD-MCP recouverts de plus de 8 nm d'Al2 O3 a environ cinq fois le courant de sortie que les MCP traditionnels et a une meilleure performance de durée de vie.
Abréviations
- ALD :
-
Dépôt de couche atomique
- ALD-MCP :
-
Plaque à microcanaux traitée par dépôt de couche atomique
- EDS :
-
Spectroscopie à dispersion d'énergie
- MCP :
-
Plaque micro-canaux
- VOIR la couche :
-
Couche d'émission d'électrons secondaires (SEE)
- SEM :
-
Microscopie électronique à balayage
- SEY :
-
Rendement électronique secondaire
Nanomatériaux
- Technologies avancées de dépôt de couche atomique pour les micro-LED et les VCSEL
- Dévoilement de la structure atomique et électronique des nanofibres de carbone empilées
- La conception de la couche d'émission pour les multiplicateurs d'électrons
- Caractéristiques de commutation résistive bipolaire des dispositifs RRAM à structure tricouche HfO2/TiO2/HfO2 sur des substrats revêtus de Pt et de TiN fabriqués par dépôt de couche atomique
- Caractéristiques d'alignement interfacial, électrique et de bande des piles HfO2/Ge avec une couche intermédiaire de SiO2 formée in situ par dépôt de couche atomique amélioré par plasma
- Les nanofibres hiérarchiques antibactériennes en polyamide 6-ZnO fabriquées par dépôt de couche atomique et croissance hydrothermale
- Électrodéposition de SnO2 sur FTO et son application dans les cellules solaires pérovskites à hétérojonction planaire en tant que couche de transport d'électrons
- Propriétés photocatalytiques des poudres de TiO2 revêtues de Co3O4 préparées par dépôt de couche atomique amélioré par plasma
- Réglage au niveau de Fermi des films ZnO par dépôt de couche atomique supercyclée



