Analyse comparative des défauts dans les couches de GaN implantées au Mg et dopées au Mg sur des substrats de GaN autonomes
Résumé
Le dopage inefficace de type p induit par le Mg est resté un obstacle majeur au développement de dispositifs électroniques à base de GaN pour les applications d'éclairage et d'alimentation à semi-conducteurs. Cette étude rapporte une analyse structurelle comparative des défauts dans les couches de GaN sur des substrats autoportants de GaN où l'incorporation de Mg est réalisée via deux approches :l'implantation ionique et le dopage épitaxié. La microscopie électronique à transmission à balayage a révélé l'existence de défauts pyramidaux et linéaires uniquement dans l'échantillon implanté au Mg, tandis que l'échantillon dopé au Mg n'a pas montré la présence de ces défauts, ce qui suggère que la nature des défauts dépend de la méthode d'incorporation. A partir de la spectrométrie de masse des ions secondaires, une correspondance directe est observée entre les concentrations en Mg et la localisation et le type de ces défauts. Nos investigations suggèrent que ces défauts pyramidaux et linéaires sont des espèces riches en Mg et que leur formation peut conduire à des densités de trous libres réduites, ce qui reste une préoccupation majeure pour les matériaux et dispositifs à base de p-GaN. Comme les substrats GaN autonomes offrent une plate-forme pour la réalisation de dispositifs verticaux basés sur la jonction pn, une étude structurelle comparative des défauts dus à différents processus d'incorporation de Mg dans les couches de GaN sur de tels substrats est susceptible de donner plus d'informations sur la compréhension des mécanismes d'auto-compensation du Mg, puis optimisation du processus de dopage et/ou d'implantation de Mg pour l'avancement de la technologie des dispositifs à base de GaN.
Introduction
Au cours des trois dernières décennies, le GaN est devenu l'un des semi-conducteurs composés les plus étudiés au monde. Cela est principalement dû à son énorme potentiel non seulement dans les applications d'éclairage à semi-conducteurs, mais également dans les opérations à haute puissance, haute fréquence et haute température [1,2,3,4,5,6,7,8]. Pour une utilisation réussie de dispositifs basés sur GaN et des hétérostructures associées dans de telles applications et opérations, le dopage contrôlable de type n et de type p est la condition clé. À cet égard, la réalisation et le contrôle du dopage de type n dans les épicouches de GaN ou les monocristaux sont désormais largement optimisés par rapport à son homologue de type p qui constitue toujours un goulot d'étranglement pour les universités et l'industrie. Jusqu'à présent, Mg s'est avéré être le dopant de type p le plus efficace malgré son énergie d'activation élevée qui nécessite une grande quantité de concentrations de Mg (environ 10 19 cm −3 ou plus) à incorporer afin d'atteindre des concentrations de trous libres raisonnables proches de 10 18 cm −3 . Toute augmentation des concentrations atomiques de Mg au-delà de 10 19 cm −3 conduire à une diminution de la concentration en trous libres [9,10,11]. Ce phénomène est principalement attribué à la création de lacunes N [12,13,14], de défauts ponctuels liés au Mg [10, 15], ou de complexes chargés et/ou neutres liés aux lacunes Mg qui abaissent le niveau de Fermi et saturent le trou libre. concentration [16, 17]. Sur la base de mesures de photoluminescence donnant lieu à un pic à 2,9 eV, un défaut donneur profond complexe Mg-VN était également considéré comme l'une des principales raisons du mécanisme d'auto-compensation. [17,18,19]. Par conséquent, malgré le nombre de tentatives de recherche importantes effectuées pour comprendre l'incorporation de Mg dans GaN, ce problème reste encore flou et une analyse plus approfondie doit être effectuée.
La plupart des rapports antérieurs sur l'analyse des défauts à l'aide d'études microscopiques à l'échelle atomique sont basés sur des couches de GaN dopé au Mg cultivées sur du saphir en utilisant un dépôt chimique en phase vapeur métallique (MOCVD) ou une épitaxie par faisceau moléculaire (MBE). À notre connaissance, il n'y a que peu de rapports sur l'analyse des défauts dans les substrats GaN autoportants dopés au Mg et il n'y a aucun rapport sur l'analyse des défauts par microscopie électronique à transmission dans les substrats GaN autoportants où Mg est incorporé par implantation ionique. Il est maintenant bien admis que les substrats GaN autonomes présentent plusieurs avantages par rapport aux couches GaN développées par MOCVD/MBE sur des substrats étrangers en raison du niveau réduit de densités de dislocation et de leurs applications dans des dispositifs verticaux efficaces. Atteindre une activité suffisante de dopants de type p dans de tels substrats via l'implantation ionique doit être exploré pour la commercialisation et le développement de dispositifs d'éclairage à semi-conducteurs et de haute puissance à base de GaN. En gardant tous ces problèmes comme objectif principal, nous avons effectué une analyse structurelle détaillée des défauts incorporés au Mg dans les couches autonomes de GaN où l'incorporation du Mg est obtenue par dopage ainsi que par implantation ionique.
Méthodes expérimentales
Des substrats libres de n-GaN cultivés par épitaxie en phase vapeur d'hydrure sont utilisés dans notre étude. Ensuite, des couches épitaxiées sont développées par MOCVD sur ces substrats. L'incorporation de Mg est réalisée via deux approches :l'implantation ionique et le dopage épitaxié. Dans le premier cas, Mg est implanté dans une couche épitaxiale de GaN non dopé de 4 µm d'épaisseur sans déposer de couche de protection sur les couches de GaN non dopé, tandis que dans le second cas, du GaN dopé Mg d'une épaisseur de 1 µm est épitaxié sur 4 µm. -couches épaisses de GaN non dopées en continu. Pour une comparaison fiable, le niveau d'incorporation de Mg est maintenu identique à 4 × 10 19 cm −3 dans les deux cas. L'implantation de Mg est réalisée à 500°C suivie d'un recuit à 1350°C pour l'activation des dopants. Les énergies d'implantation sont prises comme 15, 30, 55, 95 et 180 keV avec des dosages respectifs de 3,0 × 10 13 , 5,5 × 10 15 , 1,1 × 10 14 , 1,9 × 10 14 , et 8 × 10 14 cm −2 , pour obtenir un profil de boîte de 200 nm de profondeur. Des mesures de Hall sont effectuées pour évaluer les propriétés électriques des échantillons de GaN dopés au Mg et implantés au Mg. Pour l'échantillon de GaN dopé au Mg, la concentration et la mobilité des trous sont de 3,4 × 10 17 cm −3 et 9,5 cm 2 /Vs. D'autre part, les propriétés électriques de l'échantillon implanté de Mg n'ont pas pu être évaluées correctement en raison de sa nature hautement résistive. La distribution de Mg en fonction de la profondeur est étudiée à l'aide de la spectrométrie de masse à ions secondaires (SIMS) tandis que l'analyse par microscopie électronique à transmission à balayage (STEM) est utilisée pour les investigations structurelles des défauts induits par le Mg. Pour cela, des STEM et des spectroscopies de rayons X à dispersion d'énergie électronique (EDS) ont été réalisées par JEOL JEM-ARM200F fonctionnant à 200 et 80 kV. Pour ces études, des échantillons MET ont été préparés par broyage par faisceau d'ions focalisé à l'aide de faisceaux de Ga suivi d'un broyage d'ions Ar à basse énergie refroidi à l'azote liquide.
Résultats et discussion
Analyse des défauts dans la couche de GaN implantée au Mg
La figure 1 (a) montre l'image en champ clair (BF)-STEM de GaN implanté de Mg tandis que (b) montre le profil SIMS correspondant. La flèche illustrée sur la figure 1(a) représente la direction positive [0001], et les images sont visualisées le long de l'axe de la zone [11\( \overline{2} \)0]. On peut voir que les défauts ne sont pas uniformément répartis en fonction de la profondeur, en fait, une corrélation directe est observée entre les concentrations de Mg et les défauts. La plupart des défauts sont accumulés à environ 150 nm de la surface où la concentration en Mg est supérieure à 10 19 cm −3 comme observé à partir des mesures SIMS. Pour une meilleure compréhension des défauts et de leurs visualisations dues à l'implantation de Mg dans GaN, l'imagerie est réalisée en condition d'axe hors zone en inclinant l'échantillon de 10° autour de l'axe c à partir de l'axe [11\( \overline{2} \)0] . Cette condition affaiblit le contraste de diffraction dû au cristal parfait et améliore le contraste des défauts ce qui permet une meilleure visualisation des défauts par rapport au milieu environnant. L'image BF-STEM d'un échantillon de GaN implanté de Mg pris dans ces conditions d'axe hors zone est montrée sur la figure 1 (c) où certains défauts de ligne sont observés à une profondeur d'environ 200 nm de la surface. Le profil Mg SIMS correspondant est présenté en (d) en échelle linéaire où une correspondance directe est observée entre l'existence de ces défauts linéaires et la concentration en Mg. Ces défauts se trouvent dans une région étroite où la concentration en Mg est d'environ 10 19 cm −3 plage.
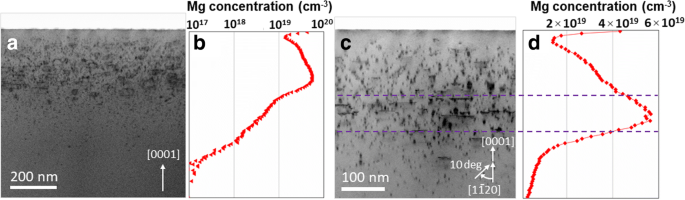
un Image STEM en champ clair en coupe transversale d'un échantillon de GaN implanté de Mg obtenu le long de l'axe [11\( \overline{2} \)0] et b profil de profondeur correspondant de Mg obtenu en utilisant SIMS. Pour une meilleure visualisation des défauts et de leur relation avec la concentration en Mg, l'imagerie est réalisée dans des conditions hors zone d'axe comme indiqué dans c . Profil Mg correspondant à c est affiché dans d à l'échelle linéaire où les défauts de ligne sont observés dans une région étroite ayant la concentration de Mg la plus élevée
En outre, l'imagerie BF-STEM à fort grossissement est réalisée dans des conditions d'axe hors zone, comme le montre la figure 2(a) avec (b) montrant la région sélectionnée de (a) à un grossissement plus élevé. Comme le montre (b), quatre types de structures étiquetées A, B, C et D sont observées. Les défauts étiquetés « A » sont de forme pyramidale tandis que « B » apparaissent comme des défauts de ligne.

un Image STEM en champ clair en coupe transversale d'un échantillon de GaN implanté de Mg obtenu dans des conditions hors zone d'axe pour renforcer les contrastes des défauts. Vue agrandie de la région marquée dans (a ) est présenté dans (b ) où quatre types différents de défauts étiquetés A, B, C et D sont observés. Image MET haute résolution des domaines pyramidaux étiquetés A dans (b ) est affiché dans (c ) avec représentation schématique en bas à droite. Le réseau déformé sur le domaine pyramidal sont représentés par compression (c ) comme indiqué dans (d ). Une image TEM à haute résolution d'un défaut typique de type C ou D est présentée dans (e ) avec image compressée dans (f ), montrant le contraste du champ de déformation autour du défaut
Les observations structurelles de ces défauts sont importantes du point de vue de la compréhension des mécanismes de compensation du Mg, et les prochaines sections du manuscrit sont principalement consacrées à l'analyse structurelle des défauts de type "A" et "B". Les structures représentées en « A » sont des défauts pyramidaux avec une direction positive [0001] pointant vers leur tête, leur base sur un plan [0001] à six parois sur des plans [11\( \overline{2} \)3] inclinés comme indiqué par image MET haute résolution d'un de ces défauts sur la figure 2(c). La représentation schématique d'un tel domaine pyramidal est également illustrée à la figure 2(c). La figure 2 (c) est comprimée perpendiculairement à la direction [0001] comme indiqué en (d) où le réseau semble être déformé dans le domaine pyramidal par rapport à la matrice GaN environnante, indiquant un déplacement entre les sous-réseaux Ga et N à l'intérieur et à l'extérieur de ces domaines pyramidaux . Ceci est cohérent avec les conclusions de Vennegues et al. [20] où l'on observe un type similaire de domaines pyramidaux. Les défauts de forme pyramidale similaires sont observés plus tôt dans les films GaN dopés au Mg et leur existence est généralement expliquée par la modification de la structure atomique du GaN due à l'introduction de Mg [19,20,21,22,23,24]. Liliental-Weber et al. [25, 26] ont proposé que de tels défauts pyramidaux proviennent d'amas riches en Mg présents près de la tête de ces pyramides. La structure de GaN en phase wurtzite est généralement décrite par un empilement hexagonal de N plans avec la moitié des N sites tétraédriques du sous-réseau remplis d'atomes de Ga. Vennegues et al. [27] sur la base de leurs recherches ont proposé que l'introduction d'un niveau plus élevé de Mg dans GaN entraîne la substitution de Ga par Mg, formant Mg3 N2 , un composé Mg-N signalé comme ayant une structure antibixbyite. La structure antibixbyte de Mg3 N2 correspond au remplissage de N sites tétraédriques du sous-réseau par Mg qui occupe trois sites sur quatre. Selon le modèle proposé par Vennegues et al. [27], un domaine pyramidal peut être considéré comme deux cristaux de GaN de polarité opposée séparés par une monocouche de Mg3 N2 . Ceci est confirmé par les recherches de Hansen et al. [28] où ces domaines pyramidaux ont été proposés pour être Mg3 N2 inclusions. Vennegues et al. [27] et Leroux et al. [23] ont également signalé que la formation de tels domaines pyramidaux ayant une taille nanométrique nécessite également une incorporation de Mg de faible à moyenne 10 19 cm −3 intervalle. Ceci est cohérent avec nos résultats où les défauts de forme pyramidale sont observés entre le bas et le milieu de 10 19 cm −3 Concentrations de Mg telles qu'elles ressortent de la corrélation entre l'image STEM (Fig. 1(c)) et le profil SIMS correspondant (Fig. 1(d)). Par conséquent, les défauts de forme pyramidale étiquetés comme structures "A" sur la figure 2 (b) de notre étude sont considérés comme des domaines pyramidaux riches en Mg et leur formation peut être directement liée au mécanisme de compensation du Mg dans les couches p-GaN. Les autres types de défauts illustrés à la figure 2(b) sont les défauts de type « C » et « D » qui sont essentiellement des structures similaires avec des variations dans leurs dimensions. Le contraste qui semble être allongé le long de la direction [0001] lorsqu'il est vu à partir de l'axe [11\( \overline{2} \)0], est probablement dû à une déformation. Pour clarifier davantage cela, une image MET à haute résolution d'un tel défaut similaire est présentée sur la figure 2(e) avec (f) montrant la même image comprimée perpendiculairement à la direction [0001]. Le réseau déformé le long de la direction [0001] suggère une constante de réseau différente en raison d'un champ de déformation différent le long de cette direction. Comme Mg est de plus petite taille par rapport à Ga, son incorporation sur les sites Ga devrait produire une contrainte dans le réseau qui peut conduire à ce contraste autour de ces défauts.
Un autre type de défauts, étiqueté « B » sur la figure 2 (b) semble être des défauts de ligne perpendiculaires à la direction [0001], vus depuis l'axe [11\( \overline{2} \)0]. Il est important de noter que ce type de défauts semble s'accumuler dans une région étroite ayant des concentrations de Mg plus élevées (comme observé à partir de la correspondance entre l'image BF-STEM et le profil Mg SIMS illustré à la Fig. 1(c) et (d)) qui suggère que leur formation est associée à la surincorporation de Mg. Une autre observation est la présence des domaines pyramidaux sur les bords de ces défauts linéaires qui indiquent que l'accumulation de ces domaines peut entraîner leur formation. Cependant, il ne faut pas exclure qu'il puisse s'agir simplement d'un chevauchement aléatoire de défauts pyramidaux et linéaires et des investigations supplémentaires sont nécessaires dans cette direction. L'image BF-STEM montrant ces types de défauts est présentée sur la figure 3(a). Pour une meilleure compréhension de ces défauts, l'échantillon est incliné à environ 10° autour de l'axe perpendiculaire à la direction [0001] et l'image BF-STEM obtenue est représentée sur la figure 3(b). Cette inclinaison de l'échantillon excite fortement les taches de diffraction dans la direction 1-100, ce qui se traduit par un contraste accru du champ de contrainte dans la direction entourant le défaut. À partir de ce contraste de champ de déformation, le défaut qui est apparu sous la forme de la ligne (voir Fig. 2(a) et (b)) consiste en fait en une paire de lignes séparées de quelques nm, plus profondes dans la direction [0001].

un Image STEM en champ clair en coupe transversale d'un échantillon de GaN en vrac implanté de Mg pour l'analyse des défauts de type B qui apparaissent comme des pyramides tronquées ou une forme trapézoïdale. b représente l'image prise en inclinant l'échantillon à 10° autour de l'axe perpendiculaire à c -axe où un contraste différent est observé aux bords de ces défauts
Il pourrait y avoir une possibilité de présence de Mg dans ces défauts car ils apparaissent dans la région plus étroite où la concentration de Mg est supérieure à 10 19 cm −3 comme observé à partir de la correspondance entre l'image STEM (Fig. 1(c)) et le profil Mg SIMS (Fig. 1(d)). Pour valider cette croyance de ces types de défauts ayant du Mg, nous avons effectué des mesures de microscopie électronique à transmission à balayage-spectroscopie à dispersion d'énergie (STEM-EDS) avec un diamètre de sonde EDS inférieur à 0,2 nm, dans deux régions différentes :« loin du défaut » et « au défaut » étiqueté comme les points 1 et 2 respectivement, comme indiqué sur la figure 4(a). Les spectres EDS comparatifs des points 1 et 2 dans la plage d'énergie de 1,19 keV à 1,35 keV où le pic de Mg est attendu sont tracés sur la figure 4(b) avec un encart montrant les spectres EDS complets. La présence de Mg est clairement visible au niveau du défaut (point 2). Pour justifier davantage cela, nous avons effectué une cartographie STEM-EDS sur un échantillon similaire de GaN implanté de Mg. La figure 4 (c) présente l'image STEM d'un échantillon de GaN implanté de Mg avec des flèches vers le bas montrant ces défauts de ligne, et la carte EDS correspondante de Mg est illustrée à la figure 4 (d). La présence de Mg est clairement visible dans ces défauts. Par conséquent, ces défauts contiennent du Mg et leur formation à des concentrations en Mg supérieures à 10 19 cm −3 est susceptible d'être une autre cause de compensation Mg.

un Image STEM en coupe d'un échantillon de GaN implanté de Mg montrant un défaut individuel de type « B ». Les points 1 et 2 représentent les régions où les mesures EDS sont effectuées et les spectres EDS résultants sont affichés dans b . Les spectres EDS dans la gamme d'énergie de 1,19 à 1,40 keV sont tracés dans b avec en médaillon montrant les spectres EDS complets avec les pics Ga et N. c et d présentez l'image STEM et la carte Mg correspondante d'un échantillon en vrac implanté de Mg similaire montrant la présence de Mg dans ces types de défauts
Analyse des défauts dans la couche GaN dopé Mg
Ensuite, nous avons effectué des investigations structurelles sur l'échantillon de GaN où une couche de GaN dopé au Mg de 1 µm d'épaisseur est épitaxiée sur une couche épitaxiale de GaN non dopé de 4 µm d'épaisseur. Il convient de mentionner à nouveau que le niveau de Mg est maintenu le même, c'est-à-dire 4 × 10 19 cm −3 pour une comparaison significative entre deux approches d'incorporation de Mg :épitaxie dopée et implantation ionique. La figure 5(a) montre une image BF-STEM de GaN dopé au Mg cultivé par épitaxie sur des substrats de GaN autonomes, vue le long de [11\( \overline{2} \)0] tandis que (b) montre le profil de Mg en fonction de la profondeur de GaN obtenu à l'aide de SIMS. Notez que la concentration en Mg reste presque constante à environ 4 × 10 19 cm −3 dans le champ de vision de la figure 5(a) (jusqu'à 700 nm) contrairement au cas antérieur de GaN implanté avec Mg où la concentration de Mg était fonction de la profondeur de GaN (voir les figures 1 (a)–(d )).
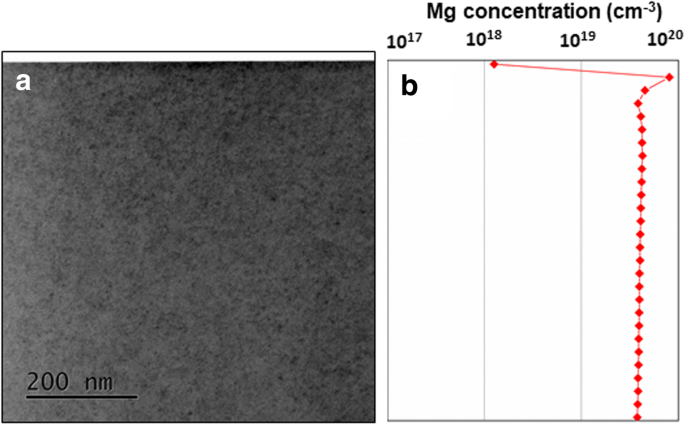
un Image STEM en champ clair en coupe transversale d'un échantillon de GaN en vrac dopé au Mg obtenu le long de l'axe [112 ̅0] et b profil de profondeur correspondant de Mg obtenu en utilisant SIMS. Les défauts en forme de points sont uniformément répartis dans l'échantillon
Pour effectuer une analyse des défauts dans un échantillon de GaN dopé au Mg, imagerie STEM dans des conditions hors zone d'axe en inclinant l'échantillon à 10° autour de c -axis de l'axe [11\( \overline{2} \)0] est exécuté. Les figures 6 (a) et (b) représentent les images BF-STEM et DF-STEM où des défauts en forme de points ayant une taille d'environ 5 nm sont observés comme étant uniformément répartis dans l'échantillon. Notez ici que le profil Mg semble également être uniforme dans ce cas, comme observé à partir du profil SIMS (voir Fig. 5(b)). La distribution uniforme de Mg et de ces défauts dans l'échantillon de GaN suggère une corrélation directe entre ces défauts et l'incorporation de Mg. Ces défauts en forme de points d'environ 5 nm sont susceptibles d'être des précipités de Mg (et éventuellement des défauts d'empilement induits par celui-ci). En raison de leur petite taille, les précipitations de Mg elles-mêmes n'ont pas pu être directement confirmées par les mesures EDS (les pics de Ga et de Mg sont assez proches les uns des autres, ce qui rend la cartographie des petites différences de concentration extrêmement difficile).
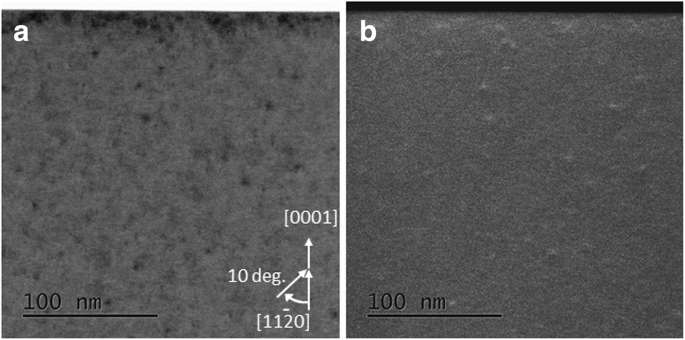
Transversal a STEM-BF et b Images STEM-ADF d'un échantillon de GaN en vrac dopé au Mg obtenues dans des conditions hors zone pour renforcer les contrastes de défauts
Cette observation est complètement différente du cas précédent de l'échantillon implanté de Mg où les défauts se sont accumulés à 200 nm de la surface où la concentration de Mg était maximale. De plus, contrairement à l'échantillon implanté de Mg, nous n'avons observé aucun défaut pyramidal et à deux lignes (étiquetés A et B sur la figure 2(b)) dans l'échantillon de GaN dopé au Mg. Il est intéressant de noter que des défauts pyramidaux et linéaires sont également signalés dans les échantillons de GaN où Mg est incorporé par des techniques autres que l'implantation ionique. Par exemple, Khromov et al. [29] ont rapporté l'existence de défauts pyramidaux dans des échantillons de GaN dopé au Mg cultivés par MOCVD. Cependant, ils n'ont observé de tels défauts que dans un échantillon de GaN plus dopé où la concentration en Mg était d'environ ~ 5 × 10 19 cm −3 . Cependant, dans les échantillons avec Mg ~ 2 × 10 18 cm −3 , ces domaines pyramidaux n'ont pas été observés. Vennegues et al. [27] ont également observé de tels domaines pyramidaux dans des échantillons de GaN dopé au Mg cultivés par MOCVD avec des concentrations de Mg se situant au milieu de 10 19 cm −3 intervalle. Ils n'ont pas observé de tels défauts dans l'échantillon avec des concentrations de Mg inférieures à 10 19 cm −3 . Dans notre travail, un niveau similaire de Mg ~ 4 × 10 19 cm −3 est incorporé par implantation ionique et dopage épitaxié pour analyser la présence de ces défauts. Ces défauts ne sont observés que dans l'échantillon implanté de Mg, pas dans l'échantillon dopé au Mg, ce qui suggère que la distribution de Mg devrait également être considérée pour expliquer leur existence. D'après les mesures SIMS, le Mg s'avère non uniformément distribué dans l'échantillon implanté de Mg (Fig. 1(b) et (d)) tandis que l'échantillon dopé au Mg a montré une distribution uniforme de Mg (Fig. 5 (b)). De plus, dans l'échantillon implanté de Mg, ces défauts se sont avérés n'exister que dans une fenêtre étroite avec une concentration de Mg plus élevée par rapport à la matrice environnante. Par conséquent, la formation de ces défauts est liée au niveau de Mg incorporé et à la distribution de Mg et ils sont susceptibles de se former dans les régions où Mg se situe dans la plage de 10 19 cm −3 . Il semble que le profil de Mg non uniforme dans l'échantillon implanté de Mg entraîne une distribution non uniforme des défauts. Cependant, il ne faut pas nier les possibilités telles que des défauts distribués de manière non uniforme provoquant une distribution de Mg non uniforme ou une dépendance du profil d'implantation de Mg sur l'existence de tels défauts ; par conséquent, des investigations supplémentaires sont nécessaires dans cette direction. Notre analyse comparative des défauts dans le GaN incorporé au Mg suggère que la nature et le type des défauts dépendent de la méthode d'incorporation.
Conclusions
Pour résumer, les investigations structurelles basées sur la microscopie électronique à transmission à balayage des défauts dans les épi-couches implantées au Mg et dopées au Mg sur des substrats autoportants de GaN ont révélé que la nature des défauts dépend fortement de la méthode d'incorporation du Mg. Le GaN implanté au Mg a montré la présence de domaines pyramidaux pointant vers la direction [0001] et des défauts à deux lignes avec des caractéristiques séparées de quelques nanomètres plus profondément dans la direction [0001]. On pense que les domaines pyramidaux sont Mg3 N2 à base de structures alors que les défauts de ligne ont également du Mg comme observé par la spectroscopie à dispersion d'énergie. Ces défauts de ligne se trouvent à une profondeur d'environ 200 nm de la surface, dans une région étroite ayant une concentration en Mg d'environ 10 19 cm −3 ce qui suggère que leur formation est liée au niveau de concentration en Mg implanté. On s'attend à ce que la formation de ces défauts dans GaN sur l'implantation de Mg contribue de manière significative aux mécanismes d'auto-compensation de Mg conduisant à un dopage de type p inefficace. Au contraire, l'échantillon de GaN dopé au Mg n'a montré que la présence de défauts en forme de points qui se sont avérés être uniformément répartis sur l'ensemble de l'échantillon. La présente étude mettant en évidence la dépendance de la méthode d'incorporation de Mg et ses concentrations sur la nature et le type de défauts peut s'avérer utile pour choisir la quantité appropriée de Mg à incorporer pour atteindre une conductivité de type p élevée dans les matériaux à base de GaN pour un fonctionnement efficace de l'appareil.
Abréviations
- ADF :
-
Champ sombre annulaire
- BF :
-
Champ clair
- EDS :
-
Spectroscopie à dispersion d'énergie
- MBE :
-
Epitaxie par faisceau moléculaire
- MOCVD :
-
Dépôt chimique en phase vapeur métal-organique
- SIMS :
-
Spectrométrie de masse ionique secondaire
- STEM :
-
Microscopie électronique à transmission à balayage
Nanomatériaux
- Exemples de circuits et de listes d'interconnexions
- Méthode et analyse du courant de maillage
- 5G et GaN :le passage du LDMOS au GaN
- 5G et GaN :futures innovations
- Analyse de l'actine et de l'organisation de l'adhésion focale dans des cellules U2OS sur des nanostructures polymères
- Analyse de la réflectance infrarouge de couches de GaN dopées épitaxiales de type n cultivées sur du saphir
- Électrofilage sur des substrats isolants en contrôlant la mouillabilité et l'humidité de la surface
- Fabrication de couches minces SrGe2 sur des substrats Ge (100), (110) et (111)
- Une étude sur les nanofibres de carbone et le charbon actif en tant que supercondensateur symétrique dans l'électrolyte aqueux :une étude comparative



