Études expérimentales et théoriques du contact Mo/Au Schottky sur une couche mince de β-Ga2O3 exfoliée mécaniquement
Résumé
Nous avons étudié le mécanisme d'émission de courant inverse du Mo/β-Ga2 O3 Diode à barrière Schottky à travers les caractéristiques courant-tension (IV) dépendantes de la température de 298 à 423 K. La variation du courant inverse avec le champ électrique indique que l'émission Schottky est le mécanisme de transport de porteur dominant sous polarisation inverse plutôt que le Frenkel-Poole modèle d'émission assisté par piège. De plus, une tension de claquage de 300 V a été obtenue dans Fluorinert ambiant avec un champ électrique moyen de 3 MV/cm en Mo/β-Ga2 O3 Diode à barrière Schottky. Les effets des états de surface, sur la distribution du champ électrique, ont également été analysés par simulation TCAD. Avec l'augmentation des densités de charge de surface négatives, le champ électrique de crête diminue de façon monotone. De plus, l'inhomogénéité de la hauteur de la barrière Schottky sous biais direct a également été discutée.
Contexte
Récemment, le semi-conducteur à bande interdite ultra-large β-Ga2 O3 a suscité beaucoup d'intérêt pour ses excellentes caractéristiques, telles qu'une stabilité chimique élevée, une large bande interdite directe de 4,8 à 4,9 eV, un champ électrique de claquage théorique élevé (E BR ) de 8 MV/cm, et une figure de mérite élevée de Baliga de 3 400, qui est environ dix fois supérieure à celle du SiC et quatre fois supérieure à celle du GaN [1,2,3]. La combinaison de toutes ces propriétés avec la haute qualité, la grande surface et le β-Ga2 rentable O3 substrat cultivé par des techniques de croissance à l'état fondu fait du β-Ga2 O3 un matériau préféré pour les applications électroniques haute tension et haute puissance [4,5,6,7,8,9]. En tant qu'appareil électronique prometteur, le β-Ga2 O3 Les diodes à barrière Schottky (SBD) ont été fabriquées avec divers métaux d'électrode d'anode, notamment Cu [8], Pd [10], Pt [5, 6, 11,12,13], Au [10, 14], Ni [13, 15 ,16,17,18] et TiN [12], et ses caractéristiques électriques directes et inverses, telles que la résistance à l'état passant spécifique, I sur /Je désactivé rapport, les hauteurs de barrière, le courant de fuite inverse et la tension de claquage, ont été étudiés de manière approfondie. La hauteur de barrière Schottky non homogène et le courant de polarisation inverse non saturant ont été rapportés dans β-Ga2 O3 SBD [6, 8, 11, 18, 19] alors que beaucoup moins d'informations étaient connues sur le mécanisme de transport des porteurs sous polarisation inverse, ce qui est essentiel pour l'amélioration de la tension de claquage.
De plus, aucune enquête n'a été menée pour analyser les mécanismes d'émission de Mo/β-Ga2 O3 prendre contact. S'il y a des pièges ou des défauts dans le β-Ga2 O3 substrat, le courant de fuite sera en accord avec le modèle d'émission de Frenkel-Poole, et le courant inverse est l'émission d'électrons à partir d'un état piégé près de l'interface métal-semi-conducteur. Sinon, le processus principal dans le courant inverse sera dominé par l'émission Schottky que les électrons au-dessus de la barrière Schottky entraînent un courant inverse. -Ga2 O3 le cristal a également une propriété unique, une grande constante de réseau de 12,23 Å le long de la direction [100], qui permet un clivage facile en ceintures minces ou nano-membranes [9, 20]. Ainsi, dans ce travail, nous avons exfolié mécaniquement le β-Ga2 à grande échelle O3 à partir d'un substrat en vrac à faible densité de dislocation, et pour la première fois, le molybdène (Mo) thermiquement stable a été choisi comme métal d'électrode d'anode pour fabriquer le -Ga2 O3 diodes à barrière Schottky verticales. Le mécanisme de conduction électrique sous polarisation inverse a été discuté dans la plage de températures de 298 à 423 K. Ce travail fournit des informations sur les mécanismes de transport de porteurs qui peuvent aider à améliorer les fonctionnalités de β-Ga2 O3 -appareils basés.
Méthodes/Expérimental
Comme le montre la Fig. 1a, b, la diode à barrière Schottky a été fabriquée sur le β-Ga2 O3 (100) film exfolié mécaniquement à partir du β-Ga2 dopé au Sn O3 substrat, avec une épaisseur de 15 μm et une concentration électronique de 2 × 10 17 cm − 3 . Comme présenté dans la Fig. 1d, e, la pleine largeur à mi-hauteur (FWHM) et la moyenne quadratique (RMS) ont été estimées à 51,9 arcsec et 0,19 nm, respectivement, par diffraction des rayons X à haute résolution (HRXRD) et atomique mesures au microscope à force (AFM). Une excellente qualité de cristal et une surface lisse ont été confirmées par la mesure. Après un nettoyage chimique humide, la pile métallique Ti/Au (20 nm/100 nm) a été déposée par évaporation par faisceau électronique sur la face arrière et suivie d'un recuit thermique rapide (RTA) à 600 °C pendant 60 s sous atmosphère d'azote pour former le contact ohmique. Les électrodes circulaires d'anode Schottky d'un diamètre de 100 μm ont été formées sur la face avant par évaporation de métaux Mo/Au (40 nm/100 nm) et processus de décollement. La figure 1c montre la structure de la section transversale schématique du -Ga2 O3 SBD dans ce travail.
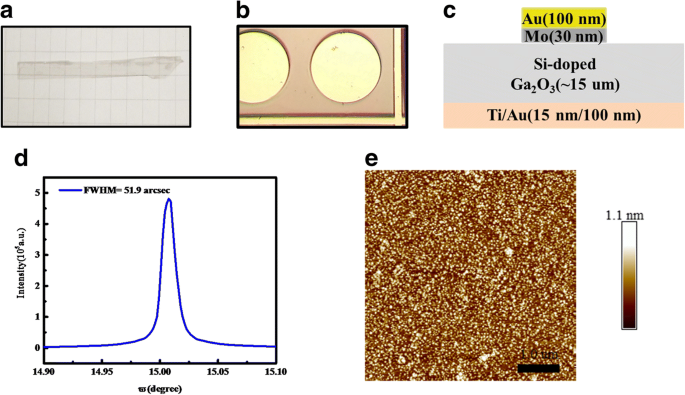
un Le -Ga2 dopé au Sn O3 substrat d'une épaisseur de 300 μm. b Les électrodes d'anode Schottky formées sur la face avant avec des diamètres de 100 μm. c La structure du schéma à travers la section du -Ga2 O3 SBD. d Courbe de bascule XRD et e Image AFM du -Ga2 O3 couche de dérive exfoliée mécaniquement à partir de (100) β-Ga2 O3 substrat
Résultats et discussion
Les caractéristiques courant-tension (I-V) de Au/Mo/β-Ga2 O3 Les diodes à barrière Schottky ont été étudiées à l'aide d'un système de caractérisation des semi-conducteurs Keithley 4200 entre 298 et 423 K. Comme le montre la figure 2a, le I sur /Je désactivé le ratio est proche de 10 10 à 298 K, indiquant un bon comportement de redressement. Pour le biais direct de 0,1 à 0,7 V, les courbes I-V semilogarithmiques sont presque linéaires et présentent un comportement fortement dépendant de la température. La polarisation directe augmentant encore, l'écart par rapport à la linéarité des courbes IV est attribué à la résistance série de la diode à barrière Schottky et la relation entre la tension appliquée et le courant peut être exprimée sous la forme \( I={I}_s\left \{\exp \left[\frac{q\left(V-{IR}_s\right)}{nkT}\right]-1\right\} \) [21,22,23], où V est la tension appliquée, R s la résistance série, T la température absolue, k la constante de Boltzmann, n le facteur d'idéalité, et I s est le courant de saturation inverse. Le n et Je s peut être déterminé à partir de la pente et de l'interception du ln I-V plots, respectivement. Pour la diode barrière Schottky idéale, le facteur d'idéalité n doit être égal à l'unité. Plus le n est élevé , plus l'écart par rapport au modèle d'émission thermique (TE) est grand. De plus, selon l'équation \( {\phi}_b=\frac{kT}{q}\ln \left[\frac{AA^{\ast }{T}^2}{I_s}\right] \ ) [21,22,23], les valeurs de ϕ b à différentes températures ont également été déterminés, comme le montre la figure 2b, où ϕ b est la hauteur de la barrière, A est la surface de la diode et A * est la constante de Richard effective 40,8 A cm −2 K − 2 avec le -Ga2 O3 masse effective de m * = 0,34 m 0 [5, 24]. Avec une augmentation de la température de 298 à 423 K, le ϕ b augmente tandis que n diminue, indiquant un autre mécanisme de transport contribuant également au transport actuel et conduisant à la déviation des caractéristiques I-V du modèle TE pur, qui a été rapporté précédemment dans β-Ga2 O3 Diodes à barrière Schottky [25] et autres dispositifs à large bande interdite [26,27,28,29,30]. L'analyse de l'inhomogénéité de la hauteur de barrière peut être décrite par une distribution gaussienne en hauteurs de barrière,
$$ {\phi}_b=\overline{\phi_{b0}}\left(T=0\right)-\frac{q{\sigma}_s^2}{2 kT} $$ (1)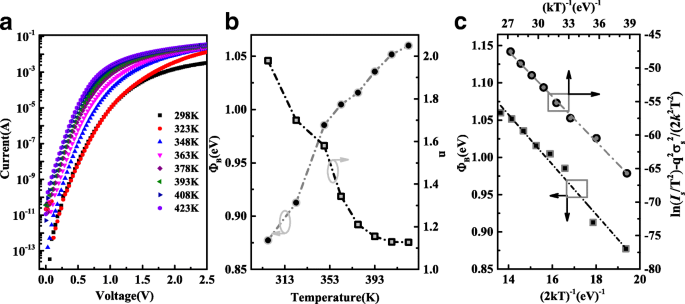
un Caractéristiques I-V directes de Mo/β-Ga2 O3 Diodes à barrière Schottky à différentes températures. b Dépendance de la température du facteur d'idéalité et de la hauteur de barrière Schottky de β-Ga2 O3 Diode à barrière Schottky. c Parcelles de ϕ ap contre q/2k T et tracé de Richardson modifié versus 1/k T pour le -Ga2 O3 Diodes à barrière Schottky
Les valeurs de la hauteur de barrière moyenne \( \overline{\phi_{b0}} \) et l'écart type σ s sont extraits à 1,55 eV et 0,186 eV, respectivement, de la figure 2c. De plus, compte tenu des inhomogénéités de hauteur de barrière, le graphique de Richardson conventionnel est modifié comme suit :
$$ \ln \left(\frac{I_{\mathrm{s}}}{T^2}\right)-\left(\frac{q^2{\sigma}_{\mathrm{s}}^ 2}{2{k}^2{T}^2}\right)=\ln \left({AA}^{\ast}\right)-\frac{q\overline{\phi_{b0}}} {kT} $$ (2)Comme le montre la figure 2c, le \( \ln \left({I}_{\mathrm{s}}/{T}^2\right)-\left({q}^2{\sigma}_ {\mathrm{s}}^2/2{k}^2{T}^2\right) \) contre 1/kT est une ligne droite. L'interception de la courbe est utilisée pour obtenir le A * de 44,7 A cm −2 K −2 , ce qui est très proche de la valeur théorique de -Ga2 O3 de 40,8 A cm −2 k −2 . Par conséquent, les inhomogénéités de barrière à l'interface métal/semi-conducteur pour β-Ga2 O3 SBD peut être expliqué par TE avec une distribution gaussienne de barrière sur les SBH.
La mesure de claquage inverse à température ambiante a également été effectuée à l'aide du système d'analyseur de semi-conducteurs haute tension Agilent B1505A, comme illustré à la Fig. 3. La tension de claquage était de 260 V alors qu'elle était de 300 V avec l'échantillon immergé dans Fluorinert ™ produit par la société 3M ce qui peut empêcher la ventilation de l'air sous une polarisation inverse élevée. Afin de comprendre la distribution du champ électrique, une simulation numérique a été réalisée avec le logiciel ATLAS, comme le montre la Fig. 4a, b. Avec l'augmentation de la distance entre l'interface entre le semi-conducteur et l'anode jusqu'à environ 1 μm, le champ électrique diminue progressivement. À la position de x = 4 μm, le champ électrique moyen est de 3 MV/cm, calculé à partir de la figure 4c. Également montré sur la figure 4d, à la position de y = 1 nm, le champ électrique maximal à la tension de claquage était d'environ 8 MV/cm au bord du contact Schottky, soit environ 2,7 fois celui du champ électrique moyen. Comme rapporté par AJ Green et al [31] et K. Zeng et al [32], le champ électrique de crête et le champ électrique moyen du bord de l'électrode étaient respectivement de 5,3, 3,8 MV/cm et 6,1, 4,4 MV/cm, et le champ électrique de crête de Mo/Ga2 O3 La diode Schottky est relativement élevée. On suppose que le -Ga2 O3 La nano-membrane obtenue par exfoliation mécanique possède un grand nombre de liaisons pendantes et d'états de surface qui capteront les électrons pour épuiser les porteurs de l'anode à la cathode sous polarisation inverse [33]. En tenant compte de la charge de surface négative, le résultat de la simulation a montré que le champ électrique au bord du contact Schottky était réduit avec des densités de charge de surface négative augmentant de 0,5 × 10 13 cm −2 à 3 × 10 13 cm −2 , respectivement. Surtout avec les densités de charge de surface négatives de 3 × 10 13 cm −2 , le champ électrique de crête au bord du contact Schottky est d'environ 5,2 MV/cm. Par conséquent, la tension de claquage inverse 300 V peut être atteinte sur le β-Ga2 O3 nano-membrane avec N D = 3 × 10 17 cm −2 sans aucune structure de terminaison de bord. Comme le montre la figure 4d, en raison de l'existence de l'état de l'interface à X -position inférieure à 2 μm, les électrons peuvent être piégés et la région d'épuisement peut être formée, ce qui entraîne le champ électrique dans le Y direction. Au fur et à mesure que la concentration de l'état de l'interface augmente, le champ électrique dans le Y direction augmente, bien que le champ électrique dans le X direction se rapproche de zéro. Donc le champ électrique augmente à X -position inférieure à 2 μm.
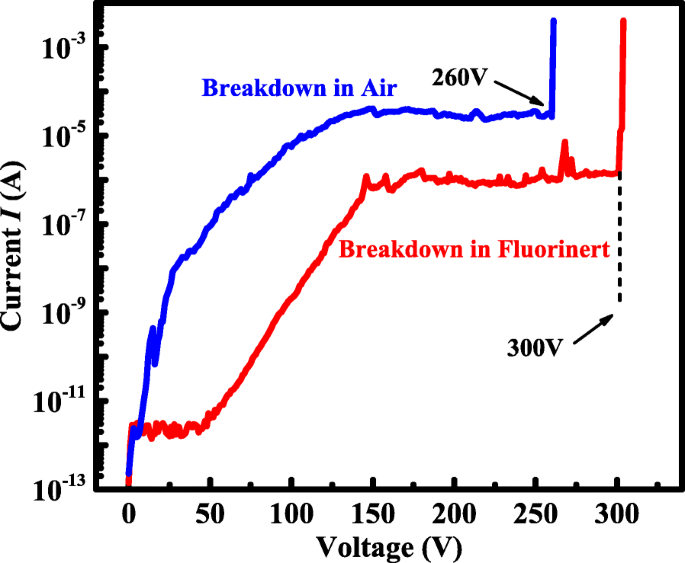
Les caractéristiques I-V inverses du -Ga2 O3 échantillons à température ambiante respectivement en Fluorinert et air

un Simulation du champ électrique TCAD à l'état bloqué des diodes à barrière Schottky sous -300 V de polarisation. b La simulation de champ électrique des régions sélectionnées dans la boîte en pointillés verts. Le potentiel le long du y axe à x = 4 μm est présent dans (c ), et le champ électrique au bord du contact Schottky réduit avec différentes densités de charge de surface négative effective sont présents dans (d )
Par contre, avec le biais inverse V re croissant, le courant de fuite I re augmente au lieu de saturer pour |V |> 3 k B T/q , comme le montre la figure 5a, ce qui est incompatible avec la théorie TE. Par conséquent, l'émission thermoionique améliorée par champ électrique a été considérée pour discuter de la dépendance de la I re sur V re , incluant l'émission Poole-Frenkel et l'émission Schottky [34, 35]. Dans l'émission Poole-Frenkel, les électrons transportent du métal dans le semi-conducteur via un état piégé et le I re est donné par
$$ {I}_{re}\propto E\exp \left(\frac{q}{kT}\sqrt{\frac{qE}{{\pi \varepsilon}_S}}\right) $$ (3 )tandis que dans l'émission Schottky, les électrons gagneront suffisamment d'énergie pour surmonter la barrière au niveau du métal/semi-conducteur pour former le courant et le I re peut être exprimé par
$$ {I}_{re}\propto {T}^2\exp \left(\frac{q}{2 kT}\sqrt{\frac{qE}{{\pi \varepsilon}_S}}\right ) $$ (4)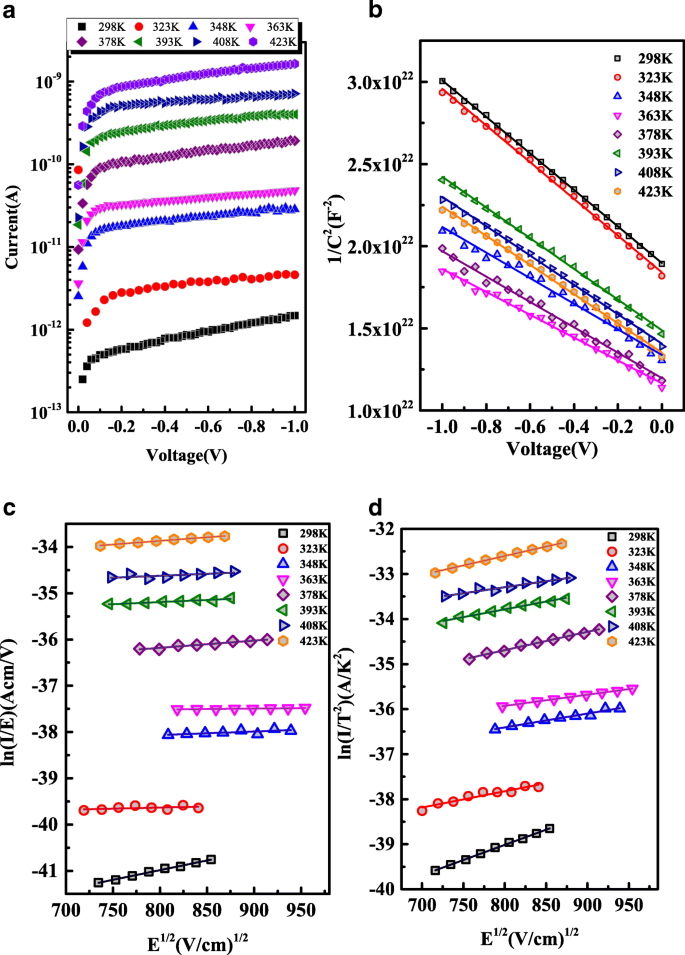
un Inverser les caractéristiques I-V de Mo/β-Ga2 O3 Diodes à barrière Schottky à différentes températures. b Dépendance à la température de 1/C 2 caractéristiques du Mo/ β-Ga2 O3 Diodes à barrière Schottky. L'analyse de dépendance au champ électrique de Mo/β-Ga2 O3 Contact Schottky avec mécanisme différent. c Mécanisme Poole-Frenkel (I /E ) contre E 1/2 et d Mécanisme Schottky ln (Je /T 2 ) contre E 1/2
où ε s est la permittivité du -Ga2 O3 (~ 10 ε0 ) et E est le champ électrique appliqué, calculé par \( E\kern0.5em =\kern0.5em \sqrt{\frac{2{qN}_D}{\varepsilon_S}\left(V+{V}_{bi}-\frac {k_BT}{q}\right)} \), N D est la densité de donneurs du -Ga2 O3 , et V bi est le potentiel intégré. Comme le montre la figure 5b, N D et V bi peut être extrait de la pente et de l'interception de la capacité carrée inverse (1/C 2 ) contre le V re tracés utilisant l'expression suivante
$$ \frac{1}{C^2}=\frac{2\left({V}_{\mathrm{bi}}- kT/qV\right)}{q{\varepsilon}_s{A}^ 2{N}_D} $$ (5)Si la courbe de ln (I/T 2 ) contre E 1/2 est linéaire, le mécanisme d'émission de Schottky est dominant. Et si l'intrigue de ln (Je /E ) contre E 1/2 est de ligne, l'émission Poole-Frenkel domine le transport à courant inverse. La figure 5c, d représente les tracés de ln (Je /E ) et ln (Je /T 2 ) contre E 1/2 , respectivement. Les deux séries de courbes sont linéaires, indiquant non seulement l'émission Poole-Frenkel mais aussi l'émission Schottky sont présentes. Afin de clarifier le mécanisme de transport de porteurs dominant, la pente des courbes ou le coefficient d'émission peut être exprimé sous la forme [34,35,36].
$$ S=\frac{q}{nkT}\sqrt{\frac{q}{\pi \varepsilon}} $$ (6)où n = 1 est pour l'émission Poole-Frenkel (S PF ) et n = 2 pour l'émission Schottky (S S ). Les valeurs expérimentales de S sont notés S m-PF et S m-S pour l'émission de Poole-Frenkel et Schottky donnée par la pente des courbes de la Fig. 5c, d, respectivement. Les rapports de la valeur expérimentale à la valeur théorique, N PF (=S m-PF /S PF ) et N S (=S m-S /S S ), sont illustrés à la Fig. 6. Étant donné que les valeurs de N S sont plus proches de l'unité que ceux de N PF , le courant inverse est dominé par l'émission Schottky.

Graphiques des coefficients relatifs des émissions de Poole-Frenkel N PF (=S m-PF /S PF ) et émission Schottky N S (=S m-S /S S ) en fonction de la température
Conclusions
Nous avons étudié les caractéristiques électriques des diodes à barrière Mo/Au Schottky fabriquées sur le (100) β-Ga2 O3 film exfolié mécaniquement à partir du -Ga2 dopé au Sn O3 substrat. Sur la base du modèle TE, le ϕ extrait b et n augmente et diminue avec l'augmentation de la température, respectivement. En supposant la distribution gaussienne de hauteur de barrière inhomogène, la hauteur de barrière moyenne de 1,55 eV et l'écart type de 0,186 eV ont été obtenus. Enfin, selon le ln (Je /T 2 ) et ln (Je /E ) contre E 1/2 plots, le paramètre N S de l'émission Schottky est proche de l'unité, illustrant l'émission Schottky étant le mécanisme de transport dominant du courant inverse. La tension de claquage de 300 V avec des échantillons en Fluorinert est obtenue dans des diodes à barrière Mo/Au Schottky avec un champ électrique moyen de 3 MV/cm, indiquant le grand potentiel du β-Ga2 O3 pour les applications d'électronique de puissance.
Abréviations
- I-V :
-
Courant-tension
- Mo :
-
Molybdène
- RTA :
-
Recuit thermique rapide
- SBD :
-
Diode barrière Schottky
- TE :
-
Émission thermoionique
Nanomatériaux
- Recherche expérimentale sur la stabilité et la convection naturelle du nanofluide TiO2-eau dans des enceintes avec différents angles de rotation
- L'effet du plasma de contact hors équilibre sur les propriétés structurelles et magnétiques des spinelles Mn Х Fe3 − X О4
- Étude expérimentale sur les caractéristiques d'écoulement et de transfert de chaleur de nanofluides TiO2-eau dans un tube cannelé en spirale
- Fabrication de couches minces SrGe2 sur des substrats Ge (100), (110) et (111)
- Nanoassemblages 5-aminolévulinique-squalène pour la photodétection et le traitement des tumeurs :études in vitro
- Étude de la force d'adhérence et de la transition vitreuse de films minces de polystyrène par microscopie à force atomique
- Préparation et caractéristiques thermoélectriques du thermocouple à couche mince ITO/PtRh:PtRh
- Études TEM et STEM sur les morphologies transversales de films antireflet SiO2 à large bande double/tricouche
- Études théoriques sur les photodiodes d'avalanche InGaAs/InAlAs SAGCM



