Études théoriques sur les photodiodes d'avalanche InGaAs/InAlAs SAGCM
Résumé
Dans cet article, nous fournissons un aperçu détaillé des photodiodes séparées d'absorption, de gradation, de charge et de multiplication InGaAs/InAlAs (APD SAGCM) et un modèle théorique d'APD est construit. Grâce à une analyse théorique et à une simulation bidimensionnelle (2D), l'influence de la couche de charge et de l'effet tunnel sur les APD est parfaitement comprise. La conception de la couche de charge (y compris le niveau de dopage et l'épaisseur) peut être calculée par notre modèle prédictif pour différentes épaisseurs de multiplication. Nous constatons que lorsque l'épaisseur de la couche de charge augmente, la plage de niveaux de dopage appropriée dans la couche de charge diminue. Par rapport à une couche de charge plus mince, les performances de l'APD varient considérablement via des écarts de plusieurs pour cent des concentrations de dopage dans une couche de charge plus épaisse. De plus, le taux de génération (G btt ) du tunnel bande à bande est calculé et l'influence de l'effet tunnel sur le champ d'avalanche a été analysée. Nous confirmons que le champ d'avalanche et le facteur de multiplication (M n ) en multiplication diminuera par effet tunnel. Le modèle théorique et l'analyse sont basés sur l'APD InGaAs/InAlAs ; cependant, ils s'appliquent également à d'autres systèmes de matériel APD.
Contexte
En0,53 Ga0.47 Les photodiodes à avalanche (APD) As (appelées ci-après InGaAs) sont les photodétecteurs les plus importants pour la détection infrarouge à ondes courtes. Ils sont importants dans les domaines traditionnels, tels que la communication par fibre optique, les applications de reconnaissance et la télédétection. InP et In0,52 Al0,48 As (appelé ci-après InAlAs) ont le même espacement de réseau avec InGaAs et de grandes caractéristiques de rupture d'avalanche; par conséquent, ce sont les matériaux de couche de multiplication appropriés des APD InGaAs dans les applications traditionnelles. Ces dernières années, en raison du développement rapide de la détection de photons uniques dans la distribution de clés quantiques [1], de la spectroscopie à résolution temporelle [2], de l'inspection de circuits optiques VLSI [3] et de la télémétrie laser 3D [4], les APD comme clé composant dans ces applications ont attiré une attention croissante [5, 6]. Pellegrini et al. ont décrit la conception, la fabrication et les performances de dispositifs InGaAs/InP à géométrie planaire qui ont été développés pour la détection de photons uniques avec une efficacité de détection de photons uniques (SPDE) de 10 % à 1550 nm (200 K) [7]. Tosi et al. ont présenté les critères de conception d'une nouvelle photodiode à avalanche à photon unique (SPAD) InGaAs/InP avec un SPDE élevé (30 %, 225 K), un faible bruit et une faible gigue temporelle [8]. En simulation, un modèle de dispositif basé sur des données expérimentales a été construit pour prédire le taux de comptage sombre (DCR) et le SPDE des SPAD InGaAsP/InP dans [9], et une plate-forme de simulation intégrée qui peut évaluer les performances de distribution de clés quantiques à l'état de leurre des InGaAs. /InP SPADs a été construit dans [10]. Acerbi et al. ont présenté des critères de conception pour les APD à photon unique InGaAs/InP avec un simulateur SPAD personnalisé [11]. Pour les APD InGaAs/InAlAs, une structure mesa SPAD InGaAs/InAlAs a été démontrée pour atteindre le SPDE de 21 % (260 K) ; cependant, un DCR élevé a été observé et a été attribué à un courant tunnel excessif [12]. Ensuite, [13] a utilisé une épaisse couche d'avalanche d'InAlAs dans des APD InGaAs/InAlAs pour améliorer le SPDE (26 %, 210 K) et diminuer le DCR (1 × 10 8 Hz). Dans la simulation d'APD basés sur InAlAs, un modèle de dispositif basé sur la méthode de Monte Carlo a été établi pour étudier la caractérisation de base des APD InGaAs/InAlAs dans [14], et l'influence de la couche de charge et de la couche de multiplication sur la tension de perforation et le claquage. tension ont été étudiées avec des simulations numériques 2D en régime permanent dans [15].
Par rapport aux APD basés sur InAlAs, les recherches sur les APD basées sur InP sont plus complètes et approfondies en théorie et en simulation. Cependant, l'APD basé sur InAlAs est de plus en plus utilisé à la place de l'InP car il a une plus grande bande interdite qui peut améliorer les caractéristiques de claquage à la fois dans les APD et les SPAD [16]. Le rapport du coefficient d'ionisation de l'électron (α) au trou (β) dans InAlAs est plus grand que dans InP, et, par conséquent, il a un faible facteur de bruit en excès et un produit gain-largeur de bande élevé. De plus, InAlAs présente une forte augmentation de la probabilité de panne avec un rapport de sur-biais, ce qui fait que les SPAD InAlAs ont un DCR plus faible [17]. Certaines propriétés et conclusions importantes concernant les APD basées sur InAlAs ont été obtenues à partir d'études précédentes, telles que le faible excès de bruit peut être obtenu dans les structures InAlAs avec des régions d'avalanche épaisses et minces [18]. Le champ électrique à seuil tunnel dans l'absorption (InGaAs) est de 1,8 × 10 5 V/cm, et le courant tunnel devient la composante dominante du courant d'obscurité dans le champ élevé [14]. Une structure d'éclairage vertical a une plus grande tolérance optique, mais elle présente un compromis plus sérieux entre le temps de transit du porteur et la réactivité [19]. De plus, le modèle théorique, la structure (épaisseur et dopage), le champ électrique et d'autres paramètres APD basés sur InAlAs ont été étudiés dans [20,21,22]. Cependant, ces études se sont uniquement concentrées sur les influences des paramètres de structure APD courants, tels que l'épaisseur de la couche d'absorption, l'épaisseur de multiplication et le niveau de dopage de la couche de charge. La relation entre les paramètres de structure et les performances de l'APD basé sur InAlAs n'a pas encore été entièrement comprise et optimisée.
Dans cet article, une étude théorique et une analyse de simulation numérique basée sur la structure verticale de InGaAs/InAlAs pour la détection de longueur d'onde de 1,55 µm ont été étudiées. Nous avons construit un modèle théorique pour étudier l'influence des paramètres de structure sur le dispositif et la relation détaillée de chaque couche dans les APD. La conception de la couche de charge avec différentes épaisseurs de multiplication, l'influence de l'épaisseur sur le niveau de dopage dans la couche de charge et l'effet tunnel sur le champ d'avalanche lors de la multiplication ont été analysés et simulés.
Méthodes
Dans cette section, une relation mathématique entre les paramètres de l'appareil et la distribution du champ électrique dans l'appareil a été établie, qui a été appliquée pour analyser la couche de charge et l'effet tunnel. Parallèlement, un modèle de simulation comprenant une structure de simulation, des paramètres de matériaux et des modèles physiques de base a été construit. Le modèle d'analyse théorique et le modèle de simulation étaient basés sur la structure verticale du SAGCM InGaAs/InAlAs APD.
Modèle théorique et analyse de la couche de charge
Les paramètres de l'appareil, tels que le niveau de dopage, l'épaisseur, les matériaux et la structure, ont été utilisés pour construire le modèle mathématique de calcul de la distribution du champ électrique dans l'APD. Les théories physiques de base qui incluent l'équation de Poisson, le modèle de couche d'appauvrissement et le modèle de jonction PN du dispositif semi-conducteur peuvent être trouvées dans les chapitres 1, 2 et 4 de [23] et [24]. L'équation du facteur de multiplication de jonction peut être trouvée dans [25], et les paramètres de matériau du semi-conducteur proviennent de [26]. Le modèle présenté adopte l'équation de Poisson, l'équation de densité de courant tunnel, le modèle de couche d'appauvrissement, le modèle de théorie de jonction et le modèle local de gain d'avalanche. Le système de coordonnées mathématique simplifié de l'APD qui comprend les paramètres de structure de base (matériaux, épaisseur, dopage et constante diélectrique) est présenté sur la figure 1. Il s'agit d'une structure APD SACM simplifiée qui ignore la couche de classement. Les matériaux de la couche de contact, de la couche de charge et de la couche de multiplication sont en InAlAs et la couche d'absorption est en InGaAs. Les jonctions de couches sont séparées par X n , 0, X m , X c , et X un et X p par le x coordonner. Les niveaux de dopage sont exprimés par N 0 , N 1 , N 2 , N 3 , et N 4 , les épaisseurs de couche sont exprimées par w 0 , w 1 , w 2 , w 3 , et w 4 , et les constantes diélectriques sont exprimées par ε s0 , ε s1 , ε s2 , ε s3 , et ε s4 du contact A, de la multiplication, de la charge, de l'absorption et du contact B, respectivement.
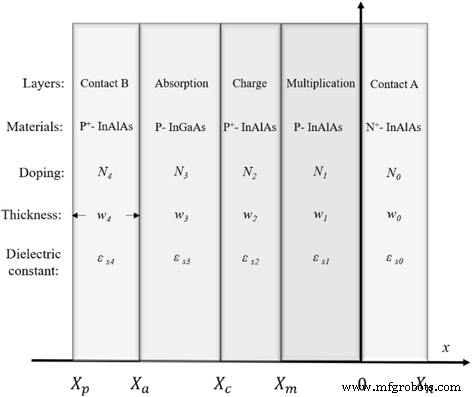
Le système de coordonnées mathématique simplifié du SACM InGaAs/InAlAs APD. Présente les structures simplifiées d'un APD qui est utilisé pour construire un modèle théorique. Le système de coordonnées mathématique simplifié de l'APD qui inclut les paramètres de structure de base (matériaux, épaisseur, dopage et constante diélectrique)
L'équation 1 est l'équation de Poisson, qui peut résoudre la distribution de potentiel électrique en utilisant la densité de charge ρ . Dans cette équation, ρ est égal à l'ion dopant N dans le modèle de couche d'épuisement, w est égal à l'épaisseur de la couche d'appauvrissement, et ε est la constante diélectrique du matériau. Dans le modèle de distribution de champ électrique de jonction PN commun, ρ est une variable qui dépend de l'épaisseur de la couche d'appauvrissement w et l'ion dopant N . Dans ce modèle, il change après avoir considéré l'effet tunnel. Cependant, avant de considérer l'effet tunnel, nous avons d'abord construit la distribution du champ électrique en utilisant une méthode commune.
$$ \frac{d\xi}{d x}=\frac{\rho }{\varepsilon }=\frac{q\times N}{\varepsilon } $$ (1)En résolvant l'équation de Poisson avec les paramètres de l'appareil, l'expression mathématique du champ électrique max est obtenue. Cette expression est déterminée par la variation d'épaisseur de pénétration dans la couche d'appauvrissement indiquée dans les formules 2 et 3. Dans cette expression, les paramètres qui incluent les niveaux de dopage (N ), épaisseurs de couche d'appauvrissement (w ), et les constantes diélectriques (ε) de différentes couches peuvent être trouvées dans la Fig. 1.
$$ {\xi}_{\max (w)}={\sum}_{k=1}^4\left(-\frac{q\times {N}_k\times {w}_k}{\ varepsilon_{sk}}\right) $$ (2) $$ {\xi}_{\max (w)}=\frac{q\times {N}_0\times {w}_0}{\varepsilon_{s0 }} $$ (3)Ensuite, la distribution du champ électrique peut être dérivée en tous les points à l'aide des formules 4 et 5. La condition aux limites ignore le potentiel intégré V br en Formule 6; par conséquent, la relation mathématique entre l'épaisseur de la couche d'appauvrissement et la tension de polarisation peut être calculée.
$$ {\xi}_{\left(x,w\right)}={\xi}_{\max (w)}+{\sum}_{k=1}^4\left(\frac{ q\times {N}_k\times \left|x\right|}{\varepsilon_{sk}}\right)\left({X}_pÀ partir du modèle, une fois que la limite de la couche d'appauvrissement atteint la région de contact, les formules 7 à 11 peuvent être utilisées pour analyser le champ électrique dans chaque couche. Dans l'APD pratique, les couches d'absorption et de multiplication sont involontairement dopées dans des couches intrinsèques. N 3 et N 1 sont inférieurs à N 2 . Ainsi, la formule 9 est approximativement égale à la formule 12. C'est la raison pour laquelle la couche de charge peut contrôler la distribution du champ électrique dans l'appareil.
$$ {\displaystyle \begin{array}{l}\xi \left(x,{V}_{\mathrm{bias}}\right)={\xi}_{\max \left({V}_ {\mathrm{biais}}\right)}+\frac{q\times {N}_1\times {w}_1}{\varepsilon_{s1}}+\frac{q\times {N}_2\times { w}_2}{\varepsilon_{s2}}+\frac{q\times {N}_3\times \left|x-{X}_c\right|}{\varepsilon_{s3}}\\ {}\kern4em \approx {\xi}_{\max \left({V}_{\mathrm{bias}}\right)}+\frac{q\times {N}_2\times {w}_2}{\varepsilon_{ s2}}\left({X}_{\mathrm{c}}\ge x\ge {X}_a\right)\end{array}} $$ (12)Dans la formule 8, la différence de champ électrique entre la multiplication et l'absorption est déterminée en utilisant le produit de N 2 et w 2 . N 2 est le niveau de dopage dans la couche de charge et w 2 est l'épaisseur de la couche de charge. Pour une distribution appropriée du champ électrique dans l'APD InGaAs/InAlAs, le champ électrique dans la couche d'absorption (InGaAs) doit se situer dans les valeurs d'intervalle de 50 à 180 kV/cm qui assurent une vitesse suffisante pour les porteurs photo-induits et évitent l'effet tunnel dans la couche d'absorption [10]. C'est-à-dire que le champ d'avalanche en multiplication devrait diminuer jusqu'à 50-180 kV/cm en absorption par la couche de charge. Ainsi, nous pouvons utiliser la formule 8 pour trouver le niveau de dopage calculé optimal et les épaisseurs de couche de charge. Lorsque la couche de multiplication est de 200 nm (le champ d'avalanche E dans la multiplication est 6.7 × 10 5 V/cm alors que la couche de multiplication est de 200 nm [27] ); les valeurs calculées du niveau de dopage et de l'épaisseur dans la couche de charge sont comparées aux résultats de [28,29,30,31,32,33] sur la figure 2. La région des valeurs théoriques est en bon accord avec les données expérimentales. Ce résultat prouve que la formule 8 peut être utilisée pour prédire le niveau de dopage avec différentes épaisseurs dans la couche de charge lorsque l'épaisseur de multiplication est certaine.
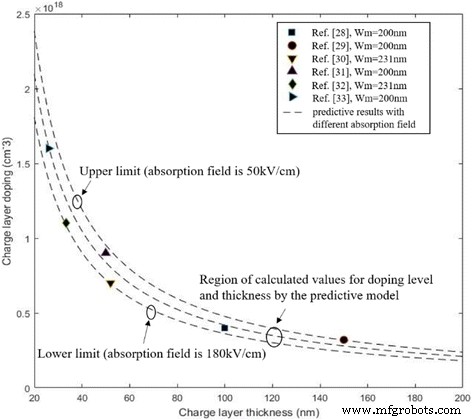
Comparaison des résultats théoriques et des données expérimentales de divers rapports (w m = 200 nm). Symboles fermés :le niveau de dopage et l'épaisseur de la couche de charge avec une épaisseur de multiplication de 200 nm (carré noir, cercle noir, triangle noir, triangle noir pointant vers la droite) et 231 nm (losange noir, triangle noir pointant vers le bas) dans les références. Présente les valeurs calculées de la couche de charge (niveau de dopage et épaisseur) par la formule 8 (le champ d'absorption est de 50 à 180 kV/cm). Lorsque le champ d'absorption est de 50 kV/cm, la limite supérieure du niveau de dopage dans la couche de charge peut être obtenue. Lorsque le champ d'absorption est de 180 kV/cm, la limite inférieure du niveau de dopage dans la couche de charge peut être obtenue. Nous comparons les résultats théoriques et les données expérimentales de divers rapports. La région des valeurs théoriques est en bon accord avec les données expérimentales. Lignes pointillées les valeurs calculées du niveau de dopage et de l'épaisseur par la formule
Nous calculons le niveau de dopage optimal pour différentes épaisseurs de la couche de charge avec la couche de multiplication de 300, 500 et 700 nm, et les résultats sont présentés sur la figure 3. Ce résultat illustre que la tolérance du niveau de dopage dans la couche de charge est liée à son épaisseur et la plage de niveau de dopage diminue avec l'augmentation de l'épaisseur de la couche de charge. C'est-à-dire que si nous appliquons une région de charge épaisse, seule une petite plage de niveaux de dopage dans la couche de charge existerait pour satisfaire le champ électrique optimal. En conséquence, les performances de l'APD varient considérablement via des écarts de plusieurs pour cent des concentrations de dopage dans la couche de charge plus épaisse. Dans la section « Résultats et discussion », les structures pratiques des APD ont été simulées pour étudier et vérifier l'analyse théorique, qui comprend l'influence de l'épaisseur de la couche de charge sur la plage de niveau de dopage dans la couche de charge et la variété des performances pour différentes épaisseurs de couche de charge dans APD.

Le niveau de dopage optimal et l'épaisseur de la couche de charge pour différentes couches de multiplication. Ligne continue :w m = 300 nm. Ligne pointillée :w m = 500 nm. Ligne pointillée :w m = 700 nm. Présente les valeurs calculées de la couche de charge (niveau de dopage et épaisseur) par la formule tandis que le champ de la couche d'absorption convient. Les épaisseurs de la couche de multiplication sont de 300, 500 et 700 nm. Lorsque l'épaisseur de la couche de multiplication est certaine, nous pouvons utiliser la formule pour trouver le niveau de dopage optimal et l'épaisseur de la couche de charge
Modèle théorique avec prise en compte du tunneling
Le modèle d'analyse ci-dessus concerne la distribution du champ électrique dans l'appareil et repose sur le principe que ρ est l'ion dopant dans la couche d'appauvrissement. S'il existe un champ électrique suffisamment élevé dans la couche d'absorption, la courbure locale de la bande peut être suffisante pour permettre aux électrons de créer un tunnel [34]. Par conséquent, un effet tunnel électronique peut se produire. D'après le diagramme schématique de l'effet tunnel de la figure 4, lorsque la couche d'absorption a un effet tunnel de claquage, l'effet tunnel modifie la densité de charge ρ , la charge positive dans l'absorption augmente et la charge négative dans les couches de multiplication et de charge augmente. Ainsi, ρ n'est pas égal à la densité de charge des ions dopants dans la couche d'appauvrissement alors que l'effet tunnel apparaît. Les formules qui ont été discutées plus tôt changeront après avoir pris en compte l'effet tunnel.

Le processus de tunneling et le changement de densité de charge dans les couches de multiplication et d'absorption. Présente un diagramme schématique du processus de tunneling dans l'appareil. S'il existe un champ électrique suffisamment élevé dans la couche d'absorption, la courbure locale de la bande peut être suffisante pour permettre aux électrons de pénétrer en tunnel. Lorsque la couche d'absorption a un effet tunnel de claquage, la charge positive en absorption augmente et la charge négative dans les couches de multiplication et de charge augmente. Ainsi, ρ n'est pas égal à la densité de charge des ions dopants dans la couche d'appauvrissement alors que l'effet tunnel apparaît
Le taux de génération G bbt du tunnel bande à bande est décrit dans la formule 13 [35, 36].
$$ {G}_{bbt}={\left(\frac{2{m}^{\ast }}{E_g}\right)}^{1/2}\frac{q^2{E_p}^ {\gamma }}{{\left(2\pi \right)}^3{\hbar}^2}\exp \left(\frac{-\pi }{4{q\mathit{\hbar E}} _p}{\left(2{m}^{\ast}\times {E_g}^3\right)}^{\raisebox{1ex}{$1$}\!\left/ \!\raisebox{-1ex} {$2$}\right.}\right)=A\times {E_p}^{\gamma}\times \exp \left(-\frac{B}{E_p}\right) $$ (13)En Formule 13, E g est la bande interdite énergétique de InGaAs, m* (égal à 0,04 m e ) est la masse réduite effective, E p est le champ électrique de claquage dans la couche d'absorption, et γ est un paramètre définissable par l'utilisateur qui est généralement limité à 1~2. Le A et B sont les paramètres de caractérisation. On calcule le G bbt avec différents γ , et les résultats sont montrés dans la Fig. 5. On peut constater que G bbt adapte le même ordre de grandeur pour le niveau de dopage de la couche de charge tandis que γ est limité à 1~1,5.

Le G btt pour différents champs dans la couche d'absorption avec différents γ . Les valeurs de γ est 1,0 (étoile noire), 1,1 (triangle noir pointant vers le bas), 1,2 (losange noir), 1,3 (triangle noir), 1,4 (carré noir), 1,5 (cercle noir). Présente les résultats calculés de G btt par la formule 13. Lorsque le champ d'absorption dépasse 19 kV/cm, G bbt augmente progressivement. On peut également constater que G bbt adapte le même ordre de grandeur pour le niveau de dopage de la couche de charge tandis que γ est limité à 1~1,5
En conséquence, la densité de charge ρ est une variable et déterminée par l'effet tunnel et l'ion dopant dans le tunnel d'absorption. A cette occasion, la Formule 1 sera changée en Formule 14 et le champ électrique dans la couche de multiplication sera décrit par la Formule 15. w tunnel est la couche d'appauvrissement efficace du processus de tunnellisation [35]. Ainsi, le changement du champ d'avalanche peut être décrit par la formule 16, et le champ d'avalanche diminuera en se multipliant avec l'effet tunnel.
$$ \frac{d\xi}{dx}=\frac{\rho }{\varepsilon }=\frac{q\times \left(N+{G}_{btt}\right)}{\varepsilon }, {E}_p> 1.8\times {10}^5V/ cm $$ (14) $$ \xi \left(x,{V}_{\mathrm{bias}}\right)={\xi}_{ \max \left({V}_{\mathrm{bias}}\right)}+\frac{q\times \left({N}_1\times \left|x\right|+{G}_{bbt }\times {w}_{\mathrm{tunnel}}\right)}{\varepsilon_{s1}}\left(0\ge x\ge {X}_m\right) $$ (15) $$ \delta \xi \left(x,{V}_{\mathrm{biais}}\right)=\delta E=\frac{q\times {G}_{btt}\times {w}_{\mathrm{tunnel }}}{\varepsilon_{\mathrm{s}3}} $$ (16)Les coefficients d'ionisation des électrons et des trous sont décrits par les formules 17 et 18 dans [18]. E est le champ d'avalanche en multiplication.
$$ \alpha ={a}_n{e}^{\raisebox{1ex}{$-{b}_n$}\!\left/ \!\raisebox{-1ex}{$E$}\right.} $$ (17) $$ \beta ={a}_p{e}^{\raisebox{1ex}{$-{b}_p$}\!\left/ \!\raisebox{-1ex}{$E$ }\droit.} $$ (18)L'effet de l'avalanche porteuse est pris en compte par le modèle d'ionisation par impact. Compte tenu de la densité de porteurs extrêmement faible de la couche de multiplication par rapport à la couche de charge, il est raisonnable de supposer que le champ électrique est uniforme dans toute la couche de multiplication. Par conséquent, le facteur de multiplication (M n ) peut être exprimé par l'équation suivante. 19. Ici, w m est l'épaisseur de la couche de multiplication et k est le rapport du coefficient d'ionisation par impact défini par α/β . Depuis k varie très lentement avec le champ électrique, k est approximativement constant pour une légère variation de w m [37].
$$ {M}_n=\frac{k-1}{k\times {e}^{-\alpha \left(1-\raisebox{1ex}{$1$}\!\left/ \!\raisebox{ -1ex}{$k$}\right.\right){w}_m}-1} $$ (19)En supposant un w constant m et tension de polarisation, différenciation de M n en ce qui concerne les coefficients d'ionisation électronique est dans les formules 20 et 21.
$$ \delta {M}_n\left|{}_{w=const\&V=const}\right.={M_n}^2{e}^{-\alpha \left(1-\raisebox{1ex} {$1$}\!\left/ \!\raisebox{-1ex}{$k$}\right.\right){w}_m}\times {w}_m\delta \alpha $$ (20) $$ \delta \alpha =\frac{\delta \alpha}{\delta E}={\alpha}_n{b}_n{e}^{\frac{-{b}_n}{E}}\frac{1 }{E^2} $$ (21)Dans les formules 20 et 21, δα/δE est positif. On suppose que 20 % d'une couche d'absorption d'épuisement total est w tunnel et la couche d'absorption a une épaisseur de 400 nm. En résolvant la Formule 16, la relation entre le δE et le champ d'absorption avec différents γ est présenté dans la Fig. 6. On peut constater que δE adapte le même ordre de grandeur pour le champ d'avalanche dans la multiplication. Ainsi, l'effet tunnel a une influence sur le champ d'avalanche et le M n diminuera avec l'effet tunnel. Dans l'analyse, nous avons supposé que la charge négative n'est pas multipliée dans la multiplication et le modèle sera plus rigoureux après prise en compte. Pour vérifier et analyser l'influence de l'effet tunnel sur la structure pratique des APD, nous avons simulé en détail la relation entre l'effet tunnel et le champ d'avalanche de multiplication dans la section « Résultats et discussion ».

Le δE pour différents champs dans la couche d'absorption avec différents γ . Les valeurs de γ est 1,0 (étoile noire), 1,1 (triangle noir pointant vers le bas), 1,2 (losange noir), 1,3 (triangle noir), 1,4 (carré noir), 1,5 (cercle noir). Présente les résultats calculés de δE par la formule 16. Lorsque le champ d'absorption dépasse 19 kV/cm, δE augmente progressivement. On peut également constater que δE adapte le même ordre de grandeur pour le champ d'avalanche dans la multiplication. Ainsi, l'effet tunnel a une influence sur le champ d'avalanche avec l'effet tunnel
Modèle de structure et de simulation
Une simulation de dispositif semi-conducteur de TCAD a été utilisée pour la simulation et l'analyse. Ce moteur de simulation définit des modèles physiques en simulation, et les résultats ont un sens physique [20]. Les modèles physiques de base ont été présentés comme suit. Les modèles de dérive-diffusion, y compris les équations de Poisson et de continuité de porteur, ont été utilisés pour simuler la distribution du champ électrique et le courant de diffusion IDIFF . Le modèle de tunneling bande à bande a été utilisé pour le courant de tunneling bande à bande IB2B , et le modèle de tunnel assisté par piège a été utilisé pour le courant de tunnel assisté par piège ITAT . Le courant de génération-recombinaison IGR a été décrit par le modèle de recombinaison Shockley-Read-Hall et le courant de recombinaison Auger IAUGER a été décrit par le modèle de recombinaison Auger. Le courant d'obscurité était clairement décrit par ces mécanismes [38]. La multiplication des avalanches a été décrite par le modèle d'ionisation par impact de Selberherr. D'autres modèles de base, y compris les statistiques des porteurs de Fermi-Dirac, les méthodes dépendantes de la concentration des porteurs, la faible mobilité du champ, la saturation de la vitesse et les méthodes de traçage des rayons, ont été utilisés pour le modèle de simulation, et un modèle de simulation rigoureux a été construit.
Les structures de dispositifs dans la simulation étaient similaires aux structures expérimentales dans [13]. La coupe transversale schématique de l'APD InGaAs/InAlAs du SAGCM illuminé par le haut est illustrée à la Fig. 7. Les structures de haut en bas sont nommées séquentiellement couche de contact InGaAs, couche de revêtement InAlAs, couche de classement InAlGaAs, couche d'absorption InGaAs, classement InAlGaAs couche de charge, couche de charge InAlAs, couche de multiplication InAlAs, couche de revêtement InAlAs, couche de contact InP et substrat InP. L'épaisseur et le dopage de chaque couche sont également présentés sur la figure 7. Pour éviter l'influence de l'épaisseur sur les résultats de la simulation, nous choisissons deux structures de simulation. Une structure de simulation est nommée APD-1 (les couches de multiplication et d'absorption sont respectivement de 800 et 1800 nm) et l'autre structure de simulation est nommée APD-2 (les couches de multiplication et d'absorption sont de 200 et 600 nm, respectivement).
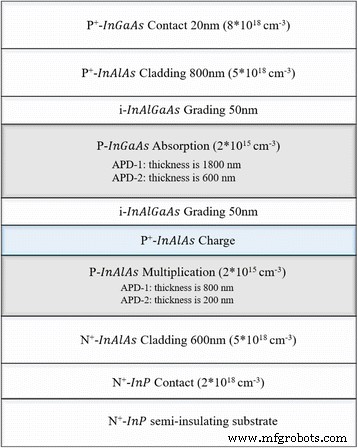
Structure de simulation et paramètres de l'APD. Présente la coupe transversale schématique des SAGCM InGaAs/InAlAs APD-1 et APD-2 illuminés par le haut. Il comprend la structure, les matériaux, le dopage et l'épaisseur
Pour tester le modèle de simulation, les données expérimentales dans [13] ont été comparées aux résultats de simulation. Dans cette simulation, nous avons utilisé la même structure dans la référence, et les caractéristiques courant-tension de l'appareil ont été données. La figure 8 montre nos résultats de simulation et les résultats de l'expérience dans la référence. Ils ont la même tension de perçage V pt et tension de claquage V br . De plus, les résultats de simulation et d'expérimentation correspondent bien. Par conséquent, le modèle de notre simulation est précis. Les paramètres mentionnés ci-dessus sont répertoriés dans le tableau 1.
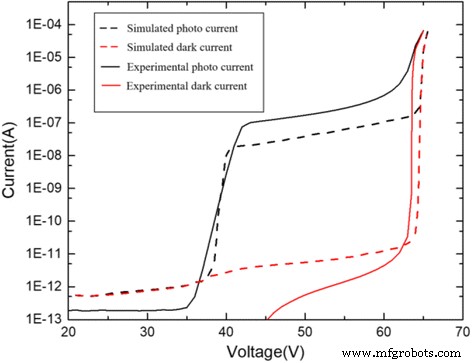
Résultats de la simulation comparés aux résultats de l'expérience (photocourant et courant d'obscurité). Ligne pointillée noire :photo-courant simulé. Ligne pointillée rouge :courant d'obscurité simulé. Ligne continue noire :photo-courant expérimental. Ligne rouge continue :courant d'obscurité expérimental. Présente la comparaison des résultats de simulation et des résultats d'expérience. Le modèle de simulation utilise les mêmes paramètres de l'expérience dans la référence
Résultats et discussion
Dans cette section, l'analyse théorique et les conclusions ont été étudiées par simulation en détail. Tout d'abord, l'influence de l'épaisseur de la couche de charge sur la tolérance du niveau de dopage dans la couche de charge a été étudiée dans la section « Influence de l'épaisseur de la couche de charge ». Ensuite, la relation entre l'effet tunnel et le champ d'avalanche de multiplication a été analysée et vérifiée dans la section « Effet tunnel sur la distribution du champ électrique ».
Influence de l'épaisseur de la couche de charge
D'après [14], une distribution de champ appropriée dans l'APD InGaAs/InAlAs devrait être conforme à ces règles. La garantie V pt < V br et V br − V pt devrait avoir une marge de sécurité pour traiter les variations des fluctuations de température et de la plage de fonctionnement. Dans la couche d'absorption, le champ électrique doit être supérieur à 50-100 kV/cm pour assurer une vitesse suffisante pour les porteurs photo-induits. Parallèlement, le champ électrique doit être inférieur à 180 kV/cm pour éviter l'effet tunnel dans la couche d'absorption. La distribution du champ électrique influence grandement les performances de l'appareil. The choice of electric field in the absorption layer has a balancing of the tradeoff between small transit time, dark current, and high responsivity for the practical requirement.
In the simulation, we used the structure of APD-1 (multiplication is 800 nm thick) and adjusted the charge layer thickness from 50 to 210 nm to study the influence of charge layer thickness on doping level range and verify the theoretical conclusions in analytical model. In the simulation, we selected different doping level ranges in the charge layer so that the electric field distribution complies with the rules. The simulation results on the relationship between thickness and doping level range in the charge layer are presented in Fig. 9a. As the charge layer thickness increases, the suitable doping level range in charge layer decreases. A relatively large doping level range exists in the thin charge layer, and under this doping level range, the device will have a suitable electric field distribution. Apparently, the doping level range is determined by charge layer thickness. The simulation result of APD-2 (with a thickness of multiplication of 200 nm) is presented in Fig. 9b, which has a similar result. Moreover, it can be found that the calculated results of Fig. 2 and simulation results of Fig. 9b match well as shown in Fig. 9c. The small difference between the calculated results and simulation results is caused by the different values of avalanche field in the simulation and calculation. The avalanche field in simulation engine is used 6.4 × 10 5 V/cm, while in the calculation, we use the value of 6.7 × 10 5 V/cm from [27].

un Relationship between suitable doping level and thickness of charge layer (APD-1). The thickness of charge layer is 50 nm (black square), 90 nm (black circle), 130 nm (black triangle), 170 nm (black down-pointing triangle), 210 nm (black diamond). un presents the suitable doping level region for different thickness of charge layer. As the charge layer thickness increases, the suitable doping level range in the charge layer decreases. A relatively large doping level range exists in the thin charge layer, and under this doping level range, the device will have a suitable electric field distribution. Apparently, the doping level range is determined by charge layer thickness. b Relationship between suitable doping level and thickness of charge layer (APD-2). The thickness of charge layer is 50 nm (black square), 70 nm (black circle), 90 nm (black triangle), 110 nm (black down-pointing triangle), 130 nm (black diamond), and 150 nm (black pentagon). The figure description of b is similar to a . c Comparison of calculated results in Fig. 2 and simulated results in Fig. 9b. Dashed line:calculated results. Closed symbols:simulated results (black square). c presents the comparison of calculated results in Fig. 2 and simulated results in Fig. 9b. The calculated results and simulated results correspond well
The charge layer thicknesses of 210 and 50 nm (APD-1) were selected to show the simulation details and the influence of doping level on the electric field distribution. Figure 10a, c shows the current simulation results of different doping levels in thicknesses of 210 and 50 nm, respectively. Figure 10b, d shows the electric field distribution simulation results using the same structure. The simulation results show that thicknesses of 210 and 50 nm have doping level ranges of 1.0 × 10 17 –1.3 × 10 17 cm −3 and 3.9 × 10 17 –5.7 × 10 17 cm −3 , respectively.

un Photocurrent and dark current with different doping level (thickness of charge layer is 210 nm). Solid line:doping level in the charge layer is 1.3 × 10 17 cm −3 . Dashed line:doping level in charge layer is 1.15 × 10 17 cm −3 . Dashed dot line:doping level in charge layer is 1.0 × 10 17 cm −3 . un Presents the simulation results of currents with different doping level. The device with a charge layer thickness of 210 nm only has a relatively narrow and suitable doping level. A minimal change in the doping level has greatly influence the punch-through voltage, breakdown voltage, and current-voltage characteristic. b Avalanche field with different doping level (thickness of charge layer is 210 nm). Solid line:doping level in charge layer is 1.3 × 10 17 cm −3 . Dashed line:doping level in charge layer is 1.15 × 10 17 cm −3 . Dashed dot line:doping level in charge layer is 1.0 × 10 17 cm −3 . b Presents the simulation results of fields with different doping level. The device with a charge layer thickness of 210 nm only has a relatively narrow and suitable doping level. A minimal change in the doping level has greatly influenced the electric field distribution. c Photocurrent and dark current with different doping level (thickness of charge layer is 50 nm). Solid line:doping level in charge layer is 5.7 × 10 17 cm −3 . Dashed line:doping level in charge layer is 4.8 × 10 17 cm −3 . Dashed dot line:doping level in charge layer is 3.9 × 10 17 cm −3 . c Presents the simulation results of currents with different doping level. The device with a charge layer thickness of 50 nm has a relatively wide and suitable doping level. A minimal change in the doping level has a small influence on the current-voltage characteristic. d Avalanche field with different doping level (thickness of charge layer is 50 nm). Solid line:doping level in charge layer is 5.7 × 10 17 cm −3 . Dashed line:doping level in charge layer is 4.8 × 10 17 cm −3 . Dashed dot line:doping level in charge layer is 3.9 × 10 17 cm −3 . d Presents the simulation results of fields with different doping level. The device with a charge layer thickness of 50 nm only has a relatively wide and suitable doping level. A minimal change in the doping level has a small influence on the electric field distribution
Clearly, the device with a charge layer thickness of 210 nm only has a relatively narrow and suitable doping level. A minimal change in the doping level has greatly influence the current-voltage characteristic and electric field distribution. As a result, the performance of APD varies significantly via several percent deviations of doping concentrations in the thicker charge layer. This conclusion is the same as the theoretical analysis. Concurrently, when designing APD structures, choosing a thin charge layer will give a high level of doping tolerance, as well as confer APD with good controllability.
Finally, the relationship between charge layer and multiplication thickness was simulated. Figure 11a presents the avalanche field with multiplication region thicknesses of 100, 200, and 300 nm in the APD-2 structure (with a charge layer thickness of 70 nm). Figure 11b presents the charge layer doping range with different multiplication thicknesses at the suitable electric field distribution condition. The charge layer thicknesses are 50, 70, and 90 nm. Clearly, a high avalanche field exists in the thin multiplication layer. As the multiplication region thickness decreases, the electric field difference between multiplication and absorption layers increases. As a result, a thin multiplication layer needs a high product of the charge layer doping level and thickness to reduce the high avalanche field.

un Avalanche breakdown electric field with different multiplication thicknesses. Solid line:w m = 100 nm. Dashed line:w m = 200 nm. Dashed dot line:w m = 300 nm. un Presents the simulation results of electric field distribution with different w m . As the w m decreases, the avalanche field in the multiplication increase. b Relationship between multiplication thickness and charge layer. The thickness of multiplication is 300 nm (black square), 200 nm (black circle), 100 nm (black triangle). b Presents the relationship between multiplication thickness and charge layer. A thin multiplication layer needs a high product of the charge layer doping level and thickness to reduce the high avalanche field
Tunneling Effect on the Electric Field Distribution
The simulation in this part will study the tunneling effect on the electric field in the device. From the theoretical analysis, the tunneling effect has an influence on the avalanche field in multiplication. Thus, the simulation will design to study the influence of electric field in the absorption layer that exceeds the tunneling threshold value. First, group A, with the structure of APD-1, charge layer thickness of 90 nm, and different charge layer doping levels of 1.4 × 10 17 –2.4 × 10 17 cm −3 , was simulated for electric field distribution when the device avalanche breaks down. The result is shown in Fig. 12a. When the charge layer doping level exceeds 2.0 × 10 17 cm −3 , the field in the absorption layer becomes lower than the tunneling threshold field and the avalanche field in the multiplication layer reaches the same value. However, when the doping level is less than 2.0 × 10 17 cm −3 , the field in the absorption layer exceeds the tunneling threshold field and the avalanche field in the multiplication layer decreases with the decrease of the doping level in charge layer. Similar results were observed in the APD-2 structure (with a charge layer thickness of 90 nm and doping level of 2.2 × 10 17 –3.6*10 17 cm −3 ) (Fig. 12b). That is, if the electric field in the absorption layer exceeds the tunneling threshold value at or over the breakdown voltage, then the breakdown electric field in the multiplication will decrease.

un Avalanche breakdown electric field with different doping levels (APD-1). Thickness of charge layer is 90 nm. Red dashed lines:the field of absorption is larger than the tunneling threshold field. Black solid lines:the field of absorption is less than the tunneling threshold field. un Presents the simulation results of electric field distribution with different doping level while avalanche breakdown. When doping level of charge layer exceeds 2.0 × 10 17 cm −3 , the field in the absorption layer becomes lower than the tunneling threshold field, and the avalanche field in the multiplication layer reaches the same value with different doping level. However, when the doping level is less than 2.0 × 10 17 cm −3 , the field in the absorption layer exceeds the tunneling threshold field, and the avalanche field in the multiplication layer decreases with the decrease of the doping level. Thus, if the electric field in the absorption layer exceeds the tunneling threshold value at or over the breakdown voltage, then the breakdown electric field in the multiplication will decrease. Thus, the electric field in the absorption should be less than the tunneling threshold value to maintain the high field in the multiplication layer when the device avalanche breaks down. b Avalanche breakdown electric field with different doping levels (APD-2). Thickness of charge layer is 90 nm. Red dashed lines:the field of absorption is larger than the tunneling threshold field. Black solid lines:the field of absorption is less than the tunneling threshold field. The figure description of b is similar to a . c Relationship between field and bias voltage in multiplication and absorption (APD-1). Thickness of charge layer is 90 nm. Electric field of multiplication (black square). Electric field of absorption (red triangle). c Presents the relationship between the electric field and bias voltage in multiplication and absorption layers. When the electric field in the absorption layer reaches the tunneling threshold value, the avalanche breakdown electric field in the multiplication gradually decreases. Moreover, the absorption field slope increases when the electric field in the absorption layer exceeds the tunneling threshold. d Relationship between field and bias voltage in multiplication and absorption (APD-2). Thickness of charge layer is 90 nm. Electric field of multiplication (black square). Electric field of absorption (red triangle). The figure legend of d is similar to a
Groups B (APD-1 thickness of 90 nm, doping level of 2.4 × 10 17 cm −3 in charge layer and APD-2 thickness of 90 nm, doping level of 3.6 × 10 17 cm −3 ) were designed to demonstrate the relationship between the threshold electric field in the absorption layer and avalanche field in the multiplication layer. The multiplication and absorption electric fields vary with the bias voltage on the device. As shown in Fig. 12c, d, when the electric field in the absorption layer reaches the tunneling threshold value, the avalanche breakdown electric field in the multiplication gradually decreases. Moreover, when the absorption field exceeds the tunneling threshold, the avalanche breakdown electric field in the multiplication layer plummets. Furthermore, the absorption field slope increases when the electric field in the absorption layer exceeds the tunneling threshold.
The phenomenon in Fig. 12 can be explained by the theoretical analysis that tunneling has an influence on the charge density in the “Methods” section. When the electric field reaches the tunneling threshold value in the absorption layer, the charge density ρ becomes unequal to the dopant ion. The multiplication field will decrease as the negative ion increases, and the absorption field will increase as the positive ion increases. Concurrently, the absorption field slope will increase due to the tunneling effect. As a result, the electric field in the absorption should be less than the tunneling threshold value to maintain the high field in the multiplication layer and the low dark current when the device avalanche breaks down.
Conclusions
In summary, we have presented a theoretical study and numerical simulation analysis involving the InGaAs/InAlAs APD. The mathematical relationship between the device parameters and electric field distribution in the device was built. And the tunneling effect was taken into consideration in the theoretical analysis. Through analysis and simulation, the influence of structure parameters on the device and the detailed relationship of each layer were fully understood in the device. Three important conclusions can be obtained from this paper. First, the doping level and thickness of the charge layer for different multiplication thicknesses can be calculated by the theoretical model in the “Methods” section. Calculated charge layer values (doping and thickness) are in agreement with the experiment results. Second, as the charge layer thickness increases, the suitable doping level range in charge layer decreases. Compared to the thinner charge layer, the performance of APD varies significantly via several percent deviations of doping concentrations in the thicker charge layer. When designing APD structures, choosing a thin charge layer will give a high level of doping tolerance, as well as confer APD with good controllability. Finally, the G btt of tunneling effect was calculated, and the influence of tunneling effect on the avalanche field was analyzed. We confirm that the avalanche field and multiplication factor (M n ) in the multiplication will decrease by the tunneling effect.
Abréviations
- 2D :
-
Bidimensionnel
- APD:
-
Avalanche photodiode
- DCR:
-
Dark count rate
- SACM APDs:
-
Separate absorption, charge, and multiplication avalanche photodiodes
- SAGCMAPDs:
-
Separate absorption, grading, charge, and multiplication avalanche photodiodes
- SPAD:
-
Single-photon avalanche photodiode
- SPDE:
-
Single-photon detection efficiency
- SRH:
-
Shockley–Read–Hall
Nanomatériaux
- Technologies avancées de dépôt de couche atomique pour les micro-LED et les VCSEL
- La conception de la couche d'émission pour les multiplicateurs d'électrons
- Propriétés photocatalytiques des poudres de TiO2 revêtues de Co3O4 préparées par dépôt de couche atomique amélioré par plasma
- Étude théorique de nanofils de germanium soumis à une traction biaxiale
- Réglage des morphologies de surface et des propriétés des films de ZnO par la conception de la couche interfaciale
- Réglage au niveau de Fermi des films ZnO par dépôt de couche atomique supercyclée
- Enquête sur une cellule solaire au silicium cristallin avec une couche de silicium noir à l'arrière
- Photoconductivité interbande des points quantiques métamorphiques InAs/InGaAs dans la fenêtre 1,3–1,55 μm
- Une simulation théorique des réponses de rayonnement de Si, Ge et de superréseau Si/Ge à une irradiation à basse énergie



