Étude des premiers principes des défauts ponctuels dans le superréseau GaAs/AlAs :la stabilité de phase et les effets sur la structure de bande et la mobilité des porteurs
Résumé
Les super-réseaux semi-conducteurs avancés jouent un rôle important dans les futures applications critiques de haute technologie telles que l'aérospatiale, la physique des hautes énergies, la détection des ondes gravitationnelles, l'astronomie et les domaines liés au nucléaire. Dans des conditions extrêmes telles que des environnements à fort rayonnement, ces super-réseaux semi-conducteurs ont tendance à générer divers défauts qui peuvent finalement entraîner la défaillance des dispositifs. Cependant, dans le super-réseau comme GaAs/AlAs, la stabilité de phase et l'impact sur les performances du dispositif des défauts ponctuels ne sont toujours pas clairs à ce jour. Les présents calculs montrent que dans le super-réseau GaAs/AlAs, les défauts antisites sont énergétiquement plus favorables que les lacunes et les défauts interstitiels. L'AsX (X =Al ou Ga) et XAs les défauts induisent toujours une métallicité du super-réseau GaAs/AlAs, et GaAl et AlGa les défauts antisites ont de légers effets sur la structure électronique. Pour le super-réseau GaAs/AlAs avec les défauts interstitiels ou de lacunes, une réduction significative de la bande interdite ou de la métallicité induite est trouvée. D'autres calculs montrent que les défauts interstitiels et de lacunes réduisent considérablement la mobilité des électrons, tandis que les défauts antisites ont des influences relativement plus faibles. Les résultats font progresser la compréhension des effets des dommages causés par les radiations du super-réseau GaAs/AlAs, qui fournissent ainsi des conseils pour la conception d'électronique et d'optoélectronique à base de super-réseaux semi-conducteurs hautement stables et durables pour des applications dans des environnements extrêmes.
Contexte
Le super-réseau (SL) est un matériau artificiel constitué de couches minces alternées de deux ou plusieurs composants différents. Le (GaAs)n /(AlAs)m est l'un des SL les plus importants depuis le développement des transistors à haute mobilité électronique (HEMT) et des lasers à cascade quantique (QCL) il y a quelques décennies [1,2,3,4,5,6]. Récemment, avec les progrès des techniques d'épitaxie de film et de nanofabrication, le (GaAs)n /(AlAs)m Les SL et les nanodispositifs basés sur (n + m) allant de 2 à 10 ont démontré des propriétés physiques passionnantes liées à la luminescence et à l'absorption optique, à l'absorption à deux phonons et aux spectres Raman et infrarouge, qui ont ainsi trouvé des applications prometteuses dans l'optoélectronique, la détection, Domaines civils et industriels liés aux LED, à l'énergie et au laser [7,8,9,10,11,12]. Pendant ce temps, vers d'autres applications de haute technologie critiques telles que l'aérospatiale, la physique des hautes énergies, la détection des ondes gravitationnelles, l'astronomie, les voyages dans l'espace, les domaines liés à la sécurité nucléaire et nationale, les SL et les dispositifs à semi-conducteurs sont exposés à différents environnements de rayonnement, c'est-à-dire X- rayon, neutrons, électrons, ions, etc., ce qui peut entraîner la génération de défauts contenant des impuretés, des lacunes, des interstitiels, des antisites et des complexes de ceux-ci. Étant donné que les matériaux semi-conducteurs et les propriétés physiques associées jouent un rôle important dans le fonctionnement et le fonctionnement de ces dispositifs électroniques et circuits intégrés, de petites quantités de défauts peuvent modifier considérablement leurs propriétés optiques et de transport, en particulier dans les systèmes multicouches [13].
Les effets des impuretés étrangères ou des défauts intrinsèques sur les SL semi-conducteurs et leurs matériaux composants ont été largement étudiés au cours des dernières décennies. Zollo et al. ont utilisé la méthode de la théorie de la fonctionnelle de la densité (DFT) pour étudier la stabilité des défauts ponctuels dans GaAs, et ont trouvé que les défauts antisites étaient plus favorables [14]. Kahaly et al. ont étudié la structure GaAs/AlAs SL par la méthode DFT et trouvé la lacune en arsenic (VAs ) un défaut au niveau et à proximité de l'interface a conduit à un quasi 2-DEG conducteur entre l'arséniure diélectrique isolant [7]. Spasov et al. ont étudié les effets des impuretés azotées sur le transport des porteurs et la recombinaison électron-trou dans des diodes SL GaAs/AlAs [9]. Ils ont rapporté que les N impuretés modifiaient l'énergie de la minibande électronique et empêchaient la diffusion des électrons à travers la minibande SL, ce qui peut conduire à une forte recombinaison radiative des paires électron-trou [9]. Wang et al. ont étudié l'inter-diffusion induite par l'impureté Zn dans les structures GaAs/AlAs SL en utilisant une méthode ab initio méthode de dynamique moléculaire (AIMD) [15]. Leurs résultats suggèrent que la diffusion du Zn est assistée par les éléments du groupe III, qui sont éjectés dans le canal interstitiel et diffusent rapidement, désorganisant ainsi le super-réseau [15]. Mitra et Stark ont découvert que la présence de lacunes améliorait le mélange Ga/Al dans GaAs/AlAs SL, résultant du mécanisme de diffusion en anneau à deux atomes proposé [16]. Récemment, une simulation AIMD de la réponse radiative de GaAs/AlAs SL a été réalisée [17], dans laquelle les énergies minimales pour chaque atome à déplacer en permanence de son site de réseau ont été déterminées, les voies de génération de défauts ont été fournies, et les types de défauts créés ont été identifiés. Il a révélé que la paire Ga (ou Al ou As) Frenkel créée et AsGa -GaAs paire d'antisites a des effets profonds sur la densité de distribution d'état et la structure de bande de GaAs/AlAs SL [17].
Jusqu'à présent, la stabilité des défauts ponctuels dans la structure SL et les propriétés de transport comme la mobilité des porteurs restent encore inconnues. Il est donc d'une importance vitale d'étudier comment la présence de lacunes, de défauts interstitiels et antisites influence la stabilité structurelle et les propriétés électriques de GaAs/AlAs SL. Dans cette étude, la stabilité de phase de la lacune simple Ga (ou Al ou As), simple Ga (ou Al ou As) interstitiel et simple GaAs (ou AlAs ou AsGa ou AsAl ) les défauts antisites ont été étudiés. Il est montré que les défauts antisites sont énergétiquement plus favorables que les lacunes et les défauts interstitiels. Les structures de bande de ces états défectueux ont été étudiées par la méthode DFT hybride, qui incorpore une partie de l'échange exact de la théorie de Hartree-Fock avec le reste de l'énergie d'échange-corrélation d'autres sources (ab initio ou empirique) [18], et devrait offrir une description plus précise de la structure électronique des matériaux semi-conducteurs que la DFT standard. En particulier, la mobilité électronique a été prédite. Il s'avère que les défauts interstitiels et de lacunes réduisent considérablement la mobilité des électrons, tandis que les défauts antisites ont des influences relativement plus faibles. Ce travail fera progresser la compréhension des effets des dommages causés par les radiations du super-réseau semi-conducteur et fournira des conseils pour la conception d'électronique et d'optoélectronique à base de super-réseaux semi-conducteurs hautement stables et durables pour des applications dans des environnements extrêmes.
Méthodes
Dans cette étude, les relaxations structurelles sont réalisées dans le cadre DFT standard et les structures de bandes sont calculées par la DFT hybride dans le cadre de Heyd-Scuseria-Emzefhof (HSE) [19] sur la base des structures relâchées. Tous les calculs sont effectués en utilisant Vienne Ab Initio Paquet de simulation (VASP) [20]. Les pseudopotentiels d'onde augmentée du projecteur sont utilisés pour décrire l'interaction entre les ions et les électrons, et les effets d'échange-corrélation sont traités en utilisant l'approximation de la densité locale dans la paramétrisation Ceperley-Alder [21]. Les critères de convergence pour les énergies et forces totales sont de 10 −4 eV et 10 −3 eV/Å, respectivement. Le groupe de points d'origine du cristal AlAs et GaAs est le T d groupe de zinc blende, comme le montre la figure 1a. L'illustration des défauts ponctuels considérés est fournie sur la figure 1b. Le GaAs/AlAs SL contenant deux monocouches de GaAs alternant avec deux monocouches d'AlAs est considéré dans cette étude et la configuration géométrique est illustrée sur la Fig. 2, avec les défauts ponctuels considérés.

Vue schématique des structures géométriques de a XAs (X =Ga ou Al); b les défauts des XA. V X :(X =Ga, Al ou As) X vacance ; X int : X interstitiel ; X Comme :X occupant le site du réseau d'As; Comme X :Comme occupant le site du treillis X. Les sphères jaunes et violettes représentent respectivement les lacunes et les défauts interstitiels

Vue schématique des structures géométriques de a superréseau idéal GaAs/AlAs; b et c Superréseau GaAs/AlAs avec différents défauts ponctuels. X Oui :(X, Y =Ga, Al ou As) X occupant le site du réseau Y; V X :X vacance; X int :X interstitiel. Les sphères jaune et carmin représentent respectivement les lacunes et les défauts interstitiels
Résultats et discussion
Propriétés de l'état du sol de GaAs et AlAs
Comme le montre le tableau 1, les constantes de réseau de GaAs et AlAs en vrac sont déterminées à 5,61 et 5,63 Å, respectivement, ce qui est bien en accord avec les valeurs expérimentales et d'autres valeurs théoriques [22,23,24]. Il semble que le décalage de réseau entre GaAs et AlAs soit faible et que la constante de réseau de GaAs/AlAs SL soit fixée à la valeur intermédiaire de 5,62 Å. Le module de vrac est calculé par \( B=\frac{1}{3}\left({C}_{11}+2{C}_{12}\right) \) [25], où C
L'énergie de formation de défauts dans le superréseau GaAs/AlAs
Pour GaAs/AlAs SL et les états en vrac, l'énergie de formation du défaut est calculée par \( {E}_f={E}_{def}-{E}_{undef}+\sum \limits_i\Delta {n}_i{ \mu}_i \) [28]. Ici, E déf est l'énergie totale de la cellule de simulation défectueuse après relaxation, E undef est l'énergie totale de la supercellule idéale relaxée, Δn i est la variation du nombre d'espèces i (i = Ga, Al ou As) et μ i est le potentiel chimique des espèces i [28].
Pour les XAs massifs (X =Al ou Ga), les potentiels chimiques de As et X obéissent aux contraintes suivantes :\( {\mu}_X\le {\mu}_X^{bulk} \), \( {\mu} _{As}\le {\mu}_{As}^{bulk} \), et \( {\mu}_{As}+{\mu}_X={\mu}_{XAs}^{bulk } \), où \( {\mu}_X^{bulk} \), \( {\mu}_{As}^{bulk} \), et \( {\mu}_{XAs}^{bulk } \) correspondent à l'énergie totale du vrac X, du vrac As et du vrac XAs, respectivement. Les énergies de formation des défauts dans des conditions riches en X, c'est-à-dire \( {\mu}_X={\mu}_X^{bulk} \) et \( {\mu}_{As}={\mu}_{XAs }^{bulk}-{\mu}_X^{bulk} \), et condition riche en As, c'est-à-dire \( {\mu}_{As}={\mu}_{As}^{bulk} \ ) et \( {\mu}_X={\mu}_{XAs}^{bulk}-{\mu}_{As}^{bulk} \), sont résumés dans le tableau 2. Pour GaAs, sous As- riche conditionne l'AsGa (En tant qu'occupant le site du réseau Ga) le défaut antisite s'avère être le plus énergétiquement favorable, comme indiqué par la plus petite énergie de formation de 1,57 eV. Le prochain défaut favorable est le GaAs (Ga occupant le site du réseau As) défaut antisite, avec une énergie de formation de 2,31 eV. L'interstitiel As (Asint ) a la plus grande énergie de formation de 5,20 eV, ce qui suggère qu'il est plus difficile à former que d'autres défauts ponctuels considérés. Dans des conditions riches en Ga, le VGa , Asint et AsGa les défauts ont des énergies de formation plus importantes, et le VAs , Gaint et GaAs les défauts ont des énergies de formation plus petites, par rapport à la condition riche en As. Évidemment, la stabilité du défaut dépend de l'environnement chimique. Par rapport à GaAs, les énergies de formation de défauts dans AlAs sont généralement plus grandes, sauf dans le cas de Asint et AsX (X =Al ou Ga) dans des conditions riches en As. L'AsAl et AlAs les défauts antisites sont déterminés comme étant le défaut le plus favorable dans des conditions riches en As et riches en Al, respectivement. Similaire au cas de GaAs, l'Asint est également défavorable en AlAs. Les énergies de formation de défauts dans des conditions riches en As et riches en X (X =Ga ou Al) dans les XA en vrac sont tracées sur la figure 3. La figure 3a montre que l'AsGa et GaAs les défauts antisites sont plus favorables dans des conditions riches en As et riches en Ga, respectivement. Il est à noter que l'AsAl le défaut antisite est préférable dans la plupart des cas (voir Fig. 3b). Dans des conditions riches en Al, la stabilité de phase de AlAs , VComme et AsAl les défauts sont proches les uns des autres, comme indiqué par les énergies de formation de 3,0, 3,16 et 3,24 eV, respectivement. Aussi, nous trouvons que dans GaAs et AlAs, la non-favorabilité de Asint est indépendant de l'environnement chimique. Zollo et al. ont effectué des calculs de premier principe sur GaAs et leurs résultats DFT ont montré que les énergies de formation de AsGa et GaAs étaient plus petits que ceux pour les lacunes et les défauts interstitiels [14], ce qui est cohérent avec nos résultats.
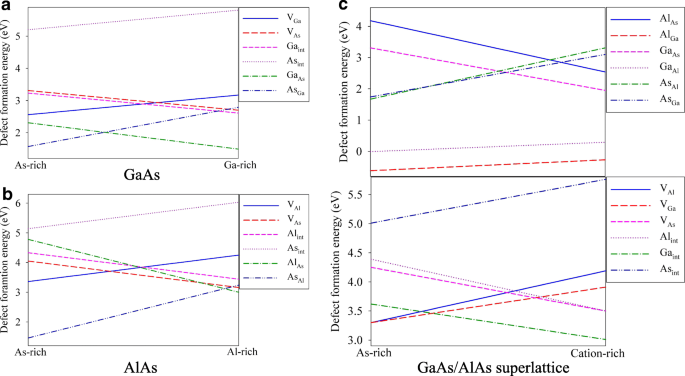
Les énergies de formation de défauts dans des conditions riches en As et riches en cations dans a GaAs, b AlAs et c Superréseau GaAs/AlAs. X Oui :(X, Y =Ga, Al ou As) X occupant le site du réseau Y; V X :X vacance; X int : X interstitiel
Le E f dans la structure GaAs/AlAs SL sont également calculés dans des conditions riches en As, c'est-à-dire \( {\mu}_{As}={\mu}_{As}^{bulk} \), \( {\mu}_ {Al}={\mu}_{Al As}^{bulk}-{\mu}_{As}^{bulk} \), et \( {\mu}_{Ga}={\mu}_ {Ga As}^{bulk}-{\mu}_{As}^{bulk} \), et une condition riche en cations, c'est-à-dire \( {\mu}_{Al}={\mu}_{Al }^{bulk} \),\( {\mu}_{Ga}={\mu}_{Ga}^{bulk} \) et \( {\mu}_{As}=\left({\ mu}_{SL}^{bulk}-{n}_{Al}\times {\mu}_{Al}^{bulk}-{n}_{Ga}\times {\mu}_{Ga} ^{bulk}\right)/{n}_{As} \), où n Al , n Ga , et n Comme représentent respectivement le nombre d'atomes Al, Ga et As dans la cellule de simulation. Comme le montre le tableau 3, l'AlGa le défaut a des énergies de formation négatives, c'est-à-dire − 0,62 et − 0,27 eV dans des conditions riches en As et riches en cations, respectivement, indiquant que la formation d'AlGa le défaut antisite est un processus exothermique. Quant à GaAl défaut, les énergies de formation sont aussi faibles que − 0,01 eV dans des conditions riches en As et 0,29 eV dans des conditions riches en cations. De toute évidence, la formation d'AlGa et GaAl les défauts antisites dans la structure GaAs/AlAs SL sont beaucoup plus faciles que les autres défauts ponctuels. Dans des conditions riches en As, les énergies de formation des seconds défauts favorables de AsGa et AsAl sont déterminés à 1,67 et 1,74 eV, respectivement. Pour les interstitiels, la stabilité de phase suit à la fois la tendance de Gaint> Alint> Asint dans des conditions riches en As et riches en cations. Les énergies de formation de défauts dans la structure GaAs/AlAs SL sont également représentées sur la figure 3c. Par rapport aux GaAs massifs, les défauts ponctuels dans GaAs/AlAs SL sont généralement plus difficiles à former, sauf le cas de Asint (voir fig. 3a, c). Les énergies de formation de Asint en vrac, les GaAs sont de 5,20 et 5,81 eV dans des conditions riches en As et riches en Ga, ce qui est légèrement supérieur aux valeurs correspondantes de 5,01 et 5,76 eV dans GaAs/AlAs SL. Comme le montrent les figures 3b et c, la stabilité des défauts ponctuels dans la structure massive d'AlAs et de SL présente un caractère différent. Les AlAs et Asint les défauts sont énergétiquement plus favorables en GaAs/AlAs SL qu'en AlAs massif, alors que VAs le défaut est plus préférable dans l'AlAs en vrac que dans la structure SL. Il est à noter que dans des conditions riches en As et riches en Al, les énergies de formation de Alint les AlAs en vrac sont comparables à ceux de GaAs/AlAs SL. Similaire au cas de Alint , le VAl le défaut de la structure massive d'AlAs et de SL montre une favorabilité similaire, comme indiqué par les énergies de formation comparables. Dans le cas de AsAl défaut, l'énergie de formation dans des conditions riches en As est plus petite (1,46 eV) dans la structure SL, alors que dans des conditions riches en cations, la valeur est plus petite (3,10 eV) dans l'AlAs massif, suggérant que la stabilité de AsAl dépend de l'environnement chimique.
En comparant la stabilité des défauts en vrac AlAs, GaAs et GaAs/AlAs SL, nous trouvons que les défauts antisites sont toujours plus préférables que les lacunes et les interstitiels, en particulier pour les cas de GaAl et AlGa en GaAs/AlAs SL. Il est également noté que dans des conditions riches en As et riches en cations, l'Asint le défaut est le plus difficile à former à la fois dans les états de masse et dans la structure GaAs/AlAs SL.
Les effets des défauts ponctuels sur les structures de bandes du super-réseau GaAs/AlAs
L'état vierge du superréseau GaAs/AlAs
Les bandes interdites pour GaAs, AlAs et GaAs/AlAs SL sont résumées dans le tableau 4, et leurs structures de bandes sont présentées sur la figure 4. Les calculs DFT hybrides déterminent que la bande interdite directe de GaAs est de 1,44 eV (voir la figure 4a). ), ce qui est en bon accord avec la valeur expérimentale de 1,52 eV [29] et d'autres calculs [24]. En revanche, la DFT standard prédit une valeur de bande interdite de 0,5 eV, ce qui sous-estime largement la bande interdite de GaAs. Pour AlAs, la structure de bande est de caractère indirect et la bande interdite DFT hybride est de 2,16 eV (voir Fig. 4b), ce qui est 0,85 eV plus grand que le résultat DFT et en bon accord avec la valeur expérimentale de 2,22 eV [23]. Comme le montre la figure 4c, la bande interdite de GaAs/AlAs SL est déterminée comme étant directe et est cohérente avec l'étude de Botti et al., qui ont trouvé la bande interdite de (GaAs)m /(AlAs)m SL (m ≥ 2) pour être direct au point Γ [3]. Dans nos calculs, la bande interdite directe pour GaAs/AlAs SL est déterminée à 2,06 eV par la méthode DFT hybride, ce qui est en accord avec la valeur expérimentale de 2,10 eV [30].

Les structures de bande de a GaAs, b AlAs et c Superréseau GaAs/AlAs. Les valeurs DFT hybrides sont tracées dans les panneaux de gauche et les résultats DFT sont tracés dans les panneaux de droite
Les effets des défauts antisites sur la structure de bande du super-réseau GaAs/AlAs
Dans la structure GaAs/AlAs SL, le GaAl et AlGa les défauts antisites sont plus énergétiquement favorables que les autres défauts ponctuels. Comme le montrent les figures 5a et b, les structures de bande de GaAl et AlGa les états défectueux sont très similaires à ceux de l'état vierge et les bandes interdites sont respectivement de 1,98 et 2,01 eV. Cela devrait être dû au fait que les éléments chimiques Al et Ga ont une configuration électronique de valence similaire, c'est-à-dire 3s 2 3p 1 pour Al et 4s 2 4p 1 pour Ga, et aucun électron ou trou supplémentaire n'est introduit lors de la formation de GaAl et AlGa défauts antisites. Les structures de bande pour AsGa et AsAl les états défectueux sont représentés sur les figures 5c et d. Il s'avère que ces deux défauts modifient considérablement la structure de bande de GaAs/AlAs SL. Tant l'AsGa et AsAl les défauts antisites introduisent des électrons supplémentaires et agissent comme des dopants de type n. Les niveaux d'impuretés s'avèrent éloignés des bandes de valence et croisent le niveau de fermi, comme le montrent les figures 5c et d. Ces niveaux de défauts profonds peuvent servir de centre de recombinaison pour les transporteurs.

Les structures de bande du super-réseau GaAs/AlAs défectueux avec différents défauts antisites. un :Ga occupant le site du réseau d'Al; b :Al occupant le site du réseau de Ga; c :As occupant le site du réseau de Ga; d :Comme occupant le site du treillis d'Al
La figure 6 présente les structures de bandes et la densité d'état partielle (PDOS) de SL défectueux avec GaAs et AlAs défauts. Comme le montre la figure 6a, la structure de bande pour GaAs le SL défectueux a un caractère de division de rotation. Dans les sous-bandes de spin-down, le niveau de fermi passe par les niveaux de défauts introduits par le GaAs défaut, indicatif du caractère semi-métallique du SL défectueux. Selon la définition du demi-gap métallique [31], la bande interdite de GaAs l'état défectueux est d'environ 0,10 eV. Comme indiqué dans le PDOS du SL défectueux avec GaAs , les sous-bandes de spin-down près du niveau de fermi sont principalement contribuées par p ondes partielles. En raison des configurations d'électrons de valence similaires entre les atomes de Ga et d'Al, les structures de bandes de spin-up et de spin-down calculées de AlAs l'état défectueux sont déterminés (voir Fig. 6b), et la bande interdite est calculée à 0,15 eV. Dans l'ensemble, l'AlGa et GaAl les défauts antisites ont des effets négligeables sur la structure électronique de GaAs/AlAs SL. On note également que le SL défectueux avec AsAl et AsGa les défauts présentent une métallicité, tandis que les SL défectueux avec GaAs et AlAs sont à moitié métalliques.

Les structures de bandes et la densité d'état partielle du super-réseau GaAs/AlAs défectueux avec a GaAs et b AlComme défauts antisites. X Comme (X =Ga ou Al) X occupant le site du réseau As
Les effets des défauts d'inoccupation sur la structure de bande du superréseau GaAs/AlAs
Les structures de bande de la structure SL avec différentes lacunes sont tracées sur la figure 7, et leurs PDOS correspondants sont représentés sur la figure 8. Le caractère de division de spin de la structure de bande se retrouve également dans le cas de SL défectueux avec VGa et VAl défauts, comme le montrent les Fig. 7a et b. En effet, la suppression des atomes de leurs positions d'origine laisse quatre liaisons pendantes liées au sp 3 orbitales. Au cours de la relaxation structurelle, les atomes les plus proches autour de la lacune sont également déplacés vers le site de réseau vide, ce qui entraîne une symétrie de site définie par le tétragonal D 2d groupe de points. Les niveaux de défauts induits apparaissent près de la bande de valence et se situent dans la région interdite du GaAs/AlAs SL. La bande interdite est déterminée à 0,47 et 0,44 eV pour le SL avec VGa et VAl défauts, respectivement. Comme indiqué dans le PDOS du SL défectueux avec VGa et VAl (voir Fig. 8a et b), la principale influence des postes vacants du groupe III est sur le p États. Comme le montre la figure 7c, la structure de bande du SL défectueux avec VAs le défaut se divise en parties de rotation ascendante et de rotation descendante, et les niveaux de défaut apparaissent près de la bande de conduction. Depuis le VAs le défaut agit comme un dopant de type n, le niveau de fermi passe à une énergie plus élevée et traverse le bord du niveau de défaut. Kahaly et al. ont étudié les propriétés électriques des hétérointerfaces GaAs-AlAs et ont trouvé que VAs défaut à l'interface conduit à quasi 2-DEG [7], ce qui est cohérent avec nos résultats. Nos calculs montrent que les lacunes ont des effets différents sur la structure de bande de GaAs/AlAs SL, c'est-à-dire le VAs le défaut induit la métallicité de GaAs/AlAs SL, et le VGa et VAl les défauts réduisent considérablement la bande interdite de la structure SL.

Les structures de bande du super-réseau GaAs/AlAs défectueux avec a VGa , b VAl et c VComme défauts de vacance. V X (X =Ga, Al ou As) X poste vacant

La densité partielle d'état du super-réseau GaAs/AlAs défectueux avec a VGa , b VAl et c VComme défauts de vacance. V X (X =Ga, Al ou As) X poste vacant
Les effets des défauts interstitiels sur la structure de bande du super-réseau GaAs/AlAs
La figure 9 présente les structures de bande de la structure SL avec des défauts interstitiels. Il est à noter que le niveau de fermi passe à une énergie élevée et traverse le bord de la bande de conduction (voir Fig. 9a et b), en raison du fait que les interstitiels du groupe III sont des défauts de type donneur. Par conséquent, les SLs défectueuses avec Gaint et Alint montrer un caractère métallique. Comme le montre la figure 9c, dans les parties de spin-up et de spin-down de la structure de la bande, les niveaux d'impuretés apparaissent près de la bande de conduction et le niveau de fermi traverse le bord du niveau d'impureté, indiquant la métallicité induite de GaAs/AlAs SL défectueux avec Asint . De toute évidence, les défauts interstitiels modifient significativement les structures électroniques de GaAs/AlAs SL et induisent généralement une métallicité de la structure SL défectueuse.

Les structures de bande du super-réseau GaAs/AlAs défectueux avec a Gaint défaut, b Alint défaut et c Asint défaut. X int (X =Ga, Al ou As) X interstitiel
En comparant les structures de bandes et les PDOS représentatifs du GaAs/AlAs SL avec des antisites, des lacunes et des interstitiels, nous trouvons que les défauts modifient considérablement les structures électroniques, sauf dans le cas de GaAl et AlGa défauts antisites. En outre, le rétrécissement de la bande interdite et même la métallicité sont induits, ce qui influencera considérablement les performances de GaAs/AlAs SL.
Les effets des défauts ponctuels sur la mobilité électronique du super-réseau GaAs/AlAs
La mobilité électronique à 0 K peut être calculée à partir de l'équation μ = eτ /m ∗ , où e est la charge électronique, τ est le temps de relaxation, et m ∗ est la masse effective du porteur [32]. Les masses effectives des électrons peuvent être évaluées à partir de la courbure des structures de bandes via la relation \( {m}^{\ast }={\mathrm{\hslash}}^2{\left(\frac{d^2\varepsilon }{dk^2}\right)}^{-1} \) [32], où est la constante de Planck réduite, k est le vecteur d'onde, et ε est l'énergie du minimum de la bande de conduction. Comme le montrent les Fig. 4a et b, nous obtenons m * = 0,057 m e pour GaAs et m * = 0.19 m e pour AlAs, en bon accord avec les valeurs expérimentales de 0,057 m e pour GaAs [33] et 0,124 m e pour AlAs [34], où m e est la masse statique des électrons. Le temps de relaxation pour AlAs et GaAs est supposé être respectivement de 0,17 et 0,48 ps [35]. La mobilité électronique de GaAs et AlAs à 0 K est calculée à 1,48 × 10 4 cm 2 /Vs et 1,57 × 10 3 cm 2 /Vs, respectivement, ce qui est comparable aux valeurs expérimentales de 0.94 × 10 4 cm 2 /Vs pour GaAs [36] et 0,28 × 10 3 cm 2 /Vs pour AlAs [37].
Comme le montre le tableau 5, la masse effective de l'électron au point Г (\( {m}_{\Gamma}^{\ast } \)) est déterminée à 0,113 m e pour le GaAs/AlAs SL vierge et le temps de relaxation τ est supposée être de 0,4 ps [38]. La mobilité des électrons le long de la direction z, c'est-à-dire la direction Γ-X dans la zone Brillouin (μ Γ − X ) est calculé comme étant 0,623 × 10 4 cm 2 /Vs pour GaAs/AlAs SL idéal, qui est comparable à la valeur expérimentale de 1,0 × 10 4 cm 2 /Vs [38]. Quant au SL défectueux avec défauts antisites, la valeur de μ Γ − X est comparable à celui du SL idéal, sauf pour les cas de GaAs et AlAs défauts. La mobilité des électrons le long de la direction Γ-X est déterminée à 0,263 × 10 4 cm 2 /Vs et 0.311 × 10 4 cm 2 /Vs pour GaAs et AlAs états défectueux, respectivement, qui sont beaucoup plus petits que celui de l'état idéal. Il est à noter que le Gaint , Alint et Asint les défauts réduisent également la mobilité des électrons de manière significative, comme indiqué par les valeurs de 0,225 × 10 4 cm 2 /Vs pour Gaint , 0,243 × 10 4 cm 2 /Vs pour Alint et 0,315 × 10 4 cm 2 /Vs pour Asint . Par rapport à l'antisite et au défaut interstitiel, les lacunes ont les effets les plus profonds. Pour VGa et VAl défauts, les valeurs de μ Γ − X sont environ six fois plus petits que celui de l'état vierge. Le VAs le défaut diminue également de manière significative la mobilité des électrons, comme indiqué par 0,127 × 10 4 cm 2 /Vs. Tanaka et al. ont étudié les effets de l'irradiation électronique sur les propriétés électriques des hétérostructures GaAs/AlGaAs et ils ont trouvé que la mobilité des électrons était réduite à des doses supérieures à 5 × 10 20 cm −2 [dix]. Especially, the defect creation in GaAs channel region, rather than n-AlGaAs layer, is thought to be the main cause of the mobility degradation [10]. Recently, it has been suggested that the electrons are possibly trapped by defects or impurity and produce metastable states accompanied by lattice relaxation [39]. Consequently, the electronic structure and carrier mobility of GaAs/AlAs SL are influenced significantly by the point defects. Therefore, it is necessary to enhance the radiation tolerance of GaAs/AlAs SL to improve its electronic performance under radiation environment.
Conclusions
In this work, a hybrid density functional theory study is performed to investigate the effects of point defect on the electrical properties of GaAs/AlAs superlattice (SL). The calculated defect formation energies show that the antisite defects are the most favorable in bulk GaAs and AlAs. In GaAs/AlAs SL structure, the antisite defects are always dominant under cation-rich and As-rich conditions and the interstitial defects are very difficult to form during the whole range of chemical potentials. It is shown that the different point defects have various effects on the electronic structures of GaAs/AlAs SL. The AsX (X =Al or Ga) and XAs antisite defects always induce metallicity, although the defective SLs with XAs antisites show spin splitting. As for vacancies, the defective SL with VAs shows metallicity character, and the group III vacancy defects reduce the band gap of the superlattice significantly. The metallicity is also found in the defective GaAs/AlAs SL with the interstitial defects. The further carrier mobility calculations show that the interstitial and vacancy defects reduce the electron mobility significantly, while the antisite defects have relatively smaller influence.
Abréviations
- 2-DEG:
-
Two-dimensional electron gas
- AIMD:
-
Ab initio molecular dynamics
- Al :
-
Aluminium
- AlAs:
-
Aluminum arsenide
- As:
-
Arsenic
- AsX :
-
As occupying the X lattice site
- DFT :
-
Théorie fonctionnelle de la densité
- Ga :
-
Gallium
- GaAs:
-
Gallium arsenide
- HEMT:
-
High electron mobility transistors
- HSE:
-
Heyd-Scuseria-Emzefhof
- LED:
-
Light-emitting diode
- N :
-
Azote
- PDOS :
-
Partial density of state
- QCLs:
-
Quantum cascade lasers
- SL:
-
Superlattice
- VASP:
-
Vienna Ab Initio Simulation Package
- VX (X =Ga, Al or As):
-
X vacancy
- XAs :
-
X occupying the As lattice site
- Xint :
-
X interstitial
- Zn:
-
Zinc
Nanomatériaux
- Dévoilement de la structure atomique et électronique des nanofibres de carbone empilées
- Absorbeur parfait à bande ultra-étroite et son application en tant que capteur plasmonique dans la région visible
- Étude des premiers principes sur la stabilité et l'image STM du borophène
- Effet du traitement de recuit in situ sur la mobilité et la morphologie des transistors à effet de champ organiques à base de TIPS-Pentacène
- Les effets du rapport Li/Nb sur la préparation et les performances photocatalytiques des composés Li-Nb-O
- Influence de l'eau sur la structure et les propriétés diélectriques de la microcristalline et de la nano-cellulose
- Effets de l'épaisseur de la bicouche sur les propriétés morphologiques, optiques et électriques des nanolaminés Al2O3/ZnO
- Étude expérimentale sur les caractéristiques d'écoulement et de transfert de chaleur de nanofluides TiO2-eau dans un tube cannelé en spirale
- Les effets de couplage des polaritons de plasmon de surface et des résonances dipolaires magnétiques dans les métamatériaux



