Mécanisme de conduction et endurance améliorée dans la RRAM à base de HfO2 avec traitement de nitruration
Résumé
Une technologie de traitement de nitruration avec une source d'azote complexe urée/ammoniac a amélioré la propriété de commutation résistive en HfO2 -mémoire résistive à accès aléatoire (RRAM). Le traitement de nitruration a produit un appareil performant et fiable qui se traduit par une endurance supérieure (plus de 10 9 cycles) et un effet d'auto-conformité. Ainsi, le mécanisme de conduction actuel a changé en raison du défaut de passivation par les atomes d'azote dans le HfO2 couche mince. À un état de haute résistance (HRS), il a été transféré à l'émission Schottky de Poole-Frenkel dans HfO2 basée sur la RRAM. À l'état de faible résistance (LRS), le mécanisme de conduction actuel était un courant à charge limitée (SCLC) après le traitement de nitruration, ce qui suggère que les atomes d'azote forment des amas de lacunes Hf-N-Ox (Vo + ) qui limitent le mouvement des électrons à travers la couche de commutation.
Contexte
Récemment, la mémoire à accès aléatoire à résistance (RRAM) composée d'une couche isolante prise en sandwich par deux électrodes a été largement étudiée comme un candidat prometteur pour la mémoire non volatile de nouvelle génération en raison de ses propriétés supérieures telles qu'une structure simple, une faible consommation d'énergie, un fonctionnement à grande vitesse. (< 300 ps) et lecture non destructive [1–9]. Bien que la plupart des dispositifs RRAM aient de nombreuses propriétés supérieures à la mémoire non volatile, le courant de fonctionnement élevé de la RRAM et la dégradation des performances sont des problèmes majeurs dans la mémoire non volatile en termes d'application de produits électroniques portables.
Le Pt/HfO2 La structure /TiN peut fournir un chemin de conduction qui induit un comportement de commutation résistif [10–19]. Cependant, les défauts du HfO amorphe2 augmentera le nombre de chemins de fuite, entraînant une consommation d'énergie et une dégradation de l'échauffement par effet joule. Dans ce travail, la couche de commutation résistive de HfO2 a été traité par une solution avec une source d'azote complexe urée/ammoniac comme traitement de nitruration pour améliorer ses propriétés de commutation électrique.
Méthodes
Les motifs TiN/Ti/SiO2 Le substrat /Si a été fabriqué avec un processus de dépôt et de gravure standard, après quoi des trous de traversée peuvent être formés (encadré de la figure 1a). Ensuite, un HfO2 de 23 nm d'épaisseur un film mince a été déposé dans des trous d'interconnexion sur le substrat par pulvérisation cathodique magnétron RF à l'aide d'un HfO2 pur cibler. La puissance de pulvérisation a été fixée à une puissance RF de 150 W et a été réalisée dans une atmosphère d'argon (Ar = 30 sccm) avec une pression de travail de 4 mtorr à température ambiante. Le HfO2 Le dispositif semi-fini /TiN a été placé dans la chambre réactive et immergé dans la solution avec une source d'azote complexe urée/ammoniac pour le traitement de nitruration. Pendant le traitement de nitruration, la solution a été chauffée à 160 °C dans la chambre en acier inoxydable du système pendant 30 min. Ensuite, l'électrode supérieure en Pt de 110 nm d'épaisseur a été déposée par pulvérisation cathodique magnétron DC sur le HfO2 film mince pour former des appareils électriques avec Pt/HfO2 /Structures sandwich TiN. Enfin, toutes les caractéristiques électriques ont été mesurées par l'analyseur de paramètres à semi-conducteur Agilent B1500. Les polarisations de balayage DC et d'impulsion ont été appliquées à l'électrode inférieure (TiN) tandis que l'électrode supérieure (Pt) était mise à la terre pendant les mesures électriques. De plus, la spectroscopie infrarouge à transformée de Fourier (FTIR) a été mesurée par un spectromètre Bruker VERTEX 70v dans la région de l'infrarouge moyen.

un Les courbes de courant de formation de HfO2 -périphériques RRAM basés. b Comparaison des cycles de balayage CC à un courant de conformité de 5 mA entre le traitement initial et après le traitement de nitruration de HfO2 basée sur la RRAM. c Cycles de balayage CC sans conformité de courant externe du HfO2 appareil après traitement de nitruration. d Temps de rétention du HfO2 -Dispositifs RRAM à 85 °C avec et sans courant de conformité après traitement de nitruration
Résultats et discussion
Un processus d'électroformage est nécessaire pour activer tous les dispositifs RRAM en utilisant une polarisation CC avec un courant de conformité de 10 μA, comme illustré à la Fig. 1a. Après le processus de formage, les propriétés électriques courant-tension (I-V) du HfO2 -base RRAM ont été comparés au début et après le traitement de nitruration. Au LRS, le courant était évidemment réduit par rapport à celui du HfO2 non traité film mince, comme le montre la figure 1b. La diminution actuelle peut être attribuée aux défauts passivés par le NH3 molécule dans la solution de traitement. Nous avons constaté que la distribution HRS est beaucoup plus stable après le traitement de nitruration, comme dans l'encart de la figure 1b. Les états de résistance sont extraits avec une tension de lecture de 0,1 V pendant les 100 cycles de balayage en fonctionnement continu (encadré de la figure 1b). Le rapport résistance marche/arrêt a été légèrement réduit après le traitement de nitruration. Fait intéressant, une propriété de commutation résistive d'auto-conformité a été observée dans ces HfO2 périphériques RRAM après le traitement, comme le montre la figure 1c. Après plus de 10 3 cycles de balayage, une caractéristique d'autoprotection reproductible de l'appareil sans panne brutale a été observée. Le temps de rétention a été évalué à 85 °C et est resté stable même après 10 4 s à la fois dans HRS et LRS.
Pour évaluer davantage les performances de l'appareil, les tests d'endurance de HfO2 -base RRAM ont été effectuées pour le traitement initial et après le traitement de nitruration, comme le montre la figure 2. Dans l'appareil non traité après 10 6 cycles de balayage, le rapport HRS/LRS se dégrade considérablement de 100:1 à 5:1, comme le montre la figure 2a. Après le traitement de nitruration, cependant, même après plus de 10 9 cycles de balayage, l'appareil présentait un rapport HRS/LRS stable, comme dans la Fig. 2b. Ces résultats indiquent que le processus de nitruration a amélioré le HfO2 -Basé sur la RRAM pour fonctionner avec des fonctionnalités de commutation et une fiabilité supérieures. Pour approfondir ces résultats, une analyse FTIR a été utilisée pour observer les altérations chimiques du HfO2 film mince, comme le montre la Fig. 3. Un pic net à 1589 et 1311 cm −1 est apparu après le traitement de nitruration, correspondant au pic de vibration d'étirement symétrique et asymétrique d'une liaison N–O [20]. De plus, l'intensité maximale des liaisons N-H à 1471 cm −1 [21] a augmenté en raison du processus de nitruration par source d'azote complexe urée/ammoniac (encadré de la Fig. 3). Par conséquent, nous pouvons déduire la formation de composés azotés après le traitement de nitruration.
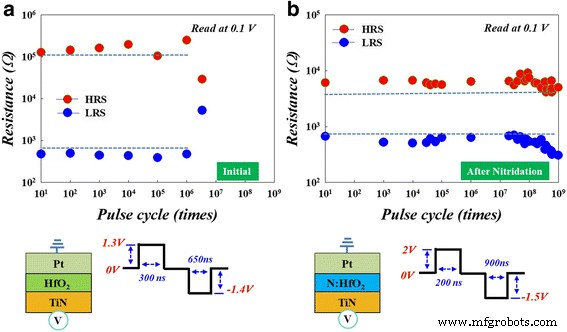
Comparaison des temps d'endurance en HfO2 -base RRAM :a initiale et b après traitement de nitruration. Les diagrammes du bas sont les structures d'appareil correspondantes et les conditions d'impulsion d'endurance

La comparaison des spectres FTIR de HfO2 films minces entre le traitement initial et après le traitement de nitruration
Afin de clarifier le mécanisme de commutation résistive, nous avons analysé le mécanisme de conduction actuel du HfO2 film mince avec et sans traitement de nitruration, illustré aux Fig. 4a et d. Pour le HfO2 non traité film mince, les électrons ont été transférés à travers les défauts, de sorte que le mécanisme de conduction du courant était dominé par la conduction de Poole-Frenkel selon la relation linéaire entre ln(I/V) et la racine carrée de la tension appliquée (V 1 /2 ) sur HRS, comme illustré à la Fig. 4b [22].
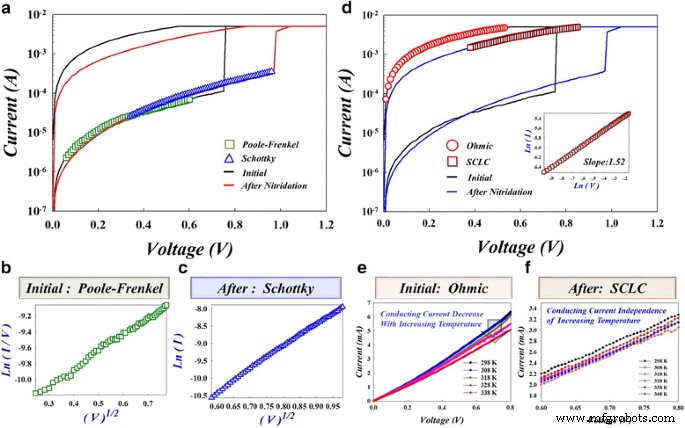
un Analyse du mécanisme de conduction du courant de HRS à partir des courbes I-V dans HfO2 -base RRAM entre le traitement initial et après le traitement de nitruration. b Le mécanisme de conduction de courant Poole-Frenkel de HRS dans HfO2 basée sur la RRAM. c Le mécanisme de conduction du courant d'émission Schottky de HRS dans HfO2 -base RRAM après le traitement de nitruration. d Analyse du mécanisme de conduction du courant du LRS qui se transforme en SCLC à partir de la conduction ohmique après traitement de nitruration dans HfO2 basée sur la RRAM ; la figure en médaillon montre le résultat de l'ajustement du courant SCLC. e Le mécanisme de conduction ohmique du LRS dans HfO2 -base RRAM qui est caractéristique de la corrélation négative actuelle avec la température. f Le mécanisme SCLC du LRS dans HfO2 -à base de RRAM indépendante de la température après le traitement de nitruration
En revanche, HfO2 -based RRAM présentait le mécanisme d'émission Schottky selon la relation linéaire entre ln(I/T 2 ) et la racine carrée de la tension appliquée (V 1/2 ) de HRS, comme le montre la Fig. 4c [23, 24]. Cela est dû à la diminution des défauts et des liaisons pendantes, car les liaisons sont passives par les atomes d'azote après le traitement de nitruration. De plus, nous avons également analysé le mécanisme de conduction actuel avec et sans traitement au LRS dans HfO2 basée sur la RRAM. Sur LRS, le mécanisme de transport porteur du HfO2 non traité La RRAM basée sur la technologie était dominée par la conduction ohmique, où le courant diminue avec l'augmentation de la température, comme le montre la figure 4e. Après traitement de nitruration, le mécanisme de conduction du courant passe au courant à charge limitée (SCLC) avec une pente de 1,52. La courbe I-V n'est pas relative à la température, avec une relation linéaire entre ln(I) et le carré de la tension appliquée V 2 sur LRS, comme illustré à la Fig. 4f [25].
Nous avons proposé un modèle pour expliquer les caractéristiques du mécanisme de conduction actuel, et il est montré comme Fig. 5. Ainsi, il y a deux dipôles décalés associés aux atomes N et O et un atome Hf (c'est-à-dire la séquence O-Hf-O est remplacé par O–Hf–N–O) après avoir dopé N atomes en HfO2 couche mince. Étant donné que la négativité électronique de l'azote est inférieure à celle de l'oxygène, le dipôle de la liaison Hf-N est inférieur à la liaison Hf-O, ce qui crée une région de constante diélectrique inférieure. Lorsqu'une polarisation positive est appliquée au cours du processus SET, une série de lacunes Hf-N-Ox sont formées en raison de leur constante diélectrique inférieure, formant alors des amas de lacunes (Vo + ). Le chemin conducteur se forme généralement avec les groupes de lacunes Hf-N-Ox (Vo + ) car les atomes d'azote capturent les ions d'oxygène autour des amas, comme le montre la figure 5b. La présence de ces amas de lacunes isolantes Hf–N–Ox (Vo + ) entraîne une réduction du courant et l'effet d'auto-conformité trouvé dans HfO2 basée sur la RRAM.

Un schéma de la migration des ions oxygène à travers le processus défini dans HfO2 -base RRAM pour a initiale et b après traitement de nitruration, qui forme des amas de lacunes Hf–N–Ox (Vo + )
Conclusions
En résumé, une propriété de commutation résistive d'auto-conformité a été observée dans un Pt/HfO2 /TiN RRAM après le traitement de nitruration. Les temps d'endurance ont atteint 10 9 cycles et un temps de rétention de plus de 10 4 s a été atteint à 85 °C. En raison de la plus petite négativité électronique de l'atome d'azote par rapport à l'atome d'oxygène, le dipôle de la liaison Hf-N est plus petit que celui de la liaison Hf-O, ce qui crée une région de constante diélectrique inférieure. Au cours du processus SET, les clusters de postes vacants Hf–N–Ox (Vo + ) forment le chemin conducteur. Les grappes d'inoccupation isolantes Hf–N–Ox (Vo + ) protéger l'appareil contre les pannes dures et effectuer une propriété d'auto-conformité.
Abréviations
- FTIR :
-
Spectroscopie infrarouge à transformée de Fourier
- HRS :
-
État de haute résistance
- LRS :
-
État de faible résistance
- RRAM :
-
Mémoire vive résistive
- SCLC :
-
Charge d'espace courant limité
Nanomatériaux
- Beurre et margarine
- Entretien avec un expert :Spencer Wright de pencerw.com et nTopology
- Gagner en traction avec Markforged :surmouler et couler des roues imprimées en 3D
- Matériaux :Mousse EPP avec propriétés de surface améliorées et comportement de remplissage optimisé
- Nanomatériau et nanocomposite intelligents dotés d'activités agrochimiques avancées
- Modèle de rétention de TaO/HfO x et TaO/AlO x RRAM avec caractéristiques de commutateur auto-rectifiant
- Nanoparticules d'albumine chargées de resvératrol avec une circulation sanguine prolongée et une biocompatibilité améliorée pour une thérapie ciblée très efficace contre les tumeurs pancréat…
- Amélioration de l'efficacité antitumorale et de la pharmacocinétique de la bufaline via les liposomes pégylés
- Toxicité des nanoparticules de CoFe2O4 enrobées de PEG avec effet thérapeutique de la curcumine



