Caractérisation et fabrication du CFM-JTE pour dispositif d'alimentation 4H-SiC avec protection à haute efficacité et fenêtre de tolérance de dose JTE accrue
Résumé
Un redresseur 13,5 kV 4H-SiC PiN avec une surface active considérable de 0,1 cm 2 est fabriqué dans cet article. L'extension de terminaison de jonction modulée par champ de charge (CFM-JTE) a été proposée pour satisfaire l'exigence de tension inverse ultra-élevée, qui élargit la fenêtre de tolérance de dose JTE, la rendant environ 2,8 fois supérieure à celle du JTE conventionnel à deux zones. En outre, le CFM-JTE peut être mis en œuvre via le processus JTE conventionnel à deux zones. Le courant direct mesuré est jusqu'à 100 A @ V F = 5,2 V en l'absence de technologie d'amélioration de la durée de vie du support. La structure CFM-JTE atteint 96 % de la tension de claquage théorique de la jonction plane parallèle avec une zone terminale relativement petite de 400 μm, ce qui contribue à atteindre le facteur de mérite de Baliga de 58,8 GW/cm 2 .
Introduction
Le carbure de silicium est devenu une nouvelle option pour améliorer les applications d'alimentation en raison de ses caractéristiques de tension plus élevée fonctionnant avec des couches actives plus minces, une densité de puissance étendue, une commutation de fréquence plus élevée, une meilleure dissipation thermique, une taille de système plus petite et un coût de système inférieur [1, 2]. Au cours des dernières années, les redresseurs SiC et les MOSFET commerciaux ont été évalués à 1,2-1,7 kV. Cependant, dans des domaines d'application représentatifs tels que les réseaux intelligents, les véhicules électriques, les alimentations à impulsions et les alimentations à semi-conducteurs ultra haute tension, il existe une demande croissante pour une capacité de blocage supérieure à 10 kV et une capacité de courant direct supérieure à 1 000 A cm −2 .
Jusqu'à présent, les principaux défis rencontrés par les dispositifs électroniques de puissance à 10 kV et SiC de niveau supérieur se sont concentrés sur les performances de la technologie de terminaison de jonction, la simplification des processus de fabrication, la haute qualité de la couche épitaxiale épaisse et la réduction des défauts de surface. Pour les dispositifs SiC ultra haute tension, la longueur de la structure terminale est généralement 6 à 8 fois supérieure à l'épaisseur épitaxiale [3], ce qui réduit considérablement le taux d'utilisation de la plaquette et augmente ainsi le coût de fabrication. Les redresseurs 4H-SiC PiN sont devenus les candidats les plus appropriés pour les applications à très haute tension en raison de l'effet de modulation de conductivité. Pour la structure d'anneau de limitation de champ (FLR), une conception d'optimisation précise peut être obtenue par calcul analytique [4], tandis que la photolithographie actuelle ne peut pas atteindre l'espace et la largeur précis des anneaux. La nouvelle borne annulaire de limitation de champ pour dispositif SiC 10 kV a été appliquée pour avoir une efficacité de protection inverse élevée [5, 6], mais sa surface terminale dépasse 700 μm, ce qui entraîne une consommation supplémentaire de la plaquette SiC. L'extension de terminaison de jonction (JTE) est une autre structure de protection terminale à haute efficacité fréquemment utilisée, mais son efficacité est extrêmement sensible à la dose de JTE. Pour les niveaux de très haute tension, les MZ-JTE et CD-JTE [7] sont utilisés pour moduler de manière critique le champ électrique et nécessitent des conditions et des temps d'implantation ionique stricts, ce qui augmente à son tour la complexité et le coût de fabrication. Afin d'améliorer la capacité de conduction, des recherches sur les caractéristiques de la hauteur de barrière entre divers métaux et SiC ont été menées [8, 9]. Habituellement, un film Ti/Al de 50 à 100 nm d'épaisseur est formé pour le contact ohmique de l'anode et le film Ni est pour le contact ohmique de la cathode, respectivement. En outre, l'échelle de la zone active du redresseur 4H-SiC affectera grandement les caractéristiques de courant direct. On constate que dans la couche épitaxiale 4H-SiC de type N, le Z 1/2 centre (E C -0,65 eV), le niveau d'accepteur de la monovacance de carbone, affecte principalement la durée de vie du porteur [10]. L'implantation d'ions aluminium conduira à une grande concentration de niveaux profonds massifs impliquant le Z 1/2 centre dans la périphérie de la mésa et la région de terminaison de jonction [11], entraînant une diminution de la durée de vie du porteur. Par conséquent, les redresseurs 4H-SiC avec une grande surface active (> 9 mm 2 ) sont requis dans la conception et la fabrication car l'impact de la durée de vie réduite du support dans la région périphérique de la mésa et la région de terminaison est relativement négligeable.
Dans cet article, le redresseur 4H-SiC CFM-JTE PiN est fabriqué sur une couche épitaxiale de 100 μm de 5 × 10 14 cm −3 et atteint une capacité de blocage considérable de 13,5 kV à l'état éteint et un courant direct de 100 A à V F = 5,2 V à l'état passant. La résistance différentielle à l'état passant du redresseur CFM-JTE PiN est mesurée à 3,1 mΩ cm 2 à température ambiante. Le CFM-JTE obtient 96 % de la tension de claquage théorique grâce au concept et à l'analyse de la modulation du champ de charge, qui élargit favorablement la fenêtre de tolérance de la dose d'implantation et conduit à une longueur de terminaison acceptable de 400 μm.
Méthodes
Analyse de la structure des appareils
La conception, l'optimisation et l'analyse sont exécutées par Silvaco-TCAD. La figure 1 montre le schéma de la structure 4H-SiC PiN avec terminaison, impliquant :(a) charge-champ modulé (CFM-JTE), (b) out-ring-assisted JTE (ORA-JTE) et (c) JTE à deux zones (TZ-JTE). Dans l'état de blocage, le taux d'ionisation par collision électron-trou est étroitement lié à l'intensité du champ électrique. Un concept de modulation de champ électrique de charge E q (r ) est proposé de révéler le mécanisme de modulation du CFM-JTE à travers la méthode de superposition vectorielle du champ électrique terminal causé par le champ électrique de charge E q (r ) sur la figure 1a. Le CFM-JTE se compose de la région JTE1, de la région JTE2 et de trois groupes d'anneaux. Les anneaux multiples divisent de manière équivalente le terminal en cinq zones dopées :R1 -R2 , R2 -R3 , R3 -R4 , R4 -R5 et R5 -R6 , où les frais effectifs de Q 1 , Q 2 , Q 3 , Q 4 et Q 5 sont introduits, respectivement. Basé sur la décomposition et la superposition de vecteurs de champ électrique à x et y coordonnées, le champ électrique global situé dans R je point causé par le champ potentiel appliqué E p (r ) et le champ électrique de charge E Qi (r ) généré par chaque Q je peut être exprimé analytiquement dans le x et y directions, comme indiqué dans les équations. (1) et (2), respectivement.
$$E_{Ri, x} =E_{px} + \mathop \sum \limits_{j =1}^{i - 1} E_{Qjx} - \mathop \sum \limits_{j =i}^{5 } E_{Qjx}$$ (1) $$E_{Ri,y} =E_{py} + \mathop \sum \limits_{j =1}^{i - 1} E_{Qjy} + \mathop \sum \limits_{j =i}^{5} E_{Qjy}$$ (2)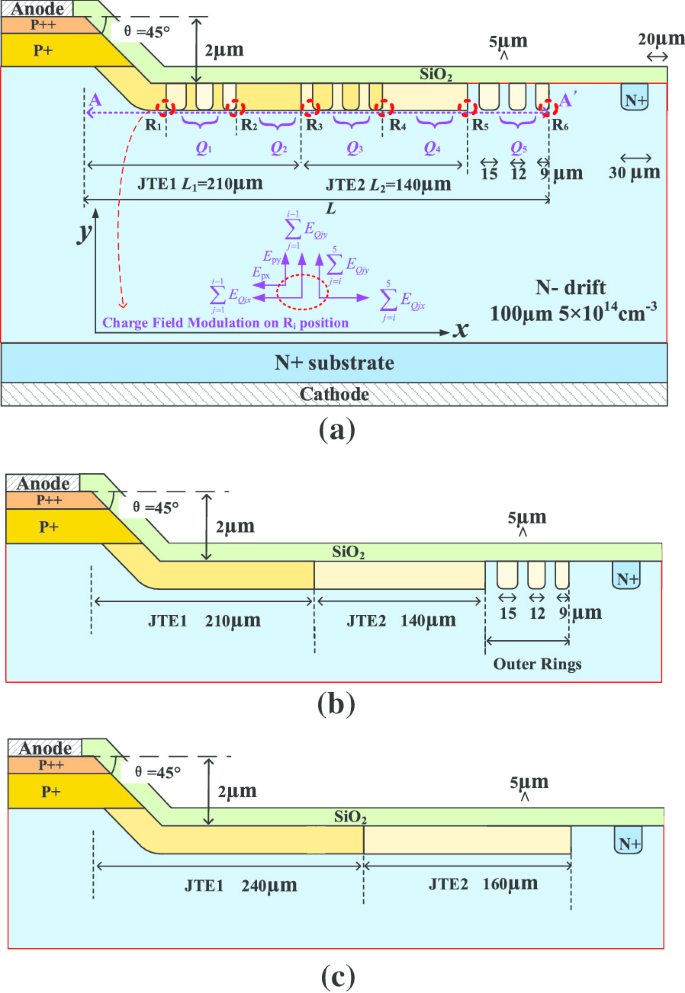
Coupe schématique du redresseur 4H-SiC PiN avec a CFM-JTE, b ORA-JTE, c TZ-JTE conventionnel
À l'état bloqué, la région d'appauvrissement faiblement dopée se contracte prématurément et avorte au niveau de la région de terminaison en raison de l'effet de courbure dans la jonction principale PiN. Ainsi, le champ potentiel appliqué E p (r ) est entièrement concentré à la périphérie de la jonction principale. L'existence de Q je favorise l'épuisement le long du CFM-JTE jusqu'à la couche épitaxiale la plus externe. La force du champ électrique de charge E Qi est associé à la quantité de Q je . La diminution de Q je le long du bord extérieur terminal réalise efficacement la modulation du champ électrique dans la région terminale. Par conséquent, grâce au mécanisme et à l'effet de la modulation du champ électrique de charge, le CFM-JTE surmonte le manque de faible coefficient de diffusion du SiC pour former l'effet de dopage latéral varié (VLD), qui est une technologie de protection de borne de jonction très efficace, robuste et mature. pour les appareils Si [12, 13]. La largeur de l'anneau (w r ) de chaque groupe est diminué à 15 μm, 12 μm et 9 μm, respectivement. L'espace de chaque anneau est égal à la même valeur de 5 μm. La longueur et la dose de la région JTE1 et de la région JTE2 sont toutes deux à un rapport fixe de 3:2. Les paramètres détaillés du redresseur proposé sont donnés dans le tableau 1.
Simulation et optimisation
Afin de diminuer les écarts causés par la sensibilité de la structure du dispositif et les concentrations de dopage, la configuration de traitement Athena est appliquée. Les concentrations de dopage du CFM-JTE sont formées à travers de multiples étapes de simulation du processus d'implantation d'aluminium. La profondeur totale du dopage atteint près de 1 μm.
La figure 2 montre les capacités de blocage et les tolérances à la dose d'implantation de CFM-JTE, ORA-JTE et TZ-JTE conventionnel. Les quatre structures de terminaison partagent une valeur de longueur fixe de L = 400 μm pour comparer leur efficacité. La longueur et la dose de JTE1 et JTE2 sont fixées au rapport de 3:2. La simulation est effectuée sur la structure 2D, et le critère de jugement de claquage est que le courant de fuite inverse atteint 1 × 10 –9 A. La ligne continue noire représente la BV théorique qui est calculé comme 14,1 kV selon [10, 14], et la ligne pointillée grise indique 12 kV. La marge de conception de 20 % est appliquée dans l'objectif pour 10 kV en tenant compte de la tolérance du processus et de l'écart de simulation. Dans le TZ-JTE classique, la tension de claquage est assez sensible à la dose d'implantation et n'atteint plus de 12 kV que lorsque la dose varie entre 0,98 et 1,14 × 10 13 cm −2 . La sensibilité de l'ORA-JTE à la concentration d'injection de JTE est atténuée et une fenêtre de tolérance plus large de 0,97 à 1,28 × 10 13 cm −2 est obtenu pour maintenir la tension cible au-dessus de 12 kV. Le CFM-JTE a la tolérance la plus large de la fenêtre de dose d'implantation dans une plage de 0,86 à 1,30 × 10 13 cm −2 , soit environ 2,8 fois celui du TZ-JTE conventionnel et 1,4 fois celui de l'ORA-JTE. Ainsi, le CFM-JTE montre une meilleure robustesse pour les variations de processus.
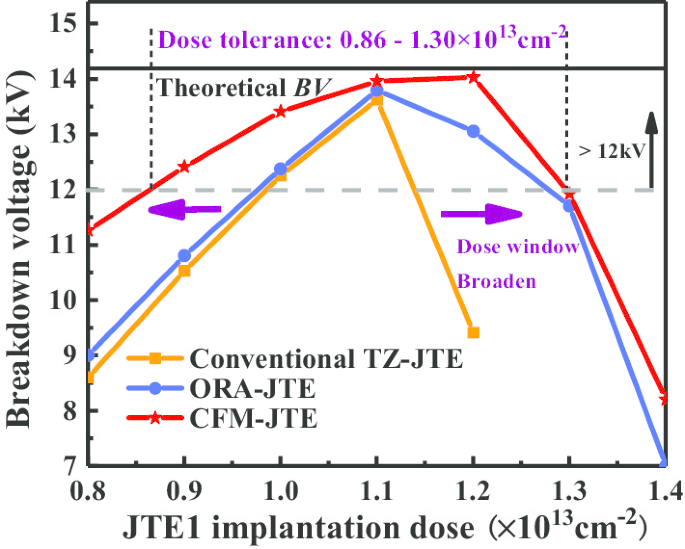
Comparaison des capacités de claquage à la fenêtre de dose JTE pour le redresseur 4H-SiC PiN avec CFM-JTE, ORA-JTE et TZ-JTE conventionnel
La figure 3 montre la comparaison de la distribution du champ électrique de surface et de l'intensité de CFM-JTE, ORA-JTE et TZ-JTE dans l'état de blocage. Le champ électrique de crête est principalement concentré dans la jonction principale et la périphérie terminale. Le CFM-JTE aplatit la distribution du champ électrique et favorise l'intensité du champ électrique le long de la borne, ce qui améliore efficacement la capacité de blocage.
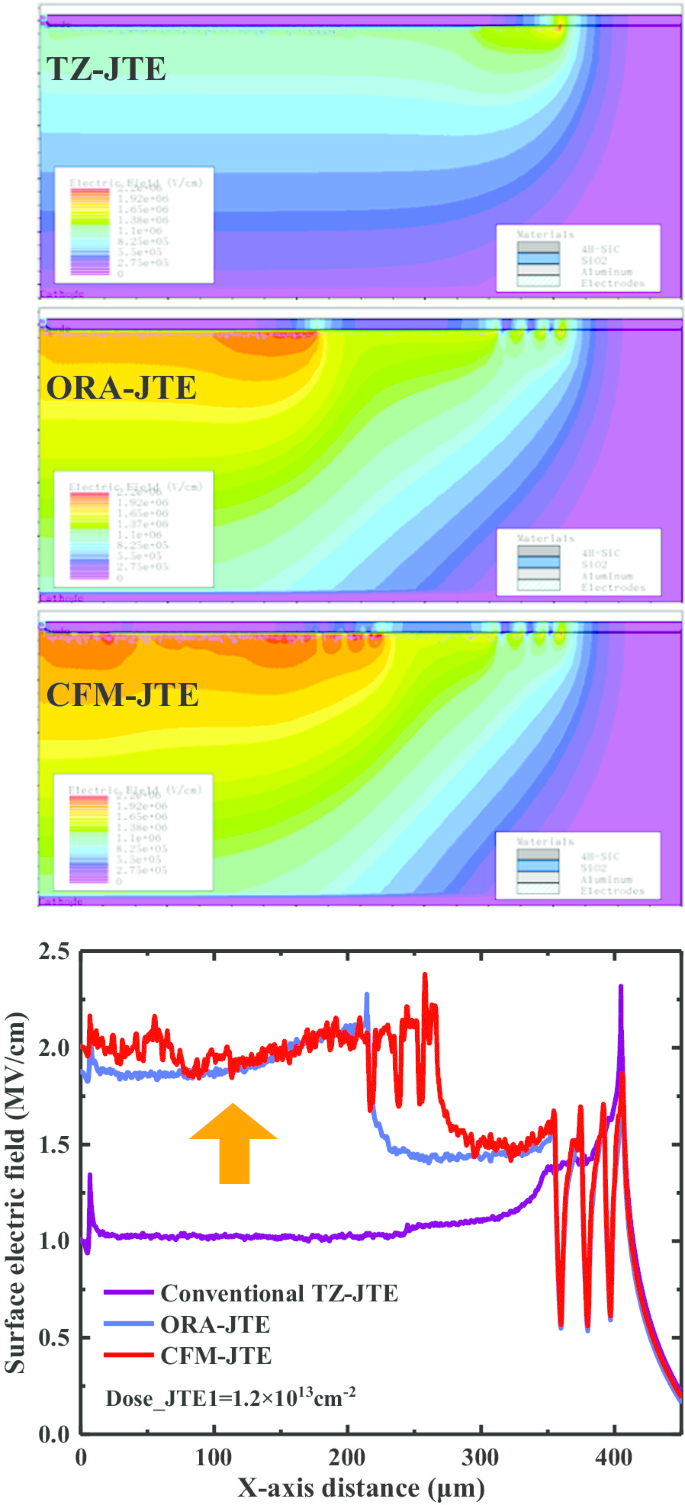
Inverser la distribution et l'intensité du champ électrique de surface en CFM-JTE, ORA-JTE et TZ-JTE conventionnel
Afin de comprendre le mécanisme du champ électrique de charge modulant CFM-JTE, les distributions du champ électrique de claquage sur la ligne de coupe AA' de la figure 1a avec différentes doses d'implantation de JTE1 sont tracées sur la figure 4. L'existence de Q je , en particulier le Q hautement dopé 1 zone à côté de la jonction principale, atténue énormément la concentration des lignes de champ électrique au coin de gravure mesa. Le Q 5 zone est définie pour atténuer l'encombrement du champ électrique à R5 point sur la figure 1a. Les résultats démontrent que l'uniformité de la distribution du champ électrique peut être efficacement améliorée grâce à la modulation du champ électrique de charge E Qi (r ) dans le terminal. Ainsi, la capacité de la tension de blocage et la fiabilité de l'appareil pourraient être améliorées.

Distributions de champ électrique de surface en claquage correspondant aux différentes doses d'implantation de JTE1
La taille de la zone terminale affecte directement l'efficacité de l'utilisation de la puce. Dans l'état de blocage, le champ de potentiel appliqué est groupé autour de la périphérie de la jonction principale. La région JTE1 près de la jonction principale doit introduire plus de charges pour améliorer l'effet de modulation du champ de charge (E q ). Ainsi, L 1 doit être défini plus longtemps que L 2 . Lorsque le rapport de L 1 à L 2 est fixé à 3 :2, les capacités de blocage des différentes longueurs L sur le terminal sont analysés de manière comparative dans la Fig. 5.

Capacités de blocage avec différentes longueurs de bornes
Les distributions de champ électrique correspondantes sont affichées sur la Fig. 6. La zone à grande échelle de CFM-JTE est propice à l'augmentation de la charge requise Q je et en faisant jouer pleinement l'effet de modulation de E Qi (r ), de manière à obtenir une fenêtre de tolérance de dose d'implantation (TW) plus importante. Lorsque la longueur CFM-JTE L est défini sur 300 μm, 350 μm, 400 μm et 450 μm, la plage TW augmente séquentiellement, correspondant à 3 × 10 12 cm −2 , 3,2 × 10 12 cm −2 , 4,4 × 10 12 cm −2 et 4,7 × 10 12 cm −2 dans la plage à condition que le BV soit supérieur à 12 kV. Il est plus approprié de sélectionner une longueur de borne L de 400 μm dans ce travail basé sur le compromis entre la taille du terminal, la fenêtre de tolérance de dose JTE, la modulation du champ électrique du terminal et la capacité de tension de claquage.
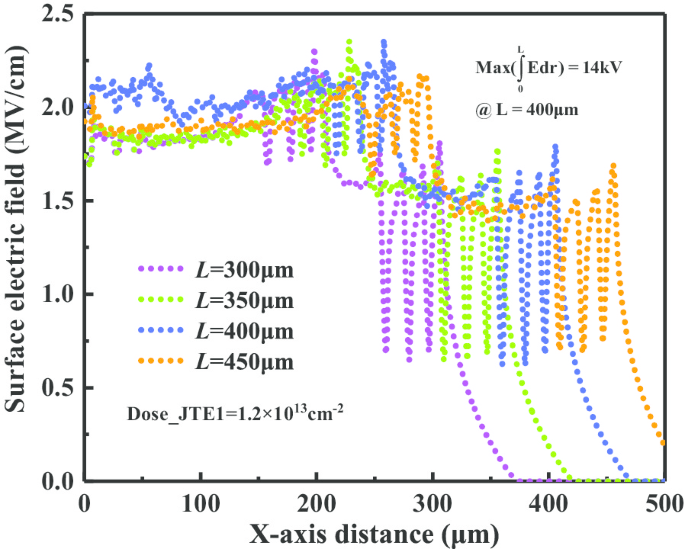
Distributions de champ électrique de surface en claquage correspondant à différentes longueurs de bornes
L'existence d'états de surface doit être considérée dans la fabrication même du redresseur 4H-SiC PiN. Ces états de surface sont dérivés de trous piégés dans des états d'interface profonds, de charges d'oxyde fixes de P-SiC (dont P ++ couche et région P-JTE)/SiO2 interface et le processus de mise en œuvre [15,16,17,18]. Pour la terminaison CFM-JTE, la modulation du champ électrique à l'interface S 1 et S 2 par les charges positives d'interface (Q il ), frais effectifs (Q j ) et le potentiel appliqué dans le sens de la verticale est analysé sur la figure 7.
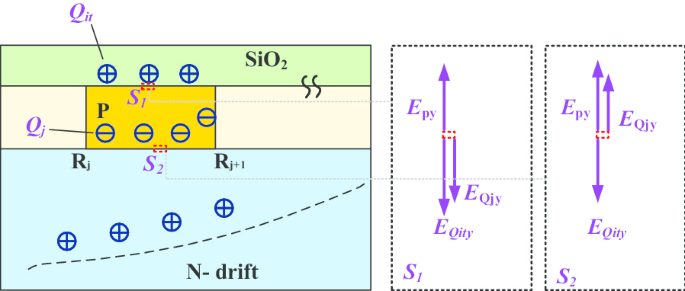
Modulation du champ électrique à S 1 et S 2 par les charges positives d'interface (Q il ), frais effectifs (Q j ) et potentiel appliqué
Frais d'interface positifs (Q il ) génèrent un champ de charge opposé (E Qualité ) par rapport au champ potentiel appliqué (E py ), aidant à atténuer l'intensité du champ électrique dans la direction de l'interface verticale. La figure 8 présente les distributions de champ électrique dans SiO2 /Interface SiC S 1 dans des conditions de Q différents il .

Distributions de champ électrique dans SiO2 Interface /SiC avec différents Q il
En termes d'analyse de modulation de champ de charge à l'interface S 2 , E Qualité est opposé à la direction du vecteur de E py et E Qjy . L'existence de Q il aide à réduire le champ électrique dans S 2. Compte tenu de l'existence de la redevance d'interface (Q il ), une plus grande charge effective d'ionisation Q j est nécessaire pour contrer l'intensité du champ électrique généré par le Q il . Par conséquent, lorsque la quantité de Q il augmente, la concentration de dose d'implantation optimale de JTE doit être simultanément augmentée pour maintenir la même capacité de blocage. Comme le montre la figure 9, la BV–Dose globale la courbe se déplace dans le sens de la hausse avec l'augmentation de Q il .

Comparaison des influences sur la capacité de blocage par les charges d'interface dans le redresseur 4H-SiC PiN
Résultats et discussion
Le redresseur CFM-JTE 4H-SiC PiN proposé a été fabriqué dans une plaquette de type N de 4 pouces avec 4° hors axe (0001). La plaquette est cultivée par épitaxie avec quatre couches (N + , N − , P + , P ++ ) correspondant à la concentration de 1 × 10 18 cm −3 , 5 × 10 14 cm −3 , 1 × 10 18 cm −3 et 5 × 10 19 cm −3 . Le flux de processus principal de la fabrication du CFM-JTE est illustré à la Fig. 10. Le P ++ couche est développée par épitaxie pour obtenir un dopage uniforme et élevé pour favoriser la qualité de contact ohmique entre le SiC et le métal de l'anode. La structure de gravure mésa est formée dans l'installation ICP-RIE à travers le masque de gravure mésa. Le gaz de gravure est principalement composé de SF6 et l'oxygène. De multiples implantations d'ions Al sont mises en œuvre à une énergie maximale de 500 keV pour former la structure CFM-JTE. Une implantation d'ions Al en deux étapes est appliquée pour former les cinq zones dopées décroissantes. JTE1 et R2 -R3 des zones sont formées à travers le premier masque d'implantation. JTE2, R1 -R2 , R3 -R4 , R4 -R5 et R5 -R6 des régions sont configurées simultanément par l'implantation d'ions Al à travers le second masque d'implantation. Comme tout le monde le sait, le taux d'activation des ions dans le carbure de silicium n'est pas élevé après l'implantation d'ions à haute énergie, accompagné de graves dommages au réseau. Afin d'améliorer la situation indésirable ci-dessus, les implantations d'ions aluminium sont réalisées à une température de 500 °C à travers un masque d'oxyde. Le recuit post-implantation a été effectué dans une atmosphère d'argon à une température de 1800 °C pendant 10 min avec un capuchon en carbone afin de rénover davantage les dommages causés par l'implantation d'ions à haute énergie et d'améliorer la précision de la concentration de dopage en augmentant l'ion efficace taux d'activation. Le contact ohmique SiC de type P est formé à l'aide d'Al/Ti. Le processus RTA est systématiquement effectué et inspecté pendant deux minutes dans un environnement d'azote gazeux inerte à une température de 1000 °C. Couches de passivation de haute qualité (SiO2 couche, Si3 N4 film et couche épaisse de polyimide) sont déposés pour éviter les fuites en surface et éviter les étincelles dans l'air [5]. Le redresseur CFM-JTE PiN couvre une surface active jusqu'à 0,1 cm 2 . Le processus de fabrication est cohérent avec le redresseur JTE 4H-SiC PiN conventionnel à deux zones, sans masques ni étapes de processus supplémentaires, ce qui est extrêmement propice à la réduction de la complexité et des coûts de fabrication.
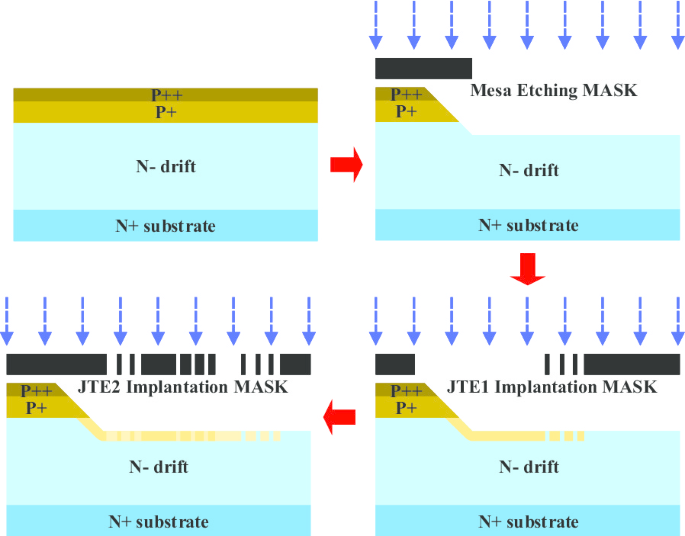
Flux de processus du CFM-JTE
Les caractéristiques directes du redresseur CFM-JTE PiN fabriqué sont testées sur la plaquette à l'aide de l'instrument CS-3200 Curve Tracer. Le redresseur CFM-JTE PiN fabriqué présente une grande capacité de conduction de courant direct sans technologie d'amélioration de la durée de vie du support. Le courant direct est mesuré jusqu'à 100 A correspondant à une tension directe de 5,2 V, comme illustré à la Fig. 11. La résistance différentielle à l'état passant du redresseur proposé est mesurée à 3,1 mΩ cm 2 à température ambiante, correspondant à la tension directe de 3,6 V. Les caractéristiques de conduction directe à différentes températures sont également illustrées dans l'encadré de la figure 11. Le I-V La courbe montre une particularité de coefficient de température négatif. En effet, à mesure que la température augmente, la mobilité du matériau diminue, tandis que la bande interdite plus étroite du matériau SiC réduit le potentiel auto-construit de la jonction P-N, et la durée de vie du porteur de la région de dérive s'étend avec l'augmentation de température, entraînant ainsi une augmentation de la densité de courant. La tension d'activation mesurée est définie à une densité de courant directe de 10 A·cm −2 . Elle passe progressivement de 3,14 à 3,04 V lorsque la température ambiante passe de 25 à 150 °C. Le décalage maximal de la tension d'activation directe a été bloqué dans une plage de 3 %, correspondant à une valeur de 0,1 V, ce qui présente une bien meilleure stabilité de température que Si PiN.
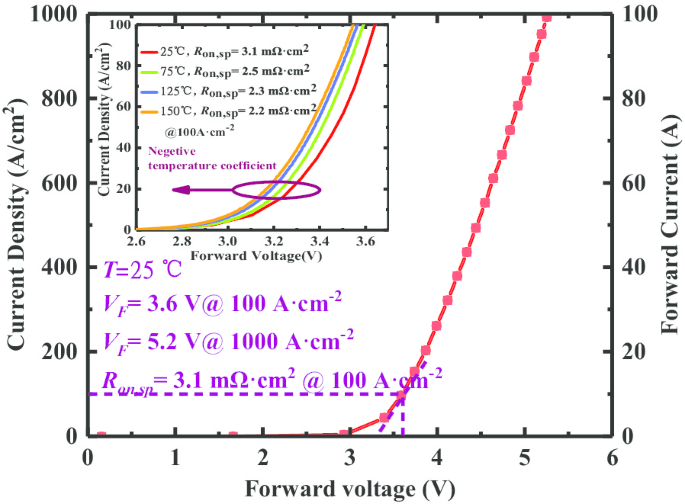
Transférer I–V courbe du redresseur CFM-JTE PiN et caractéristiques à divers environnements de température dans l'encart
Les redresseurs 4H-SiC PiN avec CFM-JTE, ORA-JTE ainsi que TZ-JTE conventionnel sont fabriqués sur la plaquette de 4 pouces, et leurs effets de protection des bornes sont illustrés à la Fig. 12. Des mesures de tension de claquage inverse sont exécutées et immergées dans de l'huile Fluorinert pour éviter la formation d'arc dans l'air. Dans des mesures expérimentales avec une dose de JTE1 de 1,2 × 10 13 cm −2 , les redresseurs PiN avec ORA-JTE et le TZ-JTE conventionnel obtiennent les capacités de blocage de 12,5 kV et 9,6 kV, respectivement, avec la même longueur de borne de 400 μm.
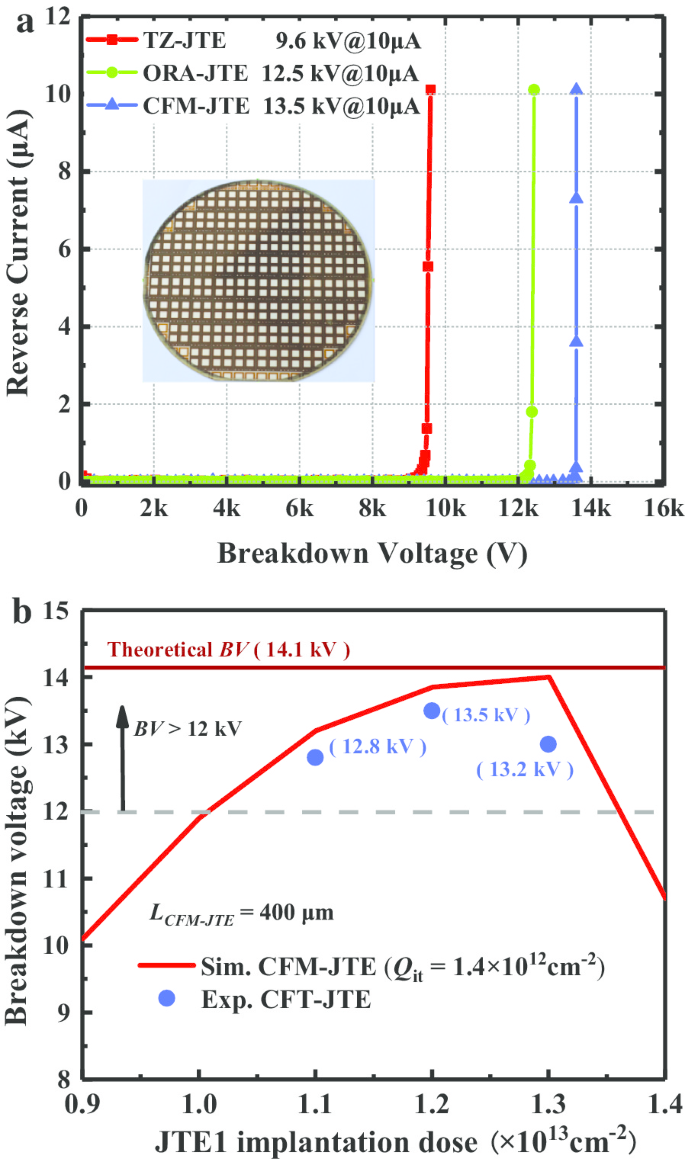
Caractéristiques de panne du redresseur 4H-SiC PiN fabriqué. un BV mesuré des CFM-JTE, ORA-JTE et TZ-JTE. b BV mesurée du CFM-JTE avec différentes doses d'implantation. Les points pleins sont les valeurs expérimentales
Des échantillons multi-lots de redresseurs CFM-JTE PiN ont pu obtenir à plusieurs reprises la tension de claquage de 13,5 kV au courant de fuite de 10 μA. La tension de blocage expérimentale atteint jusqu'à 96% de la valeur de claquage théorique, ce qui indique que le CFM-JTE a une efficacité de protection terminale plus élevée. Une tension de tenue de plus de 130 V/μm a été obtenue dans la couche de dérive de 100 μm du redresseur 4H-SiC PiN. La figure du mérite de Baliga (BFOM = BV 2 /R sur,sp ) atteint 58,8 GW/cm 2 à température ambiante. Les PiN CFM-JTE avec différentes doses d'implantation de JTE1 ont été fabriqués. Les valeurs expérimentales et simulées de la tension de claquage sont illustrées à la Fig. 12b. Les valeurs expérimentales sont conformes à la tendance de la simulation et confirment que la structure CFM-JTE peut étendre efficacement la fenêtre de tolérance de dose JTE. Le tableau 2 compare les caractéristiques des redresseurs ultra-haute tension 4H-SiC récemment signalés. Le redresseur CFM-JTE 4H-SiC fabriqué dans ce travail montre d'excellentes performances en termes de capacité de blocage ultra-haute tension, de capacité de conduction de courant direct ultra-élevée et d'efficacité de terminaison élevée.
Conclusions
Dans ce travail, le redresseur 4H-SiC CFM-JTE PiN a été conçu et fabriqué avec succès. La tension de claquage expérimentale du CFM-JTE PiN est de 13,5 kV correspondant à 96 % de la valeur de blocage théorique. Le CFM-JTE présente une efficacité de protection terminale bien améliorée par rapport à l'ORA-JTE (BV = 12,5 kV, avec une efficacité de protection jusqu'à 88 %) et le TZ-JTE conventionnel (BV = 9,6 kV, avec une efficacité de protection jusqu'à 68 % ). Le redresseur CFM-JTE PiN acquiert un courant direct important de 100 A @ V F =5,2 V sans utiliser la technologie d'amélioration de la durée de vie de l'opérateur et présente un I–V vers l'avant stable caractéristiques à différentes températures. Le facteur de mérite de Baliga pour le redresseur CFM-JTE PiN atteint 58,8 GW/cm 2 à température ambiante. La tolérance de la fenêtre de dose d'implantation pour le CFM-JTE est élargie sur la base de la modulation du champ électrique de charge, qui est environ 2,8 fois celle du TZ-JTE conventionnel et 1,4 fois celle de l'ORA-JTE, montrant une bien meilleure robustesse aux variations de traitement. De plus, le processus de fabrication du CFM-JTE est cohérent avec le processus conventionnel TZ JTE sans augmenter le nombre de processus ou de masques exceptionnellement complexes, ce qui démontre que le CFM-JTE est optimal pour les applications à ultra-haute puissance avec une efficacité terminale satisfaisante et tolérance de processus.
Disponibilité des données et des matériaux
Toutes les données sont disponibles sans restrictions.
Abréviations
- SiC :
-
Carbure de silicium
- JTE :
-
Extension de terminaison de jonction
- CFM :
-
Champ de charge modulé
- TZ-JTE :
-
Extension de terminaison de jonction à deux zones
- FLR :
-
Bague de limitation de champ
- MZ-JTE :
-
Extension de terminaison de jonction multizone
- CD-JTE :
-
Extension de terminaison de jonction dopée
- Ti :
-
Titane
- Al :
-
Aluminium
- E c :
-
Bande de conduction énergétique
- V F :
-
Tension directe
- ORA-JTE :
-
Extension de terminaison de jonction assistée par anneau extérieur
- E q :
-
Champ électrique de charge
- E p :
-
Champ potentiel appliqué
- Q je :
-
Charge effective
- VLD :
-
Dopage latéral varié
- w r :
-
Largeur de bague
- 2D :
-
Deux dimensions
- BV :
-
Tension de claquage
- TW :
-
Fenêtre de tolérance
- Q il :
-
Frais d'interface
- Q j :
-
Charge efficace d'ionisation
- RTA :
-
Recuit thermique rapide
- R sur,sp :
-
Sur-résistance spécifique
- BFOM :
-
La figure de mérite de Baliga
Nanomatériaux
- Considérations relatives à la conception de la protection, du contrôle et de la détection des circuits pour les applications de sécurité domestique intelligente
- Fabrication et caractérisation d'un nouveau support de catalyseur anodique en nanofibre de carbone composite Tio2 pour pile à combustible au méthanol direct via la méthode d'électrofilage
- Fabrication, caractérisation et activité biologique de systèmes de nano-administration d'avermectine avec différentes tailles de particules
- Fabrication, caractérisation et cytotoxicité de nanoparticules de carbonate de calcium dérivées de coquilles d'or conjuguées de forme sphérique pour des applications biomédicales
- La fabrication et les performances d'absorption des ondes électromagnétiques à haute efficacité des nanocomposites structurés CoFe/C Core-Shell
- Fabrication et caractérisation de nano-clips de ZnO par le procédé à médiation par polyol
- Synthèse et caractérisation de zéolites ZSM-5 hiérarchiques avec une mésoporosité exceptionnelle et d'excellentes propriétés catalytiques
- Un nouvel appareil module la lumière visible avec la plus petite empreinte et la plus faible consommation d'énergie
- L'approche de la sécurité des gaz et des flammes pour l'industrie de la production d'énergie



