Un nouveau canal TFET SiGe en forme d'aileron sans dopage avec des performances améliorées
Résumé
Dans cet article, un TFET à canal SiGe en forme d'ailette sans dopage (DF-TFET) est proposé et étudié. Pour former une jonction tunnel de ligne sans dopage à haute efficacité, un canal SiGe en forme d'ailette et un chevauchement grille/source sont induits. Grâce à ces méthodes, le DF-TFET avec un courant à l'état passant élevé, un rapport de commutation de 12 ordres de grandeur et aucun effet ambipolaire évident ne peut être obtenu. Élevé κ Le diélectrique de grille d'empilement de matériaux est induit pour améliorer la fuite à l'état bloqué, les caractéristiques d'interface et la fiabilité du DF-TFET. De plus, en utilisant la structure de canal et d'ailette sans dopage, les difficultés du processus de dopage et de la formation de chevauchement de grille asymétrique peuvent être résolues. En conséquence, la structure du DF-TFET peut posséder une bonne applicabilité de fabrication et réduire considérablement l'empreinte. Le mécanisme physique du dispositif et l'effet des paramètres sur les performances sont étudiés dans ce travail. Enfin, le courant à l'état passant (I ON ) de 58,8 μA/μm, oscillation sous-seuil minimale de 2,8 mV/dec (SSmin ), oscillation moyenne sous le seuil (SSavg ) de 18,2 mV/déc peut être obtenu. Avec des caractéristiques de capacité améliorées, une fréquence de coupure de 5,04 GHz et un produit de bande passante de gain de 1,29 GHz peuvent être obtenus. Avec des performances et une robustesse améliorées, le DF-TFET peut être un candidat très attractif pour les applications ultra basse consommation.
Introduction
Avec la réduction d'échelle des MOSFET, la vitesse de commutation, les performances à haute fréquence, la densité, le coût et la fonctionnalité des circuits intégrés (CI) sont en grande partie améliorés[1]. Mais avec la progression continue de la réduction de la tension, la consommation élevée inacceptable devient un problème sérieux pour les circuits intégrés modernes [1, 2]. Bénéficiant du mécanisme de tunneling bande à bande, le tunnel FET (TFET) avec un SS raide et une faible consommation d'énergie apporte une nouvelle solution à ce problème et a attiré beaucoup d'attention [3,4,5,6,7,8,9 ]. Mais les applications des TFET conventionnels à base de silicium sont limitées par le courant à l'état passant considérablement faible (I ON ), un faible rapport de commutation, un effet ambipolaire sévère et une grande oscillation moyenne sous le seuil (SS) [1, 7]. Pour améliorer les performances des TFET, des applications de nouvelles structures et de nouveaux matériaux sur les TFET ont été proposées ces dernières années. Par exemple, des TFET avec couche améliorée à taux de tunnel sont proposés ces dernières années [5, 10, 11]. Avec cette couche, la longueur effective du chemin de tunnel est réduite et se traduit par une amélioration évidente du taux de tunnel. De plus, les TFET avec une structure de grille améliorée sont étudiés par de nombreux groupes de recherche [12,13,14,15,16,17,18,19,20]. Le concept de tunneling de ligne est introduit dans L-TFET [17,18,19]. En conséquence, SSavg de 42,8 mV/décade et I ON de 10 −6 A/μm peut être obtenu par L-TFET. Pour améliorer encore les performances des TFET, un TG-TFET amélioré avec un chevauchement en forme de T et une double source est rapporté [20, 21]. En conséquence, le I ON de TG-TFET atteint 81 μA/μm. Pour améliorer encore les performances du dispositif, une exigence élevée sur le profil de dopage de la jonction tunnel est requise. Les ingénieurs de fonderie doivent créer une jonction abrupte ultra-pentue qui n'a que quelques nanomètres d'épaisseur, ce qui est très difficile à réaliser. Afin d'éviter cette difficulté, le TFET sans dopage (DL-TFET) sur un film semi-conducteur intrinsèque mince utilisant le concept de plasma de charge est décrit par des groupes de recherche [22, 23]. En DL-TFET, la difficulté de fabrication peut être considérablement réduite en supprimant la jonction abrupte ultra-pentue. La dégradation des performances induite par les fluctuations aléatoires du dopant peut être évitée. De plus, la fabrication du DL-TFET ne demande pas de budgets thermiques élevés pour créer la source et le drain, ce qui ouvre la possibilité de réaliser des TFET sur d'autres substrats comme le silicium monocristallin sur verre. En conséquence, le SS du DL-TFET a été considérablement amélioré. Cependant, en raison de la faible efficacité de la jonction tunnel ponctuelle, le courant du DL-TFET n'est pas assez élevé, ce qui est difficile pour répondre aux exigences toujours croissantes des applications de circuits modernes.
Dans cet article, un nouveau TFET à canal SiGe en forme d'ailette sans dopage (DF-TFET) est proposé et étudié. Pour améliorer les performances et la robustesse du dispositif, une jonction tunnel de ligne et un matériau SiGe sont appliqués au DF-TFET. Pendant ce temps, la fonction de travail du métal de la grille est optimisée pour améliorer encore le taux de tunnellisation. De plus, le canal sans dopage a réduit la difficulté du processus de fabrication tandis que la structure à ailettes rend applicable la fabrication asymétrique de grille/porte arrière. Par conséquent, le courant à l'état passant (I ON ) de 58,8μA/μm, courant de fuite à l'état bloqué (I OFF ) près de 10 −11 μA/μm, oscillation moyenne sous le seuil (SSavg ) de 18,2 mV/déc et une oscillation sous-seuil minimale (SSmin ) de 2,8 mV/déc peut être atteint par DF-TFET. Avec une capacité de grille relativement faible (C gg ) et la capacité de grille à drain (C gd ), de bonnes performances analogiques/RF peuvent être obtenues. Enfin, la fréquence de coupure (f T ) a atteint 5,04 GHz et le produit de gain de bande passante (GBW) a atteint 1,29 GHz.
Les structures de cet article sont les suivantes :La section « Structure du dispositif et méthode de simulation » montre les méthodes de simulation TCAD de ce travail. La structure et le paramètre de DF-TFET sont introduits. Les différences et les avantages du DF-TFET par rapport au DL-TFET et au TG-TFET sont illustrés. Le mécanisme, les caractéristiques et les performances analogiques/RF du DF-TFET sont discutés dans la section « Résultats et discussion ». Une comparaison des performances entre DF-TFET, DL-TFET et TG-TFET est effectuée dans cette section. De plus, l'influence des paramètres de l'appareil sur les performances et les paramètres RF typiques du DF-TFET est étudiée dans cette section. Afin de mieux comprendre le potentiel des DF-TFET dans les applications à très faible consommation, des comparaisons des caractéristiques électriques entre différents TFET et DF-TFET sous polarisation basse tension ont été effectuées.
Structure de l'appareil et méthode de simulation
La structure proposée du DF-TFET est illustrée à la Fig. 1a. Pour améliorer les performances du dispositif, une jonction tunnel de ligne est appliquée au canal SiGe en forme d'ailette sans dopage par le concept de plasma de charge [24, 25]. Il est connu que l'épaisseur du diélectrique de grille peut affecter de manière significative le courant tunnel. En effet, dans le résultat de l'approximation WKB [26], comme le montre l'Eq. (1), la probabilité d'effet tunnel dépend de la longueur effective du blindage (λ ), masse porteuse effective (m * ), bande interdite énergétique (E g ) et fenêtre d'énergie de criblage efficace (ΔΦ ).
$$T_{{{\text{WKB}}}} \approx \exp \left( { - \frac{{4\lambda \sqrt {2m^{ * } } \sqrt {E_{{\text{g} }}^{3} } }}{{3q\hbar (E_{{\text{g}}} + \Delta \Phi )}}} \right)$$ (1)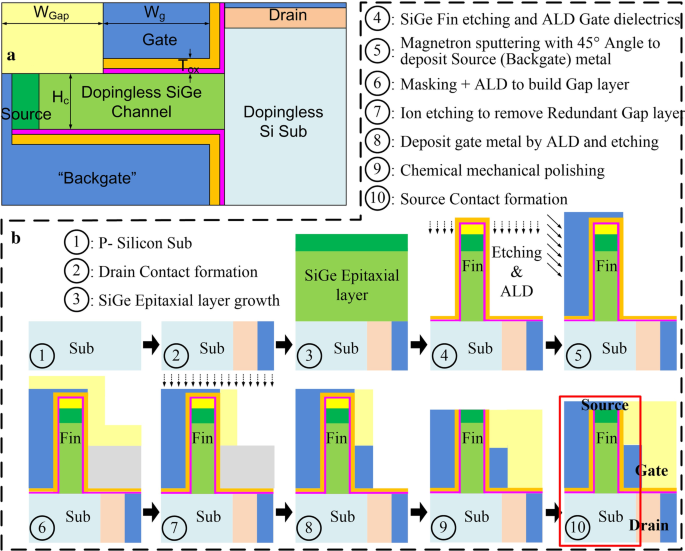
un Structure et b flux de fabrication de DF-TFET
Réduire l'épaisseur du diélectrique de grille ou utiliser un κ élevé diélectrique réduira λ et augmentez ΔΦ , ce qui entraînera une augmentation exponentielle de la probabilité de tunneling. Ainsi, en utilisant un κ élevé diélectriques et la réduction de l'épaisseur diélectrique peuvent augmenter considérablement le courant à l'état passant du TFET. Mais la faible épaisseur diélectrique et les problèmes de qualité d'interface de haute κ diélectriques causera de sérieux problèmes de fiabilité. Ainsi, un diélectrique de grille d'empilement de 0,5 nm d'Al2 O3 et 2,0 nm de HfO2 est réglé pour garantir une bonne qualité d'interface [27,28,29], ce qui peut réduire considérablement le courant de fuite et améliorer la fiabilité du diélectrique de grille. L'électrode source est située sur le dessus de la structure à ailettes. En même temps, il se trouve également à côté d'un côté de l'aileron et fonctionne comme une « porte arrière » pour appliquer un biais nul. En utilisant une électrode de grille et de source avec différentes fonctions de travail du métal, une jonction tunnel de ligne peut être formée dans le canal SiGe en forme d'ailette sans dopage par le concept de plasma de charge. La direction de tunnelage bande à bande (BTBT) est perpendiculaire à la surface canal/grille. Cela peut aider à augmenter I ON en améliorant la zone de jonction efficace du tunnel.
Rapport de commutation élevé (I ON /Je OFF ) peut être obtenu en raison du grand courant à l'état passant (I ON ) et un petit courant à l'état bloqué (I OFF ) fourni par la jonction tunnel de ligne. De plus, l'application d'une structure à ailettes dans le DF-TFET peut réduire considérablement l'empreinte par rapport au TFET à effet tunnel de la ligne de rabotage [30, 31]. La figure 1b montre un flux de fabrication disponible pour former la structure du DF-TFET. Le tableau 1 montre les principaux paramètres de processus du DF-TFET. Enfin, sans la difficulté de faire une jonction p–n abrupte et uniforme, de bonnes performances et une bonne robustesse de l'appareil peuvent être obtenues.
Pour mieux comprendre les différences et les avantages du DF-TFET, du DL-TFET et du TG-TFET, la figure 2 montre la structure de ces trois dispositifs. Avec la jonction tunnel de ligne, le L-TFET et le TG-TFET devraient obtenir un courant à l'état passant élevé. Mais les résultats expérimentaux montrent que les performances réelles du L-TFET ne sont pas aussi élevées que prévu [18, 19]. L'une des raisons les plus importantes est la difficulté à former une jonction p–n abrupte et uniforme avec des caractéristiques d'interface parfaites. Basé sur la structure de L-TFET, TG-TFET fait une grande amélioration sur I ON . Mais TG-TFET est toujours confronté à la difficulté de former une jonction p–n abrupte parfaite. Ainsi, pour obtenir les bonnes performances souhaitables, une jonction p–n abrupte et uniforme qui n'a que quelques nanomètres d'épaisseur doit être obtenue, mais elle est très difficile à réaliser dans le processus de fabrication. En utilisant un canal sans dopage, le DL-TFET peut éviter ce problème et apporter une meilleure qualité d'interface près de la jonction tunnel. Cependant, par rapport aux TFET à effet tunnel [16,17,18,19,20,21] avec des jonctions p–n abruptes, le résultat de la simulation montre que le I ON de DL-TFET est relativement faible [22, 23]. Pour une amélioration supplémentaire, le DF-TFET est proposé et étudié dans ce travail.
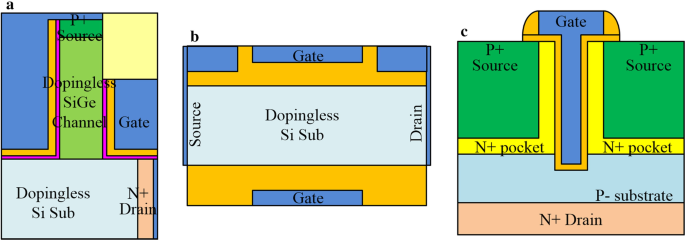
Structure de a DF-TFET, b DL-TFET, c TG-TFET
La simulation du DF-TFET est réalisée dans les outils Silvaco Atlas TCAD. Un modèle BTBT non local est introduit dans cette simulation pour prendre en compte la variation spatiale de la bande d'énergie, ce qui peut aider à améliorer la précision du processus de tunnellisation BTBT. Le modèle de mobilité Lombardi est considéré pour rendre la mobilité du canal précise. Le modèle de rétrécissement de la bande interdite est pris en compte pour s'adapter aux régions de contact ohmiques fortement dopées, et le modèle de recombinaison Shockley-Read-Hall est également pris en compte dans cet article.
Résultats et discussion
Mécanisme et comparaison de DF-TFET, DL-TFET et TG-TFET
La figure 3a montre la comparaison des caractéristiques de transfert de DF-TFET, DL-TFET et TG-TFET. Bénéficiant de la jonction tunnel de ligne dans le canal SiGe en forme d'ailette, le DF-TFET atteint un courant à l'état passant (I ON ) de 58,8 μA/μm et atteint un rapport de commutation élevé de plus de 12 ordres de grandeur où aucun effet ambipolaire évident ne se produit. De plus, l'oscillation minimale sous le seuil (SSmin ) de 2,8 mV/déc et une oscillation sous-seuil moyenne (SSavg ) de 18,2 mV/déc sont obtenus. En conséquence, DF-TFET a une amélioration évidente de I ON par rapport au DL-TFET et oscillation sous le seuil par rapport au TG-TFET. Je ON de DF-TFET est plus d'un ordre de grandeur plus grand que DL-TFET à V DS = V GS = 1 V. La figure 3b montre l'état de la bande d'énergie du DF-TFET et illustre la formation de la fenêtre tunnel dans le canal en forme d'ailette. La ligne pointillée rouge dans l'encart de la Fig. 3b montre la position où la courbe de bande d'énergie est obtenue.
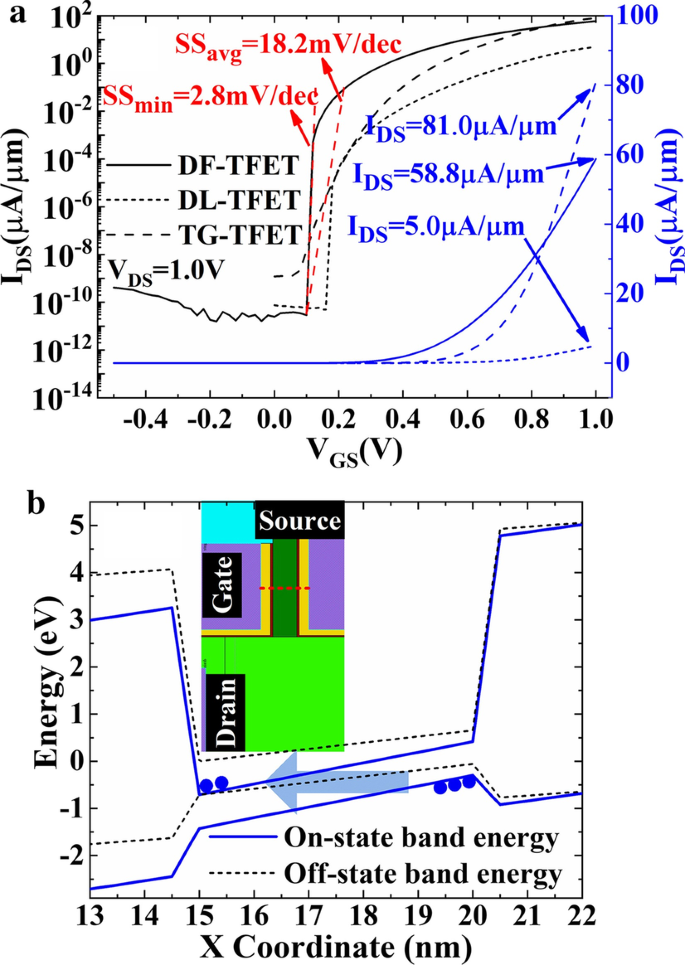
un Caractéristiques de transfert de DF-TFET, DL-TFET et TG-TFET. b Condition de bande d'énergie du DF-TFET dans différentes conditions de travail (l'encart montre la position de la ligne de coupe)
La distribution d'une quantité physique importante dans le processus d'effet tunnel du DF-TFET est illustrée à la Fig. 4, qui comprend la distribution de (a) potentiel, (b) e taux d'effet tunnel, (c) densité de courant totale et (d) taux de recombinaison dans un condition de travail sur l'état. Sur la figure 4a, un gradient de potentiel clair perpendiculaire à l'interface grille/canal peut être observé. Ainsi, une énorme différence de potentiel est générée dans le canal en forme d'ailette et cela modulera la concentration d'électrons et de trous des deux côtés du canal d'ailette. En même temps, une forte flexion de bande d'énergie peut être formée dans le canal en forme d'ailette. En conséquence, une jonction tunnel de ligne parallèle à l'interface grille/canal peut être formée. La figure 4b montre le taux de tunnellisation électronique dans le canal de la structure des ailettes. La valeur maximale du taux de tunnel électronique est uniformément répartie près de l'interface porte/canal et parallèlement à la surface. Cela prouve que la jonction tunnel de ligne est parallèle à l'interface porte/canal. La figure 4c montre le chemin actuel dans DF-TFET. Les électrons de la bande de valence du côté grille/canal sont tunnelés vers la bande de conduction près du côté grille/canal. Sous l'influence de la tension de grille et de la tension de drain, les électrons se déplacent le long du canal à ailettes jusqu'à l'électrode de drain. De cette manière, un chemin de courant tunnel est formé dans le DF-TFET. La figure 4d montre la distribution du taux de recombinaison dans le DF-TFET ; cela peut illustrer plus clairement l'emplacement de la jonction tunnel. La bande violette dans le canal d'ailette SiGe peut représenter l'emplacement de la jonction tunnel.
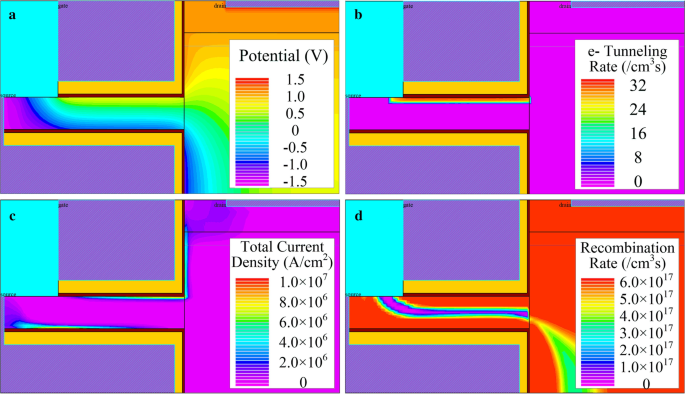
Répartition de a potentiel, b e taux de tunnel, c densité de courant et d taux de recombinaison du DF-TFET
Caractéristiques CC avec différents paramètres et performances analogiques/RF
La figure 5a, b montre les caractéristiques d'entrée et de sortie du DF-TFET sous différents biais. L'augmentation de V DS a peu d'effet sur les caractéristiques d'oscillation sous le seuil, mais I ON aura une croissance linéaire tandis que V DS augmente de 0,2 à 1,2 V (à V GS = 1,0 V). La figure 5c montre la fréquence de coupure (f T ) et gain produit de bande passante (GBW) calculé par les équations. (2) et (3). Le résultat montre qu'une fréquence de coupure de 5,04 GHz et un produit de gain de bande passante de 1,29 GHz peuvent être obtenus.
$$f_{{\text{T}}} =\frac{{g_{{\text{m}}} }}{{2\pi C_{{{\text{gs}}}} \sqrt {1 + 2C_{{{\text{gd}}}} /C_{{{\text{gs}}}} } }} \approx \frac{{g_{{\text{m}}} }}{{2 \pi \left( {C_{{{\text{gs}}}} + C_{{{\text{gd}}}} } \right)}} =\frac{{g_{{\text{m} }} }}{{2\pi C_{{{\text{gg}}}} }}$$ (2) $${\text{GBW}} =g_{{\text{m}}} /2 \pi 10C_{{{\text{gd}}}}$$ (3)
un Saisie, b sortie et c caractéristiques radiofréquence du DF-TFET
La figure 6a montre l'effet de la fonction de travail de la porte (φ Porte ) et fonction de vidange (φ Vidange ) sur les caractéristiques de transfert du DF-TFET. Avec l'augmentation du travail de sortie, la courbe caractéristique de transfert se déplace vers la direction positive. Comme la fonction de travail varie de 3,7 à 4,2 eV, le V ème augmente linéairement de 0 à 0,5 V tandis que le I ON diminue linéairement de 93,4 à 18,6 μA/μm. Cela permet d'ajuster V ème à appliquer à différentes exigences d'application. La figure 6b montre l'effet du rapport de composition X de Si1−X GeX . L'augmentation de la composition du germanium conduit à la diminution de la bande interdite énergétique et à l'augmentation de la fenêtre tunnel, comme le montre l'encart de la figure 6b. Enfin, les résultats dans le I ON la courbe caractéristique d'augmentation et de transfert se traduit dans le sens négatif. Cependant, lorsque X> 0,7, à la fois la courbe caractéristique de transfert et le I ON ont peu de changement avec l'augmentation de X . C'est parce que la structure de la bande d'énergie du canal devient insensible à X quand X> 0,7, comme le montre l'encadré de la Fig. 6b. La figure 6c, d montre l'effet de la longueur de la porte (W g ) et l'épaisseur du canal (H c ) sur les caractéristiques de transfert. L'encart de la figure 6c montre les dimensions du canal de l'appareil sous différents W g . Il n'est pas difficile d'observer à partir de la Fig. 6d que le DF-TFET subira I ON diminuer lorsque H c devient à la fois trop petit et trop grand. Ainsi, un bon H c profitera aux performances de l'appareil.

Caractéristiques de transfert avec différents a fonction de travail du portail (φ Porte ) et fonction de vidange (φ Vidange ), b Rapport de composition SiGe, c longueur du portail (W g ) et d épaisseur du canal (H c )
Afin de comprendre le potentiel du DF-TFET dans les applications à très faible consommation, le tableau 2 présente une comparaison des performances de différents TFET avec le DF-TFET. Comparé aux TFET avec une jonction tunnel p–n traditionnelle fortement dopée [6, 20, 32, 33, 34, 35], le DF-TFET présente des avantages évidents sur le SS et le rapport de commutation. Cela est dû aux caractéristiques du DF-TFET en utilisant le dopage électrostatique. Comparé aux autres TFET sans dopage [22, 23, 36, 37], le DF-TFET présente des avantages évidents sur ION . Cela est dû au taux d'effet tunnel amélioré grâce à l'utilisation d'une jonction à effet tunnel de ligne et d'un matériau SiGe. En combinant les avantages de la jonction tunnel p–n et de la jonction tunnel sans dopage, le DF-TFET peut fournir un courant de fonctionnement élevé et une faible consommation d'énergie statique dans les applications à très faible consommation.
Conclusion
Dans ce travail, un nouveau DF-TFET est proposé et les caractéristiques électriques sont analysées par une méthode de simulation. Les caractéristiques de la structure, le mécanisme physique, les performances avec différents paramètres et les performances analogiques/RF du DF-TFET sont discutés et étudiés. Bénéficiez du canal de structure à ailettes sans dopage, du diélectrique de grille d'empilement, du matériau de canal SiGe et de la jonction tunnel à haute efficacité, de bonnes performances dans les caractéristiques de commutation et les caractéristiques analogiques/RF peuvent être obtenues. De plus, en évitant la formation de la jonction p-n abrupte dans le processus de fabrication, un dopage uniforme avec une consistance élevée et une robustesse élevée aux fluctuations du processus peut être obtenu. Le résultat de la simulation montre que, I ON de 58,8 μA/μm, rapport de commutation de 12 ordres de grandeur, pas d'effet ambipolaire évident, SSmin de 2,8 mV/déc et f T de 5,04 GHz peut être atteint par DF-TFET. Avec un courant de fonctionnement élevé, un rapport de commutation élevé, une SS raide, une bonne fiabilité, un processus de fabrication stable et une bonne aptitude à la fabrication, on peut s'attendre à ce qu'il soit l'un des candidats prometteurs pour les futures applications de circuits intégrés basse consommation et de capteurs sensibles.
Disponibilité des données et des matériaux
Non applicable (Ce manuscrit est une étude purement théorique sur les performances analogiques/RF du TFET. Les données de simulation ont été données dans ce manuscrit, et elles ne doivent pas être décrites ici).
Abréviations
- DF-TFET :
-
Canal SiGe en forme d'ailette sans dopage TFET
- IC :
-
Circuits intégrés
- TGTFET :
-
TFET double source à grille en forme de T
- DL-TFET :
-
TFET sans dopage
- Je ON :
-
Courant à l'état activé
- Je OFF :
-
Courant à l'arrêt
- SSmin :
-
Balançoire sous-seuil minimale
- SSavg :
-
Swing moyen sous le seuil
- C gg :
-
Capacité de grille
- C gd :
-
Portail pour drainer la capacité
- f T :
-
Fréquence de coupure
- GBW :
-
Gain de bande passante produit
- λ :
-
Longueur de criblage effective
- m * :
-
Masse porteuse effective
- E g :
-
Bande interdite énergétique
- ΔΦ :
-
Fenêtre énergétique de criblage efficace
- W g :
-
Longueur du portail
- W Écart :
-
Longueur de l'écart
- T bœuf :
-
Épaisseur d'oxyde de grille d'empilement
- H c :
-
Épaisseur du canal
- φ Porte /φ Vidange :
-
Fonction de travail de porte et de drain
- V DS :
-
Drain à la tension source
- V GS :
-
Tension grille à source
Nanomatériaux
- Une nouvelle approche améliore la stabilité du PUF
- Améliorez les performances avec le soudage automatisé
- Blog :Appareils médicaux à haute performance
- Un nouveau photocatalyseur à hétérojonction Bi4Ti3O12/Ag3PO4 avec des performances photocatalytiques améliorées
- Performances améliorées d'un nouveau catalyseur anodique PdAu/VGCNF pour l'électro-oxydation dans une pile à combustible au glycérol
- Mécanisme de conduction et endurance améliorée dans la RRAM à base de HfO2 avec traitement de nitruration
- Fabrication d'hétérostructures Hiérarchiques ZnO@NiO Core–Shell pour de meilleures performances photocatalytiques
- Lasers à nanofils plasmon à canal avec cavités à rainure en V
- 6 façons d'améliorer Protocase Designer avec la version 4.6



