Influence du dopage sur les nanofils sans catalyseur VS InAs
Résumé
Nous rapportons la croissance de nanofils d'InAs sans catalyseur dopé au Te par épitaxie par faisceau moléculaire sur des substrats de silicium (111). Des changements dans la morphologie du fil, c'est-à-dire une diminution de la longueur et une augmentation du diamètre, ont été observés avec l'augmentation du niveau de dopage. L'analyse de la structure cristalline basée sur la microscopie électronique à transmission ainsi que la diffraction des rayons X révèle une amélioration du rapport segment zinc blende/(wurtzite+zinc blende) si Te est fourni pendant le processus de croissance. De plus, des mesures électriques en deux points montrent qu'un dopage au Te accru entraîne un gain de conductivité. Deux séries de croissance comparables, ne différant que par la pression partielle As d'environ 1 × 10 −5 Torr tout en gardant tous les autres paramètres constants, ont été analysés pour différents niveaux de dopage au Te. Leur comparaison suggère que la structure cristalline est fortement affectée et que le gain de conductivité est plus distinct pour les fils développés à une pression partielle As comparativement plus élevée.
Contexte
Les nanofils (NW) ont attiré une attention notable au cours de la dernière décennie, car ils sont considérés comme un élément de construction prometteur pour les technologies émergentes et futures. Leurs applications techniques sont diverses, allant des transistors à effet de champ et dispositifs optiques aux cellules solaires [1, 2]. La large applicabilité des NW est basée sur leurs caractéristiques remarquables, telles qu'un rapport d'aspect élevé, une dissipation de puissance ultra-faible et, dans le cas des InAs, l'absence de barrière Schottky à l'interface avec les contacts métalliques [3,4,5] . Cette dernière est due au fait que l'InAs présente une couche d'accumulation en surface, permettant la mise en contact ohmique [6]. Du point de vue de la physique, les nanoparticules d'InAs possèdent des propriétés exceptionnelles, à savoir une mobilité électronique élevée [7], une faible masse effective [8], un facteur g important [9] et un fort couplage spin-orbite Rashba [10, 11]. Pour cette raison, ils sont devenus un ingrédient important dans la recherche liée à l'information quantique [5, 12, 13, 14].
Les InAs NW sont généralement cultivés via une méthode de croissance vapeur-liquide-solide (VLS) utilisant des gouttelettes d'or comme catalyseur. L'utilisation de Au présente au moins deux inconvénients. D'une part, il incorpore comme impureté non intentionnelle dans les NW dégradant leurs propriétés matérielles [2, 15, 16], d'autre part, l'intégration d'applications importantes déjà démontrées comme les transistors à effet de champ NW (FET) [17], tunnel FET [18], photodétecteurs [19], etc., sur la technologie à base de silicium n'est pas possible. Ainsi, une croissance sans catalyseur en mode vapeur-solide (VS) développée précédemment a été appliquée dans cette communication [20]. Outre la phase de mélange de zinc cubique (ZB), qui est la phase stable dans les matériaux en vrac III-V, la phase de wurtzite hexagonale (WZ) est également présente dans les nanofils. Le polytypisme ZB-WZ et d'autres défauts tels que les jumeaux de rotation et les défauts d'empilement sont couramment signalés. La phase pure, presque exempte de défauts d'empilement, InAs NWs peut être obtenue par croissance VLS assistée par Au [21, 22] mais pas en utilisant la méthode VS sans catalyseur [23, 24, 25]. Ces défauts ont un impact négatif sur le transport [26, 27] et les propriétés optiques [28].
Une façon de contrer la diminution du transport de charge est l'utilisation du dopage, c'est-à-dire l'incorporation de porteurs supplémentaires. Cependant, les méthodes de dopage bien établies utilisées pour les couches semi-conductrices composées III-V ne peuvent pas simplement être transférées aux structures filaires. Les nanofils ont des facettes de croissance axiales et radiales avec différentes orientations cristallines et reconstructions de surface résultant en une croissance hautement anisotrope qui est censée influencer l'incorporation de dopant. La situation est compliquée par les différents modes de croissance, vapeur-liquide-solide (VLS) et VS, des facettes participantes [29, 30] et le polytypisme particulier de la phase cristalline [31]. Toutes ces caractéristiques spécifiques conduisent à une distribution inhomogène du dopant, à la fois axialement et radialement [29, 32, 33]. L'élément Si du groupe IV a été couramment utilisé comme dopant de type n pour les films minces III-V à croissance MBE. Cependant, Si est connu pour présenter un comportement amphotère, c'est-à-dire que les atomes de Si peuvent être incorporés en tant que donneurs sur les sites du réseau cationique ou accepteurs sur les sites du réseau anionique, en fonction de l'orientation du substrat et des conditions de croissance [34, 35]. Ce comportement a également été observé dans les nanofils en corrélation avec les différentes orientations cristallines des facettes impliquées dans la croissance, les mécanismes de croissance et la température de croissance [29, 36, 37]. En revanche, l'élément du groupe VI Te est un dopant de type n très efficace dans les épicouches [38] ne présentant aucun risque de comportement amphotère. De plus, Te présente d'autres avantages :une énergie d'ionisation inférieure par rapport aux autres dopants de type n couramment utilisés dans les systèmes de matériaux III-V, ce qui conduit potentiellement à l'obtention de niveaux de dopage plus élevés [39] ; un coefficient de diffusion plus faible [40] et un effet mémoire plus faible par rapport aux autres éléments du groupe VI, à savoir S et Se, qui sont importants pour les interfaces abruptes [41]. Le comportement exclusivement dopant de type n du Te a été rapporté pour les nanofils de GaAs catalysés par Au [42] et auto-catalysés, montrant le potentiel d'une concentration élevée de dopage riche, mais aussi l'impact sur la morphologie du fil et la structure cristalline [43, 44] .
Dans cette communication, nous étudions le dopage au Te dans les NW d'InAs, en fournissant des informations sur l'impact du dopage sur la morphologie du NW et la commutation entre la structure ZB et WZ au sein de la croissance VS en présence de Te. Des recherches basées sur la microscopie électronique à balayage (MEB) ont révélé un fort impact de Te sur la morphologie NW. Les mesures par microscopie électronique à transmission à haute résolution (HR-TEM) [45] et par diffraction des rayons X (XRD) ont permis de mettre en évidence un changement du rapport ZB/(WZ + ZB) et les mesures électriques en deux points ont montré une augmentation de la conductivité avec augmenter le niveau de dopage Te.
Méthodes/Expérimental
Les InAs NW ont été cultivés en mode VS sans l'utilisation de catalyseur étranger sur des substrats Si (111) de type n.
Préparation du substrat
Avant la croissance, les substrats ont été nettoyés à l'aide de HF et d'eau DI. Un traitement consécutif au peroxyde d'hydrogène pendant 45 µs conduit à la formation d'un film de SiO2 de quelques angströms d'épaisseur contenant des trous d'épingle, qui servent de centres de nucléation pour la croissance NW [20]. Après l'oxydation, les substrats ont été immédiatement transférés dans le sas de chargement dans lequel ils ont été chauffés à 200 °C pendant 45 min. Cela a été suivi d'une étape de dégazage dans la chambre de préparation, chauffant les échantillons à 400 °C pendant 45 min supplémentaires.
Croissance des nanofils InAs
Les NW ont été cultivés à une température de substrat de 475°C pendant 1:20 h dans une chambre d'épitaxie par faisceau moléculaire (MBE) Omicron Pro 100. Un taux de croissance interne de 0,1 μmh −1 a été utilisé pour la croissance NW. L'arsenic a été fourni via une cellule de craquage As et la pression équivalente du faisceau As4 (BEP) a été ajustée à des valeurs de 2,3 × 10 –5 Torr et 3,3 × 10 –5 Torr. La première série d'échantillons (série A) a été cultivée à une pression partielle d'As plus élevée par rapport à une deuxième série de croissance (série B) (cf. Tableau 1), tout en gardant tous les autres paramètres constants. Le tellure a été fourni pendant la croissance en utilisant GaTe stoechiométrique. La température de fonctionnement de la cellule d'effusion a varié entre 401 °C et 562 °C sur la base d'étalonnages effectués sur des couches de GaAs dopé au Te via des mesures Hall. Les températures de la cellule GaTe 401 °C, 447 °C, 500 °C et 561 °C correspondent à une concentration en porteurs d'environ 1 × 10 15 cm −3 , 4 × 10 16 cm −3 , 5 × 10 17 cm −3 , et 6 × 10 19 cm −3 respectivement, dans les couches GaAs (100) utilisées pour l'étalonnage.
Traitement de l'appareil
Afin de traiter les contacts à deux points, les NW ont été transférés mécaniquement sur un substrat de Si pré-structuré qui a été recouvert de 200 nm de SiO2. Un diagramme schématique des étapes de mise en contact est fourni dans le fichier supplémentaire 1 :Figure S1. Avant le dépôt de métal, les fils ont été revêtus par centrifugation par un système à trois couches de résine PMMA 50 K (AR-P639.04), 50 K et 950 K (AR-P679.04) sur laquelle la forme de contact a été définie par lithographie par faisceau électronique. Après développement, la zone de contact a été passivée par du polysulfure d'ammonium dilué à 3,5% (H2 O :(NH4)2 S3 , 34:1) à 60 °C pendant 30 min. Les électrodes, constituées de 100 nm de titane et de 40 nm d'or, ont été déposées via un évaporateur à faisceau d'électrons.
La liste complète des échantillons étudiés via SEM, TEM, XRD et mesures électriques est présentée dans le tableau 1. Ici, les lettres A, B et C indiquent les séries d'échantillons qui ont été cultivées chacune à des pressions partielles As différentes, mais à part cela. dans des conditions égales. Une température GaTe de 0 °C correspond à un obturateur à cellules fermées.
Résultats et discussion
Morphologie
L'imagerie SEM a été utilisée afin d'étudier l'influence du dopage au Te sur la morphologie du fil. Les résultats sont présentés sur la figure 1. Chaque point de données sur les graphiques représente la moyenne d'au moins 40 fils et la barre d'erreur leur écart type.

Morphologie des nanofils. Longueur et diamètre moyens des nanofils à différentes températures des cellules GaTe. un La série A a été cultivée à une pression partielle d'As d'environ 3,3 × 10 –5 Torr. b La série B a été cultivée à une pression partielle d'As de 2,3 × 10 –5 Torr. Les lignes brisées guident les yeux. La micrographie SEM présentée dans l'encart montre des InAs NW non dopés entourés de cristallites formés pendant la croissance. La barre d'échelle est de 300 nm et 120 nm, respectivement
La figure 1a montre la morphologie de la série de fils A développée à une pression partielle As d'environ 3,3 × 10 −5 Torr. La température de la cellule GaTe variait de 0°C à 561°C. En tenant compte de la barre d'erreur, aucune tendance distincte du diamètre et de la longueur NW n'est observée jusqu'à une température de cellule de 500 °C. Cependant, à 561°C, l'apport de Te est clairement préjudiciable, entraînant une forte augmentation du diamètre et une diminution de la longueur NW. La série de croissance B, illustrée à la figure 1b, a été cultivée à une pression d'As comparativement plus faible de 2,3 × 10 −5 Torr. L'encart montre une vue latérale SEM exemplaire d'un échantillon cultivé, présentant des InAs NW et des grappes sur la surface du substrat. D'autres images SEM des séries A et B sont présentées dans le fichier supplémentaire 1 :Figure S2. Ici, une plage de température des cellules GaTe de 0°C à 462°C a été explorée. Nous observons une diminution de la longueur lorsque Te est ajouté au cours de la croissance pour la série B à une température de cellule de 401 °C. En comparant les mesures des séries A et B dans le même intervalle de température, on observe qu'en particulier la diminution de la longueur NW est plus nette à des pressions d'As comparativement plus faibles (série B). Cependant, la même tendance globale, c'est-à-dire une diminution de la longueur NW est observée pour les deux séries et une augmentation du diamètre est observée pour la série A.
Le dopage Si conduit de manière similaire à une augmentation du diamètre et une diminution de la longueur pour InAs et GaAs, indépendamment de la méthode de croissance (MBE ou épitaxie en phase vapeur métalorganique (MOVPE)) [46, 47]. Le même changement de dimensions a été observé pour le dopage au Te de GaAs NWs sans catalyseur cultivés par MBE [44]. Il semble qu'indépendamment du système de matériaux utilisé, c'est-à-dire des matériaux IIIV dopés avec des matériaux du groupe IV (InAs/Si, GaAs/Si) ou du groupe VI (GaAs/Te, InAs/Te), la même tendance globale concernant la morphologie est observée.
Te présente un rayon covalent assez grand par rapport aux atomes du réseau hôte et peut donc jouer le rôle de tensioactif [48, 49]. Le comportement observé pourrait donc provenir d'une diminution de la diffusivité des atomes d'In causée par Te. Cela pourrait à son tour entraîner une augmentation de la croissance radiale et une diminution de la longueur car les adatomes In sont entravés sur leur chemin vers la pointe NW où ils contrôlent la croissance [46]. En comparant la Fig. 1a (série A) et la Fig. 1b (série B), nous constatons que la pression de l'As influence la façon dont la morphologie du fil est affectée par l'ajout de Te. La découverte suggère qu'il pourrait être possible de contrecarrer l'impact décroissant de Te sur la dimension radiale et axiale du fil d'InAs en augmentant la pression d'As dans une certaine mesure.
Structure cristalline
L'impact des dopants Te sur la structure cristalline a été étudié à l'aide de MET et XRD. Adoptant la classification utilisée par Caroff et al. [49], une séquence d'empilement cristallin était attribuée à un segment ZB (cf. Fig. 2a) ou WZ (cf. Fig. 2d) si la séquence d'empilement suivait exactement quatre bicouches d'atomes. Cela signifie que ...ABCA... a été compté comme un segment ZB et …ABAB… comme un segment WZ. Ceci est illustré à la Fig. 2b, e. Ici, chaque lettre représente une bicouche d'atomes. Certaines sections de fil sont interrompues par des failles d'empilement (SF) constituées d'une couche manquante ou en excès dans la séquence cristalline, comme le montre la Fig. 2c, f. Bien que rarement observé, le jumelage par rotation est également présent dans certains segments (non illustré ici).
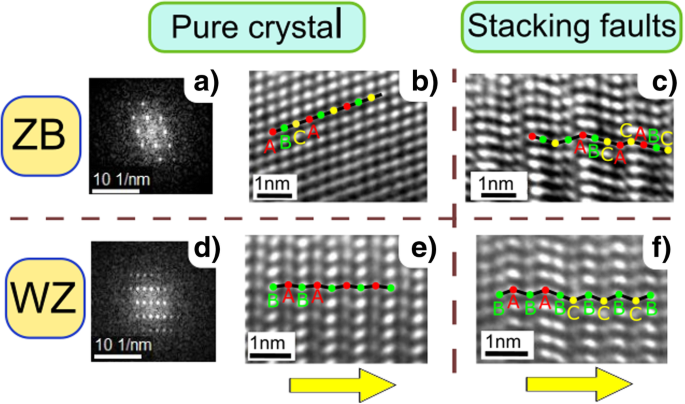
Analyse de la structure cristalline. Images HR-TEM d'InAs NWs, illustrant les structures cristallines ZB et WZ avec et sans failles d'empilement. Les flèches jaunes indiquent le sens de croissance [111]. Les points colorés et les lignes noires guident les yeux pour retracer la caractéristique d'empilement. un Diagramme de diffraction FFT pour un ZB sans défaut. b , c Structure ZB. d Diagramme de diffraction FFT pour WZ et e sans défaut –f Structure WZ
Les sections de cristal n'ont été identifiées comme des segments ZB ou WZ que si une séquence complète constituée de quatre bicouches d'atomes était observée. Les sections restantes ont été attribuées à des SF ou à des jumeaux en rotation.
La structure cristalline à trois niveaux de dopage différents évalués selon les caractéristiques expliquées est illustrée sur la figure 3. Différentes zones WZ et ZB sont mises en évidence. Cependant, pour l'analyse, seuls les segments individuels ont été comptés. Afin de quantifier l'influence du dopage au Te sur la structure cristalline NW, une longueur totale d'environ 150 nm de segments de 10 NW pour chaque niveau de dopage a été analysée et moyennée (cf. Fig. 3b–d). Le rapport des segments ZB/(WZ + ZB) a été déterminé en comptant le nombre de segments ZB et WZ simples. Les échantillons B1, B3, C1 et A4 à 0 °C, 447 °C et 500 °C ont été analysés (cf. Fig. 4), respectivement. Nous observons une amélioration du rapport segment ZB/(WZ + ZB) avec l'augmentation de la température de la cellule GaTe. Cette tendance est illustrée à la Fig. 4. En comparant les deux premiers points de données (0 °C et 447 °C), le rapport amélioré est dû à une augmentation plus forte des segments ZB par rapport à l'augmentation des segments WZ du non dopé au température de dopage la plus basse (cf. encadré Fig. 4). Les deux types de structure sont améliorés et le nombre de SF est diminué. Cependant, la tendance diffère pour le troisième point. En comparant le niveau de dopage le plus élevé avec le niveau de dopage le plus faible (500 °C et 447 °C), on constate que le nombre de segments WZ diminue et le nombre de segments ZB reste quasiment constant (cf. encadré Fig. 4) tandis que le nombre de SFs augmente. Cela conduit à un ratio élevé. Pourtant, la section ZB est promue par rapport au cas non dopé. Enfin, les résultats montrent que le dopage au Te améliore en effet le rapport segment ZB/(WZ + ZB). Cependant, il reste ambigu si la formation des segments ZB est strictement favorisée par l'incorporation de Te.
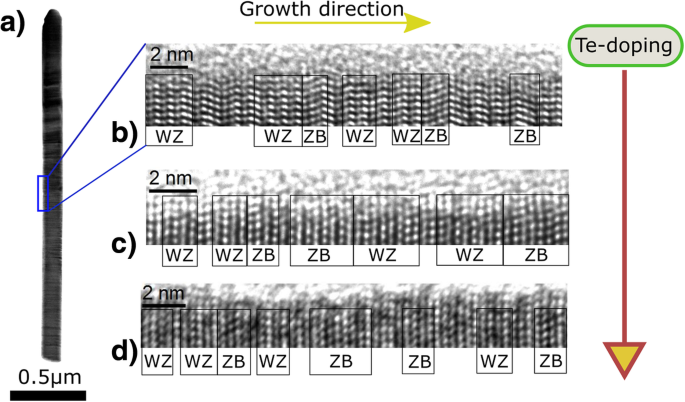
Influence du dopage au Te sur la structure cristalline. Images MET illustrant la structure cristalline dans des InAs NW non dopés et dopés au Te. un Vue latérale d'un InAs NW. b –d Images HR-TEM de la structure cristalline InAs NW (image tournée à 90° dans le sens des aiguilles d'une montre). Les zones WZ et ZB sont étiquetées. Les échantillons et les températures des cellules GaTe suivants ont été choisis :b B1 (Comme4 -BEP = 2,3 × 10 −5 Torr), non dopé, c'est-à-dire 0°C. c B3 (Comme4 -BEP = 2,3 × 10 −5 Torr), 447°C. d C1 (Comme4 -BEP = 3.0 × 10 −5 Torr), 500°C

Rapport entre les segments ZB et WZ. Rapport du nombre de segments ZB et du nombre total de segments identifiés comme WZ ou ZB en fonction de la température de la cellule GaTe. Pour les deux premières mesures B1 et B3 ont été analysées. A 500°C, les résultats des fils C1 et A4 ont été fusionnés car ils ont été développés à un As-BEP similaire. Le graphique à barres dans l'encart représente la longueur cumulée de tous les segments WZ et ZB présents dans le NW à la température de cellule indiquée, respectivement
Afin de compléter les observations faites par MET, des mesures XRD ont été effectuées. Nous avons effectué des -scans en nous concentrant sur les réflexes cubique (220) et hexagonal [10,11,12,13,14,15]. Ces réflexes peuvent être attribués sans ambiguïté à la structure ZB et WZ, respectivement. La mesure des intensités respectives a permis d'extraire le I ZB /(Je ZB + Je WZ ) rapport d'intensité. Les balayages représentés sur la figure 5a ont servi à déterminer les intensités relatives des pics ZB et WZ à chaque température de dopage des cellules GaTe. Pour le réflexe ZB, six pics se produisent même si le réseau cubique ne devrait conduire qu'à une symétrie triple. Nous attribuons ces pics à des jumeaux symétriques dans la structure ZB. Les pics symétriques sextuples apparaissant dans le balayage WZ sont caractéristiques de la structure cristalline hexagonale et correspondent à nos attentes. Ici, l'intensité du signal des cristallites de surface d'InAs (cf. encadré sur la Fig. 1) est supposée être inférieure de deux ordres de grandeur au signal NW [50] et peut donc être négligée. Le rapport d'intensité correspondant I ZB /(Je ZB + Je WZ ) est tracé sur la Fig. 5b (triangles colorés pour la série A). Il montre une augmentation du I ZB /(Je ZB + Je WZ ) rapport d'intensité avec l'augmentation de la température de la cellule GaTe, devenant apparent après 401°C pour la série A. Ce résultat est en accord avec l'observation déjà obtenue à partir de l'analyse MET. Notez que les ratios d'intensité donnés ne représentent pas la proportion réelle ZB/WZ mais constituent un résultat qualitatif. Ceci est dû au fait que les différents réflexes sont d'intensité différente, selon le facteur de structure qui n'a pas été explicitement pris en compte. Cependant, la comparaison entre les points de données reste valable. La même mesure sensible au réflexe a été réalisée pour la série B qui a été cultivée à une pression d'As inférieure à celle de la série A présentée ci-dessus. Les résultats représentés sur la figure 5b (points noirs) montrent une tendance similaire à celle de la série A, c'est-à-dire une augmentation du rapport d'intensité ZB/(WZ + ZB) à des températures de cellule plus élevées. Cependant, l'impact des atomes de Te sur la structure cristalline est moins distinct par rapport à des pressions d'As plus élevées et une nette augmentation n'est observée qu'à 462°C. Bien que la série B ne montre qu'une amélioration du rapport d'intensité ZB/(WZ + ZB) dans le XRD pour la température de cellule GeTe la plus élevée de 462 °C, la série A montre clairement une augmentation à 447 °C et 500 °C de température de cellule. Cette observation suggère que les atomes d'As facilitent l'incorporation d'atomes de Te, ce qui à son tour entraîne une modification de la structure cristalline. Par conséquent, un impact plus important sur le rapport ZB/(WZ + ZB) est observé pour la pression d'As respective plus élevée. La diminution du rapport d'intensité à 447 °C sur la figure 5b pourrait être due à des effets d'ombrage, car la densité NW de l'échantillon B3 était supérieure à la moyenne, bien que cela ne soit pas encore entièrement compris.

Analyse aux rayons X de la structure du réseau. un φ scans obtenus par mesures radiographiques sur InAs NWs A1-A4. b I résultant ZB /(Je WZ + Je ZB ) rapport d'intensité par rapport à la température de la cellule GaTe. Les points de données triangulaires sont extraits des mesures décrites dans (a ) pour les échantillons A1–A4. Les points noirs indiquent les points de données des échantillons B1–B4
D'après les résultats MET présentés ci-dessus, on conclut que les NW qui ont été cultivés sous réserve de Te montrent un nombre accru de segments ZB et WZ et donc moins de SF par rapport au cas non dopé. De plus, les mesures XRD indiquent que le rapport d'intensité ZB/(WZ + ZB) augmente avec l'augmentation du niveau de dopage Te (à des températures plus élevées), ce qui est qualitativement conforme aux mesures MET. Contrairement aux éléments communs utilisés pour le dopage des matériaux III-V tels que Si (InAs/Si [30], GaAs/Si), C (GaAs/C) ou Be (GaAs/Be), Te affecte clairement la structure cristalline du NO. La promotion de la formation de ZB observée pourrait provenir d'un changement des énergies de surface, abaissant la barrière énergétique pour la nucléation de ZB. Cela a également été observé dans les nanofils InP dopés au zinc [51] où la croissance VLS catalysée par Au a été utilisée. Cependant, des recherches supplémentaires sont nécessaires pour clarifier le mécanisme sous-jacent.
Mesures électriques
La conductivité définie par σ = A·R·L −1 w a été extrait de mesures en deux points utilisant des contacts Ti/Au. Ici, A est la section hexagonale du fil avec A = 3√3d 2 NO /8 où d NO est le diamètre maximal, R la résistance, et Lw la distance entre les contacts électriques. L w et d NO ont été mesurés individuellement pour chaque fil via l'imagerie SEM. Des exemples de caractéristiques I-V d'InAs NW non dopés et dopés sont présentés dans les Fig. 6a-d. Les graphiques montrent le comportement ohmique attendu dû à la couche d'accumulation superficielle d'InAs [6, 52]. La conductivité en fonction du niveau de dopage a été déterminée sur la base des mesures I-V et de la géométrie NW. La dépendance résultante entre la conductivité et la température de la cellule GaTe est illustrée à la Fig. 6e. À chaque température, au moins 20 NW ont été examinés pour la série A. En comparant les fils non dopés et dopés, une augmentation de la conductivité moyenne d'environ un ordre de grandeur au niveau de dopage le plus élevé est observée. A une température de cellule GaTe de 500°C, une conductivité moyenne d'environ 80 S/cm a été déterminée (comparée à environ 8 S/cm pour 0°C). Bien que la dispersion de la conductivité pour des niveaux de dopage plus élevés soit assez nette, notre observation montre que l'incorporation de Te a en effet un fort impact, conduisant à une augmentation de la conductivité en moyenne. La comparaison de la XRD et de la mesure de conductivité suggère qu'en dessous de 401 °C, l'impact du Te sur la structure cristalline et les propriétés de transport ne joue qu'un rôle mineur. La grande variance de la conductivité des InAs NW mentionnée ci-dessus a été rapportée de manière similaire dans la littérature [53]. Aucune tendance de la conductivité n'a été observée en ce qui concerne un changement de diamètre NW ou d'espacement des contacts, comme prévu [26]. Ainsi, nous excluons le rapport hauteur/largeur différent comme source d'erreur. Nous identifions trois raisons principales responsables de la forte variance de la conductivité :(i) la méthode de passivation par contact utilisant du polysulfure d'ammonium pourrait conduire à une qualité de contact hétérogène. (ii) La surface du fil n'est pas passivée et les états de surface peuvent être influencés par une saturation non homogène des liaisons pendantes au niveau des facettes latérales du fil via l'eau et l'oxygène, ce qui entraîne finalement une oxydation de surface non uniforme. Cela a à son tour un impact important sur les caractéristiques de transport, conduisant à de grandes erreurs [54]. Une façon d'empêcher ces états de surface hétérogènes est la passivation via le dépôt in situ d'Al2 O3 [53, 55]. (iii) Un dopage inhomogène le long du NW, tel qu'observé pour le dopage Si [26], pourrait également causer la grande diffusion des données, bien que nous ayons essayé de l'exclure en plaçant les contacts centrés pour chaque fil. Enfin, les variations de longueur NW (cf. Fig. 1) et de densité peuvent entraîner des effets d'ombrage, empêchant une incorporation homogène de Te dans l'échantillon. Cependant, des investigations plus systématiques sont nécessaires pour identifier l'origine de la grande variance observée. De plus, des mesures de conductivité pour les NW de la série B cultivées à une pression d'As comparativement inférieure ont été effectuées. Ici, au moins six fils ont été mesurés pour chaque température de cellule GaTe. Les résultats représentés sur la figure 6e montrent un comportement similaire à ceux discutés ci-dessus pour la série A. La conductivité de InAs NWs est augmentée pour des températures de cellule GaTe plus élevées. Cependant, l'effet est moins net par rapport à la série A, cultivée à une pression d'As plus élevée. En comparant les conductivités des deux séries à 401 °C et 447 °C sur la Fig. 6e, nous constatons que les valeurs de la série A sont environ deux fois plus élevées que celles trouvées pour B. Les résultats XRD présentés ci-dessus (cf. Fig. 5 ) illustrent que la structure cristalline de la série A est plus fortement affectée par l'incorporation de Te que dans la série B. La combinaison des deux résultats indique que la conductivité élevée est liée au changement de la structure cristalline, c'est-à-dire l'augmentation de ZB/(WZ + ZB) rapport d'intensité. Il est connu de la littérature qu'une modification de la structure cristalline InAs NW de WZ dominé vers ZB dominé, améliore la conductivité [50, 53, 56]. Basé sur des investigations MET sur InAs1 − x Sbx NWs, Sourribes et al. rapportent une augmentation de la conductivité de 1,5 pour un gain de fraction NW ZB de 20 à 80 % [50]. Nos résultats MET (cf. Fig. 4) montrent un rapport ZB/(WZ + ZB) élevé de 32 % (NW non dopé) à 43 % (NW dopé maximum) tandis que la valeur moyenne de la conductivité augmente d'environ un facteur 10. Cela la comparaison suggère que la structure cristalline altérée n'est pas la seule raison de l'amélioration de la conductivité. Bien que la modification de la structure cristalline affecte le transport des porteurs, l'effet observé est probablement également dû à une augmentation de la densité des porteurs induite par le Te agissant comme donneur.
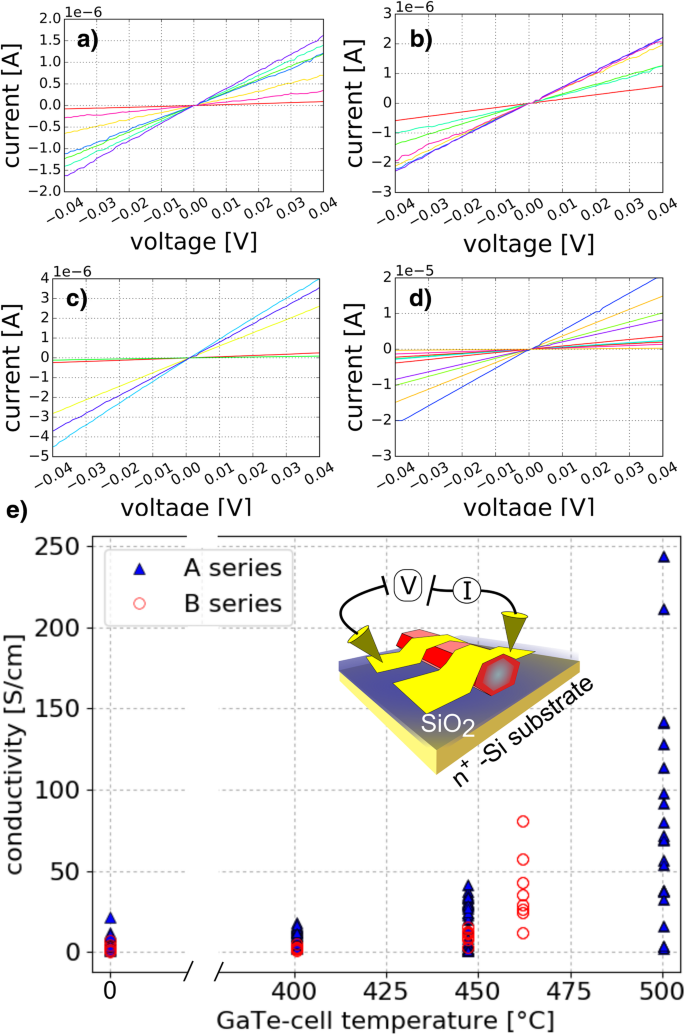
Caractérisation électrique. un –d Exemples de mesures I–V de InAs NW à une température de cellule GaTe de 0 °C, 401 °C, 447 °C et 500 °C (série A) mesurées via des contacts à deux points. e Détermination des valeurs de conductivité des NW d'InAs dopé au Te en fonction de la température de la cellule GaTe pour les séries A (haut As-BEP) et B (bas As-BEP). L'encart montre un schéma de la configuration de mesure électrique
Conclusion
En résumé, nous avons cultivé des InAs NW sans catalyseur dopé au Te sur des substrats de Si (111) via la méthode de croissance vapeur-solide. Le Te a été fourni par une cellule GaTe permettant la croissance de InAs NW dopés au Te à différents niveaux de dopage en ajustant la température de la cellule. Deux séries d'échantillons cultivées à différents As-BEP ont été caractérisées par des mesures SEM, TEM, XRD et électriques. Nous avons montré que Te modifie la morphologie NW conduisant à une tendance globale à une augmentation du taux de croissance radiale et à une diminution de la croissance axiale. L'impact est plus fort à des pressions partielles d'As comparativement plus faibles. Les mesures TEM et XRD ont révélé que la structure cristalline NW est affectée par l'addition de Te, entraînant une augmentation du rapport ZB/(WZ + ZB) pour les deux séries de croissance. L'influence sur la structure cristalline NW cultivée à un As-BEP comparativement plus élevé était plus accentuée que celle observée pour les NW cultivés à un As-BEP inférieur. Des mesures électriques en deux points ont démontré une augmentation de la conductivité moyenne pour les fils développés sous alimentation en Te. Ceci a été observé pour deux séries de croissance, cultivées à des pressions d'As différentes. La comparaison entre les deux séries d'échantillons a montré que les propriétés cristallines et électriques des NW d'InAs sont plus fortement affectées par l'ajout de Te à des pressions d'As plus élevées. Le résultat indique que la conductivité moyenne améliorée est fortement liée au changement de la structure cristalline, c'est-à-dire à l'augmentation du rapport ZB/(WZ + ZB). Nous attribuons les propriétés de transport améliorées à la fois à l'élément Te du groupe VI incorporé agissant comme donneur ainsi qu'à une structure cristalline altérée. Ce travail constitue une contribution importante afin d'étendre les options pour le dopage NW qui est d'un grand intérêt pour contrer la dégradation des propriétés de transport par les FS.
Abréviations
- Comme :
-
Arsenic
- BEP :
-
Pression équivalente du faisceau
- C :
-
Carbone
- GaA :
-
Arséniure de gallium
- Gate :
-
Tellurure de gallium
- HR-TEM :
-
Microscopie électronique à transmission haute résolution
- InAs :
-
Arséniure d'indium
- MBE :
-
Epitaxie par faisceau moléculaire
- MOVPE :
-
Epitaxie métalorganique en phase vapeur
- NW :
-
Nanofil
- SEM :
-
Microscopie électronique à balayage
- SF :
-
Défaut d'empilement
- Si :
-
Silicium
- Te :
-
Tellure
- VS :
-
Vapeur-solide
- WZ :
-
Wurtzite
- XRD :
-
Diffraction des rayons X
- ZB :
-
Mélange de zinc
Nanomatériaux
- Soutenir la croissance de l'IoT
- Croissance de la GMAO des petites entreprises
- Les scientifiques des matériaux enseignent aux nanofils comment « danser »
- À propos des nanoparticules semi-conductrices
- Enquêtes sur les structures de postes vacants liées à leur croissance dans la feuille h-BN
- Croissance auto-catalysée de nanofils verticaux de GaSb sur des tiges d'InAs par dépôt en phase vapeur de produits chimiques organo-métalliques
- Nanofils de silicium amorphe cultivés sur film d'oxyde de silicium par recuit
- Étude théorique de nanofils de germanium soumis à une traction biaxiale
- Contrôle de la croissance des nanofils de séléniure d'indium à haute uniformité (In2Se3) via le processus de recuit thermique rapide à basse température



