Étude de la variabilité de la mémoire à accès aléatoire à résistance de contact par modèle de vacance stochastique
Résumé
La variabilité des cellules de mémoire vive résistive a été l'un des défis critiques pour le développement de matrices RRAM haute densité. Alors que les sources de variabilité au cours de la commutation résistive varient pour différents films d'oxyde de métal de transition, la génération/recombinaison stochastique de lacunes d'oxygène est généralement considérée comme la cause dominante. Grâce à l'analyse des données expérimentales, un modèle stochastique qui relie les caractéristiques de commutation ultérieures avec ses états initiaux de cellules RRAM de contact est établi. En combinant un modèle de réseau de conduction et le mécanisme de tunnel assisté par piège, les impacts de la concentration et de la distribution des lacunes d'oxygène intrinsèques dans le film diélectrique RRAM sont démontrés avec la simulation Monte Carlo. Les données de mesure sur les matrices RRAM de contact concordent bien avec les caractéristiques projetées par le modèle basé sur la présence de lacunes intrinsèques distribuées de manière aléatoire. Une forte corrélation entre les caractéristiques de formage et les états initiaux est vérifiée, ce qui relie les comportements de formage aux lacunes d'oxygène de préformage. Cette étude fournit une compréhension complète des sources de variabilité dans les dispositifs RRAM de contact et un programme de formation de réinitialisation pour réduire le comportement de variabilité dans les états RRAM suivants.
Contexte
La mémoire à accès aléatoire résistive (RRAM) a été considérée comme une solution prometteuse de stockage de données non volatile, en raison de ses caractéristiques souhaitables, telles qu'une faible puissance, une vitesse P/E élevée et une compatibilité supérieure avec le processus logique CMOS [1,2,3 ,4]. Cependant, il reste encore de nombreux obstacles à surmonter pour implémenter facilement des matrices de mémoire RRAM dans les circuits CMOS de pointe actuels [5, 6]. L'un des principaux défis d'une matrice RRAM de grande taille réside dans la variation existant entre et à l'intérieur des cellules [7,8,9,10]. De nombreux modèles et simulations ont été proposés pour décrire le processus de génération/recombinaison stochastique de la lacune d'oxygène (Vo-) dans un film d'oxyde de métal de transition (TMO) [11,12,13,14]. Kim et Brivio ont proposé des modèles de réseau de disjoncteurs aléatoires pour émuler les caractéristiques électriques typiques des RRAM unipolaires et bipolaires, respectivement [11, 12]. Cependant, les résistances dans ces études étaient toutes réglées pour être constantes sans tenir compte du transport d'électrons dans le film RRAM. En outre, étant donné que les modèles présentés traitent des processus stochastiques de RRAM à partir d'un seul niveau de périphérique au lieu d'une analyse statistique, la variabilité du comportement de la RRAM dans un tableau n'est pas bien abordée et discutée dans des travaux antérieurs [11,12,13,14]. De plus, la présence de défauts dans le film diélectrique pendant la fabrication a été étudiée de manière approfondie pendant de nombreuses années [15, 16], mais son impact sur les caractéristiques de commutation résistive dans la RRAM doit encore être analysé de manière approfondie pour que la technologie soit appliquée dans des macros mémoire de grande taille. Pour étudier l'effet de la distribution Vo- intrinsèque sur les caractéristiques de la RRAM, un réseau de résistances modélisé sur le mécanisme de tunnel assisté par piège est construit pour une analyse statistique plus approfondie de la variation et pendant les opérations de cette étude [11,12,13,14, 17 ]. En outre, le processus de génération stochastique de Vo- est simulé par la méthode de Monte Carlo pour établir la corrélation entre la RRAM dans ses états initiaux et les caractéristiques de formation suivantes [18,19,20]. La forte corrélation entre la tension intrinsèque Vo- et la tension de formation est établie en vérifiant le résultat de la simulation avec des données mesurées sur des matrices RRAM de contact [21]. Enfin, différents types de filament conducteur (CF) générés et la variation d'état de résistance après les opérations de formage en raison de la distribution intrinsèque de Vo sont projetés et étudiés de manière approfondie. De plus, une solution pour soulager l'impact de la variabilité Vo-on préformée est proposée et démontrée dans cette étude.
Méthodes
Les données de mesure pour une analyse statistique plus poussée sur la variabilité sont collectées à partir de matrices RRAM de contact (CRRAM) 16 × 16 qui ont été fabriquées par des processus logiques CMOS 28 nm, où le processus de fabrication de CRRAM est illustré à la Fig. 1 [21]. La couche d'oxyde de protection de résistance (RPO) et le diélectrique intercouche (ILD) sont d'abord déposés une fois le processus frontal terminé avec les transistors formés. Pour construire un film de commutation résistif fonctionnel, une taille de trou de contact appropriée, une taille de contact de 30 nm × 30 nm, est effectuée pour éviter de court-circuiter la prise W et la région de diffusion n + . Enfin, la couche barrière, le TiN et le bouchon de tungstène sont déposés individuellement. L'image TEM en coupe de CRRAM est illustrée à la Fig. 2a. Comme le montre l'image, la CRRAM est connectée en série à un transistor de sélection à canal n. Une structure 1T1R est adoptée pour assurer une sélection appropriée dans un réseau et éviter les dépassements. La figure 2b montre le mappage de la composition de la CRRAM. Sa couche d'oxyde de métal de transition (TMO), d'une épaisseur de 9 nm, composée de TiN/TiON/SiO2 empilé est formé entre les électrodes de tungstène supérieure et inférieure de silicium. Après la fabrication de l'appareil, l'analyse électrique et la construction du modèle physique dans cette étude sont effectuées respectivement par l'analyseur de paramètres à semi-conducteur Aglent 4156C et la plate-forme logicielle MATLAB.
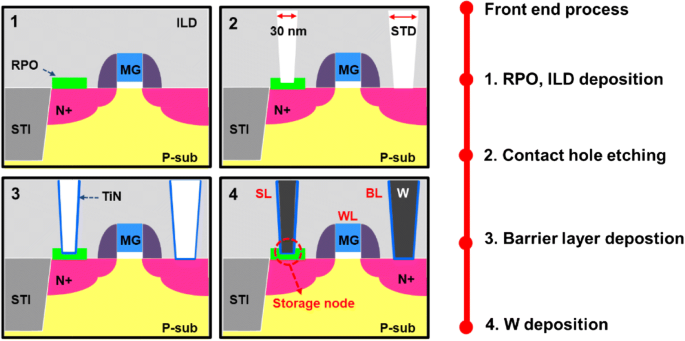
Flux de processus de la RRAM de contact sur une plate-forme de processus logique CMOS à porte métallique haute k de 28 nm. Une taille de contact plus petite pour CRRAM est conçue pour contrôler l'épaisseur de gravure pour former une couche de commutation résistive fonctionnelle
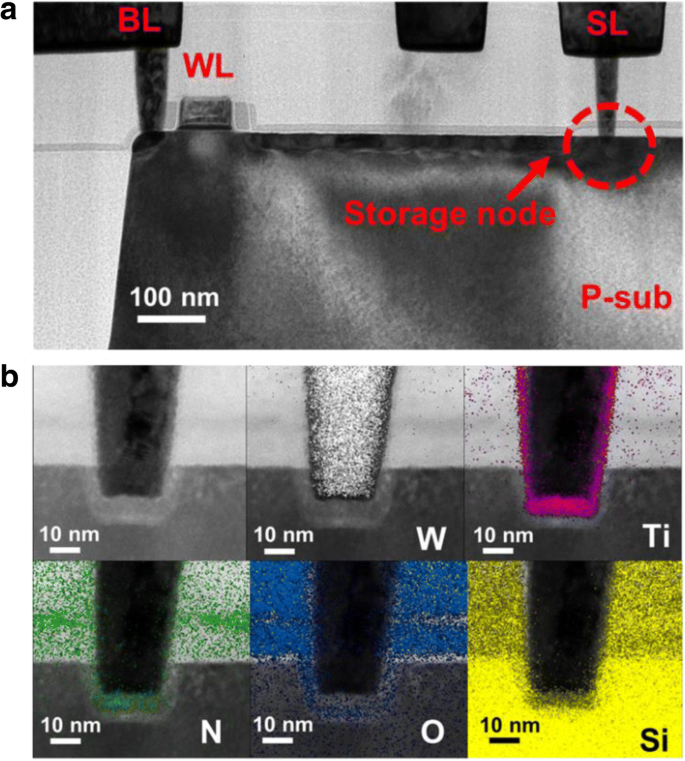
un Image TEM en coupe de la structure 1T1R CRRAM. b Cartographie de la composition du CRRAM. Le film de commutation résistif est composé de TiN/TiON/SiO2 pris en sandwich entre la fiche supérieure en tungstène et l'électrode inférieure en Si
Comme indiqué dans une étude précédente [22], une large distribution d'états initiaux est trouvée sur la matrice CRRAM. Pour étudier l'origine de la variation de l'état initial, les épaisseurs de couche TMO avec différentes résistances initiales sont d'abord comparées sur la figure 3. Les données suggèrent qu'il n'y a pas de différence d'épaisseur significative entre les deux cellules avec une grande différence dans les niveaux de résistance initiaux. De nombreuses études ont rapporté que les Vo- sont générés dans un film diélectrique ou RRAM pendant la fabrication [23,24,25,26], ce qui implique que la différence de nombre et de densité de Vo- devrait être responsable des variations de conductivité initiales.
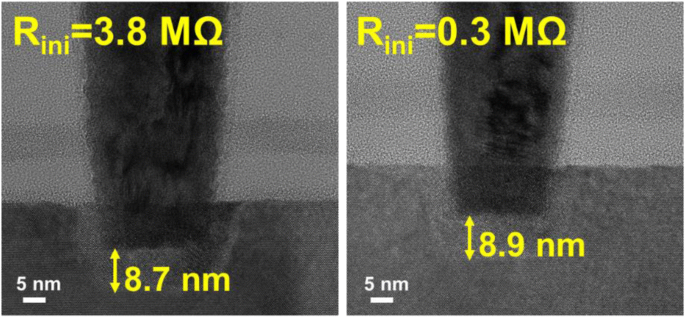
Comparaison de l'épaisseur de couche TMO entre deux cellules CRRAM avec une grande différence de résistance initiale. Les deux cellules sont observées avec des épaisseurs de couche diélectrique d'environ 9 nm
Résultats et discussion
Modèle intrinsèque de répartition des postes vacants
Pour émuler les interactions entre les Vo- intrinsèques, un modèle de réseau de résistances illustré à la Fig. 4a est établi [11,12,13,14]. Les résistances dans chaque grille sont calculées à l'aide d'un flux de simulation décrit dans la figure 4b, tandis que les paramètres physiques correspondants utilisés sont répertoriés dans le tableau 1. Basé sur l'image TEM de CRRAM, une structure bidimensionnelle de 30 nm de largeur, 10 nm d'épaisseur , est défini pour décrire la couche TMO, comme le montre la figure 5a. La résistance du site d'oxyde, R oxyde , et la grille de maillage sont déterminés par la propriété matérielle de l'anatase-TiO2 , qui a été utilisé comme matériau de commutation résistif dans de nombreuses études [27,28,29,30]. En raison de sa structure tétragonale, les constantes de réseau de l'anatase-TiO2 varient avec l'axe cristallographique. Pour plus de simplicité, les grilles de maillage de notre modèle sont toutes définies à 1 nm en introduisant la constante de réseau dans la direction c de l'anatase-TiO2 [31,32,33]. De plus, les résistances des grilles sont également déterminées en se référant à la résistivité de l'anatase-TiO2 [34, 35]. Comme le montre la figure 5a, des Vo- distribués aléatoirement sont initialement donnés à l'intérieur du maillage 2D. Les dépendances de la température et du champ électrique du courant de conduction de CRRAM sont résumées dans les Fig. 6a, b, respectivement. Les principales caractéristiques du courant tunnel assisté par piège (TAT) sont illustrées par son effet à faible température et la dépendance linéaire entre ln(J) et 1/E [17, 36]. En utilisant le modèle de conduction TAT, le profil potentiel à l'intérieur du film TMO doit d'abord être calculé pour obtenir davantage chaque Vo-résistance localisée. On s'attend à ce que la distribution de Vo- affecte principalement le courant conducteur car la distance de tunnel varie entre les lacunes d'oxygène. La résistance de Vo-, R j , est ensuite calculé par l'équation. 1, qui considère les probabilités de présence de Vo sur le site et adopte le modèle TAT, pour calculer la probabilité de tunneling entre les états d'inoccupation.
$$ {R}_{\mathrm{ij},N}=\frac{R_{\mathrm{oxyde}}}{\alpha\ {C}_{\mathrm{Vo}-}^{\kern0.75em \beta }\ \exp \left(\frac{\phi }{d}\right)} $$ (1)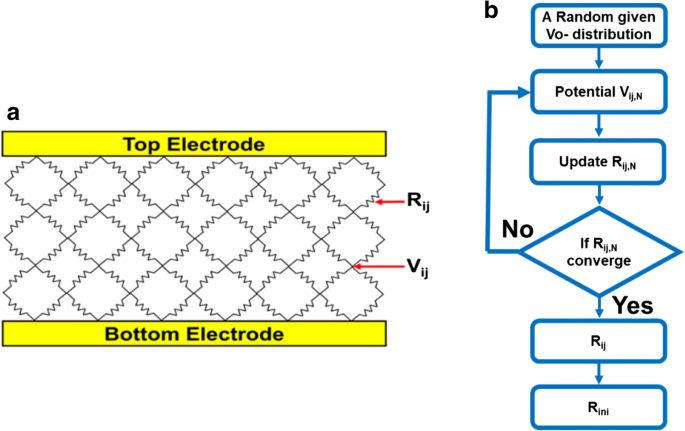
un Schéma du modèle de réseau de résistances composé d'une résistance localisée variable de Vo-. Les nœuds de ce réseau sont connectés les uns aux autres pour simuler l'interaction entre Vo-. b Flux de simulation de variabilité du niveau de résistance initial. La distribution stochastique de Vo- émergent intrinsèque pendant la fabrication est considérée par la méthode de Monte Carlo

un La distribution aléatoire de Vo- intrinsèque est initialement donnée dans le film RRAM. b Distribution de résistance localisée de Vo- calculée par la prise en compte de la tunnellisation assistée par piège. c R ini la distribution des cellules fraîches collectées à partir des matrices CRRAM concorde bien avec les données de simulation en considérant le mécanisme de conduction TAT de préformage Vo-
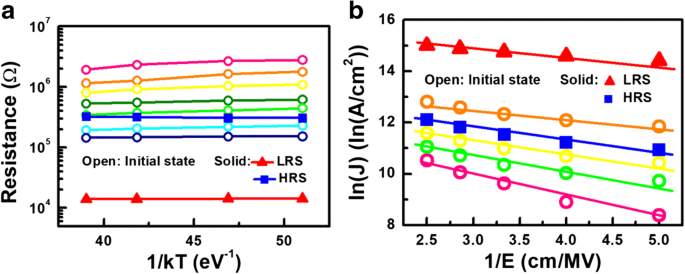
Le mécanisme de conduction de CRRAM est déterminé en vérifiant a dépendance à la température et b dépendance au champ électrique. L'effet tunnel assisté par piège suivi par CRRAM est considéré par deux caractéristiques de conduction, une faible dépendance à la température et un ajustement linéaire entre ln(J) et 1/E
Chaque R ij,N est mis à jour à chaque itération jusqu'à ce que le résultat converge finalement. En tant que R final j la distribution est obtenue, comme illustré sur la Fig. 5b, la résistance globale, R ini , d'une nouvelle cellule peut également être projetée ultérieurement, comme le montre la Fig. 5c. Comme on peut le voir sur la figure 5c, la variation du R simulé ini distribution obtenue par le flot de simulation proposé en considérant la distribution stochastique et la concentration de Vo intrinsèque assez bien en accord avec la distribution du R ini mesurée sur des matrices CRRAM. Par conséquent, les couches Vo-in intrinsèques TMO distribuées de manière aléatoire, créant plusieurs chemins de tunnel, contribuent à la résistance initiale largement répandue trouvée dans les matrices CRRAM préformées.
Analyse du processus de formation non uniforme
Après modélisation des causes attribuées à la variation de cellule à cellule à l'état frais, l'opération de formage, initialisant les caractéristiques de commutation résistive, est analysée. Le flux de simulation de l'opération de formage en mode de balayage CC est illustré à la Fig. 7 [18,19,20]. Comme le montre la figure 8a, une cellule est connectée à un transistor sélectionné en série avec une résistance de canal d'environ 5 KΩ dans la région linéaire et un courant de saturation d'environ 80 μA. En raison de la faible tension de formation, les mécanismes de conduction et de contrainte du diélectrique en régime de faible champ électrique doivent être pris en compte. Sur la base du modèle thermochimique proposé dans les études précédentes, une prédiction précise de la défaillance diélectrique a été démontrée [37,38,39,40]. Comportement de claquage théorique du TiO2 simulée par le modèle thermochimique [41] a montré des caractéristiques similaires à celles observées dans le CRRAM. Par conséquent, le taux de génération de Vo est obtenu sur la base du modèle chimique thermique ici [42,43,44]. Comme suggéré par le modèle thermochimique, les points de grille à côté de Vo- sont définis comme un point faible à proximité entourant les défauts. La présence de Vo- induit également un champ accru localisé, illustré à la Fig. 8b, et accélère le processus de génération de Vo- [45]. Considérant le temps jusqu'au processus de claquage diélectrique dans le modèle thermochimique avec une dépendance au champ de exp.(−E), la probabilité de génération de Vo P j est calculé par l'équation suivante [42].
$$ {P}_{\mathrm{ij}}=\gamma\ \exp \left(\mathrm{E}\right)\ \left\{\begin{array}{c}\kern1.75em \upgamma =0,\mathrm{if}\ \mathrm{site}\ \mathrm{est}\ \mathrm{pas}\ \mathrm{faible}\ \mathrm{spot}\\ {}\upgamma =1,\mathrm{if }\ \mathrm{site}\ \mathrm{is}\ \mathrm{faible}\ \mathrm{spot}\end{array}\right. $$ (2)
Flux de simulation d'un processus de formage basé sur le modèle thermochimique, en supposant le temps de défaillance diélectrique avec une dépendance au champ électrique de exp.(−E)
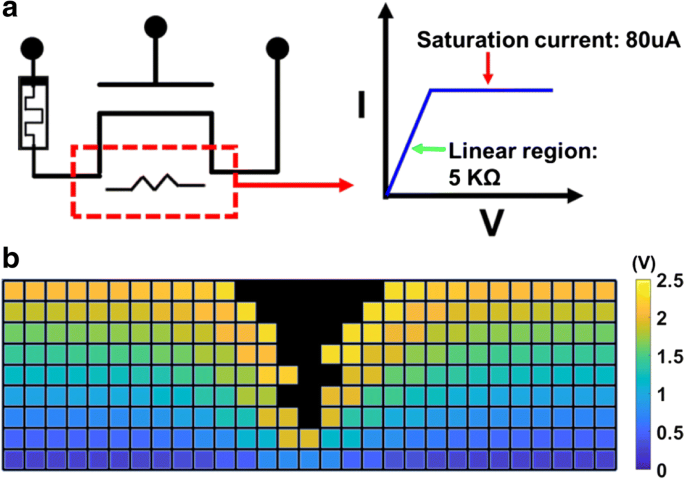
un L'opération de formage est simulée par une CRRAM connectée en série avec un transistor idéal. b La distribution de potentiel électrique non uniforme, résultant de Vo- préexistant, induit un champ localisé et accélère la génération de nouveaux défauts
Un niveau critique, P g , et un critère, P j> P g , sont définis pour savoir si un nouveau Vo- est généré. Un processus de rampe est appliqué pour mettre à jour la nouvelle distribution Vo- à chaque itération jusqu'à ce que la tension de formation atteigne 2,7 V. Enfin, avec un Vo- intrinsèque distribué de manière aléatoire, le faible niveau de résistance R former après formage, l'opération peut être obtenue. Sur la base du modèle ci-dessus, le R simulé former la distribution a projeté une grande variation, comme le montre la figure 9a, et le I-V calculé les caractéristiques concordent bien avec les données mesurées. De plus, la corrélation entre les caractéristiques de formation et les états initiaux est également étudiée. Une concentration plus élevée et un Vo- distribué localisé accélèrent le processus de formage. Par conséquent, corrélation positive entre la tension de formation et R ini se trouvent à la fois dans les résultats de simulation et les données mesurées, comme le montre la figure 9b.
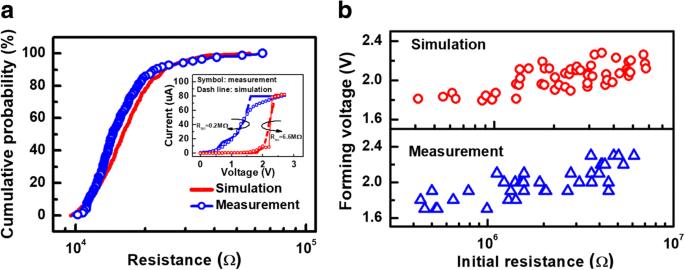
un La distribution de résistance simulée de l'opération de formage concorde bien avec le résultat de la mesure. b Des corrélations positives entre la résistance initiale et la tension de formation sont trouvées dans les données mesurées et simulées en raison de plus de points faibles et d'une intensité de champ électrique plus élevée produite par le préformage. Vo-
De plus, le Vo généré lors de l'opération de formage induit un chemin conducteur et entraîne un changement de CF dans les cellules, où l'évolution de CF pendant le processus de formage est illustrée à la Fig. 10. Pour les cellules avec un R élevé ini , il y a moins de Vo- intrinsèque et moins de points faibles, comme illustré sur la Fig. 10a. Après l'opération de formage, un seul chemin conducteur est plus susceptible de se produire entre les électrodes. Cependant, la croissance de la mucoviscidose dans les cellules avec beaucoup de Vo intrinsèque montrée sur la figure 10b a tendance à être plus répandue ; par conséquent, les FC dendritiques sont générées après la formation. La corrélation entre les différentes topographies CF et la distribution Vo à son état frais est également vérifiée par les données de mesure. Vo- et CF dans la couche TMO sont connus pour conduire à un bruit télégraphique aléatoire (RTN) distinctif pendant le processus de piégeage/dépiégeage d'électrons [46]. Des fluctuations de résistance se produisent si le chemin conducteur est bloqué par des électrons piégés, et la résistance diminue lorsque les électrons sont dé-piégés. L'analyse RTN de la CRRAM après la formation est résumée à la figure 11. Une fluctuation de résistance régulière en deux étapes est observée dans les cellules avec un R élevé. ini , lorsque le piégeage/dépiégeage d'électrons a lieu dans un dispositif avec un CF dominant. D'autre part, le RTN à plusieurs niveaux se trouve dans les cellules avec un faible R ini qui devrait obstruer le CF dendritique avec plus d'une voie. Le résultat statistique de RTN est résumé dans la Fig. 12, en analysant la mesure RTN de plus de 200 cellules CRRAM. Les données suggèrent que les cellules avec un R élevé ini ont tendance à ne présenter qu'une RTN à deux niveaux, ce qui est plus probable dans les dispositifs avec une CF dominante [46,47,48,49]. La variation de résistance après l'opération de formage est présentée sur la figure 13. Les données suggèrent qu'une variation de résistance plus élevée est trouvée à la fois dans les résultats de mesure et de simulation dans les cellules avec un faible R ini . Comme les CF moins confinés poussent le transistor sélectionné à entrer tôt dans la région de saturation, une cellule peut ne pas être correctement formée, ce qui entraîne des niveaux de résistance d'état de faible résistance plus larges.

Progression de la mucoviscidose en cellule avec a résistance initiale élevée et b faible résistance initiale. Une concentration intrinsèque plus élevée de Vo dans la couche TMO entraîne une génération aléatoire de Vo aux points faibles. Ces Vo- se connectent également les uns aux autres pour former des chemins dendritiques

Les topographies de CF en cellule avec a résistance initiale élevée et b les faibles résistances initiales sont analysées par ses données RTN correspondantes. L'apparition d'une fluctuation de résistance multiple dans les cellules à faible résistance initiale et plus intrinsèque V-vérifie l'existence de CFs dendritiques dans la couche TMO

La corrélation entre le niveau de résistance initial et le niveau RTN sur les cellules CRAM est résumée. Une probabilité plus élevée de fluctuation de la résistance à deux niveaux devrait se produire pour les cellules avec un chemin conducteur dominant, qui est fortement corrélée avec les cellules de R élevé ini
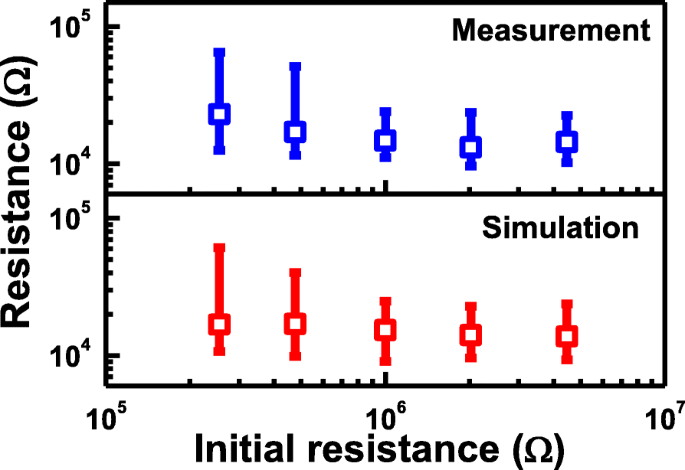
L'analyse de la variation du niveau de résistance après l'opération de formage est examinée à la fois par simulation et par mesure. Une variation plus élevée induite par la génération de FC dendritique se trouve dans les cellules avec une faible résistance initiale
Pour soulager la variabilité de formation causée par Vo- intrinsèque dans la couche TMO, une opération d'apprentissage de réinitialisation, qui balaie SL à 1,4 V sous une tension WL fixe de 2 V, est proposée pour être appliquée aveuglément sur des cellules de mémoire entières dans le réseau CRRAM avant la formation. Cette opération devrait annihiler les défauts préexistants existant dans les cellules à faible R ini et pour assurer une croissance de CF mieux confinée pendant le processus de formation ultérieur. En raison de la faible tension appliquée, il n'y a pas de changement dans les cellules avec un R élevé ini après le processus de formation. Avec une opération d'entraînement de réinitialisation générale, la résistance des cellules à faible R ini , augmente sans perturber les cellules avec un R élevé ini , comme le montre la Fig. 14. Par la suite, des caractéristiques de formage plus uniformes peuvent être obtenues.

Une opération d'apprentissage de réinitialisation globale est proposée pour être appliquée sur la matrice CRRAM. Résistance dans les cellules à faible R ini est augmentée en annihilant les défauts intrinsèques, mais les cellules avec un R élevé ini n'est pas dérangé
Conclusions
Un modèle de réseau de résistances prenant en compte l'effet de champ local et la conduction tunnel assistée par piège entre Vo- a été établi avec succès. Par simulation Monte Carlo, la variabilité cellulaire sur sa résistance initiale ainsi que sur le processus de formation est étudiée. La variation des états frais de CRRAM peut être expliquée avec succès par une distribution aléatoire de Vo- intrinsèque. La distribution de résistance projetée après formage est également en bon accord avec le résultat de la mesure en adoptant le modèle thermochimique. La croissance de CF pendant la formation est discutée et liée à la variabilité observée dans ce processus. Enfin, une opération d'apprentissage de réinitialisation est proposée pour soulager davantage la variabilité de formation causée par Vo- intrinsèque dans la couche TMO. Une forte corrélation entre les états initiaux et les caractéristiques de formation fournit des lignes directrices pour de nouvelles opérations adaptatives pour le développement futur des technologies RRAM.
Abréviations
- CF :
-
Filament conducteur
- CRRAM :
-
Contacter la mémoire vive résistive
- CVo- :
-
Vo-concentration
- d :
-
Distance de tunnel
- E :
-
Champ électrique
- ILD :
-
Diélectrique intercalaire
- N :
-
Temps d'itération
- P g :
-
Probabilité de commutation de seuil
- P j :
-
Probabilité de génération Vo
- R former :
-
Résistance après formage
- R j :
-
Résistance localisée de Vosite
- R ini :
-
État de résistance initial
- R oxyde :
-
Résistance localisée du site d'oxyde
- RPO :
-
Résistance de protection oxyde
- RRAM :
-
Mémoire vive résistive
- RTN :
-
Bruit télégraphique aléatoire
- TAT :
-
Tunneling assisté par piège
- TMO :
-
Oxyde de métal de transition
- V f :
-
Tension de formation
- V j :
-
Potentiel
- Vo- :
-
Vacance d'oxygène
- α :
-
Paramètre d'ajustement
- β :
-
Paramètre d'ajustement
- γ :
-
Paramètre d'ajustement
- ϕ :
-
Différence de potentiel électrique
Nanomatériaux
- ÉTUDE DE CAS :La méthode Honda
- Yantracraft et le Temple d'or
- Modèle de rétention de TaO/HfO x et TaO/AlO x RRAM avec caractéristiques de commutateur auto-rectifiant
- Étude d'un nouveau système micellaire ressemblant à un ver amélioré par des nanoparticules
- Une RRAM SRAM 4T intégrée avec charge de commutation résistive à auto-inhibition par un processus logique CMOS pur
- Étude des premiers principes sur la stabilité et l'image STM du borophène
- L'effet du plasma de contact hors équilibre sur les propriétés structurelles et magnétiques des spinelles Mn Х Fe3 − X О4
- Étude sur la mémoire à commutation de résistance multi-niveaux et la phototension dépendante de l'état de la mémoire dans les jonctions Pt/Nd:SrTiO3
- Étude collective sur la modélisation et la simulation de mémoires résistives à accès aléatoire



