Couches de dopage au silicium optimal des barrières quantiques dans la séquence de croissance formant un potentiel de confinement souple de huit périodes In0.2Ga0.8N/GaN Puits quantiques de bleu LED
Résumé
Les caractéristiques de l'In0.2 à huit périodes Ga0,8 Les puits quantiques N/GaN (QW) avec dopage au silicium (Si) dans les deux à cinq premières barrières quantiques (QB) de la séquence de croissance des diodes électroluminescentes (DEL) bleues sont explorés. Les épicouches des structures de QW sont cultivées sur 20 paires de In0,02 Ga0.98 Superréseau N/GaN agissant comme des couches de décharge de traction (SRL) sur des substrats en saphir à motifs (PSS) par un système de dépôt chimique en phase vapeur métal-organique à basse pression (LP-MOCVD). Spectres de photoluminescence (PL) dépendant de la température, courant par rapport à la tension (I -V ) courbes, puissance lumineuse en fonction du courant d'injection (L -Je ) et des images de microscopie électronique à transmission à haute résolution (HRTEM) d'épicouches sont mesurées. Les conséquences montrent que les QW avec quatre QB dopés Si ont une plus grande énergie de localisation de porteur (41 meV), des tensions d'activation (3,27 V) et de claquage (− 6,77 V) plus faibles et une puissance de sortie plus élevée de la lumière des LED bleues à une injection plus élevée courant que les autres échantillons. La faible hauteur de barrière des QB dans un échantillon de QB dopé au silicium quatre entraîne un potentiel de confinement doux des QW et des tensions d'allumage et de claquage plus faibles de la diode. Les images HRTEM prouvent que cet échantillon a des interfaces relativement diffusives de QW. Une répartition uniforme des porteurs parmi huit QW et une localisation supérieure des porteurs dans chaque puits sont responsables de l'amélioration de la puissance de sortie lumineuse, en particulier du courant d'injection élevé dans l'échantillon QB dopé à quatre Si. Les résultats démontrent que quatre QB sur huit In0.2 Ga0,8 Les QW N/GaN avec dopage Si réduisent non seulement l'effet Stark confiné quantique (QCSE), mais améliorent également la distribution et la localisation des porteurs dans les QW pour de meilleures performances optiques des LED bleues.
Contexte
Le dopage au silicium (Si) dans les barrières quantiques (QB) GaN peut allumer l'écran de Coulomb du champ de polarisation et provoquer la suppression de l'effet Stark confiné quantique (QCSE) dans les puits quantiques InGaN/GaN (QW). Les recombinaisons radiatives des excitons dans les QW InGaN/GaN peuvent être considérablement améliorées grâce aux QB dopés Si [1,2,3,4]. Des fluctuations de composition de l'indium (In) et une séparation de phase spinodale se produisent dans l'alliage ternaire InGaN en raison de l'écart inhérent de miscibilité en phase solide de GaN et InN. La formation d'amas riches en In pourrait agir comme de fortes localisations de porteurs, empêchant les pièges des centres de recombinaison non radiative (NRC) et facilitant la recombinaison radiative des excitons dans les QW InGaN/GaN [5,6,7,8,9,10]. La fluctuation de la composition de l'indium dans les QW InGaN/GaN a un impact significatif sur les comportements des dispositifs, par exemple, l'efficacité quantique interne (IQE), l'efficacité quantique externe (EQE) et les caractéristiques courant-tension. La fluctuation de l'indium dans les QW InGaN/GaN doit être prise en compte pour avoir de meilleures explications sur les performances des dispositifs [11]. Les QW InGaN/GaN avec des QB dopés Si ont montré les propriétés de modifications de la nanostructure matérielle et des formations d'îlots nanométriques dues à la croissance en spirale des couches QW [12], la promotion de la stabilité thermique des QW InGaN/GaN [13], amélioration de la puissance de sortie lumineuse et des comportements de décharge électrostatique (ESD) de la LED à mesure que la concentration de dopage dans les QB augmente [14], blocage facile du transport des porteurs de trous conduisant à la recombinaison des excitons au niveau des puits entre le GaN de type p (p-GaN ) et les barrières dopées [15], etc.
Les périodes et l'épaisseur favorables des QW InGaN/GaN pour une luminosité élevée et une EQE élevée sous un courant d'injection élevé (supérieur à plusieurs dizaines de mA) de LED bleues sont rapportées [16,17,18]. Dans les rapports, neuf périodes de QW InGaN/GaN cultivées sur des substrats de saphir à motifs (PSS) montrent une amélioration significative de la puissance d'émission lumineuse et des propriétés d'affaissement de l'EQE [16]. Les meilleures performances optiques et électriques des LED bleues sont démontrées si la région active est constituée de 12 périodes de QW InGaN/GaN au courant d'injection de 42 A/cm 2 [17]. La réduction apparente du statisme EQE et l'amélioration de l'IQE sont démontrées pour l'épaisseur de QB réduite de 24,5 à 9,1 nm dans les résultats de simulation des LED InGaN/GaN [18]. Le dopage Si dans l'épaisseur et le nombre de QB appropriés dans les QW InGaN/GaN est crucial pour une meilleure promotion de la luminosité et de l'efficacité des LED bleues InGaN fonctionnant à un courant d'injection élevé. Dans ce rapport, nous présentons les caractéristiques optiques, électriques et matérielles d'In0.2 à huit périodes Ga0,8 QW N/GaN avec les deux à cinq premiers QB de la séquence de croissance possédant un dopage Si des LED bleues. Les résultats donnent un aperçu plus approfondi des mécanismes de localisation des porteurs, du potentiel de confinement et du QCSE des QW sur les comportements de luminescence des LED bleues sous un courant d'injection élevé.
Méthodes expérimentales
La figure 1 représente l'illustration schématique des structures de couches de matériaux d'échantillons de LED bleues. Les épicouches sont déposées par un réacteur horizontal d'un système de dépôt chimique en phase vapeur métal-organique à basse pression (LP-MOCVD) sur des PSS à orientation (0001) (plan c). Le diamètre, la hauteur et l'intervalle des structures pyramidales régulières sur les PSS sont respectivement de 2, 1,5 et 1 μm. Les PSS ont une épaisseur de 3 μm et sont préchauffées à 1150 °C dans l'ambiance d'hydrogène avant la croissance des épicouches. Triméthylgallium (TMGa), triméthylindium (TMIn), triméthylaluminium (TMAl) et NH3 gazeux sont utilisés comme précurseurs en phase vapeur du gallium élémentaire (Ga), de l'In, de l'aluminium (Al) et de l'azote (N), respectivement. Silane (SiH4 ) et bis-cyclopentadiényl magnésium (Cp2 Mg) sont des précurseurs du dopant Si et du magnésium (Mg) dans les substances de type n et p, respectivement. Les gaz vecteurs des précurseurs sont le mélange d'hydrogène (H2 ) et l'azote (N2 ) avec le rapport 1:1 qui est chimiquement non réactif.
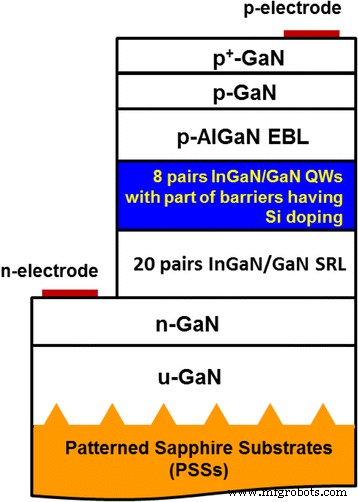
Diagramme schématique des structures de couches de puces LED bleues fabriquées. Ces dessins schématiques des épaisseurs de couche épitaxiale sont exagérés pour plus de clarté et ne sont pas à l'échelle
Une couche tampon de GaN non dopé (u-GaN) puis de GaN de type n dopé Si (n-GaN) d'une épaisseur de 3 et 3,3 μm sont développées sur des PSS. La concentration de dopage de n-GaN est de 10 19 cm −3 . Vingt paires de In0,02 Ga0.98 Des superréseaux N/GaN d'épaisseur 2/2 nm sont ensuite déposés sur n-GaN. Il joue le rôle de couches de soulagement des contraintes (SRL), qui sont utilisées pour réduire l'extension de la contrainte des épicouches sur les PSS.
Les couches actives de LED bleues contiennent des In0.2 à huit périodes Ga0,8 QW N/GaN. Les épaisseurs de QW et QB sont de 2,5 et 8 nm avec une température de croissance de 750 et 900 °C, respectivement. Si dopage avec une concentration d'environ 3 × 10 17 cm −3 dans les deux, trois, quatre et cinq premiers QB dans la séquence de croissance est nommé comme échantillons A, B, C et D, respectivement. p-type Al0.16 Ga0.84 La couche de blocage d'électrons N (EBL) a une épaisseur de 20 nm et croît à 950 °C avec un dopage au Mg. Couche de fenêtre p-GaN et p + -La couche de contact GaN est cultivée à 950 °C avec une épaisseur de 100 et 20 nm, et les concentrations de dopage sont de 10 19 et 10 20 cm −3 .
Les épicouches sont gravées sélectivement sur la couche n-GaN par un système à plasma à couplage inductif (ICP) pour former une LED à structure mesa. La couche de contact transparente (TCL) d'oxyde d'étain indium (ITO) est déposée sur le p + -GaN surface par un évaporateur à faisceau d'électrons. Les couches d'électrodes de contact multi-métaux chrome/platine/or (Cr/Pt/Au) sont ensuite évaporées sur le p + -Couches GaN et n-GaN pour un bon contact ohmique. Les plaquettes LED sont rodées et polies jusqu'à environ 120 μm pour le découpage des puces. Appareils à LED standard de type mesa avec une puce carrée de 1 mm 2 sont produits.
Le courant en fonction de la tension (I -V ) les courbes et la puissance lumineuse (P sortie ) en fonction du courant d'injection (L -Je ) des courbes de 20 à 300 mA à température ambiante (RT) de diodes sont mesurées. Spectres de photoluminescence (PL) dépendant de la température de In0,2 à huit périodes Ga0,8 Les QW N/GaN sont examinés. La source lumineuse d'excitation du PL est un laser He-Cd (325 nm) avec une puissance moyenne de 45 mW. Les images de microscopie électronique à transmission à haute résolution (HRTEM) sont prises à partir d'un microscope électronique à transmission à émission de champ (FE-TEM) EM-3000F avec une tension d'accélération de 300 kV et une résolution de 0,14 nm.
Résultats et discussion
La figure 2 trace les spectres PL d'échantillons à différentes températures de 10 à 300 K. La diminution monotone de l'intensité du pic PL avec l'augmentation de la température peut être observée. Ceci est dû à l'augmentation du processus de recombinaison non radiative avec l'augmentation de la température. Tous les profils spectraux de PL sont ajustés par des fonctions de forme de raie gaussienne pour trouver les variations de l'énergie maximale du pic avec la température, comme le montre la figure 3. L'énergie maximale du pic d'émission de PL pour l'In0,2 non dopé Ga0,8 N/GaN QWs est de 2,68 eV à température ambiante. Cela signifie que les énergies de crête PL des échantillons avec les deux à cinq premiers QB ayant un dopage Si présentent un décalage vers le bleu lorsqu'il est comparé à celui non dopé. Les deux à cinq premiers QB avec dopage Si peuvent réduire efficacement le QCSE en QW. Il convient de souligner que les utilisations de PSS et SRL dans les structures d'épicouches peuvent réduire la part de champ piézoélectrique (PZ) ainsi que QCSE en In0.2 Ga0,8 QW N/GaN.

Spectres PL d'échantillons dépendant de la température à différentes températures de 10 à 300 K

Variations de l'énergie maximale du pic PL en fonction de la température des échantillons. Les courbes les mieux ajustées à l'aide de l'équation de Varshni sont affichées en traits pleins épais et noirs
Sur la figure 3, les variations de l'énergie maximale du pic PL en fonction de la température qui présentent des courbes en forme de S de tous les échantillons peuvent être représentées. Les courbes en forme de S affichent un décalage initial vers le rouge puis le bleu puis le rouge avec l'augmentation de la température. Ce comportement est attribué à la luminescence collective dépendante de la température de forts excitons localisés dans les QW. L'équation empirique de Varshni illustrée ci-dessous peut être utilisée pour ajuster la plage de décalage du bleu au rouge des variations en forme de S [19,20,21].
$$ {E}_{\mathrm{g}}(T)={E}_{\mathrm{g}}(0)-\frac{\alpha {T}^2}{\gauche(T-\ bêta \right)}-\frac{\sigma^2}{k_{\mathrm{B}}T} $$ (1)où E g (0), α , β , et σ sont les paramètres d'ajustement. E g (0) est l'énergie de bande interdite de QW à la température absolue 0 K. α et β sont les coefficients thermiques qui sont des paramètres dépendants du matériau. σ est le paramètre d'élargissement gaussien, et il reflète physiquement le degré de distribution thermique des porteurs dans les états localisés en queue de bande. Le deuxième terme de l'équation. (1) indique que l'énergie de la bande interdite des semi-conducteurs a tendance à diminuer avec l'augmentation de la température et elle est connue sous le nom de rétrécissement de la bande interdite en raison de l'augmentation de l'amplitude des vibrations atomiques. Le troisième terme est utilisé pour caractériser le degré de localisation des porteurs avec la température sous l'hypothèse d'une distribution des porteurs non dégénérée et d'une densité d'état localisée de type gaussien. Une forte localisation des porteurs est un aspect crucial pour réaliser l'augmentation de la recombinaison radiative et de l'IQE dans les QW d'InGaN en raison de l'amélioration du chevauchement entre les fonctions d'onde des électrons et des trous. L'équation de Varshni n'est pas applicable dans la plage de décalage vers le rouge de l'énergie de crête PL à basse température, en raison de la forte dégénérescence de la distribution des porteurs. Les meilleurs résultats d'ajustement des échantillons sont illustrés par des courbes pleines épaisses et noires sur la figure 3. L'énergie de localisation des échantillons A, B, C et D est de 24, 28, 41 et 13 meV, respectivement. L'échantillon C possède la plus grande énergie de localisation, σ (41 meV). La localisation des porteurs dans les QW avec quatre QB dopés Si est plus forte que les autres. La plus petite énergie de localisation (σ ) se produit dans l'échantillon D avec la valeur 13 meV.
Courant-tension (I -V ) les caractéristiques sous polarisation directe et inverse des LED bleues sont illustrées à la Fig. 4. Dans cette figure, les tensions d'activation pour les échantillons A, B, C et D sont de 3,41, 3,47, 3,27 et 4,03 V au courant direct 20 mA, respectivement. Les tensions de claquage pour les échantillons A, B, C et D sont de − 8.85, − 9.99, − 6.77 et − 11.55 V au courant inverse 1 μA, respectivement. L'échantillon C a les tensions d'activation et de claquage les plus faibles. L'échantillon D a les tensions d'activation et de claquage les plus élevées. En conséquence, une hauteur de barrière inférieure des QB est suggérée dans l'échantillon C. Un potentiel de confinement doux (lisse) des QW est attendu dans l'échantillon avec les quatre premiers QB ayant un dopage Si. Le profil de potentiel de confinement doux implique que les décalages de bande de conduction et de valence des QW ne sont pas considérés comme des fonctions à pas net, c'est-à-dire un potentiel de confinement non rectangulaire. Des potentiels de confinement lisses peuvent supprimer dans une large mesure la recombinaison Auger et empêcher l'accumulation de nombreux porteurs dans les premiers puits dans la direction d'injection des QW InGaN/GaN [22,23,24]. Un potentiel de confinement régulier peut également être obtenu par une diminution linéaire de la composition en In le long de la direction de croissance des QW InGaN/GaN. Cela peut avoir une meilleure répartition des porteurs parmi les QW et le transport des trous, ce qui entraîne une amélioration de la baisse rapide de l'EQE et de la puissance de sortie lumineuse [25,26,27,28,29,30].
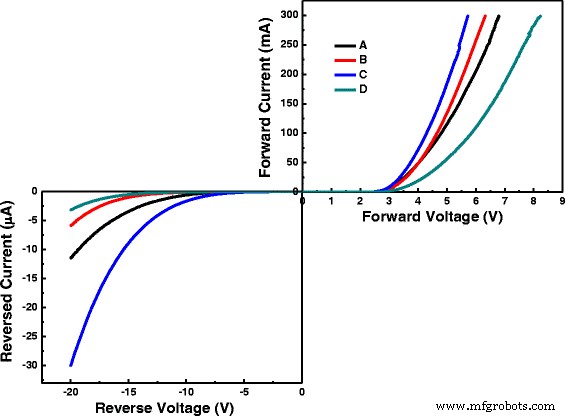
Courant-tension (I -V ) courbes sous polarisations directe et inversée des diodes
La figure 5 montre les mesures de la puissance de sortie lumineuse (P sortie ) des LED en fonction du courant d'injection (L -Je ) courbe de 0 à 300 mA par un testeur de puce. L'augmentation du P sortie avec l'augmentation du courant d'injection de L -Je des courbes peuvent être observées. Le P le plus élevé et le plus bas sortie pour un courant d'injection élevé sont indiqués dans les échantillons C et D, respectivement. Saturations de P sortie au courant d'injection 300 mA sont indiqués dans tous les échantillons à l'exception de l'échantillon C. Effet de saturation de P sortie se réfère au courant débordant des QW. Le moins de courant débordant les QW a lieu dans le potentiel de confinement doux des QW et la localisation forte des porteurs à l'intérieur de l'échantillon QW. Une meilleure répartition des porteurs parmi huit QW et une forte recombinaison radiative des porteurs à l'intérieur des QW sont affichées dans l'échantillon avec quatre QB contenant du dopage Si.

Puissance de sortie lumineuse (P sortie ) en fonction du courant d'injection (L -Je ) courbes de 0 à 300 mA de diodes
Les images en fond noir, en fond clair et en fond clair agrandies du microscope électronique à transmission à haute résolution (HRTEM) en coupe transversale d'échantillons sont montrées sur les Figs. 6, 7 et 8. Sur la figure 6, les contrastes clairs et sombres correspondent aux épicouches d'InGaN et de GaN. Huit périodes de QW et 20 paires de super-réseaux peuvent être observées. Sur la figure 7, les variations de contraste sombre représentent les fluctuations du contenu local en In et la formation d'amas riches en indium dans les QW [31,32,33,34]. Les amas riches en indium agissent comme des états localisés relativement profonds de porteurs conduisant à une recombinaison excitonique radiative élevée. Une distorsion du réseau et des défauts de défaut d'empilement sont notés autour de ces amas riches en indium, indiquant que l'énergie de déformation s'est partiellement relâchée dans la couche d'InGaN, comme le montre l'image zoomée du carré rouge de la figure 8a. Par rapport aux images agrandies à fond clair, des interfaces plus diffusives (non abruptes) de QW dans les échantillons C et D sont visibles, comme le montrent les Fig. 8c, d. L'agent provient de l'interdiffusion bien connue des atomes In et Ga à l'interface puits/barrière. Un très faible confinement et une localisation des porteurs des QW se sont produits dans l'échantillon D, ce qui est conforme au pire comportement optoélectronique de cet échantillon. Dans les images, les dislocations de filetage (TD) ne se forment pas dans tous les échantillons. Les CNR se produisent principalement sur les sites de la TD. Une meilleure qualité des épicouches est montrée dans ces échantillons comme prévu en raison de l'utilisation de PSS et de SRL [35,36,37]. Quatre QB avec dopage Si dans des QW à huit périodes sont la condition favorable pour modifier le potentiel de confinement pour atteindre le potentiel de confinement doux des QW InGaN/GaN, conduisant aux meilleures performances optoélectroniques de la LED bleue.
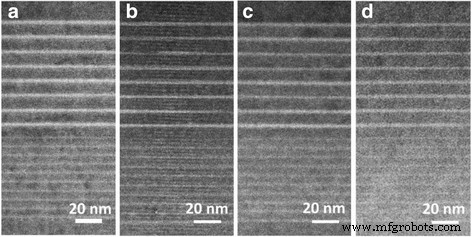
Images en fond noir des échantillons. un Échantillon A. b Échantillon B. c Échantillon C. d Exemple D
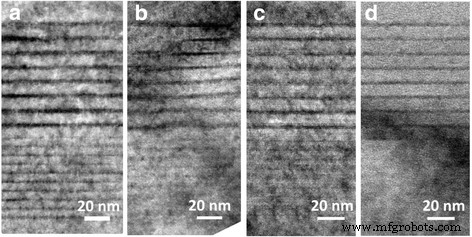
Images en fond clair des échantillons. un Échantillon A. b Échantillon B. c Échantillon C. d Exemple D
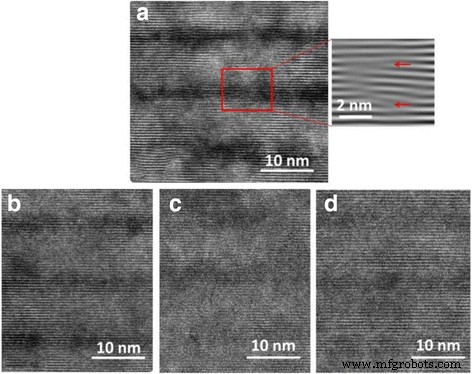
Images agrandies à fond clair des échantillons. un Échantillon A. b Échantillon B. c Échantillon C. d Exemple D
Conclusions
Spectres PL dépendant de la température, I -V courbes, L -Je courbes et images HRTEM de LED bleues avec In0.2 à huit périodes Ga0,8 Les QW N/GaN ayant les deux à cinq premiers QB dans la séquence de dépôt contenant du dopage Si ont été étudiés. Les résultats démontrent que l'échantillon avec les quatre premiers QB contenant du dopage Si a une hauteur de barrière relativement plus faible et une plus grande énergie de localisation des porteurs, ce qui est mis en évidence par les interfaces de diffusion des QW dans les images HRTEM. Le potentiel de confinement doux des QW accompagné d'une localisation plus forte des porteurs à l'intérieur des QW donne lieu à une distribution plus uniforme des porteurs parmi huit QW et à une recombinaison radiative plus élevée des porteurs à l'intérieur des QW dans cet échantillon. Une diminution des processus Auger et des fuites de porteurs ainsi qu'une augmentation de la recombinaison radiative des QW se sont produites dans les LED bleues avec quatre QB dopés au Si sous un courant d'injection élevé. Les résultats fournissent des conditions optimales de QB avec dopage Si grâce à l'analyse des effets de la localisation des porteurs, du potentiel de confinement, du champ PZ et des nanostructures de matériaux sur les propriétés de luminescence de In0.2 Ga0,8 QW N/GaN des LED bleues.
Abréviations
- Al :
-
Aluminium
- Cp2 Mg :
-
Bis-cyclopentadiényl magnésium
- EBL :
-
Couche de blocage d'électrons
- EQE :
-
Efficacité quantique externe
- FE-TEM :
-
Microscope électronique à transmission à émission de champ
- Ga :
-
Gallium
- HRTEM :
-
Microscopie électronique à transmission haute résolution
- ICP :
-
Plasma à couplage inductif
- Dans :
-
Indium
- IQE :
-
Efficacité quantique interne
- ITO :
-
Oxyde d'indium-étain
- Je -V :
-
Courant par rapport à la tension
- L -Je :
-
Puissance lumineuse en fonction du courant d'injection
- LP-MOCVD :
-
Dépôt chimique en phase vapeur métal-organique à basse pression
- Mg :
-
Magnésium
- N :
-
Azote
- n-GaN :
-
GaN de type n
- NRC :
-
Centres de recombinaison non radiative
- PL :
-
Photoluminescence
- PSS :
-
Substrats en saphir à motifs
- PZ :
-
Piézoélectrique
- QB :
-
Barrières quantiques
- QCSE :
-
Effet Stark confiné quantique
- Questions-réponses :
-
Puits quantiques
- RT :
-
Température ambiante
- Si :
-
Silicium
- SiH4 :
-
Silane
- SRL :
-
Couches de décharge de traction
- TCL :
-
Couche de contact transparente
- TMAl :
-
Triméthylaluminium
- TMGa :
-
Triméthylgallium
- TMIn :
-
Triméthylindium
- u-GaN :
-
GaN non dopé
Nanomatériaux
- 5G et GaN :le passage du LDMOS au GaN
- Le réarrangement atomique de plusieurs puits quantiques à base de GaN dans du gaz mixte H2/NH3 pour améliorer les propriétés structurelles et optiques
- Impact des états de surface et de la fraction molaire d'aluminium sur le potentiel de surface et 2DEG dans les HEMT AlGaN/GaN
- Émission multicolore de la structure nanopyramide quasi-cristalline photonique à base de GaN ultraviolet avec plusieurs puits quantiques semipolaires InxGa1−xN/GaN
- Analyse de la réflectance infrarouge de couches de GaN dopées épitaxiales de type n cultivées sur du saphir
- Points quantiques de bismuth dans des puits quantiques recuits GaAsBi/AlAs
- Percer la largeur de canaux multi-mesa limitée des HEMTs GaN normalement désactivés grâce à la modulation de la longueur de trou de passage
- Étude sur la polarisation de surface de l'hétérostructure GaN/AlGaN/GaN coiffée d'Al2O3 par spectroscopie photoélectronique à rayons X à résolution angulaire
- Comprendre le mécanisme de croissance des couches épitaxiales de GaN sur du graphite exfolié mécaniquement



