Morphologie, structure et propriétés optiques des films semi-conducteurs avec des nano-îlots GeSiSn et des couches tendues
Résumé
Les dépendances de l'épaisseur de transition critique de croissance bidimensionnelle à tridimensionnelle (2D-3D) sur la composition des films de GeSiSn avec une teneur en Ge fixe et une teneur en Sn de 0 à 16% à la température de croissance de 150 °С ont été obtenues . Les diagrammes de phase du changement de superstructure au cours de la croissance épitaxiale de Sn sur Si et sur Ge(100) ont été construits. En utilisant les données du diagramme de phase, il devient possible d'identifier la couverture de Sn sur la surface de Si et de contrôler la ségrégation de Sn sur la superstructure observée sur le diagramme de diffraction électronique à haute énergie en réflexion (RHEED). Les structures multicouches avec les couches pseudomorphes GeSiSn et le réseau d'îlots d'une densité jusqu'à 1,8 × 10 12 cm −2 ont été développées en tenant compte de la suppression de la ségrégation du Sn par la diminution de la température de croissance du GeSiSn et du Si. La superstructure à double domaine (10 × 1) liée à la présence de Sn en surface a d'abord été observée dans les structures périodiques multicouches lors de la croissance de Si sur la couche de GeSiSn. Les structures périodiques GeSiSn/Si ont démontré la photoluminescence dans la plage de 0,6 à 0,85 eV correspondant à la plage de longueurs d'onde de 1,45 à 2 μm. Le calcul du diagramme de bande pour la structure avec le Ge0.315 pseudomorphique Si0.65 Sn0,035 couches permet de supposer que les pics de photoluminescence correspondent aux transitions interbandes entre le X vallée en Si ou le Δ4 -valley dans GeSiSn et la sous-bande de trous lourds dans la couche GeSiSn.
Contexte
Les dispositifs électroluminescents efficaces n'ont pas été présentés car Si est le semi-conducteur avec la bande interdite indirecte, bien que les dispositifs photoniques au silicium, tels que les guides d'ondes [1], les photodétecteurs [2] et les modulateurs [3] aient été créés avec succès.
L'addition de Sn dans la matrice de Ge, Si ou solution solide de GeSi est l'une des approches pour obtenir le semi-conducteur à bande interdite directe qui est basée sur les matériaux du groupe IV. L'inclusion de Sn dans le réseau Ge réduit la différence entre les minima de Г et L vallées, et GeSn peut devenir un matériau de bande interdite directe. Comme il a été montré, le caractère direct du réseau cubique GeSn apparaît à une teneur en Sn d'environ 9 % [4, 5]. Cette valeur peut être inférieure à 6 % en présence de la déformation en traction, alors que pour les films avec déformation en compression, la transition peut être attendue pour une teneur en Sn supérieure à 11 % [6]. La réduction de la bande interdite due à l'inclusion de Sn permet d'augmenter la longueur d'onde de fonctionnement de la gamme infrarouge proche à moyenne, ce qui est souhaitable dans le domaine des interconnexions optiques, dans les systèmes de communication à fibre optique de nouvelle génération, les capteurs, le traitement du signal, la conversion d'énergie et dispositifs de stockage optique [7]. Par conséquent, au cours des dernières années, l'intérêt pour la classe des matériaux Ge-Si-Sn a considérablement augmenté.
De gros efforts sont mis en commun pour obtenir les films épitaxiés de GeSn de qualité instrumentale [8, 9]. L'un des problèmes graves est la formation d'inclusions de Sn (précipités) pendant la croissance de la couche de GeSn [10, 11]. En plus de la précipitation, la ségrégation du Sn est observée dans le processus de croissance de la couche de GeSn, de GeSiSn et d'oxydation du film de GeSn [11, 12]. Les techniques de croissance hors équilibre, telles que l'épitaxie par faisceau moléculaire (MBE) et le dépôt chimique en phase vapeur (CVD), servent à des méthodes fiables de suppression de la précipitation et de la ségrégation. Pour réduire l'effet de la précipitation et de la ségrégation de Sn, la diminution de la température de croissance [13] ou la déformation inclusion, ou l'ajout du troisième élément, par exemple, Si, qui réduit la contrainte locale autour des atomes de Sn, peut être effectué.
Les données sur la morphologie et la structure de surface ou sur les mécanismes de formation des films monocristallins de GeSiSn sont pratiquement introuvables dans la littérature, malgré une grande promesse des matériaux à base de composés du groupe IV. Ces données sont nécessaires à la création de nanohétérostructures avec des couches de GeSiSn contraintes et relaxées. Dans cet article, les données liées à la création de structures multicouches, des super-réseaux non seulement avec des couches pseudomorphes de GeSiSn mais aussi avec des nano-îlots de GeSiSn, sont d'abord démontrées, et elles ne contiennent pas de dislocations et permettent de faire varier la largeur de bande interdite du matériau dans une large gamme. et couvrent la gamme de longueurs d'onde infrarouges auparavant indisponibles pour GeSi.
Le but de cet article est d'étudier la croissance d'un film de GeSiSn pseudomorphe sous contrainte élastique, la formation de nano-îlots tridimensionnels et d'obtenir les structures périodiques multicouches contenant des couches et des nano-îlots pseudomorphes de GeSiSn.
Dans nos articles précédents [14,15,16], les diagrammes cinétiques de l'état morphologique du film de GeSiSn ont été construits pour divers écarts de paramètres de réseau entre GeSiSn et Si dans la plage de teneur en Sn de 0 à 8% en utilisant la diffraction d'électrons à haute énergie en réflexion ( RHEED). Cet article inclut de nouvelles dépendances critiques d'épaisseur de transition de croissance bidimensionnelle à tridimensionnelle (2D-3D) sur la composition du film GeSiSn avec une teneur en Ge fixe dans la plage de teneur en Sn de 0 à 16%. Les diagrammes de phase du changement de superstructure au cours de la croissance de Sn sur Si et Ge(100) ont été obtenus. Malgré le fait que dans [17,18,19], des reconstructions de surface de Sn sur Si ont été étudiées au niveau des différentes couvertures d'étain, nos données ont démontré de nouvelles superstructures. De plus, le diagramme de phase du changement de superstructure au cours de la croissance de Sn sur Ge(100) n'a été présenté nulle part auparavant. Les propriétés optiques de structures périodiques multicouches incluant des couches pseudomorphes de GeSiSn ont d'abord été étudiées par la méthode de photoluminescence pour des échantillons avec différentes teneurs en Sn. Le calcul du diagramme de bandes des hétérostructures GeSiSn/Si a été réalisé en utilisant l'approche de la théorie des solides modèles [20].
Expérimental
Tous les échantillons avec des couches de GeSiSn pseudomorphes et avec des nano-îlots de GeSiSn ont été cultivés dans des conditions de vide ultra-élevé 10 -7 –10 −8 Pa sur l'équipement d'épitaxie par faisceau moléculaire (MBE) "Katun C." La chambre de croissance épitaxiale comprend l'évaporateur à faisceau d'électrons pour le Si et les cellules d'effusion de Knudsen pour le Ge et le Sn. Le taux de croissance de la couche GeSiSn a varié de 0,015 à 0,05 nm/s. La croissance épitaxiale a été réalisée sur des substrats Si(100) dans la plage de température de 150 à 450 °С avec une teneur en Sn de 0 à 20 %. Non seulement des couches simples de GeSiSn mais aussi des structures périodiques multicouches, contenant des hétérojonctions GeSiSn/Si, ont été obtenues. Au début, la couche de GeSiSn a été déposée, qui a ensuite été recouverte d'une couche de Si de 10 nm à une température de croissance de 400 à 500 °С. La principale technique de contrôle des changements de morphologie et de structure de surface et d'étude des mécanismes de croissance était la réflexion de la diffraction électronique à haute énergie (RHEED). Le motif RHEED a été enregistré sur une caméra vidéo pendant la croissance. Ensuite, un profil, ainsi que l'une des directions cristallographiques, a été choisi, et les changements d'intensité de ce profil en coordonnées spatio-temporelles ont été créés. L'analyse de la distribution de l'intensité spatio-temporelle RHEED nous a permis d'étudier les mécanismes de la croissance bidimensionnelle, les changements de superstructure et la formation d'îlots tridimensionnels. Le moment de la transition de la croissance bidimensionnelle à la croissance tridimensionnelle (transition 2D-3D) a été déterminé à partir de la dépendance temporelle de l'intensité du motif RHEED avec l'un des bâtonnets dans la direction desquels le réflexe de volume apparaît. Les dépendances de l'épaisseur critique de transition 2D-3D sur la teneur en GeSiSn avec une teneur en Ge fixe ont été créées sur la base de la méthode de détermination de la transition 2D-3D. Sur la base de ces dépendances, l'épaisseur de la couche pseudomorphique GeSiSn a été définie dans des structures multicouches et des couches avec un réseau de nano-îlots GeSiSn ont été créées. La morphologie et la structure de surface ont été analysées par microscopie à effet tunnel (STM) sur un équipement à ultravide Omicron-Riber. Les propriétés optiques de l'échantillon ont été étudiées par spectroscopie de photoluminescence (PL) à l'aide d'un monochromateur ACTON 2300i et d'un détecteur OMA-V refroidi basé sur le réseau de photodiodes InGaAs avec une bande de sensibilité de 1,1 à 2,2 μm. Pour exciter la photoluminescence, le rayonnement laser Nd:YAG (532 nm) a été utilisé.
Résultats et discussion
La croissance du film mince de GeSiSn à la température de 150 °С dans la plage de teneur en Sn de 0 à 16% a été étudiée. L'accumulation de contrainte se produit pendant le dépôt de la couche de GeSiSn causée par le décalage entre le paramètre de réseau GeSiSn et Si. La transition de transition 2D-3D est observée à une certaine épaisseur. La procédure de détermination de la transition 2D-3D sur l'exemple du Ge0.6 Si0.28 Sn0.12 la croissance est présentée sur la Fig. 1. Il existe les modèles RHEED initiaux de la surface Si avant le Ge0.6 Si0.28 Sn0.12 dépôt de film (Fig. 1a), le motif RHEED final (Fig. 1c) formé par le Ge0.6 Si0.28 Sn0.12 réseau d'îles et la couche de mouillage, ainsi que la distribution d'intensité spatio-temporelle du profil vertical indiqué par la flèche sur la Fig. 1a et la dépendance de l'intensité du profil horizontal (profil horizontal indiqué sur la distribution d'intensité spatio-temporelle de la Fig. 1b) sur le Ge0.6 Si0.28 Sn0.12 épaisseur du film (Fig. 1b). Le moment de transition 2D-3D a été déterminé en traçant la tangente au tracé d'intensité sur l'épaisseur (Fig. 1b) dans la région d'une forte augmentation d'intensité. Une telle approche est généralement acceptée [21].
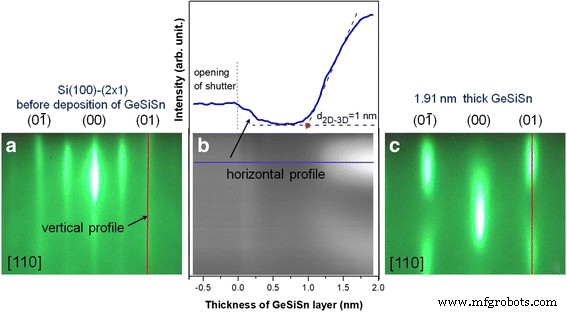
Détermination du moment de transition 2D-3D pendant la croissance du film GeSiSn :a Motif RHEED de la surface Si(100)-(2 × 1) avant le Ge0.6 Si0.28 Sn0.12 la croissance est affichée, b la distribution d'intensité spatio-temporelle du profil vertical dans l'échelle de gris et la dépendance en intensité du profil horizontal sur le Ge déposé0.6 Si0.28 Sn0.12 épaisseur du film. Les profils sont indiqués par les flèches en (a ) et (b ), et c le motif RHEED final après le Ge0,6 d'épaisseur 1,91 nm Si0.28 Sn0.12 dépôt
Les dépendances de l'épaisseur critique de transition 2D-3D sur la composition pour les films de GeSiSn avec une teneur en Ge fixe et une teneur en Sn de 0 à 16% sont construites (Fig. 2) en utilisant la technique de transition 2D-3D décrite ci-dessus. Auparavant, les diagrammes cinétiques de l'état morphologique des films de GeSiSn dans la plage de températures de 150 à 450 °С, à un décalage de réseau différent entre GeSiSn et Si, ont été publiés [14]. Sur la base de l'analyse du diagramme cinétique, la température optimale de 150 °С a été déterminée, à laquelle l'épaisseur critique de transition 2D-3D atteint sa valeur maximale et la ségrégation Sn est supprimée. La valeur de l'épaisseur du film GeSiSn en dessous de la courbe correspondant à l'épaisseur critique de transition 2D-3D sur la température et la composition détermine la région d'existence des films pseudomorphes. La diminution de l'épaisseur critique de transition 2D-3D, avec l'augmentation de la teneur en Sn de 0 à 16% est observée sur les courbes (Fig. 2). Un tel comportement s'explique par l'effet de contrainte. L'augmentation de la teneur en Sn de 0 à 16%, par exemple, le Ge0.6 Si0.28 Sn0.12 croissance, se traduit par l'augmentation de l'inadéquation des paramètres de réseau entre Ge0.6 Si0.28 Sn0.12 et Si de 2,5 à 5,6 %, respectivement, et en réduisant le temps et, par conséquent, l'épaisseur de transition vers les nano-îlots tridimensionnels. La nature de la caractéristique qui apparaît sur la courbe avec la teneur en Ge de 30 % et est observée à la teneur en Sn de 3 à 10 % jusqu'au bout n'est absolument pas claire. Connaissant l'amplitude de l'épaisseur critique de transition 2D-3D, il est possible d'obtenir les films de GeSiSn pseudomorphes et de les utiliser dans les structures périodiques multicouches avec l'hétérojonction GeSiSn/Si. Dans nos expériences, la précision de la détermination de l'épaisseur critique de transition 2D-3D est de 0,06 nm et elle est principalement déterminée par l'imprécision du maintien du débit de Si en raison de l'instabilité du fonctionnement de la source.
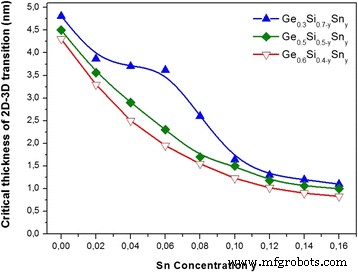
Les dépendances critiques de l'épaisseur de transition 2D-3D sur la composition du film GeSiSn à plusieurs valeurs fixes de teneur en Ge, teneur en Sn de 0 à 16% et à la température de croissance de 150 °С
Le choix de l'épaisseur de couche pseudomorphique sur la base des diagrammes cinétiques obtenus précédemment [16] et les dépendances de l'épaisseur critique de transition 2D-3D sur la composition (Fig. 2) permettent de faire croître non seulement des couches individuelles de GeSiSn mais aussi en utilisant ces couches dans des structures périodiques multicouches. Dans la structure périodique GeSiSn/Si, où la couche GeSiSn est recouverte par la couche Si, le problème se pose en raison de la ségrégation Sn sur la surface Si. La ségrégation de Sn conduit à la reconstruction de surface et à l'apparition de toute la série de superstructures en fonction de la concentration de surface en Sn. L'étude de la reconstruction de surface lors de la croissance de Sn sur Si(100) et Ge(100) a été nécessaire afin de comprendre quel revêtement de Sn correspond à la superstructure observée dans l'image RHEED. Les diagrammes de phase du changement de la superstructure ont été construits dans la plage de température de 100 à 750 °С. Un diagramme similaire pour la croissance de Sn sur Si(100) a été présenté pour la première fois dans [17]. Ueda et al. déposé du Sn à température ambiante suivi d'un recuit. Ils n'ont observé la superstructure qu'après recuit du film. Dans nos expériences, Sn a été déposé à la température de 100 °С et il a été obtenu sur la surface Si(100–(2 × 1) reconstruite. L'augmentation de la température jusqu'à 750 °С a entraîné la formation de la série de superstructures sur le surface (Fig. 3). L'effet de position des atomes de Sn adsorbés sur la surface Si (100) sur l'énergie de liaison Sn-Si a été étudié par la spectroscopie photoélectronique dans [18]. La diminution de l'énergie de liaison Sn-Si a été observée avec la Augmentation de la couverture de Sn. Ainsi, toutes les reconstructions, qui se produisent lors de la croissance de Sn sur Si(100), peuvent s'expliquer par une diminution de l'énergie du système de surface. La transition vers la croissance tridimensionnelle est associée à l'accumulation de déformations dues à l'inadéquation des paramètres de maille entre Sn et Si de 19 %. L'apparence du film polycristallin a été observée dans [17] au film épais de 3,2 ML (monocouche) de Sn. La formation du film polycristallin est causée par une faible température de dépôt du film de Sn. Le même raisonnement est lié au Sn croissance sur la surface Ge(100). À l'heure actuelle, les contributions sur les superstructures Sn sur Ge(100) n'ont pas été rapportées dans la littérature.

Diagrammes de phases de l'évolution de la superstructure au cours de la croissance :a Sn sur Si(100) et b Sn sur Ge(100)
Les superstructures indiquées dans les diagrammes apparaissent à la fois avec l'augmentation et la diminution de la température. Ces diagrammes de phases permettent de déterminer la concentration de Sn en surface lors de la croissance de Si sur la couche de GeSiSn. Les superstructures apparaissant à la surface du Si au cours de la croissance périodique de la structure peuvent être observées à des températures qui diffèrent des températures présentées dans les diagrammes de phases. La couche de Si est déposée sur la surface de GeSiSn à des températures de 400 à 500 °С ; cependant, les superstructures qui sont caractéristiques pour l'ensemble de la plage de température présentée sur la figure 3 peuvent apparaître. La création de la structure avec des hétérojonctions GeSiSn/Si nécessite d'empêcher la formation de la superstructure à deux domaines (5 × 1), qui est associée à la ségrégation Sn et à l'obstruction dans la formation de la structure périodique multicouche avec les couches pseudomorphes (Fig. 4a ). La façon la plus simple de supprimer la ségrégation de Sn au niveau de la croissance de Si sur la couche de GeSiSn est la croissance de Si en deux étapes. La première étape implique le dépôt d'une couche de Si de 1 à 2 nm d'épaisseur à température ambiante. La poursuite de la croissance du Si se poursuit à une température de 400 à 500 °С. Cette température est déterminée par la teneur en Sn de la couche de GeSiSn. Les principales séries de superstructures qui se produisent lors de la croissance du Si sur la couche de GeSiSn dans les structures périodiques multicouches sont constituées de (2 × 1) + (2 × N), c(8 × 4), (4 × 1), (6 × 1) , et (5 × 1). De plus, la superstructure à deux domaines (10 × 1) est observée à la surface du Si (Fig. 4b). Cette superstructure n'apparaissait pas dans les expériences à la croissance de Sn sur Si et Ge, mais on peut dire qu'elle correspond au revêtement minimum de Sn puisqu'elle disparaît lors d'un court recuit à une température de 400–500 °С et le (2 × 1) une superstructure apparaît, caractéristique de la surface Si.

Superstructures observées à la croissance de Si sur la couche de GeSiSn dans la structure périodique multicouche dans la direction azimutale [110] :a (5 × 1) et b (10 × 1)
Des structures périodiques, contenant des couches pseudomorphiques ou un réseau de nano-îlots GeSiSn, ont été obtenues. En utilisant les diagrammes cinétiques de l'état morphologique du film GeSiSn, un réseau d'îlots GeSiSn dans la structure périodique multicouche a été étudié. Les photos STM de Ge0.75 Si0.2 Sn0,05 surface avec le réseau de nano-îlots dans la première (Fig. 5a) et dans la cinquième période (Fig. 5b) avec une taille de balayage de 400 nm × 400 nm sont présentés. Le réseau d'îlots a été obtenu à la température de croissance de 250 °С. Les histogrammes de la distribution du nombre d'îles en taille sont également illustrés à la Fig. 5. Les îles de densité 5.18 × 10 11 cm −2 et la taille moyenne de 8,95 nm sont présentées sur la figure 5c. Le Ge déposé0.75 Si0.2 Sn0,05 l'épaisseur du film était de 1,78 nm. La taille moyenne des îles au cours de la cinquième période est d'environ 4 nm, et la densité d'îles atteint 1,8 × 10 12 sm −2 à une épaisseur effective de Ge0,75 Si0.2 Sn0,05 film 1,89 nm, et il résulte de l'histogramme de la Fig. 5d. Une augmentation de la densité d'un facteur 3,5 et une diminution de la taille de l'îlot d'un facteur 2 peuvent être liées à l'augmentation de la fraction Sn sur la surface Si avec une augmentation du nombre de périodes. Cette affirmation est confirmée par le changement de superstructures, observé par le motif RHEED lors de la croissance du film de Si sur la couche de GeSiSn, de (2 × 1) et (2 × N) à la structure de surface c(8 × 4). La formation de la superstructure c(8 × 4) a lieu au cours du processus de croissance de Sn sur Si, à partir de l'épaisseur de revêtement de 0,4 monocouche (ML) à une température de croissance de 400 °С. Avec la diminution de la température de croissance à 100 °С, nous pouvons augmenter la densité de l'île, mais la qualité de la surface est pire. Une augmentation de la température de croissance à plus de 250 °С améliore la ségrégation du Sn. Ainsi, la plage de température de croissance optimale des couches de GeSiSn avec le réseau d'îles est de 150 à 250 °С, où des oscillations de réflexion spéculaire sont observées au niveau de la croissance de la couche de mouillage GeSiSn, correspondant au mécanisme de croissance 2D.

Images STM du Ge0.75 Si0.2 Sn0,05 surface avec une taille de numérisation de 400 nm × 400 nm :a le Ge0.75 Si0.2 Sn0,05 surface en première période, b le Ge0.75 Si0.2 Sn0,05 surface en cinquième période; les histogrammes de distribution du nombre d'îles sur la taille de la base pour le Ge0.75 Si0.2 Sn0,05 film :c en première période (le Ge0.75 Si0.2 Sn0,05 l'épaisseur du film est égale à 1,78 nm) et d en cinquième période (le Ge0.75 Si0.2 Sn0,05 l'épaisseur du film est égale à 1,89 nm)
La perfection cristalline de la structure multicouche a été étudiée par microscopie électronique à transmission (MET). Les images MET pour une structure multicouche avec le Ge0.5 Si0.45 Sn0,05 L'hétérojonction /Si et une période de 25 nm sont montrées sur la Fig. 6. À partir des données MET, on peut conclure que nos échantillons ne contiennent pas de dislocations de filetage et sont cristallins parfaits avec des interfaces nettes. L'état pseudomorphique du film GeSiSn dans une structure périodique multicouche, le réseau cristallin et les déformations sont discutés dans [14] sur la base de l'analyse des données obtenues à l'aide du MET. La composition du film GeSiSn a été déterminée en définissant les flux de Si, Ge et Sn. Les taux de croissance de Si, Ge et Sn ont été mesurés avec un mesureur d'épaisseur à quartz. La composition du film GeSiSn a été identifiée par diffractométrie des rayons X. L'analyse a montré la coïncidence des compositions définies et mesurées.
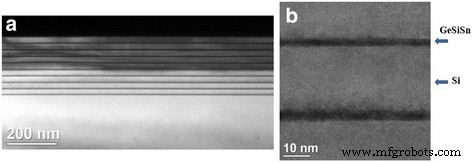
un Image TEM de la structure multicouche incluant le Ge0.5 Si0.45 Sn0,05 hétérotransition avec la période de 25 nm. b Image TEM haute résolution de la même structure
Les propriétés optiques de structures périodiques multicouches avec des couches de GeSiSn ont été étudiées par photoluminescence pour des structures avec différentes teneurs en Sn. Les structures ont démontré leur photoluminescence dans la plage de 0,6 à 0,8 eV, ce qui correspond à la plage de longueurs d'onde de 1,45 à 2 μm (Fig. 7). Les spectres de photoluminescence avec les maxima d'intensité à 0,78, 0,69 et 0,65 eV ont été obtenus. Ils correspondent aux longueurs d'onde de 1,59, 1,8 et 1,9 μm et sont observés à 3,5, 4,5 et 6 % de Sn, respectivement. L'augmentation de la teneur en Sn dans la couche de GeSiSn conduit à la fois à la diminution de l'énergie des transitions optiques et à l'augmentation de l'intensité de la photoluminescence. L'augmentation d'intensité peut être causée par l'augmentation de la profondeur du puits quantique pour une teneur en Sn plus élevée dans la couche de solution solide de GeSiSn. Pour avancer dans le domaine des longueurs d'onde à plus de 2 μm, une augmentation de la teneur en Sn dans les couches de GeSiSn est nécessaire. Pour déterminer les transitions optiques observées dans les spectres de luminescence, il a fallu calculer le diagramme de bandes de l'hétérostructure GeSiSn/Si.

Les spectres de photoluminescence des structures périodiques multicouches avec une teneur en Sn de 3,5, 4,5 et 6 % dans les couches pseudomorphes de GeSiSn
Le diagramme de bande d'hétérostructure GeSiSn/Si a été calculé en utilisant l'approche de la théorie des solides modèles [20]. Dans ce modèle, les deux semi-conducteurs formant l'hétérojonction doivent être mis à l'échelle « d'énergie » unique pour déterminer la position de la bande dans l'hétérojonction. La valeur de la bande interdite de valence pour les hétérostructures Ge/Si dans l'hétérojonction est bien connue [22] et est égale à 0,54 eV ; de plus, la bande de valence Ge est plus élevée sur l'énergie que la bande de valence Si. La bande interdite entre Ge et Sn est connue à partir du modèle présenté dans [23] et est de 0,69 eV [24]. Ainsi, la valeur de bande interdite sur l'hétérointerface pour le Si/Si 1-x-y Ge x Sn y l'hétérostructure peut s'écrire :
$$ {E}_{v, av}=0,54x+1,23y $$Puisque la bande de valence du semi-conducteur est formée par les sous-bandes de trous lourds et légers, ainsi que par la sous-bande séparée par l'interaction spin-orbite ; puis, la position de la bande de valence (E v,av ) moyennée dans les trois sous-bandes est utilisée pour déterminer la bande interdite et la construction du diagramme de bande d'hétérostructure. Pour déterminer la position de la sous-bande des trous lourds et légers, ainsi que la sous-bande séparée par l'interaction spin-orbite, les expressions suivantes sont utilisées :
$$ {\displaystyle \begin{array}{l}{E}_{\mathrm{HH}\left(\mathrm{LH}\right)}={E}_{v, av}+{\Delta} _0/3\\ {}{E}_{\mathrm{SO}}={E}_{v, av}-2/3{\Delta}_0\end{array}}, $$où les indices HH, LH et SO indiquent les sous-bandes de trous lourds et légers, ainsi que la sous-bande divisée en spin. Le Δ0 valeur désigne l'énergie de séparation spin-orbite dans le semi-conducteur. Après avoir déterminé la position de la sous-bande de la bande de valence dans l'hétérojonction, les positions des vallées de la bande de conduction correspondantes sont déterminées à l'aide de l'expression :
$$ {E}^n={E}_{\mathrm{Ge}}^n\left(1-xy\right)+{E}_{\mathrm{Si}}^nx+{E}_{\ mathrm{Sn}}^ny-{b}_{\mathrm{Si}\mathrm{Ge}}^nx\left(1-xy\right)-{b}_{\mathrm{Sn}\mathrm{Ge }}^ny\left(1-xy\right)-{b}_{\mathrm{Si}\mathrm{Sn}}^n xy, $$où indexe n = Γ , L , et X indiquer les vallées correspondantes \( {b}_{\mathrm{SiGe}}^n \), \( {b}_{\mathrm{SnGe}}^n \), et \( {b}_{\mathrm {SiSn}}^n \)––Paramètres de « courbure », prenant en compte l'écart par rapport à la loi linéaire pour la largeur de bande interdite, \( {E}_{\mathrm{Ge}}^n \),\( { E}_{\mathrm{Si}}^n \), et \( {E}_{\mathrm{Sn}}^n \)––Ge, Si et Sn bandes interdites dans la vallée correspondante. Presque tous les paramètres sont tirés de [24]. Les paramètres de courbure pour les vallées L et Г sont tirés de [25].
Après avoir déterminé la position de toutes les bandes d'intérêt dans l'hétérojonction, nous avons pris en compte leur déplacement sous l'influence des déformations. L'influence des déformations sur la bande interdite a été prise en compte au moyen de constantes de potentiel de déformation [26]. Comme les couches bidimensionnelles étaient pseudomorphes, dans notre cas, l'approche standard a été utilisée pour déterminer les déformations qui est décrite, par exemple, dans [26] :les déformations dans un plan de puits quantique peuvent être déterminées à partir de ε xx(yy) = ε ǀǀ = (un GeSiSn − a Si )/a Si , où a ––la constante de réseau du matériau correspondant. Dans la direction perpendiculaire au plan du puits quantique, la valeur de déformation ε zz = −2(С 12 /С 11 )ε xx peut être déterminé par le C 12 et C 11 modules élastiques du composé cristallin. La constante de réseau de la solution solide a été déterminée à partir de la relation quadratique :
$$ {a}_{\mathrm{Ge}\mathrm{SiSn}}={a}_{\mathrm{Ge}}\left(1-xy\right)+{a}_{\mathrm{Si} }x+{a}_{\mathrm{Sn}}y+{b}_{\mathrm{Si}\mathrm{Ge}}^{\hbox{'}}x\left(1-x\right)+{ b}_{\mathrm{Sn}\mathrm{Ge}}^{\hbox{'}}y\left(1-y\right), $$où un Bon , un Si , un Sn ––Paramètres de réseau Ge, Si et Sn [24], \( {b}_{\mathrm{SiGe}}^{\hbox{'}} \)= − 0.026 Å, \( {b}_{\ mathrm{SnGe}}^{\hbox{'}} \) = 0.166 Å––Paramètres de « courbure », prenant en compte l'écart par rapport à la loi de Vegard.
Sur la base des calculs du diagramme de bande, les pics PL correspondent aux transitions interbandes entre la vallée X de Si ou le 4 -vallée de GeSiSn et la bande de trous lourds dans la couche de GeSiSn (Fig. 8).
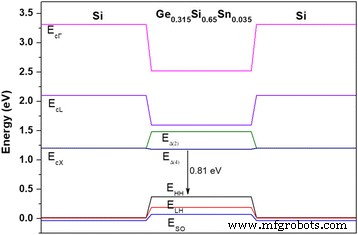
Le Si/Ge0.315 Si0.65 Sn0,035 /Si diagramme de bande d'hétérocomposition
Conclusions
Les dépendances critiques de l'épaisseur de transition 2D-3D sur la composition des couches de GeSiSn avec une teneur en Ge et une teneur en Sn fixes, variant de 0 à 16% à la température de croissance de 150 °С, ont été déterminées. Les diagrammes de phases de la superstructure pour la croissance épitaxiale de Sn sur Si(100) et Ge(100) ont été réalisés. Les structures périodiques multicouches avec des couches pseudomorphes et avec un réseau d'îlots GeSiSn d'une densité jusqu'à 1,8 × 10 12 sm −2 ont été obtenus. Pour la première fois, dans la structure périodique multicouche lors de la croissance de Si sur la couche de GeSiSn, une superstructure à deux domaines (10 × 1), qui se transforme en une superstructure (2 × 1) à un léger recuit, a été observée. Les structures périodiques GeSiSn/Si ont démontré leur photoluminescence dans la plage de 0,6 à 0,8 eV, ce qui correspond à la plage de longueurs d'onde de 1,45 à 2 μm. Basé sur les calculs du diagramme de bande pour la structure avec Ge0.315 pseudomorphique Si0.65 Sn0,035 couches, les pics PL correspondent aux transitions interbandes entre la vallée X de Si ou le Δ4 -vallée de GeSiSn et la bande de trous lourds dans la couche de GeSiSn. De nouveaux progrès dans le domaine des ondes longues nécessitent une étude des propriétés optiques des structures à forte teneur en Sn.
Abréviations
- CVD :
-
Dépôt chimique en phase vapeur
- MBE :
-
Epitaxie par faisceau moléculaire
- ML :
-
Monocouche
- PL :
-
Photoluminescence
- RHEED :
-
Diffraction des électrons à haute énergie par réflexion
- STM :
-
Microscopie à effet tunnel
- TEM :
-
Microscopie électronique à transmission
Nanomatériaux
- Nanoparticules semi-conductrices
- Structure et propriétés électroniques de la nanoargile de kaolinite dopée par un métal de transition
- Modulation des propriétés d'anisotropie électronique et optique du ML-GaS par champ électrique vertical
- Synthèse facile et propriétés optiques de petits nanocristaux et nanotiges de sélénium
- Caractéristiques optiques et électriques des nanofils de silicium préparés par gravure autocatalytique
- Influence de l'eau sur la structure et les propriétés diélectriques de la microcristalline et de la nano-cellulose
- Effets de l'épaisseur de la bicouche sur les propriétés morphologiques, optiques et électriques des nanolaminés Al2O3/ZnO
- Réglage des morphologies de surface et des propriétés des films de ZnO par la conception de la couche interfaciale
- Propriétés optiques et électroniques des photodiodes N+/P au silicium hyperdopées induites par laser femtoseconde



