Détecteur infrarouge à grande longueur d'onde prétraité par vulcanisation anodique hautes performances P+–π–M–N+ InAs/GaSb Superréseau
Résumé
Le détecteur infrarouge à super-réseau InAs/GaSb a été développé avec un effort considérable. Cependant, ses performances, en particulier les détecteurs infrarouges à grande longueur d'onde (LWIR), sont encore limitées par les performances électriques et l'efficacité quantique optique (QE). Forcer la région active à être p -type grâce à un dopage approprié peut grandement améliorer le QE, et la technique de déclenchement peut être utilisée pour améliorer considérablement les performances électriques. Cependant, la tension de polarisation de saturation est trop élevée. La réduction de la tension de polarisation de saturation a de larges perspectives pour l'application future des dispositifs de commande de tension de grille. Dans cet article, nous rapportons que le gated P + –π –M–N + Les détecteurs infrarouges à grande longueur d'onde à superréseau InAs/GaSb présentent différents niveaux de dopage de la région π qui ont un biais de saturation minimum réduit à − 10 V avec un SiO2 de 200 nm couche après un prétraitement de vulcanisation anodique simple et efficace. La tension de polarisation de la grille de saturation est bien inférieure à − 40 V qui a été signalée avec la même épaisseur d'un SiO2 de 200 nm couche de passivation et structure similaire. La caractérisation optique et électrique indique que les performances électriques et optiques du dispositif seraient affaiblies par une concentration excessive de dopage. À 77 K, la longueur d'onde de coupure de 50 % de l'appareil est d'environ 8 µm, la longueur d'onde de coupure de 100 % est de 10 µm, l'efficacité quantique maximale est de 62,4 %, le maximum de réactivité est de 2,26 A/W à 5 µm et le maximum La RA de l'appareil est de 1259,4 Ω cm 2 . De plus, la détectivité spécifique du détecteur dopé Be 780 °C sans électrode de grille présente un pic de 5,6 × 10 10 cm Hz 1/2 /W à 5 µm avec une tension de polarisation inverse de 70 mv, qui est plus de trois fois supérieure à celle d'un détecteur dopé au Be 820 °C. De plus, la détectivité spécifique du pic pourrait être encore augmentée à 1,3 × 10 11 cm Hz 1/2 /W à 5 µm avec une tension de polarisation de réserve de 10 mv qui a une polarisation de − 10 V à l'électrode de grille.
Introduction
Les super-réseaux à couche contrainte de type II (T2SL) sont de plus en plus au centre des recherches actuelles depuis que Sai-Halasz et al. [1] a proposé sa conception. Des détecteurs infrarouges hautes performances peuvent être générés en concevant soigneusement la structure de bande et la contrainte des T2SL [2]. Le super-réseau InAs/GaSb, un membre bien étudié des T2SL, est un excellent système de matériaux présentant de larges perspectives dans le détecteur infrarouge [3]. Le détecteur infrarouge à super-réseau InAs/GaSb a été développé avec un effort considérable. Cependant, ses performances, en particulier les détecteurs infrarouges à grande longueur d'onde (LWIR), sont encore limitées par les performances électriques et l'efficacité quantique optique (QE) [4]. La température ambiante correspondante (au sol) du détecteur LWIR est d'environ 300 K, ce qui correspond à la longueur d'onde maximale de 9,6 µm (le centre de la fenêtre de transmission atmosphérique LWIR) et a un large éventail d'applications [5]. Il est largement utilisé dans divers domaines tels que la détection de gaz, la vision nocturne, l'alerte précoce infrarouge, la télédétection infrarouge et le guidage infrarouge, non seulement pour un usage militaire mais aussi pour la vie des personnes. Il est extrêmement important et difficile de fabriquer des détecteurs infrarouges à ondes longues hautes performances.
La conception structurelle et la préparation du processus du détecteur ont un impact significatif sur les performances du détecteur LWIR. L'augmentation de l'épaisseur de la région active semblait être le moyen le plus direct et le plus efficace d'améliorer le QE. Cependant, plus de centres de piège sont introduits avec l'augmentation de l'épaisseur, conduisant à une réduction des caractéristiques électriques du détecteur. Dans le LWIR et les détecteurs infrarouges à très grande longueur d'onde (VLWIR), la couche d'InAs a tendance à être plus épaisse que la couche de GaSb. Ainsi, le matériau est n -type (les porteurs minoritaires sont des trous). Forcer la région active à être p -type grâce à un dopage approprié peut augmenter considérablement le QE sans aucun changement dans la taille de la région de l'appareil [6]. Cependant, plus la concentration de dopage est élevée, plus les performances de l'appareil sont améliorées. En particulier, les performances électriques [7] et optiques de l'appareil pourraient être affaiblies par une concentration excessive de dopage.
En plus de changer la concentration de dopage dans le π région, la technique de déclenchement a été appliquée dans les détecteurs infrarouges à moyenne longueur d'onde (MWIR) et les détecteurs LWIR [8] récemment pour améliorer les performances du dispositif. Cependant, il nécessite une tension de polarisation de grille très élevée. Le biais de grille peut être exprimé par l'équation. (1).
$$\sigma =\varepsilon \varepsilon_{0} V/d,$$ (1)où \(\varepsilon\) désigne la constante diélectrique relative de la couche diélectrique, \(\varepsilon_{0}\) représente la constante diélectrique du vide, V fait référence à la tension de polarisation de la grille de saturation, d est l'épaisseur de la couche diélectrique, et σ représente la densité de charge sur l'interface. Le biais de la porte a été affaibli sur la base de la formule avec beaucoup d'efforts ; les moyens d'utiliser un diélectrique à k élevé tel que Y2 O3 [9] pour passiver ou réduire l'épaisseur de la couche [10] est efficace. Cependant, il existe peu de recherches sur la réduction de la densité de charge. Dans cet article, l'anodisation est d'abord effectuée pour réduire considérablement le biais de saturation. Un mélange de NaS2 ·5H2 O et l'éthylène glycol est utilisé comme solution de vulcanisation. Pendant le processus de durcissement anodique, la combinaison d'atomes de soufre et de liaisons pendantes à la surface de l'appareil ferme les canaux conducteurs à la surface de l'appareil [11], réduit la recombinaison de surface de l'appareil et affaiblit la densité de charge de surface du appareil. Ensuite, une couche de soufre élémentaire dense et uniforme sur la surface du dispositif est obtenue. Ensuite, la surface de la couche de soufre élémentaire est recouverte d'une couche de 200 nm de SiO2 . L'électrode de grille est placée sur le SiO2 couche. La tension de polarisation de la grille de saturation est réduite à mesure que la densité de charge sur l'interface diminue.
Dans cette étude, LWIR P + prétraité par vulcanisation anodique –π –M–N + les détecteurs sont fabriqués sous une tension de polarisation de grille à faible saturation basée sur des InAs/GaSb T2SL avec différents dopages π Régions. Les résultats indiquent que plus la concentration de dopage est élevée, plus les performances de l'appareil sont améliorées. En effet, les performances électriques et optiques du dispositif seraient affaiblies par une trop forte concentration de dopage. De plus, le prétraitement par vulcanisation anodique peut réduire considérablement le biais de grille à − 10 V qui est bien inférieur à celui rapporté à la même épaisseur d'un SiO2 de 200 nm couche de passivation avec environ 40 V dans une structure similaire.
Méthodes
Matériaux et structure
Les matériaux sont produits par un système à source solide GEN 20 MBE sur le n 2 pouces -substrats de type GaSb (001). Dans ce travail, le détecteur LWIR haute performance est basé sur le P + –π –M–N + structure. Un schéma des dispositifs, des modèles de diffraction des rayons X à haute résolution (HRXRD) et de la microscopie à force atomique (AFM) est illustré dans les Fig. 1 et 2. La figure 1 indique que la structure est constituée d'un P + de 1 300 nm d'épaisseur Tampon GaSb, suivi d'un InAs 12-ML GaSb de 500 nm d'épaisseur (Be :environ 1 × 10 18 cm −3 )P + région, un InAs 12-ML légèrement dopé P à 2000 nm (Be :780 °C 800 °C 820 °C) / GaSb 7-ML π région, une région M non dopée 18-ML InAs/3-ML GaSb/5-ML AlSb/3-ML GaSb de 500 nm, une 18-ML InAs/3-ML GaSb/5-ML AlSb 500 nm d'épaisseur /3-ML GaSb (Si :environ 1 × 10 18 cm −3 ) N + région et un N + à 30 nm Couche InAs Cap. Et il montre également l'alignement de la bande de simulation avec la structure. Considérant que la performance du P + –π –M–N + Le détecteur LWIR serait significativement influencé par le dopage du π région, nous préparons trois échantillons avec des températures de dopage Be différentes variant de 780 à 820 °C.
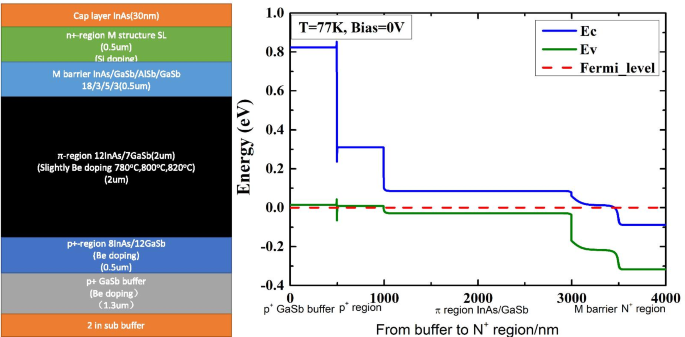
La structure épitaxiale et l'alignement des bandes des matériaux avec différents niveaux de dopage de la région π

Courbes oscillantes HRXRD pour les échantillons avec différents niveaux de dopage de la région π
Les périodes de super-réseau de 59,3 , 58,4 Å et 89,5 Å pour le p -contact, p - la région active et la couche de structure M, avec des décalages de réseau de 60 sec d'arc, 0 sec d'arc et 0 sec d'arc, de manière correspondante, sont présentées sur la figure 2. La pleine largeur à mi-hauteur pour les SL dans chaque région est de 32 arc sec, 25 arc sec et 12 arc sec, indiquant que le matériau est de haute qualité aux interfaces.
La figure 3 montre que les étapes atomiques apparaissent avec la moyenne quadratique (RMS) de la rugosité avec 1,87 sur une zone de 10 × 10 µm.
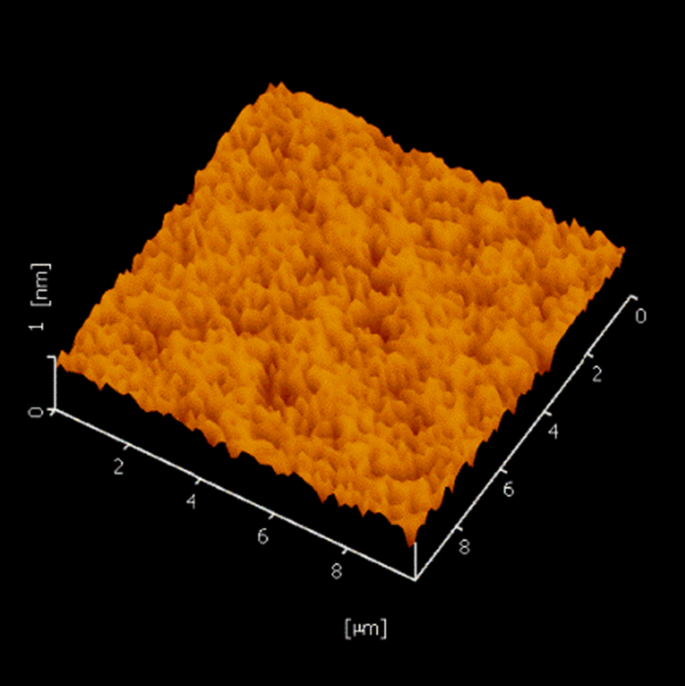
AFM d'un 10 × 10 µm 2 zone d'un échantillon
Structure et fabrication de l'appareil
Le processus est similaire à celui de la référence [12]. Tout d'abord, la plaquette est recouverte de SiO2 comme un masque de hark. Ensuite, les étapes de lithographie standard correspondantes sont adoptées. Ensuite, nous faisons un masque dur ouvert par un système de plasma à couplage inductif (ICP). Ensuite, la mesa est obtenue à l'aide d'un système plasma à couplage inductif (ICP) avec un CH4 /Cl2 /Ar mélange. Concrètement, les wafers sont gravés de la couche supérieure jusqu'au P + contacter [12]. Ensuite, le SiO2 restant la couche est supprimée. Ensuite, nous immergeons un côté de la plaquette dans une solution mixte de sulfure de sodium et d'éthylène glycol, puis appliquons un courant constant à la plaquette et définissons une tension de seuil. Une couche d'atomes de soufre se formera à la surface du film et la résistance changera. La tension sur la plaquette augmentera progressivement jusqu'à ce qu'elle atteigne la tension de seuil, puis la vulcanisation est terminée. Ensuite, la couche de soufre élémentaire est recouverte d'une couche de 200 nm SiO2 . Par ailleurs, une photolithographie est à nouveau réalisée pour ouvrir la fenêtre à travers la couche de SiO2 et du soufre élémentaire en tant que régions de contact métallique des électrodes métalliques supérieure et inférieure. De plus, une autre photolithographie conçue avec deux formes d'électrodes est réalisée; une forme d'électrode est pour la diode fermée (GD) et l'autre est pour la diode non fermée (UGD). Ti (50 nm)/Pt (50 nm)/Au (300 nm) est déposé par faisceau d'électrons déposé pour les électrodes métalliques. Enfin, les électrodes du haut, du bas et de la grille sont acquises par décollement du métal.
La figure 4 illustre la structure du GD. Comme nous le savons, l'angle de pente de la gravure du matériau peut être ajusté en modifiant la puissance ICP, la puissance RF, le débit de gaz et la pression de la chambre. Dans cette étude, l'angle d'inclinaison réel de la paroi latérale est compris entre 80 degrés et 85° pour faciliter le contact de la porte de dépôt sur la paroi latérale. L'électrode de grille est placée sur la paroi latérale du SiO2 couche.
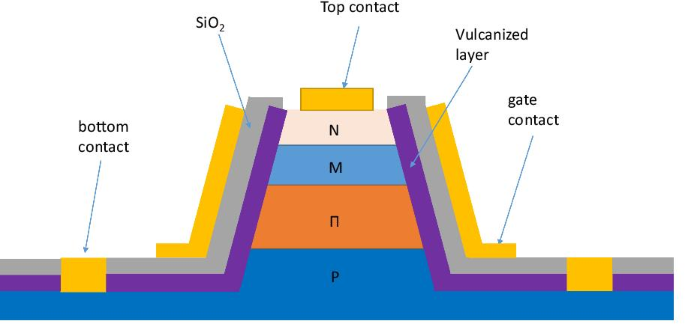
Le schéma de structure de l'appareil de GD
La figure 5 montre que des demi-diodes sont déposées pour être des GD dans les trois puces (780 °C, 800 °C et 820 °C de dopage Be). Ensuite, la diode fermée (GD) et la diode non fermée (UGD) peuvent être obtenues. En fin de compte, l'échantillon A (780 °C GD), l'échantillon B (780 °C UGD), l'échantillon C (800 °C GD), l'échantillon D (800 °C UGD), l'échantillon E (820 °C GD) et l'échantillon F (820 °C UGD) peut être acquis.

Image de l'appareil au microscope optique
Résultats et discussion
Dans les détecteurs infrarouges, une détectivité spécifique (D *) est généralement utilisé pour caractériser les performances du détecteur, qui sont calculées par l'équation. (2).
$$D^{*} =\frac{Ri}{{\sqrt {2qJ + 4\frac{kT}{{RA}}} }}$$ (2)où q indique le montant de la charge électronique ; K fait référence à la constante de Boltzmann ; T est la température Kelvin ; Ri fait référence à la réactivité du détecteur infrarouge ; J est la densité de courant d'obscurité du dispositif sous une certaine polarisation ; et RA fait référence au produit de la valeur de résistance et de la surface du dé. J et RA caractérisent les performances électriques de l'appareil. Et Ri peut être converti en QE avec la formule :
$$QE =\frac{hC}{{q\lambda }}Ri$$ (3)où \(h\) est la constante de Planck, \({ }C\) est la vitesse de la lumière, q désigne la quantité de charge électronique, \({ }\lambda\) est la longueur d'onde spécifique, et QE et Ri caractérisent les performances optiques de l'appareil. La figure 6 présente les caractéristiques optiques des échantillons avec différents π niveaux de dopage de la région à 77 K. Tous les échantillons ont une longueur d'onde de coupure similaire à 50 % de 8 µm et une longueur d'onde de coupure de 100 % de 10 µm à 77 K. Bien que le QE et la réactivité de l'appareil puissent être augmentés en changeant le type de dopage à p -type du π région, ce n'est pas plus la température est élevée, plus le QE et la réactivité sont élevés. Cependant, le QE et la réactivité sont considérablement réduits avec l'augmentation de la concentration de dopage. Pour les super-réseaux à couche contrainte de type II (T2SL), la température de dopage pendant la croissance est critique pour la concentration de dopage. Plus la température est élevée, plus la concentration de dopage est élevée. Le QE de 780 °C atteint sa valeur maximale de 62,4 %, ce qui est 1,5 fois supérieur à celui du QE de 820 °C. C'est parce que trop d'impuretés sont introduites avec l'augmentation de la concentration de dopage, conduisant à la diminution de la durée de vie excessive des porteurs/durée de diffusion et à la réduction du QE et de la réactivité [6]. Ils provoquent en outre le décalage vers le rouge spectroscopique de la figure 6a. Les figures 6a et b indiquent que 780 °C est la meilleure température de dopage des matériaux pour la caractérisation optique, avec un pic de sensibilité de 2,26 A/W à 5 µm et un pic de QE de 62,4 %.
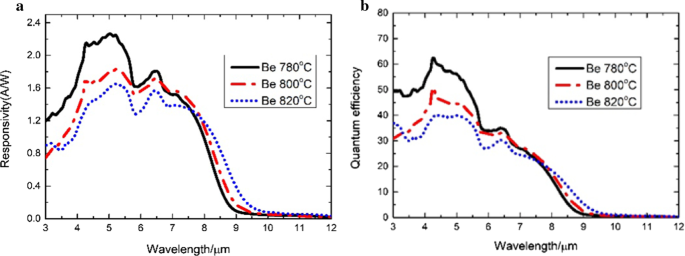
Les caractéristiques optiques des échantillons avec différents niveaux de dopage de la région π à 77 K
La figure 7 affiche les caractéristiques électriques des échantillons UGD avec différents π niveaux de dopage régional à 77 K. Les performances électriques de l'appareil seraient fortement affectées par différents π concentrations de dopage régional [7]. Avec l'augmentation du niveau de dopage de la région , le produit de la valeur de résistance et de la zone de puce (RA) dans une certaine polarisation devient plus petit, et la densité de courant d'obscurité devient plus grande en conséquence. Semblable à la référence [6], le RA atteint son maximum à près de 0 V avec un claquage doux à mesure que la polarisation inverse augmente, ce qui suggère que le dispositif a un mode de courant d'obscurité tunnel. Nous atteignons un RA maximum de 1259,4 Ω cm 2 au Be dopé à 780 °C à − 200 mv soit près de 40 fois celui du Be dopé à 820 °C. La figure 7b montre que la densité de courant d'obscurité est similaire dans la polarisation négative dans la plage de − 0,1 à 0 V, et la densité de courant d'obscurité avec Be dopé à 780 °C est un peu plus petite que les autres. Le courant d'obscurité est de 4,9 × 10 −3 A/cm 2 pour l'appareil au Be dopé à 780 °C à − 70 mv.
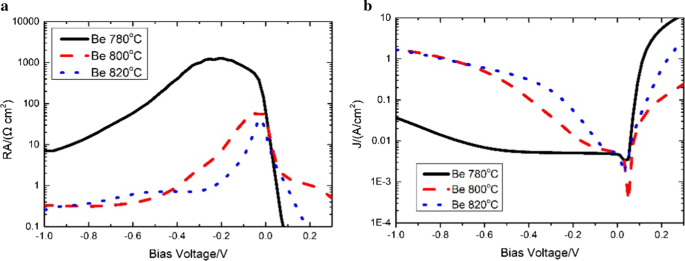
Les caractéristiques électriques des échantillons UGD avec différents π niveaux de dopage régionaux à 77 K
Le D correspondant * peut être calculé en prenant le Ri spécifique, J , et les valeurs RA sous différentes tensions de polarisation à 77 K. La figure 8 montre la détectivité des échantillons UGD avec différents π Régions. À − 30 mv, la détectivité maximale est de 5,6 × 10 10 cm Hz 1/2 /W à 5 µm au Be dopé à 780 °C, alors qu'il est de 3,8 × 10 10 cm Hz 1/2 /W au Be dopé à 820 °C. Le pic de détectivité du Be dopé à 780 °C est 1,5 fois celui du Be dopé à 820 °C. Par conséquent, la concentration de dopage appropriée est extrêmement importante. Cependant, une concentration de dopage trop élevée affaiblirait les performances de l'appareil.

Corrélation entre la détectivité spécifique à 77 K des échantillons UGD avec π niveaux de dopage et longueur d'onde de la région
La figure 9 présente les caractéristiques électriques de l'échantillon GD avec Be dopé avec 760 ° C à 77 K. Différent des dispositifs de contrôle de tension de grille ordinaires, un prétraitement de vulcanisation anodique est d'abord effectué dans cette étude pour réduire remarquablement la tension de polarisation de la grille de saturation. De plus, un mélange de NaS2 ·5H2 O et l'éthylène glycol est utilisé comme solution de vulcanisation. La méthode de passivation par vulcanisation de l'anode est utilisée pour former une couche de soufre élémentaire dense et uniforme sur la surface du dispositif. Au cours de la réaction électrochimique, les atomes de soufre sont combinés avec les liaisons pendantes à la surface du dispositif, contribuant à fermer les canaux électroniques générés par les liaisons pendantes de surface et à isoler le mécanisme de recombinaison électron-trou à la surface du dispositif [11]. Ensuite, la surface de la couche de soufre élémentaire est recouverte d'une couche protectrice de 200 nm SiO2 , et l'électrode de grille est placée sur la paroi latérale du SiO2 couche. Comme indiqué dans des recherches précédentes, la corrélation entre le biais de saturation et l'épaisseur de la couche diélectrique du dispositif est presque linéaire. La figure 9 suggère que le biais de saturation du dispositif peut être réduit à environ - 10 V grâce à un prétraitement de vulcanisation simple et efficace ; cette valeur réduite dans d'autres recherches est d'environ 40 V et est quatre fois plus grande dans des appareils de structure similaire avec la même épaisseur SiO2 couche [10]. De plus, RA atteint son maximum de 25 Ω cm 2 à près de 0 V. La tendance à la baisse s'est considérablement ralentie lorsque nous appliquons une tension de polarisation négative à environ − 10 V. Lorsque nous appliquons la tension de polarisation de − 10 V sur l'électrode de grille, RA est de 10 Ω cm 2 à − 0,3 V, soit 40 fois celui sans tension de polarisation appliquée. En outre, il est inférieur de près de deux ordres de grandeur à celui sans tension de polarisation à − 0,6 V. La figure 9b indique que le courant d'obscurité atteint son minimum de 2 × 10 –4 A/cm 2 proche de 0 V, et elle est réduite d'un ordre de grandeur à - 0,3 V. Comme on le sait, la courbe IV ne changerait pas avec la polarisation de la grille à 0 V lorsque la tension de polarisation est positive. Par ailleurs, le RA du dispositif augmente significativement lorsque la tension de polarisation passe de 0 à - 10 V; pendant ce temps, le courant d'obscurité de l'appareil diminue en conséquence. Lorsque la tension de polarisation varie de - 10 à - 20 V, le RA du dispositif diminue légèrement et le courant d'obscurité du dispositif augmente en conséquence. À une polarisation de réserve élevée (par exemple, - 1 V) entre les électrodes supérieure et inférieure, le courant d'obscurité diminue avec la polarisation de la grille, puis augmente légèrement au-delà de - 12 V. C'est principalement pour la caractéristique de polarisation de la grille. Une introduction supplémentaire est illustrée à la Fig. 10. Pour une faible polarisation inverse (par exemple, - 0,1 V), le courant d'obscurité semble augmenter à mesure que la polarisation de la grille augmente, ce qui est complètement différent de celui à - 1 V. Pour différentes polarisations inverses, nous soupçonnons que le mécanisme de fuite principal est différent. Pour une polarisation à faible réserve, une polarisation de grille élevée montre une influence négative car elle influence la diffusion de surface des électrons et des électrons chauds. Et pour une polarisation inverse élevée, la fuite diminue pour son courant de fuite de surface diminue. C'est donc différent.

Les caractéristiques électriques des échantillons GD à 780 °C Be dopé avec différentes tensions de polarisation de grille et la tension de polarisation sur l'électrode supérieure et inférieure
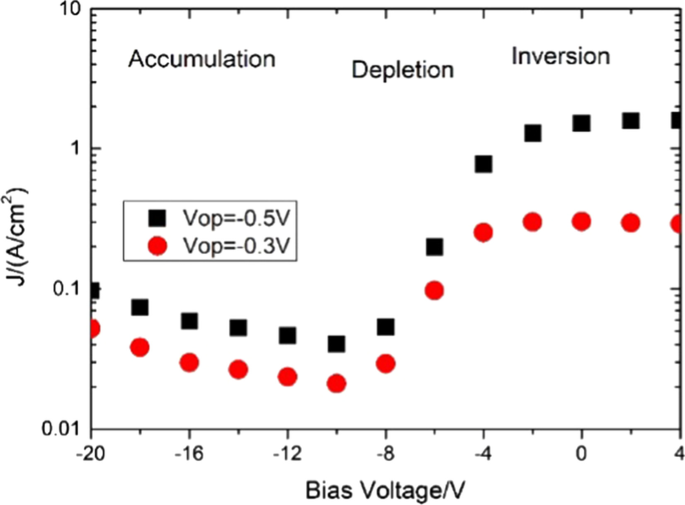
Corrélation entre la densité de courant d'obscurité inverse et le biais de grille de l'échantillon GD avec 780 °C Be dopé à différents biais de fonctionnement de diode
Comme illustré sur la figure 10, à une polarisation de réserve élevée (par exemple, - 1 V) entre les électrodes supérieure et inférieure, le courant d'obscurité diminue avec la polarisation de la grille, puis augmente légèrement au-delà de - 12 V ; nous pouvons voir que le dispositif existe en trois étapes avec le changement de tension de polarisation à 77 K [10]. D'après la référence [13], le P + et N + régions pour P + –π–M–N + dispositif de structure sont fortement dopées, et la région M est une région de bande plus grande avec une masse effective plus grande par rapport au π et P + Région; par conséquent, le biais de la porte a beaucoup plus d'influence sur le π région par rapport aux autres [13]. En utilisant une méthode similaire avec Chen [10], trois étapes au cours du processus de tension de polarisation négative élevée (− 20 à − 10 V) appliquée sur l'électrode de grille sont analysées ; les résultats indiquent que la paroi latérale de la mesa est à plat ou sous accumulation [8], et la densité de courant d'obscurité augmente légèrement avec la polarisation de grille due à l'interface de vulcanisation. Suspect pour l'interface de vulcanisation légèrement inhomogénéité de densité, quelque part la densité insuffisante se décompose légèrement. Lorsqu'une tension de polarisation négative (− 10 à − 2 V) est appliquée, la paroi latérale de la mesa s'épuise et le courant d'obscurité augmente progressivement. En outre, la largeur d'appauvrissement induit par le champ atteint son maximum et la formation de couche d'inversion lorsque la tension de polarisation à - 2 V est appliquée à une polarisation de grille positive ; ainsi, la densité de courant d'obscurité reste constante. Selon la référence [14], pourquoi le courant de génération-recombinaison de surface (G–R) à − 0,5 V est plus grand que celui à − 0,3 V est expliqué.
La figure 11 montre que, avec la polarisation de grille à − 10 V, le D * pour l'échantillon GD avec 780 °C dopé au Be atteint son pic de détectivité de 1,3 × 10 11 cm Hz 1/2 /W à 5 µm, ce qui est plus de deux fois celui sous tension sans polarisation avec 780 °C Be dopé et plus de trois fois celui sous tension sans polarisation avec 820 °C Be dopé à 77 K. Cela indique que l'application d'une polarisation négative appropriée peut améliorer considérablement les performances de l'appareil.
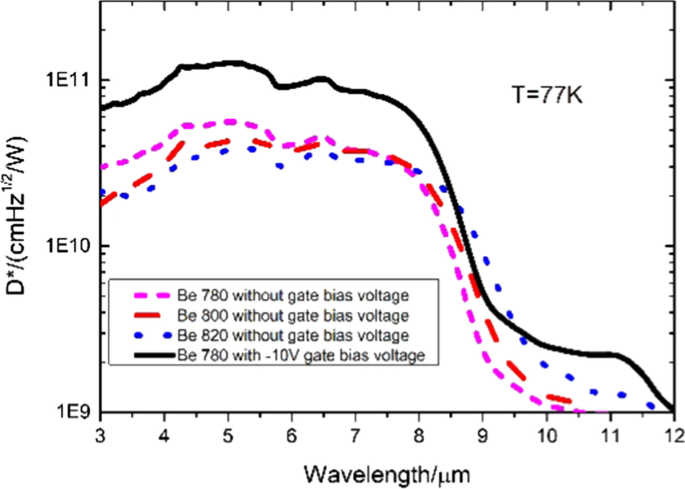
Corrélation entre la détectivité de l'échantillon GD avec 780 °C dopé Be et des échantillons UGD avec différents niveaux de dopage de la région et la longueur d'onde à 77 K
Conclusions
2017 Northwestern University a signalé des photodétecteurs infrarouges à grande longueur d'onde (LWIR) nBn basés sur InAs/InAs1−x Sbx super-réseaux de type II. L'appareil présentait une longueur d'onde de coupure ∼ 10 µm à 77 K avec une sensibilité maximale de 2,65 A/W, correspondant à une efficacité quantique de 43 % et un RA 664 Ω cm 2 et une densité de courant d'obscurité de 8 × 10 5 A/cm 2 , sous une tension de polarisation de 80 mV à 77 K; le photodétecteur présentait une détectivité spécifique de 4,72 × 10 11 cm Hz 1/2 /W [5]. La réactivité maximale de cet appareil est de 1,3 × 10 11 cm Hz 1/2 /W à 5 µm et 0 V avec une tension de polarisation de grille de - 10 V comparable au dispositif nBn. Mais le point faible est l'uniformité de la RA de l'appareil qui influence les performances de l'appareil.
En conclusion, forcer la région active à être p -type par dopage dans le π peut améliorer efficacement les performances du super-réseau LWIR InAs/GaSb P + –π –M–N + détecteur [6]. Cependant, plus la concentration de dopage est élevée, plus les performances de l'appareil sont améliorées. En particulier, les performances électriques et optiques du dispositif pourraient être réduites par une concentration excessive de dopage. La caractérisation optique à 77 K indique que l'on obtient un QE maximum de 62,4% à 4,26 µm et un maximum de 2,26 A/W à 5 µm avec du Be dopé à 780 °C. La caractérisation électrique suggère qu'un RA maximum de 1259,4 Ω cm 2 au Be dopé à 780 °C est obtenu. La détectivité spécifique atteint son maximum de 5,6 × 10 10 cm Hz 1/2 /W à 5 µm au Be dopé à 780 °C. De plus, le biais de saturation du dispositif peut être considérablement réduit grâce à un prétraitement de vulcanisation anodique simple et efficace. Le prétraitement de vulcanisation présente son potentiel pour réduire la tension de polarisation de grille. La caractérisation électrique montre que le biais de saturation n'est que de − 10 V, alors qu'il est de 40 V dans d'autres recherches sans prétraitement de vulcanisation dans une structure similaire avec la même épaisseur de SiO2 couche. De plus, les performances du dispositif peuvent être considérablement améliorées en appliquant une polarisation négative appropriée sur l'électrode de grille. Un maximum de 1,3 × 10 11 cm Hz 1/2 /W est atteint à 5 µm et 0 V avec − 10 V de tension de polarisation de grille avec Be dopé à 780 °C à 77 K. Limité par le matériel expérimental et les conditions expérimentales, nous choisissons SiO2 être une couche diélectrique, mais dans le suivi, il est envisagé d'utiliser un milieu Hi-K pour d'autres expériences. Théoriquement, la tension de polarisation de la grille peut être encore réduite.
Disponibilité des données et des matériaux
Les auteurs déclarent que les matériaux et les données sont rapidement disponibles pour les lecteurs sans qualifications indues pour les accords de transfert de matériel. Toutes les données générées ou analysées au cours de cette étude sont incluses dans cet article.
Abréviations
- LWIR :
-
Détecteurs infrarouges à grande longueur d'onde
- QE :
-
Efficacité quantique
- T2SL :
-
Super-réseaux à couche contrainte de type II
- VLWIR :
-
Détecteurs infrarouges à très grande longueur d'onde
- MWIR :
-
Détecteurs infrarouges à moyenne longueur d'onde
- HRXRD :
-
Diffraction des rayons X haute résolution
- AFM :
-
Microscopie à force atomique
- ICP :
-
Plasma à couplage inductif
- GD :
-
Diode fermée
- UGD :
-
Diode non fermée
- D* :
-
Détective spécifique
- RA :
-
Produit de la valeur de résistance et de la zone de matrice
- Ri :
-
Réactivité du détecteur infrarouge
- G–R :
-
Génération–recombinaison
Nanomatériaux
- Entretien d'experts :Scott DeFelice d'Oxford Performance Materials sur l'évolution des polymères hautes performances pour l'impression 3D
- Synthèse facile de WS2/Bi2MoO6 hétérostructurés en tant que photocatalyseurs hautes performances basés sur la lumière visible
- Croissance auto-catalysée de nanofils verticaux de GaSb sur des tiges d'InAs par dépôt en phase vapeur de produits chimiques organo-métalliques
- Biocompatibilité améliorée dans les matrices Anodic TaO x Nanotube
- Performances photocatalytiques induites par la lumière visible des nanocomposites ZnO/g-C3N4 dopés N
- Préparation et performances photocatalytiques des photocatalyseurs à structure creuse LiNb3O8
- Un nouveau photocatalyseur à hétérojonction Bi4Ti3O12/Ag3PO4 avec des performances photocatalytiques améliorées
- Performances améliorées d'un nouveau catalyseur anodique PdAu/VGCNF pour l'électro-oxydation dans une pile à combustible au glycérol
- Évaluation automatique des performances du détecteur de rayons X



