Enquêtes sur les propriétés optiques de plusieurs puits quantiques InGaN/GaN avec une épaisseur variable de couche de coiffe GaN
Résumé
Trois échantillons InGaN/GaN MQW avec différentes épaisseurs de couche de couverture de GaN ont été cultivés par dépôt chimique en phase vapeur métalorganique (MOCVD) pour étudier les propriétés optiques. Nous avons constaté qu'une couche de couverture plus épaisse est plus efficace pour empêcher l'évaporation de la composition d'In dans la couche de puits quantique d'InGaN. De plus, l'effet Stark confiné quantique (QCSE) est amélioré avec l'augmentation de l'épaisseur de la couche de couverture de GaN. De plus, par rapport aux résultats des mesures d'électroluminescence, nous nous concentrons sur la différence d'états de localisation et de défauts dans trois échantillons induits par différentes épaisseurs de calottes pour expliquer les anomalies des mesures de photoluminescence à température ambiante. Nous avons constaté qu'une couche de protection GaN trop fine exacerbe l'inhomogénéité des états de localisation dans la couche InGaN QW, et qu'une couche de protection GaN trop épaisse générera plus de défauts dans la couche de protection GaN.
Introduction
La structure à puits quantiques multiples (MQW) InGaN/GaN est largement utilisée dans les diodes électroluminescentes visibles (LED) et les diodes laser (LD) en tant que région active, et a obtenu un grand succès [1,2,3,4]. L'amélioration de la qualité des MQW InGaN/GaN est technologiquement importante pour la réalisation de LED et de LD à base de GaN hautes performances. Dans des recherches antérieures, il a été découvert que les barrières quantiques (QB) de GaN (HT-GaN) cultivées à haute température sont bénéfiques pour améliorer la qualité du cristal et l'intensité lumineuse des puits quantiques InGaN/GaN [5, 6]. En raison de la faible force de liaison In-N, la température de croissance de la couche de puits quantiques InGaN (QW) est généralement inférieure à celle des QB GaN pour obtenir une teneur élevée en In. Cela peut provoquer l'évaporation des atomes d'indium d'InGaN QW pendant la croissance de GaN QB à une température plus élevée. Il a été prouvé que l'insertion d'une couche de calotte GaN cultivée à basse température (capuchon LT-GaN) entre InGaN QW et GaN QB réduit efficacement la désorption de la composition d'In, ce qui peut améliorer l'uniformité de l'épaisseur de la couche d'InGaN QW et la distribution de la composition d'In [7,8,9]. Cependant, lorsque la température de croissance de la couche de protection GaN diminue, la capacité de migration des adatomes devient plus faible, entraînant la détérioration des matériaux GaN. De plus, il est rapporté que le nombre de défauts augmente avec l'augmentation de l'épaisseur de la couche de couverture de GaN cultivée à basse température, ce qui n'est pas en faveur de l'amélioration de l'uniformité de la distribution des atomes d'indium et de l'intensité lumineuse des puits quantiques d'InGaN [10]. De nombreux rapports précédents ne se sont pas concentrés sur l'effet des états de localisation sur les propriétés de luminescence dans la région active avec diverses épaisseurs de calotte de GaN. Dans ce travail, nous utilisons la diffraction des rayons X (XRD), l'électroluminescence (EL) et la photoluminescence (PL) pour signaler l'influence de l'épaisseur de la couche de couverture de GaN cultivée à basse température sur la structure et les propriétés de luminescence de l'InGaN/GaN MQW, et décrivent en détail le rôle des états de localisation dans les caractéristiques de luminescence par des expériences PL dépendantes de la température.
Méthodes
Trois échantillons InGaN/GaN MQWs ont été cultivés sur le substrat de saphir plan c par dépôt chimique en phase vapeur métalorganique (MOCVD). Tous les échantillons contiennent les mêmes structures, consistant en une couche tampon GaN non dopée (1,2 µm), une couche n-GaN dopé Si (1 µm), une région active InGaN/GaN MQW à deux périodes et un p-GaN dopé Mg couche (40 nm). Dans le processus de croissance de la région active d'InGaN/GaN, les conditions de croissance des QW d'InGaN étaient identiques les unes aux autres ; une fine couche de couverture de LT-GaN a été développée à la même température que l'InGaN QW (710 °C) pour empêcher l'évaporation de l'indium, et le temps de croissance de la couche de couverture de LT-GaN était de 150 s, 300 s et 500 s pour l'échantillon A, B et C, respectivement; puis la température de croissance de GaN QB a été augmentée jusqu'à 810°C pour améliorer la qualité du matériau de GaN QB, et le temps de croissance de HT-GaN QB était identique pour ces échantillons. La diffraction des rayons X (XRD) a été utilisée pour déterminer les paramètres structurels de ces trois échantillons. L'électroluminescence (EL) et la photoluminescence à température ambiante (PL) ont été réalisées pour caractériser les propriétés optiques des régions actives.
Les spectres EL ont été mesurés à l'aide du spectromètre haute résolution Ocean Optics HR2000 à courant continu (CC), où la puissance de sortie est détectée à l'aide d'une photodiode Si, et l'énergie spectrale du pic EL et FWHM sont détectés par un monochromateur et un tube photomultiplicateur. Pour la mesure PL, un λ =Un laser He-Cd à onde continue de 325 nm a été utilisé comme source d'excitation, avec une puissance optique incidente de 3 mW et une taille de spot de 0,5 mm 2 . Des mesures PL dépendantes de la température de 30 K à 300 K ont été enregistrées pour analyser l'effet des états de localisation sur les caractéristiques de luminescence en utilisant un laser à semi-conducteur GaN de 405 nm avec une puissance d'émission de 5 mW comme source d'excitation. L'échantillon a été refroidi par de l'hélium liquide à écoulement libre et un réfrigérateur à cycle fermé de CTI Cryogenics a été utilisé pour les mesures dépendantes de la température
Résultats et discussions
La figure 1a montre les diagrammes de diffraction du plan (0002) pris par balayage ω-2θ pour ces échantillons. Les pics satellites de ces échantillons sont clairement visibles, indiquant qu'une structure périodique fine et une interface nette existent dans ces MQW. Nous utilisons SmartLab Studio II et le programme Global Fit (offrant une méthode d'ajustement de base de trempe parallèle avancée pour analyser les données générées par le diffractomètre SmartLab) pour obtenir la composition moyenne en In, et l'épaisseur QB et QW, comme indiqué dans le tableau 1. Il peut être clairement vu que la composition d'In dans le QW augmente avec l'augmentation de l'épaisseur de la couche de couverture de LT-GaN, indiquant qu'une couche de couverture plus épaisse est plus efficace pour empêcher l'évaporation de la composition d'In. La figure 1b montre la cartographie spatiale réciproque (RSM) de l'échantillon C. Le pic principal de GaN et les pics satellites sont assis sur une ligne, ce qui suggère que les couches QW avec la teneur en In la plus élevée dans tous les échantillons sont complètement sous tension. Par conséquent, l'influence du champ piézoélectrique sur les propriétés lumineuses doit être prise en considération.
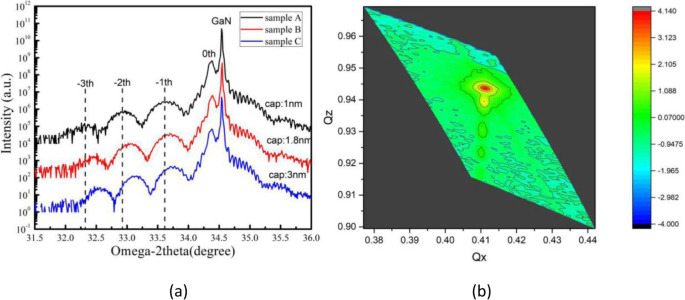
un Courbes de balayage XRD ω-2θ sur plan GaN (0002) pour les échantillons A, B et C. b Cartographie de l'espace réciproque de l'échantillon C
La figure 2 montre les spectres EL des échantillons A, B et C sous un courant de 5 mA. La longueur d'onde maximale est de 453,6 nm, 456,3 nm et 466,7 nm pour les échantillons A, B et C, respectivement. D'après les résultats des mesures XRD, à mesure que l'épaisseur de la couche de couverture LT-GaN augmente, l'augmentation de la composition en In dans les QW induira le décalage vers le rouge de l'énergie de crête EL. Nous avons également constaté que l'intensité EL diminuait avec l'augmentation de l'épaisseur de la couche de couverture de LT-GaN. Il est connu qu'une couche barrière GaN plus épaisse (l'épaisseur totale de la couche de couverture LT-GaN et HT-GaN QB) augmente la distance des trous du p-GaN à la région active, entraînant une réduction de l'efficacité d'injection des trous, ce qui conduit à une diminution de l'intensité EL [11, 12]. De plus, l'augmentation de la composition d'In améliorera le champ piézoélectrique dans la couche InGaN QW, de sorte que l'inclinaison de la bande d'énergie est aggravée, ce qui entraîne un décalage vers le rouge de l'émission de crête et une efficacité lumineuse réduite, connue sous le nom de Stark confiné quantique. effet (QCSE) [13,14,15]. Pour vérifier l'influence de QCSE sur EL, l'énergie de crête et la FWHM de EL changeant avec différentes injections sont illustrées à la Fig. 3. À mesure que le courant d'injection augmente, le décalage vers le bleu de l'énergie de crête d'émission peut être attribué à l'effet de remplissage de bande et à QCSE compensée par l'effet de filtrage électronique [16,17,18]. Étant donné que l'échantillon C avec la composition la plus In a le puits de potentiel le plus profond et le champ piézoélectrique le plus fort, l'effet de remplissage de bande et l'effet d'écran de charge sont les plus importants, de sorte que la quantité de décalage vers le bleu de l'énergie de crête EL est la plus grande pour l'échantillon C (166 meV ). L'effet de remplissage de bande et l'effet d'écran de charge dans l'échantillon A sont les plus faibles, de sorte que le rétrécissement de la bande interdite dû à l'effet thermique est progressivement dominant sous un courant d'injection élevé (50 mA), entraînant un décalage vers le rouge de l'énergie de crête. Pour l'échantillon A, la FWHM augmente avec l'augmentation du courant d'injection, comme le montre la figure 3b, indiquant que l'élargissement du spectre EL induit par l'effet de remplissage de bande est toujours dominant. Il a été rapporté que l'écran de charge du champ électrique polarisé dans les QW InGaN entraînera le rétrécissement de la bande passante spectrale EL avec l'augmentation du courant d'injection [19]. Par conséquent, pour les échantillons B et C, l'effet de remplissage de bande est significatif à des courants d'injection plus faibles, et le spectre EL est élargi. Au fur et à mesure que le courant d'injection augmente, le processus de filtrage des porteurs du champ électrique polarisé prend progressivement le relais, de sorte que la FWHM diminue. En outre, nous avons également constaté que le courant correspondant au tournant de la FWHM de la montée à la chute pour les échantillons B et C est d'environ 10 mA et 20 mA respectivement, ce qui implique également que le champ piézoélectrique dans l'échantillon C est le plus fort.
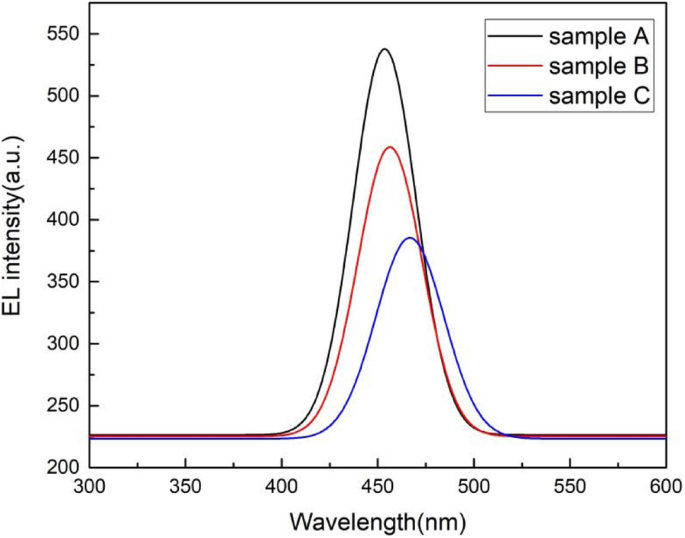
Spectres EL des échantillons A, B et C sous un courant de 5 mA
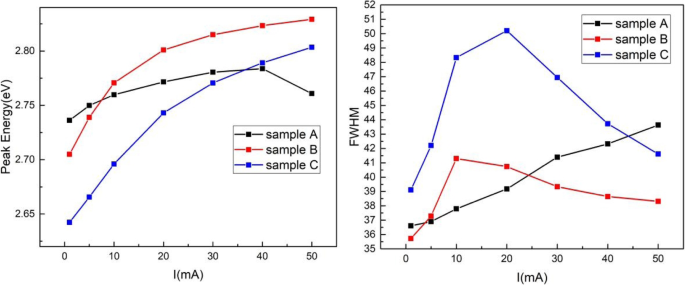
(un ) EL crête d'énergie et (b ) EL pleine largeur à mi-hauteur (FWHM) en fonction du courant d'injection pour les échantillons A, B et C
La figure 4a montre les spectres PL à température ambiante pour les échantillons A, B et C à une puissance d'excitation laser à semi-conducteur GaN de 5 mW 405 nm. La longueur d'onde maximale est de 473,1 nm, 472,9 nm et 478,2 nm pour les échantillons A, B et C, respectivement. Étant donné que l'intensité PL des échantillons B et C de la figure 4a est relativement faible, nous utilisons également un laser He-Cd de 325 nm comme source d'excitation pour exécuter l'expérience de photoluminescence. Les résultats expérimentaux de PL des figures 4a et b sont cohérents les uns avec les autres, ce qui élimine l'incertitude des résultats expérimentaux obtenus à partir de la figure 4a. Par rapport aux résultats de mesure EL de la figure 2, nous avons trouvé quelques anomalies sur la figure 4a :(1) l'échantillon A contient moins d'In que l'échantillon B, mais la longueur d'onde maximale de l'échantillon A est légèrement plus longue que celle de l'échantillon B; (2) l'intensité PL des échantillons B et C est similaire, et l'intensité lumineuse de l'échantillon A est beaucoup plus élevée que celle des échantillons B et C. Pour trouver les raisons pertinentes pour expliquer ces anomalies, PL dépendant de la température (TDPL ) a été réalisée pour trois échantillons, et l'énergie de crête PL en fonction de la température est montrée sur la figure 5. Pour l'échantillon B, l'énergie de crête d'émission diminue de façon monotone avec l'augmentation de la température. D'une manière générale, l'augmentation du rétrécissement de la bande interdite induite par la température entraînera un décalage vers le rouge de l'énergie d'émission. Cependant, il y a un décalage vers le bleu notable dans l'échantillon A lorsque la température augmente de 70 K à 190 K. La redistribution thermique des excitons localisés a été introduite pour expliquer le décalage vers le bleu d'émission anormal dans le TDPL :avec l'augmentation de la température, les excitons localisés ont été thermiquement activés et transfert thermique des minima potentiels des états de localisation à un état d'énergie plus élevé [5, 20, 21]. Pour l'échantillon C, l'énergie de crête PL est presque inchangée dans la plage de 50 K à 175 K, ce qui indique que l'effet de rétrécissement de la bande interdite et l'effet de localisation des excitons se compensent.
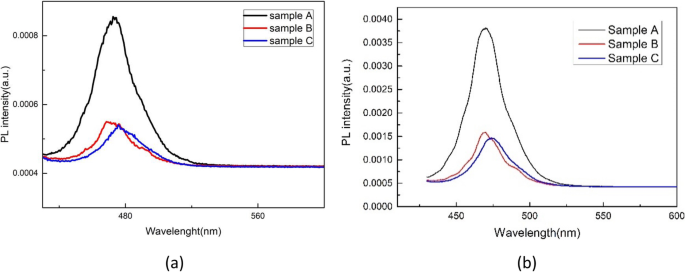
Spectres PL à température ambiante pour les échantillons A, B et C en utilisant un laser à semi-conducteur GaN de 405 nm (a ) et laser He-Cd 325 nm (b ). La longueur d'onde maximale est de 473,1 nm, 472,9 nm et 478,2 nm obtenue à partir de (a ) et 470,5 nm, 470,1 nm et 475,2 nm obtenus à partir de (b ) pour les échantillons A, B et C, respectivement
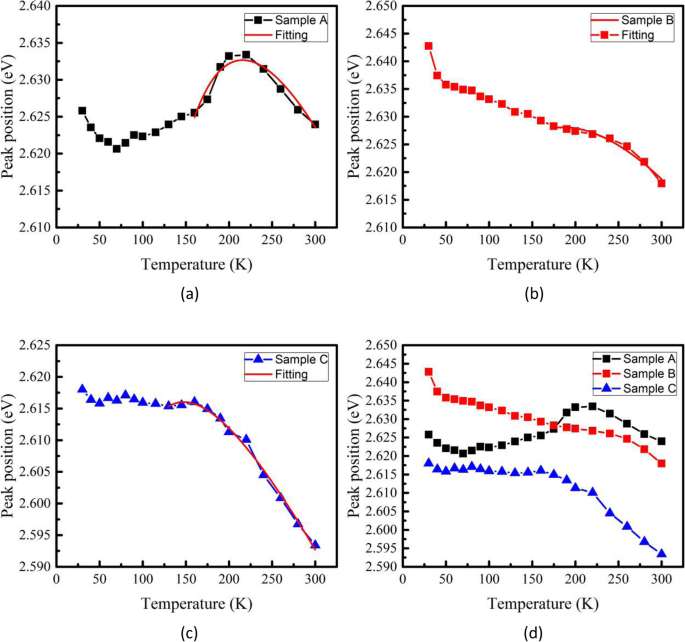
Les lignes rouges dans (a ), (b ), et (c ) sont des courbes d'ajustement basées sur l'équation. (1) et le paramètre d'ajustement σ est de 36,96 µmeV, 18,89 µmeV et 23,77 µmeV pour les échantillons A, B et C, respectivement. (d ) Affiche les données expérimentales de l'énergie de crête PL en fonction de la température
Compte tenu de l'effet de localisation des excitons, le modèle de queue de bande peut être révisé à l'expression suivante pour décrire l'énergie de pic d'émission dépendant de la température [22, 23] :
$$ {E}_0(T)={E}_0(0)\hbox{-} \frac{\alpha {T}^2}{T+\beta}\hbox{-} \frac{\sigma^2 }{{\mathrm{k}}_BT} $$ (1)où E 0 (0) est la bande interdite à T =0, α et β sont les paramètres de Varshini, k B est la constante de Boltzmann. Le troisième terme σ est l'écart type de la distribution localisée et décrit le degré d'effet de localisation, c'est-à-dire une valeur plus grande de σ signifie une plus forte inhomogénéité des états de localisation. La fluctuation de la composition d'In dans InGaN peut être la principale raison de la formation de queue de bande. Les états dans les queues de bande sont formés à l'énergie potentielle locale minimale, semblable aux points quantiques. La recombinaison de paires électron-trou dans ces boîtes quantiques autoformées peut être considérée comme une recombinaison d'excitons localisée [24, 25]. Le modèle n'est pas applicable aux basses températures en raison d'une forte dégénérescence et d'un écart possible par rapport au quasi-équilibre [20]. Le paramètre d'ajustement σ est de 36,96 µmeV, 18,89 µmeV et 23,77 µmeV pour les échantillons A, B et C respectivement, ce qui implique que les états de localisation de l'échantillon A avec la couche de couverture la plus mince sont les plus inhomogènes. En général, les états de localisation proviennent d'amas riches en In de différentes tailles et de la fluctuation de l'épaisseur QW dans les alliages InGaN. Par conséquent, nous pensons raisonnablement qu'une couche de couverture en LT-GaN plus mince ne peut pas empêcher efficacement l'évaporation de l'indium lors de l'augmentation de la température jusqu'à une couche de GaN QB développée. Le processus d'évaporation aléatoire de la composition d'indium entraîne une fluctuation de la teneur en In et de l'épaisseur de l'InGaN QW. Pour l'échantillon B, la couche de recouvrement GaN d'une épaisseur de 1,8 nm est suffisamment épaisse pour protéger In de la désorption afin de former une couche InGaN QW plus uniforme. Les états de localisation non homogènes conservent généralement un état potentiel plus profond et entraînent un décalage vers le rouge de l'énergie de pic d'émission. C'est pourquoi la longueur d'onde maximale de l'échantillon A est plus longue que celle de l'échantillon B observée sur la figure 4. De plus, une augmentation de la composition en In dans la couche InGaN QW favorisera également la formation d'amas de grande taille, ce qui explique pourquoi l'effet de localisation des excitons dans l'échantillon C avec la plus forte teneur en indium est légèrement plus fort que l'échantillon B.
La figure 6 montre l'intensité PL intégrée en fonction de la température pour les échantillons A et C, qui peut être bien ajustée par l'expression suivante [5, 26] :
$$ I(T)=\frac{1}{1+{\sum}_{\mathrm{i}}{C}_i\exp \left(-\frac{E_i}{k_BT}\right)} $ $ (2)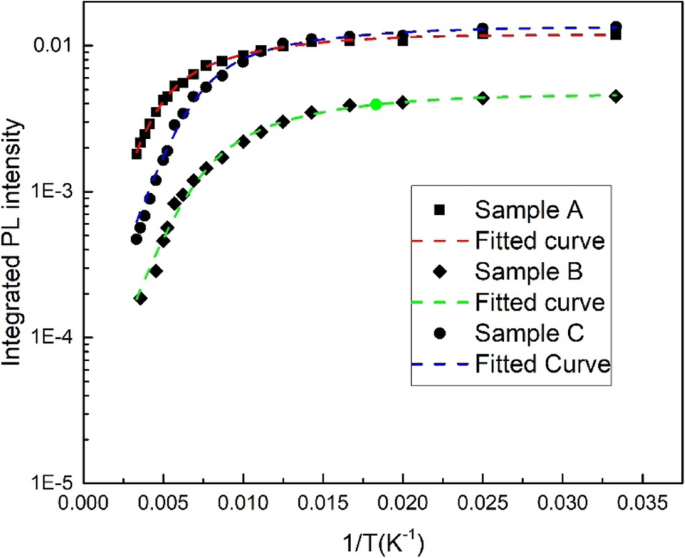
Intensité PL intégrée en fonction de la température inverse pour les échantillons A, B et C
où C je est une constante correspondant à la densité de centres de recombinaison non radiatifs, et E je représente l'énergie d'activation des centres de recombinaison non radiatifs. Le paramètre d'ajustement C je et E je ont été montrés dans le tableau 2. Il est à noter que la tension du photomultiplicateur dans le spectromètre à réseau pour l'échantillon B était inférieure à celle des échantillons A et C pendant les mesures PL dépendantes de la température ; par conséquent, l'intensité PL intégrée de l'échantillon B est la plus faible, mais elle n'affecte pas les résultats d'ajustement.
C 2 car les échantillons B et C sont plus grands que l'échantillon A, ce qui indique que davantage de défauts sont formés dans une couche de couverture de LT-GaN plus épaisse. Il a été observé que les défauts dans la couche LT-cap augmentaient avec l'augmentation de l'épaisseur de la couche LT-cap [6, 10]. L'influence des défauts dans la couche de couverture LT-GaN à côté du puits quantique sur l'intensité PL est significative car les fonctions d'onde des électrons et des trous pénètrent dans les barrières. L'énergie active de 79,67 meV (E a2 pour l'échantillon A) est liée à l'émission de trous à partir de QW suivie d'un piégeage par défauts barrière et d'une recombinaison non radiative, qui consistent avec les rapports d'Olaizola [6]. Nous avons également comparé les images micro-PL des échantillons A, B et C comme le montre la figure 7. Les taches sombres dans les images micro-PL peuvent être attribuées à la recombinaison non radiative dans la région active InGaN/GaN. Par rapport à l'échantillon A, des taches sombres de plus grande taille peuvent évidemment être observées dans les échantillons B et C, indiquant qu'il existe plus de défauts dans une couche de couverture de LT-GaN plus épaisse. En général, un recuit thermique est mis en œuvre après la couche de protection LT pour réduire l'amas d'indium dans la couche d'InGaN et améliorer la qualité du cristal. Si la couche de protection est trop épaisse, l'effet du recuit thermique sera affaibli, et la formation de plus de précipités d'indium métallique entravera la diffusion des adatomes de la couche de protection GaN et introduira plus de défauts dans la couche de protection LT. L'apparition de plus de défauts et d'un QCSE plus fort dans les MQW InGaN/GaN avec une couche de protection LT-GaN plus épaisse est désavantageuse pour améliorer l'intensité de la luminescence, alors pourquoi l'intensité PL de C est-elle comparable à B ? En fait, les états de localisation jouent également un rôle important dans l'amélioration de l'efficacité lumineuse. Les porteurs peuvent être capturés dans des états localisés et se recombiner radiativement. Plus l'effet localisé des excitons est fort, plus les porteurs ne seront pas capturés dans les défauts, ce qui semble expliquer que l'intensité PL des échantillons B et C est similaire l'une à l'autre, et l'intensité lumineuse de l'échantillon A est beaucoup plus élevée que celle des échantillons B et C.
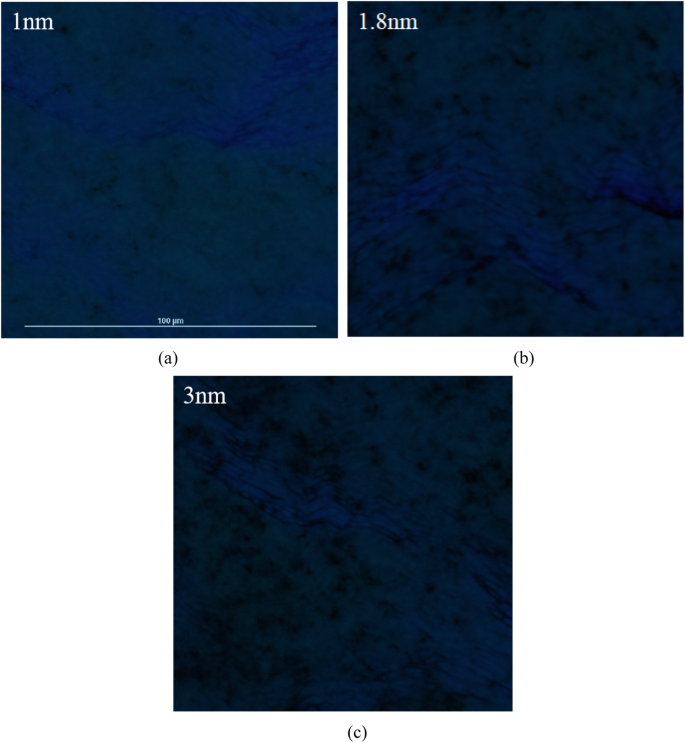
Images micro-PL des échantillons A, B et C avec différentes épaisseurs de couche de couverture LT-GaN (a ) 1 nm, (b ) 1,8 nm, et (c ) 3.0 nm
Conclusions
En résumé, l'influence de l'épaisseur de la couche de couverture de GaN sur les caractéristiques optiques a été étudiée. Les résultats obtenus à partir des mesures XRD montrent qu'une couche de couverture plus épaisse est plus efficace pour protéger la composition d'In de la désorption. QCSE est amélioré et l'efficacité d'injection de trous est réduite avec l'augmentation de l'épaisseur de la couche de couverture de GaN. Les divers degrés d'effet de localisation des excitons induits par différentes épaisseurs de couche de couverture de GaN expliquent les anomalies de la longueur d'onde et de l'intensité du pic PL pour trois échantillons. Une couche de capuchon LT trop mince exacerbera l'inhomogénéité des états de localisation dans la couche InGaN QW, et une couche de capuchon LT trop épaisse générera plus de défauts dans la couche de capuchon GaN. Par conséquent, l'optimisation de l'épaisseur de la couche de protection LT-GaN est un enjeu clé pour favoriser l'uniformité et l'intensité d'émission de la couche active d'InGaN.
Disponibilité des données et des matériaux
Les ensembles de données utilisés et/ou analysés au cours de la présente étude sont disponibles auprès de l'auteur correspondant sur demande raisonnable.
Abréviations
- MOCVD :
-
Dépôt chimique en phase vapeur métalorganique
- QCSE :
-
Effet Stark confiné quantique
- MQW :
-
Puits quantiques multiples
- QB :
-
Barrière quantique
- LED :
-
Diodes électroluminescentes
- LD :
-
Diodes laser
- HT :
-
Haute température
- LT :
-
Basse température
- EL :
-
Électroluminescence
- TDPL :
-
Photoluminescence dépendante de la température
- XRD :
-
Diffraction des rayons X
- FWHM :
-
Pleine largeur à mi-hauteur
Nanomatériaux
- Le réarrangement atomique de plusieurs puits quantiques à base de GaN dans du gaz mixte H2/NH3 pour améliorer les propriétés structurelles et optiques
- Émission multicolore de la structure nanopyramide quasi-cristalline photonique à base de GaN ultraviolet avec plusieurs puits quantiques semipolaires InxGa1−xN/GaN
- Les propriétés électriques des composites hybrides à base de nanotubes de carbone multiparois avec des nanoplaquettes de graphite
- Étude sur la polarisation de surface de l'hétérostructure GaN/AlGaN/GaN coiffée d'Al2O3 par spectroscopie photoélectronique à rayons X à résolution angulaire
- Effets de l'épaisseur de la bicouche sur les propriétés morphologiques, optiques et électriques des nanolaminés Al2O3/ZnO
- Réglage des morphologies de surface et des propriétés des films de ZnO par la conception de la couche interfaciale
- Couches de dopage au silicium optimal des barrières quantiques dans la séquence de croissance formant un potentiel de confinement souple de huit périodes In0.2Ga0.8N/GaN Puits quantiques de bleu LE…
- Enquête sur une cellule solaire au silicium cristallin avec une couche de silicium noir à l'arrière
- Morphologie, structure et propriétés optiques des films semi-conducteurs avec des nano-îlots GeSiSn et des couches tendues



