Étude de simulation du transistor à effet de champ en tunnel à double porte avec une épaisseur de canal en escalier
Résumé
Le transistor à effet de champ tunnel à double grille (DG TFET) devrait étendre les limitations du courant de fuite et de la pente sous le seuil. Cependant, il souffre également du comportement ambipolaire avec l'architecture source/drain symétrique. Pour vaincre le courant ambipolaire, il faut introduire une asymétrie entre la source et le drain. Dans cet article, nous étudions les performances du DG TFET avec une épaisseur de canal échelonnée (SC TFET) en utilisant la simulation 2D. L'asymétrie entre la source et le drain est introduite par l'épaisseur du canal en gradins; par conséquent, le comportement ambipolaire devrait être soulagé. Les résultats montrent que le TFET SC présente une réduction significative du courant ambipolaire par rapport au TFET DG conventionnel. Les mécanismes du SC TFET sont discutés en détail pour explorer la compréhension physique. Les impacts introduits par les paramètres de structure sur la tension de démarrage, la pente sous le seuil, le courant de drain à l'état passant et à l'état ambipolaire sont également présentés dans la détermination de la structure optimale.
Contexte
Alors que le processus de mise à l'échelle extrême se poursuit, la technologie CMOS avec MOSFET conventionnel rencontre divers défis tels que l'augmentation du courant de fuite et la pente sous-seuil (SS ). Le transistor à effet de champ tunnel (TFET), qui utilise les mécanismes de tunneling bande à bande (BTBT), devrait étendre les limites du courant de fuite et du SS [1,2,3,4,5,6,7,8]. Le TFET à base de silicium présente des avantages tels qu'une fiabilité élevée et un faible coût. Cependant, le TFET conventionnel à base de silicium présente un courant de passage relativement faible par rapport au MOSFET en raison du taux de BTBT contraint [9,10,11]. Pour développer le potentiel du TFET à base de silicium, diverses nouvelles structures de TFET ont été récemment proposées pour améliorer le courant à l'état passant. Le TFET à double grille (DG TFET) montre un taux de BTBT amélioré, conduisant à un courant de passage amélioré [12,13,14]. Cependant, le courant ambipolaire du DG TFET est également augmenté puisque l'amélioration du taux BTBT est également activée dans l'état ambipolaire [15]. Pour vaincre davantage le courant ambipolaire, une asymétrie doit être introduite entre source et drain [16]. Les TFET DG avec un recouvrement grille-drain et une concentration de dopage de drain moindre sont des méthodes courantes pour soulager le problème ambipolaire [17,18,19]. Mais la sous-couche grille-drain nécessite une plus grande distance S/D et moins de concentration de dopage de drain augmente les résistances série [15]. Un travail antérieur a montré que les effets ambipolaires dans le TFET avec sous-couche de drain pourraient être davantage atténués en utilisant les espaceurs à faible k et en plaçant les contacts dans la configuration supérieure et inférieure [15], suggérant que les stratégies d'asymétrie combinées pourraient être significatives dans améliorer les performances du TFET. Dans nos travaux précédents, il a été démontré que le FinFET avec une largeur d'aileron asymétrique améliore les performances du FinFET [20]. On pense également que l'épaisseur du canal t si a un impact significatif sur le taux BTBT de la DG TFET [21]; par conséquent, l'asymétrie entre l'épaisseur de la source et l'épaisseur du drain pourrait soulager davantage le courant ambipolaire et doit être étudiée en profondeur.
Dans cet article, nous étudions les différentes performances du DG TFET avec une épaisseur de canal échelonné (SC TFET), l'asymétrie entre la source et le drain est introduite à travers l'épaisseur du canal échelonné de sorte que le courant ambipolaire devrait être réduit. Le reste de cet article est organisé comme suit :la section 2 présente la structure de l'appareil et la configuration de la simulation. Dans la section 3, les mécanismes du SC TFET sont discutés en détail. La discussion détaillée concernant les impacts des paramètres de structure sur les courbes de transfert, la tension de début (V début ), SS moyen et le courant de drain à l'état passant/ambipolaire est également présenté. Enfin, les conclusions de cet article sont éclairées dans la section IV.
Structure et simulation
Le diagramme schématique du TFET SC considéré dans cet article est illustré à la Fig. 1a. L'épaisseur du canal près de la région de source n'est pas égale à l'épaisseur du canal près de la région de drain. L'épaisseur du canal change progressivement à un certain point dans la région du canal. La hauteur de marche et la position de marche sont désignées par H et L s respectivement. t si1 et t si2 sont respectivement l'épaisseur du canal près de la région de source et de la région de drain. L'épaisseur effective d'oxyde (EOT) est de 1 nm dans notre simulation. La région source est fortement dopée p (10 20 atomes/cm 3 ) et la région de drain est fortement dopée n (10 20 atomes/cm 3 ) pour réduire la résistance série [15], la région du canal est légèrement dopée n (10 17 atomes/cm 3 ). Afin d'analyser la tension de début avec diverses configurations d'épaisseur de canal, le travail de sortie de la grille métallique est fixé à 4,5 eV, la longueur de la grille est égale à la longueur du canal L ch et réglé à 50 nm [22,23,24,25]. Les simulations sont réalisées à l'aide de la version Sentaurus TCAD I-2013.12 [26, 27]. Le modèle de dépendance au dopage et le modèle de mobilité dépendant du champ sont respectivement le modèle de mobilité unifié Philips et le modèle de mobilité Lombardi. Les statistiques de Fermi-Dirac, Shockley-Read-Hall et le modèle de recombinaison Auger sont également utilisés. Afin de tenir compte des régions source/drain fortement dopées, le modèle de rétrécissement de la bande interdite est activé. Le modèle BTBT non local basé sur l'approximation de Wentzel-Kramer-Brillouin (WKB) ajustée avec les résultats expérimentaux de [28] et le modèle de quantification à gradient de densité permettent d'obtenir une simulation précise [29, 30]. La tension de démarrage est définie comme la tension de grille à laquelle la pente sous-seuil est maximale. Le SS moyen est extrait du courant à l'état bloqué vers I d =10 −11 A/μm.
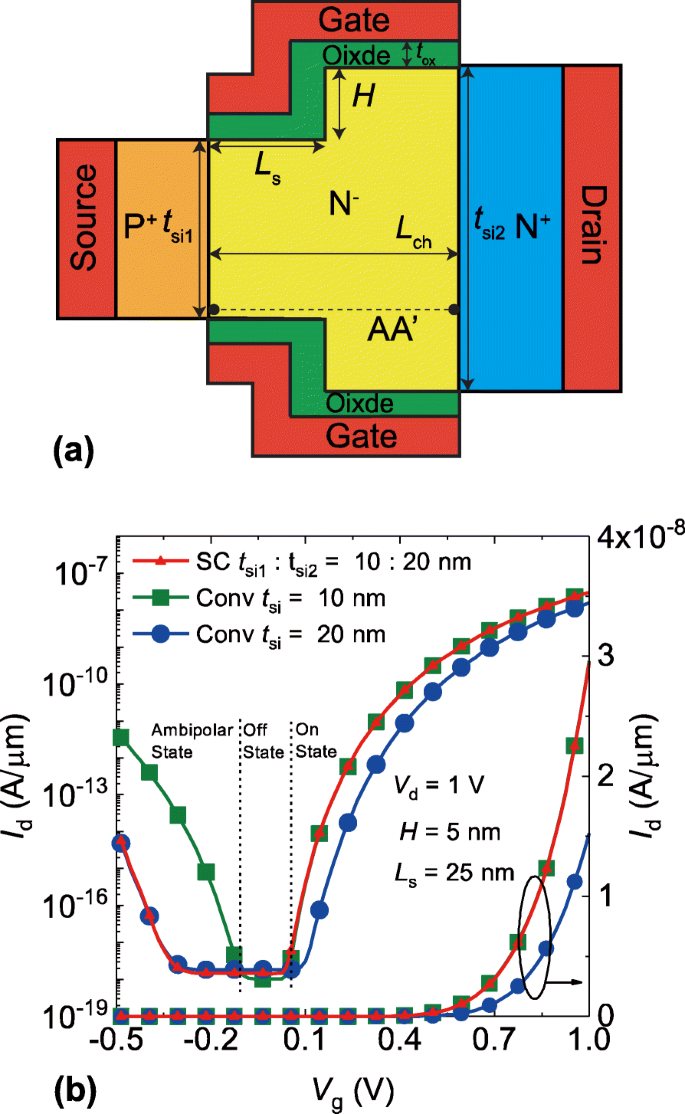
un Schéma 2D du SC TFET, t si1 et t si2 sont l'épaisseur du canal près de la région de source et de la région de drain, l'asymétrie entre la source et le drain est évidemment introduite. La ligne de coupe AA' est la ligne de coupe le long de la direction horizontale. La distance verticale entre la ligne de coupe et la surface de la région source est de 0,5 nm. b Courbes de transfert du TFET SC et des TFET DG conventionnels en échelle logarithmique et linéaire
Résultats et discussion
Courbes et mécanisme de transfert
La figure 1b montre les courbes de transfert du TFET SC et du TFET DG conventionnel en échelle logarithmique et linéaire, respectivement. Nous marquons l'état activé, l'état désactivé et l'état ambipolaire sur la figure 1b. Pour les TFET, un courant plus élevé d'état passant et un courant plus faible d'état ambipolaire sont toujours souhaités, ce qui nécessite que le V début et SS doit être faible tandis que l'état désactivé doit avoir une large plage de tension. Comme le montre la figure 1b, le V début du TFET DG conventionnel avec une épaisseur de canal de 10 nm sont inférieurs à celui du TFET DG avec une épaisseur de canal de 20 nm. Le V extrait début de la DG TFET avec t si =10 nm est 0,04 V et sa moyenne extraite SS est de 44,8 mV/déc, le V début et le SS moyen de la DG TFET conventionnelle avec t si =20 nm est de 0,1 V et 50,6 mV/déc, respectivement. Le courant de drain du DG TFET conventionnel avec t si =10 nm est amélioré de 94,7% par rapport au TFET DG conventionnel avec t si =20 nm. La principale raison de cette amélioration du courant de drain est la réduction du SS et V début . Cependant, la plage hors état du TFET DG conventionnel avec t si =10 nm est seulement 0,17 V. Le TFET DG conventionnel avec t si =20 nm, en comparaison, présente une plage d'état désactivé de 0,45 V. En conséquence, le courant à l'état ambipolaire du TFET DG conventionnel avec t si =20 nm est réduit de 3 ordres de grandeur par rapport au TFET DG conventionnel avec t si =10 nm.
Pour une comparaison équitable, le t si1 et t si2 des TFET SC sont respectivement égaux aux épaisseurs de canal des TFET DG conventionnels ci-dessus. L'épaisseur de canal plus étroite t si1 de SC TFET est de 10 nm et l'épaisseur de canal plus large t si2 de SC TFET est de 20 nm. La position de marche est supposée au milieu du canal et du L s est de 25 nm. On peut observer que le SC TFET présente des caractéristiques prometteuses, notamment le courant de drain élevé à l'état passant ainsi que la large plage d'états bloqués. Le courant de drain du TFET SC à l'état passant est similaire à celui du TFET DG conventionnel avec t si =10 nm, le SS moyen est de 45,8 mV/déc et le V début est de 0,03 V. Cependant, la plage d'état désactivé du TFET SC est améliorée jusqu'à 123,5 % et le courant à l'état ambipolaire est également réduit de 3 ordres de grandeur par rapport au TFET DG conventionnel avec t si =10 nm. En conséquence, les caractéristiques à l'état passant du TFET SC sont similaires à celles du TFET DG conventionnel avec une épaisseur de canal étroite, le TFET SC présente également des courbes off/ambipolaires presque parallèles au TFET DG conventionnel avec une épaisseur de canal large. Par conséquent, le SC TFET peut atteindre un faible SS , réduit V début , et une large plage d'état hors tension simultanément.
Pour explorer le mécanisme physique du SC TFET, nous comparons les taux BTBT et les diagrammes de bandes d'énergie dans l'état passant, proche du point de déclenchement et dans l'état ambipolaire, respectivement. La figure 2a montre les taux BTBT du TFET SC et des TFET DG conventionnels. On peut voir que le taux de BTBT dépend fortement de l'épaisseur du canal. En fait, la relation entre l'épaisseur du canal et le courant BTBT I BTBT peut être exprimé par [31].
$$ {I}_{BTBT}\propto \exp \left(-\frac{4\lambda \sqrt{2{m}^{\ast }{E_g}^{2/3}}}{3\mathrm {\hslash}\left(\Delta \Phi +{E}_g\right)}\right) $$ (1)
un Tarifs BTBT et b diagramme de bande d'énergie du TFET SC et des TFET DG conventionnels à l'état passant, la distance est la position latérale de la ligne de coupe AA' sur la figure 1
Où λ =(ε si t si t bœuf /2ε bœuf ) 1/2 est la longueur naturelle, ε si et ε bœuf sont respectivement la permittivité du silicium et de l'oxyde et t bœuf est l'épaisseur d'oxyde. ΔΦ est la plage d'énergie sur laquelle le tunnel peut avoir lieu, E g est la bande interdite à la jonction tunnel, et m * est la masse tunnel. L'équation (1) indique que le I BTBT devrait augmenter à mesure que t si réduit. Par conséquent, le taux BTBT de la DG TFET conventionnelle avec t si =10 nm devrait être supérieur à celui du TFET DG conventionnel avec t si =20 nm. Le SC TFET montre une distribution similaire du taux BTBT au TFET DG conventionnel avec t si =10 nm. En effet, le BTBT se produit principalement près de la jonction source à l'état passant, par conséquent l'épaisseur du canal près de la jonction source déterminera le taux de BTBT à l'état passant. La figure 2b montre le diagramme de bande d'énergie du TFET SC et des TFET DG conventionnels. Le taux BTBT étant fondamentalement lié à la distance de tunnel, le diagramme de bande d'énergie, qui peut présenter clairement la distance de tunnel, expliquera l'origine de la variation des taux BTBT. Sur la figure 2b, la distance de tunnelage minimale du TFET SC est située près de la jonction source et est plus ou moins égale à celle du TFET DG conventionnel avec t si =10 nm. La distance de tunnelage minimale du TFET DG conventionnel avec t si =20 nm est significativement plus large; par conséquent, son taux de BTBT est réduit par rapport au TFET SC et au TFET DG conventionnel avec une épaisseur de canal plus mince.
La figure 3a montre les taux BTBT lorsque la tension de grille est nulle et proche de la tension de début. On peut voir que le SC TFET détient le taux de BTBT le plus élevé, suivi du conventionnel DG TFET avec t si =10 nm. La DG TFET conventionnelle avec t si =20 nm montre le taux BTBT le plus bas. La figure 3b présente le diagramme de bande d'énergie correspondant. On peut observer que l'emplacement de la distance minimale de la bande de valence à la bande de conduction est au centre de la région du canal. En outre, la distance minimale du TFET DG conventionnel avec une épaisseur de canal plus large est plus longue que celle du TFET SC et du TFET DG conventionnel avec une épaisseur de canal plus mince. Cela indique que l'épaisseur du canal a également un impact significatif sur le taux de BTBT au point de début. Par conséquent, le V début dépend aussi de l'épaisseur du canal. Un autre fait est que le TFET SC présente un taux de BTBT supérieur à celui du TFET DG conventionnel avec t si =10 nm même si leurs épaisseurs de canaux minimales sont égales. Ce phénomène est attribué à la variation de distribution de potentiel introduite par le coin de l'électrode de grille, comme cela peut également être observé dans d'autres travaux [32, 33]. En conséquence, le SC TFET affiche le V le plus bas début , suivi par le TFET DG conventionnel avec une épaisseur de canal mince, et le TFET DG conventionnel avec une épaisseur de canal large présente le V le plus élevé début .

un Tarifs BTBT et b diagramme de bande d'énergie du TFET SC et des TFET DG conventionnels au point d'apparition proche, la distance est la position latérale de la ligne de coupe AA' sur la figure 1
La figure 4a montre la comparaison des taux BTBT dans l'état ambipolaire. Étant donné que le taux BTBT dépend fortement de l'épaisseur du canal, le TFET conventionnel avec t si =10 nm montre le taux BTBT le plus important par rapport aux deux autres structures TFET. Le SC TFET, cependant, présente un taux de BTBT similaire à celui du TFET DG conventionnel avec t si =20 nm. C'est parce que l'effet tunnel est principalement généré près de la région de drain et que le SC TFET a une épaisseur de canal plus large près de la région de drain. Sur la figure 4b, le diagramme de bande d'énergie dans l'état ambipolaire est également présenté. On peut clairement voir que la distance minimale de tunnel est située près de la région du drain. En outre, les distances d'effet tunnel du TFET SC et du TFET DG conventionnel avec une épaisseur de canal plus large sont supérieures à celles du TFET DG conventionnel avec une épaisseur de canal plus mince, ce qui entraîne le faible courant ambipolaire du TFET SC et du TFET DG conventionnel avec une épaisseur de canal plus large.

un Tarifs BTBT et b diagramme de bande d'énergie du TFET SC et des TFET DG conventionnels à l'état ambipolaire, la distance est la position latérale de la ligne de coupe AA' sur la figure 1
Impacts de H et LS sur les caractéristiques DC
La figure 5a montre les courbes de transfert du SC TFET avec divers H et t si1 =10 nm. On peut voir que le H a moins d'impact sur le courant à l'état passant. Le courant ambipolaire, cependant, diminue considérablement à mesure que le H augmente, la plage hors état s'améliore avec l'augmentation de H également. On peut également voir que la réduction du courant ambipolaire diminue à mesure que le H augmente. La raison en est que l'effet de couplage de la structure à double grille a tendance à être moins important avec une épaisseur de canal plus importante [31]. Par conséquent, en tant que H augmente, les taux BTBT deviennent plus indépendants de l'épaisseur du canal, conduisant à la saturation du courant ambipolaire. Pour explorer davantage le paramètre de structure optimal, les effets de H varie de 0 à 15 nm sur les performances de l'appareil sont extraites et montrées dans la Fig. 5b–d. La figure 5b montre le V début et la variation du taux BTBT avec différents H et t si1 . On peut voir que le V début diminue de façon monotone avec l'augmentation de H . En effet, le coin de l'électrode de grille introduirait la variation de la distribution de potentiel dans la région du canal [32, 33], entraînant une modification du taux BTBT et du V début . La figure 5b montre que le taux BTBT augmente à mesure que le H s'améliore. En conséquence, la diminution de V début peut être trouvé avec l'augmentation H . On peut également observer que V début augmente à mesure que le t si1 augmente. La raison principale est que l'augmentation du t si1 affaiblit le taux BTBT, entraînant un V plus élevé début . Sur la figure 5c, le SS moyen extrait de SC TFET avec divers H et t si1 est montré. La tendance de la SS avec différents H est opposé à celui du V début . En d'autres termes, la SS s'élève à mesure que le H augmente. Nous avons mentionné que le courant de drain à l'état passant dépend du t si1 , de sorte que les TFET SC avec différents H mais avec le même t si1 devrait avoir le même courant de drain à l'état passant. En outre, il est également connu que le V début diminue avec l'augmentation de H . Cela implique que la plage de tension de grille pour piloter le même courant de drain est améliorée que le H augmente. En conséquence, le SS moyen augmente de façon monotone avec la montée de H . On peut également voir que l'augmentation de t si1 sapera la SS , ce qui est dû à la capacité de contrôle de porte réduite. La figure 5d montre le courant de drain à l'état passant et à l'état ambipolaire avec différents H et t si1 , respectivement. Le courant à l'état passant est presque indépendant sur le H , mais il est grandement affecté par le t si1 , ce qui correspond à notre résultat précédent selon lequel l'effet tunnel à l'état passant se produit principalement près de la région source et dépend fortement de l'épaisseur du canal près de la région source. Le courant ambipolaire, cependant, diminue à mesure que le H augmente. Étant donné que l'effet tunnel de l'état ambipolaire est dominé près de la région du drain, l'augmentation de H améliorera l'épaisseur du canal côté drain et affaiblira ainsi le courant ambipolaire. On peut également voir que le courant ambipolaire chute plus significativement lorsque le H est inférieure à 10 nm, ce qui est dû à l'effet de couplage plus important avec une épaisseur de canal plus mince.

Les impacts de H sur le a courbes de transfert, b V apparition et taux de BTBT, c SS moyen , et d drainer le courant à l'état activé/ambipolaire, H est la hauteur de la marche et H =0 nm représente le TFET DG conventionnel
Sur la figure 6a, les courbes de transfert du SC TFET avec différents L s sont présentés respectivement. L s =0 nm représente le TFET DG conventionnel avec le t correspondant si2 et L s =50 nm représente le TFET DG conventionnel avec le t correspondant si1 . On peut voir que l'emplacement de l'étape a un impact significatif sur le courant ambipolaire et la plage d'état bloqué. Les TFET SC avec L s moins de 30 nm montrent un courant ambipolaire et une plage d'état bloqué similaires. En tant que L s dépasse 30 nm, le courant ambipolaire est fortement renforcé. La figure 6b montre le V début et la variation du taux BTBT avec divers L s et t si1 , la tendance que le V début augmente à mesure que le t si1 des améliorations peuvent également être clairement observées. Le point d'inflexion du changement sur le L s =10 nm est le résultat de la variété du t si1 . Depuis L s =0 nm est le TFET DG conventionnel avec une plus grande épaisseur de canal, le taux de BTBT réduirait, entraînant une augmentation de V début et une diminution du courant à l'état passant. Hormis le cas de la DG TFET conventionnelle, le V début de SC TFET est augmenté de façon monotone à mesure que le L s augmente, ce qui est dû au taux de BTBT réduit induit par la structure de canal à gradins. La figure 6c montre les impacts du L s et t si1 sur le SS des TFET SC. L'augmentation t si1 entraîne la dégradation du SS . Selon l'éq. (1), une épaisseur de canal élevée réduirait les effets de couplage entre les électrodes de grille, conduisant à une capacité de contrôle de grille réduite et à un SS accru [12]. En tant que L s chutes, la région avec une plus grande épaisseur de canal s'étendra et affaiblira la capacité globale de contrôle de grille. En conséquence, un L réduit s sapera la SS des TFET SC, qui peuvent être clairement observés sur la figure 6c. La figure 6d présente le courant de drain à l'état passant et à l'état ambipolaire avec différents L s et t si1 , respectivement. On peut observer que le courant à l'état passant du SC TFET est plus ou moins égal au DG TFET conventionnel avec le t correspondant si1 . Quant au courant ambipolaire, les SC TFET avec L s moins de 30 nm montrent un courant similaire aux TFET DG conventionnels avec le t correspondant si2 . Lorsque le L s augmente jusqu'à 40 nm, le courant ambipolaire augmente considérablement. En fait, pour le cas du SC TFET avec L s =40 nm et t si1 =20 nm, son courant ambipolaire est même supérieur à celui du TFET DG conventionnel avec t si1 =20 nm. En effet, la partie verticale de l'électrode de grille peut améliorer la zone d'effet tunnel, en particulier lorsque la partie verticale de l'électrode de grille est proche de la jonction PN [34]. Il indique que le L s doit être inférieur à 40 nm dans le but de réduire le courant ambipolaire.

Les impacts de L s sur le a courbes de transfert, b V apparition et taux de BTBT, c SS moyen , et d drainer le courant à l'état activé/ambipolaire, L s est la distance latérale de la région source à la marche, L s =0 nm représente le TFET DG conventionnel avec le t correspondant si2 et L s =50 nm représente le TFET DG conventionnel avec le t correspondant si1.
Pour déterminer les paramètres de structure optimaux du SC TFET, une simulation orthogonale est réalisée en étudiant l'effet combiné du H et le L s sur les performances de l'appareil. Le t si1 est fixé à 10 nm pour obtenir un plus grand courant à l'état passant. Sur la figure 7a, le courant ambipolaire est extrait en fonction du L s avec divers H . On peut clairement voir que le courant ambipolaire diminue considérablement à mesure que le H diminue, ce qui suggère qu'un H plus élevé est prometteur en termes d'obtention d'un courant ambipolaire plus faible. Cependant, on peut observer que le bénéfice d'une plus grande H est moins important. Par conséquent, un H =15 nm serait la valeur optimale en considérant qu'un plus grand H ne pouvait qu'augmenter la surface de l'appareil. Pendant ce temps, une diminution de L s réduira également le courant ambipolaire surtout avec un plus grand H . Par conséquent, un L inférieur s est souhaitée dans le but d'un courant ambipolaire minimal. Néanmoins, un L inférieur s pourrait également conduire à une augmentation de la pente sous-seuil, comme on peut l'observer sur la figure 7b. La pente sous-seuil augmente lentement avec un L plus élevé s mais augmente rapidement avec un L inférieur s , indiquant qu'un L s environ 25 nm serait la valeur de compromis. Par conséquent, les paramètres optimaux de l'appareil seraient H =15 nm et L s =25 nm où le courant ambipolaire et la pente sous-seuil sont relativement faibles.
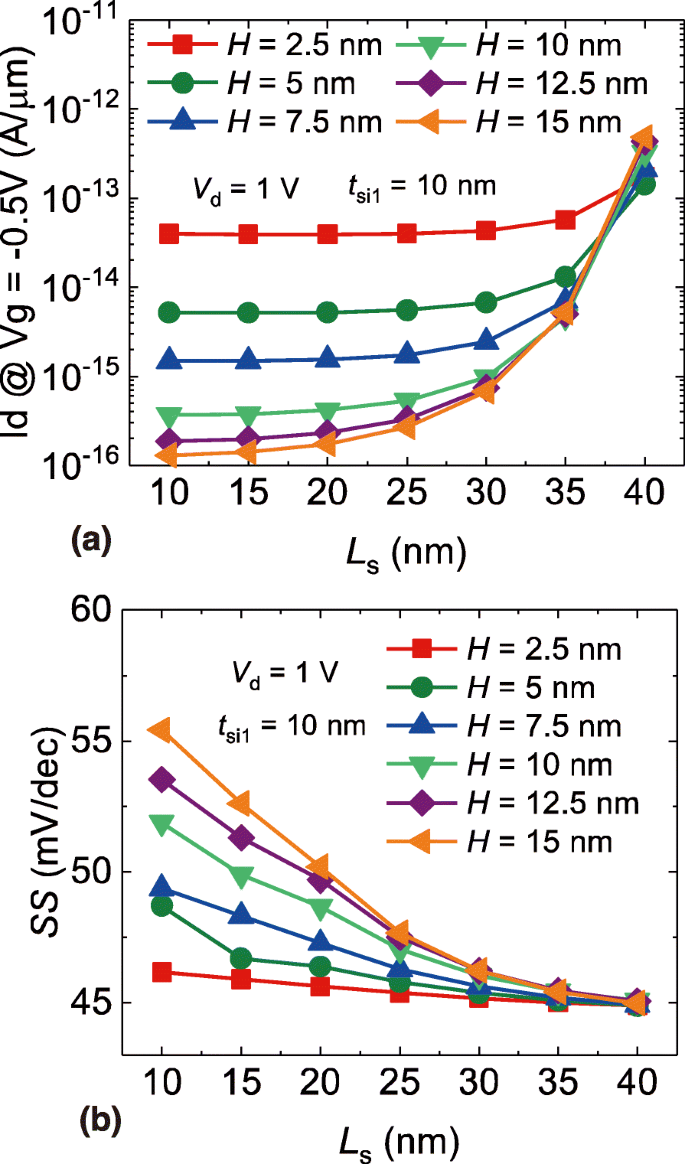
un Le courant ambipolaire et b la pente sous-seuil du SC TFET en fonction du L S avec divers H
Méthode de fabrication
Un processus de fabrication réalisable du TFET SC est présenté sur la figure 8. En raison de la forme unique du canal, l'épaisseur du canal à gradins peut être obtenue plus facilement en adoptant la structure verticale. Le processus commence par la préparation du substrat de silicium avec dépôt de SiN et de résine photosensible, comme illustré sur la figure 8a. Sur la figure 8b, le motif SiN est réalisé par lithographie, suivi de la gravure pour former la région du canal, puis le N + région est introduite par une implantation d'As verticale et un recuit [35]. Après cela, l'oxyde d'isolement est déposé pour empêcher la région de drain de se graver dans le processus suivant, comme le montre la figure 8c. Sur la figure 8d, l'incinération et le rognage sont adoptés en utilisant la gravure ionique réactionnelle [36] pour réduire l'épaisseur et la largeur de SiN. L'épaisseur du canal en gradins est ensuite introduite par gravure, comme le montre la figure 8e. Les processus restants sont similaires au TFET vertical conventionnel, impliquant la formation d'oxyde de grille, le dépôt de grille, l'exposition au silicium et l'implantation de la région source [35, 37], comme le montre la figure 8f.
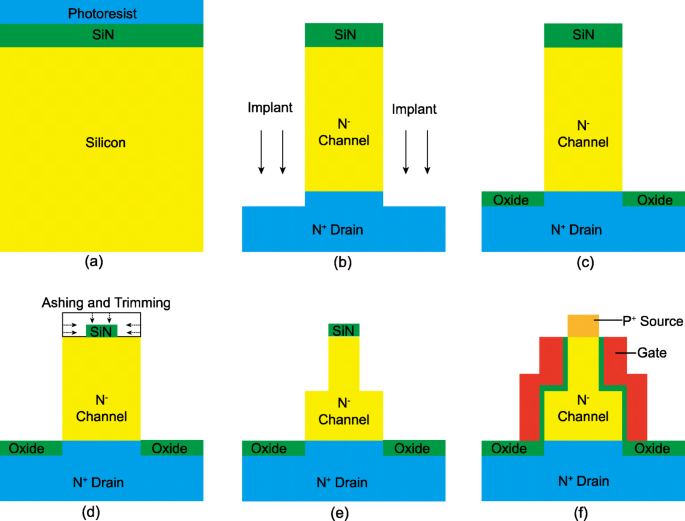
Processus de fabrication du SC TFET. un Préparation du substrat de silicium avec dépôt de SiN et photoresist. b Gravure, implantation et recuit. c Dépôt d'oxyde d'isolement. d Réduction de l'épaisseur et de la largeur du SiN par incinération et rognage. e L'épaisseur du canal à gradins est introduite. f Formation d'oxyde de grille, dépôt de grille, planarisation de grille et implantation de région source
Conclusion
Nous étudions les performances électriques du DG TFET avec une épaisseur de canal échelonnée (SC TFET) en utilisant la simulation 2D. L'asymétrie entre la source et le drain s'introduit à travers l'épaisseur du canal en gradins; par conséquent, le comportement ambipolaire est considérablement soulagé. Le TFET SC présente des caractéristiques à l'état passant similaires à celles du TFET DG conventionnel avec le t correspondant si1 et courbes parallèles off/ambipolaires du TFET DG conventionnel avec le t correspondant si2 . En conséquence, le SC TFET peut atteindre une large plage d'états off, un faible courant ambipolaire et maintenir le faible SS simultanément. Les mécanismes du SC TFET sont discutés en détail pour explorer la compréhension physique. Les impacts introduits par les paramètres de structure sur la tension de démarrage, la pente sous le seuil, le courant de drain à l'état passant et l'état ambipolaire sont également étudiés pour déterminer la structure optimale. Le SC TFET avec H de 15 nm et L s de 25 nm montre les performances optimales. De plus, l'architecture de l'épaisseur du canal à gradins offre une méthode alternative d'asymétrie. Étant donné que les stratégies d'asymétrie combinées se sont avérées efficaces, nos travaux pourraient encore améliorer les performances du TFET.
Disponibilité des données et des matériaux
Toutes les données sont entièrement disponibles sans restriction.
Abréviations
- DG TFET :
-
Transistor à effet de champ tunnel à double grille
- SC TFET :
-
DG TFET avec épaisseur de canal échelonnée
- SS :
-
Pente sous le seuil
- BTBT :
-
Tunneling bande à bande
- EOT :
-
Épaisseur effective d'oxyde
- V début :
-
Tension de début
- H :
-
Hauteur de marche
- L s :
-
Position des marches
- L ch :
-
Longueur du canal
- t si :
-
Épaisseur du canal
- t si1 :
-
Épaisseur du canal près de la région source
- t si2 :
-
Épaisseur du canal près de la zone de drainage
Nanomatériaux
- Connexion des pièces :intégration d'un composant portable conforme à FACE à un environnement de simulation
- Le transistor à effet de champ à jonction (JFET) en tant que commutateur
- Comprendre les composants de courant de fuite dans les transistors MOS à canal court
- En accord avec le cœur d'un atome de cuivre
- MoS2 avec épaisseur contrôlée pour l'évolution électrocatalytique de l'hydrogène
- Effet de surface sur le transport du pétrole dans les nanocanaux :une étude de dynamique moléculaire
- Étude d'un nouveau système micellaire ressemblant à un ver amélioré par des nanoparticules
- L'optimisation de la programmation de la DRAM 1T sans condensateur basée sur le TFET à double porte
- Transistors à effet de champ ferroélectrique à base de motifs à rayures micrométriques à dominance de nanotubes de carbone à simple paroi avec couche de contrôle des défauts HfO2



