Un Memristor à plusieurs niveaux basé sur une couche mince HfO2 dopé Al
Résumé
La mémoire non volatile (NVM) jouera un rôle très important dans les technologies numériques de prochaine génération, y compris l'Internet des objets. Les memristors à oxyde métallique, notamment à base de HfO2 , ont été privilégiés par de nombreux chercheurs en raison de sa structure simple, de son intégration élevée, de sa vitesse de fonctionnement rapide, de sa faible consommation d'énergie et de sa compatibilité élevée avec les technologies CMOS avancées (silicium à oxyde métallique complémentaire). Dans cet article, une résistance stable à 20 niveaux indique HfO2 dopé à l'Al -basé memristor est présenté. Son endurance de cycles, son temps de rétention des données et son rapport de résistance sont supérieurs à 10 3 ,>10 4 s et> 10, respectivement.
Contexte
Bien que le phénomène de résistance négative ait d'abord été découvert par Hickmott dans un Al/Al2 O3 /Au en 1962 [1], et Chua a proposé le concept de memristor en 1971 [2]. Ce n'est que lorsque Strukov et al ont préparé le TiO2 -based memristor en 2008 [3] que les gens ont commencé à prêter attention à l'étude sur les memristors. À l'heure actuelle, les chercheurs ont préparé des memristors avec plus de dizaines de matériaux résistifs actifs, y compris de multiples oxydes complexes [4, 5], des oxydes métalliques tels que ZnO [6], TiOx [7], TaOx [8], et les matériaux bidimensionnels [9, 10]. HfO2 a été utilisé comme diélectrique de grille à k élevé dans les dispositifs CMOS en raison de sa haute fiabilité, de sa vitesse de fonctionnement rapide et de sa faible consommation d'énergie [11, 12]. Il est également préféré par les chercheurs comme matériau memristif [13,14,15].
Le memristor à plusieurs niveaux peut être largement utilisé comme stockage de données [16,17,18], calcul logique [19], dispositif synaptique électronique [20,21,22,23], etc. Wang Y. [16] et Gao B. et al. [24] préparé des memristors multi-niveaux en dopant HfO2 avec Cu et Gd, respectivement, mais ils ne peuvent créer qu'un état de stockage à 4 niveaux, ce qui est difficile pour répondre aux demandes des applications. Par conséquent, l'étude sur HfO2 memristors multi-niveaux est d'une grande importance.
Méthodes
Ti/Al:HfO2 Le dispositif /Pt a été fabriqué comme le montre la figure 1a. La zone de cellule active a été définie par l'électrode supérieure en Ti de forme carrée (TE). Une couche adhésive Ti de 20 nm a été déposée par pulvérisation cathodique en courant continu (DC) sur un substrat de silicium, puis un film de Pt de 100 nm a été déposé en tant qu'électrode inférieure (BE). Le HfO2 dopé Al 20 nm couche fonctionnelle a été déposée par le réacteur de dépôt de couche atomique (ALD) (R-150, Picosun, Espoo, Finlande) à 300 °C avec MeCp2 HfMe(OMe) (noté HfD-04) comme précurseur Hf, et H2 O comme source d'oxygène [25]. Les précurseurs ont été transportés par N2 de haute pureté (> 99,999 %) dans la chambre du réacteur. Les films dopés Al ont été obtenus en déposant un cycle d'Al2 O3 à tous les 8 cycles de HfO2 avec le triméthylaluminium (TMA) comme source d'Al et H2 O comme source d'oxygène. La concentration atomique en Al de 6,2 % est détectée par spectroscopie photoélectronique à rayons X (XPS, Axis Ultra DLD, Kratos Analytical, Manchester, Royaume-Uni) sur un système Theta 300 XPS de Thermo Fisher. Un film de 50 nm de Ti en tant que TE et 100 nm de Pt en tant que couche de recouvrement ont été déposés par pulvérisation cathodique DC. Les dispositifs sont obtenus en modelant le TE par lithographie optique et processus de décollage. La figure 1b est la micrographie optique des dispositifs. Nous avons préparé des appareils avec différentes zones allant de 5 m × 5 m à 500 m × 500 μm.
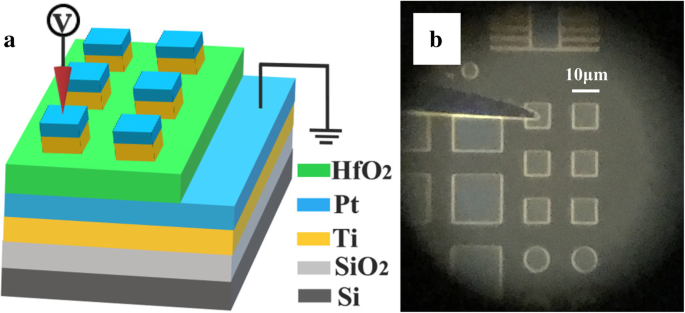
La structure des appareils. un Modèle 3D des memristors. b Microscopie optique des appareils
Résultats et discussion
La figure 2 montre le XPS des dispositifs dopés à l'Al et non dopés. Comparés aux spectrogrammes des dispositifs non dopés, les dispositifs dopés à l'Al montrent un pic distinct de 74,1 eV d'Al 2p sur la figure 2a, et l'énergie de liaison de Hf 4f a une certaine augmentation sur la figure 2b. Le rapport de Hf 4f5/2 à Hf 4f7/2 également augmenté pour les dispositifs dopés. Il est cohérent avec les autres rapports [14, 26, 27]. Les atomes d'Al se lient à la structure HfO2 pour former Hf-Al-O, ce qui entraîne des liaisons Hf-O plus faibles et plus faciles à rompre.

L'XPS des appareils dopés à l'Al et non dopés. un Al 2p et b Hf 4f sont comparés
Pour toutes les mesures électriques, le Ti TE était polarisé tandis que le Pt BE était mis à la terre. Des balayages CC ont été effectués à l'aide d'un analyseur de paramètres B1500A (Santa Clara, Californie, États-Unis) avec une source/unité de mesure, et des mesures électriques par impulsions avec un générateur de formes d'onde/unité de mesure rapide sont également utilisées. Tous les appareils présentent un état de résistance élevée (HRS) avant un processus de formage électrique nécessaire. La figure 3a montre la caractéristique de formation des dispositifs 10 m × 10 m dopés Al et non dopés. Une conformité de courant pendant le formage est nécessaire pour protéger les appareils contre les dommages. La résistance initiale et la tension de formation du dispositif non dopé sont plus grandes. L'oscillation dans la zone basse tension du dispositif non dopé est due au fait que le courant est inférieur à la limite de mesure de l'instrument. Le processus de réinitialisation après l'étape de formation est motivé par l'application d'une tension négative, comme illustré sur la figure 3a, puis le premier processus défini est motivé. Au fur et à mesure que l'amplitude de tension de réinitialisation augmente, le courant des deux dispositifs augmente jusqu'à un maximum supérieur au courant limité de formation, puis diminue. Les courants HRS des deux appareils sont supérieurs de plusieurs ordres à celui de l'état initial à la même tension. Cela suggère qu'il y a encore du filament conducteur qui ne peut pas être complètement fondu après la réinitialisation. Les courbes I–V de réglage/réinitialisation typiques de la Fig. 3b montrent que la typologie de ces deux dispositifs est le mode de fonctionnement bipolaire [28]. Le rapport de commutation et la tension d'activation/de réinitialisation du dispositif dopé à l'Al sont inférieurs à ceux du dispositif non dopé, mais son processus de transformation de l'état de résistance est plus doux et convient comme dispositif de stockage à plusieurs valeurs.
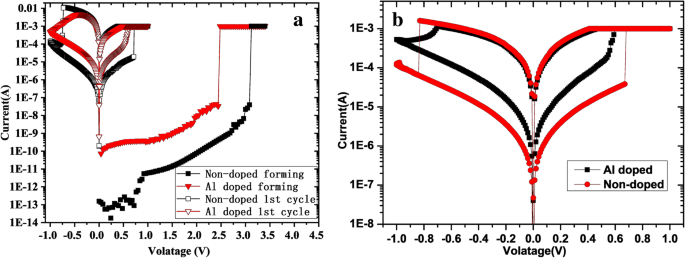
Les caractéristiques I/V des appareils. un Le processus de formage et le premier cycle. b Le processus de configuration/réinitialisation typique
Pour clarifier les mécanismes de commutation des appareils, les courbes I-V sont tracées en double échelle logarithmique sur la figure 4. Pour les deux types d'appareils, la courbe de faible résistance présente un comportement ohmique linéaire, ce qui indique la formation de filaments conducteurs dans HfO2 films lors de leur mise en scène [29, 30]. Cependant, les courbes de haute résistance sont assez différentes entre ces deux types d'appareils. Pour le dispositif dopé, il est composé de trois régions :la région ohmique (I∝V), la région de la loi d'enfant (I∝V 2 ), et la région d'augmentation de courant abrupte, qui est conforme à la caractéristique I-V typique du courant limité à charge d'espace contrôlé par piège (SCLC) [31, 32]. La courbe à haute résistance du dispositif non dopé est composée de deux régions :la conduction ohmique (I∝V) au niveau de la région basse tension, et l'ajustement linéaire du lnI-V 1/2 à la région de haute tension (l'encart de la Fig. 4), confirmant le mécanisme d'émission de Schottky [15, 33].
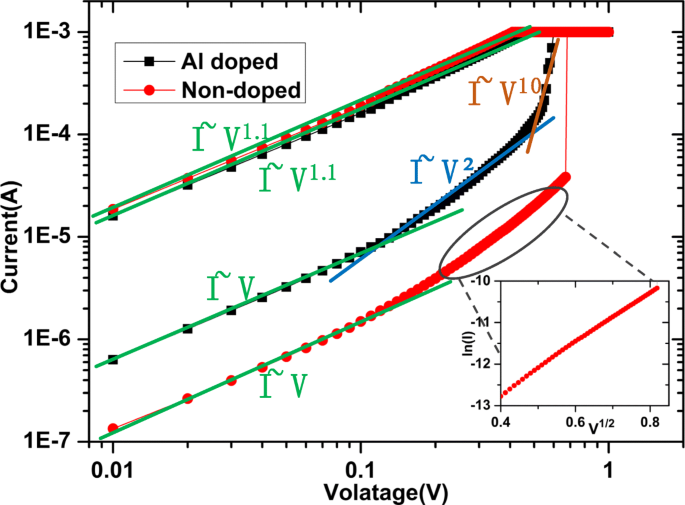
L'ajustement de courbe du processus SET dans les doubles coordonnées logarithmiques
Selon les caractéristiques ci-dessus, les mécanismes microscopiques des memristors sont résumés comme suit. Pour les dispositifs non dopés, à mesure que la tension positive appliquée à l'électrode en titane augmente, de plus en plus d'ions d'oxygène génèrent dans le HfO2 et se déplacer vers l'électrode de titane [34], produisant de l'oxyde de titane [35]. Dans le même temps, les lacunes en oxygène s'accumulent à l'interface entre l'électrode de platine et le HfO2 , formant progressivement des filaments conducteurs [36]. Par conséquent, le courant augmente progressivement avec la tension. Les dispositifs passent en état de faible résistance (LRS) lorsque les lacunes d'oxygène des filaments conducteurs relient le TE et le BE. Alors que l'électrode en titane est appliquée avec une tension négative, les ions oxygène se combinent avec les lacunes d'oxygène au niveau du HfO2 /Pt [37], ce qui conduit à une concentration plus faible en manque d'oxygène et à une barrière Schottky plus élevée. Lorsque la tension de réinitialisation est atteinte, le filament conducteur est rompu et l'appareil passe en HRS.
Pour les dispositifs dopés à l'Al, les atomes d'Al se lient à la structure HfO2 pour former Hf-Al-O, ce qui entraîne des liaisons Hf-O plus faibles et plus faciles à rompre. L'énergie de formation du manque d'oxygène est réduite. Par conséquent, les dispositifs de dopage ont une résistance plus faible et une tension de transition plus faible. Dans les films non dopés, les lacunes d'oxygène ont tendance à s'accumuler le long des joints de grains [38, 39]. En conséquence, les filaments conducteurs sont peu nombreux et épais. La résistance des dispositifs varie fortement avec la conduction et la rupture des filaments conducteurs. Dans les films dopés, des lacunes d'oxygène se forment facilement à proximité des atomes d'impuretés [35, 40, 41]. La distribution uniforme d'une grande quantité d'impuretés dans le film mince rend les filaments conducteurs formés par des lacunes d'oxygène plus contrôlables. Par conséquent, il est plus facile d'atteindre plusieurs valeurs de résistance.
Les appareils peuvent être réglés sur différents états de résistance stable en modifiant la conformité actuelle du processus défini. Vingt états de résistance stables sont obtenus en réglant la conformité de courant de 0,5 mA à 10 mA avec un pas de 0,5 mA sur la figure 5a. Comme les états de résistance sont définis par balayage CC, la consommation d'énergie est importante et l'opération est compliquée. D'autre part, les valeurs de résistance sont facilement verrouillées dans LRS lorsqu'une grande compliance de courant est utilisée. Cette méthode est également incapable d'ajuster le HRS. États de résistance à vingt niveaux obtenus en modifiant l'amplitude de tension des impulsions de réglage et de réinitialisation. Pour éviter la possibilité d'un dépassement de courant et d'un échec de réglage/réinitialisation, l'amplitude de la tension est limitée entre 1 V~1,9 V pour le SET et − 1 V~− 1,9 V pour le reset. On peut voir sur le schéma de la boîte (Fig. 5b) que la plage de tension autorisée est divisée en 20 valeurs et que le rendement de l'appareil dépasse de loin le niveau 3 σ (99,73%). Il s'agit d'une exigence courante dans la production. L'inconvénient de cette méthode est que les appareils ne peuvent pas être réglés directement d'un HRS (LRS) à un autre HRS (LRS), mais doivent d'abord être réinitialisés (définis) sur LRS (HRS), puis réglés sur le HRS cible (LRS) . Cela augmente la complexité et la consommation d'énergie de l'opération.

Le stockage multi-valeurs des appareils. un Transformez les états de résistance en réglant les courants de conformité. b 20 états de résistance stables obtenus en réglant l'amplitude de la tension d'impulsion La largeur et l'intervalle d'impulsion sont tous deux de 500 s
Une meilleure approche est illustrée sur la figure 6. La conductance du dispositif est augmentée ou diminuée par incréments par impulsions consécutives. La durée et l'intervalle d'impulsion sont tous deux de 10 s. La conductance est mesurée par une impulsion de lecture de 0,1 V après chaque impulsion de réglage/réinitialisation. Comme le montre la figure 6, le nombre d'impulsions nécessaires pour régler/réinitialiser les dispositifs à différents niveaux dépend de la tension appliquée. Les différentes statues résistantes à 20 niveaux sont obtenues par set et reset en sélectionnant respectivement 0,5 V comme tension SET et − 0,7 V comme tension reset (Fig. 7). L'appareil est réinitialisé à un HRS par 10 - 0,9 V impulsions consécutives à chaque fois avant d'être réglé sur l'état cible ou réglé sur un LRS par 10 impulsions consécutives de 0,8 V avant le réglage. Considérant le même statut présent à la fois au processus de réglage et de réinitialisation, 35 statuts différents sont obtenus au total. La déviation du nombre d'impulsions nécessaire pour les deux états de résistance adjacents de l'ensemble (réinitialisation) dépasse le niveau de 3 σ. L'inconvénient est que si les valeurs de résistance des appareils changent considérablement, le nombre d'impulsions nécessaire sera grand et la vitesse de fonctionnement sera lente.
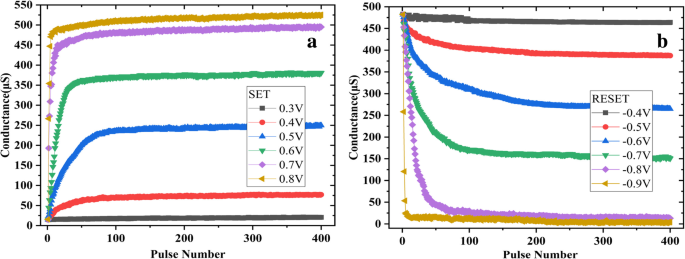
La résistance ajustée par des impulsions consécutives. un Définir le processus et b processus de réinitialisation

Numéro d'impulsion nécessaire pour définir (a ) ou réinitialiser (b ) les appareils à 20 niveaux différents
Pour tester la conservation des données des appareils, 20 appareils sont réglés/réinitialisés sur une série de valeurs de résistance différentes, et les conservent sur une table chauffante à 85 °C [42]. Les valeurs de résistance ont été mesurées avec une tension de 0,1 V toutes les 100 s. On peut voir sur la figure 8a que la résistance des appareils reste stable après 10 4 s. Afin de tester la fiabilité du cycle de l'appareil, nous avons répété l'opération de réglage et de réinitialisation avec une impulsion de réglage de 1,8 V/500 s et une impulsion de réinitialisation de - 1,8 V/500 s. Après 10 3 cycles, le rapport de commutation de l'appareil est toujours supérieur à 10 sur la figure 8b.
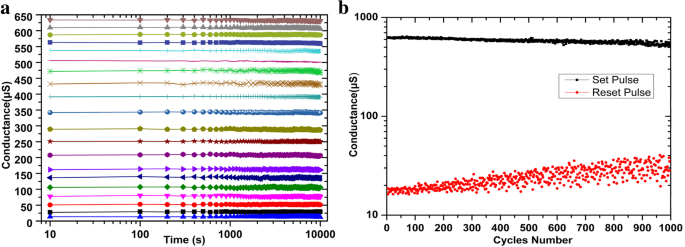
Les tests de fiabilité des appareils. un Caractéristiques de conservation des données après les opérations d'impulsion de réglage/réinitialisation. b Courbes d'endurance des cycles pour les opérations d'impulsion de réglage/réinitialisation
Conclusions
Le HfO2 dopé à l'Al proposé memristor affiche une performance de réglage/réinitialisation progressive et stable. En ajustant la courbe du processus défini des dispositifs dopés à l'Al et non dopés, on constate que, dans HRS, le dispositif non dopé suit le mécanisme d'émission de Schottky, tandis que le dispositif dopé à l'Al suit le mécanisme conducteur SCLC. Le mécanisme physique microscopique du changement de résistance est également discuté. De plus, le stockage multi-valeurs de l'appareil a été confirmé en modifiant le courant de compliance, en ajustant l'amplitude de tension d'impulsion de réglage/réinitialisation et en utilisant les impulsions courtes consécutives. Enfin, nous avons testé la fiabilité des appareils pour prouver qu'il a une rétention de données de plus de 10 4 s (85 °C) et un rapport de commutation supérieur à 10 après 10 3 cycles.
Disponibilité des données et des matériaux
Toutes les données générées ou analysées au cours de cette étude sont incluses dans cet article publié.
Abréviations
- ALD :
-
Dépôt de couche atomique
- BE :
-
Électrode inférieure
- CMOS :
-
Silicium d'oxyde métallique complémentaire
- HfD-04 :
-
MeCp2 HfMe(OMe)Hf
- HRS :
-
État de haute résistance
- LRS :
-
État de faible résistance
- NVM :
-
Mémoire non volatile
- SCLC :
-
Courant limité dans l'espace
- TE :
-
Électrode supérieure
- TMA :
-
Triméthylaluminium
- XPS :
-
Spectroscopie photoélectronique aux rayons X
Nanomatériaux
- Authentification de périphérique basée sur X.509 dans Eclipse Hono
- Nano graphème, mémoire transparente flexible à base de silicium
- Caractéristiques de commutation résistive bipolaire des dispositifs RRAM à structure tricouche HfO2/TiO2/HfO2 sur des substrats revêtus de Pt et de TiN fabriqués par dépôt de couche atomique
- Fabrication de fosses à l'échelle nanométrique avec un débit élevé sur une couche mince de polymère à l'aide de la lithographie dynamique à base de pointes AFM
- Préparation et caractéristiques thermoélectriques du thermocouple à couche mince ITO/PtRh:PtRh
- Capteur de contrainte ultra-sensible basé sur un film piézoélectrique flexible en poly(fluorure de vinylidène)
- Performances énergétiques améliorées basées sur l'intégration avec les nanolaminés Al/PTFE
- Ambarella, Lumentum et ON Semiconductor collaborent sur la détection 3D basée sur le traitement de l'IA pour les appareils AIoT de nouvelle génération
- Revêtement en couche mince de nitrure de titane niobium



