Transistors à couche mince a-InGaZnO hautes performances avec un budget thermique extrêmement faible en utilisant un diélectrique Al2O3 riche en hydrogène
Résumé
Les caractéristiques électriques des transistors à couche mince (TFT) amorphes In-Ga-Zn-O (a-IGZO) sont comparées en utilisant O2 dépôt de couche atomique assisté par plasma Al2 O3 diélectriques à différentes températures. Les TFT a-IGZO hautes performances sont démontrés avec succès avec un Al2 O3 diélectrique déposé à température ambiante, qui présente une mobilité à effet de champ élevée de 19,5 cm 2 V − 1 s − 1 , une petite oscillation sous le seuil de 160 mV/déc, une tension de seuil faible de 0,1 V, un rapport de courant marche/arrêt important de 4,5 × 10 8 , et des stabilités supérieures de polarisation de grille négative et positive. Ceci est attribué à l'Al2 riche en hydrogène O3 diélectrique déposé à température ambiante par rapport à des températures de dépôt plus élevées, passivant ainsi efficacement les états d'interface de a-IGZO/Al2 O3 et les lacunes d'oxygène et l'amélioration de la conductivité du canal a-IGZO en générant des électrons supplémentaires en raison du dopage à l'hydrogène amélioré pendant la pulvérisation cathodique de l'IGZO. Un tel budget thermique extrêmement faible pour les TFT a-IGZO hautes performances est très attractif pour une application électronique flexible.
Contexte
Les transistors à couche mince (TFT) amorphes à base d'In-Ga-Zn-O (a-IGZO) ont attiré beaucoup d'attention au cours de la dernière décennie en raison de leur grande mobilité, de leur bonne uniformité, de leur transparence élevée à la lumière visible et de leur faible température de traitement [1, 2,3]. Ces mérites en font un candidat prometteur pour l'application de l'électronique de nouvelle génération, comme l'affichage transparent, les dispositifs flexibles ou l'électronique portable. En particulier, pour les applications de l'électronique flexible, les TFT sont généralement fabriqués sur des substrats polymères faiblement stables thermiquement. Ainsi, il est nécessaire de réduire le budget thermique de la fabrication du TFT a-IGZO. À cette fin, de nombreux chercheurs se sont concentrés sur les TFT a-IGZO avec des isolants de grille fabriqués à température ambiante, tels que la pulvérisation [4,5,6], le processus de mise en solution [7,8,9], l'évaporation par faisceau électronique [10] et anodisation [11]. Cependant, ces films diélectriques souffrent souvent d'une forte densité de pièges et d'une forte diffusion interfaciale diélectrique/a-IGZO, ce qui entraîne une mobilité limitée des effets de champ, une grande oscillation sous-seuil et un faible rapport de courant marche/arrêt [4,5,6 ,7,8,9,10,11].
D'autre part, le dépôt de couche atomique (ALD) est une technique prometteuse, qui peut fournir des films de haute qualité, un contrôle précis de l'épaisseur du film, une bonne uniformité sur une grande surface et une faible température de traitement [12,13,14]. Zheng et al. [15] ont rapporté que le TFT a-IGZO avec ALD SiO2 diélectrique a présenté d'excellentes performances électriques sans avoir besoin de post-recuit. Cependant, une température de substrat élevée de 250 °C est requise pour l'ALD de SiO2 [15], ce qui est supérieur aux températures de transition vitreuse de la plupart des substrats plastiques flexibles. Fait intéressant, il est rapporté que l'ALD de Al2 O3 les films peuvent être réalisés même à température ambiante (RT) [16, 17] ; pendant ce temps, l'Al2 O3 le film déposé à TA contient une grande quantité d'impuretés d'hydrogène (H) [17]. Cependant, à notre connaissance, l'Al2 riche en H mentionné ci-dessus O3 le film n'a jamais été utilisé comme isolant de grille dans un TFT a-IGZO. Par conséquent, il est souhaitable d'explorer le TFT a-IGZO avec un RT ALD Al2 O3 isolant de portail.
Dans cette lettre, le TFT a-IGZO hautes performances a été fabriqué avec succès avec un Al2 déposé à température ambiante. O3 diélectrique de grille. En comparant les caractéristiques des TFT a-IGZO avec divers Al2 O3 isolants de grille déposés à différentes températures, le mécanisme sous-jacent a été abordé.
Méthodes
Des plaquettes de silicium de type p hautement dopées (< 0,0015 Ω cm) ont été nettoyées par des procédés RCA standard et ont servi d'électrodes de grille. Quarante nanomètres Al2 O3 les films ont été déposés dans un système ALD commercial (Picsun Ltd.) utilisant du triméthylaluminium (TMA) et du O2 plasma comme précurseur et réactif, respectivement. Un cycle de croissance consistait en une impulsion TMA de 0,1 s, 10 s N2 purge, 8 s O2 pouls plasmatique et 10 s N2 purge. Le TMA a été maintenu à 18 °C pour une pression de vapeur et une dose stables, et le O2 le débit de gaz a été fixé à 150 sccm avec une puissance de générateur de plasma de 2500 W. Par la suite, des films a-IGZO de 40 nm ont été déposés par pulvérisation RF à l'aide d'une cible en céramique IGZO avec un rapport atomique de In:Ga:Zn:O = 1 :1:1:4. Pendant la pulvérisation, la pression de travail et Ar et O2 les débits de gaz ont été fixés à 0,88 Pa et 48 et 2 scccm, respectivement. La région active a été formée par photolithographie et gravure humide. Après cela, des électrodes source/drain de bicouches Ti 30 nm/Au 70 nm ont été préparées par évaporation par faisceau d'électrons et méthode lift-off. Aucun autre processus de recuit n'a été appliqué sur ces appareils.
Les propriétés électriques des TFT a-IGZO ont été caractérisées à l'aide d'un analyseur de dispositif à semi-conducteur (Agilent Tech B1500A) dans une boîte noire à température ambiante. Les stabilités du dispositif ont été mesurées sous des contraintes de polarisation de grille positives et négatives, respectivement. Les profils de profondeur des éléments et la composition chimique ont été mesurés par spectrométrie de masse à ions secondaires (SIMS) et spectroscopie photoélectronique à rayons X (XPS), respectivement.
Résultats et discussion
La figure 1a compare les constantes diélectriques de l'Al2 O3 films déposés à différentes températures en fonction de la fréquence (c'est-à-dire de 10 Hz à 10 5 Hz). Lorsque la température de dépôt augmente de 100 à 150 °C, le film montre une diminution progressive de la constante diélectrique. Une tendance similaire a également été signalée dans la littérature précédente pour le changement de température de dépôt de la température ambiante à 150 °C [18, 19]. C'est parce que le RT Al2 O3 Le film contient la plus forte concentration d'hydrogène (H) sous forme de groupes OH. Ainsi, la constante diélectrique correspondante est améliorée en raison d'une rotation de plusieurs groupes OH dans un champ électrique [20]. En termes de fréquence de mesure de 10 Hz, les constantes diélectriques extraites pour le RT, 100 °C et 150 °C Al2 O3 les films sont égaux à 8,6, 7,9 et 7,4, respectivement, qui sont utilisés pour l'extraction de la mobilité à effet de champ (μ FE ) et la densité de piège interfacial (D il ) du dispositif TFT fabriqué. La figure 1b montre les caractéristiques de courant de fuite de différents Al2 O3 cinéma. On constate que la RT Al2 O3 le film présente une faible densité de courant de fuite de 2,38 × 10 − 8 A/cm 2 à 2 MV/cm et un champ électrique de claquage de 5,3 MV/cm. De plus, le champ électrique de claquage augmente progressivement avec l'augmentation de la température de dépôt de 100 à 150 °C.
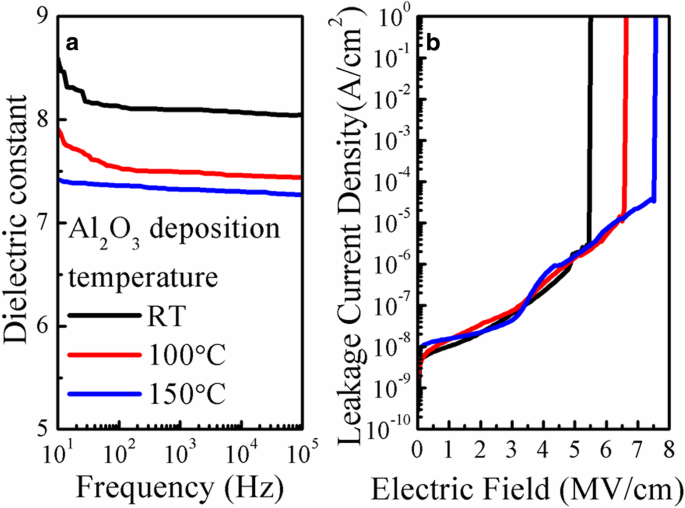
Propriétés électriques de l'Al2 O3 films déposés à différentes températures. un Constante diélectrique en fonction de la fréquence. b Densité de courant de fuite par rapport au champ électrique
La figure 2 montre les courbes de transfert typiques des TFT a-IGZO avec différents Al2 O3 isolants de portail. Le RT Al2 O3 TFT présente les meilleures performances, telles qu'un μ élevé FE de 19,5 cm 2 V − 1 s − 1 , une petite oscillation sous-seuil (SS) de 160 mV/dec, une petite tension de seuil (V T ) de 0,1 V, et un grand rapport de courant marche/arrêt (I on/off ) de 4.5 × 10 8 . Cependant, les TFT a-IGZO avec Al2 O3 les isolants de grille déposés à 100 et 150 °C présentent des performances bien inférieures, c'est-à-dire des courants d'activation réduits (10 − 7 et 3 × 10 − 9 A) et SS dégradé. Le D il à l'interface de Al2 O3 /a-IGZO peut être calculé sur la base de l'équation suivante [21] :
$$ {D}_{\mathrm{it}}=\left(\frac{\mathrm{SS}\times \lg e}{kT/q}-1\right)\frac{C_{ox}}{ q^2} $$ (1)où e , k , T , et q représentent respectivement le nombre d'Euler, la constante de Boltzmann, la température absolue et la charge électronique unitaire. C bœuf est la capacité diélectrique de grille par unité de surface. Pour la RT Al2 O3 TFT, le D il est égal à 1,1 × 10 12 eV − 1 cm − 2 , ce qui est plus d'une ou deux fois inférieur à ceux des TFT avec l'Al2 O3 isolants de grille déposés à 100 et 150 °C.

Courbes de transfert des TFT a-IGZO avec ALD Al2 O3 isolants de grille déposés à différentes températures avec les paramètres de l'appareil extraits
Les stabilités de polarisation de grille des dispositifs ont été en outre mesurées en appliquant des tensions négatives et positives. La figure 3 montre le V T décalage en fonction du temps de contrainte de polarisation pour différents TFT. En termes de contrainte de polarisation de grille négative (NGBS), le RT Al2 O3 TFT présente un V négligeable T décalage de - 0,04 V après avoir été sollicité à - 10 V pendant 40 min. Cependant, l'Al2 à température plus élevée O3 les isolateurs de grille génèrent un plus grand V T se déplace surtout pour 150 °C. Une stabilité NGBS si élevée pour RT Al2 O3 doit être attribuée à une faible concentration de lacunes en oxygène (V O ) dans le canal a-IGZO [22]. En ce qui concerne la contrainte de polarisation de grille positive (PGBS), le RT Al2 O3 TFT affiche un V T décalage de 1,47 V, ce qui est beaucoup plus faible que ceux (8,8 V et 12,1 V) pour les 100 et 150 °C Al2 O3 TFT. De plus, l'influence du temps de stockage sur les performances de l'appareil a été étudiée, comme le montre la figure 4. Bien qu'aucune couche de passivation ne soit recouverte sur le canal arrière, l'appareil conserve toujours d'excellentes performances après avoir été conservé dans une armoire (20 % d'humidité relative). pendant 60 jours à 30 °C ; pendant ce temps, aucune variation significative de μ FE et SS sont observés. Ceci indique le RT Al2 O3 Les TFT sans aucune couche de passivation ont une bonne stabilité en fonction du temps de stockage dans l'ambiance actuelle.

V T décalage en fonction du temps de contrainte de polarisation sous NGBS = − 10 V et PGBS = 10 V pour les TFT avec Al2 O3 isolants déposés à différentes températures

Stabilité en fonction du temps de RT Al2 O3 TFT après avoir été conservé dans une armoire (20 % HR) à 30 °C. un Courbes de transfert. b Mobilité et oscillation sous le seuil
Le tableau 1 compare les performances de notre RT Al2 O3 TFT avec d'autres rapports. Il s'avère que notre appareil présente un V proche de zéro T , plus petit SS et plus grand I on/off en cas de mobilité comparable [4, 23]. Bien que utilisant un Ta2 O5 l'isolateur de grille peut obtenir une mobilité plus élevée de 61,5 cm 2 V − 1 s − 1 , à la fois SS et I on/off se détériorer considérablement [10]. En un mot, notre RT Al2 O3 TFT possède une performance globale supérieure en comparaison avec les 100 et 150 °C Al2 O3 TFT. Étant donné que toutes les étapes de traitement sont identiques à l'exception de l'étape de dépôt de Al2 O3 , de telles différences significatives dans les performances électriques doivent provenir de l'Al2 O3 isolateurs de portail.
Pour comprendre le mécanisme sous-jacent, les profils de profondeur des éléments dans l'a-IGZO/Al2 O3 les films empilés ont été analysés par SMIS. La figure 5a montre la dépendance de la concentration en H sur la profondeur dans les cheminées d'IGZO/Al2 O3 , où l'Al2 O3 les films ont été déposés à RT et 150°C, respectivement. A titre de comparaison, un film d'IGZO déposé sur un substrat de Si nu a également été analysé. Le film d'IGZO déposé sur Si nu contient une concentration en H de ~ 3 × 10 21 cm − 3 , qui provient du gaz résiduel dans le système de pulvérisation et a absorbé H2 /H2 Molécules O à la surface du Si. Les deux films IGZO déposés sur l'Al2 O3 les films contiennent des concentrations de H plus élevées que celles du substrat de Si nu. Cela indique que l'augmentation des concentrations de H devrait provenir de la libération d'impuretés H dans l'Al2 sous-jacent O3 films lors de la pulvérisation d'IGZO. De plus, on observe que la concentration en H dans le film IGZO au sommet du RT Al2 O3 Le film est plus élevé que celui de 150 °C dans la région proche de l'interface, ce qui peut fournir une passivation plus efficace des états interfaciaux. Cela améliore ainsi la stabilité SS et PGBS du RT Al2 O3 TFT en réduisant le piégeage interfacial des porteurs. De plus, les spectres XPS O 1s des films a-IGZO près de l'interface IGZO/Al2 O3 ont été analysés, comme le montre la figure 5b. Les pics ajustés sont situés à 530,2 ± 0,1 eV, 530,9 ± 0,1 eV et 531,6 ± 0,1 eV, correspondant à O 2− ions liés au métal (O1), V O (O2) et les groupes OH (O3), respectivement [13, 24]. Le pourcentage d'O2 est de 26,3 % dans la couche a-IGZO au-dessus du Si nu; cependant, il diminue à 12,3% et 6,8% pour les 150 °C et RT Al2 O3 films sous-jacents, respectivement. Cela indique que plus de V O dans le canal IGZO peut être efficacement passivé par des impuretés H supplémentaires provenant de l'Al2 sous-jacent O3 films, notamment pour la RT Al2 O3 film avec une concentration en H plus élevée. Il est rapporté que lorsque V O et H sont tous deux présents dans le film a-IGZO, ils peuvent se combiner pour former un état stable dans lequel H est piégé à V O (V O H), et le V résultant O H est un donneur peu profond [25,26,27]. Ainsi, dopage H amélioré dans le canal IGZO au sommet du RT Al2 O3 améliore la conductivité du canal en fournissant des électrons supplémentaires. De plus, le petit V T décalage sous NGBS pour la RT Al2 O3 Le TFT peut également être attribué à la passivation H effective de V O [28]. Comme indiqué dans la littérature, l'instabilité du TFT sous NGBS provient de l'ionisation du V neutre O (V O → V O 2+ +2e − ) [17, 29]. De plus, le pourcentage d'O3 du film a-IGZO sur le RT Al2 O3 est de 6,9 %, ce qui est supérieur à ceux sur le 150 °C Al2 O3 (5,3%) et le Si nu (4,6%), respectivement. Le groupe OH pourrait provenir de la réaction O 2− + H → OH − + e − lors du dépôt de films IGZO [30]. Ainsi, le dopage H amélioré dans le canal IGZO au sommet du RT Al2 O3 le film génère plus de groupes OH et contribue également à améliorer la conductivité du canal.

un Profils SIMS de concentration d'hydrogène dans Al2 O3 déposé à TA et 150°C. b Spectres O1s XPS haute résolution du canal IGZO déposés sur RT Al2 O3 , 150 °C Al2 O3 , et Si nu
Conclusions
Un TFT a-IGZO hautes performances a été fabriqué avec succès sous le budget thermique extrêmement faible de la RT en utilisant un Al2 riche en H O3 diélectrique de grille préparé par O2 ALD assistée par plasma. Ceci est attribué au fait que l'Al2 O3 le diélectrique déposé à TA contient plus d'impuretés d'hydrogène que celles déposées à des températures plus élevées. Ainsi, les impuretés H libérées lors de la pulvérisation cathodique d'IGZO ont généré plus d'électrons et ont passivement efficacement les états d'interface de a-IGZO/Al2 O3 et le V O dans le canal a-IGZO.
Abréviations
- a-IGZO :
-
In-Ga-Zn-O amorphe
- ALD :
-
Dépôt de couche atomique
- D il :
-
Densité de piège interfacial
- H :
-
Hydrogène
- Je on/off :
-
Ratio courant marche/arrêt
- NGBS :
-
Contrainte de polarisation de porte négative
- PGBS :
-
Contrainte de polarisation de grille positive
- RT :
-
Température ambiante
- SIMS :
-
Spectrométrie de masse ionique secondaire
- SS :
-
Balançoire sous le seuil
- TFT :
-
Transistor à couche mince
- V O :
-
Vacance d'oxygène
- V O H :
-
Hydrogène piégé au niveau du manque d'oxygène
- V T :
-
Tension de seuil
- XPS :
-
Spectroscopie photoélectronique aux rayons X
- μ FE :
-
Mobilité à effet de champ
Nanomatériaux
- Installations d'impression 3D avec des matériaux hautes performances
- Utiliser de la résine époxy avec des illustrations
- Contrôle complet de la polarisation térahertz avec bande passante élargie via des métasurfaces diélectriques
- Transistors multicouches à effet de champ SnSe Nanoflake avec contacts Au Ohmic à faible résistance
- Grande amélioration de la conductivité thermique du composite de silicone avec des nanofils de cuivre ultra-longs
- Fabrication de nanomotifs ordonnés à l'aide d'un copolymère tribloc ABC avec du sel dans du toluène
- Électrode porte d'argent imprimée par jet d'encre et durcie aux UV avec une faible résistivité électrique
- RGO et réseaux tridimensionnels de graphène co-modifiés TIM avec de hautes performances
- Dépôt en couche atomique de nano-films d'oxyde d'indium pour transistors à couche mince



