Modification des propriétés optiques des points quantiques InAs coiffés en GaAsSb au moyen d'intercalaires InAlAs
Résumé
Dans ce travail, nous étudions les propriétés optiques des points quantiques InAs (QD) coiffés d'In0.15 composite. Al0,85 As/GaAs0,85 Sb0.15 couches de réduction de contrainte (SRL) au moyen de la diffraction des rayons X à haute résolution (HRXRD) et de la spectroscopie de photoluminescence (PL) à 77 K. Thin In0,15 Al0,85 En couches d'épaisseur t = 20 Å, 40 Å et 60 Å ont été insérés entre les QD et un GaAs de 60Å d'épaisseur0,85 Sb0.15 couche. Les émissions de type II observées pour GaAs0,85 Sb0.15 -les QD InAs plafonnés ont été supprimés par l'insertion du In0.15 Al0,85 Comme intercalaire. De plus, la longueur d'onde d'émission a été décalée vers le bleu pour t = 20 Å et décalé vers le rouge pour t ≥ 40 Å résultant de l'augmentation du potentiel de confinement et de l'augmentation de la déformation, respectivement. La séparation d'énergie de l'état fondamental et de l'état excité est augmentée pour atteindre 106 meV pour t = 60 Å comparé à 64 meV pour les QDs plafonnés avec uniquement GaAsSb SRL. De plus, l'utilisation de l'In0.15 Al0,85 Au fur et à mesure que les couches rétrécissent considérablement la largeur de raie spectrale QD de 52 à 35 meV pour les échantillons avec 40 et 60 Å d'épaisseur d'In0,15 Al0,85 Comme intercalaires.
Contexte
Au cours des dernières décennies, les points quantiques auto-organisés (QD) synthétisés à l'aide de la technique de Stranski-Krastanov ont attiré beaucoup d'attention. Leurs propriétés optiques et électroniques ont été étudiées de manière intensive en raison de leurs applications potentielles dans les dispositifs optoélectroniques [1]. Le système QD InAs/GaAs largement étudié a été utilisé dans une gamme de dispositifs optoélectroniques en tant que matériau actif. Au cours de la croissance de ces nanostructures, un changement significatif dans la taille et la forme des QD se produit pendant le processus de coiffage. Ce processus est assez complexe et implique un mélange, une ségrégation ou une diffusion sous contrainte [2]. L'utilisation d'une couche de recouvrement en GaAs pur limite l'émission QD à moins de 1300 nm. Pour pallier ce problème, des couches de réduction de déformation en (Ga, In)(As, Sb, N) ont été utilisées [2,3,4,5,6,7]. En particulier, le ternaire GaAsSb a reçu une attention particulière car son alignement de bande résultant peut être adapté pour être de type I ou de type II en modifiant la teneur en Sb [8, 9] et par sa capacité à étendre la longueur d'onde d'émission au-delà de la bande C. [dix]. Cependant, la différence d'énergie entre l'état fondamental et excité est limitée à 60–75 meV lorsque GaAsSb est utilisé comme couche de réduction de contrainte (SRL) [11]. Cette séparation d'énergie n'empêche pas les porteurs de s'échapper thermiquement des QD. Pour les applications nécessitant une longue durée de vie des porteurs, l'insertion d'une barrière mince entre les QD InAs et GaAsSb sera bénéfique, car elle augmentera la séparation des porteurs entre les QD et le puits quantique GaAsSb (QW). À titre d'exemple, des couches intermédiaires de GaAs ont été utilisées, ce qui a permis d'améliorer le rendement énergétique des cellules solaires d'un facteur de 23 % [12]. L'utilisation de couches d'InAlAs peut être intéressante pour concevoir le type de recombinaison radiative. Pour la transition de type II, l'insertion d'InAlAs augmentera la durée de vie du porteur [13] et la séparation énergétique entre les états fondamental et le premier état excité [14,15,16]. De plus, l'insertion d'une couche d'InAlAs entre les QD InAs et GaAsSb devrait diminuer la ségrégation In et supprimer le mélange des atomes In et Ga entre les QD InAs et le SRL GaAsSb et réduire davantage la contrainte QD [17]. Les SRL composites InAlAs/InGaAs ont été utilisés pour couvrir les QD d'InAs, ce qui entraîne une émission à grande longueur d'onde et une séparation d'énergie favorable entre l'état fondamental et excité jusqu'à 104 meV [16, 18].
Dans cet article, nous rapportons la première enquête sur l'effet de l'utilisation d'un In0.15 Al0,85 En tant qu'intercalaire sur les propriétés optiques de l'InAs/GaAs0,85 Sb0.15 QDs au moyen de la spectroscopie de photoluminescence (PL). En particulier, la variation de la longueur d'onde d'émission, le type d'émission optique, la largeur de raie spectrale et la séparation d'énergie entre l'état fondamental et le premier état excité ont été étudiés en détail.
Méthodes
Les échantillons étudiés dans la présente étude ont été cultivés sur des substrats de GaAs de type p (001) epi-ready quarter 2″ dans un système d'épitaxie par faisceau moléculaire Veeco Gen20A. Des crackers à valve ont été utilisés pour générer As2 et Sb2 dimères. Après la croissance d'une couche tampon de GaAs à 590 °C, la température du substrat a ensuite été abaissée à ~ 485 °C pour faire croître des QD d'InAs d'une épaisseur nominale de 2,5 ml. Après une courte pause sous As2 flux, un composite In0.15 Al0,85 As/GaAsSb SRL a été déposé immédiatement suivi de la croissance d'un GaAs de 5 nm d'épaisseur à la même température, après quoi la température de croissance a été augmentée à 570°C pour faire croître une couche barrière de GaAs de 38 nm. L'épaisseur de GaAsSb a été fixée à 60 Å tandis que l'épaisseur de In0.15 Al0,85 As a varié de 20 à 60 . Le GaAsSb SRL de 60 Å d'épaisseur a été réalisé en utilisant un As2 /Sb2 rapport de flux donnant une teneur en Sb de 15 % déterminée par des mesures de diffraction des rayons X sur un échantillon de référence. Un taux de croissance Ga fixe de 0,5 ML/s a été utilisé pour toutes les couches. Quatre échantillons notés A, B, C et D ont été cultivés pour lesquels le In0,15 Al0,85 Comme épaisseur t a été réglé sur 0 Å, 20 Å, 40 Å et 60 Å, respectivement. Sur la base de la procédure utilisée par Krijn [19] et en utilisant les paramètres de [20], la position relative des bandes de conduction et de valence a été estimée et un schéma des structures développées avec leur diagramme de bande correspondant est représenté sur la Fig. 1.
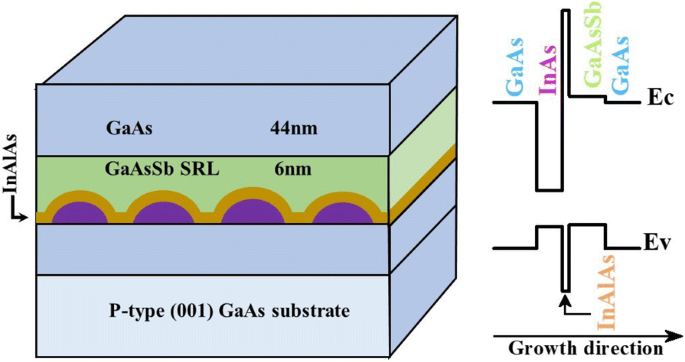
Schéma des structures développées et diagramme de bande d'énergie correspondant des QD InAs coiffés d'un composite In0.15 Al0,85 Comme /GaAs0,85 Sb0.15 . L'In0.15 Al0,85 Comme épaisseur t = 0 Å, 20 Å, 40 Å et 60 Å pour les échantillons A, B, C et D, respectivement
La qualité cristalline des échantillons a été caractérisée par diffraction des rayons X à haute résolution (HRXRD) à l'aide d'un diffractomètre à rayons X Panalytical. Les propriétés optiques des échantillons cultivés ont été évaluées au moyen de la spectroscopie PL à 77 K en utilisant un module PL connecté à un instrument infrarouge à transformée de Fourier Vertex 80 (Bruker Optics GmbH) et en utilisant un détecteur InGaAs à gain élevé refroidi thermoélectriquement [21]. Les échantillons ont été excités avec une source laser à semi-conducteurs CW 532 nm.
Résultats et discussion
La qualité cristalline des échantillons cultivés a été caractérisée par HRXRD en utilisant des balayages de courbes oscillantes en enregistrant le diagramme de diffraction à partir de 004 plans atomiques. La figure 2a montre les diagrammes de diffraction obtenus pour les échantillons A, B, C et D correspondant à une épaisseur d'InAlAs de 0, 20, 40 et 60 Å, respectivement. Des pics satellites clairs résultant de l'InAs/InAlAs/GaAsSb sont observés montrant la bonne qualité cristalline des échantillons cultivés. Les courbes d'oscillation de rayons X simulées sont incluses dans la Fig. 2a avec les données expérimentales. La teneur moyenne en Sb obtenue dans l'échantillon de référence A est de 13 % et l'épaisseur de GaAsSb est de 66 µ. Ces valeurs ont été utilisées dans les échantillons B, C et D pour trouver la teneur en In et l'épaisseur de la couche intermédiaire d'InAlAs. La simulation a montré que la teneur moyenne en In est de 13,5% et l'épaisseur de l'intercalaire InAlAs est de 22 Å, 44 Å et 65 Å dans les échantillons B, C et D, respectivement, qui sont proches des épaisseurs nominales.

un ω haute résolution /2θ recherche les échantillons A, B, C et D. b Spectre PL de l'échantillon A obtenu à 77 K et 100 mW d'excitation. c PL dépendant de la puissance de l'échantillon A à 77 K. d Le pic d'énergie correspondant pour les deux premières transitions optiques par rapport à Pex 1/3 à 77 K
Les propriétés optiques de l'échantillon de référence A ont d'abord été étudiées à 77 K en utilisant la technique PL dépendante de la puissance. La figure 2b montre le spectre PL pour une puissance d'excitation de 100 mW. Le spectre PL peut être ajusté par trois pics gaussiens centrés à 1004 meV, 1068 meV et 1113 meV, qui peuvent être identifiés comme les transitions optiques fondamentales et excitées. La pleine largeur à mi-hauteur (FWHM) des états fondamental et premier excité est de 52 et 58 meV, respectivement. Afin de comprendre l'origine des deux premières transitions optiques observées, la puissance d'excitation a varié de 1 à 100 mW et les spectres PL correspondants ont été acquis comme illustré sur la figure 2c. Pour chaque puissance d'excitation, l'énergie des deux premiers pics a été extraite à l'aide d'un ajustement de fonction multi-gaussienne et tracée en fonction de la racine cubique de la puissance d'excitation, comme le montre la figure 2d. L'énergie de la transition fondamentale diminue avec la réduction de la puissance d'excitation compatible avec une transition de type II indiquant que l'émission est le résultat de la recombinaison d'électrons situés dans l'état électronique fondamental dans le QD (E0QD ) et des trous situés dans le GaAsSb QW (H0QW ). Pour l'alignement des bandes InAs/GaAsSb de type II, la localisation des électrons et des trous dans les QD et GaAsSb SRL, respectivement, induit un effet de courbure de bande résultant du champ électrique, qui est principalement le long de la direction de croissance [22]. L'énergie de transition de type II devrait augmenter proportionnellement avec la troisième racine de la puissance d'excitation, comme démontré par Jin et al. [22]. De même, l'énergie de la première transition d'état excité diminue avec la réduction de la puissance d'excitation, et cette transition est très probablement le résultat de la recombinaison des électrons dans le premier état excité d'électrons dans le QD (E1QD ) et des trous dans le GaAsSb QW (H0QW ) car la densité d'états dans le GaAsSb QW est beaucoup plus grande que la densité d'états dans les QDs. Les deux premières transitions optiques sont illustrées sur la figure 3a. Nous notons également que la séparation d'énergie entre l'état fondamental et le premier état excité ΔE reste presque constante à 64 meV avec une puissance d'excitation décroissante, ce qui prouve que le champ électrique résultant de l'accumulation de charge est perpendiculaire à la direction de croissance [22], c'est-à-dire que les trous dans le GaAsSb sont localisés au-dessus des QD. Une émission de type II est attendue dans l'échantillon A car la teneur en Sb dans le GaAsSb, qui est de 13%, est proche de la composition où se produit une transition du type I vers le type II [23, 24]. Pour la teneur en Sb considérée, une petite bande de valence décalée entre les QD et le GaAsSb QW devrait exister favorisant la localisation des trous dans le GaAsSb QW et par la suite les émissions de type II [25, 26].
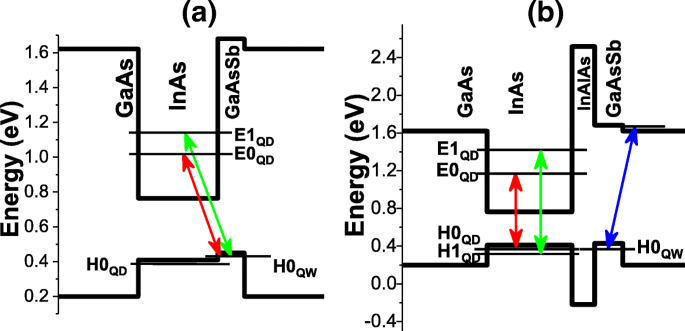
Profils de bande de l'échantillon A (a ) et les échantillons B, C et D (b ) avec leurs canaux de recombinaison correspondants
La figure 4a montre l'émission PL correspondant aux échantillons avec différents In0.15 Al0,85 Comme épaisseur avec une puissance d'excitation allant de 1 à 100 mW. Trois pics principaux peuvent être identifiés pour tous les échantillons contenant un In0.15 Al0,85 Comme intercalaire. On note une altération des positions des pics énergétiques des différents canaux radiatifs par rapport à l'échantillon de référence A. A une puissance d'excitation de 100 mW, l'énergie de la transition fondamentale, FWHM, et la séparation énergétique ΔE ont été extraites et comparées à l'échantillon A. Les valeurs extraites sont rapportées sur la figure 4b.

un PL dépendant de la puissance de l'InAs/In0,15 Al0,85 QD As/GaAsSb à 77 K. b L'énergie de crête correspondante, FWHM et ΔE par rapport à l'épaisseur d'InAlAs et c la variation de l'énergie de crête des canaux de transition optique en fonction de la racine cubique de la puissance d'excitation pour les échantillons B, C et D
La transition d'état fondamental de l'échantillon A se produit à 1004 meV avec une FWHM de 52 meV et une séparation d'énergie ΔE de 64 meV. Insertion de 20 de In0.15 Al0,85 As (échantillon B) induit un décalage vers le bleu de la transition de l'état fondamental de 52 meV. Le décalage vers le bleu est cohérent avec ce qui a été observé lorsqu'un composite InAlAs/InGaAs a été utilisé pour les QD cultivés à presque la même température de croissance [27]. Le décalage vers le bleu de l'énergie de transition de l'état fondamental des QD d'InAs dans l'échantillon B résulte de l'augmentation du potentiel de confinement [15]. Au fur et à mesure que la barrière pour les électrons et les trous augmente, la séparation des niveaux d'énergie des électrons et des trous devrait augmenter, entraînant le décalage vers le bleu d'émission observé. Il est bien connu que le plafonnement de l'InAs avec du GaAs entraîne une réduction de la hauteur QD en raison de la ségrégation de l'In et du mélange In-Ga [28]. L'introduction de Sb dans la couche de recouvrement GaAs réduit la décomposition QD en inhibant le mélange In-Ga entraîné par la contrainte [29]. L'insertion de la couche intermédiaire InAlAs devrait supprimer davantage la ségrégation In et le mélange In-Ga résultant de l'inactivité des adatomes Al. En fait, Jun et al. [17] ont montré au moyen de STEM que l'utilisation d'une couche de combinaison InAlAs/InGaAs comme couche de coiffage supprime fortement la ségrégation In, et le mélange In-Ga le long de la direction de croissance pendant le processus de coiffage des QD InAs, conduisant à l'augmentation hauteur des nanostructures et une concentration en In plus élevée dans les QD d'InAs après coiffage. Compte tenu de la faible température de croissance des QD, c'est-à-dire 485 °C, la ségrégation de l'indium et le mélange d'interface entre les QD et l'intercalaire InAlAs devraient être insignifiants en raison de l'inactivité des adatomes Al.
La FWHM et la ΔE sont réduites et augmentées à 39 meV et 92 meV, respectivement. Augmenter encore l'épaisseur de In0.15 Al0,85 Quant à 40 Å et 60 Å (échantillons C et D, respectivement) provoque un décalage vers le rouge de la longueur d'onde d'émission. Ce décalage vers le rouge est probablement dû à la modification de la déformation dans les QD d'InAs lorsque l'épaisseur totale du composite InAlAs/GaAsSb SRL augmente avec l'augmentation de l'épaisseur d'InAlAs [30]. Cela peut changer les dimensions structurelles des QD et donc modifier les niveaux d'énergie des électrons et des trous. Il semble que pour les échantillons C et D (40 Å et 60 Å, respectivement), l'effet de déformation domine l'effet potentiel de confinement. La plus faible FWHM de 35 meV et la séparation d'énergie la plus élevée ΔE de 35 meV et 106 meV ont été obtenues respectivement pour l'échantillon D. La grande ΔE est causée par l'utilisation d'une couche d'InAlAs plus épaisse et éventuellement d'une hauteur QD accrue [31, 32]. La séparation énergétique est comparable à celle obtenue lorsqu'on utilise un SRL composite InAlAs/InGaAs (104 meV) [16, 33]. La réduction de la FWHM peut être comprise en termes de réduction du brassage entre In0.15 Al0,85 Au fur et à mesure des QD et donc une préservation de la distribution des QD. Les paramètres extraits sont résumés dans le tableau 1.
L'intensité PL des échantillons B et C a été augmentée par rapport à l'échantillon A; cependant, une forte réduction de l'intensité PL a été observée pour l'échantillon D, c'est-à-dire une réduction d'un facteur 5 par rapport à l'échantillon C. L'intensité PL réduite résulte de la réduction de l'injection de porteurs de la couche de GaAsSb vers les QD. En effet, lors de l'illumination, de nombreux porteurs sont photogénérés et l'insertion du In0.15 Al0,85 L'intercalaire crée une barrière pour les porteurs et peut limiter leur injection dans les QD. Les porteurs peuvent être transférés vers les QD via un processus de tunnellisation, et l'intensité PL est plus élevée pour les échantillons avec un In0,15 plus fin Al0,85 Comme barrières [34]. L'échantillon D a montré l'intensité PL la plus faible en tant que tunnel à travers le 60 Å In0,15 Al0,85 As est considérablement réduit, et cela est mis en évidence par l'augmentation de l'émission PL du GaAsSb QW, comme le montre la figure 4a. La réduction du processus tunnel rend favorable et améliore la recombinaison radiative des électrons et des trous dans le GaAsSb QW.
La principale observation du PL dépendant de la puissance à 77 K pour les échantillons B, C et D illustrés sur la Fig. 4a est la position d'énergie fixe des deux premiers pics avec une puissance d'excitation croissante par rapport à ce qui a été observé dans l'échantillon A. Ceci est une caractéristique d'une émission de type I où les électrons et les trous sont localisés dans les QD. Les deux premiers pics d'émission résultent de la recombinaison d'électrons et de trous dans les états fondamental et premier excité dans les QD (E0QD -H0QD et E1QD -H1QD ). Nous pensons que le troisième pic provient d'une émission de type II résultant de la recombinaison d'électrons au sein de GaAs et de trous localisés dans GaAsSb QW. En effet, l'énergie correspondant à cette transition augmente avec l'augmentation de la puissance d'excitation comme le montrent la Fig. 4a et la Fig. 4c caractéristique d'une transition de type II. De plus, on voit que son intensité augmente avec l'augmentation de In0.15 Al0,85 Comme épaisseur de couche. Ceci est en accord avec la réduction de l'intensité PL de la transition fondamentale comme un In0.15 plus épais Al0,85 Comme couche réduit l'effet tunnel des porteurs de GaAsSb vers les QD et favorise l'émission de type II obtenue à partir de la recombinaison d'électrons et de trous situés respectivement dans GaAs et GaAsSb. Un schéma des canaux de recombinaison pour les échantillons B, C et D est représenté sur la figure 3b. La suppression de l'émission de type II peut être comprise comme suit. L'insertion d'un 20-Å In0.15 Al0,85 Au fur et à mesure que la couche augmente, la séparation des porteurs entre les QD et GaAsSb QW, et par conséquent, le chevauchement des fonctions d'onde des électrons et des trous diminue. De plus, le fait que la teneur en Sb dans la teneur en GaAsSb soit proche du crossover de type I-type II, le In0.15 Al0,85 Comme intercalaire apportera le niveau confiné dans le QW (H0QW ) en dessous du premier niveau quantifié dans les QD (H0QD ) comme le montre la Fig. 3b et, par conséquent, les trous capturés dans le QW peuvent creuser un tunnel à travers la couche d'InAlAs, rendant moins probable l'émission de type II. Pour un In0.15 plus épais Al0,85 Comme intercalaire (40 Å et 60 Å), l'effet tunnel est encore réduit mais le chevauchement des fonctions d'onde des électrons et des trous est sensiblement réduit favorisant la recombinaison des électrons dans GaAs avec des trous dans GaAsSb [13]. La transition optique des QD InAs/GaAsSb peut être adaptée au type d'application nécessitant des durées de vie courtes ou longues. Dans notre étude, nous avons considéré une teneur en Sb de 13% dans GaAsSb, ce qui est proche de la transition de type I à type II. L'insertion d'une couche intermédiaire d'InAlAs a supprimé l'émission de type II et augmenté la séparation d'énergie entre l'état fondamental et le premier état excité, ce qui est souhaitable pour les applications nécessitant une courte durée de vie des porteurs. La présente étude peut également être adaptée pour des applications nécessitant une longue durée de vie des porteurs. En effet, la combinaison de l'utilisation d'une teneur en Sb plus élevée dans la couche de GaAsSb et de l'insertion d'un intercalaire en InAlAs devrait maintenir l'émission de type II pour les intercalaires minces en InAlAs tout en augmentant significativement la durée de vie du porteur. Dans le même temps, la séparation énergétique accrue entre l'état fondamental et le premier état excité réduira l'échappement thermique du porteur.
Conclusion
InAs QD plafonnés avec composite In0.15 Al0,85 As/GaAs0,85 Sb0.15 SRL avec In0.15 variable Al0,85 Au fur et à mesure que les épaisseurs ont été augmentées et caractérisées. Notre analyse montre que l'insertion d'un In0.15 Al0,85 Comme couche supprime l'émission de type II observée obtenue à partir d'InAs/GaAs0,85 Sb0.15 QD. De plus, la longueur d'onde d'émission est décalée vers le bleu pour t = 20 Å et décalé vers le rouge pour t ≥ 40 Å résultant de l'augmentation du potentiel de confinement et de l'augmentation de la déformation, respectivement. Une grande séparation énergétique ΔE de 106 meV a été obtenue pour l'échantillon avec un In0,15 d'épaisseur 60Å Al0,85 Comme intercalaire. De plus, l'introduction de l'In0.15 Al0,85 Comme intercalaire réduit considérablement le FWHM de 52 meV atteignant un minimum de 35 meV.
Abréviations
- FWHM :
-
Pleine largeur à mi-hauteur
- HRXRD :
-
Diffraction des rayons X haute résolution
- PL :
-
Photoluminescence
- QD :
-
Points quantiques
- QW :
-
Puits quantique
- SRL :
-
Couches réductrices de contraintes
Nanomatériaux
- Le réarrangement atomique de plusieurs puits quantiques à base de GaN dans du gaz mixte H2/NH3 pour améliorer les propriétés structurelles et optiques
- N,N-diméthylformamide régulant la fluorescence des points quantiques MXene pour la détermination sensible de Fe3+
- Détection de l'excitation spatialement localisée dans les superréseaux à points quantiques InAs/InGaAs auto-organisés :un moyen d'améliorer l'efficacité photovoltaïque
- Effets de l'épaisseur de la bicouche sur les propriétés morphologiques, optiques et électriques des nanolaminés Al2O3/ZnO
- Synthèse verte de points quantiques InP/ZnS Core/Shell pour une application dans des diodes électroluminescentes sans métaux lourds
- Synthèse de points quantiques de sulfure d'antimoine solubles dans l'eau et de leurs propriétés photoélectriques
- Synthèse sonochimique en une étape facile et propriétés photocatalytiques des composites graphène/Ag3PO4 Quantum Dots
- Élimination de la taille bimodale dans les points quantiques InAs/GaAs pour la préparation de lasers à points quantiques de 1,3 μm
- Photoconductivité interbande des points quantiques métamorphiques InAs/InGaAs dans la fenêtre 1,3–1,55 μm



