FET à canal U rectangulaire hautes performances avec une distance de seulement 2 nm entre les contacts source et drain
Résumé
Un nouveau FET à canal U rectangulaire à grille haute performance (FET RGUC) pour une distance intégrée extrême entre les contacts de source et de drain est proposé dans cet article. Le RGUC FET représente des caractéristiques de sous-seuil presque idéales jusqu'à ce que la distance entre les contacts source/drain (S/D) soit réduite à 2 nm. Différent des autres FET à base de canal en retrait ou en forme de U, les contacts de grille n'ont pas besoin d'être formés dans la région en retrait mais uniquement dans une couche d'espacement pour l'isolation entre les deux parties verticales de part et d'autre du canal en U. Ses avantages structurels lui permettent d'être appliqué à la fabrication de circuits intégrés avec une intégration plus élevée pour une distance intégrée extrême entre les contacts de source et de drain. Les propriétés électriques du FET RGUC ont été scrupuleusement étudiées en étudiant l'influence des paramètres de conception, notamment la distance horizontale entre les contacts S/D, la hauteur d'extension de la région S/D, ainsi que l'épaisseur et le matériau de la couche d'oxyde de grille. Les propriétés électriques du FET RGUC sont vérifiées par simulation quantique. Par rapport aux autres FET multiportes à canaux non planificateurs, le nouveau FET RGUC est adapté à une intégration plus élevée.
Introduction
En tant que l'un des dispositifs les plus prometteurs utilisés dans les circuits intégrés (CI) à l'échelle nanométrique, le transistor à effet de champ sans jonction (FET JL) qui présente des caractéristiques électriques remarquables par rapport aux FET à semi-conducteur à oxyde métallique (MOS) conventionnels à base de jonction, en plus de sa simplicité de fabrication, a été profondément étudiée ces dernières années [1,2,3,4]. Alors que l'augmentation de la tension de grille forme la région d'accumulation dans le canal, ce qui entraîne une augmentation du courant d'activation [5], l'introduction du FET à grilles multiples (MG) a renforcé la contrôlabilité du courant source-drain à partir de la tension de grille, résultant à de bien meilleures propriétés de sous-seuil de l'appareil. Les FET à grilles multiples sans jonction (JL MG) ont également été largement étudiés pendant des années [6,7,8]. Bien que le MOSFET tout autour de la porte à canal vertical montre un I presque idéal -V performances avec un rayon de quelques nanomètres seulement, le canal vertical de celui-ci fait que le contact source et drain n'a pas pu être fabriqué dans la même couche, ce qui rend l'agencement des circuits intégrés incompatible avec la technologie du planificateur. De plus, comme la fabrication des semi-conducteurs a été forcée de réduire la longueur du canal à moins de 10 nm, les FET MG sont à nouveau confrontés à l'effet de canal court [9,10,11]. Afin de surmonter l'effet de canal court, les MOSFET à canal en retrait sont devenus un sujet brûlant ces dernières années [12,13,14,15,16]. Le travail de modélisation et de simulation des MOSFET à canal en retrait est également réalisé de manière exhaustive [17,18,19,20]. Un MOSFET à canal encastré a à la fois des parties de canal vertical planificateur sous les contacts de source et de drain et une partie de canal plan horizontal. Il prolonge en fait la longueur effective du canal par rapport aux MOSFET conventionnels avec uniquement le canal plan horizontal. Pour le dispositif avec la même distance entre les contacts de source et de drain, il peut être plus immunisé contre l'effet de canal court par rapport aux MOSFET conventionnels à canal plan; cependant, les données expérimentales montrent que l'oscillation sous-seuil des MOSFET avec canal en retrait ne peut pas réaliser une oscillation sous-seuil idéale avec une longueur de canal effective inférieure à 100 nm. En effet, bien que la longueur du canal soit prolongée, la contrôlabilité de la porte n'est pas renforcée en tant que MG FET. Il est à noter qu'il est préférable de définir un nouveau paramètre géométrique clé lié à la description de l'intégration, au lieu de la longueur du canal. La distance entre les contacts de source et de drain est plus réaliste et efficace car l'objectif final de la conception du dispositif à l'échelle nanométrique est la réalisation des meilleures performances dans une zone de puce donnée limitée, et la taille réelle du dispositif est liée à la largeur du canal. et la distance entre les contacts de source et de drain. Afin de combiner les avantages des FET MG et des MOSFET à canal en retrait, dans nos travaux précédents, nous avons proposé des FET à grille en forme de selle avec un canal en U [21,22,23], ce qui favorise la contrôlabilité de la grille à l'horizontale. partie du canal du canal en retrait d'un type plan à grille unique à un type à triple grille 3-D. Après cela, nous améliorons cette fonction de triple porte 3-D formée non seulement dans la partie du canal horizontal, mais également dans les deux parties du canal vertical. Ce dispositif est nommé FET à canal U à porte H, et le canal en retrait est également mis à niveau en un canal de tube en forme de U 3-D [24]. Comme mentionné ci-dessus, l'objectif final de la conception du dispositif à l'échelle nanométrique est la réalisation des meilleures performances dans une zone de puce donnée limitée grâce à l'optimisation. Pour réaliser un dispositif hautes performances optimisé, la structure de porte et la structure de canal correspondante doivent être bien étudiées et conçues. De plus, la complexité de fabrication doit être bien prise en compte. Les dispositifs mentionnés ci-dessus, tels que le dispositif à canal en retrait, les FET en selle précédemment proposés et les FET HGUC ont une masse commune, une structure sandwich oxyde de grille/grille/oxyde de grille doit être bien formée dans la petite région en retrait. Cette caractéristique structurelle limite sa poursuite de la promotion de l'intégration. Il semble qu'un bon moyen de promouvoir l'intégration consiste à simplifier la caractéristique structurelle dans la région en retrait et à maintenir la capacité de contrôle de la porte à la partie de canal vertical et à la partie de canal horizontale du canal en forme de U en même temps. Afin de réaliser ces caractéristiques et fonctions de l'appareil, dans cet article, nous avons proposé un nouveau FET à canal U à grille rectangulaire (RGUC FET) pour une distance intégrée extrême entre les contacts de source et de drain. Il a un canal en forme de U qui peut prolonger la longueur du canal d'effet sans augmenter la distance entre les contacts de source et de drain. Comparé aux autres FET à canal en forme de U, le FET RGUC est doté d'une structure interne plus simple dans la région en retrait du canal en forme de U ; par la suite, il peut réaliser une fabrication plus simple dans la partie interne de la région en retrait et une distance plus petite entre les contacts de source et de drain (intégration plus élevée). La structure proposée a une meilleure contrôlabilité de la grille et un courant de fuite inverse plus petit accompagné d'un I plus élevé ON /Je OFF rapport. La distance entre le contact source et le contact drain peut être réduite à moins de 2 nm. L'ensemble des propriétés électriques est analysé par des simulations quantiques.
Méthodes
La figure 1a présente la vue schématique 3D du FET RGUC, et les figures 1b à d sont des profils de l'appareil coupés à travers les plans A, B, C et D illustrés sur la figure 1a. W est la largeur du corps du silicium, t b est l'épaisseur du corps du silicium, h dans est la hauteur intérieure de l'entretoise dans la région en retrait, h ex est la hauteur de la région source/drain d'extension, t bœuf est l'épaisseur de l'oxyde de grille autour du corps en silicium, et t sp est l'épaisseur de l'espaceur de la couche isolante déposée dans la région en retrait du canal en forme de U qui est égale à la distance entre le contact de source et le contact de drain.
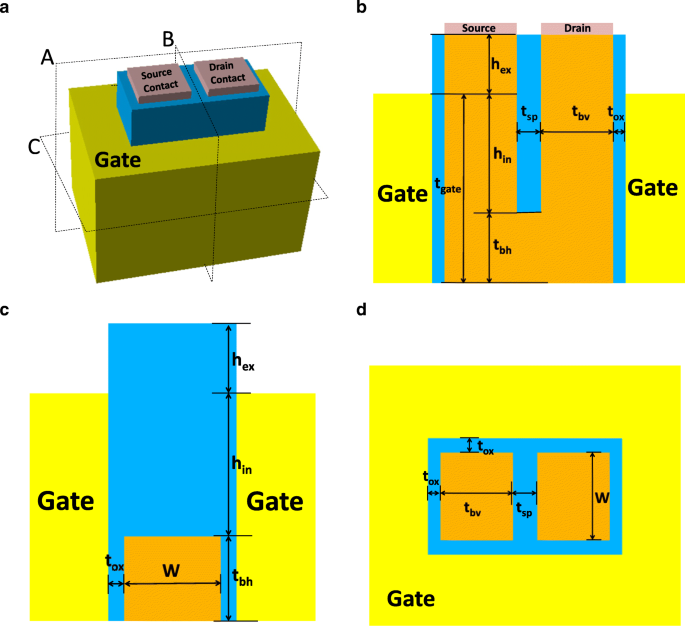
un Vue schématique en 3D du RGUC FET. b Profils de l'appareil coupés à travers le plan A de a . c Profils de l'appareil coupés à travers le plan B de a . d Profils de l'appareil découpés dans le plan C de a
Étant donné que l'épaisseur du corps en silicium est inférieure à 6 nm, des simulations quantiques sont introduites dans cet article à la place des simulations classiques pour obtenir des résultats de simulation plus précis. Toutes les simulations sont effectuées à l'aide de la simulation de dispositif TCAD de SILVACO Atlas 3D, à l'aide du modèle de mobilité dépendant de la concentration, du modèle Shockley-Read-Hall dépendant de la concentration, du modèle de recombinaison Auger, du modèle de rétrécissement de la bande interdite, du modèle de tunnel bande à bande standard et Modèle de potentiel quantique de Bohm [25]. Les paramètres de simulation sont répertoriés dans le tableau 1. Les deux parties verticales du corps sont en fait des cubes à quatre côtés, dont les surfaces supérieures sont recouvertes de la région de source ou de drain et la surface inférieure sont toutes deux connectées à la partie horizontale du corps. Les triples côtés extérieurs des parties verticales du corps sont entourés par l'oxyde de grille et le contact de grille rectangulaire, et l'autre côté intérieur est connecté à l'entretoise intérieure dans la région en retrait. Les quatre côtés du corps horizontal sont tous entourés par l'oxyde de grille et le contact de grille rectangulaire. Il est conjecturable que la porte rectangulaire a une forte capacité de contrôle d'effet de champ à la fois sur le corps horizontal et les deux parties verticales en raison des caractéristiques de structure mentionnées ci-dessus. Et, l'entretoise interne a en fait prolongé la distance du chemin le plus court entre les contacts de source et de drain dans le silicium, ce qui pourrait éliminer l'effet de canal court qui ne peut être évité pour les dispositifs multi-grilles avec des caractéristiques de canal plan. Par rapport à d'autres dispositifs à canaux 3D [21,22,23,24], la structure proposée ne nécessite aucune formation de grille dans la région en retrait, ce qui réduit considérablement la complexité de la structure interne de la région en retrait.
Résultats et discussions
Le modèle de potentiel quantique de Bohm (BQP) calcule un terme d'énergie potentielle dépendant de la position à l'aide d'une équation auxiliaire dérivée de l'interprétation de Bohm de la mécanique quantique. Ce modèle est dérivé de la physique pure et permet au modèle d'approcher le comportement quantique de différentes classes de dispositifs ainsi que d'une gamme de matériaux. Les effets du confinement quantique sur les performances de l'appareil, y compris I -V caractéristiques, seront alors calculés avec une bonne approximation. Des études antérieures montrent que le courant de fuite de grille est négligeable pour les cas d'épaisseur d'oxyde supérieure à 0,5 nm [7, 26].
La figure 2a montre les comparaisons de la tension grille-source du courant drain-source (I DS -V GS ) caractéristiques du FET RGUC avec différents h dans s sur les échelles logarithmique et linéaire. La figure 2b montre les comparaisons des oscillations sous le seuil (SS) et I ON /Je OFF rapport du RGUC FET avec différents h dans s. Avec l'augmentation de h dans , le chemin vertical de l'ensemble du canal de la source au drain est continuellement augmenté, puis la longueur effective de canal la plus courte augmente progressivement, et l'effet de canal court s'affaiblit progressivement et est finalement éliminé. Le SS peut atteindre une valeur presque idéale de 65 mV/dec pour h dans atteint 10 nm. Le Je ON /Je OFF rapport augmente également environ 35 fois pour h dans augmente de 2 à 10 nm en raison de la diminution continue de la SS. Le h prolongé dans fait passer la distance du chemin le plus court de la source au drain de 6 à 22 nm, ce qui équivaut à 2 h dans + t sp et équivaut à la longueur effective du canal de la structure proposée. Les figures 2c et d montrent une distribution de concentration d'électrons en 2D dans le corps en silicium à l'état éteint pour l'appareil avec 2 nm et 10 nm h dans , respectivement. Pour le cas de 2 nm, la concentration d'électrons la plus élevée dans la région horizontale du corps est d'environ 10 12 cm −3 et la distance entre le contact source/drain et la région horizontale du corps est très courte. Par la suite, la polarisation source/drain affecte sérieusement la distribution des électrons dans la région horizontale du corps ; la solution consiste à prolonger le canal vertical qui maintient la source/le drain à l'écart de la région horizontale du corps. Pour le cas de 10 nm, sur la figure 2d, nous pouvons voir que la concentration d'électrons la plus élevée dans la région horizontale du corps est réduite à 10 9 cm −3 , et il fait une région complètement épuisée plus idéale pour l'état éteint qui apporte un niveau beaucoup plus faible de courant de fuite.

un Les comparaisons du I DS -V GS caractéristiques du RGUC FET avec différents h dans s sur les échelles logarithmique et linéaire. b Les comparaisons des oscillations sous-seuil (SS) et I ON /Je OFF rapport du RGUC FET avec différents h dans s. c Distribution de concentration d'électrons 2-D dans le corps de silicium à l'état éteint pour le dispositif avec 2 nm h dans . d Distribution de la concentration d'électrons 2-D dans le corps en silicium à l'état éteint pour l'appareil avec 10 nm h dans
La figure 3a montre les comparaisons des I DS -V GS caractéristiques du RGUC FET avec différents t sp s sur les échelles logarithmique et linéaire. La figure 3b montre les comparaisons des oscillations sous le seuil (SS) et I ON /Je OFF rapport du FET RGUC avec différents t sp s. Avec la diminution de t sp , la distance entre les contacts de source et de drain est également diminuée en continu. Le courant de fuite est principalement induit par le courant tunnel de bande à bande. La probabilité d'effet tunnel est proportionnelle à la courbure de la bande qui peut être équivalente à l'intensité du champ électrique en un certain point. Le courant tunnel total est la somme du courant tunnel généré en chaque point de la région du corps.
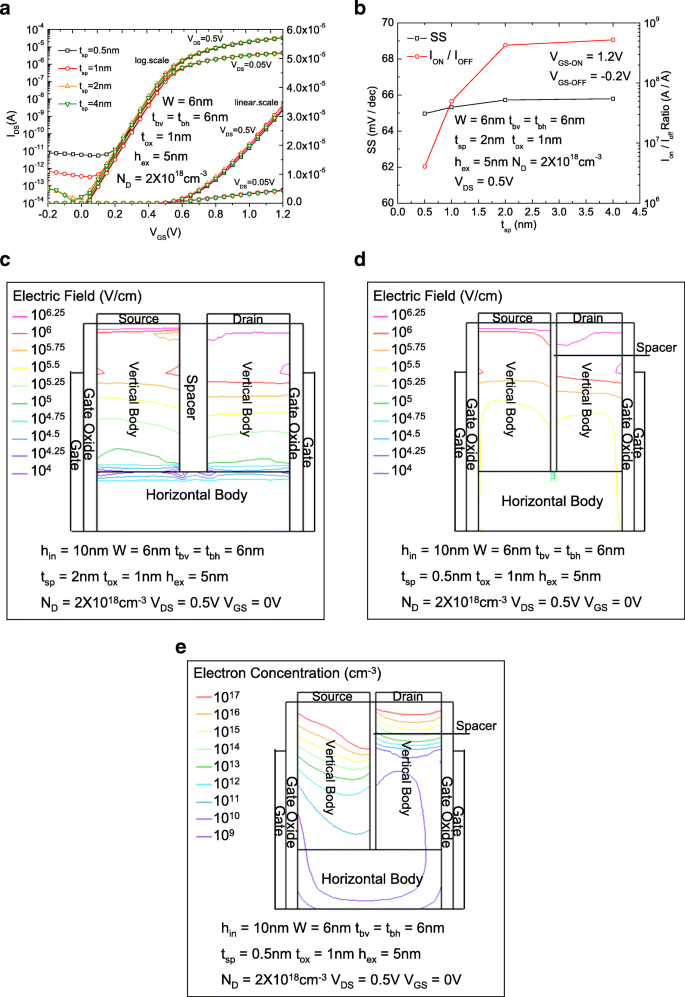
un Les comparaisons du I DS -V GS caractéristiques du RGUC FET avec différents t sp s sur les échelles logarithmique et linéaire. b Les comparaisons des oscillations sous-seuil (SS) et I ON /IOFF rapport du FET RGUC avec différents t sp s. c Répartition du champ électrique 2-D dans le corps en silicium à l'état éteint pour l'appareil avec 2 nm t sp . d Répartition du champ électrique 2-D dans le corps en silicium à l'état éteint pour l'appareil avec 0,5 nm t sp . e Distribution de la concentration d'électrons 2-D dans le corps en silicium à l'état éteint pour l'appareil avec 0,5 nm t sp
La figure 3c et la figure 2d montrent une distribution de champ électrique 2D dans le corps en silicium à l'état éteint pour l'appareil avec 2 nm et 0,5 nm t sp , respectivement. Pour une épaisseur d'entretoise plus importante ou une tension drain-source plus faible (V DS ) polarisation, l'intensité du champ électrique sur l'interface entre l'entretoise dans la région en retrait n'est pas assez forte pour produire une grande quantité de courant de fuite. L'intensité de champ électrique la plus forte apparaît près de l'interface entre l'oxyde de grille et la partie verticale du corps, qui est déterminée par V GD . Cependant, si la distance source-drain est réduite à moins de 1 nm (inférieure à l'épaisseur d'oxyde de grille), l'intensité de champ la plus forte apparaît près de l'interface entre l'espaceur dans la région en retrait et les deux parties verticales du corps. On peut voir que lorsque t sp est inférieur à 1 nm, pour un V plus grand DS (0,5 V par exemple), le courant de fuite est presque indépendant de la polarisation de la grille et principalement décidé par le V DS . Le SS est presque indépendant avec t sp et maintient une valeur presque idéale de 65 mV/dec pour un h dans =cas 10 nm jusqu'au t sp est inférieur à 2 nm. Le Je ON /Je OFF le rapport maintient 10 8 jusqu'au t sp = 2 nm et est sérieusement dégradé pour t sp moins de 2 nm en raison de l'augmentation du courant de fuite induite par le champ électrique intense apparaît près de l'interface entre l'espaceur dans la région en retrait et les deux parties verticales du corps. L'intensité du champ électrique du corps en silicium dans la région du corps est considérablement améliorée pour le t 0,5 nm sp Cas. La figure 3e montre la distribution de la concentration d'électrons en 2D dans le corps en silicium à l'état éteint pour l'appareil avec 0,5 nm t sp . Par rapport à la figure 2d, on voit clairement que la concentration d'électrons dans la région horizontale du corps est agrandie de 10 9 à 10 10 cm −3 . En outre, la dimension de l'épaisseur de l'espaceur de 0,5 nm est très proche d'une couche à molécule unique, ce qui peut endommager la propriété d'isolation de la couche d'espacement dans une certaine mesure. Pour la raison mentionnée ci-dessus, le t sp est suggéré d'être de 2 nm pour une conception à haute intégration et à faible consommation d'énergie.
La figure 4 montre le I DS -V DS du FET RGUC proposé avec une structure optimisée sous différents.
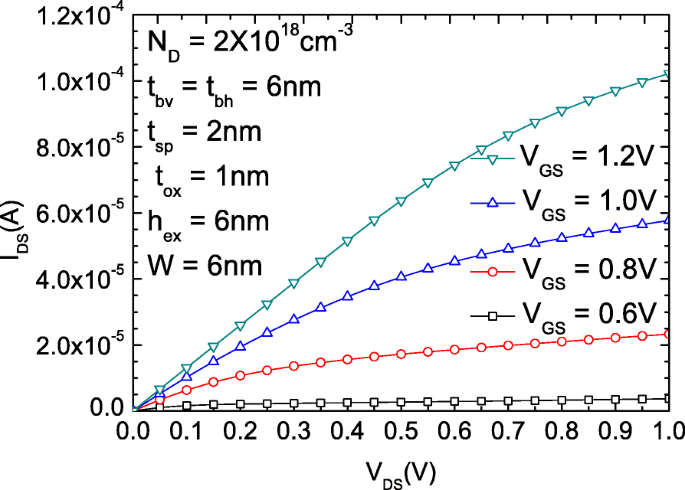
Je DS -V DS caractéristique du RGUC FET proposé avec des paramètres d'appareil optimisés
V GS valeurs, dont le SS est d'environ 63 mV/dec, et le I ON/Je OFF est 10 9 ~ 10 10 . Le courant saturé augmente comme V GS augmente.
Conclusions
Un nouveau FET RGUC avec une intégration élevée et des performances élevées est proposé dans cet article, qui présente des oscillations inférieures au seuil et un I plus élevé. ON /Je OFF rapport. La distance entre les contacts source/drain (S/D) peut être réduite à 2 nm, avec des caractéristiques presque idéales telles que SS, courant de fuite inverse et I ON /Je OFF rapport. Toutes les propriétés électriques sont simulées avec des modèles quantiques pour garantir des résultats plus précis.
Abréviations
- BQP :
-
Potentiel quantique de Bohm
- FET :
-
Transistor à effet de champ
- h ex :
-
Hauteur d'extension de l'entretoise entre la région S/D
- h dans :
-
Hauteur intérieure de l'entretoise dans la zone en retrait
- Je OFF :
-
Hors courant
- Je ON :
-
Sur courant
- JL :
-
Sans jonction
- MOS :
-
Semi-conducteur à oxyde métallique
- N D :
-
Concentration de dopage
- RGUC :
-
Portail rectangulaire canal U
- S/D :
-
Source/drain
- SS :
-
Balançoire sous le seuil
- t bh :
-
Épaisseur horizontale du corps
- t bv :
-
Épaisseur verticale du corps
- t porte :
-
Longueur verticale du portail
- t bœuf :
-
Épaisseur de la couche d'oxyde de grille
- t sp :
-
Epaisseur de l'entretoise entre la région S/D
- V DS :
-
Tension drain-source
- V GS :
-
Tension grille-source
- W :
-
Largeur du corps
Nanomatériaux
- Différence entre structure et classe :expliquée avec un exemple C++
- Différence entre while et do-while :expliquée avec des exemples
- Nanomatériau et nanocomposite intelligents dotés d'activités agrochimiques avancées
- Transistors multicouches à effet de champ SnSe Nanoflake avec contacts Au Ohmic à faible résistance
- Synthèse facile de nanofils d'argent avec différents rapports d'aspect et utilisés comme électrodes transparentes flexibles hautes performances
- Électrode porte d'argent imprimée par jet d'encre et durcie aux UV avec une faible résistivité électrique
- Résistance de contact réduite entre le métal et le n-Ge par insertion de ZnO avec traitement au plasma d'argon
- Lasers à nanofils plasmon à canal avec cavités à rainure en V
- Matériaux d'interface thermique assistés par graphène avec un niveau de contact d'interface satisfaisant entre la matrice et les charges



