Analyse théorique des photodiodes d'avalanche à photon unique InGaAs/InAlAs
Résumé
L'analyse théorique et la simulation bidimensionnelle de photodiodes à avalanche InGaAs/InAlAs (APD) et d'APD à photon unique (SPAD) sont présentées. La distribution du champ électrique et l'effet tunnel des APD et SPAD InGaAs/InAlAs sont étudiés. Lorsque les SPAD InGaAs/InAlAs fonctionnent en mode Geiger, le champ électrique augmente linéairement dans la couche d'absorption et dévie de ses relations linéaires dans la couche de multiplication. Compte tenu du champ électrique de seuil d'effet tunnel dans la couche de multiplication, l'épaisseur de la couche de multiplication doit être supérieure à 300 nm. De plus, les SPAD peuvent fonctionner sous une tension de polarisation élevée pour éviter l'effet tunnel dans la couche d'absorption avec des concentrations élevées de dopage dans la couche de charge.
Contexte
En0,53 Ga0.47 As/In0,52 Al0,48 Les photodiodes à avalanche As (ci-après dénommées InGaAs/InAlAs) et InGaAs/InP (APD) sont les photodétecteurs les plus importants pour la détection infrarouge à ondes courtes. Ces dernières années, les recherches sur la distribution des clés quantiques ont rapidement progressé et les APD InGaAs/InAlAs et InGaAs/InP peuvent désormais réaliser le comptage et la synchronisation d'un photon en tant qu'APD à photon unique (SPAD) [1]. Par rapport à d'autres détecteurs à photon unique dans la gamme de longueurs d'onde SWIR, tels que les tubes photomultiplicateurs, les diodes à avalanche à photon unique InGaAs présentent les avantages distinctifs de hautes performances, haute fiabilité, faible polarisation, petite taille, bonne résolution temporelle et facilité d'utilisation [ 2, 3]. Ainsi, les APD InGaAs/InAlAs et InGaAs/InP attirent l'attention [4, 5]. Par rapport aux APD fonctionnant en mode linéaire, les APD fonctionnant en mode Geiger en tant que SPAD sont appliqués avec une polarisation inverse qui dépasse la tension de claquage [6]. Les SPAD atteignent un gain élevé dans la couche de multiplication, et un seul photon peut déclencher une impulsion de courant macroscopique, ce qui permet de détecter avec précision l'arrivée au détecteur d'un seul photon [7]. Ainsi, les SPAD peuvent détecter le photon unique à une longueur d'onde de 1550 nm [8]. Pendant ce temps, la longueur d'onde d'absorption peut être contrôlée par les matériaux de la couche d'absorption [9].
Par rapport aux SPAD à base d'InAlAs, les études théoriques et de simulation des SPAD à base d'InP sont plus complètes [2, 10,11,12]. Cependant, les APD basés sur InAlAs sont de plus en plus utilisés à la place des APD basés sur InP car ils peuvent améliorer les performances à la fois des APD et des SPAD [13]. Le rapport du coefficient d'ionisation de l'électron (α) au trou (β) dans InAlAs est plus grand que celui dans InP, ce qui entraîne un faible facteur de bruit excessif et un produit gain-largeur de bande élevé dans les APD à base d'InAlAs [14]. La plus grande bande interdite des InAlAs peut améliorer les caractéristiques de claquage et diminuer le taux de comptage de noir (DCR) dans les SPAD [15]. Les APD à base d'InAlAs ont une mobilité électronique élevée, ce qui conduit à des temps de réponse plus rapides que ceux des APD à base d'InP [16]. De plus, le rapport de coefficient d'ionisation des APD InAlAs est moins sensible aux changements de température des APD à base d'InP [17]. Par conséquent, les APD InGaAs/InAlAs peuvent atteindre des performances élevées en termes de caractéristiques de claquage, de DCR, de bruit excessif, de bande passante de gain, de temps de réponse et de caractéristiques de température.
Les études sur les APD InGaAs/InAlAs se sont principalement concentrées sur l'augmentation de l'efficacité de détection de photon unique (SPDE) et la diminution du DCR dans les SPAD. Karvé et al. ont démontré les premiers SAPD InGaAs/InAlAs, qui ont un SPDE de 16 % à 130 K [18]. Nakata et al. amélioré les performances de température des SPAD, qui atteignent un SPDE de 10 % à 213 K [19]. Zhao et al. conçu un SPAD InGaAs/InAlAs à auto-extinction et auto-récupération avec un SPDE de 11,5% à 160 K ; parallèlement, un DCR de 3,3 M Hz a été observé [20]. Meng et al. conçu une structure mesa InGaAs/InAlAs SPAD, qui atteint un SPDE de 21% à 260 K [21]. Ensuite, ils ont appliqué une couche épaisse d'absorption et de multiplication dans une structure similaire, ce qui améliore le SPDE à 26 % à 210 K et diminue le DCR à 1 × 10 8 Hz [22]. Cependant, dans ces études, les DCR des SPAD InGaAs/InAlAs sont trop élevés par rapport aux SPAD InGaAs/InP (dans les SPAD InP récents, les DCR sont typiques < 10 4 Hz) [23]. Les DCR élevés dans les SPAD InGaAs/InAlAs sont attribués aux courants d'effet tunnel, qui sont causés par le champ élevé à la surtension de polarisation [21, 22, 24]. Ainsi, la diminution des mécanismes liés à l'effet tunnel est importante pour les SPAD InGaAs/InAlAs, et ces mécanismes sont liés à la distribution du champ électrique dans les SAPD. Des littératures [1. 9], le champ électrique de seuil tunnel est de 2,0 × 10 5 V/cm dans la couche d'absorption (InGaAs) et 6,8 × 10 5 V/cm dans la couche de multiplication (InAlAs). Ainsi, une distribution de champ électrique appropriée est importante pour les SPAD InAlAs, qui est déterminée par l'épaisseur de la couche de charge et de la couche de multiplication. Considérant la couche de charge des APD InAlAs, Kleinow et al. ont étudié l'influence de la concentration de dopage dans cette couche et ont constaté que la concentration de dopage est plus importante pour les performances des APD InGaAs/InAlAs [25, 26]. Chen et al. ont étudié l'influence des couches de charge et de multiplication sur les tensions de perforation et de claquage par analyse théorique et simulation [27]. Ces études se sont concentrées sur les performances des APD InAlAs sous le modèle linéaire. Cependant, les performances des SPAD InAlAs n'ont pas encore été entièrement comprises en mode Geiger.
Dans cet article, l'analyse théorique et la simulation sont utilisées pour étudier l'effet tunnel et la distribution du champ électrique dans les SPAD InGaAs/InAlAs. Avec la prise en compte du champ électrique à seuil tunnel sous le mode Geiger, les critères de conception des SPAD sont optimisés pour éviter l'effet tunnel.
Méthodes
Des simulations numériques sont effectuées pour les APD SAGCM InGaAs/InAlAs à éclairage frontal en utilisant le TCAD [28]. Les modèles physiques utilisés pour la simulation sont présentés comme suit. Le modèle d'ionisation par impact de Selberherr simule la multiplication des avalanches dans InAlAs. La distribution du champ électrique et le courant de diffusion sont décrits par le modèle de dérive-diffusion, qui inclut les équations de Poisson et de continuité des porteurs. Des modèles de tunneling bande à bande et assistés par piège sont utilisés pour le courant tunnel. D'autres modèles de base, notamment les statistiques des porteurs de Fermi-Dirac, la recombinaison Auger, la dépendance à la concentration des porteurs, la recombinaison Shockley-Read-Hall, la faible mobilité de champ, la saturation en vitesse, l'ionisation par impact et la méthode de traçage des rayons sont utilisés dans la simulation. La coupe transversale schématique de la structure épitaxiale APD à éclairage frontal pour la simulation est illustrée à la figure 1.
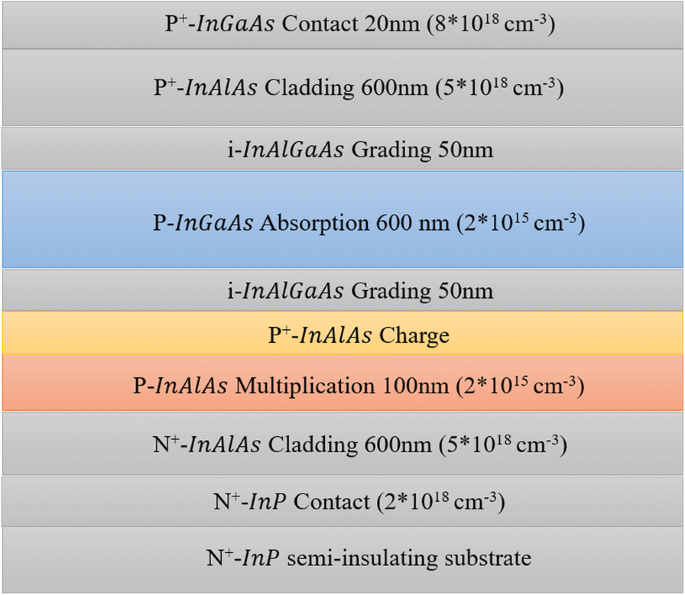
Coupe schématique des APD SAGCM à éclairage frontal. Présente la coupe transversale schématique de l'APD SAGCM InGaAs/InAlAs illuminé par le haut. Il comprend la structure, les matériaux, le dopage et l'épaisseur. De bas en haut, les couches sont nommées séquentiellement comme substrat, couche de contact, couche de revêtement, couche de multiplication, couche de charge, couche de classement, couche d'absorption, couche de classement, couche de revêtement et couche de contact
De bas en haut, les couches sont nommées séquentiellement substrat, couche de contact, couche de revêtement, couche de multiplication, couche de charge, couche de classement, couche d'absorption, couche de classement, couche de revêtement et couche de contact. Les porteurs photogénérés induits dans la couche d'absorption dérivent vers la couche de multiplication, où ils déclenchent le claquage par avalanche. Le champ électrique dans l'absorption est ajusté à l'aide du contrôle de la couche de charge et maintient un champ élevé uniquement dans la couche de multiplication. Entre les couches de charge et d'absorption, une couche de gradation InAlGaAs évite l'accumulation d'électrons à l'hétérojonction InGaAs-InAlAs. La structure du dispositif dans notre simulation est similaire à la structure expérimentale de la réf. [21].
La distribution du champ électrique dans SAGCM APD peut être résolue avec l'équation de Poisson, le modèle de couche d'appauvrissement PN et l'équation de condition aux limites [29]. L'équation de Poisson est donnée par
$$ \frac{d\xi}{d x}=\frac{\rho }{\varepsilon }=\frac{q\ast N}{\varepsilon }. $$ (1)L'équation de condition aux limites est donnée par
$$ Vbias+ Vbi=-{\int}_0^w\xi \left(x,\mathrm{w}\right) dx. $$ (2)Dans ces équations, ρ est égal à l'ion dopant q × N dans la couche d'épuisement, ε est la constante diélectrique du matériau, V biais est la tension de polarisation sur les APD, V bi est le potentiel intégré, et w est l'épaisseur de la couche d'appauvrissement. La relation mathématique entre la distribution du champ électrique et la tension de polarisation lorsque la limite de la couche d'appauvrissement atteint la couche de contact dans le dispositif peut être dérivée à l'aide des équations. (1) et (2).
Les courants tunnel sont composés de tunnels bande à bande et assistés par piège. Le courant tunnel bande à bande dépend du champ dans le matériau et devient une composante dominante du courant d'obscurité à des champs élevés [24, 30]. Le taux de génération du tunnel bande à bande est donné par [31].
$$ {G}_{\mathrm{btb}}={\left(\frac{2{m}^{\ast }}{E_g}\right)}^{1/2}\frac{q^2E }{{\left(2\pi \right)}^3\mathrm{\hslash}}\exp \left(\frac{-\pi }{4q\mathrm{\hslash}E}{\left(2{ m}^{\ast}\ast {E}_g^3\right)}^{\raisebox{1ex}{$1$}\!\left/ \!\raisebox{-1ex}{$2$}\right. }\droit) $$ (3)Dans l'équation ci-dessus, E g est la bande interdite énergétique de InGaAs (0,75 eV) ou InAlAs (1,46 eV), m* (égal à 0,04 m e en InGaAs et 0,07 m e en InAlAs) est la masse réduite effective, et E est le champ électrique maximal. G btb dépend du champ électrique E et bande interdite énergétique E g , w tunnel est supposée être l'épaisseur effective pour le processus de creusement, et A est supposé être la surface de l'appareil. Ainsi, le courant tunnel du tunnel bande à bande est donné par [13].
$$ {I}_{\mathrm{tunnel}}/A={G}_{\mathrm{btb}}\ast q\ast {w}_{\mathrm{tunnel}} $$ (4)Les résultats calculés de I tunnel /Un (w tunnel = 1 μm) sont présentés sur la Fig. 2. I tunnel devient significatif à 2.0 × 10 5 V/cm d'InGaAs et 6,9 × 10 5 V/cm d'InAlAs, respectivement. Nous constatons que ces valeurs calculées correspondent bien au champ électrique seuil tunnel (2,0 × 10 5 V/cm, InGaAs) et (6,8 × 10 5 V/cm, InAlAs) en références. Le courant tunnel peut suffisamment influencer les performances des SPAD à un champ élevé. Ainsi, le champ doit être ajusté à une valeur inférieure à la valeur de seuil d'effet tunnel à la fois dans l'InGaAs et l'InAlAs des SPAD. Le tableau 1 présente les paramètres utilisés dans la simulation.
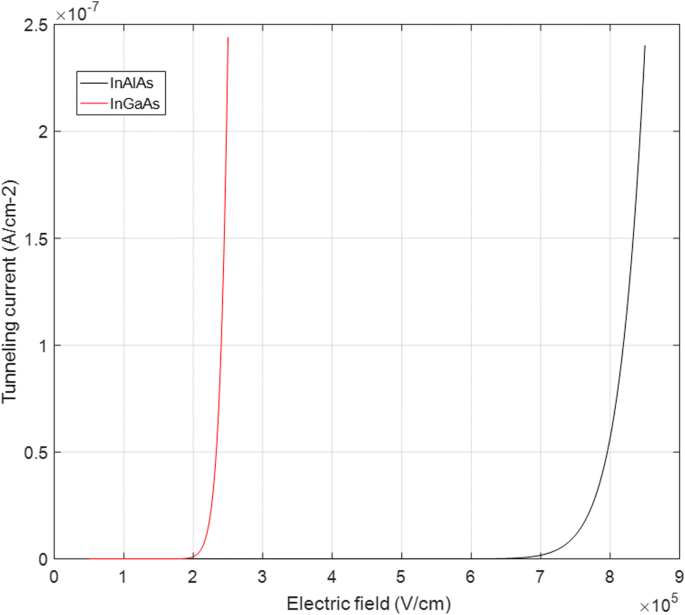
Relation entre Je tunnel /Un et le champ électrique dans InGaAs et InAlAs. Présente les résultats calculés de I tunnel /Un . Je tunnel devient significatif à 2.0 × 10 5 V/cm d'InGaAs et 6,9 × 10 5 V/cm d'InAlAs, respectivement
Résultats et discussion
Dans cette section, l'analyse théorique et les conclusions ont été étudiées par simulation. Tout d'abord, la distribution du champ électrique en mode Geiger a été étudiée dans la section A. Ensuite, avec la considération du champ électrique à seuil tunnel sous le mode Geiger, les critères de conception des SPAD sont optimisés pour éviter l'effet tunnel dans la section B. Le dispositif typique La structure de la référence [22] a été utilisée pour tester le modèle de simulation. Dans cette simulation, nous avons utilisé le même moteur de simulation que la référence [28] et la courbe courant-tension ainsi que la courbe gain en fonction de la tension ont été données par la Fig. 3. On peut constater que le gain augmente progressivement après la tension de perçage et augmentation soudaine de la tension de claquage.
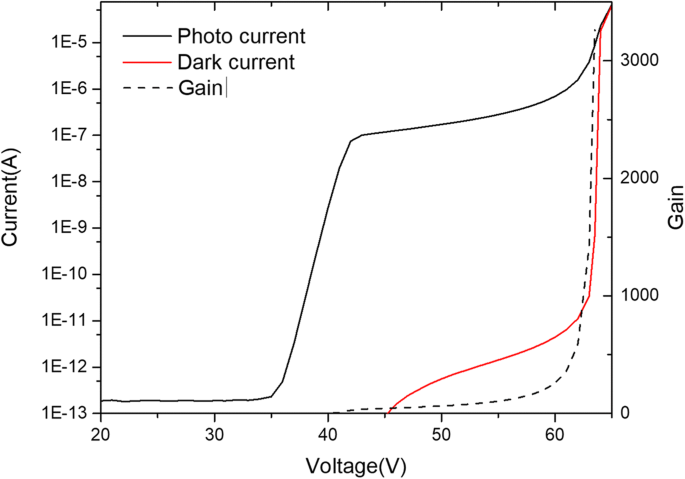
Courbe courant-tension avec gain en fonction de la tension de l'APD InGaAs/InAlAs. Présente la courbe i-v ainsi que la courbe de gain en fonction de la tension pour une structure d'appareil typique comme figure
Distribution du champ électrique en mode Geiger
Nous avons constaté que les performances de l'appareil sont fortement influencées par la distribution du champ électrique. Pour maintenir le gain élevé et le faible courant d'obscurité, le contrôle approprié du champ électrique dans les couches de multiplication et d'absorption est important. De la réf. [32], une distribution de champ appropriée dans l'APD InGaAs/InAlAs devrait être conforme à ces règles. La garantie Vpt (tension de perforation) < Vbr (tension de claquage) et Vbr -Vpt devrait avoir une marge de sécurité pour traiter les variations des fluctuations de température et de la plage de fonctionnement. A la tension de claquage, le gain de multiplication tend vers l'infini et le courant augmente brutalement [32]. Lorsque le courant d'obscurité ou photo a atteint 50 μA, la tension correspondante est appelée tension de claquage Vbr . Dans la couche d'absorption, le champ électrique doit être supérieur à 50-100 kV/cm pour assurer une vitesse suffisante pour les porteurs photo-induits. Parallèlement, le champ électrique doit être inférieur à 180 kV/cm pour éviter l'effet tunnel dans la couche d'absorption. La distribution du champ électrique influence grandement les performances de l'appareil. Le choix du champ électrique dans la couche d'absorption permet d'équilibrer le compromis entre un temps de transit court, un courant d'obscurité et une réactivité élevée pour les exigences pratiques.
Les figures 4 et 5 présentent les caractéristiques de tension de champ simulées dans les couches de multiplication et d'absorption sous le mode Geiger, respectivement. Les APD fonctionnant en mode Geiger en tant que SPAD sont appliqués avec une polarisation inverse qui dépasse la tension de claquage 1 à 6 V dans la simulation. L'épaisseur de la couche de charge (W facturation ) est de 50 nm, et les épaisseurs de la couche de multiplication (W multiplication ) sont respectivement de 100, 200 et 300 nm.
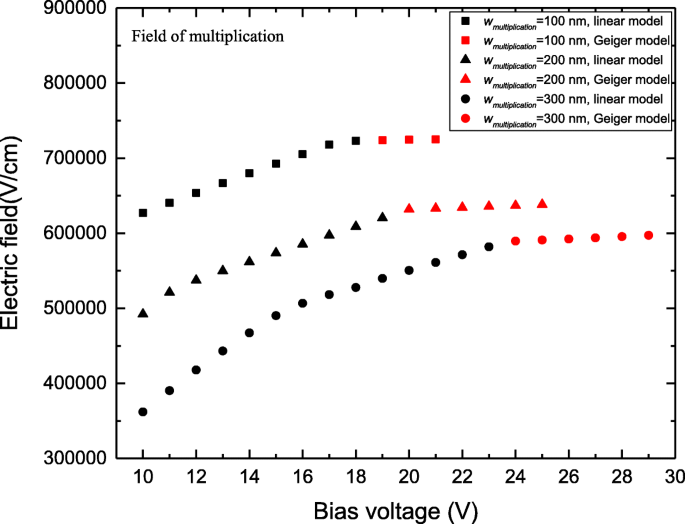
La simulation produit un champ électrique en multiplication sous le mode Geiger. Les valeurs de W multiplication est 100 nm (carré noir), 200 nm (triangle noir), 300 nm (cercle noir). La figure 3 présente les caractéristiques de tension de champ simulées dans les couches de multiplication sous le mode Geiger. L'épaisseur de la couche de charge est de 50 nm et les épaisseurs de la couche de multiplication sont respectivement de 100, 200 et 300 nm
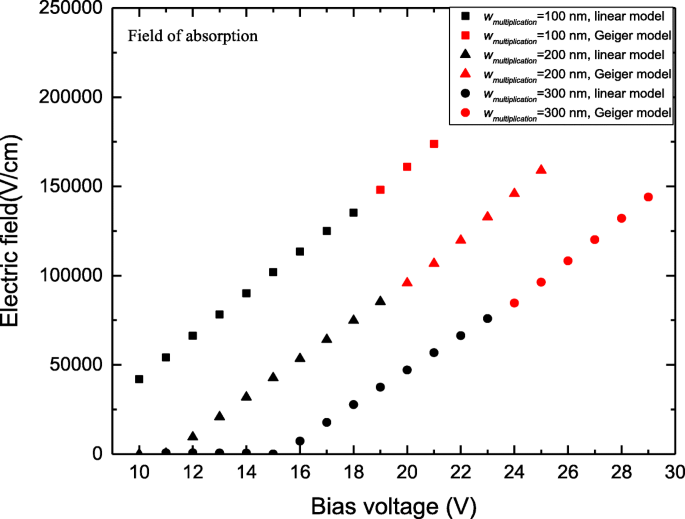
La simulation résulte du champ électrique en absorption sous le mode Geiger. Les valeurs de W multiplication est de 100 nm (carré noir), 200 nm (triangle noir), 300 nm (cercle noir). La figure 4 présente les caractéristiques de tension de champ simulées dans les couches d'absorption sous le mode Geiger. L'épaisseur de la couche de charge est de 50 nm et les épaisseurs de la couche de multiplication sont respectivement de 100, 200 et 300 nm.
Lorsque les SPAD InGaAs/InAlAs fonctionnent selon le modèle linéaire (APD), le champ électrique dans la couche d'absorption et la couche de multiplication augmente linéairement avec l'augmentation de la tension de polarisation. Cependant, comme la tension de polarisation dépasse la tension de claquage sous le mode Geiger, le champ électrique dans la couche d'absorption augmente linéairement comme auparavant, tandis que l'augmentation du champ électrique d'avalanche dans la couche de multiplication devient lente. Par rapport aux APD InGaAs/InAlAs fonctionnant en mode linéaire, les SPAD InGaAs/InAlAs atteignent un gain élevé dans la couche de multiplication avec le champ d'avalanche le plus élevé, et un seul photon peut déclencher une impulsion de courant macroscopique. Parallèlement, le champ d'absorption sous le mode Geiger est plus grand que celui sous le modèle linéaire. Le courant tunnel devient la composante dominante du courant d'obscurité dans le champ élevé et un seul photon peut déclencher une impulsion de courant macroscopique avec le gain d'avalanche, qui est beaucoup plus grand que le mode linéaire.
Considération de conception des SPAD
Nous savons que les SAPD fonctionnent en mode saturé. Pour maintenir le gain élevé et le faible courant d'obscurité, le contrôle du champ électrique dans les couches de multiplication et d'absorption est important. Si le champ en absorption est inférieur au champ seuil d'effet tunnel, cela peut maintenir un champ électrique d'avalanche élevé dans la couche de multiplication et éviter un courant d'effet tunnel. Par conséquent, la concentration et l'épaisseur de chaque couche doivent être correctement conçues pour les SPAD.
La figure 2 montre que les SPAD ont une probabilité d'effet tunnel important en raison du champ élevé dans les couches de multiplication et d'absorption, qui dépassent le champ électrique seuil de tunnel. Ainsi, les champs électriques doivent être ajustés pour être inférieurs à la valeur seuil d'effet tunnel à la fois en absorption InGaAs et en multiplication InAlAs. L'analyse théorique montre que le champ électrique d'avalanche de multiplication est diminué par les produits de N facturation et w facturation [28]. Ainsi, la couche de charge peut contrôler le champ en absorption; cependant, le champ électrique d'avalanche de la couche de multiplication est déterminé par w multiplication . La figure 6 présente les caractéristiques de tension de champ simulées pour différentes épaisseurs de multiplication (100 à 500 nm) lorsque l'appareil subit un claquage par avalanche. Le dopage de fond dans la couche de multiplication et la couche d'absorption est de 2 × 10 15 cm −3 , qui est la concentration intrinsèque de l'épitaxie par faisceau moléculaire (MBE). Les résultats de la simulation montrent que le champ électrique d'avalanche dans la couche de multiplication diminue avec l'augmentation de l'épaisseur de la couche de multiplication. Ainsi, une couche de multiplication épaisse peut éviter la probabilité d'effet tunnel à travers un champ électrique d'avalanche faible lors de la multiplication.

Champ électrique dans la couche de multiplication avec différents W multiplication . La figure 5 présente les caractéristiques de tension de champ simulées pour différentes épaisseurs de multiplication (100 à 500 nm) lorsque l'appareil subit un claquage par avalanche
Pour éviter que le champ électrique d'avalanche lors de la multiplication ne dépasse la valeur seuil d'effet tunnel sous le mode Geiger, l'épaisseur de la multiplication doit être> 300 nm, ce qui a un champ électrique d'avalanche inférieur à 6 × 10 5 V/cm et dépasse même la tension de claquage de la figure 4. Ainsi, une couche de multiplication épaisse peut éviter l'effet tunnel dans les SPAD que sous le mode Geiger. C'est la raison pour laquelle le faible DCR dans les SPAD avec une multiplication épaisse.
Comme mentionné dans la section A, le champ électrique dans la couche d'absorption augmente linéairement sous le mode Geiger. L'augmentation de la tension de polarisation influence de manière significative le champ électrique dans la couche d'absorption, ce qui induit que le champ a une forte probabilité dépassant 2,0 × 10 5 V/cm. La figure 7 présente la distribution simulée du champ électrique pour différentes concentrations de dopage dans la couche de charge (w facturation = 50 nm). Nous constatons que des concentrations de dopage plus élevées ont un faible champ électrique dans la couche d'absorption et dépassent même la tension de claquage de 5 V sous le mode Geiger ; cependant, à des concentrations de dopage plus faibles, le champ électrique seuil d'effet tunnel est rapidement atteint. Par conséquent, les concentrations de dopage plus faibles dans la couche de charge provoquent une initiation plus précoce des effets tunnel. Pour acquérir une tension de polarisation de fonctionnement suffisante en mode Geiger, le N facturation des SPAD est plus grand que le N facturation des APD. Par rapport au N inférieur facturation des SPAD, le plus élevé N facturation des SPAD peuvent fonctionner sous une tension de polarisation élevée pour éviter l'effet tunnel et obtenir un gain élevé dans la couche de multiplication.
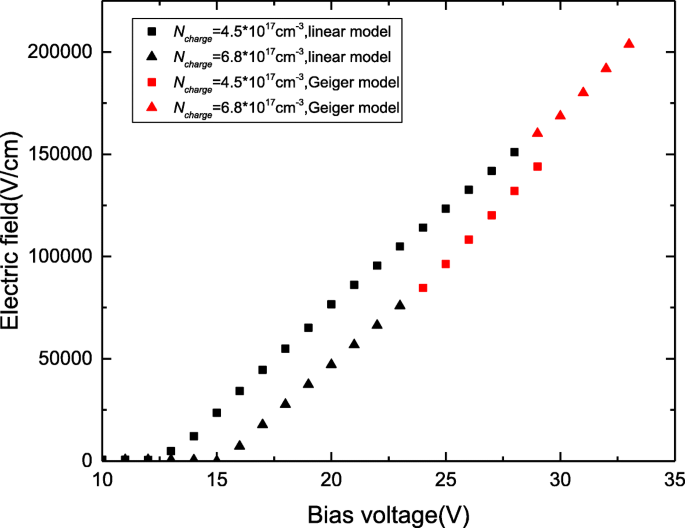
Champ dans la couche d'absorption avec différents N facturation . Les valeurs de N facturation est de 4,5*10 17 cm − 3 (carré noir), 6,8*10 17 cm −3 (triangle noir). La figure 6 présente la distribution d'absorption du champ électrique pour différentes concentrations de dopage dans la couche de charge (W facturation = 50 nm)
Conclusions
Nous étudions la distribution du champ électrique et l'effet tunnel des APD et SPAD InGaAs/InAlAs par analyse théorique et simulation. Lorsque les SPAD InGaAs/InAlAs fonctionnent en mode Geiger, le champ électrique dans la couche d'absorption augmente linéairement et dévie de ses relations linéaires. Compte tenu du champ électrique de seuil d'effet tunnel dans la couche de multiplication, l'épaisseur de la couche de multiplication doit être supérieure à 300 nm. De plus, les SPAD peuvent fonctionner sous une tension de polarisation élevée pour éviter l'effet tunnel dans la couche d'absorption avec des concentrations élevées de dopage dans la couche de charge.
Abréviations
- 2D :
-
Bidimensionnel
- APD :
-
Photodiode d'avalanche
- DCR :
-
Taux de comptage sombre
- SAGMAPD :
-
Photodiodes séparées d'absorption, de gradation, de charge et d'avalanche de multiplication
- SPAD :
-
Photodiode à avalanche monophotonique
- SPDE :
-
Efficacité de détection de photon unique
Nanomatériaux
- Options d'analyse
- Analyse de l'actine et de l'organisation de l'adhésion focale dans des cellules U2OS sur des nanostructures polymères
- Analyse de la réflectance infrarouge de couches de GaN dopées épitaxiales de type n cultivées sur du saphir
- Source lumineuse à photon unique à 1,3 μm basée sur un point quantique à double couche InAs dans un micropilier
- Étude théorique de nanofils de germanium soumis à une traction biaxiale
- Analyse de cartographie Raman des résonateurs à micro-anneaux en silicium intégrés au graphène
- Fabrication de nanofibres hélicoïdales CA/TPU et son analyse de mécanisme
- Photoconductivité interbande des points quantiques métamorphiques InAs/InGaAs dans la fenêtre 1,3–1,55 μm
- Études théoriques sur les photodiodes d'avalanche InGaAs/InAlAs SAGCM



