Dépendance de l'épaisseur sur les propriétés interfaciales et électriques dans la couche atomique déposée AlN sur le plan c GaN
Résumé
Les propriétés interfaciales et électriques de la couche atomique déposée AlN sur n-GaN avec différentes épaisseurs d'AlN ont été étudiées. Selon capacité-tension (C –V ), l'échantillon avec un AIN de 7,4 nm d'épaisseur présentait les densités d'interface et de piège à oxyde les plus élevées. Lorsque l'épaisseur d'AlN était de 0,7 nm, les spectres de spectroscopie photoélectronique à rayons X (XPS) ont montré le pic dominant associé aux liaisons Al-O, ainsi qu'aucun pic d'AlN clair. La quantité d'atomes d'oxygène restants près de la surface de GaN s'est avérée diminuer pour l'AlN plus épais. Cependant, de nombreux atomes d'oxygène étaient présents à travers la couche d'AlN, à cause des défauts liés à l'oxygène, qui ont finalement augmenté la densité d'état de l'interface. L'inhomogénéité de la barrière avec le modèle d'émission thermoionique (TE) était appropriée pour expliquer le courant de polarisation directe pour l'échantillon avec un AIN de 7,4 nm d'épaisseur, ce qui n'était pas approprié pour l'échantillon avec un AIN de 0,7 nm d'épaisseur. Les courants de fuite inverse pour les deux échantillons avec de l'AlN de 0,7 et 7,4 nm d'épaisseur ont été mieux expliqués en utilisant les émissions de Fowler-Nordheim (FN) plutôt que de Poole-Frenkel.
Contexte
En raison de la large bande interdite, de la vitesse de saturation élevée des électrons et du champ de claquage élevé, les matériaux à base de nitrure III présentent un grand intérêt non seulement pour les dispositifs optoélectroniques tels que les diodes électroluminescentes bleues (LED), les diodes laser (LD) et les détecteurs UV, mais aussi pour des dispositifs électroniques tels que les transistors à haute mobilité électronique (HEMT) et les dispositifs de puissance [1,2,3,4]. La réalisation de dispositifs à base de GaN hautes performances nécessite une interface métal/GaN avec une densité d'état d'interface minimale, qui peut agir comme des pièges à électrons ou limiter la modulation des hauteurs de barrière en fonction de la fonction de travail du métal en fixant le niveau de Fermi [5, 6]. Pour d'autres techniques d'amélioration des dispositifs à base de GaN, certaines méthodes telles que la prolifération de coalescence de nanocolonnes GaN, les m non polaires -plane GaN, nanoimprint GaN template, et nanotiges de GaN à face semi-polaire ont également été démontrés [7,8,9,10,11]. Parmi les semi-conducteurs composés de nitrure III, le nitrure d'aluminium (AlN) peut être appliqué aux détecteurs UV, aux émetteurs à courte longueur d'onde et aux détecteurs, en raison de sa bande interdite élevée (∼ 6,2 eV), de sa conductivité thermique élevée, de sa résistance électrique élevée et de sa faible expansion. à haute température [12, 13]. De plus, AlN peut être déposé dans un procédé compatible métal-oxyde-semi-conducteur complémentaire (CMOS) par dépôt de couche atomique (ALD) (~ 300 °C), ce qui est un gros avantage. Les films d'AlN polycristallins et amorphes cultivés par ALD peuvent être utilisés comme couche diélectrique pour les dispositifs microélectroniques [14]. Malgré les progrès des techniques de croissance de l'AlN, l'AlN cultivé par ALD révèle encore une propriété non stoechiométrique qui contient une grande quantité d'impuretés liées à l'oxygène [15]. La quantité d'atomes d'oxygène dans l'AlN peut affecter fortement les propriétés électriques et optiques de l'AlN [16].
Haut-k oxydes diélectriques tels que Al2 O3 et HfO2 ont été utilisés comme couche de passivation dans des transistors à haute mobilité électronique (HEMT) AlGaN/GaN [17, 18]. Mais la formation de liaisons Ga-O au niveau de l'Al2 O3 L'interface /(Al)GaN est connue pour produire une haute densité d'états d'interface profonds (et lents) [19]. En tant que matériau de passivation alternatif avec de faibles états d'interface, l'AlN a été envisagé pour les dispositifs à base de GaN en raison de sa plus petite disparité de réseau avec GaN [20, 21]. De plus, la modulation des propriétés électriques telles que les hauteurs de barrière dans les contacts métal/semi-conducteur (MS) en insérant une couche d'oxyde très mince a été rapportée dans GaN [22, 23]. Augmentation de la hauteur de barrière en Pt/HfO2 Diodes /GaN métal-isolant-semiconducteur (MIS) avec un HfO2 de 5 nm d'épaisseur couche a été rapporté [22]. L'insertion d'une couche de 3 nm de MgO à une interface Fe/GaN s'est avérée réduire la hauteur de barrière effective à 0,4 eV [23]. Encore maintenant, cependant, il existe un nombre limité d'articles faisant état des propriétés de contact artificielles avec de l'AlN cultivé par ALD sur GaN. Dans ce travail, nous avons déposé des couches d'AlN sur n-GaN par ALD avec différentes épaisseurs et étudié les propriétés de l'interface AlN/n-GaN.
Méthodes
Matériaux et fabrication de dispositifs
Epitaxie en phase vapeur d'hydrure (HVPE) cultivée, non dopée, c -plan (0001) en vrac GaN (épaisseur 300 m, concentration de porteur 5 × 10 14 cm −3 , densité de dislocation de filetage 1,5 × 10 7 cm −2 ) acheté chez Lumilog a été utilisé dans ce travail. Après avoir coupé la plaquette en petits morceaux, certains d'entre eux ont été chargés dans une chambre ALD après un processus de nettoyage dans un HCl:H2 O (1:1) solution. Ensuite, la température a été augmentée jusqu'à 350 °C pour déposer la couche d'AIN. Des couches minces d'AlN ont été déposées par système ALD thermique (fabricant :CN-1 en Corée ; modèle :Atomic Classic) en utilisant du triméthylaluminium (TMA) et du NH3 comme précurseurs. Trois couches d'AlN épaisses différentes (0,7, 1,5 et 7,4 nm) ont été préparées en faisant varier le nombre de cycles ALD. Les épaisseurs de film d'AlN ont été mesurées à l'aide d'ellipsomètres multi-longueurs d'onde FS-1 (fabricant :Film Sense aux USA; modèle :FS-1). Pour examiner les caractéristiques électriques des films, des diodes MIS ont été fabriquées avec une électrode Pt Schottky (diamètre 500 µm, épaisseur 50 nm) et un contact arrière en Al (épaisseur 100 nm). À titre de référence, des diodes Schottky Pt/n-GaN (c'est-à-dire sans couche d'AlN) ont également été fabriquées.
Caractérisation
Courant-tension dépendant de la température (I –V –T ) les mesures ont été effectuées avec un analyseur de paramètres à semi-conducteurs HP 4155B après avoir placé des échantillons sur un mandrin chaud connecté à un contrôleur de température, et capacité-tension (C –V ) les mesures ont été effectuées à l'aide d'un appareil de mesure LCR HP 4284A. Les mesures de spectroscopie photoélectronique aux rayons X (XPS) ont été effectuées à l'aide d'un Al Κα monochromatique Source de rayons X pour observer le mécanisme de formation à l'interface AlN/GaN.
Résultats et discussion
La figure 1a–c montre les images en coupe transversale de microscopie électronique à transmission à balayage (STEM) autour de la couche d'AlN. Les épaisseurs estimées des couches d'AlN étaient similaires aux valeurs de l'ellipsomètre. La densité-tension de courant semilogarithmique typique (J –V ) sont représentées sur la figure 2a. Par rapport à l'échantillon sans AIN (c'est-à-dire l'échantillon de référence), les valeurs actuelles ont augmenté pour l'échantillon avec un AIN de 0,7 nm d'épaisseur et ont diminué pour les échantillons avec de l'AIN de 1,5 et 7,4 nm. En utilisant le modèle d'émission thermoionique (TE) [24], le transport de courant de polarisation directe d'une diode Schottky a été analysé pour obtenir à la fois la hauteur de barrière et le facteur d'idéalité. Les hauteurs de barrière calculées étaient de 0,77 (± 0,03), 0,61 (± 0,01), 0,83 (± 0,05) et 1,00 (± 0,08) eV pour les échantillons avec 0-, 0,7-, 1,5- et 7,4-nm- AIN épais, respectivement. Les facteurs d'idéalité se sont avérés être 1,63 (± 0,18), 4,19 (± 0,16), 1,83 (± 0,33) et 1,57 (± 0,03) pour les échantillons de 0, 0,7, 1,5 et 7,4 nm d'épaisseur. AIN, respectivement. Avec un AIN de 0,7 nm d'épaisseur, la hauteur de la barrière a diminué et le facteur d'idéalité a augmenté. Avec des couches d'AlN plus épaisses, le facteur d'idéalité était similaire mais la hauteur de la barrière a augmenté par rapport à l'échantillon de référence. On voit sur la figure 2c qu'avec l'augmentation de l'épaisseur d'AIN, la hauteur de la barrière diminue d'abord puis augmente en raison de la résistance tunnel induite par une couche épaisse d'AlN. Cela indique qu'environ 0,7 nm est un tournant pour la hauteur de la barrière en termes d'épaisseur d'AlN.
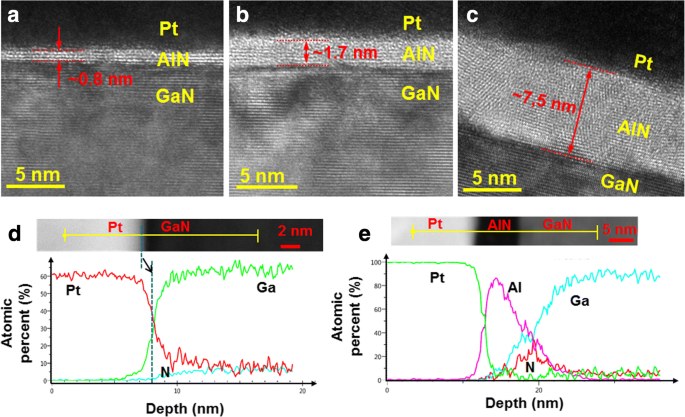
Images de microscopie électronique à transmission à balayage (STEM) en coupe transversale avec a 0,7-, b 1.5-, et c AlN de 7,4 nm d'épaisseur. d , e Pourcentage atomique par rapport aux profils de profondeur obtenus à partir de balayages linéaires de spectroscopie à rayons X à dispersion d'énergie (EDS) pour les échantillons avec respectivement 0 et 7,4 nm d'épaisseur d'AlN

un Courant-tension semilogarithmique typique (I –V ) caractéristiques. b Graphiques de la hauteur de la barrière en fonction du facteur d'idéalité. c Hauteurs de barrière et facteurs d'idéalité en fonction de l'épaisseur d'AlN
La figure 3 montre le C –V courbes mesurées à différentes fréquences. Lorsque les épaisseurs d'AlN sont de 0 et 0,7 nm, l'inversion des valeurs de capacité a été observée en dessous de 10 kHz. Au lieu de l'inversion, un épuisement profond est normalement observé pour les matériaux à large bande interdite comme le GaN en raison du faible taux de génération de porteurs minoritaires (trous) [25, 26]. Comme le montrent les figures 3c, d, une telle inversion n'a pas été observée pour les couches d'AlN plus épaisses. Ici, il est à noter qu'à la jonction Au/GaN, aucune inversion n'a été observée aux basses fréquences. En utilisant la spectroscopie transitoire de niveau profond (DLTS), Auret et al. ont observé des défauts induits par les faisceaux électroniques dans les jonctions Schottky Pt/n-GaN [27]. Ici, nous avons effectué des mesures de spectroscopie à rayons X à dispersion d'énergie (EDS) et les profils de profondeur pour les échantillons avec 0 et 7,4 nm d'épaisseur d'AlN sont présentés sur les figures 1d, e, respectivement. On voit clairement sur la figure 1d que les atomes de Pt ont diffusé dans la couche de GaN, alors que la diffusion d'atomes de Pt dans la couche de GaN a été supprimée efficacement à cause de la couche d'AlN. Par conséquent, il serait possible de suggérer que les défauts induits par le dépôt de Pt près de la surface de GaN produisaient la capacité d'inversion aux basses fréquences et que la formation de ces défauts était supprimée avec une couche d'AlN relativement épaisse (> 1,5 nm).
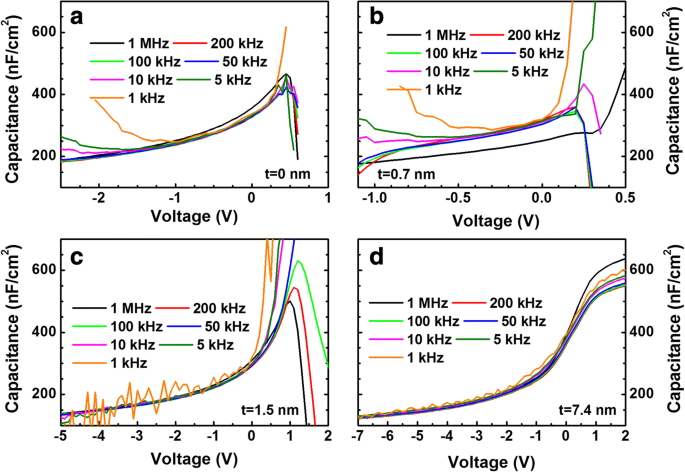
Capacité–tension (C –V ) données mesurées à différentes fréquences pour les échantillons avec a 0-, b 0.7-, c 1.5-, et d AlN de 7,4 nm d'épaisseur
À l'exception de l'échantillon avec un AIN de 7,4 d'épaisseur, tous les autres échantillons ont montré le pic anormal dans le C –V courbe avec l'augmentation de la tension de polarisation, qui étaient associées à la distribution des pièges profonds dans l'espace, la résistance série et les états d'interface [28, 29]. La dispersion de fréquence dans la région d'accumulation est associée à la formation d'une couche inhomogène à l'interface. La capacité d'une telle couche agit en série avec la capacité d'oxyde provoquant la dispersion dans l'accumulation [30]. La dispersion de l'épuisement est due à la présence d'états d'interface répondant à la fréquence appliquée. Si les constantes de temps des états d'interface sont comparables à la fréquence du petit signal, les états d'interface apportent une contribution à la capacité totale de telle sorte que la capacité seuil augmente avec la diminution de la fréquence [31].
La figure 4 montre la conductance-tension (G /ω –V ) courbes mesurées à différentes fréquences. Sous des polarisations directes et inverses suffisamment élevées, les défauts activés pourraient communiquer plus efficacement avec les états d'interface voisins aux basses fréquences et donc augmenter la conductance. Approximativement dans la gamme de - 1 et 0 V, tous les échantillons ont montré l'augmentation de la conductance avec l'augmentation de la fréquence. Ce comportement est devenu plus important pour l'échantillon avec un AIN de 7,4 nm d'épaisseur. L'augmentation de la conductance avec l'augmentation de la fréquence était associée aux centres de recombinaison favorisant le courant de recombinaison dans la région d'appauvrissement et aux états d'interface fournissant un courant de charge et de décharge ou un processus de conduction par saut se produisant à haute fréquence [32]. Les résultats indiquent donc que des états d'interface avec diverses constantes de temps sont présents pour tous les échantillons, et la présence de tels défauts est la plus significative pour l'échantillon avec un AlN de 7,4 nm d'épaisseur.
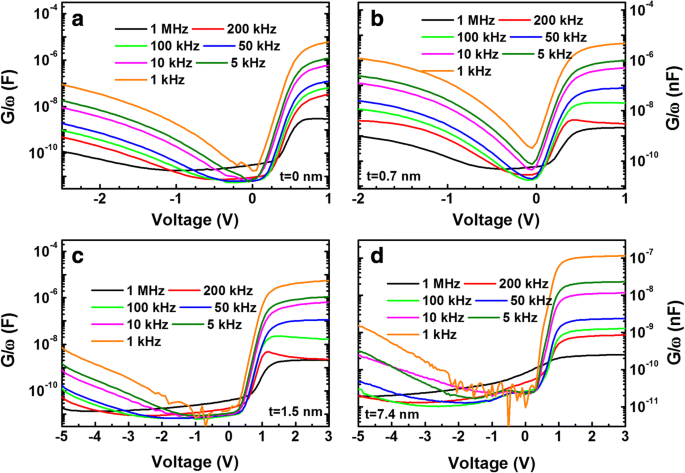
Conductance–tension (G /ω –V ) données mesurées à différentes fréquences pour les échantillons avec a 0-, b 0.7-, c 1.5-, et d AlN de 7,4 nm d'épaisseur
Comme le montre la figure 5a, une estimation de la densité d'état de l'interface (D il ) a été faite en appliquant la méthode de Terman au C–V expérimental courbes mesurées à 1 MHz [33]. Le D obtenu il contre E C –E t (emplacement de l'état de l'interface) est présenté sur la figure 5b. Ici, nous n'avons pas analysé le C–V courbe de l'échantillon avec un AIN de 0,7 nm d'épaisseur car l'échantillon présentait des fuites et la capacité exacte de l'oxyde (C OX ) n'était pas bien défini. L'échantillon avec un AlN de 7,4 nm d'épaisseur a montré la densité d'état d'interface la plus élevée, en particulier pour E C –E t> 0,4 eV. De plus, l'interface moyenne et la densité de piège à oxyde (Q T ) le long de la bande interdite GaN (E g ) ont été calculés en analysant C –V tracés d'hystérésis, en utilisant le décalage de tension de bande plate (ΔV FB ) par l'équation Q T = (C OX ΔV FB )/qE g [34]. Le petit décalage de tension de bande plate et la petite fenêtre d'hystérésis indiquent une faible densité de piège. L'encart de la figure 4b montre C –V tracés d'hystérésis. Les densités de charge piégées ont été calculées pour être 4,2 × 10 9 , 9,3 × 10 9 , et 3,6 × 10 11 cm −2 eV −1 pour les échantillons avec respectivement 0, 1,5 et 7,4 nm d'AlN. L'hystérésis peut provenir des pièges d'interface d'AlN/GaN et des pièges de bordure (ou vrac) dans la couche d'AlN. Comme la méthode Terman, une couche d'AlN de 7,4 nm d'épaisseur a révélé l'interface et la densité de piège d'oxyde la plus élevée. Par conséquent, il est possible de suggérer dans cet échantillon que les pièges de frontière dans la couche AlN ainsi que les pièges d'interface ont contribué de manière significative au changement de C –V parcelles.
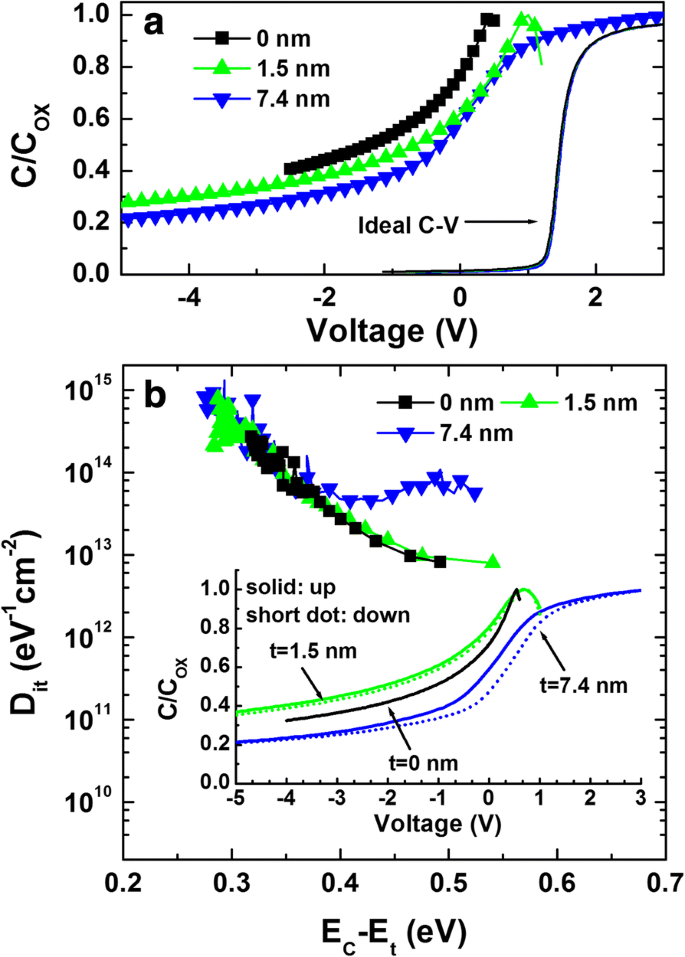
un Comparaison expérimentale capacité-tension (C –V ) données mesurées à 1 MHz et idéal C–V données et b densité d'état de l'interface (D il ) distributions déterminées en appliquant la méthode de Terman pour les échantillons avec une couche d'AlN de 0, 1,5 et 7,4 nm d'épaisseur. L'encart dans b montre le C –V tracés d'hystérésis mesurés à 1 MHz
La composition chimique à l'interface AlN/GaN a été étudiée en utilisant des mesures XPS pour deux échantillons avec de l'AlN de 0,7 et 7,4 nm d'épaisseur. Ici, un traitement de gravure par pulvérisation a été effectué sur l'échantillon avec un AIN de 7,4 nm d'épaisseur car l'épaisseur d'AIN était trop épaisse pour obtenir les informations exactes à proximité de l'interface AIN/InP. Bare GaN a également été scanné en surface comme référence. La figure 6a montre les profils de profondeur XPS pour chaque élément obtenu à partir de l'échantillon avec un AIN de 7,4 nm d'épaisseur. La diffusion des atomes de Ga dans la couche d'AlN a été clairement observée. Une quantité assez importante d'atomes d'oxygène a été trouvée à travers la couche d'AlN. Cependant, les atomes d'O et d'Al n'ont pas été bien observés près de l'interface AlN/GaN. La quantité plus élevée d'oxygène près de la surface d'AlN, par rapport à l'interface AlN/GaN, indique qu'une partie importante de celui-ci résulte de l'oxydation atmosphérique, et non du processus de dépôt d'ALD lui-même. Nous avons ensuite sélectionné les spectres XPS scannés étroits à une profondeur de gravure (l'épaisseur de l'AlN restant était d'environ 1,5 à 2,0 nm) et les avons comparés aux données d'autres échantillons. La figure 6b montre le Ga 2p 3/2 spectres au niveau du noyau. Les pics à ~ 1118,0 eV et ~ 1119,2 eV pour le GaN nu et l'échantillon avec un AlN de 0,7 nm d'épaisseur sont associés à GaN et Ga2 O3 , respectivement [35, 36]. Le pic à ~ 1117,4 eV pour l'échantillon avec un AIN de 7,4 nm d'épaisseur est dû au Ga lié à l'AlN [37]. Cependant, nous ne pouvons pas exclure la possibilité qu'il puisse provenir de Ga2 O pic (~ 1117,3 eV) [38].

un Profils de profondeur XPS pour chaque élément obtenu à partir de l'échantillon avec un AIN de 7,4 nm d'épaisseur. Spectres de base XPS de b Ga 3p 3/2, c O 1s , et d Al 2p pour les échantillons avec 0, 1,5 et 7,4 nm d'AlN
Comme le montre la figure 6c, les pics à ~ 530,2 et ~ 531,9 eV sont attribués à O et Ga2 chimisorbés O3 , respectivement [39]. De plus, le pic à ~ 532,8 eV est associé à Al–OH [40]. Cependant, aucun pic particulier n'a été observé pour l'échantillon avec un AIN de 7,4 nm d'épaisseur à la profondeur sélectionnée. De même, aucun pic n'a été observé aux profondeurs de gravure plus profondes (non représentées). Lorsque l'épaisseur d'AlN est mince (0,7 nm), les atomes d'oxygène chimisorbés ont été éliminés mais les atomes d'Al se sont liés avec OH. Avec l'augmentation de l'épaisseur d'AlN, très peu d'atomes d'oxygène étaient présents près de la région de surface de GaN, indiquant l'effet de nettoyage. Cependant, une grande quantité d'atomes d'oxygène était présente dans la région envahie par l'AlN, à cause des charges d'oxyde. O 1s les spectres au niveau du cœur aux profondeurs de gravure où la quantité d'atomes de Ga est négligeable (environ 0 ~ 3 nm de la surface d'AlN sur la figure 6a) présentaient le pic dominant à ~ 531,8 eV, associé à Al2 O3 [41]. Cela signifie qu'une partie de la couche d'AlN est composée d'Al2 O3 . Comme le montre la figure 6d, le pic lié à l'AIN n'est pas bien observé pour l'échantillon avec un AIN de 0,7 nm d'épaisseur. Au contraire, deux pics sont observés à ~ 74,1 et ~ 75,6 eV, associés à AlOx et Al-OH, respectivement [42]. Ces pics liés à la liaison Al-O tels que AlOx et Al-OH peut agir comme des défauts. Le pic à ~ 73,6 eV pour l'échantillon avec un AlN de 7,4 nm d'épaisseur est associé à l'AlN [43].
Les propriétés de transport du courant pour les échantillons avec de l'AlN de 0,7 et 7,4 nm d'épaisseur ont été étudiées plus en détail à l'aide d'un courant-tension dépendant de la température (I –V –T ) des mesures. Comme le montre la figure 7, le courant de polarisation directe et inverse a augmenté à un degré similaire pour l'échantillon avec une épaisseur de 0,7 nm. Pour l'échantillon avec un AIN de 7,4 nm d'épaisseur, cependant, les courants de fuite inverse étaient plus dépendants de la température que les courants directs. Sous polarisation inverse, une température plus élevée pourrait provoquer une émission thermique des trous des niveaux profonds dans la bande de valence AlN et, ainsi, introduire une autre alimentation en électrons [44]. Selon le modèle de barrière inhomogène [24], la hauteur de barrière effective dépendant de la température (φ B ) est lié à une hauteur de barrière moyenne à biais nul (\( {\overline{\varphi}}_B \)) et à un écart type (σ 0 ) comme \( {\varphi}_B={\overline{\varphi}}_B-q{\sigma_0}^2/2 kT \). Le σ 0 les valeurs ont été obtenues à 0,147 et 0,204 V pour les échantillons avec 0,7 et 7,4 nm d'épaisseur d'AlN, respectivement. En utilisant ces valeurs, les tracés de Richardson modifiés de ln(I 0 /T 2 ) − q 2 σ 0 2 /2k 2 T 2 contre 1/kT ont été obtenus, illustrés à la Fig. 8a. Les interceptions en ordonnée ont produit les constantes de Richardson de A ** comme 397,3 et 27,1 A cm −2 K −2 pour les échantillons avec respectivement 0,7 et 7,4 nm d'AlN. La valeur pour l'échantillon avec un AlN de 7,4 nm d'épaisseur est similaire à la valeur théorique de 26,4 A cm −2 K −2 pour n-GaN, indiquant que l'inhomogénéité de la barrière avec le modèle TE peut expliquer le transport actuel. Cependant, pour l'échantillon avec un AIN de 0,7 nm d'épaisseur, la valeur est trop élevée par rapport à la valeur théorique, indiquant que le modèle TE incluant même l'inhomogénéité de la barrière ne peut pas expliquer le transport actuel. La figure 8b montre les valeurs de nkT en fonction de kT . La ligne droite avec des pentes de 1,15 correspond bien aux données expérimentales de l'échantillon avec un AlN de 7,4 nm d'épaisseur utilisant le modèle TE. Pour l'échantillon avec un AIN de 0,7 nm d'épaisseur, cependant, la pente s'est avérée être de 5,11. Un écart aussi important par rapport à l'unité pourrait provenir des états de l'interface, de la couche isolante et du courant tunnel.
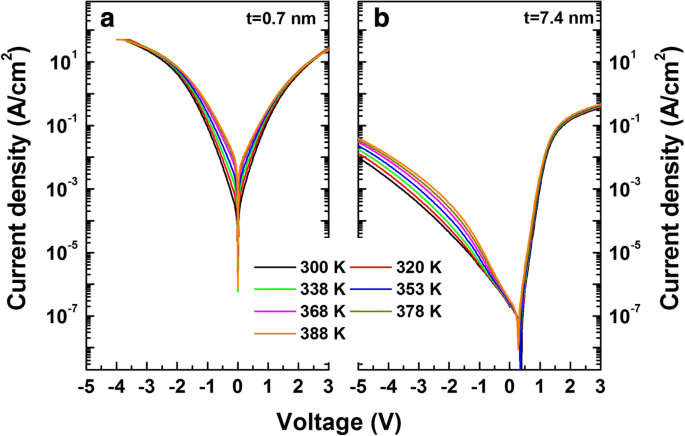
Densité de courant-tension dépendant de la température (J –V ) caractéristiques pour les échantillons avec a 0.7- et b AlN de 7,4 nm d'épaisseur
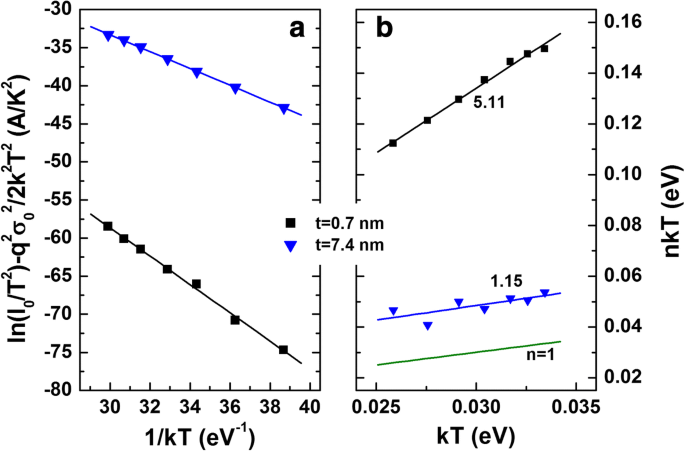
un Tracés de Richardson modifiés et b nkT contre kT graphiques avec les ajustements linéaires aux données expérimentales. En b , la droite avec une pente de 1 (n = 1) a également été inclus comme référence
La densité de courant de fuite inverse a été analysée à l'aide du modèle d'effet tunnel de Fowler-Nordheim (FN), donné par [45].
$$ J=\alpha {E}^2\exp \left(-\beta /E\right) $$ (1)où α = 1,54 × 10 −6 /m ∗ ΦB et β = 6.83 × 10 −7 (m ∗ ) 1/2 (ΦB ) 3/2 ; m * (m * = 0,30 pour AlN [46]) est la masse électronique effective dans l'isolant et ΦB est la hauteur de la barrière tunnel. La figure 9a, b montre que l'émission de FN a été observée pour les échantillons avec 0,7 et 7,4 nm d'AlN, lorsque les tensions de polarisation sont supérieures à - 0,9 V et - 3 V, respectivement. Une tension plus élevée pour l'échantillon avec un AIN de 7,4 nm d'épaisseur est due au fait qu'un AIN plus épais nécessite une tension tunnel plus élevée. A partir de la pente montrée sur la figure 9, les hauteurs de barrière tunnel ont été déterminées pour chaque température, qui sont présentées dans l'encart sur la figure 9b. À température ambiante, les hauteurs de barrière pour les échantillons d'AlN de 0,7 et 7,4 nm d'épaisseur ont été calculées à environ 1,67 et 0,78 eV, respectivement. Ces valeurs sont inférieures au décalage de bande de conduction rapporté de 2,58 eV à l'interface AlN/GaN [47]. La mauvaise qualité interfaciale près de l'interface AlN/GaN pourrait produire de telles valeurs inférieures. La hauteur de barrière inférieure pour l'échantillon avec un AIN de 7,4 nm d'épaisseur peut également être associée à l'interface élevée et à la densité de piège à oxyde près de l'interface AIN/GaN et aux défauts liés à l'oxygène dans la couche d'AIN. En conséquence, le tunnelage assisté par piège s'est produit plus facilement et a augmenté le courant de fuite inverse.
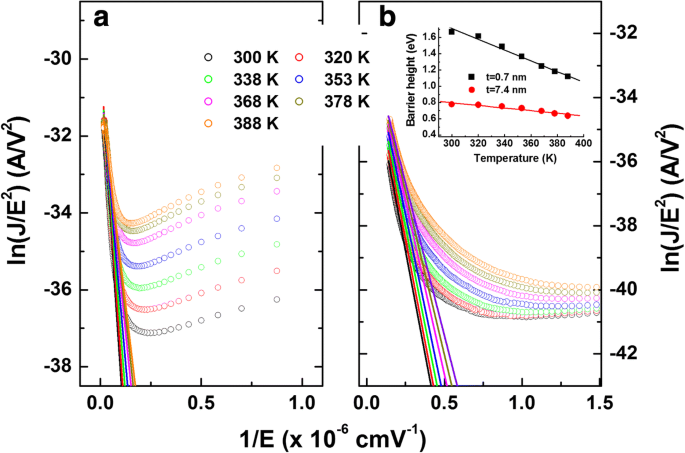
Parcelles de tunnels Fowler–Nordheim (FN) de ln(J /E 2 ) contre 1/E avec les ajustements linéaires aux données expérimentales pour les échantillons avec a 0.7- et b AlN de 7,4 nm d'épaisseur. L'encart dans b présente les hauteurs de barrière calculées en fonction de la température
Le modèle d'émission de Poole-Frenkel (PF) a également été appliqué au courant de fuite inverse, donné par [48].
$$ \ln \gauche(J/E\droite)=m(T){E}^{1/2}+b(T)\Grand) $$ (2)avec
$$ m(T)=\frac{q}{kT}\sqrt{\frac{q}{{\pi \varepsilon}_0{\varepsilon}_{\mathrm{AlN}}}},b(T) =-\frac{q{\varphi}_t}{kT}+\ln C $$ (3)où ϕ t est la hauteur de la barrière d'émission d'électrons à partir des états du piège, ε AlN est la permittivité diélectrique relative de l'isolant de grille à haute fréquence (ε AlN 4,77 [49]), ε 0 est la permittivité de l'espace libre, et C est une constante. La validité de l'ajustement d'émission PF a été vérifiée en vérifiant la dépendance à la température du coefficient linéaire m (T ) obtenu à partir de l'ajustement linéaire des tracés PF ln(J /E ) en fonction de E 1/2 [50], qui est illustré à la Fig. 10. À partir du m (T ) valeurs obtenues à partir de l'ajustement linéaire à ces tracés (encadré dans la Fig. 10a), ε AlN s'est avéré être de 64,9 et 959,0 pour les échantillons avec respectivement 0,7 et 7,4 nm d'AlN. Les valeurs obtenues sont trop élevées par rapport à la valeur théorique de 4,77, ce qui montre que l'émission de PF ne peut pas expliquer correctement le transport actuel pour les deux échantillons. Par conséquent, le tunneling FN est un mécanisme de transport plus approprié dans le courant de fuite inverse.
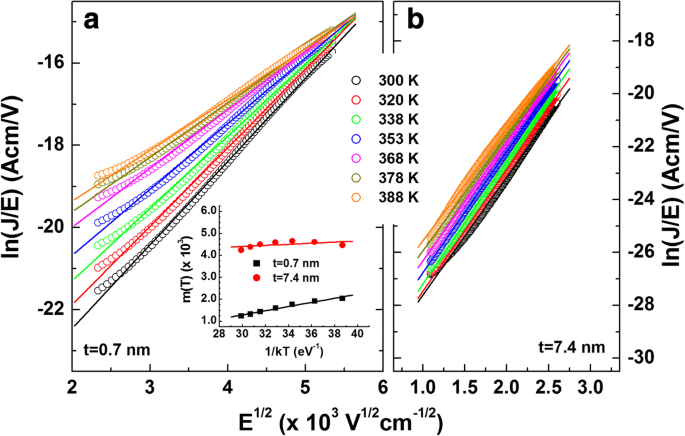
Diagrammes d'émission de Poole-Frenkel (PF) de ln(J /E ) contre E 1/2/ avec l'ajustement linéaire aux données expérimentales pour l'échantillon avec a 0.7- et b AlN de 7,4 nm d'épaisseur. L'encart dans a présente le m calculé (T ) valeurs vs température
Même si l'Éq. (1) ne contient aucune dépendance à la température, les hauteurs de barrière obtenues diminuent avec l'augmentation de la température. Les pentes ont été obtenues comme - 6,67 meV/K et - 1,62 meV/K pour les échantillons avec 0,7 et 7,4 nm d'épaisseur, respectivement. Il a été rapporté dans la structure SiO2/4H-SiC que l'effet tunnel FN possède une dépendance en température avec une pente de − 7,6 meV/K [51]. Les électrons éjectés de l'électrode de Pt suivaient la distribution de Fermi-Dirac [52], et ainsi, le courant de fuite inverse par l'effet tunnel pourrait également augmenter avec la température. Dans ce cas, l'augmentation avec la température serait plus importante pour une couche d'AlN plus mince.
Pendant ce temps, il a été rapporté que les mécanismes de transport du courant à champ électrique élevé ne peuvent pas être expliqués uniquement par l'effet tunnel FN [53, 54]. Même en incluant les changements dans les charges dans l'oxyde et le niveau de Fermi du substrat, et la distribution d'énergie des électrons au SiO2 Interface /SiC avec température, le courant de fuite inverse dans SiO2 Le /4H-SiC n'a pas été expliqué de manière satisfaisante [53]. Il a été proposé que l'émission PF activée thermiquement d'électrons piégés à partir des pièges à électrons interfaciaux contribue de manière significative à l'augmentation du courant de fuite [54]. Par conséquent, la réduction de tels défauts dans l'AlN pendant le processus ALD est cruciale pour les performances du dispositif basé sur AlN/GaN, en particulier pendant le fonctionnement à haute température.
Comme le montre le graphique de la hauteur de la barrière en fonction de l'épaisseur de l'AIN sur la figure 2c, Li et al. observé un comportement similaire dans les contacts métal/n-Ge avec Y2 O3 couches [55]. Ils ont attribué la réduction de la hauteur de la barrière à la suppression du GeO instablex la croissance et la passivation des liaisons pendantes à la surface du Ge. Karpov et al. inséré Si3 N4 couche en contacts Ni/n-GaN et a constaté que la hauteur de la barrière diminuait de 0,78 à 0,27-0,30 eV avec un Si3 N4 couche. Les résultats ont été expliqués par la formation de dipôles au Si3 N4 /Interface GaN [56]. De plus, Zheng et al. a étudié la résistance de contact par rapport à Al2 O3 épaisseur dans la structure Al/n-SiC et a trouvé que le dipôle d'interface a commencé à se former à l'épaisseur de 1,98 nm [57]. Au-dessus de cette épaisseur, la résistance de contact a diminué d'abord en raison de l'effet dipôle, puis a augmenté en raison de l'augmentation de la résistance à l'effet tunnel. Selon les données XPS de la figure 6, la formation d'une couche d'AIN n'est pas claire pour l'échantillon avec un AIN de 0,7 nm d'épaisseur. Par conséquent, la réduction de la hauteur de la barrière avec un AIN de 0,7 nm d'épaisseur est plus probablement due à l'effet de passivation qu'à la formation d'un dipôle d'interface.
Le processus de gravure sèche tel que la gravure par plasma à couplage inductif (ICP) est largement utilisé dans les dispositifs à base de GaN en raison de la stabilité chimique du GaN [58], même si une gravure chimique humide renforcée par les ultraviolets a été démontrée [59]. Cependant, le processus de gravure à sec peut induire des dommages sur la surface du GaN, augmentant le courant de fuite et dégradant le comportement de redressement. Un traitement post-gravure utilisant un recuit thermique et une solution de KOH après une gravure ionique réactive (RIE) s'est avéré efficace pour éliminer les dommages de surface sur GaN [60]. Compte tenu des résultats obtenus jusqu'à présent, nous suggérons qu'un dépôt d'AlN (supérieur à 1 nm) peut être appliqué pour réduire les dommages sur la surface de GaN gravée, ce qui devrait augmenter davantage la qualité de l'interface et les caractéristiques de rectification.
Conclusions
Nous avons étudié les propriétés interfaciales et électriques d'une couche atomique déposée d'AlN sur du n-GaN avec différentes épaisseurs d'AlN. Selon capacité-tension (C –V ), l'échantillon avec un AIN de 7,4 nm d'épaisseur présentait l'interface et la densité de piège à oxyde les plus élevées. Selon les mesures de spectroscopie photoélectronique aux rayons X (XPS), l'échantillon avec un AlN de 0,7 nm d'épaisseur a révélé un pic dominant lié aux liaisons Al-O, sans pic clair associé à AlN. Les atomes d'oxygène restants près de la surface de GaN se sont avérés très faibles pour l'échantillon avec un AIN de 7,4 nm d'épaisseur. D'autre part, de nombreux atomes d'oxygène se sont avérés présents à travers la couche d'AlN, ce qui a fourni les défauts liés à l'oxygène dans la couche d'AlN. Les analyses sur le courant de fuite inverse ont révélé que les émissions de Fowler-Nordheim (FN) plutôt que de Poole-Frenkel (PF) étaient plus appropriées pour expliquer le transport de courant pour les échantillons avec 0,7 et 7,4 nm d'AlN.
Abréviations
- ALD :
-
Dépôt de couche atomique
- AlN :
-
Nitrure d'aluminium
- C –V :
-
Capacité–tension
- FN :
-
Fowler-Nordheim
- J –V :
-
Densité de courant–tension
- PF :
-
Poole-Frenkel
- TE :
-
Émission thermoionique
- XPS :
-
Spectroscopie photoélectronique aux rayons X
Nanomatériaux
- Technologies avancées de dépôt de couche atomique pour les micro-LED et les VCSEL
- Caractéristiques d'alignement interfacial, électrique et de bande des piles HfO2/Ge avec une couche intermédiaire de SiO2 formée in situ par dépôt de couche atomique amélioré par plasma
- Caractéristiques optiques et électriques des nanofils de silicium préparés par gravure autocatalytique
- Les nanofibres hiérarchiques antibactériennes en polyamide 6-ZnO fabriquées par dépôt de couche atomique et croissance hydrothermale
- Étude sur la polarisation de surface de l'hétérostructure GaN/AlGaN/GaN coiffée d'Al2O3 par spectroscopie photoélectronique à rayons X à résolution angulaire
- Propriétés photocatalytiques des poudres de TiO2 revêtues de Co3O4 préparées par dépôt de couche atomique amélioré par plasma
- Effets de l'épaisseur de la bicouche sur les propriétés morphologiques, optiques et électriques des nanolaminés Al2O3/ZnO
- Réglage des morphologies de surface et des propriétés des films de ZnO par la conception de la couche interfaciale
- Réglage au niveau de Fermi des films ZnO par dépôt de couche atomique supercyclée



