Charge Splitting In Situ Recorder (CSIR) pour l'examen en temps réel de l'effet de charge du plasma dans les processus FinFET BEOL
Résumé
Un nouveau dispositif pour surveiller les dommages induits par le plasma dans le processus de fin de ligne (BEOL) avec une capacité de division de charge est proposé et démontré pour la première fois. Ce nouvel enregistreur in situ à division de charge (CSIR) peut tracer indépendamment la quantité et la polarité des effets de charge du plasma pendant le processus de fabrication des circuits de transistors à effet de champ à ailettes (FinFET) avancés. Non seulement il révèle les niveaux de charge plasma en temps réel et in situ sur les antennes, mais il sépare également l'effet de charge positif et négatif et fournit deux lectures indépendantes. Alors que les technologies CMOS poussent vers des lignes métalliques plus fines à l'avenir, le nouveau schéma de séparation de charge fournit un outil puissant pour l'optimisation du processus BEOL et d'autres améliorations de la fiabilité des appareils.
Contexte
Les procédés améliorés par plasma sont largement utilisés dans la formation de circuits à transistors à effet de champ à ailettes (FinFET), composés de nombreuses structures à rapport d'aspect élevé et de fines lignes métalliques [1]. Lors de la fabrication, l'étape de gravure et de dépôt pour la réalisation de ces compositions 3D peut conduire à des contraintes induites par plasma importantes sur les dispositifs FinFET [2,3,4]. Au fur et à mesure que la technologie CMOS FinFET progresse, la largeur et le pas de la ligne métallique se réduisent plus agressivement que sa hauteur, ce qui rend nécessaire la formation de tranchées à rapport d'aspect élevé définies par des lignes extrêmement fines. Inévitablement, cela favorise la gravité des dommages induits par le plasma (PID) sur les transistors, et son effet correspondant sur la fiabilité des circuits devient l'une des principales préoccupations dans le développement des technologies FinFET [5,6,7]. Lors de la formation de petits contacts, de vias et de fines lignes métalliques, un plasma à forte puissance et à haute sélectivité est généralement appliqué [8]. De plus, lors de la gravure de l'ailette massive, la pulvérisation cathodique d'ions réactifs sur la surface de l'ailette peut conduire à des défauts dans l'ailette massive, critiques pour les caractéristiques des transistors [9]. Afin de permettre la grille métallique à ailettes et les structures d'interconnexion denses, des empilements métalliques complexes sont plus souvent utilisés dans les technologies FinFET avancées [10, 11]. De plus, un haut-k Le diélectrique de grille utilisé dans la technologie de pointe conduit généralement à un meilleur piégeage induit par la contrainte après le processus plasma [12,13,14]. Pendant le chargement du plasma, le chemin de décharge à travers des ailettes étroites et vers le substrat peut entraîner des niveaux de contrainte plus non uniformes sur l'ensemble d'une plaquette [15]. La contrainte induite par le plasma sur l'oxyde de grille du transistor est connue pour entraîner une dégradation supplémentaire de l'intégrité diélectrique de la grille [16, 17].
Les dommages induits par le plasma sur le film diélectrique de grille peuvent entraîner une dégradation des performances dans des scénarios de charge très non uniformes, voire une perte de rendement [18,19,20], en raison de défaillances de fiabilité [21,22]. Ainsi, dans les technologies FinFET avancées, des dispositifs de test avec des structures d'antenne élargies sont généralement utilisés pour surveiller les effets PID, qui fournissent des retours pour une optimisation ultérieure du processus.
La mesure de PID la plus courante et la plus largement utilisée est la caractéristique de temps de claquage des échantillons d'essai avec de grandes structures d'antenne. Les dommages latents sur ces modèles PID sont généralement reflétés en mesurant la dégradation en fonction du temps des couches diélectriques de grille, par conséquent, ne donnant pas le retour en temps réel des processus plasma [23]. De plus, les appareils de test conventionnels ne peuvent pas indiquer les sources et la polarité du taux de charge induit par le plasma et/ou l'accumulation de potentiel maximum sur l'antenne. Un enregistreur PID avec une grille flottante couplée par une structure d'antenne a été proposé avec une capacité de détection in situ dans notre étude précédente [24, 25]. Dans ce travail, nous avons proposé un enregistreur PID révisé avec une fonction de répartition des charges. Grâce à une diode directe et une diode inverse connectées à une structure d'antenne commune, la nouvelle conception fournit des chemins séparés pour les charges positives et négatives. Par conséquent, les niveaux de charge des deux polarités peuvent être enregistrés indépendamment. Ce nouvel enregistreur in situ à division de charge (CSIR) ne nécessitant que de petites antennes permet une étude future de l'effet de charge du plasma dans les processus de milieu de gamme (MEOL).
Méthodes
Polarité de charge du plasma
Des études antérieures ont rapporté que, pendant le processus de gravure dans la formation de couches poly- ou métalliques, l'inhomogénéité du plasma ainsi que les variations du potentiel de l'antenne peuvent conduire à une différence drastique dans le taux de charge ou même les polarités peuvent changer à différents endroits [24, 25]. Le macro-environnement dans la chambre à plasma et les micro-motifs peuvent tous deux affecter la distribution des taux de charge sur une plaquette [26]. À savoir, le taux de charge du plasma dans la gravure en fin de ligne (BEOL) varie dans l'espace et dans le temps. Pendant les processus plasma radiofréquence (RF), la surface de la plaquette collecte le courant de charge, J p , qui est composé d'un courant ionique J je et un courant d'électrons J e [26]. Le courant ionique est presque constant dans le temps et est déterminé par la densité ionique J je et la vitesse de Bohm [26]. Puisque le potentiel plasmatique V p (t ) est supérieur au potentiel de grille V G la plupart du temps, le courant électronique ne circule que pendant les courtes périodes où le potentiel plasma est proche de son minimum. Pendant Q FG processus, la tension de grille peut augmenter ou diminuer sur de nombreux cycles RF, selon la composante des courants la plus grande, jusqu'à ce qu'une tension de grille en régime permanent soit atteinte lorsque le courant tunnel s'équilibre J p sur l'antenne. Comme le montre la figure 1, la distribution du taux de charge du plasma, J P (x ,y ,t ), à travers la plaquette pendant le processus de gravure à différents stades, les changements d'amplitude ainsi que de polarités, où il peut être exprimé comme dans l'équation. (1) où J e représente la densité de courant électronique, et J je représente la densité de courant ionique.
$$ {J}_{\mathrm{p}}={J}_{\mathrm{e}}+{J}_{\mathrm{i}}\dots $$ (1)
Distribution du taux de charge induit par le plasma dans la ligne centrale de la plaquette pendant le processus de gravure à différents moments. La polarité de charge du plasma sur un emplacement particulier peut changer avec le temps
Les différentes polarités de charge du plasma entraînent une charge d'antenne positive ou négative, Q P , accumulés à un moment et à un endroit différents. Pour clarifier, à l'instant t 1 , un J négatif p conduit à une charge d'antenne négative Q -. À t 2 , un J positif p induit une charge d'antenne positive Q+ sur le même emplacement sur la plaquette, comme illustré sur la figure 1. Ainsi, des charges positives ou négatives peuvent s'accumuler sur une même antenne à des moments différents au cours du processus de gravure. D'après les rapports précédents [27], les niveaux de crête de J e et J je sont autour de − 0.15 et 0.35 mA/cm 2 , respectivement. Il a été trouvé [28, 29] que les contraintes de grille CC et CA/bidirectionnelle sur le FinFET à canal n et à canal p entraînent différents dommages latents au film diélectrique de la grille. Des contraintes de haute tension avec une polarisation CC positive ou négative et une tension CA avec une fréquence de commutation de 0,1 Hz sont appliquées respectivement aux échantillons de test FinFET conventionnels. Comme le montre la figure 2, le temps de panne (T BD ) d'un transistor sollicité par des contraintes positives, négatives et de grille dans les deux sens sont comparés. Les résultats indiquent que la contrainte de grille CC causera des dommages plus importants sur les échantillons, tandis que la contrainte de grille CA entraînera des dommages moins graves à ces transistors, comme le suggère le T plus long. BD pour les échantillons soumis à une contrainte bidirectionnelle. La figure 2 montre également que la dégradation de l'oxyde dépend non seulement de la polarité de charge, mais aussi du type de puits sous les transistors à canal n et à canal p, ce qui devrait être causé par la différence dans les chemins de décharge de ces tests. appareils pendant le processus. Par conséquent, le détecteur PID conventionnel, qui utilise T BD car l'indicateur de la gravité des dommages ne peut pas refléter le niveau de charge du plasma pendant le processus. D'autre part, l'enregistreur de charge plasma proposé dans nos travaux précédents enregistre le niveau de contrainte en injectant ou en éjectant des électrons vers/depuis une grille flottante (FG) couplée par une antenne collectrice de charges. Les données enregistrées, charge de grille flottante (Q FG ), est lu ultérieurement après fabrication [24, 25]. L'enregistrement est alors mesuré par décalage de tension de seuil sur le transistor de lecture, dont le canal est commandé et dirigé par la même grille flottante. Le potentiel élevé sur l'antenne avec Q P de la charge plasma peut induire à la fois une tension d'antenne positive et négative lors de la formation d'une seule couche métallique. En outre, pour différentes couches métalliques, différents paramètres de fabrication sont utilisés. Par exemple, le temps de gravure, le produit chimique utilisé et les températures de la chambre peuvent varier. Ces paramètres peuvent affecter la distribution de charge d'antenne à travers une plaquette pendant la gravure. Dans d'autres cas, un transistor avec des connexions à plusieurs couches métalliques soumis à des séquences de charge plasma encore plus complexes, comme illustré Fig. 3a.
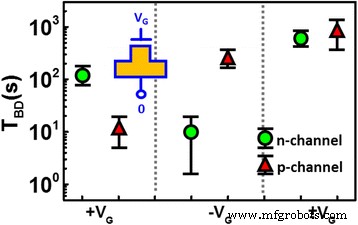
Temps de panne (T BD ) des FinFET à canal n et à canal p soumis à une charge positive, négative et positive + négative sur les électrodes de grille. T BD de dispositifs sous différentes contraintes de polarité suggère que les dommages accumulés sur le diélectrique de grille dépendent non seulement de la polarité de charge, mais aussi des puits sous les FinFET correspondants
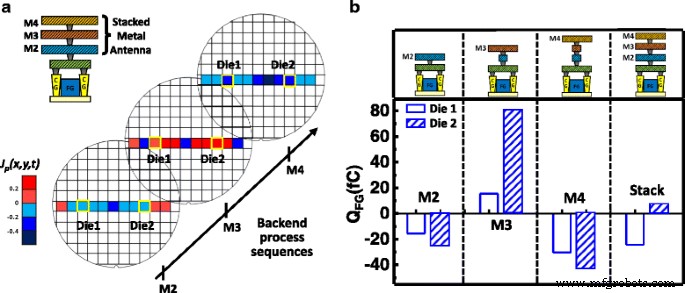
un L'effet de charge du plasma pour les différentes couches métalliques varie à différents endroits sur la tranche. b Les charges positives et négatives peuvent se compenser dans les couches métalliques empilées
À différentes étapes du processus BEOL, le courant de charge du plasma à une antenne particulière peut basculer entre le courant ionique et électronique, c'est-à-dire le Q net P peut également passer du positif au négatif. Les enregistrements sur des échantillons avec une antenne constituée de métal 2, de métal 3, de métal 4 et de plusieurs couches métalliques sont résumés sur la figure 3b. Les données suggèrent une charge nette d'une seule couche métallique [24] sur un changement de polarité particulier d'une couche à l'autre. De plus, l'effet de moyenne trouvé sur le Q FG des échantillons avec des structures d'antenne de plusieurs couches métalliques est en outre pris en charge par les données mesurées dans la Fig. 3b. Avec un V positif et négatif G sur l'antenne, le Q final FG sera ensuite moyenné par injection et éjection d'électrons dans/depuis le FG qui peuvent se produire séquentiellement. Cet effet de compensation limitera l'enregistreur à révéler les conditions de stress réelles qu'un appareil a subies pendant les processus plasma. Le CSIR révisé est conçu pour résoudre le problème de l'enregistrement individuel des effets de charge positifs et négatifs sans interférence et pour fournir des données plus détaillées sur la situation de charge dans la chambre à plasma.
Modèle de test pour la séparation des charges
Dans cette recherche, la charge d'ions positifs et la charge d'électrons négatifs sur l'antenne peuvent être séparées avec un nouvel enregistreur in situ à division de charge (CSIR) proposé, comme illustré sur la figure 4a. Un CSIR se compose de deux portes flottantes, FG1 et FG2 qui enregistrent séparément les différents types d'effet de charge. La structure d'antenne se connecte aux deux portes de couplage via une diode directe (D1) et une diode inverse (D2), respectivement. Dans la moitié gauche de la structure, les charges positives s'écouleront dans la grille de couplage 1 (CG1 ) à D1. Lorsque CG1 est chargée positivement, la tension est couplée à la grille flottante à travers les fentes de contact des deux côtés. La grille flottante sera chargée négativement lorsque les électrons seront injectés depuis le substrat. La moitié droite de la structure, quant à elle, est le chemin de charge négatif, permettant au courant de circuler de l'antenne dans la porte de couplage 2 (CG2 ) à D2, résultant en un Q positif FG . La figure 4b montre en outre la vue en coupe transversale du CSIR avec des diodes pn sur puce, dirigeant les chemins de charge positifs et négatifs vers les portes de couplage séparées, CG1 et CG2 , qui couplent le potentiel sur l'antenne au FG1 et le FG2 , respectivement.
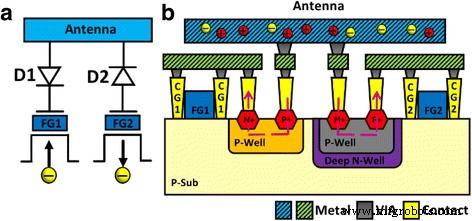
un Enregistreur in situ à division de charge avec deux grilles flottantes séparées en se connectant à une diode directe (D1) et une diode inverse (D2) pour détecter la charge électron/ion, respectivement. b Illustration en coupe du nouvel enregistreur in situ à division de charge avec diodes pn sur puce, dirigeant la charge positive et négative vers les portes de couplage séparées, CG1 et CG2
Lorsque la moitié gauche de l'enregistreur est activée dans le CSIR sous une antenne chargée positivement, la moitié droite est inactive car la charge est bloquée par la diode inverse, et vice versa. Les deux diodes sur puce sont composées de puits n+/p. Pour que D2, pour maintenir une tension négative dans son puits p, la région p doit être entourée d'un puits n profond, bloquant le chemin de charge directement vers le substrat. La distribution de potentiel simulée sur la section transversale dans un CSIR sous des périodes de charge positives et négatives de l'antenne est représentée sur les Fig. 5a et b, respectivement. En supposant que le potentiel d'une antenne atteigne 5 V, à travers la diode de gauche, une charge positive s'écoule vers la grille de contrôle de gauche, ce qui entraîne une tension positive élevée (V CG1 ). Dans le même temps, la charge positive est bloquée par la diode de droite, ce qui donne un V proche de zéro CG2 . La différence de potentiel sur les deux portes de commande est vérifiée par les contours de potentiel simulés de la figure 5a. L'effet de la charge négative sur l'antenne est illustré à la Fig. 5b. Les profils de potentiel simulés vérifient que les diodes pn sur puce peuvent diriger et bloquer efficacement le potentiel vers CG1 et CG2 , à titre gracieux, tel que conçu. De cette façon, les effets de charge positifs et négatifs correspondant à différentes sources dans les traitements plasma peuvent être obtenus indépendamment, évitant ainsi les problèmes de compensation de charge et d'interférence sur le détecteur.

Distribution de potentiel simulée dans CSIR avec tension de grille d'antenne positive et négative. Les diodes pn directe et inverse séparent avec succès la polarité de charge de l'antenne
Résultats et discussion
Le décalage de tension de seuil mesuré (ΔV T ) sur l'appareil contrôlé par FG1 avec diode directe et celle par FG2 avec diode inverse et des échantillons sans diode sont comparés sur la figure 6. Les données le long de la ligne médiane d'une plaquette révèlent qu'un enregistreur avec une seule grille flottante est soumis à une neutralisation de charge même dans le cadre du traitement d'une seule couche métallique. L'effet de moyenne d'un enregistreur sans diode prouve que les taux de charge de pointe ne seront pas reflétés de manière véridique. D'un autre côté, les lectures du nouveau CSIR peuvent fournir des niveaux de charge positifs et négatifs, indépendamment. Pour étudier plus en détail l'effet de charge du plasma dans la formation du métal 2 (M2), la charge collectée sur FG1 et FG2 du CSIR de chaque matrice peut être calculé indépendamment par l'Eq. (2),
$$ {Q}_{\mathrm{FG}}={C}_{\mathrm{T}}\times \Delta {V}_{\mathrm{T}}\times {\alpha}_{\mathrm {RG}}\dots $$ (2)où Q FG est la charge dans la grille flottante. C T est la capacité totale de la grille flottante, comme illustré sur la Fig. 7. ΔV T est le décalage de tension de seuil détecté à la porte de lecture de l'enregistreur, tandis que α RG est le rapport de couplage de la porte de lecture.
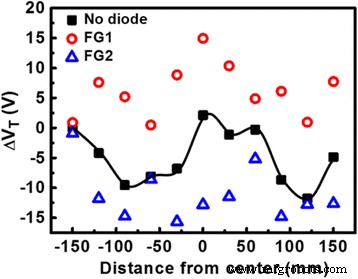
Distribution du delta V T sur FG1 avec diode directe et FG2 avec diode inversée et FG sans diode le long de la ligne médiane d'une plaquette
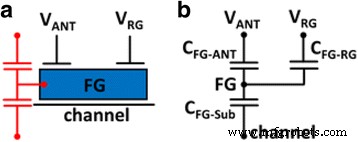
un Le diagramme schématique d'un modèle de réseau de capacité dans un dispositif CSIR. b La capacité totale de la grille flottante correspond à toutes les capacités mentionnées en série plus celle en parallèle
Lorsque la charge de grille flottante est initialement nulle et Q FG atteint le niveau saturé lorsque le champ électrique à travers la couche diélectrique de grille est réduit à zéro, le potentiel de grille d'antenne final à la fin d'un processus plasma peut être exprimé comme suit :
$$ {V}_{\mathrm{ANT}}=\frac{V_{\mathrm{FB}}-\frac{Q_{\mathrm{FG}}}{C_{\mathrm{T}}}}{ \alpha_{\mathrm{ANT}}}\dots $$ (3)dans lequel, V FOURMI est le potentiel de grille d'antenne par charge plasma et α FOURMI représente le rapport de couplage à la grille flottante de la grille d'antenne. V FB est la tension de bande plate de la grille métallique au substrat à ailettes. Sous un temps de traitement donné, la densité de courant de charge plasma moyenne, J p peut alors être projeté par l'équation. (4).
$$ {J}_{\mathrm{p}}=\frac{V_{\mathrm{ANT}}\times {C}_{\mathrm{ANT}}}{A_{\mathrm{ANT}}\times \Delta t}\dots $$ (4)où t est la durée d'un processus plasma [28, 29] et C FOURMI est la capacité totale de l'antenne métallique, tandis que A FOURMI est la zone de charge d'une antenne. Tous les paramètres utilisés dans les calculs ci-dessus sont résumés dans le tableau 1.
La distribution des taux de charge positifs et négatifs sur une plaquette pendant le traitement des couches supérieure (métal 9) et inférieure (métal 2) est comparée plus en détail à la Fig. 8. Cela implique que la charge sur la structure de l'antenne est plus importante à un métal plus élevé. niveaux (métal 9), car sur le métal 9, son énergie plasmatique plus élevée provoque J p être plus grand que J p du métal 2 en termes de grandeur. En outre, les données suggèrent que les taux de charge des électrons et des ions culminent autour du centre dans les deux cas. Comme prévu, les matrices fermées au centre de la plaquette subissent un niveau de charge élevé, ce qui peut être attribué au chemin de décharge plus long pendant le traitement au plasma. Cet effet de localisation s'avère être identique pour les conditions dominantes de charge plus élevée d'électrons et d'ions. Le taux de charge plasma projeté, J P (x,y ), en moyenne sur la formation d'une seule couche métallique, le métal 2 (M2) et le métal 9 (M9), sont comparés plus en détail sur la figure 9. Ces cartes de plaquettes révèlent que le taux de charge des électrons semble être à un plateau, sauf au bord , tandis que les taux de charge ionique ont montré une variation plus élevée dans la section médiane de la plaquette. À l'avenir, ces cartes de plaquettes dans différentes conditions de traitement devraient fournir des informations à la chambre à plasma, ou d'autres directives d'optimisation en compensant mieux les effets de charge.

Comparaison des taux de charge positifs et négatifs dans la ligne centrale d'une plaquette pour les procédés métal 2 et métal 9. Les taux de charge culminent autour du centre, ce qui signifie que les dommages induits par le plasma sont plus graves au centre de la plaquette

Le taux de charge projeté des électrons et des ions, J e (x ,y ) et J je (x ,y ) sont obtenus par les enregistreurs à division de charge sur la surface de gravure pendant la formation du métal 2 du métal 9
Effet de rapport d'antenne
Les dispositifs de surveillance PID traditionnels sont généralement conçus pour amplifier l'effet PID en connectant les grilles du transistor directement à une grande antenne, en évaluant les niveaux de contrainte en augmentant le Q total P devrait être déchargé à travers une petite région de canal [30, 31]. Le rapport d'antenne (AR) est proportionnel à la densité de courant de contrainte à travers le diélectrique de grille pendant les processus plasma [32]. Grand Q P sur l'antenne est connu pour induire des dommages latents et/ou des pièges dans la couche diélectrique, ce qui conduit finalement à une dégradation de la fiabilité [33]. Comme prévu, un AR plus élevé sur les FinFET conventionnels élève considérablement les niveaux de stress, provoquant un TBD plus sévère dégradation, à savoir, défaillance de l'appareil au cours d'une période de fonctionnement plus courte, voir Fig. 10. D'autre part, dans un CSIR, le niveau de charge du plasma enregistré comme charge de grille flottante, Q FG , montre très peu d'effet d'antenne. À savoir, il ne répond pas à l'augmentation de la surface de l'antenne, comme le révèlent les données résumées sur la Fig. 11.

un Les caractéristiques de temps de panne I G en fonction du temps des détecteurs PID conventionnels avec l'augmentation de la taille de l'antenne. b T BD diminue considérablement lorsque l'AR dépasse 1000
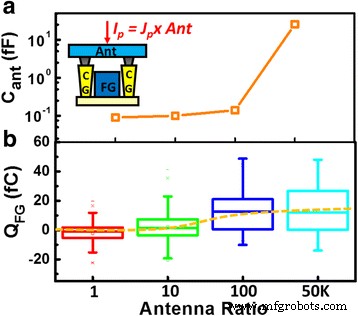
un Lorsque la capacité de l'antenne augmente, V CG devient indépendant de l'AR. b Q FG sature lorsque l'AR dépasse 100×
Dans le nouveau CSIR à grille flottante, le rapport d'antenne (AR) affectera le potentiel de crête sur les grilles de couplage pendant la charge du plasma. Dans les technologies mises à l'échelle, les capacités parasites sur la structure de connexion et de couplage devraient diminuer, entraînant une moindre sensibilité AR sur les résultats d'enregistrement. Les raisons qui ont conduit à une différence aussi évidente d'effet AR entre le CSIR et les détecteurs conventionnels sont les suivantes. Dans ces enregistreurs à grille flottante, la charge accumulée sur l'antenne, Q P ne seront pas déchargés à travers la zone du canal. Augmentation du Q P augmente V CG , conduisant à l'injection ou à l'éjection d'électrons dans/depuis les grilles flottantes. Comme le montre la capacité simulée de la Fig. 11a, la capacité de l'antenne, C fourmi , augmente proportionnellement à la surface de l'antenne, A fourmi . Avec le courant de charge total directement proportionnel à la surface de l'antenne, l'augmentation de l'AR dans un CSIR n'affectera pas le potentiel de l'antenne. Les données de mesure révèlent que le Q FG le niveau reste à peu près le même pour le SCIR avec un RA dépassant 100×.
Cette fonctionnalité enregistre non seulement la zone de motif de test, mais permet également de trouver J P (x ,y ) avec une résolution spatiale plus élevée pour étudier l'effet de structuration sur le PID. En outre, un détecteur avec une petite antenne peut faciliter la conception de modèles de test pour comprendre le PID en milieu de ligne (MEOL) et les processus de contact.
Enfin, le résumé des performances du nouveau CSIR pour la surveillance du PID dans le processus BEOL FinFET avancé est résumé dans le tableau 2. La plage de détection du détecteur traditionnel est AR, tandis que la plage de détection du nouvel enregistreur in situ est basée sur la longueur de la grille flottante. De plus, la zone du nouvel enregistreur in situ peut être très petite. Plus important encore, le nouveau CSIR peut fournir la rétroaction en temps réel du processus plasma et des niveaux séparés de charge ionique et de taux de charge électronique, indépendamment.
Conclusions
Un nouvel enregistreur in situ à division de charge (CSIR) pour surveiller les dommages induits par le plasma est proposé et démontré pour la première fois. Le CSIR fournit un outil puissant pour comprendre simultanément les taux de charge des électrons et des ions dans une chambre à plasma. Les cartes de plaquettes peuvent faciliter une étude plus approfondie entre la corrélation avec la fiabilité de l'appareil et ces effets de charge individuels.
Historique des modifications
Nanomatériaux
- Zebrafish :Un système modèle en temps réel prometteur pour l'administration de médicaments neurospécifiques par la nanotechnologie
- Dopage de substitution pour les minéraux d'aluminosilicate et performances supérieures de fractionnement de l'eau
- Nanoparticules de chitosane chargées de génistéine et de bioflavonoïdes ciblés sur les récepteurs folates pour un effet anticancéreux amélioré dans les cancers du col de l'utérus
- L'effet du plasma de contact hors équilibre sur les propriétés structurelles et magnétiques des spinelles Mn Х Fe3 − X О4
- Effet du traitement de recuit in situ sur la mobilité et la morphologie des transistors à effet de champ organiques à base de TIPS-Pentacène
- Synthèse in situ de nanoparticules bimétalliques de tungstène-cuivre via un plasma thermique à radiofréquence (RF) réactif
- Dépôt précis in situ assisté par champ électrique de nanofibres électrofilées γ-Fe2O3/polyuréthane pour l'hyperthermie magnétique
- Mailles fibreuses à base d'iode électrofilage in situ pour pansements antibactériens
- Un nanogénérateur triboélectrique portable pour la surveillance de la respiration en temps réel



