Étude sur la polarisation de surface de l'hétérostructure GaN/AlGaN/GaN coiffée d'Al2O3 par spectroscopie photoélectronique à rayons X à résolution angulaire
Résumé
La polarisation de surface du nitrure de gallium (GaN) face Ga (GaN) (2 nm)/AlGaN (22 nm)/canal GaN (150 nm)/tampon/Si avec Al2 O3 couche de coiffage est étudiée par spectroscopie photoélectronique à rayons X à résolution angulaire (ARXPS). On constate que la bande d'énergie varie d'une flexion vers le haut à une flexion vers le bas dans la région d'interface, ce qui est censé correspondre à la variation de polarisation. Une couche interfaciale se forme entre le dessus GaN et Al2 O3 en raison de la rupture de la liaison Ga–N et de la formation de la liaison Ga–O pendant Al2 O3 dépôt via le dépôt par couche atomique (ALD). On pense que cette couche interfaciale élimine la polarisation GaN, réduisant ainsi les charges négatives induites par la polarisation. De plus, cette couche interfaciale joue un rôle clé pour l'introduction des charges positives qui conduisent la bande d'énergie vers le bas. Enfin, un N2 on observe qu'un recuit à 400 °C améliore la croissance de la couche interfaciale, augmentant ainsi la densité des charges positives.
Contexte
Le nitrure de gallium (GaN) est considéré comme l'un des matériaux semi-conducteurs les plus attrayants dans de nombreux domaines allant des industries des LED aux industries de l'électronique de puissance [1, 2]. La popularité est due à un certain nombre d'avantages par rapport au silicium :un champ électrique de claquage élevé, une mobilité élevée des électrons et une excellente stabilité thermique [3, 4]. Le transistor GaN à haute mobilité électronique (HEMT) est largement étudié pour les applications haute puissance et haute fréquence [1, 5, 6]. Dans le HEMT, si la porte Schottky est adoptée, cette interface de porte apporte de grands états d'interface qui exacerbent le courant de fuite important et le faible champ de claquage [7]. Un isolant induit en tant que couche de passivation de surface et diélectrique de grille pourrait aider à atténuer les problèmes ci-dessus [8,9,10].
Al2 O3 est préféré pour une telle application d'isolant en raison de sa large bande interdite, de sa constante diélectrique élevée et de son énergie libre de Gibbs plus négative par rapport à Ga2 O3 , on pense donc que Al2 O3 pourrait passiver les états de surface et améliorer le champ de claquage électrique [5]. Cependant, une couche interfaciale se forme inévitablement au niveau du GaN/Al2 O3 interface après le dépôt de l'Al2 O3 [11, 12]. On pense que cette couche interfaciale est corrélée à la fiabilité de la tension de seuil et à la propriété du gaz d'électrons bidimensionnel (2DEG) et joue un rôle clé pour contrôler la flexion de la bande [2, 13,14,15,16].
Bien que la couche interfaciale ait été étudiée par plusieurs groupes de recherche, le rôle joué par la couche interfaciale n'a pas été exploité en profondeur [12, 17]. Par conséquent, dans cet article, nous utilisons la spectroscopie photoélectronique à rayons X à résolution angulaire (ARXPS) pour détecter les changements graduels de la courbure de la bande et obtenir la structure atomique de la couche interfaciale [11]. Différentes épaisseurs d'Al2 O3 sont déposés sur des échantillons de GaN par dépôt de couche atomique (ALD). ALD bénéficie d'une technologie de dépôt couche par couche à basse température, qui limite la réaction thermique entre GaN et Al2 O3 . Ainsi, l'ALD est privilégiée par les industries pour déposer des diélectriques à k élevé en raison de sa conformabilité et de son uniformité élevées, de la précision du contrôle de l'épaisseur, de la haute qualité du film et de la faible densité de défauts [4]. Cela permet un Al2 lisse et à faible défaut O3 /Interface GaN. Après Al2 O3 dépôt, un échantillon de recuit post-dépôt (PDA) à 400 °C est également préparé pour intensifier la réaction de la couche interfaciale, améliorant ainsi la formation de la couche interfaciale. Sur la base des résultats de l'ARXPS, on constate que la bande se plie initialement vers le haut depuis le substrat GaN jusqu'à l'interface proche en raison des charges négatives induites par la polarisation. Cependant, comme une augmentation de l'angle de détection θ , la bande se courbe progressivement vers le bas en raison de la formation de charges positives [5, 11,12,13].
Méthodes
La plaquette GaN/AlGaN/GaN-on-Si (111) à face Ga a été achetée auprès d'une société commerciale (Enkris.com). La structure épitaxiale de wurtzite comprend une couche de GaN de 2 nm au-dessus d'une couche d'AlGaN de 22 nm, et les deux couches épitaxiales sont développées sur une couche d'i-GaN de 150 nm. Une couche tampon sert de couche de transition reliant l'épicouche de GaN et le substrat de Si. Trois échantillons, S1, S2 et S3, sont préparés. Tous les échantillons ont d'abord été réduits pendant 5 minutes dans de l'acétone, suivis d'une immersion dans de l'alcool isopropylique et d'un rinçage dans de l'eau déminéralisée (DI). L'oxyde natif a ensuite été décapé en le trempant dans une solution diluée de HCl (HCl:H2 O =1:10) pendant ~ 1 min, suivi d'un rinçage à l'eau DI. L'Al2 O3 sont déposés par ALD sur GaN, avec du triméthyl aluminium (TMA) et H2 O comme précurseur de métal et oxydant, respectivement. L'Al2 O3 l'épaisseur est de 1 nm pour l'échantillon S1 et de 3 nm pour les échantillons S2 et S3. L'épaisseur est mesurée par l'ellipsomètre. De plus, S3 a été soumis au PDA en N2 à 400 °C pendant 5 min.
Les mesures ARXPS ont été effectuées dans un système Thermo Fisher Scientific Theta Probe équipé d'une source de rayons X monochromatique et microfocalisée Al Kα (1486,6 eV) et d'un analyseur d'énergie électronique hémisphérique. L'étalonnage de l'énergie de liaison (BE) a été effectué à l'aide d'échantillons standard de Ni, Au, Ag et Cu purs en définissant le bord Ni Fermi, Au 4f 7/2 , Ag 3d 5/2 , et Cu 2p 3/2 pics à 0,00 ± 0,02, 83,98 ± 0,02, 368,26 ± 0,02 et 932,67 ± 0,02 eV, respectivement. La FWHM d'un spectre de composants donné a pu varier dans une plage étroite uniquement (± 0,1 eV). Le plus petit nombre de spectres de composants a été utilisé pour obtenir des valeurs résiduelles acceptables [11]. Les spectres XPS ont été enregistrés à différents angles de détection (θ ), allant de 27,5° à 72,5° par rapport à l'échantillon normal en parallèle sans incliner l'échantillon. Pour supprimer un éventuel décalage de BE induit par la charge positive, les spectres XPS obtenus ont été référencés au C 1s pic à 285,0 eV. L'analyse quantitative, y compris la détermination du rapport élément/liaison, a été réalisée à l'aide de facteurs de sensibilité relative et d'algorithmes intégrés dans le logiciel Avantage [11].
Résultats et discussion
Le Ga 3d les spectres au niveau du cœur pour S1–S3 à différents angles de détection de photoélectrons sont représentés respectivement sur les figures 1a–c. Pour S1, chaque Ga 3d spectre peut être équipé de deux pics, correspondant aux liaisons Ga-N et Ga-O. Les liaisons Ga-O sont dues à la formation d'oxyde à la suite de l'exposition à l'oxygénant dans l'ALD, et l'oxygénant a pénétré dans le mince Al2 initial O3 couche [3]. Pour S2 et S3, trois pics peuvent être identifiés, notés Ga-N, Ga-O et O 2s , respectivement. Les O 2s Le pic est attribué aux liaisons Ga-O et Al-O, et il devient évident lorsque l'angle de détection devient plus grand. Comme cet article n'est pas axé sur ce pic, il ne sera pas discuté plus avant. La figure 2 présente le BE des pics Ga–N en fonction de θ pour S1–S3. Une diminution de 0,2 eV est obtenue à partir de θ =27,5° à 72,5° pour S1. Il suggère une flexion de la bande vers le haut, ce qui est cohérent avec les publications [3, 11]. Pour S2, le BE présente une diminution de 0,1 eV, indiquant une légère flexion de bande vers le haut près de l'interface par rapport à S1 ou une bande d'énergie plate sans flexion de bande en tenant compte de l'erreur expérimentale. Cependant, pour S3, il y a une augmentation de 0,2 eV du BE, ce qui contraste avec les échantillons S1 et S2, conseillant une flexion de bande vers le bas. La figure 3 enregistre l'Al 2p spectres pour tous les échantillons, et il n'y a pas de changement dans les BE. De plus, le pic est noté comme la liaison Al-O, et par conséquent, la couche d'AlGaN a une influence négligeable sur la variation Ga-N BE. Le tableau 1 résume les EB de Ga 3d et Al 2p à des angles de détection différents pour tous les échantillons, avec une erreur de ± 0,1 eV.

Le XPS Ga 3d spectres de base pour a S1, b S2 et c S3

Le BE du pic du spectre Ga–N en fonction de l'angle de détection θ (par rapport à la normale) pour S2. La barre d'erreur est de ± 0,1 eV

Le XPS Al 2p spectres de base pour a S1, b S2 et c S3, et le pic indique la liaison Al-O. De plus, il n'y a pas de variation significative du BE
Les rapports du pic Ga–O sur Ga–N pour tous les échantillons sont donnés dans le tableau 2. Le rapport est d'environ 0,2 pour les échantillons S1 et S2, ce qui est cohérent avec les résultats précédents [3]. Cependant, après le traitement PDA, le rapport augmente jusqu'à ~ 0,3 et dénote une augmentation du GaO x couche interfaciale. De plus, le rapport Ga/N est également donné dans le tableau 2. Le rapport est calculé en comparant les intensités intégrées du Ga 3d et N 1s pics avec des facteurs de sensibilité atomique [18]. Pour les échantillons S1 et S2, le rapport autour de 1,7 suggère une couche interfaciale riche en Ga. Cependant, après le N2 recuit, le rapport diminue jusqu'à ~ 1,0. De plus, la profondeur d'échantillonnage est également donnée dans le tableau 2 pour chaque angle. En raison de l'atténuation exponentielle des photoélectrons, 63 et 95% des électrons détectés proviennent d'une distance de 1λ (c'est-à-dire que λ représente le libre parcours moyen inélastique des électrons (IMFP)) et 3λ, respectivement, de la surface. Par conséquent, la profondeur d'échantillonnage XPS est définie comme 3λ nanomètres sous la surface de l'échantillon. Dans notre cas, Al2 O3 est la couche de recouvrement et le de Ga 3d photoélectrons dans Al2 O3 est estimée à ~ 3,4 nm. Pour une estimation approximative, la profondeur d'échantillonnage à différents angles est donnée par 3λcosθ . Cependant, la profondeur d'échantillonnage réelle de Ga–N BE doit tenir compte de l'épaisseur de Al2 O3 , la profondeur d'échantillonnage est donc estimée à 3λcosθ moins le plafond Al2 O3 épaisseur. Parce que le GaO x couche est au-dessus de l'hétérostructure GaN, le signal de cette couche est inclus pour chaque angle de détection. Cependant, avec l'augmentation de l'angle de détection, l'intensité du signal de la liaison Ga-N est diminuée, entraînant une augmentation du rapport Ga-O/Ga-N. En comparant S2 à S3, l'augmentation du rapport Ga–O/Ga–N et la diminution du rapport Ga/N suggèrent que la couche riche en Ga a été oxydée pour former GaO x .
Pour illustrer les données expérimentales présentées ici, un modèle est proposé schématiquement sur la figure 4. Le niveau d'énergie de Fermi du substrat GaN/AlGaN/GaN est calibré à 0 eV lors de la mesure XPS [19]. Le maximum de bande de conduction (CBM), le maximum de bande de valence (VBM) et le niveau de base sont donnés. Le BE est la différence d'énergie entre le niveau de base et le niveau de Fermi. Dans le dépôt ALD, O de l'oxygénant pourrait remplacer N dans la liaison Ga-N pour oxyder le GaN et les atomes N environnants pourraient former N2 molécules [20], ce qui conduit à la formation de la couche riche en Ga et de l'oxyde de gallium (GaO x ) couche interfaciale [11, 18]. Ceci est soutenu par le rapport Ga/N qui est supérieur à 1 dans le tableau 2. Ce rapport indique le changement de stoechiométrie GaN, et l'effet de polarisation spontanée intrinsèque de GaN devrait disparaître [21,22,23]. En conséquence, la couche riche en Ga, comme le GaN-à-GaO x couche de transition, élimine les charges négatives induites par la polarisation et donne une bande de conduction plate [11], comme le montre la figure 4.
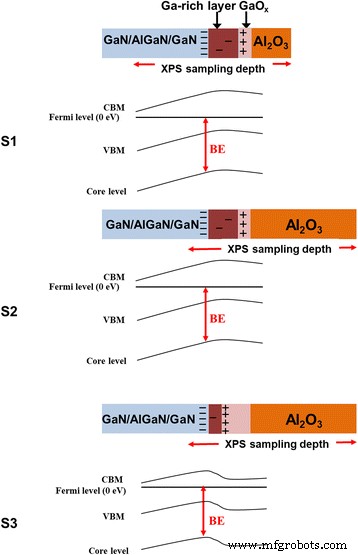
Dans la région d'interface, O remplaçant N dans la liaison Ga-N donne une couche riche en Ga et un GaO x couche. La couche riche en Ga agit comme le GaN-à-GaO x couche de transition. La formation Ga–O élimine la polarisation de GaN et agit comme des charges positives. En conséquence, la bande de conduction se plie progressivement de haut en bas et le BE varie en conséquence
De plus, dans le processus de recuit, la surface riche en Ga est oxydée pour former un GaO x plus épais couche. Comme l'oxydation est une réaction cinétiquement limitée et limitée à environ deux monocouches de surface, la masse ne sera pas fortement perturbée [24]. Par conséquent, le signal de liaison Ga-N provient principalement de la masse sous-jacente non oxydée, ce qui donne un rapport stoechiométrique Ga/N de 1 pour S3. Le GaO x Il a été rapporté que la couche apporte des charges positives qui peuvent être des charges fixes interfaciales avec des états d'énergie entre les minima de bande de conduction de l'oxyde natif et GaN, ce qui plierait la bande vers le bas [4, 11, 13, 14]. Par conséquent, la bande de conduction de la couche riche en Ga commence à diminuer dans la région proche du GaO x couche. Un GaO x plus épais devrait apporter une plus grande densité de charges positives. Par rapport à la constante BE de Ga–O et Al–O dans S3, cela indique que la charge positive devrait se situer à l'interface de la couche riche en Ga/GaO x couche. Les charges positives et les charges négatives induites par la polarisation créent un champ électrique interne qui a modifié la flexion de la bande de la flexion de la bande vers le haut à la flexion de la bande vers le bas, illustrée à la Fig. 4. En raison de la flexion de la bande vers le bas, le BE augmente avec l'augmentation de l'angle de détection .
Le GaO x la couche interfaciale apporte des charges positives qui augmentent la hauteur de la barrière d'interface ɸb . ɸb est définie comme la différence d'énergie entre le niveau de Fermi et le minimum de la bande de conduction à la surface ou à l'interface [25]. En conséquence, après le A2 O3 dépôt, la mobilité du 2DEG est augmentée et la densité électronique du 2DEG est diminuée [16, 25, 26].
Avec l'augmentation de l'Al2 O3 épaisseur, le signal XPS se reflète davantage sur la région d'interface entre l'Al2 coiffé O3 et GaN/AlGaN/GaN, qui est validé par la profondeur d'échantillonnage XPS indiquée dans le tableau 2. Ceci explique que seule une partie du profil de courbure de la bande a pu être détectée pour S2 [27]. En conséquence, la variation BE est de 0,1 eV, inférieure à 0,2 eV de S1. Pour S3, avec une couche interfaciale plus épaisse, la densité de charges positives est augmentée, ce qui entraîne une flexion de la bande vers le bas.
Conclusions
En résumé, la polarisation d'interface de Al2 O3 Le GaN/AlGaN/GaN coiffé est étudié par l'ARXPS. La polarisation intrinsèque du GaN est éliminée du fait d'une couche riche en Ga et d'un GaO x formation de couche. De plus, les liaisons Ga–O du GaO x couche apporte des charges fixes interfaciales positives. En raison de cette variation de polarisation, la bande varie de la flexion vers le haut à la flexion vers le bas dans la région d'interface.
Nanomatériaux
- 5G et GaN :futures innovations
- Impact des états de surface et de la fraction molaire d'aluminium sur le potentiel de surface et 2DEG dans les HEMT AlGaN/GaN
- Analyse de la réflectance infrarouge de couches de GaN dopées épitaxiales de type n cultivées sur du saphir
- Cibler les cellules endothéliales avec des nanoparticules GaN/Fe multifonctionnelles
- Réglage des morphologies de surface et des propriétés des films de ZnO par la conception de la couche interfaciale
- Couches de dopage au silicium optimal des barrières quantiques dans la séquence de croissance formant un potentiel de confinement souple de huit périodes In0.2Ga0.8N/GaN Puits quantiques de bleu LE…
- Enquête sur une cellule solaire au silicium cristallin avec une couche de silicium noir à l'arrière
- Comprendre le mécanisme de croissance des couches épitaxiales de GaN sur du graphite exfolié mécaniquement
- Recombinaison à contrainte contrôlée dans plusieurs puits quantiques InGaN/GaN sur substrats de silicium



