Croissance auto-catalysée de nanofils verticaux de GaSb sur des tiges d'InAs par dépôt en phase vapeur de produits chimiques organo-métalliques
Résumé
Nous rapportons la première croissance auto-catalysée de nanofils de GaSb de haute qualité sur des tiges d'InAs en utilisant le dépôt chimique en phase vapeur métal-organique (MOCVD) sur des substrats de Si (111). Pour réaliser la croissance de nanofils verticaux à hétérostructure InAs/GaSb, les débits en deux étapes du triméthylgallium (TMGa) et du triméthylantimoine (TMSb) sont utilisés. Nous utilisons d'abord des débits de TMGa et TMSb relativement faibles pour préserver les gouttelettes de Ga sur les tiges minces d'InAs. Ensuite, les débits de TMGa et de TMSb sont augmentés pour améliorer la vitesse de croissance axiale. En raison du taux de croissance radiale plus lent du GaSb à une température de croissance plus élevée, les nanofils de GaSb cultivés à 500 °C présentent des diamètres plus grands que ceux cultivés à 520 °C. Cependant, en ce qui concerne la croissance axiale, en raison de l'effet Gibbs-Thomson et de la réduction de la sursaturation des gouttelettes avec l'augmentation de la température de croissance, les nanofils de GaSb cultivés à 500 °C sont plus longs que ceux cultivés à 520 °C. Des analyses détaillées par microscopie électronique à transmission (MET) révèlent que les nanofils de GaSb ont une structure cristalline de zinc-blende (ZB) parfaite. La méthode de croissance présentée ici peut convenir à d'autres croissances de nanofils d'antimonide, et les nanofils axiaux à hétérostructure InAs/GaSb peuvent avoir un fort potentiel d'utilisation dans la fabrication de nouveaux dispositifs à base de nanofils et dans l'étude de la physique quantique fondamentale.
Contexte
Les nanofils semi-conducteurs III-V ont été reconnus comme des candidats prometteurs pour la prochaine génération de dispositifs électroniques, optiques et quantiques à l'échelle nanométrique en raison de leurs propriétés électroniques, optiques et géométriques uniques [1,2,3]. Parmi les matériaux semi-conducteurs III-V, en raison de leurs avantages uniques, tels qu'une bande interdite directe étroite, une faible masse effective de porteur et la mobilité de porteur la plus élevée, les antimoniures III ont un fort potentiel d'utilisation dans la fabrication d'infrarouges à ondes moyennes et longues. photodétecteurs [4], transistors à grande vitesse de faible puissance [5,6,7] et dans l'étude de la physique quantique fondamentale [8,9,10]. Cependant, en raison de leur masse atomique élevée, la faible volatilité du Sb élémentaire et la faible température de fusion des composés III-antimonide, la croissance de nanofils à base d'antimonide, est extrêmement difficile [11].
En particulier, les nanofils de GaSb, considérés comme des nanofils d'antimoniure de type p extrêmement importants, ont été principalement développés à l'aide de catalyseurs Au [12,13,14,15,16]. Cependant, l'introduction d'Au peut former des centres de recombinaison de niveau profond indésirables dans la bande interdite Si et dégrader les propriétés électroniques et optiques des nanofils III-V [17, 18]. Par conséquent, il est hautement souhaitable de faire croître des nanofils de GaSb sans aucun catalyseur étranger. De plus, pour la croissance verticale de nanofils d'antimoniure, la nucléation directe sur le substrat est très difficile. Pour éviter le problème de nucléation, une tige courte d'un autre matériau est toujours cultivée en premier pour aider à la croissance des nanofils verticaux de GaSb. Récemment, la croissance auto-catalysée de nanofils de GaSb sur des tiges de GaAs a été réalisée par épitaxie par faisceau moléculaire (MBE) [19], mais à notre connaissance, il n'existe aucun rapport sur la croissance de nanofils de GaSb de haute qualité sans le utilisation de catalyseurs étrangers basés sur une technique de dépôt chimique en phase vapeur métal-organique (MOCVD). Ici, nous présentons la croissance auto-catalysée de nanofils de GaSb à l'aide de tiges d'InAs en utilisant MOCVD sur des substrats de Si (111). D'une part, la croissance de nanofils de GaSb sur des tiges de nanofils d'InAs par un mécanisme auto-catalysé est difficile en raison du changement d'anions et de cations de la tige d'InAs vers le GaSb supérieur. D'autre part, en raison du faible décalage de maille de 0,6% et de l'alignement unique de la bande brisée de type II entre InAs et GaSb, la croissance des nanofils de GaSb sur des tiges d'InAs pour former des nanofils à hétérostructure axiale InAs/GaSb permet une nouvelle plate-forme pour de nombreuses applications, y compris les dispositifs basés sur l'effet tunnel [7, 14, 20, 21], les transistors métal-oxyde-semiconducteur complémentaire (CMOS) à grande vitesse [22, 23], la recherche sur l'hybridation électron-trou [9] et l'exciton- et des études sur la physique du spin [24].
Dans cet article, des nanofils de GaSb de haute qualité avec des parois latérales lisses ont été obtenus grâce à un contrôle minutieux des conditions de croissance. Pour réaliser la croissance de nanofils verticaux à hétérostructure InAs/GaSb, des débits relativement faibles de triméthylgallium (TMGa) et de triméthylantimoine (TMSb) ont d'abord été utilisés pour préserver les gouttelettes de Ga sur les tiges d'InAs. Ensuite, les débits de TMGa et TMSb ont été augmentés pour améliorer la croissance axiale des nanofils de GaSb. En raison du taux de croissance radiale plus lent du GaSb à une température de croissance plus élevée, les nanofils de GaSb cultivés à 500 °C ont des diamètres plus grands que ceux cultivés à 520 °C. De plus, en raison de l'effet Gibbs-Thomson et de la réduction de la sursaturation des gouttelettes avec l'augmentation de la température de croissance, les nanofils de GaSb cultivés à 500 °C sont plus gros en diamètre et en longueur que ceux cultivés à 520 °C. Des analyses détaillées par microscopie électronique à transmission (MET) révèlent que la structure cristalline des tiges d'InAs est composée d'un polytype de structures wurtzite (WZ) et zinc-blende (ZB), tandis que les nanofils de GaSb à croissance axiale ont une structure cristalline ZB pure complètement libre de défauts planaires.
Méthodes
Croissance des nanofils
Les nanofils d'hétérostructure InAs/GaSb ont été développés par un système MOCVD à pomme de douche monobloc (AIXTRON Ltd, Allemagne) à une pression de chambre de 133 mbar. Le triméthylindium (TMIn) et le TMGa ont été utilisés comme précurseurs du groupe III, et l'arsine (AsH3 ) et TMSb ont été utilisés comme précurseurs du groupe V. Hydrogène ultra-pur (H2 ) a été utilisé comme gaz vecteur, et le débit total de H2 était de 12 slm. Les nanofils ont été développés sur des substrats de Si (111). Avant la croissance, les substrats ont été chauffés à 635°C pour le recuit puis refroidis à 400°C sous AsH3 flux pour former des surfaces de type (111)B [25]. Les tiges d'InAs ont été cultivées à 545°C pendant 45 s avec TMIn et AsH3 débits de 1,0 × 10 −6 mol/min et 2.0 × 10 −4 mol/min, respectivement. Par la suite, les flux sources ont été basculés de TMIn et AsH3 à TMGa et TMSb, et les substrats ont été refroidis à la température spécifique pour la croissance axiale des nanofils de GaSb. Enfin, les échantillons ont été refroidis à température ambiante en utilisant du TMSb comme agent protecteur.
Méthodes de caractérisation
La morphologie des nanofils a été caractérisée par microscopie électronique à balayage (SEM) (Nova Nano SEM 650), et TEM (JEM2010F TEM; 200 kV) en conjonction avec la spectroscopie à dispersion d'énergie des rayons X (EDS) a été utilisée pour étudier la structure cristalline et la distribution de la composition élémentaire, respectivement. Pour les observations MET, les nanofils cultivés ont été transférés mécaniquement des échantillons vers des grilles de cuivre recouvertes d'un film de carbone. Les mesures Raman ont été effectuées en géométrie de rétrodiffusion à température ambiante en utilisant un laser de longueur d'onde de 532 nm comme source d'excitation (système Jobin-Yvon HR Evolution Raman). Les échantillons ont été excités avec une puissance laser de 0,36 mW sur une taille de spot d'environ 1 m.
Résultats et discussion
La figure 1 montre une illustration schématique de la croissance axiale de nanofils de GaSb sur des tiges d'InAs et les séquences source-alimentation pour la croissance des nanofils. Les nanofils se développent via un mécanisme auto-catalysé et les gouttelettes catalytiques passent progressivement de In à Ga après avoir basculé les flux de TMIn et AsH3 à TMGa et TMSb. Par rapport aux nanofils tiges, les nanofils de GaSb ont toujours un diamètre beaucoup plus épais, ce qui signifie que la taille des gouttelettes catalytiques de Ga est bien plus grande que celle des gouttelettes d'In. Ensuite, une collecte trop rapide d'adatomes de Ga par les gouttelettes sur les tiges minces d'InAs peut provoquer un glissement des gouttelettes (comme indiqué dans le fichier supplémentaire 1 :Figure S1). Pour garantir que les gouttelettes catalytiques aient suffisamment de temps pour collecter les adatomes de Ga pendant la phase de transition de InAs à GaSb, nous avons d'abord utilisé des débits relativement faibles de TMGa et de TMSb pour protéger les gouttelettes de Ga sur les tiges d'InAs, comme le montre la figure 1. Lors de la première étape, les débits TMGa et TMSb étaient de 0,35 × 10 −6 mol/min et 2.0 × 10 −6 mol/min, ce qui correspond à un rapport V/III d'environ 5,7, et le processus de croissance est resté à 15 min (région 2 sur la figure 1). Après cela, pour augmenter le taux de croissance axiale, les débits de TMGa et TMSb ont été augmentés à 0,7 × 10 −6 mol/min et 4.0 × 10 −6 mol/min pour la croissance ultérieure des nanofils de GaSb (en maintenant le rapport V/III constant), respectivement. En utilisant les débits TMGa et TMSb en deux étapes, nous avons réussi à réaliser la croissance verticale de nanofils de GaSb sur des tiges d'InAs. Compte tenu du temps de croissance inchangé des nanofils de GaSb avec les faibles débits, sauf indication contraire, les temps de croissance des nanofils de GaSb mentionnés dans les paragraphes suivants sont identiques à celui de la croissance de GaSb avec les débits élevés (région 3 de la Fig. 1) .
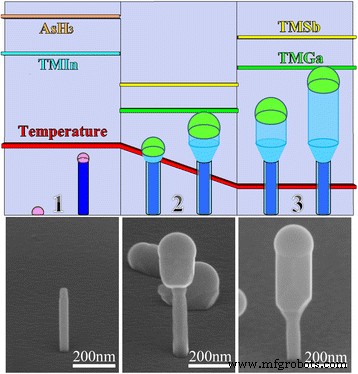
L'illustration de la croissance axiale de nanofils de GaSb sur des tiges d'InAs et les séquences source-alimentation pour la croissance des nanofils. Les nanofils de GaSb présentés ici ont été cultivés à 520 °C
Des images SEM typiques des nanofils de GaSb cultivés sur des tiges d'InAs à différentes températures de 480, 500, 520 et 545 °C sont présentées respectivement sur les figures 2a–d (les tiges d'InAs avant la croissance de GaSb sont présentées dans le fichier supplémentaire 1 :Graphique S2). Le temps de croissance du GaSb est de 10 min. On observe que le comportement de croissance du GaSb est très sensible à la température de croissance. Clairement, à 480 °C, au lieu d'une croissance axiale, le GaSb a tendance à croître radialement autour des tiges d'InAs ou le long de la direction planaire (Fig. 2a). Des détails sur la croissance radiale des coques de GaSb sur les noyaux d'InAs et la croissance planaire des nanofils d'antimonide ont été rapportés ailleurs [26,27,28]. Cependant, la situation change à mesure que la température de croissance du GaSb augmente jusqu'à 500 ou 520 °C, où la croissance axiale des nanofils de GaSb est réalisée sur les tiges d'InAs autonomes (Fig. 2b, c). Les gouttelettes de Ga aux extrémités des nanofils indiquent un mécanisme de croissance auto-catalysé vapeur-liquide-solide (VLS) des nanofils de GaSb. Le diamètre des segments supérieurs de GaSb est généralement plus épais que celui des segments d'InAs, et la largeur croissante des segments de GaSb à l'interface InAs/GaSb indique que la taille des gouttelettes catalytiques de Ga augmente progressivement au stade initial de croissance de GaSb. De plus, les segments de tige beaucoup plus minces de la figure 2c peuvent impliquer que la croissance radiale de GaSb a diminué progressivement avec la température de croissance passant de 500 à 520 °C. Cependant, lorsque la température est encore augmentée à 545 °C, les nanofils de GaSb semblent croître le long de la direction plane ou inclinée. De plus, la plupart des tiges d'InAs ont disparu et le diamètre des tiges d'InAs résiduelles est très mince (marqué par les cercles rouges sur la figure 2d, et d'autres images SEM sont présentées dans le fichier supplémentaire 1 :figure S3). Nous supposons que les tiges d'InAs sont sérieusement décomposées à la température de croissance élevée de 545 °C, entraînant la chute des nanofils de GaSb pendant le processus de croissance. Par conséquent, pour obtenir la croissance verticale des nanofils de GaSb sur des tiges de nanofils d'InAs, la température de croissance des nanofils de GaSb doit être soigneusement contrôlée.

Les images SEM inclinées à 80° des nanofils de GaSb cultivés sur des tiges d'InAs à a 480 °C, b 500 °C, c 520 °C, et d 545 °C pendant 20 minutes. Les conditions de croissance des tiges de nanofils d'InAs ont été maintenues constantes. Encarts en b et c montrer des images SEM à plus fort grossissement. Les cercles rouges en d marquer les tiges InAs résiduelles
La figure 3 affiche les distributions statistiques du diamètre et de la longueur des segments de GaSb illustrés sur les figures 2b, c, où les températures de croissance de GaSb sont respectivement de 500 et 520 °C. De toute évidence, la distribution de taille des nanofils de GaSb cultivés à la même température (points rouges ou bleus sur la figure 3) démontre que les nanofils les plus épais ont tendance à être plus longs. Ce phénomène a également été rapporté pour la croissance catalysée par Ga de nanofils GaAsP par MBE [29] et pour la croissance catalysée par Au de nanofils à hétérostructure InAs/InSb par épitaxie chimique par faisceau (CBE) [30] et de nanofils InGaSb par MOCVD [31 ]. La raison est principalement attribuée à la sursaturation effective plus faible (Δμ ) dans les plus petites gouttelettes catalytiques. Pour le mécanisme de croissance VLS, la sursaturation Δμ , qui est le changement de potentiel chimique par paire III-V dans la goutte catalytique et le nanofil, est la principale force motrice de la croissance du nanofil. Au cours du processus de croissance auto-catalysé, les nanofils sont cultivés dans un environnement riche en groupe III et la concentration des atomes du groupe V incorporés dans la gouttelette catalytique domine la sursaturation effective. Pour la croissance auto-catalysée des nanofils de GaSb, la sursaturation effective Δμ est dominée par la concentration d'atomes de Sb incorporés dans les gouttelettes catalytiques de Ga. Par conséquent, la sursaturation effective Δμ peut être présenté comme [32, 33]
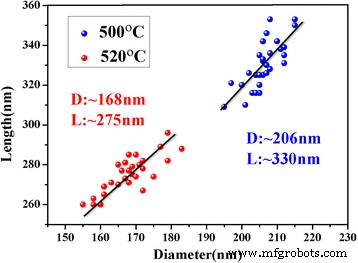
Données statistiques du diamètre et de la longueur des nanofils de GaSb cultivés à 500 et 520 °C
.
$$ \varDelta \mu ={k}_{\mathrm{B}} T \ln \left({x}_{\mathrm{Sb}}/{x}_{\mathrm{Sb},\mathrm{ eq}}\right) $$ (1)où k B est la constante de Boltzmann, T est la température absolue. x Sb et x Sb,eq sont la fraction atomique de Sb dans les gouttelettes catalytiques de Ga pendant le processus de croissance du nanofil et à l'équilibre avec le cristal de nanofil de GaSb, respectivement. De plus, sur la base de la théorie classique de la croissance cristalline, la vitesse de croissance axiale du nanofil (v ) peut être exprimé par [34].
$$ v\sim {\left(\varDelta \mu /{k}_{\mathrm{B}} T\right)}^2 $$ (2)De toute évidence, le taux de croissance des nanofils dépend fortement de la concentration en Sb x Sb dans les gouttelettes de Ga. En raison de l'effet Gibbs-Thomson, la pression de vapeur de Sb dans les gouttelettes catalytiques peut augmenter de manière significative lorsque le diamètre diminue [35, 36]. Ensuite, les plus petites gouttelettes peuvent plus facilement désorber les atomes de Sb des particules catalytiques de Ga, ce qui entraînera une concentration plus faible en Sb (x Sb ) dans les plus petites gouttelettes catalytiques de Ga. En conséquence, la sursaturation effective dans les plus petites gouttelettes est inférieure à celle des plus grosses, réduisant ainsi le taux de croissance axiale des nanofils de GaSb par le mécanisme de croissance auto-catalysé.
De plus, lorsque l'on compare les distributions de taille des nanofils de GaSb cultivés à 500 et 520 °C, les nanofils de GaSb cultivés à 500 °C (points bleus sur la figure 3 ; diamètre et longueur moyens 206 et ~330 nm) ont à la fois un diamètre et une longueur plus grands que les nanofils de GaSb cultivés à 520 °C (points rouges sur la figure 3 ; diamètre et longueur moyens 168 et ~275 nm). Les nanofils plus minces développés à 520°C peuvent être attribués au taux de croissance radiale plus lent du GaSb à une température de croissance plus élevée. Cependant, pour la croissance axiale, outre l'effet Gibbs-Thomson, l'augmentation de la température de croissance peut également réduire la sursaturation des gouttelettes et réduire encore la vitesse de croissance axiale des nanofils de GaSb [29, 37]. Ainsi, les nanofils de GaSb cultivés à 500 °C sont plus grands en diamètre et en longueur que les nanofils de GaSb cultivés à 520 °C.
Pour mieux déterminer les avantages découlant de l'assistance des nanofils de tige, nous avons ensuite comparé les nanofils de GaSb cultivés directement sur des substrats de Si et sur de courtes tiges d'InAs, comme le montre la figure 4. Les nanofils de GaSb montrés sur la figure 4a, b ont été cultivés. à 500 °C, tandis que les nanofils de GaSb présentés sur la figure 4c ont été cultivés à 520 °C. De toute évidence, les tiges de nanofils d'InAs jouent un rôle crucial dans la croissance réussie des nanofils verticaux de GaSb. Comme le montre la figure 4a, les nanofils de GaSb cultivés directement sur des substrats de Si (111) préfèrent croître le long de la direction planaire (d'autres images SEM sont disponibles dans le fichier supplémentaire 1 :figure S4), et nous supposons que cette question des nanofils d'antimonide directement nucléées sur les substrats est associée à l'effet tensioactif des adatomes Sb, qui peut diminuer l'angle de contact entre les gouttelettes de Ga pré-déposées et la surface du substrat Si [38, 39]. Alors que, comme le montre la figure 4b, c, les nanofils verticaux de GaSb sont réalisés à l'aide des tiges courtes d'InAs. Nous notons que, sur la figure 4b, c, le temps de croissance des tiges de nanofils d'InAs est réduit à 20 s (ce qui entraîne une longueur des nanofils d'InAs généralement inférieure à 120 nm), tandis que le temps de croissance des nanofils de GaSb est augmenté à 30 minutes. Tous les nanofils de GaSb ont des parois latérales extrêmement lisses sur toute leur longueur sans effilement visible. Notamment, les segments de tige d'InAs ont presque le même diamètre que les nanofils de GaSb supérieurs (comme indiqué dans l'encadré de la Fig. 4b, c), ce qui indique que le taux de croissance radiale de GaSb autour des tiges d'InAs est plus rapide que celui autour des nanofils de GaSb supérieurs. . Cette différence pourrait être associée au fait que les adatomes réactifs diffusés à partir de la surface du substrat ont tendance à se rassembler autour des parois latérales des nanofils d'InAs minces et courts, entraînant une augmentation locale du taux de croissance radiale de GaSb autour des tiges d'InAs. Enfin, avec un temps de croissance suffisant, les nanofils développés ont un diamètre presque uniforme le long de la direction de croissance; le même comportement a également été observé dans la croissance de nanofils d'InSb à base de tiges courtes d'InAs par MOCVD [40].

Les images SEM inclinées à 80° des nanofils de GaSb cultivés sans tiges d'InAs (a ), et sur les courtes tiges InAs (b , c ). Les nanofils de GaSb montrés dans a et b ont été cultivés à 500 °C, tandis que les nanofils de GaSb en c ont été cultivés à 520°C. Encarts en b et c afficher des images SEM à plus fort grossissement
Pour examiner les caractéristiques structurelles des nanofils obtenus, des mesures MET détaillées ont été effectuées. La figure 5a montre une image MET basse résolution à fond clair (BF) d'un nanofil de GaSb typique développé sur une tige d'InAs à 520 °C (comme le montre la figure 2c). Après la croissance ultérieure du nanofil de GaSb, le nanofil d'InAs plus fin a une morphologie rugueuse. Cela pourrait être attribué à la pyrolyse de l'InAs et à la croissance radiale irrégulière du GaSb au cours du processus de croissance des nanofils de GaSb. Les figures 5b–e représentent les images MET haute résolution (HRTEM) correspondantes prises dans les régions marquées de quatre rectangles rouges sur la figure 5a. La micrographie HRTEM et le modèle de transformée de Fourier rapide (FFT) associé sur la figure 5b révèlent que le nanofil de GaSb à croissance axiale a une structure cristalline ZB pure totalement exempte de défauts planaires, ce qui est couramment observé dans la croissance de nanofils d'antimonide. Cependant, les défauts planaires occasionnels (plans jumeaux (TP) et défauts d'empilement (SF)) se présentant au sommet et au début de la région de croissance du nanofil de GaSb (Fig. 5c, d) peuvent être causés par une légère fluctuation des conditions de croissance locales pendant le processus de refroidissement éventuel et l'étape initiale de transition de l'InAs au GaSb supérieur. De plus, les atomes d'As résiduels peuvent également jouer un rôle dans la formation de défauts planaires dans la région de transition (comme le montrent les analyses EDS ci-dessous). En revanche, comme le montre la figure 5e, la structure cristalline de la tige d'InAs est composée d'un polytype de structures WZ et ZB avec un grand nombre de défauts planaires le long de sa direction de croissance ; en raison de la coexistence des structures WZ et ZB, les taches FFT correspondantes se divisent et sont légèrement allongées le long de la direction de croissance (encadré sur la figure 5e). Il a été démontré que les défauts structurels des nanofils peuvent provoquer des inhibitions indésirables de la mobilité des porteurs [41] et donc réduire les propriétés de transport dans le système d'hétérostructure InAs/GaSb. Récemment, il a été rapporté que l'incorporation de Sb améliore efficacement la qualité cristalline des nanofils d'InAs [42, 43], augmentant ainsi considérablement le potentiel de l'ingénierie de la phase cristalline des nanofils d'InAs sans aucun catalyseur étranger.
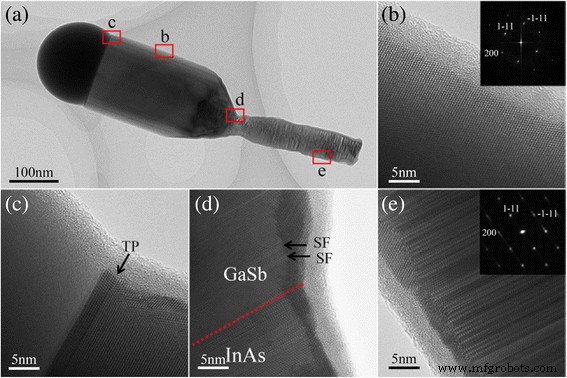
un Une image MET à faible grossissement d'un nanofil à hétérostructure InAs/GaSb typique. b –e Images TEM haute résolution (HRTEM) prises dans les régions marquées par des rectangles rouges dans (a ) respectivement. Toutes les images HRTEM sont acquises à partir de l'axe de zone 〈110〉. La ligne pointillée rouge en d indique l'interface entre la tige d'InAs et le nanofil supérieur de GaSb. Les encarts en b et e sont les modèles de transformée de Fourier rapide (FFT) correspondants du nanofil GaSb et de la tige InAs, respectivement
Les figures 6a–f montrent une image MET d'un autre nanofil à hétérostructure InAs/GaSb et les analyses EDS correspondantes. Toutes les mesures EDS utilisent les signaux d'émission Lα de In, As et Sb et le signal d'émission Kα de Ga. Le balayage linéaire de l'EDS le long de la direction axiale (Fig. 6b) et la cartographie élémentaire de la composition des nanofils (Fig. 6c–f) montrent que la goutte contient majoritairement du Ga et une petite quantité d'In, alors qu'on n'observe quasiment pas d'As ou de Sb, ce qui confirme directement le mécanisme de croissance auto-catalysé des nanofils de GaSb (pourcentage atomique issu de l'analyse quantitative ponctuelle EDS au spot 1 :Ga, 96,13 % ; In, 3,8 % ; As, 0 ; Sb, 0,07 %, respectivement. Les spectres EDS des analyses ponctuelles dans les deux spots sont présentés dans le fichier supplémentaire 1 :Figure S5). Cette faible concentration en In dans la gouttelette est principalement attribuée à la dissolution des atomes d'In dans la gouttelette de Ga lors de l'étape initiale de transition de InAs à GaSb. De plus, selon le balayage linéaire EDS de la figure 6b, la croissance des nanofils de GaSb commence sur les tiges d'InAs, et à partir de l'analyse ponctuelle EDS de la distribution de la composition élémentaire au point 2 (Ga, 48,86%; In, 0,91%; As, 0,70 %; Sb, 49,53 %), le rapport stoechiométrique des atomes Ga et Sb dans le segment GaSb développé est d'environ 1:1. Cependant, les signaux relativement élevés de Ga et Sb dans la section InAs proviennent de la croissance radiale du GaSb autour de la tige InAs, et le gradient élémentaire pour les signaux In, As, Ga et Sb près de l'interface peut être principalement causé par le résidu In et As après le TMIn et AsH3 les flux sont coupés.

un L'illustration des nanofils à hétérostructure axiale InAs/GaSb et une image MET à faible grossissement d'un nanofil InAs/GaSb cultivé à 520 °C. b Balayage de ligne EDS le long de la ligne rouge marqué en (a ). c –f Cartes compositionnelles EDS du nanofil dans (a ), montrant la distribution Ga, Sb, In et As. Deux points dans a marquer les positions où les analyses de points EDS ont été effectuées
Pour analyser les propriétés optiques des nanofils de GaSb cultivés, des mesures Raman ont été effectuées. La figure 7 montre les spectres Raman d'un substrat de GaSb (100) et les nanofils de GaSb développés sur les tiges courtes d'InAs. Deux pics de diffusion sont observés dans le spectre du GaSb massif à environ 226,5 et 235,2 cm −1 (ligne rouge sur la Fig. 7) et sont attribuées aux modes de phonons optiques transversaux (TO) et optiques longitudinales (LO) de GaSb, respectivement. Pour les nanofils de GaSb, deux pics similaires ont également été observés clairement à environ 225,0 et 233,6 cm −1 dans le spectre Raman (ligne bleue sur la figure 7), indiquant une qualité photonique élevée des nanofils de GaSb obtenus. Dans les mesures de rétrodiffusion Raman, le mode phonon TO est interdit dans la direction (100), un petit pic de mode phonon TO pour le substrat massif GaSb (100) pourrait être attribué à une légère mauvaise orientation ou imperfection du substrat [44]. Cependant, pour les nanofils de GaSb, parce que les nanofils sont développés le long de la direction verticale (111) et avec six parois latérales {110}, les modes de phonons TO et LO peuvent être clairement observés dans le spectre Raman. De plus, par rapport au GaSb massif, les modes de phonons TO et LO des nanofils de GaSb présentent une faible rétrogradation. Dans les mesures de diffusion Raman, à la fois le confinement quantique et les défauts peuvent induire la descente en fréquence des pics de phonons [45]. Considérant qu'en raison du grand diamètre des nanofils de GaSb cultivés qui ne montre presque aucun effet de confinement quantique, nous supposons que cette faible diminution de la fréquence des phonons peut être associée à des défauts de surface des nanofils de GaSb. Avec les débits en deux étapes du TMGa et du TMSb, nous avons réalisé la croissance verticale de nanofils de ZB GaSb purs sur des tiges d'InAs par MOCVD sans aucun catalyseur étranger. Nous prévoyons qu'en optimisant davantage les paramètres de croissance, tels que la température de croissance et différentes combinaisons des débits de TMGa et de TMSb dans le processus de croissance en deux étapes, des nanofils de GaSb avec un rapport d'aspect plus élevé pourraient être obtenus.

Spectres Raman d'un substrat GaSb (100) (ligne rouge ) et les nanofils de GaSb (ligne bleue ). Les lignes vertes sont les résultats d'un ajustement lorentzien multi-pics
Conclusions
En résumé, nous avons démontré la croissance auto-catalysée de nanofils de GaSb sur des tiges d'InAs par MOCVD. Pour réaliser la croissance des nanofils verticaux d'hétérostructure InAs/GaSb, nous utilisons d'abord des débits de TMGa et TMSb relativement faibles pour préserver les gouttelettes de Ga sur les tiges d'InAs. Ensuite, les débits de TMGa et de TMSb sont augmentés pour améliorer le taux de croissance axiale. En raison de la vitesse de croissance radiale plus lente du GaSb à une température de croissance plus élevée, les nanofils de GaSb cultivés à 500 °C ont un diamètre plus grand que ceux cultivés à 520 °C. Cependant, pour la croissance axiale, en raison de l'effet Gibbs-Thomson et de la réduction de la sursaturation des gouttelettes avec l'augmentation de la température de croissance, les nanofils de GaSb cultivés à 500 °C sont plus longs que ceux cultivés à 520 °C. Des mesures MET détaillées révèlent que la structure cristalline des tiges InAs est un mélange de structures WZ et ZB, tandis que les nanofils GaSb supérieurs ont une phase cristalline ZB parfaite, et les analyses Raman indiquent une qualité optique élevée des nanofils GaSb obtenus. La méthode de croissance présentée ici peut convenir à la croissance d'autres nanofils à base d'antimonide. De plus, les nanofils de GaSb cultivés sur des tiges d'InAs peuvent introduire de nouvelles possibilités d'applications dans les dispositifs à base de nanofils et pour l'étude de la physique quantique.
Abréviations
- CMOS :
-
Métal-oxyde-semi-conducteur complémentaire
- EDS :
-
Spectroscopie à dispersion d'énergie
- FFT :
-
Transformée de Fourier rapide
- LO :
-
Optique longitudinale
- MBE :
-
Epitaxie par faisceau moléculaire
- MOCVD :
-
Dépôt chimique en phase vapeur métal-organique
- SEM :
-
Microscopie électronique à balayage
- SF :
-
Défaut d'empilement
- TEM :
-
Microscopie électronique à transmission
- TMGa :
-
Triméthylgallium
- TMSb :
-
Triméthylantimoine
- À :
-
Optique transversale
- TP :
-
Avion jumelé
- VLS :
-
Vapeur-liquide-solide
- ZB :
-
Mélange de zinc
Nanomatériaux
- Qu'est-ce que le dépôt chimique en phase vapeur?
- Les scientifiques des matériaux enseignent aux nanofils comment « danser »
- Technologies avancées de dépôt de couche atomique pour les micro-LED et les VCSEL
- Décryptage de l'évolution morphologique et de la cinétique de gravure de nanofils de silicium poreux lors d'une gravure chimique assistée par métal
- Les nanofibres hiérarchiques antibactériennes en polyamide 6-ZnO fabriquées par dépôt de couche atomique et croissance hydrothermale
- Film WS2 de grande surface avec de grands domaines uniques cultivés par dépôt chimique en phase vapeur
- Contrôle de la croissance des nanofils de séléniure d'indium à haute uniformité (In2Se3) via le processus de recuit thermique rapide à basse température
- Performance de magnétisation uniaxiale de réseaux de nanofils Fe texturés électrodéposés par une technique de dépôt de potentiel pulsé
- Propriétés électriques des super-réseaux InAs/GaSb à ondes moyennes et longues cultivées sur des substrats GaAs par épitaxie par faisceau moléculaire



