Technologies avancées de dépôt de couche atomique pour les micro-LED et les VCSEL
Résumé
Ces dernières années, les exigences de processus des nano-dispositifs ont conduit à la réduction progressive de l'échelle des dispositifs à semi-conducteurs et aux défauts de paroi latéraux non négligeables causés par la gravure. Étant donné que le dépôt chimique en phase vapeur assisté par plasma ne peut plus fournir une couverture d'étape suffisante, les caractéristiques de la technologie ALD de dépôt de couche atomique sont utilisées pour résoudre ce problème. L'ALD utilise des interactions auto-limitantes entre le gaz précurseur et la surface du substrat. Lorsque le gaz réactif forme une seule couche de produit chimique adsorbé sur la surface du substrat, aucune réaction ne se produit entre eux et l'épaisseur de croissance peut être contrôlée. Au niveau Å, il peut fournir une bonne couverture de pas. Dans cette étude, les recherches récentes sur la passivation ALD sur les microdiodes électroluminescentes et les lasers à cavité verticale à émission de surface ont été examinées et comparées. Il a été démontré que plusieurs méthodes de passivation permettent d'améliorer l'efficacité lumineuse, de réduire les fuites et d'améliorer la fiabilité.
Introduction
Le développement de la technologie de dépôt par couche atomique (ALD) a commencé dans les années 1970. En 1977, le Dr Tuomo Suntola de Finlande, a officiellement déposé le premier brevet pour la technologie ALD [1]. Entre 1983 et 1998, la technologie ALD a été appliquée à la production d'affichages électroniques à l'aéroport d'Helsinki en Finlande. À la fin des années 90, en raison de l'introduction du procédé ALD dans l'industrie des semi-conducteurs, des fonds et une main-d'œuvre considérables en recherche et développement ont été investis, ce qui a contribué de manière significative à la croissance rapide de la technologie des procédés ALD. En 2007, Intel a utilisé la technologie du procédé ALD pour produire du dioxyde d'hafnium (HfO2 ) couche de passivation de grille, qui a été appliquée à un transistor à effet de demi-champ à oxyde métallique sur un microprocesseur de 45 nm, consolidant ainsi l'importance de la technologie des procédés ALD dans l'industrie des semi-conducteurs [2].
L'ALD est basée sur des réactions chimiques de surface [3] et se caractérise par une excellente précision d'épaisseur au niveau atomique, une grande uniformité et une conformité du film sur la structure avec un rapport d'aspect élevé. Contrairement au dépôt chimique en phase vapeur (CVD) traditionnel ou au dépôt physique en phase vapeur (PVD), comme le montre la figure 1, le procédé ALD utilise généralement deux précurseurs chimiques différents. Ceux-ci sont passés dans la chambre de réaction à des moments différents pour former deux réactions en demi-cycle, et toutes les réactions chimiques sont confinées à la surface par chimisorption. Ces deux réactions en demi-cycle, qui constituent un cycle ALD facilitant le dépôt d'un film monocouche, peuvent être répétées couche par couche pour faire croître le film. Ces réactions chimiques de surface se produisent dans les conditions d'une réaction auto-limitée, qui est la fenêtre du processus ALD. L'utilisation de deux réactions en demi-cycle pour déposer le film évite la présence simultanée de deux précurseurs chimiques dans la chambre de réaction, et un mode de dépôt tel que CVD est formé, permettant à la technologie ALD de contrôler avec précision l'épaisseur et l'uniformité du film [4, 5,6,7].

Représentation schématique de l'ALD thermique et assistée par plasma
Le taux de croissance des films ALD est exprimé par la croissance par cycle (GPC) [8, 9]. En général, le GPC a une épaisseur de 0,05 à 0,1 nm. Le choix des précurseurs chimiques affecte la qualité du film, sa vitesse de croissance et le temps nécessaire au processus. La procédure de dépôt ALD se compose de quatre étapes séquentielles :impulsion A, propre A, impulsion B et propre B. L'impulsion A se compose de vapeurs précurseurs métalliques et l'impulsion B se compose de vapeurs précurseurs non métalliques. Des gaz inactifs tels que l'azote ou l'argon et des pompes à vide sont utilisés pour nettoyer les sous-produits de réaction gazeux et les molécules réactives résiduelles de l'espace de réaction pendant le nettoyage A et le nettoyage B. La séquence de dépôt comprend au moins un cycle de dépôt. Le cycle de dépôt est répété jusqu'à ce que la séquence de dépôt ait produit un film d'épaisseur désirée.
La réaction d'autolimitation forme le noyau de l'ALD [10,11,12,13]. Le réglage et l'ajustement des paramètres du procédé (tels que la température du procédé, la sélection du précurseur chimique, le dosage, etc.) pour permettre à la réaction chimique de surface d'atteindre la condition d'autolimitation est la première étape du développement du procédé ALD. Dans le cas du respect de la fenêtre du processus ALD, toutes les réactions chimiques se produisent à la surface, satisfaisant les conditions d'autolimitation. Par conséquent, si suffisamment de molécules précurseurs chimiques sont introduites dans chaque cycle ALD, la quantité totale de précurseurs chimiques participant à la réaction chimique de surface dépend du nombre de groupes réactifs en surface. Si la température du processus est contrôlée à un niveau où les molécules précurseurs chimiques ne sont pas dans la plage d'adsorption physique et de craquage thermique automatique, une couche atomique peut être déposée uniformément sur toutes les surfaces du substrat dans chaque cycle ALD. Par conséquent, la technologie ALD a une excellente uniformité et capacité de conformation et peut réduire l'épaisseur du film. La précision du contrôle est un facteur clé au niveau atomique [14,15,16,17].
L'application la plus importante de l'ALD se situe dans le domaine des semi-conducteurs [18,19,20,21,22], tels que la préparation de diélectriques à k élevé, de films métalliques minces, de films barrières en cuivre et de couches d'arrêt de gravure pour le champ d'ailettes. transistors à effet (FinFET) [23,24,25,26,27,28], couches de passivation d'oxyde et couches antireflet pour LED et VCSEL. La couverture très uniforme et les caractéristiques de film haute densité de l'ALD le rendent adapté aux appareils sensibles à l'eau et à l'oxygène. Par conséquent, ALD est devenu le meilleur outil de revêtement pour les couches protectrices des appareils nécessitant une grande fiabilité. Le taux de transmission de la vapeur d'eau (WVTR) est un indicateur important pour mesurer la résistance du film à l'eau et à l'oxygène, en particulier pour les écrans à diodes électroluminescentes organiques (OLED) flexibles, sensibles à la vapeur d'eau [29,30,31, 32,33,34,35,36,37]. Sa valeur doit atteindre 10 −4 g/m 2 -jour ou moins. Pour les autres VCSEL haute puissance, dispositifs d'alimentation et LED haut de gamme, leur WVTR doit être au moins inférieur à 10 −3 g/m 2 -jour pour assurer la fiabilité dans les environnements difficiles. Par conséquent, ces dispositifs ont commencé à utiliser la passivation ALD pour assurer sa stabilité [38,39,40,41,42,43,44]. En plus des applications mentionnées ci-dessus, les dispositifs photovoltaïques [45,46,47], les batteries au lithium [48,49,50], les piles à combustible et les systèmes micro-électromécaniques (MEMS) utilisent également de nombreux procédés ALD [6, 51, 52,53]. Dans cet article, nous nous concentrons sur les effets des technologies ALD sur les performances des appareils et examinons le cas des VCSEL. De plus, cet article fournit un aperçu des processus ALD pour améliorer les performances des VCSEL.
Technologies ALD pour les micro-LED
La LED bleu-vert est principalement composée de matériaux à base d'InGaN. De par sa structure cristalline, il s'agit d'un matériau piézoélectrique. Il possède un champ électrique intégré puissant, qui affecte la longueur d'onde d'émission et l'efficacité de recombinaison des porteurs de la zone active. Ce phénomène est appelé effet Stark confiné quantique (QCSE), qui est l'une des principales raisons de l'efficacité lumineuse des LED [54]. Par conséquent, l'équipe de recherche a utilisé les caractéristiques du QCSE via une nanostructure en forme d'anneau sur une plaquette épitaxiale verte. La fabrication de la structure libère la contrainte dans la zone active de la LED pour obtenir une modulation de longueur d'onde. Il module la longueur d'onde d'émission du vert au bleu car la nanostructure sacrifie une partie de la zone lumineuse et réduit l'intensité lumineuse [55]. La figure 2 montre un schéma de la micro-LED (μ-LED). À mesure que la taille de la μ-LED diminue, les défauts de paroi latérale ont un impact plus important sur la plaquette, entraînant une diminution de l'efficacité lumineuse de la puce [56,57,58]. La passivation dans les micro-LED est généralement réalisée à l'aide d'un dépôt chimique en phase vapeur assisté par plasma (PECVD), qui utilise des précurseurs à base d'hydrogène pour obtenir des taux de dépôt rapides [30, 32]. L'ALD est préférable pour les LED de petite taille. En comparaison avec les couches de passivation déposées par PECVD, l'ALD est capable de déposer des films diélectriques très compacts d'épaisseur nanométrique. ALD fournit une approche prometteuse pour la passivation des -LED en offrant des films diélectriques compacts et denses ainsi qu'un meilleur contrôle de l'épaisseur du film. Par conséquent, de nombreuses équipes de recherche ont introduit la technologie de protection par passivation à couche mince ALD pour remplacer la méthode traditionnelle PECVD. F Koehler et al. ont rapporté que le PECVD standard peut déposer un film à des températures modérées (400 °C) mais souffre de forts effets de chargement. L'ALD présente l'avantage d'une bonne conformité à basse température. De plus, l'ALD montre une uniformité supérieure de plaque à plaque et à l'intérieur de la plaque [59, 60, 61]. De plus, Milojevic [38] a rapporté que l'augmentation du courant de fuite dans les petites LED μ peut être due à la qualité diélectrique du PECVD. Cette augmentation a révélé que la passivation des parois latérales PECVD était insuffisante pour réduire le courant de fuite pour les -LED avec un grand rapport périmètre/surface ; Nakamura et al. ont étudié les effets optoélectroniques de la passivation des parois latérales sur les micro-LED en utilisant ALD et PECVD, et ces résultats ont également révélé que l'ALD est plus bénéfique pour l'amélioration des effets optiques et électriques [62]. La couche de protection contre la passivation ALD a une densité élevée, une couverture de pas élevée, une réparation efficace des défauts et d'autres caractéristiques qui empêchent les porteurs d'être piégés par des défauts à la surface de l'appareil. Ainsi, l'intensité lumineuse de l'appareil augmente considérablement, entraînant une efficacité améliorée [44, 55, 60, 63,64,65,66,67].
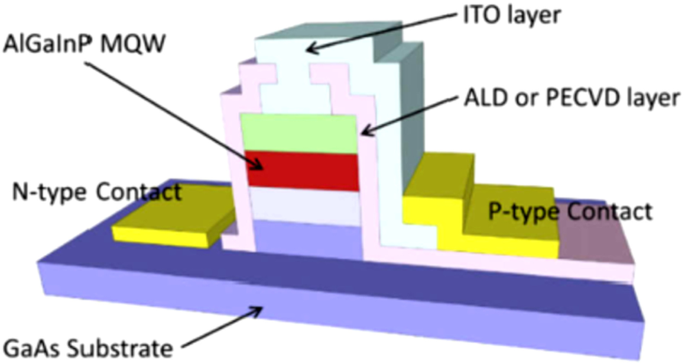
Schéma d'une μ-LED [67]
Compte tenu de l'influence de la couche de protection de passivation développée par PECVD et ALD sur le courant de fuite, la figure 3 montre les diagrammes de courant de fuite de la μ-LED rouge après protection de passivation PECVD et ALD [66,67,68]. On observe que le courant de fuite moyen du dispositif utilisant l'ALD est bien inférieur à celui obtenu avec le PECVD. En outre, le courant de fuite augmente uniformément à mesure que la taille du composant est réduite en raison de l'augmentation du rapport surface/volume des petits dispositifs et du chemin de fuite supplémentaire sous polarisation inverse.
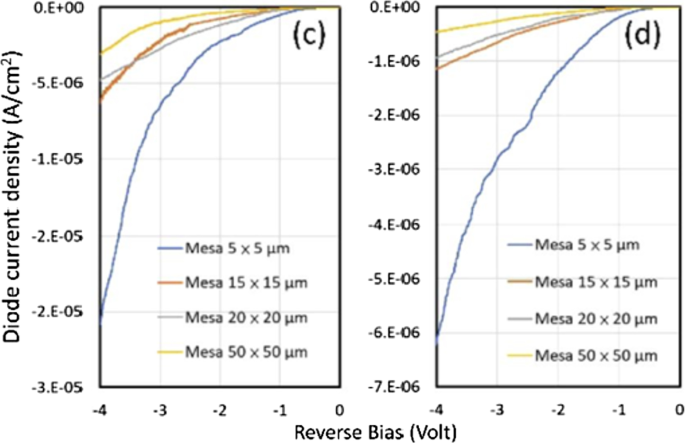
Courbes de polarisation inverse J-V de a Échantillons PECVD et b Échantillons ALD [68]
Pour illustrer l'influence de la couche de protection de passivation sur la puissance optique de la lumière rouge μ-LED, la figure 4 compare la puissance optique des couches de protection de passivation PECVD et ALD pour différentes tailles et densités de courant. On peut voir que lorsque la taille du composant est supérieure à 15 µm, la puissance optique des couches de passivation PECVD et ALD peut atteindre des niveaux satisfaisants, mais lorsque la taille du composant est inférieure à 5 µm, ALD surpasse la protection de passivation fournie par PECVD. A partir de la comparaison entre des dispositifs avec différents revêtements et différents niveaux de courant, une baisse spectaculaire en termes de puissance optique intégrée peut être observée. Sous la même densité de courant et des tailles différentes, la différence de puissance optique fournie par ALD est de 570 fois, tandis que les composants utilisant PECVD sont jusqu'à 850 fois. Cela montre que l'ALD fournit toujours une excellente passivation pour les petits composants. La couche protectrice permet la suppression continue des défauts de surface et augmente l'efficacité de recombinaison du rayonnement. De plus, la protection de passivation fournie par ALD augmente la fiabilité de l'appareil. Étant donné que le processus de gravure à sec peut provoquer des dommages et des défauts sur les parois latérales, l'impact des défauts des parois latérales peut augmenter proportionnellement lorsque la taille du dispositif est réduite, entraînant une dégradation prématurée des performances. Ainsi, la qualité de la couche de passivation est particulièrement importante. Les résultats ci-dessus démontrent qu'à mesure que la taille de l'appareil diminue, les appareils protégés par la passivation ALD fonctionnent mieux dans différentes conditions. Dans les futurs processus de fabrication avancés, la technologie ALD devrait continuer à jouer un rôle important.
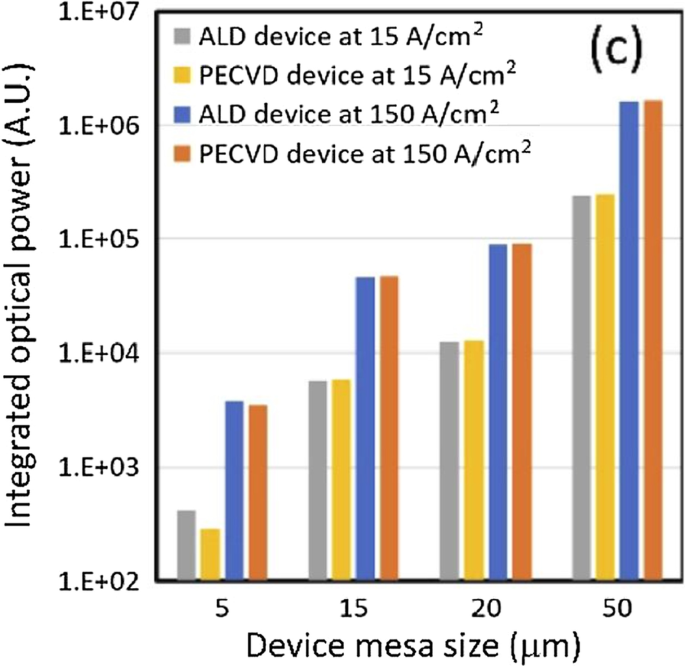
Intensité spectrale intégrée entre les échantillons ALD et PECVD sous des densités de courant élevées/faibles [68]
Compte tenu de l'influence de l'EQE, la présente étude a déterminé la présence d'une couche de passivation sur la paroi latérale et a comparé les effets des couches de passivation produites par ALD et PE-CVD sur l'EQE comme suit :LED-1 :μ-LED non soumise à la passivation des flancs; LED-2 :μ-LED soumise à la passivation de la paroi latérale de l'ALD et à une gravure plasma à couplage inductif ; LED-3 :μ-LED soumise à passivation de la paroi latérale PE-CVD et gravure HF; LED-4 :μ-LED soumise à passivation de la paroi latérale ALD et gravure HF. La figure 5a, b affiche les EQE obtenus pour 100 × 100 m 2 et 20 × 20 m 2 dispositifs, respectivement, pour illustrer les effets de différentes techniques de passivation des flancs. Tous les 100 × 100 μm 2 passivés Les μ-LED avaient un EQE de pic similaire (LED-1, 40 %; LED-2, 36 %; LED-3, 38 %; et LED-4, 41 %). En raison du faible rapport périmètre-surface, les dommages aux parois latérales ont eu peu d'effet sur les performances de l'appareil. Par conséquent, la passivation des parois latérales n'a pas affecté de manière significative les grandes LED . De plus, l'EQE est moins affecté par les dommages aux parois latérales dans le cas d'appareils plus gros et ne s'améliore pas avec la passivation des parois latérales. Pour le 100 × 100 μm 2 échantillon, quelle que soit la méthode de passivation des parois latérales utilisée, la chute de l'EQE variait bien que l'EQE maximale soit restée constante. Pour -LED d'une surface de 20 × 20 m 2 , l'EQE obtenu avec et sans passivation ALD était de 33 % et 24 %, respectivement. Ce résultat est attribué aux effets combinés de l'extraction améliorée de la lumière, de la réorganisation de la surface et de la réduction du courant de fuite causé par les dommages aux parois latérales.
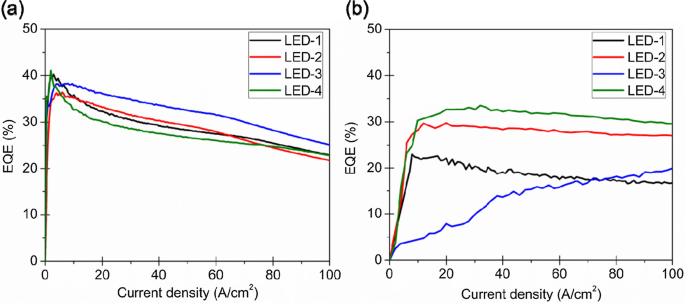
Dépendance de l'EQE sur le courant pour a 100 × 100 μm 2 et b 20 × 20 μm 2 appareils avec différentes méthodes de passivation des parois latérales [63]
Par conséquent, la technologie μ-LED a un grand potentiel pour modifier le secteur de l'éclairage à semi-conducteurs, et ce sera certainement une technologie d'affichage qui changera la donne. La passivation des parois latérales est essentielle pour maintenir la fiabilité requise pour des performances élevées avec une réduction supplémentaire de la taille de l'appareil. En général, l'ALD est une technique clé pour effectuer la passivation des parois latérales afin d'éviter une baisse de l'efficacité des -LED, car leur taille caractéristique est réduite à l'échelle microscopique en raison du courant de fuite [69].
Technologies ALD pour VCSEL
Les VCSEL à oxyde présentent de nombreux avantages, tels qu'une meilleure stabilité modale et une faible gigue pour les applications de transmission de données, ainsi qu'un faible coût dans les boîtiers émetteurs-récepteurs non hermétiques. Cependant, en raison de la densité de puissance élevée du laser, l'oxyde VCSEL nécessite également des méthodes plus protectrices pour empêcher la mutation des caractéristiques du laser.
Le VCSEL se compose de trois parties :le réflecteur de Bragg à distribution supérieure (p-DBR), la cavité et le n-DBR inférieur. Le DBR se compose de 20 à 40 paires de films minces. La cavité a généralement une épaisseur de plusieurs microns. Par rapport à la longueur de gain de l'émetteur latéral, la longueur de gain de la couche active du VCSEL est très faible (quelques dizaines de nanomètres). Pour obtenir l'émission stimulée de rayonnement lumineux, le DBR doit avoir une réflectivité très élevée pour qu'une émission stimulée de rayonnement lumineux se produise. Pour améliorer les caractéristiques des VCSEL, l'ALD a été appliqué pour préparer la couche de passivation, le DBR, les puits quantiques multiples (MQW) et même les électrodes transparentes des VCSEL.
Technologies ALD pour la couche de passivation des VCSEL
ALD a été appliqué pour l'amélioration de la fiabilité des points quantiques et LCD [31, 32, 70, 71], pour la couche de passivation de VCSEL, le film mince de revêtement uniforme et dense d'ALD peut améliorer sa fiabilité. L'insertion du film dense en tant que couche de passivation d'oxyde pour les VCSEL est très importante pour protéger la cavité du VCSEL. Auparavant, les films protecteurs étaient généralement plaqués à l'aide de PECVD. Cependant, un film épais est généralement nécessaire pour maintenir la compacité du film, ce qui provoque une contrainte excessive et affecte la fiabilité des VCSEL. La technologie ALD peut déposer de l'Al2 O3 des films minces avec des caractéristiques similaires à celles de la couche de passivation des VCSEL, et le film mince de revêtement uniforme et dense peut isoler complètement la puce de protection. Ainsi, l'ALD a été utilisé pour remplacer le PECVD en tant que meilleur procédé de revêtement pour les couches de passivation des VCSEL.
La fiabilité des VCSEL d'oxyde était très élevée dans le test 85/85 (85 °C et 85 % d'humidité relative, RH) en raison de la couche d'oxydation d'AlGaAs avec une concentration en Al plus élevée par rapport aux couches DBR. Une ouverture d'oxyde d'Al plus élevée a conduit à un délaminage par corrosion à l'interface oxyde-semi-conducteur. Xie et al. ont montré que la croissance des dislocations, la fissuration grossière et la dégradation de la surface des ouvertures se produisaient dans un pourcentage significatif de VCSEL d'oxyde exposés à l'humidité [72]. Herrick et al. ont également observé des défaillances similaires résultant de l'exposition à l'humidité dans une chambre 85/85 [73]. Au cours des vingt dernières années, de nombreux chercheurs et entreprises ont investi dans la recherche sur la prévention du vieillissement des éléments VCSEL causé par la pénétration d'humidité et ont proposé une large gamme de changements de conception de film passif et de mise en page de protection. Par exemple, en 2004, Agilent Technologies a proposé un trou de gravure et un remplissage dans le polymère pour éviter l'exposition à l'humidité [74]. En 2006, Debrabander a proposé la méthode de détection des trous d'épingle du film de passivation mesa [75], tandis qu'en 2014, TrueLight a proposé le film de passivation SiON [76]. Ici, nous ne citons que quelques études à titre d'exemples. Cette étude a principalement utilisé Al2 O3 films développés par ALD et formant un complexe empilé pour des films de passivation résistants à l'humidité avec du SiNx développé par PECVD . Nous avons conçu l'expérience et mené une étude comparative pour montrer l'amélioration de l'échec du test 85/85 avec la couche ALD, et les couches diélectriques résistantes à l'humidité de la structure VCSEL déposées par PECVD et ALD ont été désignées comme dispositif A et dispositif B, respectivement .
La figure 6 montre la structure du VCSEL, y compris le DBR de type n, les couches MQW, une couche d'ouverture d'oxyde AlGaAs à haute teneur en Al (~ 0,98) et des couches DBR de type p. La description suivante concerne les étiquettes. Les couches de passivation résistantes à l'humidité n'ont été déposées par ALD sur la paroi latérale du dispositif B qu'après oxydation.
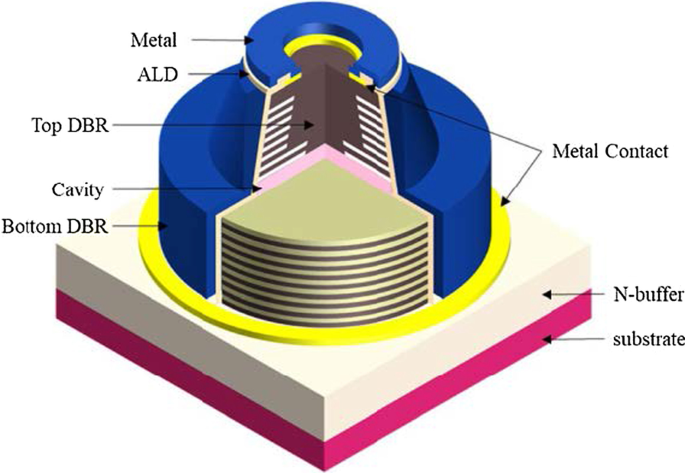
Schéma du VCSEL [42]
Le tableau 1 montre la comparaison des VCSEL dans ce travail et dans d'autres groupes. Dans ce travail, le LIV, S 21, le diagramme de l'œil et la durée de vie en fonctionnement humide à haute température (WHTOL) des VCSEL avec et sans ALD ont été étudiés, et ces résultats montrent que l'ALD n'a pas affecté les propriétés photoélectriques et de communication des hautes fréquences. accélèrent les VCSEL, mais améliorent la fiabilité des VCSEL à grande vitesse.
Comme le montre la Fig. 7, la transmission sans erreur de 53 Gb/s jusqu'à 100 m dans la fibre monomode (SMF) GI sous préaccentuation de la modulation NRZ-OOK est obtenue avec le diamètre de 6 μm de l'ouverture d'oxyde dans les quelques -mode (FM) VCSEL. Dans ce travail, la technique de l'ALD a été utilisée pour améliorer la fiabilité du FM VCSEL.

Diagrammes oculaires de 53 Gb/s de transmission sans erreur jusqu'à 100 m avec le diamètre d'ouverture d'oxyde de 6 μm dans le VCSEL après ALD
Les performances CC, CA et de transmission du dispositif B sont démontrées. La figure 8a, b montre la courbe de courant lumineux (L-I) et la réponse de modulation en petits signaux du dispositif B à 25 °C. La figure 9 illustre le diagramme de l'œil à modulation d'amplitude d'impulsion à 4 niveaux (PAM4) à 56 Gb/s sous un biais de I = 8 mA à 25 °C. La figure 10a, b montre le diagramme de l'œil d'activation/désactivation (OOK) à 28 Gb/s sous un biais de I = 8 mA de l'appareil B à 25 °C et 75 °C.
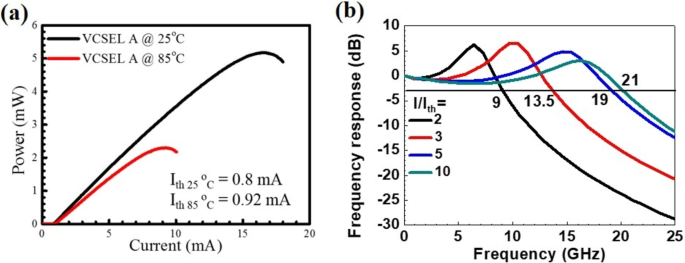
un Caractéristiques du courant lumineux d'un VCSEL 850 nm à 25 °C et 85 °C, b réponse de modulation à petit signal pour l'appareil B à 25 °C

Diagramme oculaire du signal PAM4 transmis par le VCSEL 850 nm à 56 Gb/s sous un biais de I = 8 mA à 56 Gb/s à 25 °C
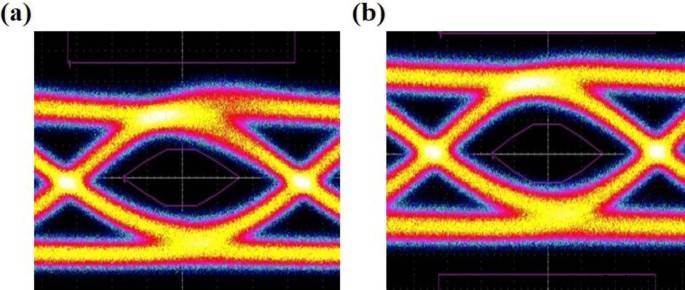
Diagramme oculaire du signal OOK transmis par le VCSEL 850 nm à 28 Gb/s sous un biais de I = 8 mA à a 25 °C et b 75 °C
Etudier l'amélioration de la résistance à l'humidité par passivation de l'Al2 O3 Couche ALD, deux dispositifs recouverts de couches diélectriques ont été définis. Dans le dispositif A, la couche diélectrique ne revêtait que du SiNx , tandis que dans l'appareil B, il a enduit Al2 O3 ALD et SiNx ensemble. SiNx , polyimide, SiNx , et la métallisation ont été achevées en séquence. Le premier métal p a formé un contact ohmique avec le matériau supérieur GaAs. Le 2ème p-métal est un métal de plot de connexion. Les films de passivation empilés complexes couvraient efficacement la surface de la mesa dans le dispositif B. L'ensemble des appareils vieillissants a été préparé en bidon ouvert TO.
Les conditions environnementales de vieillissement étaient de 85 °C et 85 % d'humidité relative, avec un biais de 6 mA pour la durée de vie en fonctionnement humide à haute température (WHTOL). Les quantités d'entrée pour les dispositifs A et B étaient de 18 et 18, respectivement. Les résultats sont présentés sur la figure 11. Dans l'appareil A, il y avait cinq puces défaillantes et des défaillances ont été trouvées de manière aléatoire dans les 500 h. Contrairement à l'appareil B, aucune panne ne s'est produite avant 960 h. Les résultats sont présentés dans la Fig. 11a, b. Ces résultats indiquent que l'Al2 cultivé par ALD O3 Le film ALD a une meilleure encapsulation sur la paroi latérale du mesa que seul le SiNx cultivé par PECVD film pour empêcher la pénétration d'humidité.
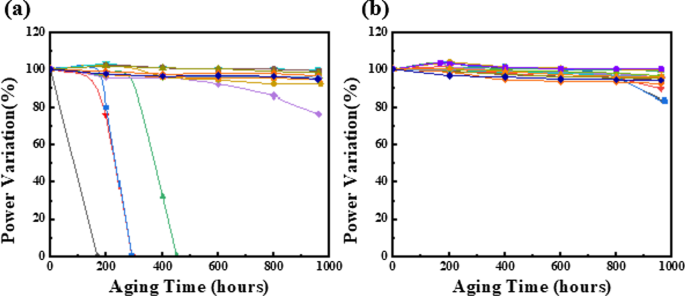
Performances WHTOL (85 °C/85 % d'humidité) des puces VCSEL, a appareil A, uniquement SiNx comme couche de passivation, b appareil B, Al2 O3 /SiNx comme couches de passivation
Technologies ALD pour le DBR de VCSEL
Le dépôt DBR de VCSEL par ALD présente l'avantage d'une bonne adhérence avec substrat saphir et d'un bon état à l'interface des différentes couches diélectriques de DBR [80]. Selon la structure du VCSEL, la cavité dans la direction verticale du laser est formée par deux groupes de miroirs enserrant la couche active, et la lumière est réfléchie entre le p-DBR et le n-DBR plusieurs fois avant de se propager dans l'air . La structure du DBR se compose de deux types de matériaux semi-conducteurs avec des indices de réfraction différents, et l'épaisseur périodique du DBR doit être contrôlée avec précision à /4 (λ désigne la longueur d'onde centrale). Les méthodes de conception et de croissance constituent la base de la fabrication de DBR à haute réflectivité. Pour un DBR de haute qualité, l'effet d'interférence de phase aide à renforcer la lumière dans la cavité, tandis que la réflectivité élevée du DBR (> 99 %) peut grandement améliorer le gain de seuil et l'efficacité quantique des VCSEL. Pour obtenir une réflectivité élevée, une large bande d'arrêt et une réponse en phase douce, les périodes du DBR doivent se situer entre 20 et 40, et les matériaux utilisés dans sa fabrication doivent avoir une grande différence d'indice de réfraction. Dans ce cas, de nombreux groupes ont signalé que les AIA/GaAs, Al2 O3 , HfO2 , SiO2 , etc., sont adaptés à la croissance de DBR.
Il existe diverses méthodes de croissance pour le DBR, y compris l'épitaxie par faisceau moléculaire (MBE) et le dépôt métal-organique en phase vapeur (MOCVD). Cependant, l'ALD est également une méthode de croissance précise pour le DBR. Pour que le DBR préparé par ALD avec une faible épaisseur, une réflectivité élevée et une faible rugosité puisse améliorer efficacement les propriétés des VCSEL, de nombreux chercheurs ont étudié des techniques pour améliorer le DBR à l'aide des techniques ALD. Par exemple, en 1997, Huffaker [81] a proposé que la contrainte due au DBR inférieur puisse être réduite en utilisant Alx O1-x couches dont l'épaisseur était inférieure à celle d'un quart d'onde. En 2013, Guo et al. [82] ont rapporté que le DBR fabriqué par le processus ALD s'est avéré avoir une meilleure qualité que celui fabriqué par EBE, et que le temps de processus ALD est presque le même que le processus EBE ou même moins. De plus, pour faire croître un DBR composé d'au moins deux types de matériaux ou plus, il est généralement nécessaire d'élever et d'abaisser fréquemment la température dans le procédé EBE, alors que la température peut être maintenue identique dans le procédé ALD pour déposer différents matériaux. En 2017, Liu [83] a signalé que la méthode ALD pouvait être appliquée pour préparer des couches de haute qualité avec une interface nette et une bonne uniformité. Ainsi, ALD convient au dépôt de DBR de haute qualité.
Par exemple, Sakai et al. ont proposé la fabrication sur plaquette de diodes laser UV-C à miroir gravé (LD) avec un DBR déposé par ALD, qui contribuent à réduire la densité de courant de seuil laser. Dans cette étude, quatre périodes de HfO2 et Al2 O3 ont été déposés en utilisant ALD pour le DBR. Al2 O3 a été sélectionné comme matériau à indice de réfraction inférieur car son taux de dépôt est remarquablement supérieur à celui de SiO2 . La figure 12 montre l'image TEM du DBR déposé par ALD, qui montre l'excellente épaisseur et la qualité du DBR.
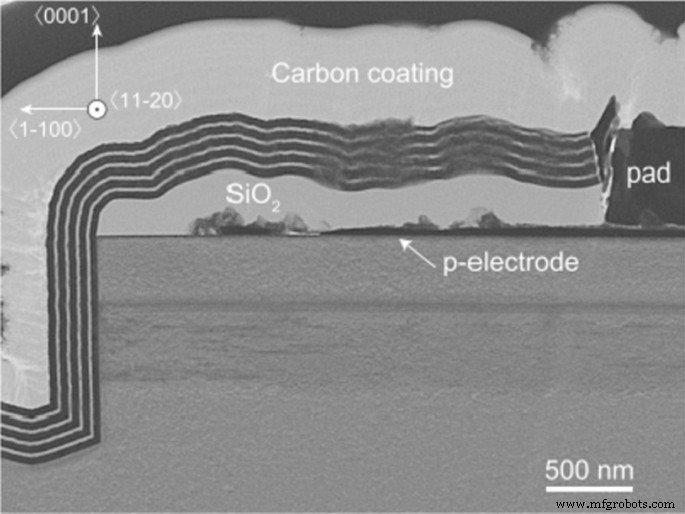
Image MET du DBR déposé à l'ALD [84]
La technique de MOCVD a été largement utilisée dans le dépôt de DBR pour de nombreux avantages tels que le contrôle précis de la croissance du film et le dépôt de film de haute qualité. Cependant, dans le processus de production réel, la condition d'interface sera affectée à l'interface de différentes couches diélectriques de DBR ; sinon, la méthode de conception du DBR nécessiterait une optimisation complexe telle que le dépôt d'une autre couche tampon supplémentaire à l'interface de différentes couches diélectriques. La figure 13a montre le calcul de la méthode de la matrice de transfert (TMM) pour la réflectivité du DBR avec MOCVD sans insertion de couche tampon. Les spectres de réflectivité du HfO2 /Al2 O3 Les DBR déposés auprès d'ALD sont plus cohérents avec le spectre TMM calculé sur la figure 13b [85]. Dans ce cas, la technique de l'ALD peut déposer du DBR avec une meilleure interface entre les différentes couches diélectriques par rapport au MOCVD (Fig. 14).
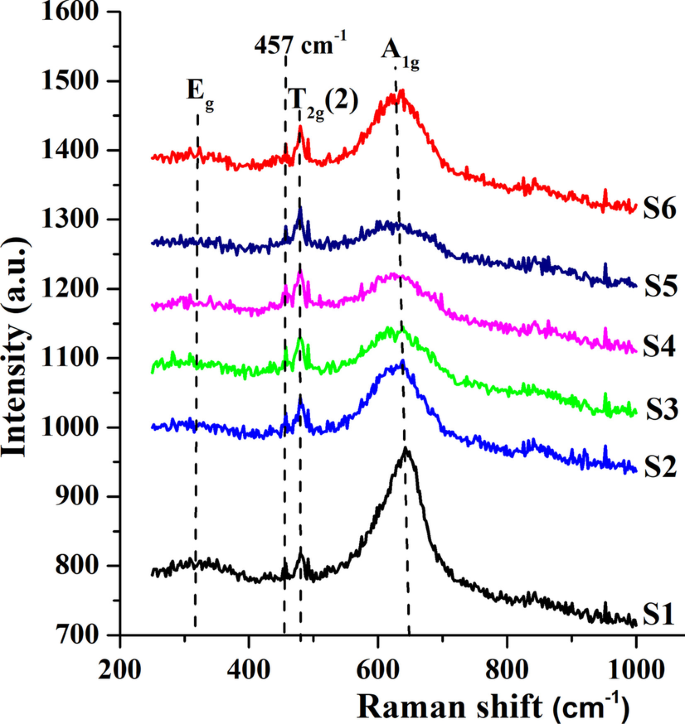
Spectres de réflectance mesurés et calculés du DBR conçu déposé auprès de a MOCVD, b ALD [84, 85]
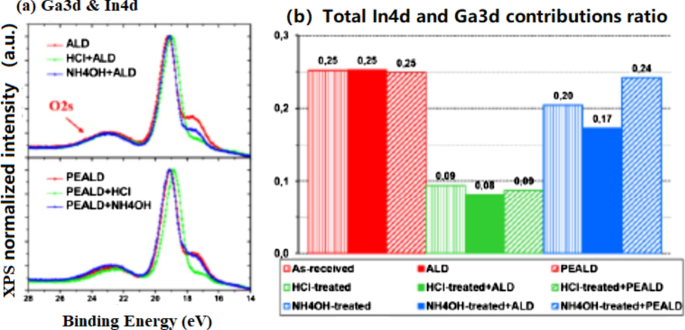
un Superposition des spectres Ga3d-In4d normalisés pour les échantillons ALD et PEALD sans, avec HCl ou avec NH4 Traitement de surface OH, b Rapports Ga3d-In4d pour les mêmes échantillons en comparaison avec Al2 O3 surfaces libres [86]
Technologies ALD pour les puits quantiques multiples des VCSEL
Owing to the high requirement for optical gain in VCSELs, most devices use MQWs as the active region. In general, when the MQW period increases to a certain value, the threshold current density of the VCSEL is mainly caused by the following three factors. First, for the width of the quantum well, the active region cannot overlap with the peak position of the waveform. The farther the quantum well from the peak position, the lower is its gain efficiency. Therefore, distant quantum well regions cannot play a significant role in improving the optical gain. Second, there is a direct proportional relationship between the total transmittance current and period of MQWs. The total transmittance current increases with the MQW period because the transmittance current is a part of the threshold current of the device. Therefore, the threshold current of the device will increase with the transmittance current. Third, as the current increases, the slope of the optical gain to current curve will decrease, increasing the threshold current of the device. Hence, thin MQWs with high crystalline quality and optical properties are promising candidates for realizing VCSELs.
For the MQWs of VCSEL, ALD can optimize the interface properties and surface recombination of MQWs [80, 83,84,85]. In the last several decades, methods for optimizing MQWs using ALD have been studied. In 2008, Lo et al. reported the successful growth of high-quality ultraviolet (UV) AlGaN/GaN MQWs structures using ALD [87]. In the same year, Bosund et al. [88] proposed that a thick TiN passivation layer deposited by ALD on top of InGaAs/GaAs can significantly increase the photoluminescence intensity and carrier lifetime of the MQWs, while Li et al. reported that a low dislocation density ultraviolet (UV) AlGaN/GaN MQW structure can be grown using the ALD technique. In 2019, Lee et al. [89] proposed that the emission intensity of the 860 nm GaAs VCSEL with SiN anti-reflection film was significantly increased (compared to the VCSEL without the SiN anti-reflection film) to improve the light extraction efficiency of a VCSEL. Here, we cite a few studies as examples.
A deep understanding of semiconductor–dielectric interface properties will provide guidelines for optimizing efficient passivation solutions for InGaN/GaN-based µ-LEDs. To this end, quantum well (QW) semiconductors are of tremendous interest because many surface recombinations are likely to occur at the edges of the LED active regions and are probably responsible for the low µ-LED efficiencies. Thus, Le Maoult et al. [86] studied the X-ray photoemission (XPS) and wavelength dispersive X-ray fluorescence (WDXRF) characteristics of In0.1 Ga0.9 N surfaces after acid, base, or sulfur-based chemical treatments followed by ALD of Al2 O3 thin films with TMA/H2 O or TMA/O2 plasma (plasma-enhanced ALD) at 250 °C.
The ALD of Al2 O3 with H2 O as a weak oxidizer does not seem to significantly modify the InGaN surface. Indium depletion occurs as the In4d intensity decreases, as observed previously in the case of the HCI or NH4 OH-treated surfaces only (upper portion of Fig. 15a, b). On the contrary, during the PEALD of A12 O3 (strong oxidizer), the NH4 OH-treated surfaces changed compared to HCl because the In4d component level is indistinguishable from the PEALD reference (as illustrated by Fig. 15a, bottom, and 15b). Then, if indium is assumed to be the main species sensitive to plasma-induced oxidation, the indium-depleted surfaces after HCI treatment would indeed remain in a stable state of oxidation regardless of the ALD or PEALD process. On the contrary, a higher proportion of indium from the NH4 OH-treated surfaces is more likely to be oxidized by the plasma species.
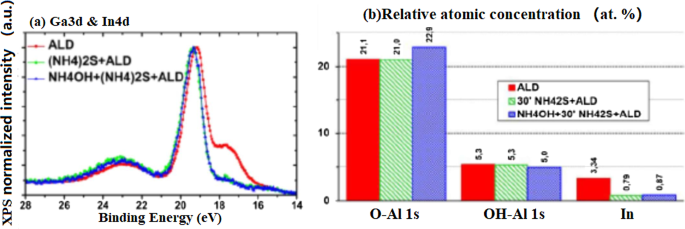
un Superposition of normalized Ga3d-In4d spectra for ALD and PEALD samples without, with a 30’ (NH4 )2 S or with a NH4 OH + 30’ (NH4 )2 S surface treatment, b proportion of O1s components and total indium contribution using In4d line [86]
If a 30' (NH4 )2 S surface treatment with or without prior treatment with NH4 OH is performed before ALD, the quantitative analysis seems to report (Fig. 15b) results similar to those observed previously without the alumina layer. As an example, a similar decrease in the indium proportion was observed (~ 75%). However, a slight increase in the O–Al-related component from the O1s line was observed for the sample that underwent the double surface treatment, probably owing to the increased surface hydrolysis by the first NH4 OH treatment. Thus, ALD does not seem to significantly modify the initial state of the (NH)S-treated surfaces. However, these results do not provide quantitative information regarding the proportion of sulfur after the deposition of Al2 O3 by ALD. Considering that sulfur was adsorbed on InGaN before deposition, further investigations are required to determine the evolution of sulfur bonds after ALD of Al2 O3 , especially if binding state differences with stronger oxidizing processes such as PEALD are evident.
ALD Technologies for the Transparent Electrode of VCSEL
For the transparent electrode of VCSEL, ALD can deposit the electrode with high transparency and good current spreading properties [90]. In terms of the current spreading of the conventional VCSEL, the metal electrode has good current spreading properties, but strongly absorbs the emitted light. Hence, the conventional VCSEL relies on the upper heavily-doped layer for current spreading. However, since the upper heavily-doped layer has poor current spreading performance and absorbs part of the emitted light, the light output power of the device is lowered. Therefore, a transparent conductive oxide (TCO) film deposited by ALD, exhibiting excellent photoelectric performance, can solve the current spreading problem described above.
Figure 16 shows the SEM images of ZnO films deposited on Si with ALD and CVD modes as the transparent conductive materials, which can be applied to new-generation photovoltaic devices. So far, there are few studies and reports on the application of TCO films in VCSEL devices. At present, the indium tin oxide (ITO) films are used in VCSEL devices. In 1997, C. L. Chua et al. [91] first reported the top-emitted VCSEL with a transparent tin oxide electrode. In this study, the peak transmittance of ITO is 96%. In 2002, Jiang et al. [92] studied the P-type ohmic contact of ITO as an 850 nm GaAs-based oxide restricted type VCSEL. In comparison with VCSELs with traditional Ti/Au contact, they found output power of the VCSEL with ITO contact is 1.27 times higher than the VCSEL with T/Au contact. In 2014, Meng et al. [93] found that the output power of the 850 nm GaAs oxide-confined VCSEL with an ITO transparent conductive film is 1.18 times higher than the traditional VCSEL.
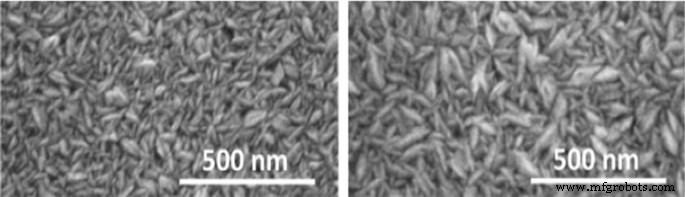
SEM images of ZnO films deposited on Si using ALD and CVD [90]
At present, the commonly used techniques for preparing TCO are magnetron sputtering, pulsed laser deposition, CVD, ALD, etc. However, it is difficult to achieve large-scale and large-area film formation using magnetron sputtering, the film deposited by pulsed laser deposition is uniform, and it is difficult to prepare large-area films while the deposition temperature for CVD is high, which renders it unsuitable for some devices that need to be prepared at low temperature. ALD possesses the advantage of highly controllable deposition parameters and the film deposited by it is characterized by good uniformity, absence of pinholes, and excellent shape preservation for film graphics. In this case, the oxide (TCO) film deposited by ALD can improve the properties of VCSELs.
Conclusions
This article reviews the application of ALD technology to the optoelectronic devices, µ-LEDs and VCSELs. Since sidewall damage is prominently observed in μ-LEDs when their sizes are reduced to the microscale level, this issue must be addressed to achieve high device performance. ALD sidewall passivation is a crucial technique because the sidewall damage can be reduced after passivating a surface with an ALD-grown dielectric. ALD passivation has also been found to help in protecting the quantum dot (QD) conversion layer in full-color displays. Different approaches involving the deposition of passivation layers have been established for reducing sidewall damage. In addition, an 85 °C/85% RH test with bias, which is a very difficult challenge for oxide-confined VCSEL devices, was conducted. In this study, we demonstrate that complex stacked dielectric layers as passivation films resist moisture ingress. The stacked passivation layers consist of Al2 O3 growth by ALD film and SiNx growth by PECVD film. A very good encapsulation that prevented damage from moisture and excellent reliability was observed. In addition, the effects of ALD on the accurate control of DBR growth are specified. This technique has also been found to enhance the optical properties of MQWs, such as the deposition of an anti-reflection layer for improving the light extraction efficiency of a VCSEL and the accurate control of the growth of MQWs for improving its crystalline quality. In addition, because the output power of the VCSEL with an ITO transparent conductive film exceeds that of the traditional VCSEL, this study addresses the potential applications of ALD for preparing the TCO films of VCSELs.
Disponibilité des données et des matériaux
The data used and analyzed during the current study are available from the corresponding authors upon reasonable request.
Abréviations
- PECVD:
-
Plasma-enhanced chemical vapor deposition
- ALD:
-
Atomic layer deposition
- LED:
-
Light emitting diode
- VCSEL:
-
Vertical cavity surface emitting laser
- CVD:
-
Chemical vapor deposition
- PVD:
-
Physical vapor deposition
- GPC:
-
Growth per cycle
- HKMG:
-
High-K metal gate
- FinFET:
-
Fin field-effect transistor
- WVTR:
-
Water vapor transmission rate
- OLED:
-
Organic light-emitting diode
- MEMS:
-
Micro-electro mechanical systems
- μLED:
-
Micro-LED
- WHTOL:
-
Wet high-temperature operation life
- OOK:
-
On–off keying
- PAM4:
-
Amplitude modulation 4-level
Nanomatériaux
- Mitsubishi Chemical Advanced Materials vise la neutralité climatique d'ici 2023 et la positivité climatique d'ici 2030
- Caractéristiques de commutation résistive bipolaire des dispositifs RRAM à structure tricouche HfO2/TiO2/HfO2 sur des substrats revêtus de Pt et de TiN fabriqués par dépôt de couche atomique
- Caractéristiques d'alignement interfacial, électrique et de bande des piles HfO2/Ge avec une couche intermédiaire de SiO2 formée in situ par dépôt de couche atomique amélioré par plasma
- Les nanofibres hiérarchiques antibactériennes en polyamide 6-ZnO fabriquées par dépôt de couche atomique et croissance hydrothermale
- Propriétés photocatalytiques des poudres de TiO2 revêtues de Co3O4 préparées par dépôt de couche atomique amélioré par plasma
- Réglage au niveau de Fermi des films ZnO par dépôt de couche atomique supercyclée
- Un système de refroidissement avancé pour ordinateurs et batteries
- Revêtement et dépôt de forme libre pour la fermeture du canal de liquide de refroidissement
- SIGRABOND® Chemical CFRP pour composants et assemblages



