Comportements de programmation dépendant de la tension et de la polarité de la mémoire à transistor à couche mince amorphe In–Ga–Zn–O avec un piégeage de charge de ZnO déposé sur une couche atomique Couche
Résumé
Les mémoires à transistors à couche mince (TFT) amorphes In–Ga–Zn-O (a-IGZO) suscitent de nombreux intérêts pour les futures applications système sur panneau ; cependant, ils présentent généralement une efficacité d'effacement médiocre. Dans cet article, nous étudions les comportements de programmation dépendants de la polarité de la tension d'une mémoire TFT a-IGZO avec une couche de piégeage de charge (CTL) de ZnO déposée sur une couche atomique. Les dispositifs vierges présentent des caractéristiques électriquement programmables non seulement sous des polarisations de grille positives mais également sous des polarisations de grille négatives. En particulier, ce dernier peut générer une efficacité de programmation beaucoup plus élevée que le premier. Lors de l'application d'une impulsion de polarisation de grille de +13 V/1 s, l'appareil affiche un décalage de tension de seuil (ΔVth ) de 2 V ; et le ΔVème est aussi grand que -6,5 V pour une impulsion de polarisation de grille de -13 V/1 s. Dans le cas d'une programmation 12 V/1 ms (P) et d'un effacement -12 V/10 µs (E), une fenêtre mémoire de 7,2 V peut être atteinte à 10 3 des cycles P/E. En comparant les CTLs ZnO recuits en O2 ou N2 avec celui déposé, il est conclu que la lacune en oxygène (VO Les défauts liés à ) dominent les caractéristiques de programmation bipolaire des dispositifs de mémoire TFT. Pour la programmation à une tension de grille positive, des électrons sont injectés du canal IGZO dans la couche de ZnO et préférentiellement piégés à des niveaux profonds de lacune d'oxygène ionisé unique (VO + ) et le manque d'oxygène doublement ionisé (VO 2+ ). En ce qui concerne la programmation à une tension de grille négative, les électrons sont facilement piégés à partir des lacunes d'oxygène neutres en raison des donneurs peu profonds et du tunnel de retour vers le canal. Cela conduit ainsi à un effacement très efficace par la formation de lacunes supplémentaires en oxygène ionisé avec des charges positives.
Contexte
Un transistor à couche mince (TFT) basé sur l'oxyde d'indium-gallium-zinc amorphe (a-IGZO) a été largement étudié pour l'application aux systèmes électroniques flexibles et transparents [1,2,3,4,5,6,7 ,8,9,10,11,12]. Ceci est attribué à certaines propriétés spécifiques des films a-IGZO telles qu'une bonne uniformité, une faible température de traitement, une transparence à la lumière visible et une mobilité électronique élevée [13]. En dehors de cela, des mémoires non volatiles a-IGZO TFT ont également été proposées, et sa capacité de stockage de données non volatiles étend la portée de l'utilisation du dispositif a-IGZO TFT. En tant qu'architecture typique des dispositifs de mémoire non volatile, une mémoire TFT a-IGZO à grille flottante a été intensivement étudiée ces dernières années. Jusqu'à présent, divers matériaux ont été explorés en tant que grille flottante (c'est-à-dire support de stockage de charge), tels que les diélectriques [14, 15], les nanocristaux métalliques [16, 17] et les matériaux semi-conducteurs [18,19,20,21] . Étant donné que l'a-IGZO est un semi-conducteur naturel de type n et que l'inversion des trous est difficilement réalisée dans un a-IGZO TFT sous une polarisation de grille négative, par conséquent, les mémoires a-IGZO TFT ont généralement une faible efficacité d'effacement. En d'autres termes, la plupart des mémoires TFT a-IGZO ne peuvent pas être effacées électriquement par injection de trous à partir du canal [14,15,16]. Néanmoins, Zhang et al. [21] ont fabriqué une mémoire TFT utilisant a-IGZO à la fois comme couche de piégeage de charge (CTL) et comme couche de canal, qui présentait des caractéristiques électriquement programmables et effaçables, ainsi qu'une bonne rétention des données. Pendant ce temps, Yun et al. a également étudié les caractéristiques des mémoires TFT a-IGZO avec différentes compositions IGZO CTL, révélant une fenêtre mémoire décroissante avec l'augmentation du O2 pression partielle (PO2 ) lors du dépôt par pulvérisation du CTL [18]. De plus, Bak et al. ont rapporté les performances des mémoires TFT a-IGZO avec diverses conductivités CTL ZnO et en ont déduit que la nature électronique optimisée de la structure de bande interdite pour les CTL ZnO pourrait être l'un des facteurs les plus importants pour réaliser des mémoires TFT à oxyde hautement fonctionnelles [20]. Bien que les mémoires TFT a-IGZO à base de CTL à semi-conducteur d'oxyde susmentionnées présentent des vitesses de programmation/d'effacement électriques supérieures, les caractéristiques de programmation bipolaire des dispositifs susmentionnés n'ont pas été rapportées, et les processus de capture correspondants de différentes charges dans le CTL de semi-conducteur d'oxyde ne sont pas clair encore, en particulier pour le piégeage des charges positives.
Dans ce travail, une mémoire TFT a-IGZO programmable bipolaire a été fabriquée en utilisant un film de ZnO déposé sur une couche atomique comme CTL. En comparant les caractéristiques de programmation bipolaire des dispositifs de mémoire TFT avec celles déposées, O2 - ou N2 -CTL de ZnO recuit, les processus de capture de différentes charges dans la couche de ZnO ont été discutés. Il est révélé que les défauts liés au manque d'oxygène dominent les caractéristiques de programmation bipolaire des dispositifs de mémoire TFT a-IGZO.
Méthodes
Des plaquettes de Si (100) de type P avec une résistivité de 0,001 à 0,005 Ω cm ont été nettoyées à l'aide du processus de nettoyage RCA standard et utilisées comme porte arrière de l'appareil. Ensuite, 35 nm Al2 O3 et des films de 20 nm de ZnO ont été déposés successivement par dépôt de couche atomique (ALD) à 250 °C et 200 °C, qui ont servi respectivement de couche de blocage et de CTL de la mémoire TFT. Il convient de mentionner que le film de ZnO a une rugosité quadratique moyenne (RMS) de 0,553 nm. Par la suite, une photolithographie et une gravure humide ont été effectuées pour définir le CTL de ZnO. Après cela, un Al2 8 nm O3 La couche tunnel a été développée par ALD. Les précurseurs du diéthylzinc (DEZ)/H2 O et TMA/H2 O ont été utilisés pour la croissance de ZnO et Al2 O3 films, respectivement. Par la suite, un film a-IGZO de 40 nm a été déposé par pulvérisation cathodique magnétron radiofréquence en tant que couche de canal à température ambiante en utilisant un InGaZnO4 cibler. Le canal actif d'une largeur (W)/longueur (L) de 100/10 µm a ensuite été défini par photolithographie et gravure HCl dilué. Les contacts source et drain de Ti/Au (30 nm/70 nm) ont été formés par évaporation par faisceau électronique suivie d'un processus de décollage. Enfin, tous les appareils fabriqués ont été recuits à 250 °C dans O2 pendant 5 min pour améliorer ses performances. Les caractérisations électriques ont été réalisées en utilisant un analyseur de paramètres à semi-conducteur (Agilent B1500A) à température ambiante. La tension de seuil (Vth ) est défini comme la tension de grille à laquelle le courant de drain est égal à W/L×10 −9 A. La concentration de porteurs de films de ZnO a été extraite des mesures de l'effet Hall (Ecopia HMS-3000) à température ambiante.
Résultats et discussion
La figure 1 montre les diagrammes schématiques du dispositif de mémoire TFT a-IGZO fabriqué sous programmation de polarisation positive et négative, respectivement. Pendant la programmation électrique, une impulsion électrique est appliquée sur la grille arrière et les électrodes de source et de drain sont mises à la terre. La figure 2 montre les caractéristiques de programmation des dispositifs de mémoire vierges dans différentes conditions. Pour le périphérique de mémoire vierge, il présente un rapport de courant marche/arrêt (I sur /Je désactivé ) de 1,5 × 10 7 , mobilité par effet de champ de 7,1 cm 2 V −1 s −1 , et une oscillation sous le seuil (SS) de 0,67 V/déc. En termes de programmation de 80 ms à différents biais positifs, le I d –V g la courbe se déplace progressivement dans le sens d'une polarisation positive en fonction de la tension de programmation, par exemple, le Vth résultant décalage par rapport à l'appareil vierge (ΔVth ) augmente de 1,3 à 4,8 V avec l'augmentation de la tension de programmation de 8 à 13 V, présentant une saturation de programmation à 12 V, comme le montre la Fig. 2a. Un ΔVème si important suggère que des électrons considérables du canal a-IGZO de type n sont injectés dans le CTL de ZnO. De plus, lorsque la tension de programmation est fixée à 13 V, le ΔVth augmente lentement de 2 à 3,1 V en prolongeant le temps de programmation de 1 s à 30 ms, comme le montre la figure 2c. Fait intéressant, lorsque le dispositif de mémoire vierge est programmé avec une polarisation de porte négative, le Vth présente une évolution notable vers un biais négatif, illustré à la figure 2b. Pour un temps de programmation constant de 80 ms, le ΔVth augmente de -5,2 à -7,4 V avec un biais de programmation croissant de -8 à -13 V. Même si le dispositif de mémoire vierge est programmé à -13 V pendant 1 s, il peut également démontrer un ΔVth aussi grand que -6,5 V, illustré à la Fig. 2d. Cela signifie qu'un très grand nombre d'électrons sont dé-piégés du CTL, ce qui entraîne le reste de nombreuses charges positives.
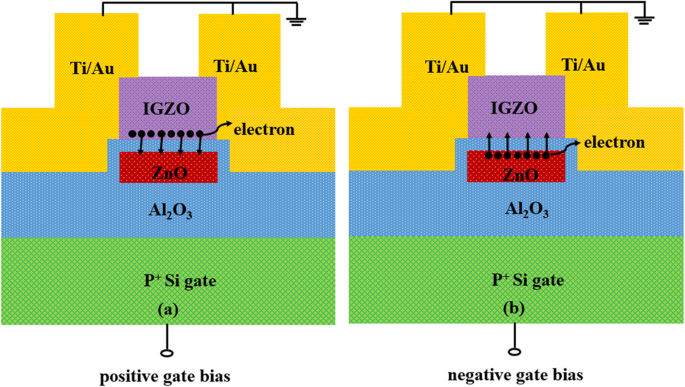
Les diagrammes schématiques en coupe transversale du dispositif de mémoire TFT a-IGZO programmé sous une polarisation de porte positive (a ) et un biais de porte négatif (b ), respectivement.
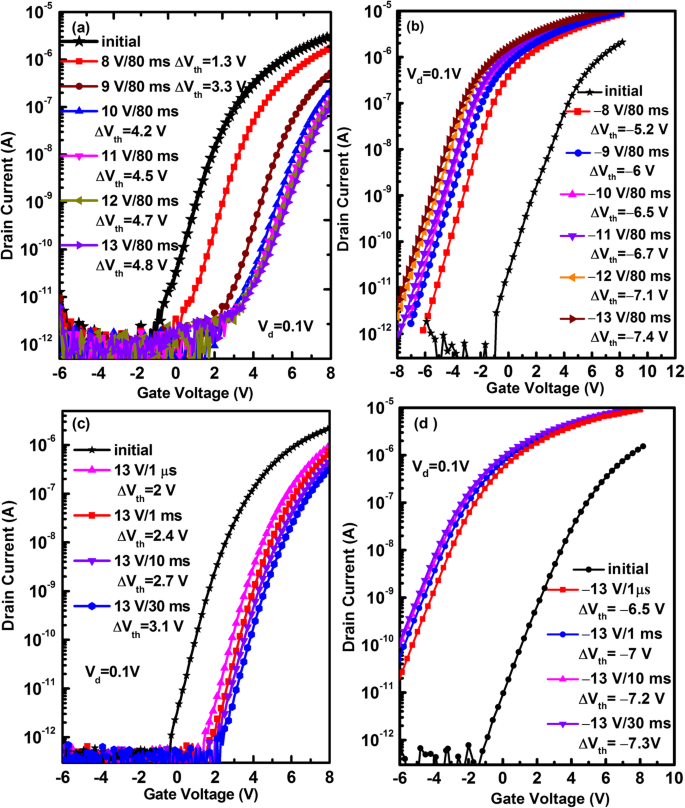
Les courbes de transfert du dispositif de mémoire TFT a-IGZO et celles programmées a à divers biais de porte positifs pour un temps constant de 80 ms, b à divers biais de grille négatifs pour un temps constant de 80 ms, c à 13 V pour divers temps de programmation, et d à -13 V pour divers temps de programmation. Toutes les courbes de transfert pour chaque figure ont été mesurées sur le même appareil, et toutes les opérations de programmation ont été effectuées en séquence.
Pour comprendre l'effet de piégeage de charge de la couche de ZnO, des TFT a-IGZO sans ZnO CTL sont également fabriqués comme dispositifs de contrôle à des fins de comparaison. La figure 3 montre les caractéristiques de transfert des dispositifs de contrôle lorsqu'ils sont programmés sous différentes polarisations positives et négatives, respectivement. On constate que l'appareil ne présente pas de Vth discernable indépendamment de la polarité et de l'amplitude de la tension de programmation. Cela indique que le ΔVth distinct susmentionné pour les dispositifs de mémoire doit être attribué au CTL ZnO. D'autre part, il est à noter que l'IGZO est un semi-conducteur naturel de type n, donc les électrons dans le canal IGZO peuvent être facilement injectés dans le ZnO CTL sous une polarisation de grille positive (par exemple . , +9V). Cependant, lorsqu'une polarisation de programmation négative est appliquée à l'électrode de grille du dispositif, le canal a-IGZO a tendance à s'épuiser et la conduction du trou est difficilement atteinte [15]. Dans ce cas, le dispositif ne peut pas être programmé via l'injection de trous à partir du canal, et donc la possibilité unique de programmation électrique doit être réalisée en dépiégeant des électrons intrinsèques dans le CTL ZnO vierge. En fait, nos résultats expérimentaux indiquent que le dispositif peut être facilement programmé sous des biais de grille négatifs, voir Fig. 2d. La figure 4 montre les caractéristiques d'endurance de la mémoire en fonction des cycles de programmation/effacement (P/E). L'appareil présente une fenêtre mémoire de 3,7 V pour 10 3 de cycles P/E dans le cas d'une programmation 11 V/1 ms et d'un effacement -9 V/10 µs. De plus, une fenêtre de mémoire aussi grande que 7,2 V peut être atteinte à 10 3 de cycles P/E par rapport à la programmation 12 V/1 ms et à l'effacement -12 V/10 µs. Le tableau 1 compare les caractéristiques de programmation et d'effacement de diverses mémoires TFT a-IGZO [14, 22, 23]. Par rapport à d'autres appareils, notre appareil présente une efficacité d'effacement beaucoup plus élevée même sous une polarisation plus faible (−12 V) et un temps beaucoup plus court (10 s) malgré une supériorité non notable dans l'efficacité de programmation.
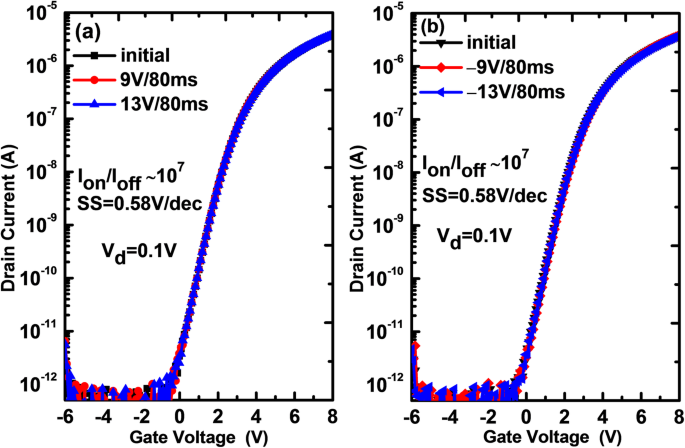
Les courbes de transfert de l'appareil TFT a-IGZO et celles programmées a à différentes polarisations de grille positives pour un temps constant de 80 ms et b à différents biais de grille négatifs pour un temps constant de 80 ms
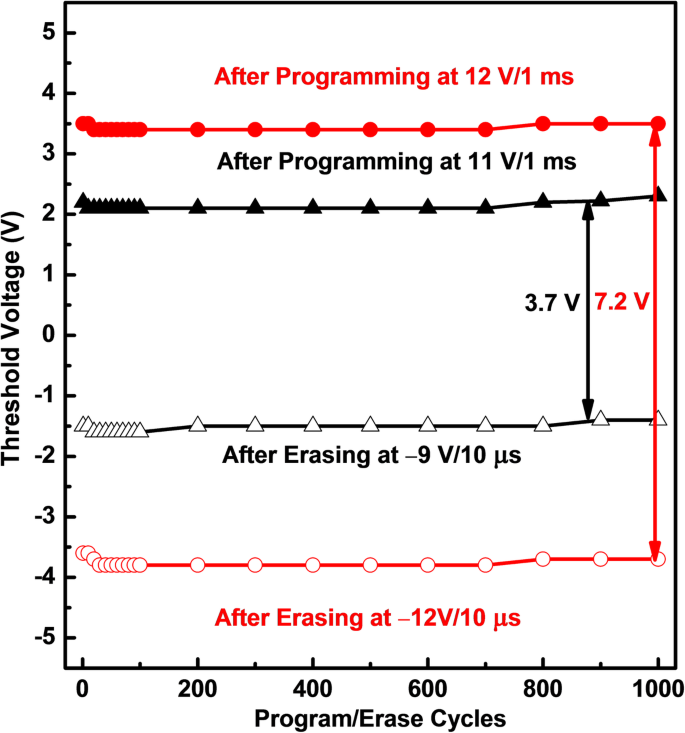
Les caractéristiques d'endurance du dispositif de mémoire TFT a-IGZO en fonction des cycles P/E
Pour clarifier l'origine des électrons dé-piégés du CTL ZnO vierge, divers CTL ZnO traités sont comparés dans les dispositifs de mémoire TFT a-IGZO. La figure 5 montre la dépendance de la tension de programmation de △Vth pour les appareils avec différents CTL ZnO. On observe que, pour les dispositifs de mémoire avec le comme-déposé et N2 -CTLs ZnO recuits, le ΔVth résultant présente une tendance à la hausse similaire avec l'augmentation de la tension de programmation malgré les polarités de tension. Cependant, pour le dispositif de mémoire avec le O2 -recuit ZnO CTL, la valeur absolue de ΔVth montre une diminution significative dans la même condition de programmation, par exemple, la valeur absolue de ΔVth diminue respectivement de 2 et 3 V dans le cas d'impulsions de programmation 13 V/80 ms et -12 V/1 µs. De plus, des comportements de programmation saturés sont observés pour le O2 -CTL ZnO recuit dans le cas de polarisations de grille positives et négatives. Cela devrait être attribué au nombre limité de pièges dans le CTL. En un mot, le post-recuit en O2 à 250 °C réduit le nombre de centres de piégeage dans le film de ZnO, entraînant ainsi une diminution de la capacité de piégeage de charge.

Les décalages de tension de seuil des dispositifs de mémoire TFT a-IGZO avec différentes couches de piégeage de charge de ZnO traitées en fonction de a tension de programmation positive pour un temps de programmation constant de 80 ms et b tension de programmation négative pour un temps de programmation constant de 1 s. Pour chaque condition, cinq appareils ont été mesurés.
Pour étudier l'influence du post-recuit sur les propriétés du film de ZnO, les films de ZnO tels que déposés et traités sont caractérisés par des mesures d'effet Hall et XPS. Comme le montre la figure 6, le film de ZnO recuit dans N2 à 250 °C montre une concentration en porteurs de 4,4×10 19 cm −3 , ce qui est très proche de cela (4,5 × 10 19 cm −3 ) du film de ZnO tel que déposé ; cependant, le film de ZnO recuit en O2 à 250 °C présente une diminution remarquable de la concentration en porteurs, qui est égale à 1,8 × 10 18 cm −3 . Il est rapporté que les donneurs intrinsèques dans les films semi-conducteurs de ZnO de type n sont des lacunes d'oxygène [24]. Kwon et al. ont également rapporté que le rapport atomique O/Zn dans le film ALD ZnO diminuait progressivement de 0,90 à 0,78 avec l'augmentation de la température de dépôt de 70 à 130 °C [25]. Ceci révèle l'existence de lacunes d'oxygène dans les films ALD ZnO. Par conséquent, le O2 -la diminution de la concentration de porteurs (électrons) induite par le recuit devrait être liée à la réduction des lacunes d'oxygène dans le film de ZnO. En outre, les spectres O1s XPS haute résolution du film ZnO tel que déposé et ceux recuits dans N2 ou O2 sont analysés, comme le montre la figure 7. Les trois pics déconvolués sont centrés à 530,0, 531,6 et 532,4 eV, correspondant à O 2− ions liés avec Zn 2+ (O1), les lacunes en oxygène (O2) et l'élément oxygène chimisorbé (-OH, etc.) (O3), respectivement [26]. Par rapport au film de ZnO tel que déposé, le post-recuit en O2 génère une diminution de 2,1 % du pourcentage relatif d'O2. Néanmoins, pour le film ZnO recuit en N2 , le pourcentage relatif d'O2 est presque inchangé. Ces résultats indiquent que le O2 le recuit peut passiver les lacunes d'oxygène dans le film de ZnO, mais le N2 le recuit ne peut pas faire. Cela confirme encore la corrélation entre les lacunes en oxygène et la concentration de porteurs.

Les concentrations de porteurs du film de ZnO tel que déposé et de ceux recuits dans différentes conditions.
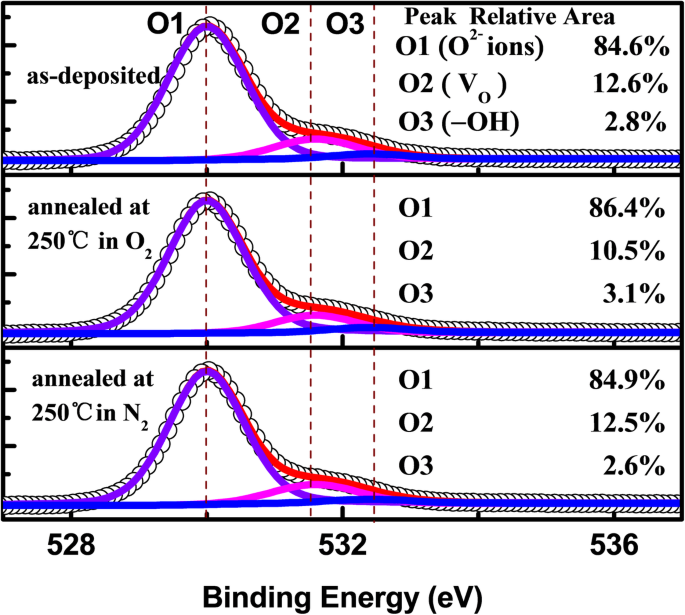
Spectres O1s XPS haute résolution du film de ZnO tel que déposé et de ceux recuits à 250 °C dans O2 et N2 , respectivement. O1 et O2 correspondent à O 2− ions liés avec Zn 2+ et les lacunes en oxygène, respectivement. L'O3 est attribué à l'élément oxygène chimisorbé (-OH, etc.). Pour éliminer involontairement les contaminants de surface, tous les échantillons ont été gravés avec un bombardement d'ions Ar in situ
Sur la base des résultats expérimentaux susmentionnés, on peut conclure que les caractéristiques de programmation des dispositifs de mémoire vierges sont dominées par la concentration de défauts liés à la lacune d'oxygène dans le ZnO CTL. En d'autres termes, les lacunes d'oxygène dans le film de ZnO servent principalement de centres de piégeage pour piéger les charges positives et négatives. Il est rapporté que les défauts liés au manque d'oxygène dans le ZnO incluent le manque d'oxygène neutre (VO ), manque d'oxygène ionisé simple (VO
+
), et le manque d'oxygène doublement ionisé (VO
2+
), dont les niveaux d'énergie se situent respectivement à 0,02–0,04, 0,3–0,45 et 0,61 eV en dessous du minimum de la bande de conduction de ZnO [27, 28]. Étant donné que le film de ZnO tel que déposé montre une concentration élevée en électrons dans notre cas, la concentration des lacunes d'oxygène neutre servant de donneurs peu profonds devrait être beaucoup plus élevée que celle des lacunes d'oxygène ionisé (VO
+
et VO
2+
). En termes de programmation avec une polarisation de grille positive, les électrons de la couche d'accumulation du canal a-IGZO sont injectés dans la couche de ZnO par le mécanisme d'effet tunnel de Fowler-Nordheim (FN), ce qui est démontré par un Vth
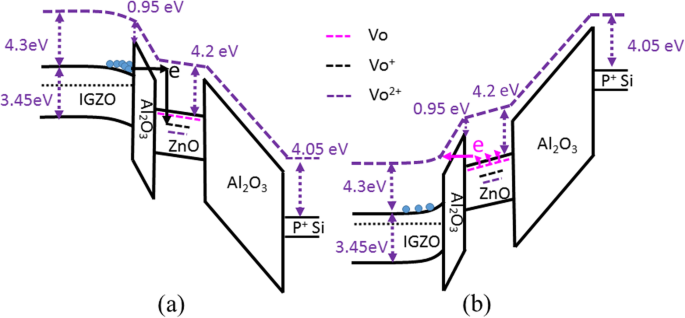
Diagrammes de bande d'énergie des dispositifs de mémoire TFT a-IGZO programmés à a un biais de porte positif et b un biais de grille négatif, respectivement. Vo , Vo + , et Vo 2+ désignent respectivement un manque d'oxygène neutre, un manque d'oxygène ionisé simple et un manque d'oxygène doublement ionisé
Conclusions
En résumé, nous avons fabriqué une mémoire TFT a-IGZO programmable bipolaire avec un CTL ZnO déposé sur une couche atomique. Par rapport à la programmation sous une polarisation de grille positive, la programmation sous une polarisation de grille négative peut générer une efficacité beaucoup plus élevée. Cela est dû au fait que différents défauts de manque d'oxygène prennent effet lors de la programmation dépendante de la polarité de la tension. C'est-à-dire des défauts profonds de VO + et VO 2+ jouent un rôle clé pour le piégeage des électrons lors de la programmation de polarisation positive et les défauts superficiels de VO donnent principalement des électrons pendant la programmation de polarisation négative, ce qui entraîne la génération de lacunes d'oxygène chargées positivement.
Disponibilité des données et des matériaux
Les ensembles de données soutenant les conclusions de ce manuscrit sont inclus dans le manuscrit.
Abréviations
- a-IGZO :
-
Oxyde d'indium-gallium-zinc amorphe
- ALD :
-
Dépôt de couche atomique
- CTL :
-
Couche de piégeage des charges
- TFT :
-
Transistor à couche mince
- XPS :
-
Spectroscopie photoélectronique aux rayons X
Nanomatériaux
- Réglage des morphologies de surface et des propriétés des films de ZnO par la conception de la couche interfaciale
- Réglage au niveau de Fermi des films ZnO par dépôt de couche atomique supercyclée
- Cellules solaires à pérovskite inversée hautement efficaces avec couche de transport d'électrons CdSe QD/LiF
- Enquête sur une cellule solaire au silicium cristallin avec une couche de silicium noir à l'arrière
- Amélioration des performances du périphérique TFT a-IGZO à l'aide d'un processus d'interface propre via des nano-couches Etch-Stopper
- Résistance de contact réduite entre le métal et le n-Ge par insertion de ZnO avec traitement au plasma d'argon
- Effet des hétérostructures bicouche CeO2−x/ZnO et ZnO/CeO2−x et polarité d'électroformage sur les propriétés de commutation de la mémoire non volatile
- Enquête sur la bande d'énergie aux hétérojonctions de ZnO/β-Ga2O3 (\( \overline{2}01 \)) déposées sur la couche atomique
- Python - Programmation d'extensions avec C



