Fenêtre de mémoire et amélioration de l'endurance des FeFET à base de Hf0.5Zr0.5O2 avec des couches d'ensemencement de ZrO2 caractérisées par des mesures d'impulsions de tension rapide
Résumé
Le HfO2 Le transistor à effet de champ ferroélectrique (FeFET) basé sur un empilement de grilles métal/ferroélectrique/isolant/semiconducteur (MFIS) est actuellement considéré comme un candidat possible pour une mémoire non volatile à haute densité et à vitesse d'écriture rapide. Bien que les performances de rétention du HfO2 FeFET basé sur une pile de portes MFIS pourrait répondre aux exigences des applications pratiques, sa fenêtre de mémoire (MW) et sa fiabilité en termes d'endurance devraient être encore améliorées. Ce travail étudie l'avantage d'employer ZrO2 couches de graines sur le MW, rétention et endurance du Hf0,5 Zr0,5 O2 FeFET basés sur (HZO) avec des piles de portes MFIS, en utilisant des mesures d'impulsions de tension rapides. On constate que le FeFET à base de HZO avec un ZrO2 la couche d'ensemencement montre un MW extrapolé initial et sur 10 ans plus important, ainsi que des performances d'endurance améliorées par rapport au FeFET à base de HZO sans le ZrO2 couche de graines. Les résultats indiquent que l'utilisation d'un empilement de grilles cristallines directes à haute teneur en k/Si améliorerait encore le MW et la fiabilité du HfO2 basés sur des FeFET.
Contexte
HfO2 Les films minces ferroélectriques à base sont considérés comme des matériaux d'empilement de grilles prometteurs pour les transistors à effet de champ ferroélectrique (FeFET) en raison de leur compatibilité et de leur évolutivité complémentaires métal-oxyde-semiconducteur (CMOS). Parmi plusieurs types de structures d'empilement de grilles pouvant être utilisées dans les FeFET, une configuration métal/ferroélectrique/isolant/semiconducteur (MFIS) représente une configuration plus pratique car elle suit les architectures actuelles des dispositifs MOS et correspond bien à la grille métallique high-k moderne. (HKMG) processus. Par conséquent, de gros efforts ont été déployés pour concevoir et fabriquer des FeFET avec des structures d'empilement de portes MFIS pour des applications dans des mémoires non volatiles intégrées, des transistors à effet de champ à capacité négative, des neurones artificiels, des synapses et des dispositifs logiques en mémoire [1,2,3,4 ,5,6,7,8].
Jusqu'à présent, des FeFET à haute densité et à vitesse d'écriture rapide avec des structures de pile de portes MFIS ont été fabriqués avec succès à l'aide de processus HKMG [9, 10]. En plus de la densité d'intégration élevée et de la vitesse d'écriture rapide, une grande fenêtre de mémoire (MW) et une fiabilité élevée en termes de rétention et d'endurance sont également essentielles pour l'utilisation de FeFET pour les applications de mémoire non volatile [11,12,13,14]. En raison d'une large bande décalée par rapport au silicium, d'un champ coercitif élevé et d'une constante diélectrique modérée du HfO2 -à base de couches minces ferroélectriques, HfO2 Les FeFET basés sur des structures de pile de portes MFIS présentent des propriétés de rétention fiables (extrapolation sur 10 ans) [15,16,17]. Cependant, bien que le HfO2 -Les films minces à base de démonstration d'une endurance modérée sur 1 × 10 9 cycles de commutation [14, 18], HfO2 -Les FeFET avec des structures de pile de portes MFIS ont une endurance plutôt limitée allant de 1 × 10 4 à 1 × 10 7 cycles de commutation [17, 19, 20, 21, 22, 23]. Théoriquement, l'utilisation de couches isolantes à k élevé devrait réduire le champ électrique dans la pile de portes MFIS, ce qui atténuerait la flexion de la bande, améliorant ainsi les propriétés d'endurance et les MW du HfO2 à base de FeFET [12, 14]. Expérimentalement, Ali et al. vérifié que l'augmentation de la valeur k de la couche isolante ultrafine (c'est-à-dire en utilisant SiON au lieu de SiO2 ) peut améliorer efficacement les propriétés d'endurance ainsi que le MW du HfO2 à base de FeFET [13]. Dans nos recherches précédentes [24], nous avons signalé que l'insertion d'un ZrO2 cristallin Une couche à k élevé dans les empilements de portes MFIS pourrait améliorer la qualité cristalline et supprimer la formation de phase monoclinique dans Hf0,5 Zr0,5 O2 (HZO) couches minces, ce qui conduit à une grande MW de 2,8 V caractérisée par la méthode de balayage de tension continue.
Dans ce travail, nous rapportons la caractérisation des MW, la rétention et l'endurance des FeFET à base de HZO avec et sans ZrO2 cristallin. couches d'ensemencement en utilisant des mesures rapides d'impulsions de tension positives et négatives. De plus, l'avantage d'employer le ZrO2 cristallin les couches de graines sur les propriétés MW et d'endurance sont discutées.
Méthodes
Les FeFET à canal n avec et sans ZrO2 les couches de germe ont été fabriquées en utilisant un processus de type gate last, comme décrit dans [24]. Le ZrO2 la couche de graines et la couche HZO ont toutes deux été cultivées à une température de croissance de 300 o C par dépôt de couche atomique (ALD). Le schéma des FeFET fabriqués est illustré à la Fig. 1a, dont la largeur de canal (W ) et la longueur (L ) étaient respectivement de 80 et 7 µm. Pendant ce temps, TaN/HZO/TaN et TaN/HZO/ZrO2 Des condensateurs /TaN ont également été fabriqués pour évaluer les propriétés ferroélectriques des films minces HZO. La polarisation–tension (P–V ) les boucles d'hystérésis des condensateurs ont été mesurées à l'aide d'un système de test ferroélectrique Radiant Technologies RT66A, tandis que les caractéristiques du dispositif des FeFET ont été mesurées par un analyseur de dispositif à semi-conducteur Agilent B1500A avec une unité génératrice d'impulsions (B1525A) [20]. Deux séquences de test principales utilisées pour les mesures de MW et d'endurance sont illustrées aux Fig. 1b et c. Pour les mesures de MW et de rétention, des impulsions de programmation/effacement (P/E) ont d'abord été appliquées aux grilles des FeFET, et les opérations de lecture ont été effectuées à différents intervalles de temps à l'aide de I D –V G balayage (V D = 0.1 V) pour détecter V TH . Généralement, V TH est déterminé comme une tension de grille correspondant à un courant de drain de 10 -7 A∙W/L [25], et le MW est défini comme la différence de V TH valeurs entre les états programmés et effacés. Pour les mesures d'endurance, le MW a été mesuré après un certain nombre d'impulsions P/E alternées.

un Schéma des FeFET fabriqués. Le ZrO2 cristallin supplémentaire la couche d'ensemencement est marquée par des lignes de quadrillage noires. b , c Séquences de test utilisées pour les mesures de MW et d'endurance
Résultats et discussion
La figure 2a montre le P–V boucles d'hystérésis des TaN/HZO/TaN et TaN/HZO/ZrO2 /Condensateurs Tan. Remarquablement, le TaN/HZO/ZrO2 Le condensateur /TaN possède des propriétés ferroélectriques encore meilleures que le condensateur TaN/HZO/TaN, ce qui est cohérent avec les résultats rapportés [26], indiquant que le ZrO2 cristallin La couche germe pourrait en effet améliorer la qualité cristalline et supprimer la formation de phase monoclinique dans les films minces de HZO [24]. La figure 2b montre le I D –V G courbes des FeFET à base de HZO avec et sans ZrO2 cristallin supplémentaire couches de graines après les impulsions P/E. Les lignes de symboles rouges représentent le I D –V G courbes après application d'une impulsion de programme de 7 V/100 ns, tandis que les lignes de symboles bleus représentent le I D –V G courbes après application d'une impulsion d'effacement de - 7 V/100 ns. On peut voir que le I D –V G les courbes des deux FeFET montrent des caractéristiques de commutation dans le sens inverse des aiguilles d'une montre, suggérant que les MW des FeFET actuels proviennent de la commutation de polarisation des couches HZO, plutôt que du piégeage et de l'injection de charge. Néanmoins, le FeFET à base de HZO avec le ZrO2 cristallin supplémentaire la couche d'ensemencement présente un MW amélioré de 1,4 V, environ 1,8 fois plus grand que celui (0,8 V) du FeFET à base de HZO sans le ZrO2 cristallin supplémentaire couche de graines. De plus, le MW obtenu de 1,4 V est comparable aux meilleurs résultats rapportés à ce jour [9, 11, 14, 17, 21, 22, 23, 27].
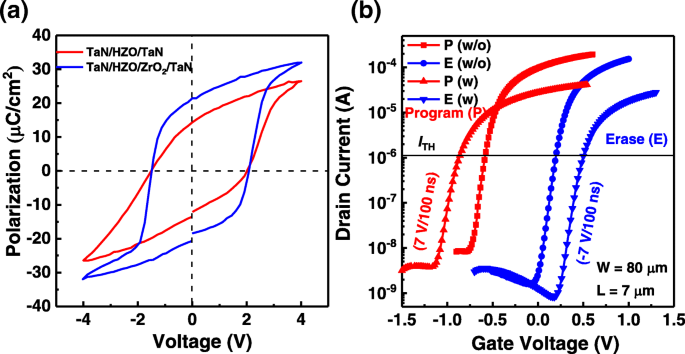
un P–V boucles d'hystérésis de TaN/HZO/TaN et TaN/HZO/ZrO2 /TaN Structures MFM mesurées à 4 V et une fréquence de 5 kHz. b Je D –V G courbes de FeFET à base de HZO avec (w) et sans (w/o) ZrO2 couches germes après une impulsion de programme (+ 7 V/100 ns) et une impulsion d'effacement (− 7 V/100 ns)
Fiabilité en ce qui concerne la rétention des FeFET à base de HZO avec et sans ZrO2 cristallin supplémentaire les couches de graines ont également été évaluées. La figure 3 montre le V TH caractéristiques de rétention après application d'une impulsion de programme de 7 V/100 ns et d'une impulsion d'effacement de – 7 V/100 ns à température ambiante. Il est clair que le V TH les valeurs sont approximativement linéaires avec l'échelle de temps logarithmique. Le MW extrapolé après 10 ans pour le FeFET à base de HZO avec le ZrO2 cristallin supplémentaire la couche d'ensemencement est de 0,9 V, plus grande que celle (0,6 V) pour le FeFET à base de HZO sans le ZrO2 cristallin supplémentaire couche de graines. Étant donné que l'épaisseur équivalente de capacité épaisse (CET) du ZrO2 (1.5 nm)/SiO2 (2.6 nm) les couches d'isolant de grille conduiraient à un champ de dépolarisation amélioré dans l'empilement de grilles [13, 15], une amélioration supplémentaire des propriétés de rétention pourrait être attendue si l'épaisseur du SiO2 couche est réduite.

Caractéristiques de rétention des FeFET à base de HZO avec et sans ZrO2 couches germes
La figure 4 montre l'évolution de I D –V G courbes après ± 7 V/100 ns cycles P/E alternatifs. Pour le FeFET sans le ZrO2 cristallin supplémentaire couche de semence, à la fois un déplacement et une dégradation de la pente importants dans le I D –V G les courbes sont observées dès les premiers stades du cycle P/E, et le I D –V G les courbes dans les états effacés présentent plus de dégradation de pente par rapport aux états du programme. Pour le FeFET avec le ZrO2 cristallin supplémentaire couche de semence, bien que le I D –V G les courbes dans les états effacés présentent un décalage positif évident au cours des premiers stades du cycle P/E qui est attribué à l'effet de « réveil » [13, 28,29,30,31,32], aucun décalage évident de I D –V G courbes dans les états du programme est observée jusqu'à 1 × 10 3 cycles. De plus, pour le FeFET avec le ZrO2 cristallin supplémentaire couche semence, le I D –V G les courbes dans les états effacés et programmés ne présentent qu'une légère dégradation de la pente jusqu'à 1 × 10 3 cycles.
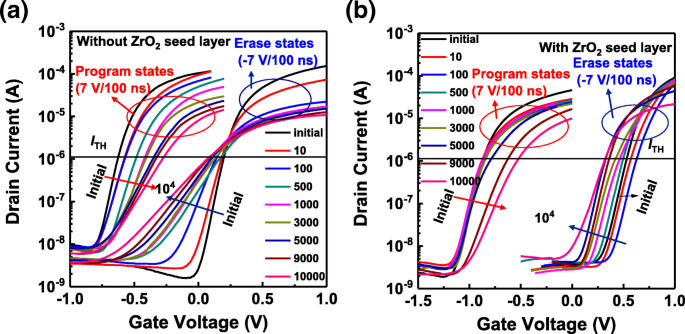
Évolution de Je D –V G courbes de FeFET à base de HZO a sans et b avec ZrO2 couches de semences avec cycle P/E
Selon les rapports précédents [12, 28, 33], le déplacement parallèle de I D –V G courbes est attribuée à l'accumulation progressive de charges piégées dans la pile de grille, tandis que la dégradation de la pente dans I D –V G courbes est le résultat de la génération de traps d'interface. Étant donné que les charges piégées peuvent être dé-piégées par des moyens électriques, mais que la génération de pièges d'interface est irréversible, la minimisation de la génération de pièges d'interface est extrêmement importante pour améliorer les propriétés d'endurance [28]. Les pièges d'interface générés par le cyclage P/E (ΔN il ) peut être décrit à l'aide de l'équation. (1) [34, 35] :
$$ \Delta \mathrm{SS}=\frac{\Delta {N}_{it} kT\ln 10}{C_{FI}{\varnothing}_F} $$ (1)où ΔSS est le changement de l'oscillation sous-seuil, k est la constante de Boltzmann, T est la température absolue, C FI est la capacité totale de la pile de grille, et ∅ F est le potentiel de Fermi. Le ΔN il en fonction du cycle P/E pour les FeFET à base de HZO avec et sans ZrO2 cristallin supplémentaire Les couches de germe sont illustrées à la Fig. 5. Clairement, pour le FeFET sans le ZrO2 cristallin supplémentaire couche semence, le ΔN il augmente évidemment dès les premiers stades du cycle P/E, et ΔN il dans les états effacés est beaucoup plus grande que celle dans les états de programme. Cependant, le ΔN il pour le FeFET avec le ZrO2 cristallin supplémentaire la couche de graines ne change presque pas jusqu'à 1 × 10 3 cycles, et il est toujours plus petit que celui du FeFET sans le ZrO2 cristallin supplémentaire couche de graines. Parce que l'insertion du ZrO2 supplémentaire la couche de germe réduit le champ électrique dans l'empilement de grilles et donc la courbure de la bande est plus faible, la génération de piège d'interface est atténuée [12, 14].
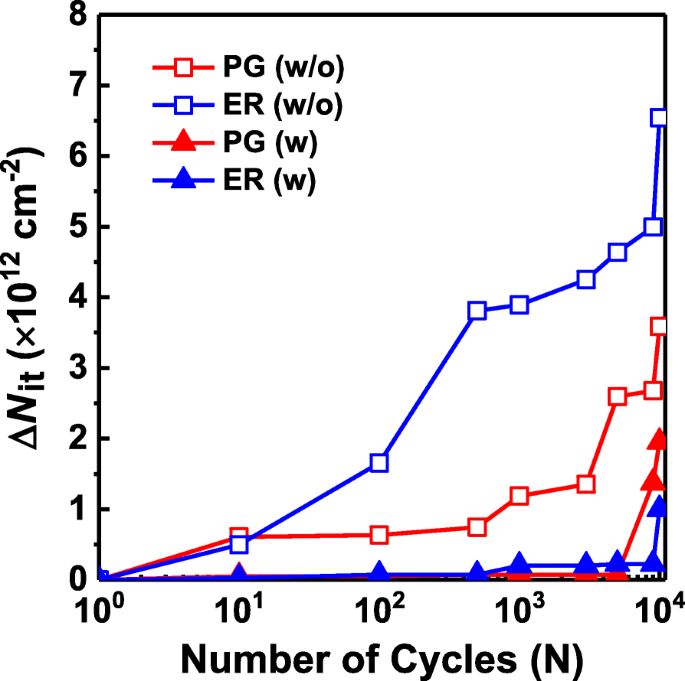
Évolution de ∆N il avec P/E cyclisme
La figure 6 montre l'évolution des caractéristiques du courant de fuite de grille (I G –V G courbes) de FeFET à base de HZO avec et sans ZrO2 couches de graines avec cycle P/E. Pour le FeFET sans le ZrO2 cristallin supplémentaire couche germe, le courant de fuite de grille augmente considérablement dès les premiers stades du cycle P/E. Cependant, le courant de fuite de grille pour le FeFET avec le ZrO2 cristallin supplémentaire la couche de graines ne change presque pas jusqu'à 5 × 10 2 cycles, et il est toujours plus petit que celui du FeFET sans le ZrO2 cristallin supplémentaire couche de graines. Il est rapporté que l'augmentation du courant de fuite de grille pourrait être liée aux pièges d'interface générés [28]. La réduction du courant de fuite de grille avec cyclage pour le FeFET avec le ZrO2 cristallin supplémentaire la couche germe serait attribuée à la suppression de la génération de pièges d'interface.
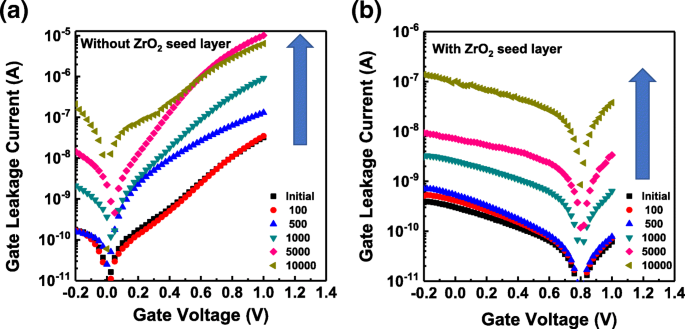
Evolution des caractéristiques de courant de fuite de grille (I G –V G courbes) de FeFET à base de HZO a sans et b avec ZrO2 couches de semences avec cycle P/E
Le V TH valeurs des états de programmation et d'effacement extraites du I D –V G courbes des FeFET à base de HZO avec et sans ZrO2 cristallin supplémentaire les couches d'ensemencement sont illustrées à la figure 7. Le FeFET à base de HZO avec le ZrO2 cristallin supplémentaire la couche d'ensemencement présente toujours un MW plus grand que le FeFET à base de HZO sans le ZrO2 cristallin supplémentaire couche de graines. De plus, le MW du FeFET à base de HZO sans le ZrO2 cristallin supplémentaire la couche de germe diminue évidemment dès les premiers stades du cycle P/E, tandis que le MW du FeFET à base de HZO avec le ZrO2 cristallin supplémentaire la couche de graines diminue légèrement jusqu'à 1 × 10 3 cycles. Au fur et à mesure que le nombre de cycles P/E augmente, le FeFET à base de HZO avec le ZrO2 cristallin supplémentaire la couche de graines montre également une dégradation évidente de la pente du I D –V G courbes et le MW, en raison de la génération améliorée de pièges d'interface. Cependant, le MW du FeFET à base de HZO avec le ZrO2 cristallin supplémentaire la couche d'ensemencement est toujours plus grande que 0.9 V jusqu'à 1 × 10 4 cycles, ce qui est environ 2,3 fois plus grand que celui (0,4 V) du FeFET à base de HZO sans le ZrO2 cristallin supplémentaire couche de graines. Comme discuté précédemment, la diminution du champ électrique requis pour obtenir des états de polarisation plus saturés est probablement responsable de l'amélioration des propriétés d'endurance.

Évolution de V TH avec P/E cyclisme
Conclusions
Les MW ainsi que la fiabilité en termes de rétention et d'endurance des FeFET à base de HZO avec le TaN/HZO/SiO2 /Si et TaN/HZO/ZrO2 /SiO2 Les empilements de portes /Si MFIS ont été caractérisés par des mesures d'impulsions de tension rapides. Les résultats montrent que le FeFET à base de HZO avec le ZrO cristallin supplémentaire2 la couche de germe présente une grande fenêtre de mémoire initiale de 1,4 V et une rétention extrapolée de 10 ans de 0,9 V, plus grande que la fenêtre de mémoire initiale (0,8 V) du FeFET à base de HZO sans le ZrO2 couche de graines. De plus, la fiabilité par rapport à l'endurance du FeFET à base de HZO peut être améliorée en insérant le ZrO2 cristallin couche d'ensemencement entre la couche HZO et le SiO2 /Si substrat. L'amélioration du MW et de l'endurance des FeFET à base de HZO avec ZrO2 les couches germes sont principalement liées à l'amélioration de la qualité cristalline de la couche HZO et à la suppression de la génération de pièges d'interface en raison de la diminution du champ électrique requis pour obtenir des états de polarisation plus saturés. Sur la base de ce travail, on s'attend à ce que l'utilisation d'un empilement de grilles cristallines directes à haute teneur en k/Si améliorerait encore les MW et la fiabilité du HfO2 -basés sur des FeFET, et justifient donc une étude et un développement plus approfondis.
Disponibilité des données et des matériaux
Les ensembles de données soutenant les conclusions de cet article sont inclus dans l'article.
Abréviations
- CMOS :
-
Métal-oxyde-semi-conducteur complémentaire
- FeFET :
-
Transistor à effet de champ ferroélectrique
- FeFET :
-
Transistors ferroélectriques à effet de champ
- HKMG :
-
Porte métallique High-k
- HZO :
-
Hf0,5 Zr0,5 O2
- Je D :
-
Courant de vidange
- L :
-
Longueur
- MFIS :
-
Métal/ferroélectrique/isolant/semi-conducteur
- MW :
-
Fenêtre mémoire
- P/E :
-
Programmer/effacer
- P–V :
-
Polarisation–tension
- SS :
-
Balançoire sous le seuil
- V G :
-
Tension de grille
- V TH :
-
Tension de seuil
- W :
-
Largeur
- ΔN il :
-
Les pièges d'interface générés
Nanomatériaux
- ST :MCU 8 bits avec analogique riche et DMA dans un package SO-8 à faible coût
- Nanomatériau et nanocomposite intelligents dotés d'activités agrochimiques avancées
- Mémoire résistive ZrO2/ZrO2 − x /ZrO2 sans conformité avec comportement de commutation multi-états interfacial contrôlable
- Mécanisme de conduction et endurance améliorée dans la RRAM à base de HfO2 avec traitement de nitruration
- Amélioration de la modulation et de l'absorption de fréquence du microbolomètre THz avec structure en micropont par antennes de type spirale
- Morphologie, structure et propriétés optiques des films semi-conducteurs avec des nano-îlots GeSiSn et des couches tendues
- FET à canal U rectangulaire hautes performances avec une distance de seulement 2 nm entre les contacts source et drain
- Une référence de tension sans résistance à faible puissance à l'échelle nanométrique avec un PSRR élevé
- Couche atomique déposée Memristor flexible à base de Hf0.5Zr0.5O2 avec plasticité synaptique à court/long terme



